基片溫度對 Ti O2薄膜的微觀結構和紫外光電特性的影響
劉子麗,肖 峻*,蔣向東,孫繼偉
1.西南民族大學電氣信息工程學院,成都 610041;2.電子科技大學光電信息學院,成都 610054
1.School of Electrical&Information Engineering,Southwest University for nationalities,Chengdu 610041,China;
2.School of Opto-Electronic Information,University of Electronic Science and Technology,Chengdu 610054,China
TiO2薄膜具有高的化學穩定性[1]、良好的電性能、優異的光學性能。特別是納米尺度的 TiO2薄膜,它所特有的表面積大,光吸收性能好,表面活性大的優點,使其具有非常優異的光電性能[2]。TiO2薄膜的氣敏特性、紫外吸收及光伏特性應用于氣敏器件、光催化以及太陽能電池方面的研究十分活躍,已成為近年來薄膜科學與技術的研究熱點[3-5]。
TiO2的晶體結構分為三種:銳鈦礦、金紅石、板鈦礦。一般 TiO2薄膜中只存在銳鈦礦和金紅石兩種晶體結構[6]。金紅石相在高溫穩定,而銳鈦礦相易在低溫下生長[7]。
應用直流磁控濺射[8]設備制備 TiO2薄膜有以下優點:
(1)能夠控制薄膜的化學計量比;
(2)所獲得的薄膜與基片結合良好;
(3)濺射工藝可重復性好,膜厚可以控制,可在大面積基片上獲得厚度均勻的薄膜;
(4)相對于射頻磁控濺射,它的沉積速率較高。
本實驗研究了不同基片溫度對直流磁控濺射制備出的 TiO2薄膜的微觀結構、表面形貌、薄膜組分、紫外光照射下電阻響應時間的影響。
1 實驗
TiO2薄膜是利用直流磁控濺射鍍膜機在玻璃基底上通過反應磁控濺射制備的。實驗中 Ar作為濺射氣體,O2為反應氣體,分別通過氣體流量計進入制備室中。濺射靶為半徑 50 mm,厚度 350 mm的金屬 Ti,靶到基底距離為 7.5 cm。
根據設備的條件,通過優化濺射工藝參數,本底真空為 7×10-4Pa,工作氣體為 99.99%的 Ar,反應氣體為 99.999%的O2,用氣體流量計來控制其流量,用真空計來確定氣體分壓。通過控制氣體流量來達到控制氧分壓。濺射之前都要在純 Ar中預濺 30 min,以除去靶表面氧化物。當觀察到靶表面的輝光穩定,通入O2再預濺 20 min左右即可進行正式濺射。基片溫度由加熱器控制。由于在真空室中基片和加熱器緊密接觸,所以認為加熱器的溫度近似等于基片的溫度。
薄膜的晶體結構用 X射線衍射(XRD)進行分析,薄膜的表面形貌利用掃描電子顯微鏡(SEM)進行分析,掃描電子顯微鏡附帶的 X-射線能譜儀(EDS)測定薄膜的成分,薄膜紫外光電特性采用紫外燈照射薄膜,用萬用表記錄薄膜電阻,秒表記錄薄膜電阻的響應時間。
2 結果與討論
2.1 基片溫度對 TiO2薄膜結構的影響
基片溫度的選擇對制備高質量的 TiO2薄膜非常重要,圖 1為不同基片溫度下樣品的 XRD分析結果,由此圖可看到基片溫度對 TiO2薄膜的晶體取向有較大的影響。

圖 1 不同基片溫度下樣品的XRD分析
由圖 1(a)表明室溫下制備的樣品呈非晶態;圖 1(b)表明基片溫度為 250℃時,樣品的晶體取向為銳鈦礦的(101)、(112)、(200)、(211)方向,但衍射峰強度低,且有一些雜質峰,表明 TiO2薄膜結晶程度差,這些雜質峰可能是基片或雜質造成的[9];圖 1(c)表明基片溫度為 300℃時,樣品的晶體取向為銳鈦礦的(112)、(200)方向,比基片溫度為 250℃時的雜質峰減少;圖 1(d)表明基片溫度為 400℃時,晶體明顯地傾向于銳鈦礦的(101)方向,且衍射峰強度高,表明TiO2薄膜結晶程度高。這一結果與 Meng等[10]人在試驗中只發現了銳鈦礦結構的薄膜是相同的。但與其他一些研究者的結果有所不同,Pawlewicz和Busch[11]在基片溫度 200~400℃范圍內制備了具有金紅石和銳鈦礦共存結構的薄膜,Suhail等人[12]的實驗結果也報道了具有共存結構的薄膜。其主要機理可以解釋為,隨基片溫度的升高,落在基片表面上的薄膜原子的能量增強,晶體成核速率加快,容易形成晶體。由圖 1的 TiO2薄膜 XRD圖譜可知,隨著基片溫度的升高,TiO2的衍射峰強度變高,結晶程度變高。
2.2 基片溫度對 TiO2薄膜表面形貌的影響
圖 2為對應四種不同基片溫度薄膜的掃描電鏡照片,由圖 2可知基片溫度對 TiO2薄膜表面形貌有明顯的影響。由圖 2(a)可見基片溫度為 200℃時,薄膜表面致密光滑,幾乎沒有表面起伏;圖 2(b)為基片溫度為 250℃時,開始出現少量的晶粒,表面起伏較小,結合 XRD測試結果可知,此時 TiO2薄膜開始結晶為銳鈦礦相 TiO2;圖 2(c)為基片溫度為 300℃時,薄膜表面雖然仍比較致密,但是表面起伏出現的少量晶粒尺寸明顯變大;圖 2(d)可知基片溫度為 400℃時,TiO2薄膜表面起伏明顯增加,晶粒尺寸明顯增加[13],此照片與 XRD分析結果吻合,隨基片溫度的增加,TiO2薄膜晶粒長大并且結晶完全。
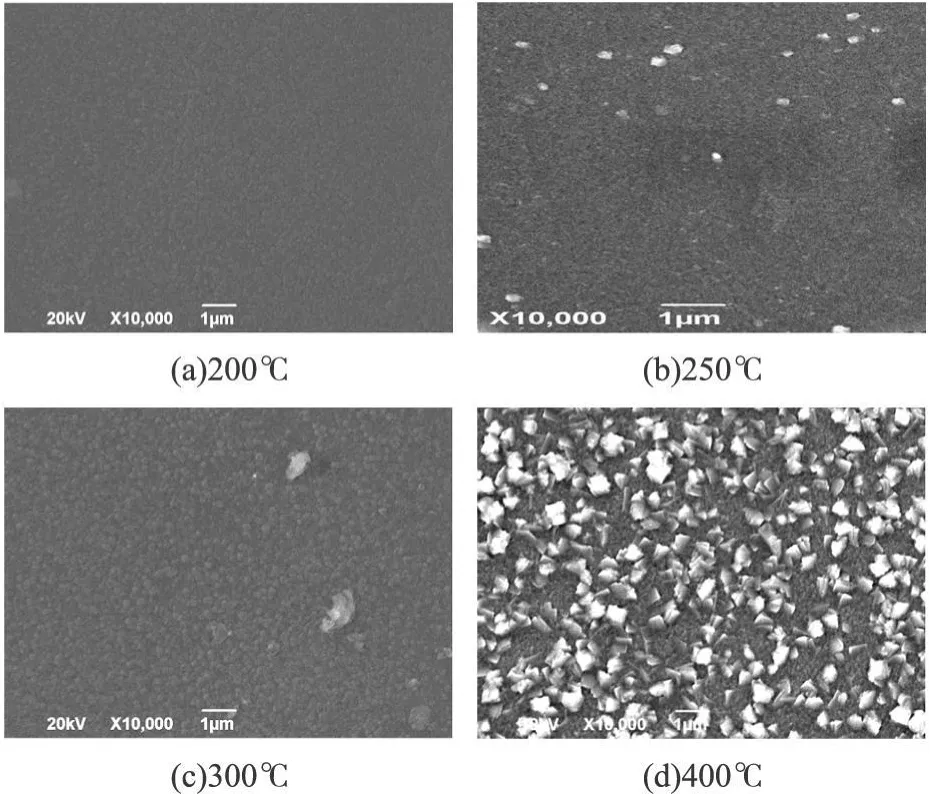
圖2 不同基片溫度薄膜的掃描電鏡照片
2.3 基片溫度對 TiO2化學計量比的影響
圖 3為不同基片溫度下 TiO2薄膜的 EDS圖譜。

圖 3 不同基片溫度下TiO2薄膜的 EDS圖譜
圖 3(a)為 250℃基片溫度下制備的 TiO2晶粒,其 EDS元素成分定性分析結果表明,Ti、O的化學計量比為 1∶1.931,基本符合 TiO2的標準化學計量比 1∶2;圖 3(b)為 400℃基片溫度下制備的 TiO2晶粒進行 EDS元素成分定性分析,結果表明,Ti、O的化學計量比為 1∶1.620,要比圖 3(a)中的晶粒化學計量比偏差。這個結果可以解釋為:隨著基片溫度的升高,晶粒出現再結晶的情況,晶粒長大,此時相對于較小晶粒表面積變小,不能與氧氣發生充分的反應,故基片溫度為 250℃時制備的薄膜更接近TiO2的化學計量比。表 1為兩種基片溫度下 TiO2薄膜元素成份的測量數據。

表1 TiO2薄膜元素成份的測量數據
2.4 基片溫度對 TiO2薄膜紫外光電特性的影響
將薄膜的兩端接在萬用表上,記錄其在紫外光照射下的電阻變化的響應時間如圖 4。圖(a)表明,200℃薄膜電阻的下降響應時間約為 5 s,上升響應時間約為 60 s,電阻從 50.2 MΩ下降到 5.4 MΩ,約9.3倍。圖 4(b)表明,250℃下薄膜電阻的下降響應時間約為 3 s,上升響應時間約為 30 s,電阻從47.2 MΩ下降到 2.5 MΩ,約 15倍;圖 4(c)可知,300℃薄膜電阻的下降響應時間約為 2.5 s,上升響應時間約為 35 s,電阻從 54.7 MΩ下降到 2.5 MΩ,約 20倍;從圖 4(d)可知,400℃薄膜電阻的下降響應時間約為 2 s,上升響應時間約為 20 s,電阻從53.2 MΩ下降到 2.3 MΩ,約 23倍。由此可知,400℃基片溫度下制備的 TiO2薄膜對紫外光更敏感,響應速度也更快。造成響應時間較長的原因,我們認為,是由于廣泛分布于納米晶體中的缺陷陷阱的存在造成的,這些缺陷起到復合中心的作用。這也與前面提到的薄膜晶體結構相一致,400℃基片溫度下制備的薄膜的結晶要比 250℃基片溫度下制備的薄膜結晶完全,并且基片溫度的升高,薄膜缺陷也會大大減小。因此為了縮短響應時間,應該盡量減少晶體的缺陷,提高晶體完整性。

圖4 不同基片溫度紫外光照射下 TiO2薄膜電阻的響應時間
3 結論
采用直流磁控濺射制備 TiO2薄膜,在室溫的情況下制備的 TiO2薄膜呈非定型態,在 250℃基片溫度時制備的薄膜結晶為銳鈦礦相,基片溫度為 300℃時,TiO2薄膜的雜質峰減少,結晶性變好,基片溫度達到 400℃時,TiO2薄膜出現(101)方向上的擇優取向的銳鈦礦。隨著基片溫度的升高,TiO2薄膜的表面起伏增加,晶粒尺寸增大。基片溫度為 250℃時,晶粒的表面積較大,使得與氧氣充分反應,得到具有較好化學計量比的 TiO2薄膜。另外由于400℃基片溫度下薄膜的結晶性較好,其在紫外光照射下電阻的響應時間比低溫下制備的好。
[1] Radecka M.TiO2for Photoelectrolytic Decomposition of Water[J].Thin film,2004,451:98-104.
[2]Fujishima A,Honda K.Electrochemical Photolysis of Water at a Semiconductor Electrode[J].Nature,1972,238:37-38.
[3]Kei Murakaoshi,Ryuichiro Kogure,Yuji Wada,et al.Fabrication of Solid-State Dye-Sensitized TiO2Solar Cells Combined with Poly Pyrrole[J].Colar Energy Materials and Solar Cells,1998,55:113-125.
[4]Luzzati S,Basso M,Catellnai M,et al.Photo-Induced Eleetron Transfer from a Dithiend Thiophene-Based Polymer to TiO2[J].Thin Solid Films,2002,403:52-56.
[5]Fred Williams A J,Muilnberg G,Smith T,et al.Irreversibilities in the Mechanism of Photo Electorlysis[J].Nature,1978,271:137-139.
[6]Junga C K,Leea SB,Boo J H,et al.Characterization of Growth Behavior and Structural Properties of TiO2Thin Films Grown on Si(100)and Si(111)Substrates[J].Surface and Coatings Technology.2003,174:296-302.
[7] 姚紅軍,汪榮昌,戎瑞芬,等.TiO2薄膜氧敏特性研究[J],半導體學報,1997,18(10):761-764.
[8]Mark C.Barnes,Sunil Kumar,Len Green,The Mechanism of Low Temperature Deposition of Crystalline Anatase by Reactive DC Magnetron Sputtering[J].Surface&Coatings Technology,2005,190:321-330.
[9] 王賀權,沈輝,巴德純,等.氧流量對直流反應磁控濺射制備TiO2薄膜的光學性質的影響[J].中山大學學報(自然科學版),2005,44(6):36-40.
[10]Meng Lijian,Andrischky M,Dos Santos MP.Investigation of Titanium Oxide Films Deposited by D CReactive Magnetron Sputtering in Different Sputtering Pressure[J].Thin Solid Films,1993,226:22-29.
[11]Pawlewicz W T,Mann,Lowdermilk I B,et al.Laser Damage Resistant Transparent Conductive Indium Tin Oxide Coatings[J].Applied Physics Letters,1979,34:196-198.
[12]Suhail M H,Mohan Rao G,Mohan S.DC Reactive Magnetron Sputtering of Titanium-Structural and Optical Characterization of TiO2Films[J].Applied Physics,1992,71:1421-1427.
[13] 劉佳,朱昌.退火溫度對薄膜結構和光學性能的影響[J].表面技術,2009,38(1):40-42.

