低偏振高功率1 310 nm超輻射發光二極管的液相外延生長
周 勇,段利華,2*,張 靖,劉尚軍,韓偉峰,黃 茂
(1.重慶光電技術研究所,重慶 400060; 2.重慶大學應用物理系,重慶 400044)
低偏振高功率1 310 nm超輻射發光二極管的液相外延生長
周 勇1,段利華1,2*,張 靖1,劉尚軍1,韓偉峰1,黃 茂1
(1.重慶光電技術研究所,重慶 400060; 2.重慶大學應用物理系,重慶 400044)
對新月形超輻射發光二極管的液相外延生長過程進行了機理分析。利用Matlab軟件對建立的非平面生長模型進行了理論計算,并利用掃描電鏡(SEM)對液相外延生長的形貌進行了分析,通過理論計算與實驗分析設計了獲得低偏振、高功率超輻射發光二極管的外延結構。利用該結構研制的超輻射發光二極管芯片在100 mA工作電流、25℃工作溫度下輸出功率達到3.6 mW,相應的輸出波長為1 306 nm,光譜半寬為39 nm,光譜波紋為0.17 dB,偏振度為2%。
超輻射發光二極管;低偏振度;高功率;液相外延
1 引 言
超輻射發光二極管(SLD)的性能介于激光二極管與發光二極管之間,具有短相干長度、低噪聲以及寬光譜等優點,是用于光纖陀螺[1]、光學傳感[2]等領域的理想光源。實際的SLD光源發射的是部分偏振光,大部分的功率在平行于半導體結的水平偏振中,并且在相同驅動電流下,光源出射光的偏振度會隨著外界環境的變化而波動,在光纖陀螺中會導致偏振相位誤差。光源出射的光的偏振度越高,其出射光的偏振態對外界環境越敏感。通過在光源后面使用消偏器可以實現2%~5%的低偏振度[3],不過這種途徑需要考慮技術成本等問題。近年來,關于SLD的研究主要集中在~0.8[4],~1.0[5],~1.3[6],~1.5μm[7]波段。人們通過采用腔面鍍抗反射膜、非泵浦吸收區以及傾斜腔面等技術來抑制F-P腔內的光振蕩以實現低光譜波紋。為了實現SLD高功率輸出,Yoo等[8]提出了“V”溝結構、Xin等[9]提出了多段圖形結構等SLD制作技術。Khan等[10]通過采用量子阱和量子線等技術,提高了SLD的光譜半寬。隨著對應變結構材料研究的進步,偏振不敏感半導體光放大器(SOA)與SLD器件得以實現,SOA與SLD的偏振度普遍降低至1 dB(~10%)的水平[11-13]。劉科等[14]采用MOCVD生長混合應變量子阱的脊波導結構SLD,在100mA注入電流下,裸管芯的輸出功率為3.5 mW,偏振度為0.3 dB。由于具有更好的圖形對稱性,方塊狀的體材料有源區比量子阱結構有源區更容易實現偏振不敏感。掩埋異質結構(BH)的橫向折射率差遠大于脊波導結構,能更好地實現光源與光纖的有效耦合、線性光-電流特性、穩定的基橫模以及良好的漏電流限制,有利于實現低偏振、大功率輸出。
液相外延生長技術具有工藝簡單、成本低、外延層界面質量好等優點,已廣泛應用于Ⅲ-Ⅴ族材料的制備[15-18]。為了提高輸出功率,我們曾對雙溝平面掩埋異質結構(DCPBH)SLD的漏電機理進行了擬合分析,并通過結構優化實現了對電流限制較為理想的掩埋異質結構[19]。針對光纖陀螺等領域的應用,本文就掩埋新月形(BC)結構的液相外延生長技術進行了研究分析,通過采用體材料有源區結構,實現了低偏振度、高功率的SLD器件。
2 理論分析
2.1 基橫模條件
SLD外延片采用兩步外延工藝制作。一次外延采用MOCVD生長,在n-InP襯底上依次生長n-InP緩沖層、p-InP電流阻擋層和n-InP限制層。然后,通過光刻工藝在一次外延片上沿〈011〉晶向刻蝕出寬約1.8μm、深約2.5μm的燕尾槽。二次液相外延在溝道襯底上依次生長n-InP緩沖層、InGaAsP下波導層、InGaAsP有源層、InGaAsP上波導層、p-InP限制層和n-InGaAsP頂層。外延生長完成后,在燕尾槽上方刻蝕窗口,并通過p型Cd擴散形成電流通道。SLD層次結構如圖1(a)所示。
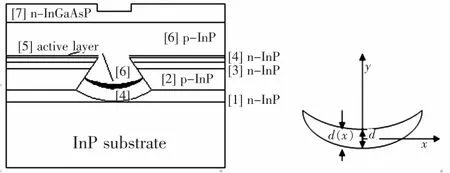
圖1 (a)SLD層次結構示意圖;(b)分析導模時所采用的坐標系統。Fig.1 (a)Schematic diagram of layers structure of SLD. (b)Coordinate system for guided modes.
圖1(b)為分析導模時所采用的坐標系統。從BC激光器導模的性質出發,認為新月形有源區為一個被包層覆蓋的拋物線波導,有源層厚度d(x)隨x呈拋物線變化[20]:

式中,d0為有源層中心厚度,W為沿x方向的有源層寬度。若有源區的折射率為n1,InP包層的折射率為n2,對于薄的有源層以及弱波導情況下,拋物線波導的模截止寬度Wc為:

其中,m=1,2…。取n1=3.358,n2=3.162,λ0= 1.3μm,可求出基橫模截止時的Wcd0=0.302 μm2。圖2為計算出的各階模截止條件。
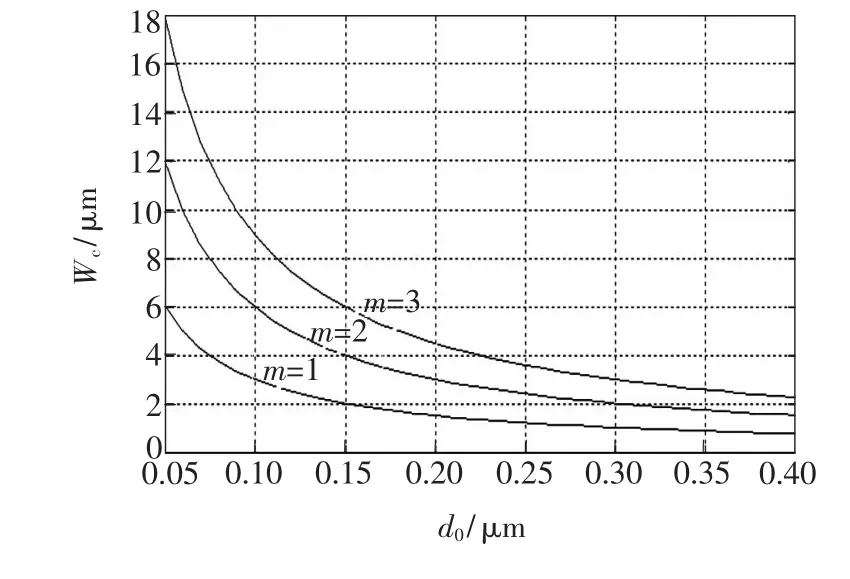
圖2 各階模截止條件Fig.2 Cut-off conditions of differentmodes
我們生長的有源層厚度典型值為d0=0.15 μm。為獲得穩定的基橫模輸出,有源層的寬度最大不能超過2μm。采用的光刻圖形為溝道寬1.8μm、深2.5μm的燕尾槽結構,燕尾槽底部的寬度為5μm。這種燕尾槽結構在掩埋生長時不容易實現窄條寬的生長,而為了實現基橫模、高功率輸出,減小有源層的條寬是必須的。有源層的形狀直接受二次外延時第一層n-InP生長的影響。第一層生長時間短,有源層位置低、寬度大,如圖3(a)所示,有源層寬度為2.72μm。增加n-InP層的生長時間可以抬高有源層的位置使其向燕尾槽口偏移,這樣可以略微減小有源層的寬度,但是容易出現槽口回熔塌邊增加漏電,如圖3(b)所示,有源層的寬度為2.45μm。為了有效地縮小有源層條寬同時抑制槽口的回熔,我們對二次外延時第一層n-InP的外延生長機理進行了分析。
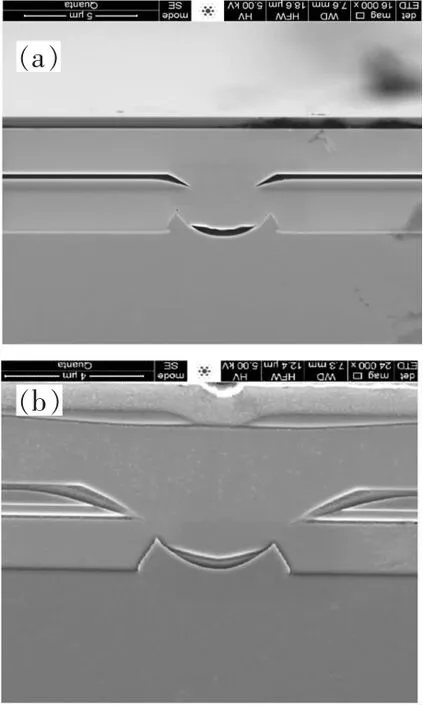
圖3 液相外延生長截面SEM圖Fig.3 SEM sectional views of the SLD grown by LPE
2.2 生長機理分析
二次液相外延第一層n-InP的生長厚度以及所形成界面的曲率直接決定了第二層有源層的生長形狀。溝道內的生長速率是不同的,拐角處的生長速率比平面的快。由于局部的快速生長導致熔源中缺磷,拐角處的快速生長致使溝道底部中間的生長緩慢[21]。
對于實際有用的幾種非平面結構,可將固-液界面分解為扇形“基元”,以建立非平面LPE生長的理論模型。如圖4(a)所示,選用通常的極坐標系,其中0≤θ0≤2π,近邊區生長滿足如下方程[17]:


略去馳豫項,可以得到在近邊區的生長層厚度為:


圖4 (a)非平面結構的基本模型;(b)燕尾槽示意圖。Fig.4 (a)Fundamental model of curved surface.(b) Schematic diagram of dovetail groove.
用這種“基元”組成燕尾槽,如圖4(b)所示。不管是理論預期還是實際生長情況,在圖4(b)中的A點處,即溝道底部的中間生長是比較緩慢的。為方便計算,第一層在A點處外延生長的厚度認為是燕尾槽底部兩個角在此處生長厚度的疊加。于是,A點處的厚度為:

利用Matlab軟件對上述模型進行擬合計算,參數選取D=4×10-4cm2/s,K=10-2cm/s[17]。圖4(b)中A點處生長厚度與生長時間的關系曲線如圖5所示。從理論曲線可以看到,在生長時間少于3 s時,A點處無外延層生長。隨著生長時間的增加,生長厚度開始時較快,然后趨于緩慢。剛開始時,由于拐角處優先生長導致局部溶質飽和度降低,在短時間內A點處無法生長。計算時我們假定A點處厚度是兩個厚度的近似疊加,落入溝道內的溶液同時為兩個角的生長提供溶質,局部溶質更容易耗盡,生長速度變緩,厚度值相對于獨立的一個角所處情況要小,所以生長初期A點處的實際值略小于理論值。隨著生長的進行,拐點優勢逐漸消失,A點開始快速生長。而后由于溝道內溶液的溶質逐漸耗盡,所以生長變慢。如果繼續生長,則非常容易引起燕尾槽肩部回熔,導致溶液中溶質含量上升,生長速度加快,此時的實際值高于理論值。

圖5 A點處第一層n-InP生長厚度與生長時間的關系Fig.5 Thickness of n-InP layer at point A vs.growth time
為了便于顯結觀察,我們在n-InP層前增加一層非摻雜的InGaAsP層進行外延生長,其生長時間分別為1,2,3 s,生長形貌如圖6(a)~(c)所示。從圖6(c)可以看到,當生長時間為3 s時,燕尾槽溝底中間A點處未能長上,但是拐角處的優先生長并不明顯,這可能與生長的材料體系有關。我們將這一層InGaAsP層換成p-InP層,生長時間為2 s(圖6(d)),可以看出拐角優勢生長明顯,且A點處未長上。在n-InP層前增加一層p-InP有如下優點:(1)在燕尾槽溝底兩側形成了反向pn結電流限制,減小了漏電通道;(2)燕尾槽底角的填充有利于n-InP層生長后形成“U”型界面,從而縮小有源層的寬度,圖6(d)中有源層的寬度為1.9μm;(3)底角填充后局部區域快速生長消失,外延生長與溶質輸運達到一定平衡從而抑制了燕尾槽肩部回熔,也減少了漏電通道。所以,增加p-InP層的生長有利于實現高功率的輸出。

圖6 液相外延生長后的截面SEM圖,在n-InP之前增加了一層生長時間分別為1 s(a),2 s(b),3 s(c)的非摻雜InGaAsP,或一層生長時間為2 s的p-InP(d)。Fig.6 SEM sectional views of SLD grown by LPE,an InGaAsP layer grown with 1 s(a),2 s(b),3 s (c)or p-InP layer grown with 2 s(d)was added before n-InP layer,respectively.
3 結果與討論

圖7 芯片結構示意圖Fig.7 Schematic drawing of SLD chip
我們在二次液相外延生長n-InP緩沖層前增加一層生長時間為2 s的p-InP,然后利用常規工藝制作SLD芯片,芯片結構如圖7所示。有源發光區長300μm。非泵浦吸收區采用直波導結構,長度為600μm。在距芯片后端面200μm處制作有Ti/Pt/Au p面電極,用于接地,它可以吸收SLD后向光泄露至限制層的光子從而減少后端面光的反射,降低SLD輸出光的光譜波紋。兩個p面電極之間的高摻雜InGaAsP頂層被腐蝕以增加電極間的電阻。在經過n面減薄后,利用熱蒸發制作n面電極AuGeNi/Au。為了抑制腔內的激射振蕩,在兩腔面鍍1/4波長厚度的ZrO2增透膜。利用鉛錫將芯片燒焊至AlN熱沉上,AlN熱沉置于致冷器上以控制SLD的工作溫度。
在100 mA連續工作(CW)電流、25℃工作溫度下,對SLD芯片進行光電性能測試。其輸出波長為1 306 nm,相應的光譜半寬為39 nm,光譜波紋為0.17 dB,如圖8所示。圖9為芯片的L-IV曲線,其在100mA下的輸出功率達到3.6mW,相應的偏振度為2%。芯片相對輸出功率隨偏振角度的變化如圖10所示。
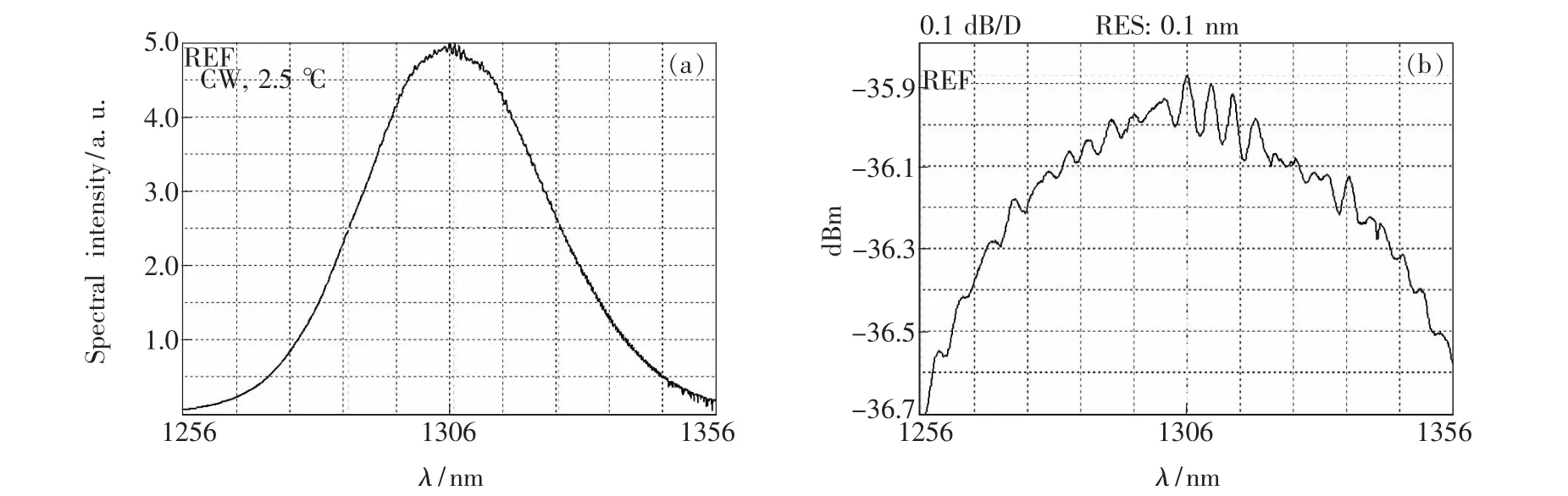
圖8 芯片典型的光譜曲線Fig.8 Typical spectrum of SLD
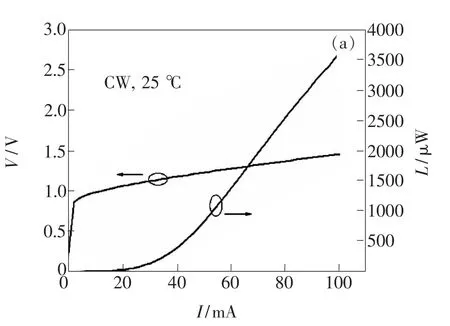
圖9 芯片典型的L-I-V曲線Fig.9 Typical L-I-V curves of SLD

圖10 芯片相對功率隨偏振角度的變化Fig.10 Relative light of SLD vs.polarization angle
4 結 論
通過理論計算得出了燕尾槽新月形結構SLD基橫模穩定輸出的條件。在此基礎上,通過建立的非平面生長模型對液相外延生長機理進行了分析,并通過理論與實驗分析設計了低偏振、高功率SLD的外延結構。在100 mA工作電流、25℃工作溫度下,利用該結構研制的SLD芯片的輸出光功率達到3.6 mW,相應的輸出波長為1 306 nm,光譜半寬為39 nm,光譜波紋為0.17 dB,偏振度為2%。該低偏振度、高功率SLD器件可以作為光源用于光纖陀螺、光纖傳感等領域。
[1]?elikel O,San SE.Design details and characterization of all digital closed-loop interferometric fiber optic gyroscope with superluminescent light emitting diode[J].Opt.Rev.,2009,16(1):35-43.
[2]Feng X J,Wang X X,Li L J,et al.Influences of imperfect polarization induced effects to the quasi-reciprocal reflective optical voltage sensor[J].J.Lightwave Technol.,2013,31(16):2777-2784.
[3]Heimann M,Liesegang M,Arndt-Staufenbiel N,et al.Optical system components for navigation grade fiber optic gyroscopes[J].SPIE,2013,8899:88991A-1-9.
[4]Andreeva E V,Il'ichenko SN,Kostin Y O,etal.Broadband superluminescent diodeswith bell-shaped spectra emitting in the range from 800 to 900 nm[J].Quant.Electron.,2013,43(8):751-756.
[5]Duan LH,Fang L,Zhang J,etal.Fabrication and characteristics of high speed InGaAs/GaAs quantum-wells superluminescent diode emitting at1 053 nm[J].Semicond.Sci.Technol.,2014,29(5):055004-1-5.
[6]Ozaki N,Yasuda T,Ohkouchi S,etal.Near-infrared superluminescent diode using stacked self-assembled InAs quantum dots with controlled emission wavelengths[J].Jpn.J.Appl.Phys.,2014,53(4S):04EG10-1-5.
[7]Kredzinski L,Connelly M J.Anti-Stokes effectCCD camera and SLD based optical coherence tomography for full-field imaging in the 1 550 nm region[J].SPIE,2012,8427:84274D-1-5.
[8]Yoo Y C,Han IK,Lee J I.High power broadband superluminescent diodes with chirped multiple quantum dots[J]. Electron.Lett.,2007,43(19):1045-1047.
[9]Xin Y C,Martinez A,Saiz T,et al.1.3-μm quantum-dotmultisection superluminescent diodes with extremely broad bandwidth[J].IEEE Photon.Technol.Lett.,2007,19(7):501-503.
[10]Khan M ZM,Majid M A,Ng T K,et al.Simultaneous quantum dash-well emission in a chirped dash-in-well superluminescent diode with spectral bandwidth>700 nm[J].Opt.Lett.,2013,38(19):3720-3723.
[11]Nkanta JE,Maldonado-Basilio R,Khan K,et al.Low polarization-sensitive asymmetricmulti-quantum well semiconductor amplifier for next-generation optical access networks[J].Opt.Lett.,2013,38(16):3165-3168.
[12]Zhao H,Huang Y D,Zhang W,et al.Simulation of polarization-insensitive multiple-quantum-well superluminescent diodes[J].Chin.Opt.Lett.,2006,4(3):181-183.
[13]Heo D,Lee J S,Yun I K,et al.Polarization-independent,high-power,and angle-flared superluminescent diode for WDM-PON applications[C]//Lasers and Electro-Optics Society,Sidney:IEEE,2005:627-628.
[14]Liu K,Song AM,Tian K,etal.Quantum well superluminescent diodeswith high power and low polarization degree[J]. Semicond.Optoelectron.(半導體光電),2013,34(6):949-953(in Chinese).
[15]Yang JH,Gao X,Li ZH,etal.A study on high-quality high power InGaAsP/GaAs lasers grown by liquid phase epitaxy[J].Acta Armamentarii(兵工學報),2001,22(2):214-217(in Chinese).
[16]Wang L,Li ZH,Xu L,et al.Al-free SQW high-power semiconductor lasers[J].Semicond.Optoelectron.(半導體光電),2002,23(6):391-392(in Chinese).
[17]Li X,Chen GX,Jian SS.Theory and experimentof liquid phase epitaxy on curved InP surface[J].Chin.J.Semicond. (半導體學報),1995,16(2):93-100(in Chinese).
[18]Vilmos R,Janos B,Sandor P,et al.Influence of LPE growth conditions on the electroluminescence properties of InP/ InGaAs(P)infrared emitting diodes[J].Mater.Sci.Eng.,2001,B80:18-22.
[19]Duan LH,Fang L,Zhou Y,et al.Analysis on current leakage in DCPBH-SLD grown by LPE[J].Semicond.Optoelectron.(半導體光電),2012,33(3):342-345(in Chinese).
[20]Wang Q Z,Zhang W F,Pang T.InGaAsP/InP buried crescent laser diode[J].J.Univ.Electron.Sci.Technol.China (電子科技大學學報),1989,18(1):78-82(in Chinese).
[21]Mito I,Kitamura M,Kobayashi K,et al.InGaAsP double-channel-planar-buried-heterostructure laser diode(DC-PBH LD)with effective current confinement[J].J.Lightwave Technol.,1983,1(1):195-202.
1 310 nm Polarization-insensitive High Power Superlum inescent Diodes Fabricated by Liquid Phase Epitaxy
ZHOU Yong1,DUAN Li-hua1,2*,ZHANG Jing1,LIU Shang-jun1,HANWei-feng1,HUANG Mao1
(1.Chongqing Optoelectronics Research Institute,Chongqing 400060,China;2.Department of Applied Physics,Chongqing University,Chongqing 400044,China) *Corresponding Author,E-mail:dlhsemi@163.com
Theoretical analyses of growing processesweremade in the case of superluminesecnt diode with crescent structure by liquid phase epitaxy(LPE),which could perfectly explain some phenomena in experiments of LPE on curved InP surfaces.The results of numerical calculation were consistentwith the experimental results.The epitaxy structure was optimized to enhance the output power and reduce the polarization of the SLD.As a result,polarization dependence as low as 2% and 3.6 mW output powerwere obtained at100mA and 25℃heat-sink temperature,corresponding to 39 nm spectralwidth with spectralmodulation of less than 0.17 dB.
superluminescent diode;polarization insensitive;high power;liquid phase epitaxy
1000-7032(2015)01-0069-06
TN248.4文獻標識碼:A
10.3788/fgxb20153601.0069
2014-09-22;
2014-11-05
國家自然科學基金(11304405)資助項目

周勇(1964-),男,重慶人,高級工程師,1985年于成都電子科技大學獲得學士學位,主要從事半導體激光器件的研究。E-mail:coeri127@163.com

段利華(1980-),男,廣西桂林人,高級工程師,2005年于重慶大學得獲碩士學位,主要從事半導體激光器件的研究。E-mail:dlhsemi@163.com

