分布式布拉格反射與小面積金屬接觸復合三維電極結構的AlGaN基紫外LEDs設計
袁照容,楊 旭,李金釵,李書平,周穎慧,康俊勇
(廈門大學 物理與機電工程學院,福建省半導體材料及應用重點實驗室,福建 廈門361005)
GaN 基 發 光 二 極 管 (light-emitting diodes,LEDs)作為第四代綠色照明光源,具有節能、環保、壽命長、體積小等特點,已得到廣泛應用[1].LEDs的發光波長主要取決于半導體有源區材料的禁帶寬度,以AlGaN半導體材料為有源區(禁帶寬度Eg=3.4~6.0eV)的紫外光LEDs發光波長能夠覆蓋從近紫外波段到紫外波段(λ=365~210nm)[2],其在照明、殺菌、醫療、印刷、生化檢測、高密度的信息儲存和保密通信等領域具有重要應用前景[3-4].然而,由高 Al組分AlGaN基材料構成的紫外LEDs器件(ultraviolet LEDs,UV LEDs)光電轉換效率與可見光GaN基LEDs器件相比仍有較大差距[5].主要原因在于Al-GaN晶體質量不佳,外延半導體材料對紫外光的透射率低,背光反射電極的反射率不夠高,以及高Al組分AlGaN由于較高的受主激活能導致p-AlGaN電導率較低等[6].由于AlGaN、AlN材料相對較高的電阻率造成UV LEDs的電流擁堵問題尤為嚴重,有源區中大量的非輻射復合導致UV LEDs的自熱效應更加明顯.再加之p-GaN和p-AlGaN對紫外波段光的嚴重吸收,因此,傳統的器件結構并不適用于UV LEDs,亟需針對AlGaN材料特性進行器件結構的改造與設計.本文綜合考慮器件中電流擴展、自熱效應和出光增強三方面的多物理場耦合關系,利用有限元方法建立了垂直結構UV LEDs器件中的多物理場模型,并在此基礎上設計了能實現更高光效的UV LEDs器件結構——分布式布拉格反射與小面積金屬接觸復合三維電極結構(專利號:CN 102820398A).通過計算分析表明,該器件結構能夠明顯改善電流分布,具有優良的散熱性能和較高的光提取效率.
1 計算方法和模型
分析半導體器件的核心物理方程[7]有:

其中,ψ為靜電勢函數,ε為介電常數,ρ為局域電荷密度.

其中,n(p)為電子(空穴)濃度,Jn(Jp)為電子(空穴)電流密度,Gn(Gp)和Rn(Rp)分別為電子(空穴)產生率與復合率.

其中,μn(μp)為電子(空穴)遷移率,φn(φp)為電子(空穴)的準費米能級電勢.

其中,ρL為材料密度,CL為材料比熱容,Jheat為熱流密度,Hheat為熱量密度.
根據材料性質選取合適的物理模型,依據器件結構設定合理的邊界條件,運用有限元的方法,將器件進行網格化,在每個格點上,聯立上述4個方程進行求解,原則上就能分析所有的器件物理問題.本文正是基于該方法對UV LEDs器件進行多物理場分析.
器件結構建模的關鍵在于選取恰當的物理模型,包括LEDs外延材料的能帶模型、遷移率模型、載流子復合模型、自熱效應模型等.本文計算所采用的能帶模型是Chuang等利用k·p算法建立的在應力場影響下的纖鋅礦半導體能帶結構模型[8-9].在遷移率模型中,Caughey等最先建立了Si材料中遷移率隨著摻雜濃度和溫度變化的解析關系[10].本文采用Farahmand等運用蒙特卡洛模擬方法對Caughey-Thomas模型進行了修正,使其適用于GaN基半導體材料[11].載流子復合模型包括有源區量子阱自發輻射復合模型、與缺陷有關的非輻射復合——Shockley-Read-Hall(SRH)復合及載流子濃度有關的非輻射復合——俄歇復合[12].而對于自熱效應模型則主要包括由于晶格散射產生的焦耳熱、非輻射復合熱等[13].
2 器件結構設計和分析
本文選取實驗中用MOVPE方法在c面藍寶石襯底上生長的UV LEDs外延結構:AlN復合基底生長于藍寶石襯底上,隨后依序為1.75μm厚的n-Al0.6Ga0.4N層、3個周期的多層量子阱結構(其阱層為5 nm厚的非摻雜Al0.35Ga0.65N、壘層為10nm厚的低摻雜n-Al0.56Ga0.44N)、1nm 的 p-Al0.8Ga0.2N 電子阻擋層、84nm 的 p-Al0.55Ga0.45N 層 以 及 20nm 的 p+-GaN作為p電極歐姆接觸層[14].由于藍寶石襯底本身絕緣,在計算時未考慮其具體厚度.首先采用有多物理場有限元方法對外延結構中有源區內載流子輻射復合率和電致發光譜(electroluminescence spectrum,EL)進行了計算.由于電子和空穴在各個量子阱區域的濃度分布不均勻導致各個量子阱的載流子輻射復合率不同,如圖1(a)所示,中間的量子阱(QW2),其空穴濃度高于靠近n型層的量子阱(QW3)而電子濃度又高于靠近p型層的量子阱(QW1),導致QW2中的載流子輻射復合率最高,發光最強.因此,本文選取QW2作為器件水平方向上載流子輻射復合率的分析區域,同時選取EL發光譜峰位波長296nm作為背反射鏡設計的參考波長.
由于紫外光對大多數半導體材料的吸收,使得大部分UV LEDs器件都采用倒裝結構和垂直結構.其中,垂直結構器件通過激光剝離藍寶石襯底,將n電極制作在剝離后的n型層上面作為出光面,同時在p電極一側鍍上金屬背反射鏡,可提高器件的光提取效率[15-16].此外,垂直結構的p和n型電極分別位于器件的兩邊,也減弱了臺面結構所帶來的電流擁堵問題,提高了器件電流注入的均勻性,降低了器件產生的熱量.然而,常規的垂直結構中,n型電極一般為塊狀電極,為了不影響器件出光,n電極的尺寸不能過大,再加上n型AlGaN層的電阻率相對較高,電子電流在n型層側向擴展十分有限,電流在n型電極兩側邊緣仍然出現擁堵問題.此外,雖然金屬Al在紫外波段具有很好的反射特性[17],可以作為UV LEDs背反射鏡的候選材料.但是,Al本身作為電極卻難以與p-GaN層形成歐姆接觸,若在p-GaN層和Al反射鏡之間再插入Ni/Au的p型歐姆接觸層,Ni/Au對紫外光的吸收將導致背反射鏡的反射率嚴重降低.針對上述問題,本文在傳統垂直結構器件基礎上,結合器件電流分布、溫度控制及出光增強三方面因素,設計了一種分布式布拉格反射與小面積金屬接觸復合三維電極結構,以實現更高光效的UV LEDs.該器件的具體結構如圖1(b)所示,n型條形陣列接觸電極位于n-Al0.6Ga0.4N 層的正上方從下至上依次為金屬 Ti/Al/Ti三層結構,厚度分別為20,200和5nm;由 HfO2/SiO2構成的多層介質分布式布拉格反射鏡(distributed braggs reflector,DBR)淀積在p-GaN 層表面;金屬Ni/Au構成的小面積陣列作為p型歐姆接觸電極,間隔分布在DBR結構之中,厚度均為20nm;金屬Al覆蓋在DBR和電極陣列的表面,使其既作為接觸電極陣列的互聯層又作為紫外光的金屬反射層.本文利用多物理場有限元方法對該器件結構從n型電極結構、反射基底結構與p型電極結構進一步進行了分析優化.
2.1 n型條形陣列電極結構設計和分析
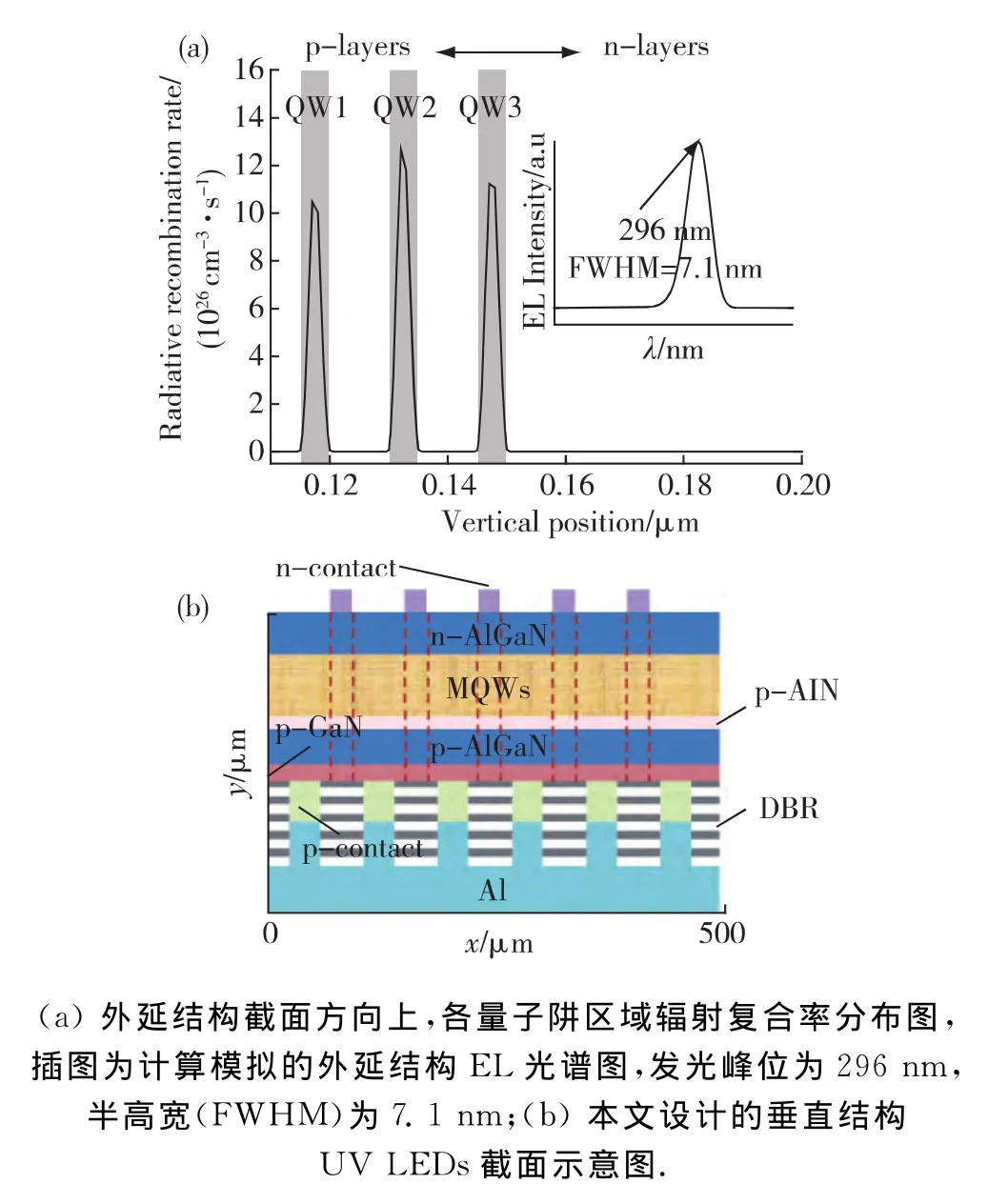
圖1 本文所采用的外延結構發光特性和器件結構Fig.1 The emission characteristics of epilayer structure and the profile of ultraviolet LEDs structure
對于可見光波段,我們設計了一種樹葉脈絡形電極,大幅度提高了大功率GaN基發光二極管電流注入的均勻性(專利號:200610092944.1).受此啟發,又設計了4種不同尺寸和間距的n型條形陣列電極.為了定量分析條形陣列電極對器件性能的改善,也對傳統塊狀n型電極的器件結構進行了計算,作為結構最為簡單的垂直結構LEDs,單個塊狀n型電極位于n型出光面的中心.芯片尺寸設計為500μm×500μm,2列條形電極寬度為25μm,間距150μm;5列條形電極寬度為10μm,間距為90μm;10列條形電極寬度為5 μm,間距40μm;25列條形電極寬度為2μm,間距18 μm.而塊狀電極的尺寸為50μm×50μm,所有n型電極金屬面積所占n型出光面的面積比例均為1%.5列條形電極的結構如圖2(a)插圖所示.
圖2(a)給出了4種條形電極與塊狀電極的電流-電壓(I-V)關系.從I-V 曲線斜率可看出,條形陣列電極能有效降低器件整體的串聯電阻.等間距的電極陣列縮短電流在n-AlGaN層側向傳播的距離,減少了n-AlGaN層水平方向的電阻對器件整體串聯電阻的影響,使得電子能夠更加均勻地注入到器件,改善了n型層出光面的電流分布.而不同尺寸的條形電極的IV曲線略有區別,條形數目越多、間距越小,其串聯電阻也越低,25列條形電極要比2列條形電極的結構略好.
由于器件載流子和聲子的相互作用,條狀陣列n型電極在改善器件的電流分布、提高電流注入效率的同時,也降低了器件的總體溫度.特別是在大電流注入時,4種電極設計的溫度差別愈為明顯,如圖2(b)所示.在100mA的注入電流下,塊狀n型電極器件的最高溫度達到了310K,2列條形電極n器件的最高溫度也達到了306.07K.而5列、10列和25列條形電極n器件的最高溫度只從室溫升高到303.46,303.24,303.50K.器件的主要兩大熱源焦耳熱和非輻射復合熱都與器件的電流密度密切相關,電流密度越高,所產生的熱量也就越多.可以看到,雖然采用了垂直結構,整個p型電極鍵合金屬基板提高了散熱水平,但器件溫度在大電流注入下仍然有所升高.因此,器件的溫度控制對于大電流注入下工作的UV LEDs的穩定性仍十分重要.

圖2 條形陣列和塊狀n電極結構UV LEDs電學與熱學特性關系Fig.2 The electrical and thermal characteristics of the strip and square n-contact UV LEDs
盡管條形陣列n電極能明顯改善器件的電流分布和自熱效應,然而隨著陣列數目的增加并不一定能提高器件整體的發光效率,即增加外量子效率.外量子效率是發射光子數和通過LEDs的電子束之比.明確地說,它是內量子效率、注入效率和光提取效率(light extraction efficiency,LEE)的乘積[18].因此外量子效率的提升是涉及器件多物理場綜合因素共同作用的結果.圖3(a)是在100mA注入電流下,不同n器件在有源區中間一層QW2內部載流子輻射復合率的截面分布情況.可以看出,隨著陣列數目的增多,平均每條陣列電極下方對應的有源區注入電子數目減少進而使得該有源區域產生的光子數目減少,塊狀n電極結構對應的輻射復合率的最高值為1.591×1026cm-3·s-1,而2列、5列、10列和25列條形n電極結構的輻射復合率最高值則分別為1.564×1026,1.547×1026,1.544×1026,1.545×1026cm-3·s-1.與此同時,由于電流的橫向擴展效應,條形陣列數目與間距的變化引起有源區內發光強度分布的不同.隨著電極陣列數目增多,間距減少,載流子輻射復合率分布起初會變得更為均勻,10列條形電極寬度為5μm,間距為40μm的結構器件載流子輻射復合率分布最為均勻.然而當25列電極結構寬度減少為2μm,其間距(18μm)遠小于器件的電流擴展長度時,相鄰電極間橫向電流的疊加效應,使得載流子輻射復合率分布相對于10列陣列起伏更大.通過對圖3(a)各曲線相對于x軸的積分面積可以判定出不同結構器件在100 mA電流注入下,在有源區內產生光子數目的相對大小.塊狀、2列、5列、10列和25列條形n電極結構對應的積分面積分別為7.256,7.714 6,7.711 7,7.705,7.707,塊狀電極結構的面積明顯小于陣列電極結構,5列結構的面積最大.由于器件的內量子效率僅與其外延結構相關,在內量子效率相同的情況下,有源區產生光子數越多,說明其具有更高的注入效率.因此5列n電極結構器件具有最高的注入效率.
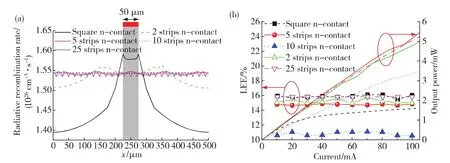
圖3 不同n型電極陣列間距d的LED器件的光電特性關系Fig.3 The typical electro-optical characteristics of LEDs with various n-contact spacing
另一方面,只有那些從器件表面提取出來的光子,才能轉化為器件的有效輸出功率.圖3(b)是采用光子追蹤法[19]結合多物理場有限元方法計算出塊狀n型電極和條形n型電極器件的LEE、輸出功率與注入電流的關系.盡管塊狀n電極器件LEE(最高達16.1%)要高于條形陣列器件的LEE(2列、5列、10列和25列最高的 LEE分別為15.7%,14.9%,11.1%和15.8%),然而條形陣列n電極能明顯改善器件的電流分布和自熱效應,綜合器件的注入效率與LEE,從整體的發光強度來看,仍然是條形陣列n電極器件要明顯高于塊狀n電極器件.特別是5列條形n電極器件平衡了電流分布、溫度控制和出光增強三者之間的關系,實現了相對最高的輸出功率,在100mA下達到5.45mW.因此,5列條形n電極是更適用于該器件的合理設計.
2.2 反射基底(全方位角反射鏡)的結構設計
在可見光波段,垂直結構LEDs常采用金屬Ag和Au作為背反射鏡材料,但這2種金屬材料在紫外波段都存在嚴重的吸收.金屬Al則在紫外波段具有很好的反射特性[17],可以作為UV LEDs背反射鏡的候選材料.然而,Al本身作為電極卻難以與p-GaN層形成歐姆接觸,若在p-GaN層和Al反射鏡之間再插入Ni/Au的p型歐姆接觸層,背反射鏡的反射率會由于Ni/Au對紫外光的吸收而嚴重降低.除金屬材料外,DBR結構由于沒有金屬反射鏡的吸收問題,又可以針對不同波長改變DBR材料的折射率或厚度來調整能隙位置,也可作為UV LEDs背反射鏡.然而,其反射率會隨著光入射角度和光的偏振性發生明顯變化.隨著入射角度的增加,高反截止波長會向短波長方向移動;而當入射角度達到布儒斯特角TM模(p偏振光)的反射率則會降至0,導致總反射率(TM模+TE模)/2,在布儒斯特角附近明顯降低.為了解決這一矛盾,我們設計了多層介質膜+金屬復合結構的全方位角反射鏡,在確保形成p型歐姆接觸的同時提高器件的光提取效率.其中背反射鏡材料選用Al,選取HfO2和SiO2分別作為紫外波段的高、低折射率材料[20].同時,利用傳輸矩陣方法[17]分別計算分析具有不同周期數N的反射鏡對波長296nm TE模和TM模光的角反射率.
圖4(a)為垂直入射光的反射譜,隨著N的增加反射率峰值逐步增加,當N=3時,在296nm波長的反射率達到98.56%.隨著入射光角度變化,TE模式光的反射率在25°~45°之間會出現振蕩,如圖4(b)所示,且振蕩角度范圍隨著N增加而增大,N=3時,振蕩角度范圍是27.2°~41.4°,但整體振蕩的幅度并不高,所有入射角度的反射率都高于88%;若角度進一步增加則會在GaN/介質界面出現全反射.而對于TM模式光,由于引入了介質DBR,造成不同周期數下均出現了反射率的極低值,當N=2時,反射率的極低值最高(71.3%),而N=3時,反射率的極低值為61.6%,如圖4(c)所示.盡管N=2時的TM 模反射率的極低值要高于N=3的情況,但比較0°~90°整個入射角范圍的平均反射率(圖4(d))可以發現,隨著N的增加,TE模的平均反射率基本不變,而TM模的平均反射率明顯增大,當N由0(只有Al金屬層作為背反射鏡)增加至3(加入3個周期的DBR結構)時,TM模的平均反射率由87%增加至95%.由此可見,多層介質膜+金屬復合結構的全方位角反射鏡能更有效地提高UV LEDs的LEE.理論上DBR周期數N 越多,全方位角反射鏡的平均反射率會越大,然而周期數越多則會由于介質層的絕緣性和高熱阻性,影響器件的電流分布和溫度控制.因此,在本文中,選取中心波長為296nm,周期數N=3的DBR結構,每層介質膜的光學厚度為中心波長1/4,HfO2和SiO2的厚度分別為38.1和50.4nm.
2.3 p型陣列電極的設計和優化
盡管條形n電極能夠改善垂直結構器件的電流分布,然而在n電極下方的電流密度仍不可避免的會高于其他區域,使正對電極下方的有源層區域產生的光子數目最多.但由于金屬電極本身對光子的吸收,電極下方的光子不能有效地出射出器件表面,降低器件的光電轉換效率.通常在n型電極正下方制備不導電的電流阻擋層(current-blocking layer,CBL),能夠阻擋電流在電極下方的輸運,使更多的電流注入到那些光子更易于出射出器件表面無電極遮擋的區域[18].巧妙的是,由前文所述在靠近p電極上方的全方位角反射鏡結構中恰好存在不導電的DBR結構.可以設想,若能合理設計DBR結構在p型外延層的分布位置,便能使DBR結構既作為背反射鏡又可作為電流阻擋層,使其在出光增強和電流分布兩個物理場領域同時發揮作用.由于DBR介質層本身的導熱性較低,p型外延層與DBR相接觸的區域無法作為有效的熱量輸運通道,DBR區域面積過大必定會影響器件的散射水平;若DBR區域面積過小,又無法起到良好的電流阻擋作用.為尋找到較為合適的DBR面積,我們設計了每個像素直徑為10μm,橫向間距d分別為10,40和100μm的圓形金屬陣列電極(如圖5(a)插圖所示),并模擬分析其器件結構光電熱特性.金屬陣列電極的總面積占據器件總面積的比例分別為9.67%,4.02%和1.63%.
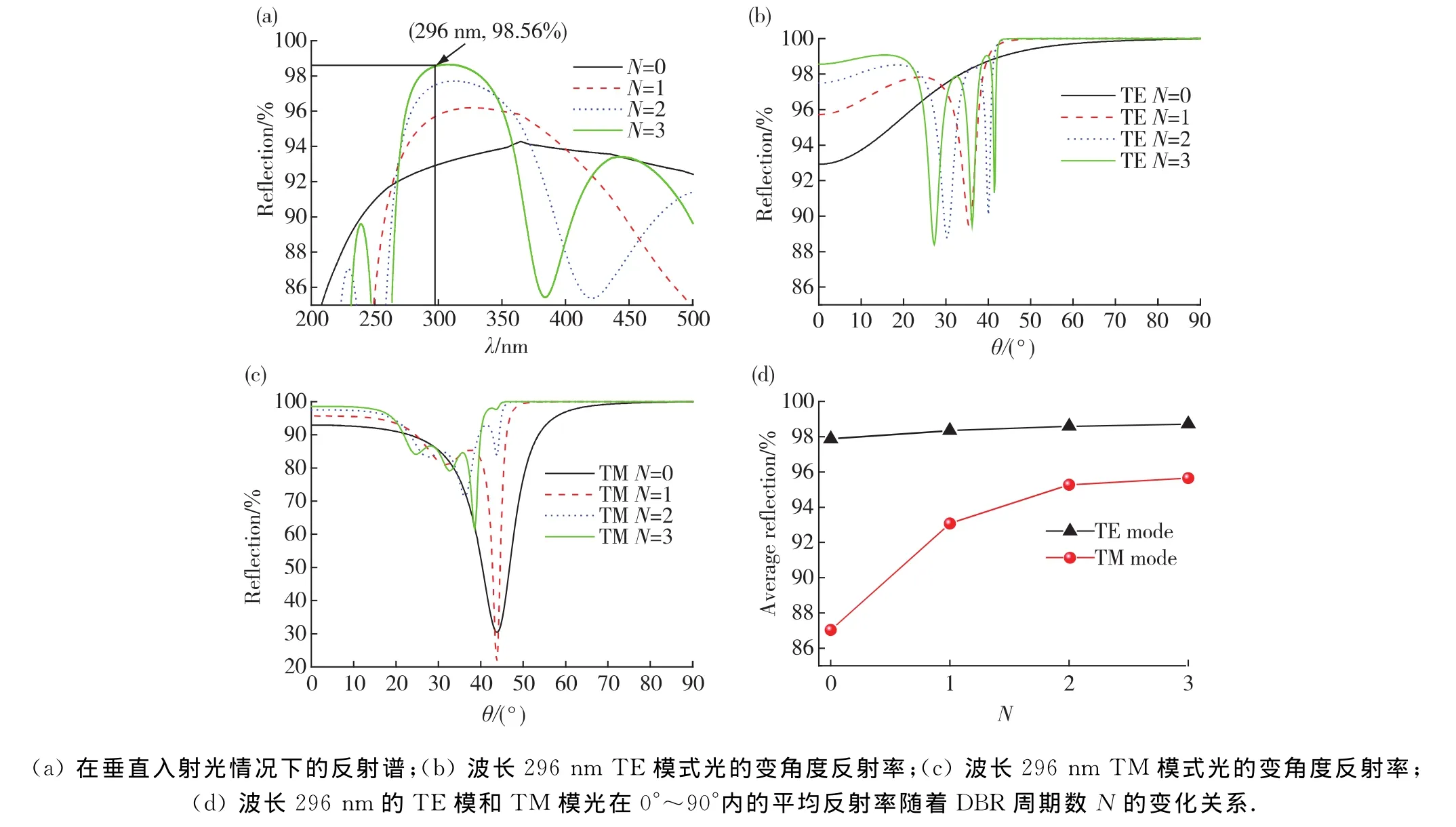
圖4 不同周期數N下全方位角反射鏡反射譜特性關系Fig.4 The reflective characteristics of omnidirectional reflector with different periodicity
從圖5(a)器件的I-V曲線斜率可看出,由于引入不導電介質層,增加了器件串聯電阻,陣列間距d越大,電流橫向擴展能力越弱.當p型陣列電極間距小于器件的電流擴展長度Ls時,如d=10μm時,p-GaN層能夠實現比較均勻的電流分布和注入,100mA注入電流下的正向電壓為14.5V.而間距d=100μm的器件結構在100mA注入電流下的正向電壓增加到15.8V.與此同時,引入DBR層也會降低器件的散熱水平,陣列電極不僅傳輸載流子,也是器件熱量的輸運通道,電極間距d增加使得在單位面積上的電極數目減少,熱量傳輸通道數目減少則會造成器件整體溫度的升高.如圖5(b)所示,d=100μm時,整個器件僅有4×13個陣列電極作為散熱通道,其器件最高溫度在注入相同電流下要明顯高于其他2種結構.進一步分析QW2水平方向上的載流子輻射復合率(圖5(c)所示),在100mA注入電流下,當d=100μm時,載流子輻射復合率最低值(0.436×1026cm-3·s-1)出現在n電極對應的正下方量子阱區域,最高值(2.646×1026cm-3·s-1)則出現在p電極對應的正下方量子阱區域,發光最強與最弱比值近6.06倍.當間距d為40和10μm時,發光最強與最弱比值則分別1.53倍和1.06倍.上述分析表明電極間距越小,器件電流和發光分布更為均勻,散熱能力更強,具有更高的注入效率,即d=10μm的結構器件注入效率最高.

圖5 不同p型電極陣列間距d的LED器件的光電特性關系Fig.5 The typical electro-optical characteristics of LEDs with various p-contact spacing
另一方面,采用介質DBR+金屬復合反射鏡后,降低了光子在器件底部的吸收和透射,同時介質DBR作為CBL,增強了光子在n電極表面出射幾率,提高了器件的LEE.陣列電極間距d越大,即復合反射鏡所占面積比例越高,LEE越高.如圖5(d)所示,d=100μm器件結構LEE最高能夠達到37.8%,相比于d=40和10μm器件結構LEE分別為36.4%和29.7%.結合圖5(a)、(b)可看出,該結構器件的電流分布、溫度控制與出光增強之間存在相互競爭關系,只專注單一物理場方面的改善,并不能有效提高器件整體的發光效率,需要在各物理場性能之間進行平衡.從圖5(d)器件整體輸出功率來看,電極間距d=40μm的器件結構能夠較好地平衡各物理場之間關系,實現最佳的光電轉換效率.在20和100mA注入電流下,其發光功率分別可達2.74和12.3mW,分別比d=0時提高了124%和127%,比傳統垂直結構UV LEDs的提高了204%和664%.由此說明,我們所設計的新型UV LEDs器件結構——分布式布拉格反射與小面積金屬接觸復合三維電極結構,可有效地改善器件的散熱性能、注入效率和LEE,最終提高器件的光電轉換效率.
3 結 論
本文在全面考慮器件的電流分布、自熱效應及出光增強這3種物理場之間耦合關系的基礎上,設計了一種新型的UV LEDs器件結構——分布式布拉格反射與小面積金屬接觸復合三維電極結構.該垂直結構器件的特征在于n型電極為寬度10μm、間隔90μm的條形金屬陣列;p型則采用直徑Φ為10μm、間隔為40μm的圓形金屬陣列;在p型陣列電極之間填充有全方位角反射鏡,該反射鏡是由3個周期的HfO2/SiO2DBR介質層和1層金屬Al層所構成.通過計算分析表明,該器件結構具有優良的散熱性能,較高的注入效率和LEE.在20和100mA注入電流下,其發光功率分別可達2.74和12.3mW,分別比傳統的垂直結構UV LEDs提高了204%和664%.
[1]Nishida T,Saito H,Kobayashi N.Efficient and high-power AlGaN-based ultraviolet light-emitting diode grown on bulk GaN[J].Applied Physics Letters,2001,79(6):711.
[2]Taniyasu Y,Kasu M,Makimoto T.Aluminum nitride deep-ultraviolet lightemitting diodes[J].NTT Technical Review,2006,4(12):54-58.
[3]Nishida T,Saito H,Kobayashi N.Milliwatt operation of AlGaN-based single-quantum-well light emitting diode in the ultraviolet region[J].Applied Physics Letters,2001,78(25):3927.
[4]Würtele M A,Kolbe T,Lipsz M,et al.Application of GaN-based ultraviolet-C light emitting diodes—UV LEDs—for water disinfection[J].Water Research,2011,45(3):1481-1489.
[5]Dobrinsky AShatalov MGaska R,et al.Physics of visible and UV LED devices[C]∥Lester Eastman Conference on High Performance Devices (LEC).New York:IEEE,2012:1-4.
[6]Shur M S,Gaska R.Deep-ultraviolet light-emitting diodes[J].Electron Devices,IEEE Transactions on,2010,57(1):12-25.
[7]Piprek J.Semiconductor optoelectronic devices:introduction to physics and simulation[M].UCSB:Academic Press,2003.
[8]Chuang S L,Chang C S.A band-structure model of strained quantum-well wurtzite semiconductors[J].Semiconductor Science and Technology,1997,12(3):252.
[9]Chuang S L,Chang C S.k·p method for strained wurtzite semiconductors[J].Physical Review B,1996,54(4):2491-2504.
[10]Shapiro S D.Carrier mobilities m silicon empirically related to doping and field[J].Proceedings of the IEEE,1967,55(12):2192-2193.
[11]Farahmand M,Garetto C,Bellotti E,et al.Monte Carlo simulation of electron transport in the III-nitride wurtzite phase materials system:binaries and ternaries[J].E-lectron Devices,IEEE Transactions on,2001,48(3):535-542.
[12]Yoshida H,Kuwabara M,Yamashita Y,et al.Radiative and nonradiative recombination in an ultraviolet GaN/AlGaN multiple-quantum-well laser diode[J].Applied Physics Letters,2010,96(21):211122.
[13]Ahmad I,Kasisomayajula V,Holtz M,et al.Self-heating study of an AlGaN/GaN-based heterostructure fieldeffect transistor using ultraviolet micro-Raman scattering[J].Applied Physics Letters,2005,86(17):173503.
[14]Gao N,Lin W,Chen X,et al.Quantum state engineering with ultra-short-period(AlN)m/(GaN)n superlattices for narrowband deep-ultraviolet detection[J].Nanoscale,2014,6(24):14733.
[15]Kelly M,Ambacher O,Dimitrov R,et al.Optical process for liftoff of group III-nitride films[J].Physica Status Solidi:A,1997,159(1):R3-R4.
[16]Wong W S,Sands T,Cheung N W.Damage-free separation of GaN thin films from sapphire substrates[J].Applied Physics Letters,1998,72(5):599.
[17]唐晉發,顧培夫,劉旭.現代光學薄膜技術[M].杭州:浙江大學出版社,2006:234.
[18]Schubert E F,Gessmann T,Kim J K.Light emitting diodes[M].Hoboken:Wiley Online Library,2005:86.
[19]Hu F,Qian K Y,Luo Y.Far-field pattern simulation of flip-chip bonded power light-emitting diodes by a Monte Carlo photon-tracing method[J].Applied Optics,2005,44(14):2768-2771.
[20]鄧文淵,李春,金春水.電子束蒸發和離子束濺射 HfO2[J].中國光學與應用光學,2010,3(6):630-636.

