四方結(jié)構(gòu)GaN 納米線制備、摻雜調(diào)控及其場(chǎng)發(fā)射性能研究*
楊孟騏 姬宇航 梁琦 王長(zhǎng)昊 張躍飛張銘 王波 王如志?
1) (北京工業(yè)大學(xué)材料科學(xué)與工程學(xué)院,新型功能材料教育部重點(diǎn)實(shí)驗(yàn)室,北京 100124)
2) (北京航空航天大學(xué)物理學(xué)院,北京 100191)
3) (北京工業(yè)大學(xué)固體微結(jié)構(gòu)與性能研究,固體微結(jié)構(gòu)與性能北京市重點(diǎn)實(shí)驗(yàn)室,北京 100124)
1 引 言
GaN 是第三代寬禁帶半導(dǎo)體典型代表, 具有電子遷移率高, 擊穿電壓高, 抗腐蝕性能強(qiáng)等優(yōu)點(diǎn),其納米線材料兼具小尺寸效應(yīng)以及量子效應(yīng)等優(yōu)勢(shì), 在微型電子元器件領(lǐng)域有巨大應(yīng)用前景[1?4].隨著人們對(duì)于半導(dǎo)體器件性能要求的不斷提升, 通過(guò)對(duì)GaN 納米線進(jìn)行摻雜改性及形貌調(diào)控來(lái)滿足不同工作環(huán)境的需求成為當(dāng)下研究熱點(diǎn)之一.
目前主要采用化學(xué)氣相沉積(chemical vapor deposition, CVD)法[5,6]、金屬有機(jī)物化合物化學(xué)氣相沉積(metallic organic compounds chemical vapor deposition, MOCVD)法[7,8]以及分子束外延(molecular beam epitaxy, MBE)法[9,10]制備GaN 納米線[11]. CVD 法制備GaN 納米線多采用NH3作為N 源, 對(duì)設(shè)備有一定的腐蝕性, 尾氣處理不當(dāng)會(huì)對(duì)環(huán)境造成損害. MOCVD 和MBE 兩種方式生長(zhǎng)條件可控性高、樣品純度及形貌較好, 但其工藝較為復(fù)雜, 制備成本較高. 近年來(lái), 我們發(fā)展了一種基于等離子體增強(qiáng)化學(xué)氣相沉積(plasma enhance chemical vapor deposition, PECVD)的無(wú)氨法制備GaN 納米線[12?14]工藝, 采用N2取代NH3作為N 源, 降低NH3對(duì)設(shè)備的損傷, 簡(jiǎn)化納米線制備流程, 有效降低其制備成本. GaN 晶體結(jié)構(gòu)屬于六方晶系[15], 所以目前制備的GaN 納米線形貌多為三方結(jié)構(gòu)以及六方結(jié)構(gòu)[13,16], 四方結(jié)構(gòu)納米線較難制備. 納米線形貌可以通過(guò)控制反應(yīng)體系中的襯底種類[17], 催化劑[18,19], 氣體環(huán)境[13]等方式進(jìn)行調(diào)控. Schoo 等[6]通過(guò)調(diào)節(jié)GaN 納米線升溫速度以及N 源濃度, 調(diào)控GaN 納米線形核過(guò)程,使之生長(zhǎng)為特殊形貌, 進(jìn)而得到三方結(jié)構(gòu)、六方結(jié)構(gòu)以及四方結(jié)構(gòu)的GaN 納米線. 由于四方結(jié)構(gòu)GaN 納米線制備難度較大, 缺乏實(shí)驗(yàn)制備基礎(chǔ), 故當(dāng)前主要采用第一性原理計(jì)算對(duì)其性能進(jìn)行研究.Srivastav 等[20]通過(guò)對(duì)比生長(zhǎng)方向?yàn)閇 100 ]的三方結(jié)構(gòu)GaN 納米線與長(zhǎng)方向?yàn)閇 120 ]的四方結(jié)構(gòu)GaN 納米線單原子結(jié)合能, 發(fā)現(xiàn)四方結(jié)構(gòu)GaN 納米線相較三方結(jié)構(gòu)更穩(wěn)定. 延[ 100 ]方向生長(zhǎng)的四方GaN 納米線有更強(qiáng)的金屬性能, 可以應(yīng)用于納米電子器件的連接領(lǐng)域[21]. 本課題組長(zhǎng)期致力于研究GaN 納米材料結(jié)構(gòu)調(diào)控及其對(duì)于場(chǎng)發(fā)射性能的影響: Wang 等[22]采用無(wú)氨法制備出了GaN 納米線并測(cè)試其場(chǎng)發(fā)射性能, 納米線開(kāi)啟電場(chǎng) 最 低可達(dá)0.86 V/μm,納 米 線表 面 吸附的O 有效降低了功函數(shù), 在電場(chǎng)強(qiáng)度過(guò)高情況下, 過(guò)大的焦耳熱會(huì)損壞GaN 納米線結(jié)構(gòu), 降低其場(chǎng)發(fā)射性能. Feng 等[14]采用無(wú)催化劑方法制備出層狀金字塔結(jié)構(gòu)的GaN 納米線, 其場(chǎng)發(fā)射開(kāi)啟電場(chǎng)最低可達(dá)4.8 V/μm, 優(yōu)異的場(chǎng)發(fā)射性能歸因于金字塔結(jié)構(gòu)的高比表面積. 通過(guò)對(duì)GaN 納米線進(jìn)行摻雜, 可以有效提高其電學(xué)性能[23,24]. Mg 原子有著與Ga 原子相近的原子半徑且有較低的形成能, 易于取代Ga 原子進(jìn)入GaN 晶格[25], 并且Mg 摻雜激活能較低[26], 可以大幅提升GaN 材料的空穴濃度, 因此Mg 是最適宜制備p 型GaN 材料的元素.然而在制備過(guò)程中仍存在H 鈍化[27,28]以及Mg 自補(bǔ)償效應(yīng)[29?31]等限制因素, 因此探索高質(zhì)量Mg 摻雜GaN 納米線的制備方法一直是半導(dǎo)體發(fā)展的重要研究方向之一. 在此研究基礎(chǔ)上, 我們采用碳粉還原Ga2O3粉末和MgO 粉末作為Ga 源和Mg 源, 采用微波激發(fā)N2形成的N 等離子體作為N 源, 以綠色低成本的手段制備Mg 摻雜GaN納米線, 通過(guò)調(diào)節(jié)Mg 摻雜比例實(shí)現(xiàn)納米線三方-四方截面結(jié)構(gòu)的轉(zhuǎn)變, 也是首次采用摻雜手段制備出四方結(jié)構(gòu)GaN 納米線. 通過(guò)測(cè)試Mg 摻雜四方結(jié)構(gòu)GaN 納米線的光致發(fā)光性能及場(chǎng)發(fā)射性能,研究了摻雜以及形貌調(diào)控對(duì)于納米線帶隙結(jié)構(gòu)及場(chǎng)發(fā)射性能的影響.
2 實(shí) 驗(yàn)
按一定物質(zhì)的量比例充分混合研磨碳粉(99.99%)、Ga2O3粉末(Alfa, 99.99%)和MgO 粉末(Alfa, 99.99%)作為前驅(qū)粉體, 稱取0.3 g 前驅(qū)粉體置于石墨坩堝內(nèi), 將預(yù)先制備的濺射Au 催化劑的Si(100)襯底放置在石墨坩堝的正上方, 襯底距離前驅(qū)粉體約為5 mm. 然后把石墨坩堝轉(zhuǎn)移到MPCVD 的加熱臺(tái)的中心, 將一枚上方開(kāi)口石英罩扣置在石墨坩堝上方, 通入13 標(biāo)準(zhǔn)立方厘米/分鐘(sccm)的N2(99.99%), 腔體壓力保持10 Torr(1 Torr = 133.322 Pa), 調(diào)節(jié)加熱臺(tái)20 min 升溫至870 ℃, 微波功率為300 W, 反應(yīng)一定時(shí)間后,關(guān)閉微波功率電源, 停止通入N2并冷卻至室溫,襯底表面黃色物質(zhì)即為所需樣品.
使用Hitachi S4800 型號(hào)場(chǎng)發(fā)射掃描電子顯微鏡(field emission scanning electron microscope,FESEM)對(duì)樣品形貌進(jìn)行分析; 使用BRUKER D8 ADVANCE 型 號(hào) X 射 線 衍 射 儀 (X-ray diffractometer, XRD)對(duì)樣品結(jié)晶質(zhì)量及純度進(jìn)行分析; 使用ESCALAB 250 Xi 型號(hào)X 射線光電子能譜(X-ray photoelectron spectroscopy, XPS)對(duì)樣品元素組成進(jìn)行分析; 使用透射電鏡對(duì)樣品微觀形貌及原子排布進(jìn)行分析; 最后對(duì)樣品進(jìn)行PL 性能測(cè)試及場(chǎng)發(fā)射性能測(cè)試.
3 結(jié)果與討論
3.1 Mg 摻雜調(diào)控GaN 納米線結(jié)構(gòu)
為了探究Mg 摻雜對(duì)于GaN 納米線生長(zhǎng)的影響, 將不同摩爾配比的原料在瑪瑙研體中充分研磨30 min 制備成為前驅(qū)粉體, 具體參數(shù)如表1 所示.
圖1 為不同原料配比制備Mg 摻雜GaN 納米線的FESEM 圖. 如圖1(a) 所示, 前驅(qū)粉體中沒(méi)有引入MgO 所制備的樣品A-a 直徑約為60—100 nm,長(zhǎng)度10—20 μm, 形貌為細(xì)長(zhǎng)的三角錐狀納米線,納米線表面光滑且沒(méi)有彎曲扭著現(xiàn)象. 納米線頂端未觀察到催化液滴, 是由于腔體內(nèi)高能N 等離子刻蝕催化劑液滴, 使其逐漸消失[32]. 如圖1(b) 所示, 引入少量Mg 摻雜的樣品A-b 相較于樣品A-a直徑增長(zhǎng)為200—250 nm, 納米線形貌大多為三方金字塔結(jié)構(gòu), 少部分為四方結(jié)構(gòu)納米線. 隨著MgO 的投入比例增加, 納米線直徑增大, 樣品中三方結(jié)構(gòu)納米線比例逐漸降低而四方結(jié)構(gòu)納米線比例逐漸上升, 推測(cè)其形貌轉(zhuǎn)變與Mg 元素?fù)诫s有關(guān). Lymperakis 等[33]采用密度泛函理論計(jì)算得出非極性GaN 表面對(duì)于N 原子吸附不穩(wěn)定, 使得GaN 在生長(zhǎng)過(guò)程中在趨于向極性生長(zhǎng), 生長(zhǎng)過(guò)程中沉積在襯底及納米線側(cè)壁的Ga 原子和N 原子延納米線軸向進(jìn)行遷移至頂部. 而Mg 摻雜對(duì)N 原子起到穩(wěn)定作用, 降低了GaN 納米線生長(zhǎng)的各向異性[34], 使得其徑向生長(zhǎng)速度上升, 對(duì)納米線側(cè)壁生長(zhǎng)產(chǎn)生促進(jìn)作用. Mg 摻雜同時(shí)降低GaN 中Ga 原子的結(jié)合能, 使其在Mg 摻雜表面更容易附著[30,35], 因此納米線側(cè)壁變厚并改變其截面形貌. 如圖1(c) 所示, 樣品A-c 形貌均勻一致且生長(zhǎng)筆直, 納米線延孿晶界非對(duì)稱生長(zhǎng), 孿晶界一側(cè)為三棱柱狀結(jié)構(gòu), 另一側(cè)延孿晶界面向上呈三角形階梯狀結(jié)構(gòu), 納米線側(cè)壁有鋸齒狀邊緣, 直徑為300—400 nm. 如圖1(d) 所示, 樣品A-d 直徑為350—400 nm, 長(zhǎng)度10—20 μm, 截面形貌為四方形結(jié)構(gòu), 側(cè)壁有較多鋸齒狀溝槽; 如圖1(e) 所示,樣品A-e 直徑為400—450 nm, 長(zhǎng)度10—20 μm,其形貌呈現(xiàn)四方形堆疊結(jié)構(gòu), 側(cè)壁鋸齒結(jié)構(gòu)較為均勻, 頂端為四方形金字塔結(jié)構(gòu), 納米線保持筆直生長(zhǎng).

圖1 不同原料配比制備Mg 摻雜GaN 納米線的FESEM 圖 (a)樣品A-a; (b)樣品A-b; (c)樣品A-c; (d)樣品A-d; (e)樣品A-eFig. 1. FESEM images Mg doped GaN nanowires prepared at different source materials ratio. (a) Sample A-a; (b) sample A-b;(c) sample A-c; (d) sample A-d; (e) sample A-e.
表2 為不同生長(zhǎng)時(shí)間制備Mg 摻雜GaN 納米線的實(shí)驗(yàn)參數(shù), 進(jìn)一步探究Mg 摻雜GaN 納米線的形核和生長(zhǎng)過(guò)程.
圖2 是不同生長(zhǎng)時(shí)間制備Mg 摻雜GaN 納米線的FESEM 圖. 如圖2(a) 所示, 樣品B-a 直徑為30—50 nm, 生長(zhǎng)較為稀疏, 納米線頂端存在球形催化劑液滴, 這是由于N 等離子體刻蝕時(shí)間較短, 催化劑液滴未被完全刻蝕, 同時(shí)也表明在納米線的形核階段為氣-液-固(VLS)生長(zhǎng)機(jī)制[36]. 如圖2(b) 所示, 樣品B-b 尖端幾乎觀查不到球狀A(yù)u 催化液滴, 這說(shuō)明Au 被等離子體完全刻蝕. 納米線呈現(xiàn)錐形生長(zhǎng), 其截面形貌大多為四方形, 并存在較少部分三方截面. 如圖2(c)(d)所示, 樣品B-c 和樣品B-d 形貌均勻, 納米線截面形貌為四方形, 長(zhǎng)度為20—25 μm, 直徑為450—500 nm. 反應(yīng)體系中N 等離子體對(duì)納米線存在一定的刻蝕作用[37], 表現(xiàn)為納米線側(cè)壁產(chǎn)生凹槽結(jié)構(gòu)[38]. 納米線頂端形貌由三角錐形結(jié)構(gòu)轉(zhuǎn)變?yōu)樗姆浇鹱炙Y(jié)構(gòu),是在Au 催化液滴被刻蝕消失的情況下, Mg 摻雜誘導(dǎo)GaN 納米線側(cè)壁生長(zhǎng)速度上升, 納米線進(jìn)行自催化生長(zhǎng), 金字塔結(jié)構(gòu)可以有效釋放納米線生長(zhǎng)過(guò)程中產(chǎn)生的殘余應(yīng)力[39], 故納米線頂端形貌自發(fā)向金字塔形貌轉(zhuǎn)變.

表2 不同生長(zhǎng)時(shí)間制備Mg 摻雜GaN 納米線的實(shí)驗(yàn)參數(shù)Table 2. The experimental parameter of preparing Mg doped GaN nanowiresat different growth time.
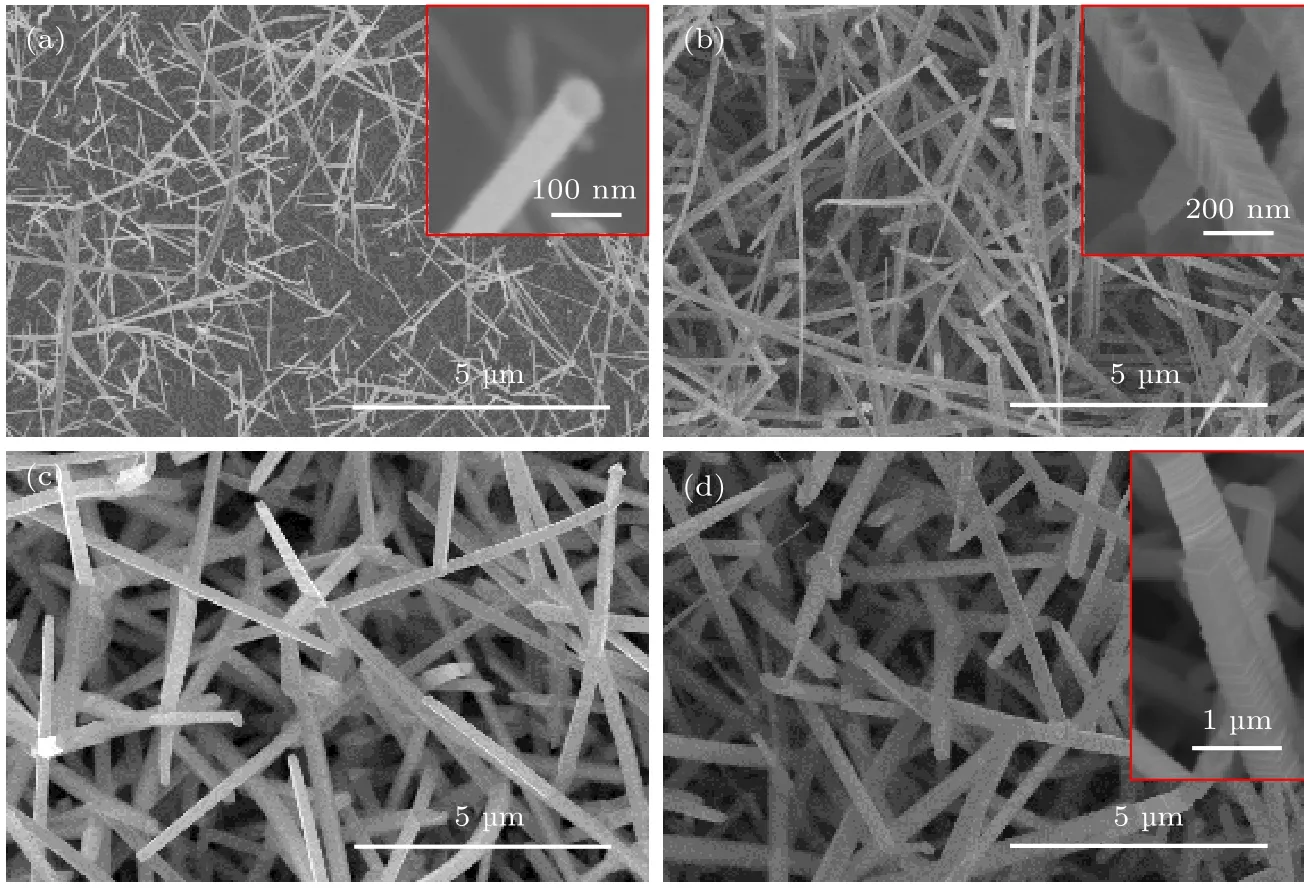
圖2 不同生長(zhǎng)時(shí)間制備Mg 摻雜GaN 納米線的FESEM 圖 (a)樣品B-a; (b)樣品B-b; (c)樣品B-c; (d)樣品B-dFig. 2. FESEM images Mg doped GaN nanowires prepared at different growth times. (a) Sample B-a; (b) sample B-b; (c) sample Bc; (d) sample B-d.
圖3 為樣品A-e 的XRD 圖譜. 從圖中可以明顯觀察到三個(gè)強(qiáng)度高且尖銳的衍射峰, 其2q角度分別為32.3°, 34.5°和36.8°, 對(duì)應(yīng)于六方纖鋅礦結(jié)構(gòu)GaN 納米線的(100), (002)和(101)晶面(JCPDS 50-0792). 圖譜中沒(méi)有觀察到Ga2O3或MgO 的峰值, 表明納米線純度較高, 并且衍射峰半峰寬度較小, 表明納米線具有良好的結(jié)晶性. 在此XRD 圖譜中未能觀察到Mg 元素對(duì)應(yīng)的特征峰,其原因是Mg 元素?fù)诫s含量較低且其特征峰對(duì)應(yīng)衍射角度與GaN 的(101)晶面對(duì)應(yīng)衍射角度接近[40,41]. 同時(shí)在XRD 的圖譜中也未觀察到Au 催化劑對(duì)應(yīng)的特征峰, 表明經(jīng)過(guò)30 min 高能量的N 等離子體不斷轟擊, 襯底及納米線頂端的Au 催化液滴被持續(xù)剝離, 最終被完全被刻蝕. 樣品 A-e的 XPS 圖譜如圖4 所示.
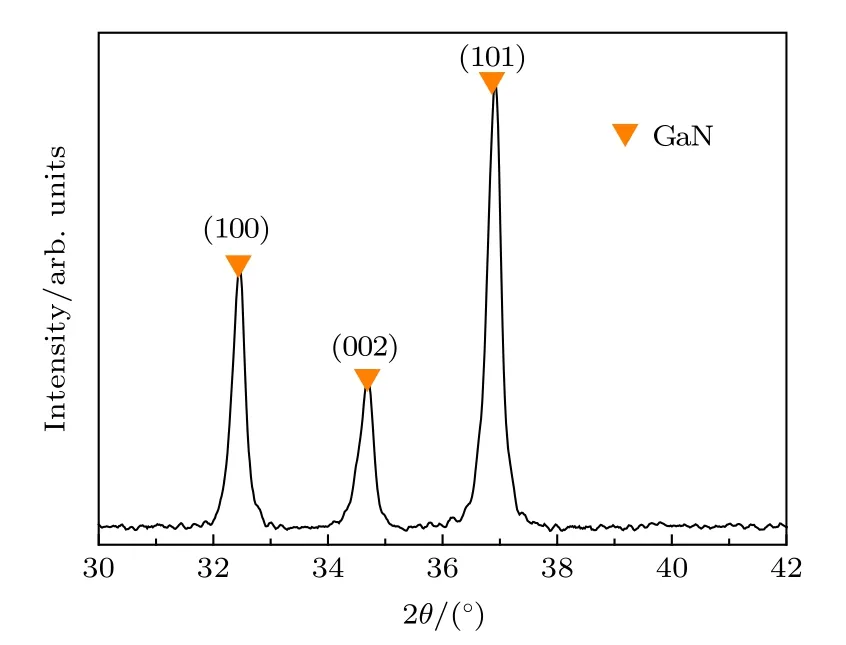
圖3 樣品A-e 的XRD 圖譜Fig. 3. XRD spectra of sample A-e.
由圖5(a) 可知, TEM 圖譜表明樣品A-e 沿軸向垂直生長(zhǎng), 直徑約為400 nm. 由圖5(b)可知, 高分辨透射電子顯微鏡(high resolution transmission electron microscope, HRTEM)圖像表面納米線原子排布整齊, 由于Mg 原子半徑為0.65 ?, 與原子半徑為0.62 ?的Ga 原子十分接近, 在摻雜過(guò)程中Mg 原子發(fā)生取代摻雜, 對(duì)晶格結(jié)構(gòu)影響較小[25].垂直軸向方向原子層間距為0.258 nm, 近似于GaN 的(002)方向晶面間距. 由選區(qū)電子衍射(selected area electron diffraction, SAED)圖 可知, 納米線衍射光斑清晰整齊, 納米線生長(zhǎng)方向?yàn)閇 010], 其[ 011 ] 晶向與[0002]晶向夾角為61.4°,表明納米線為結(jié)晶性良好的六方GaN 結(jié)構(gòu).
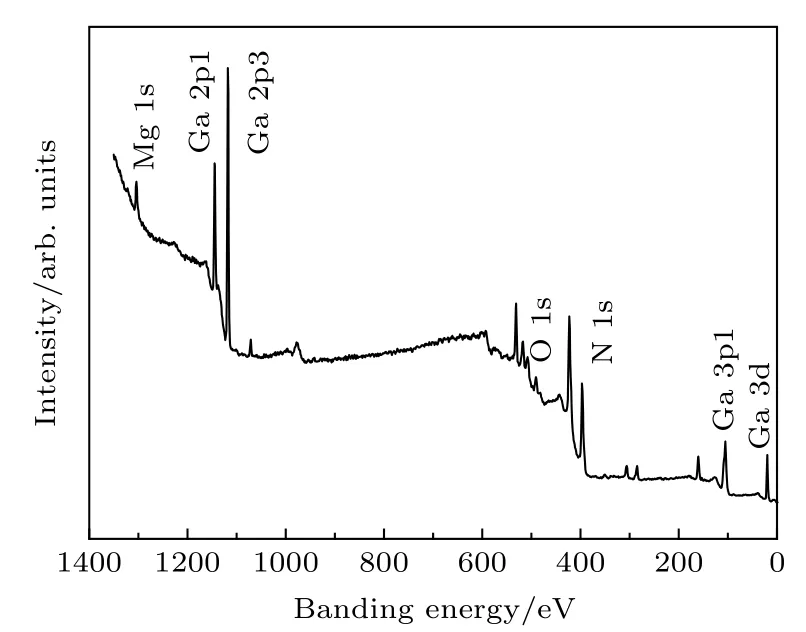
圖4 樣品A-e 的XPS 圖譜Fig. 4. XPS spectra of sample A-e.
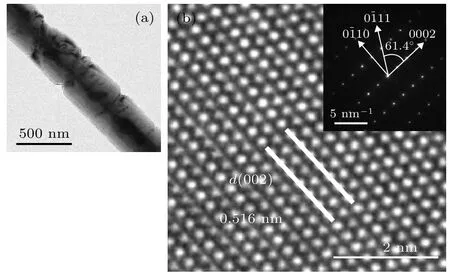
圖5 樣品A-e 的(a) TEM 圖; (b) HRTEM 圖插 圖為樣品A-e 的SAED 圖Fig. 5. (a) TEM image; (b) HRTEM image and SAED pattern (inset) of sample A-e.
3.2 四方結(jié)構(gòu)Mg 摻雜GaN 納米線生長(zhǎng)機(jī)制
通過(guò)分析不同生長(zhǎng)時(shí)間制備樣品的FESEM圖(圖2)可知, Mg 摻雜納米線的形核過(guò)程是遵循VLS 生長(zhǎng)機(jī)制, 由Au 形成的催化液滴參與納米線形核以及一定時(shí)間的生長(zhǎng)過(guò)程. 當(dāng)Au 催化液滴被N 等離子體完全刻蝕, 納米線VLS 生長(zhǎng)過(guò)程結(jié)束.隨反應(yīng)時(shí)間延長(zhǎng), 納米線直徑增大, 表明在沒(méi)有催化劑的條件下Mg 摻雜GaN 納米線可以進(jìn)行自催化氣-固(VS)生長(zhǎng). 通過(guò)分析不同投料比例制備樣品的FESEM 圖(圖1)可知, 沒(méi)有引入Mg 摻雜的GaN 納米線為纖細(xì)的三角錐型形貌, 而隨著前驅(qū)粉體中MgO 投入比例的增加, 納米線截面形貌由三方轉(zhuǎn)變?yōu)樗姆浇Y(jié)構(gòu), 且直徑也增長(zhǎng)了近10 倍左右, 表明納米線自催化VS 生長(zhǎng)能否實(shí)現(xiàn)與Mg 摻雜含量有關(guān), 只有在引入Mg 摻雜的體系中, GaN納米線才會(huì)出現(xiàn)自催化VS 生長(zhǎng). 進(jìn)而我們提出四方結(jié)構(gòu)GaN 納米線的成核和生長(zhǎng)機(jī)制的模型, 其示意圖見(jiàn)圖6. 成核和生長(zhǎng)機(jī)制詳細(xì)分為如下步驟.
1) 在Si 襯底表面的Au 薄膜在加熱過(guò)程中由于熱膨脹系數(shù)差異較大, 裂解為Au 催化液滴, 分散在襯底表面.
2) 前驅(qū)粉體受熱還原出Ga 原子和Mg 原子,與N 等離子體一同被Au 催化液滴吸收, 當(dāng)Au 催化液滴內(nèi)溶解度達(dá)到飽和, 在小液滴與襯底接觸位置析出為纖細(xì)的三方納米線. 與此同時(shí)高能量的N 等離子體轟擊Au 液滴, 使Au 液滴體積逐漸減少.
3) 隨著Au 催化液滴體積下降, 其與納米線接觸角度逐漸增大, 液滴表面張力促使其維持原始接觸角度, 因而在Au 催化液滴與納米線頂端的液-固接觸面產(chǎn)生一個(gè)向內(nèi)的應(yīng)力, 這個(gè)向內(nèi)的應(yīng)力作用于納米線頂端, 減少了催化劑對(duì)于側(cè)壁的潤(rùn)濕,抑制了納米線側(cè)壁的生長(zhǎng)速度, 使其直徑逐漸變窄.
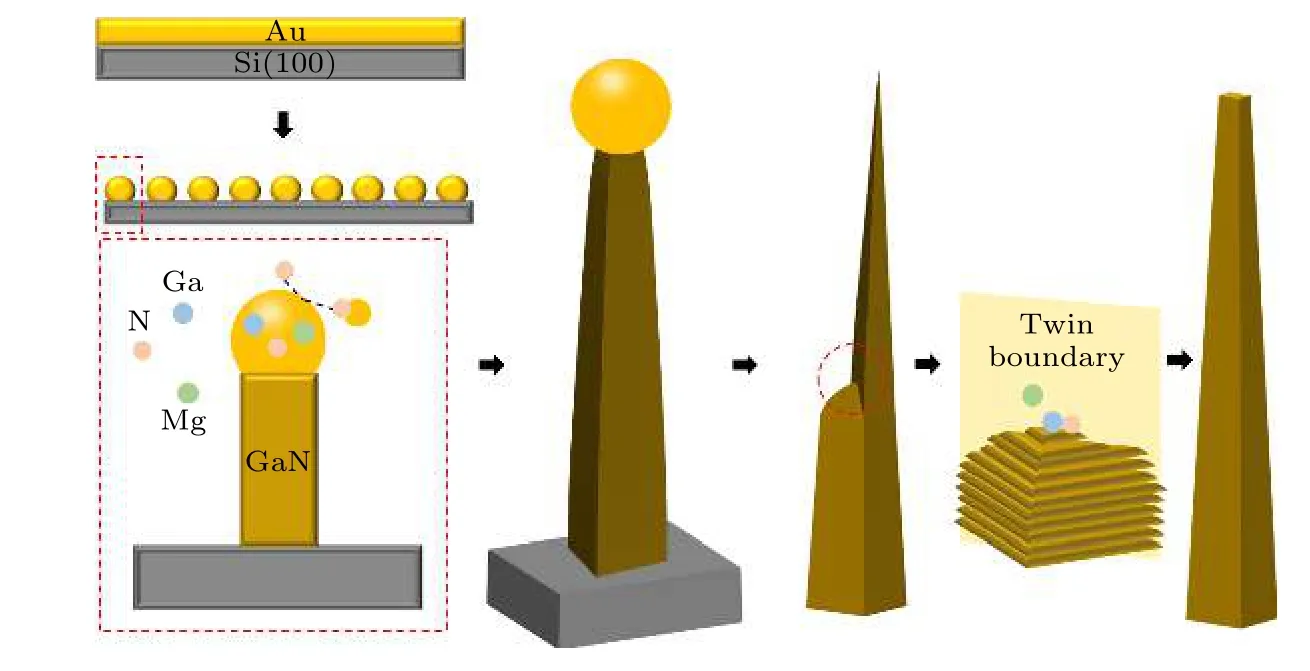
圖6 四方結(jié)構(gòu)GaN 納米線的成核和生長(zhǎng)過(guò)程示意圖Fig. 6. Schematic diagram of nucleation and growth for square-shaped GaN nanowires.
4) 隨著N 等離子體將Au 催化液滴完全刻蝕,納米線VLS 生長(zhǎng)機(jī)制結(jié)束, 其形貌為三方金字塔狀. 腔體中高濃度的Ga、Mg 原子接觸襯底以及納米線表面, 通過(guò)VS 生長(zhǎng)機(jī)制, 在低形核勢(shì)壘位點(diǎn)沉積來(lái)降低其自由能. 本征GaN 納米線趨向于延軸向生長(zhǎng), 其側(cè)壁形核勢(shì)壘較高, 不利于自催化生長(zhǎng), 而納米線金字塔尖端難以拓展為平面產(chǎn)生穩(wěn)定形核位點(diǎn), 故本征GaN 納米線維持三方金字塔形貌. 而Mg 摻雜降低了GaN 納米線生長(zhǎng)的各向異性, 降低了側(cè)壁生長(zhǎng)的勢(shì)壘, 使得納米線可以延徑向自催化VS 生長(zhǎng), 納米線直徑也逐漸增大. 與此同時(shí), 納米線側(cè)壁充當(dāng)孿晶界面, 與襯底平面接觸角位置提供了較低的形核勢(shì)壘[42,43], Ga、Mg 原子和氮等離子體延孿晶界徑向堆積成為三角形平面.在此新形成的平面之上, 勢(shì)壘更低的形核位點(diǎn)在孿晶界夾角處產(chǎn)生, 納米線將保持這種延孿晶界面逐層堆疊的方式向上自催化生長(zhǎng).
5) 隨著納米線孿晶界兩側(cè)完全對(duì)稱, 其截面形貌由三方轉(zhuǎn)變?yōu)樗姆叫? 隨著納米線頂端孿晶界的消失, 軸向生長(zhǎng)速度降低, 側(cè)壁生長(zhǎng)速度逐漸提升. 由于自催化生長(zhǎng)過(guò)程中各晶向生長(zhǎng)速度不一致, 導(dǎo)致納米線側(cè)壁出現(xiàn)擇優(yōu)取向生長(zhǎng), 形成鋸齒狀結(jié)構(gòu)[44]. 隨著Mg 摻雜濃度的上升, 納米線各向異性降低, 其側(cè)壁鋸齒狀結(jié)構(gòu)也就更加均勻一致.
3.3 四方結(jié)構(gòu)Mg 摻雜GaN 納米線PL 性能研究
由圖7(a)可知, 樣品A-a 發(fā)光峰波長(zhǎng)約為360 nm, 對(duì)應(yīng)于GaN 本征發(fā)光峰[45], 其峰值強(qiáng)度較高, 380 nm 附近存在微小凸起, 表明存在一定含量O 雜質(zhì)峰[14], 除外幾乎觀察不到其他波段的發(fā)光峰, 表面納米線缺陷較少, 結(jié)晶質(zhì)量較高. 樣品A-e 在波長(zhǎng)為386 nm 處有明顯的發(fā)光峰, 相較于A-a 的發(fā)光峰出現(xiàn)了明顯的紅移, 并且其峰值強(qiáng)度也有了一定程度的下降, 在可見(jiàn)光區(qū)范圍內(nèi)有明顯的發(fā)光峰, 表明有較多雜質(zhì)能級(jí)產(chǎn)生. 將樣品A-e的PL 譜線置換為對(duì)應(yīng)帶隙圖譜, 并采用高斯函數(shù)對(duì)其進(jìn)行分峰擬合, 其結(jié)果如圖7(b) 所示, 從圖中可以明顯觀察到3.21 eV 帶隙, 這是由于Mg 摻雜形成的MgGa受主能級(jí)對(duì)應(yīng)的帶隙[46], 使得納米線發(fā)光峰紅移, 對(duì)應(yīng)發(fā)光峰位置為386 nm. 在3.39 eV存在GaN 本征發(fā)光峰, 由于元素?fù)诫s使得其峰值強(qiáng)度較低. 在生長(zhǎng)過(guò)程中一定數(shù)量的Mg 受主會(huì)與摻雜進(jìn)入GaN 晶格的MgGa結(jié)合, 形成能級(jí)更深的施主受主對(duì), 其發(fā)光峰位置約為400—440 nm,對(duì)應(yīng)圖中2.96 eV 帶隙[47,48]. Mg-O 共摻雜形成2.47 eV 的施主能級(jí), 其發(fā)光峰位置約為502 nm[46].2.12 eV 附近的缺陷能級(jí)可能為GaN 納米線自催化生長(zhǎng)過(guò)程中產(chǎn)生的缺陷[49], 其發(fā)光峰位置為584 nm. 1.87 eV 附近帶隙可能為Mg 摻雜產(chǎn)生的紅光帶隙, 其形成原因?yàn)殡娮佑缮钅芗?jí)施主向深能級(jí)受主躍遷而產(chǎn)生, 其發(fā)光峰位置約為663 nm[46,50,51].
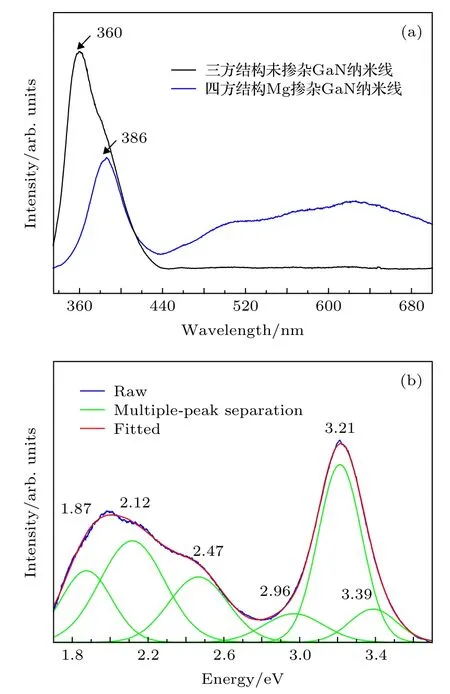
圖7 (a)樣品A-a 及樣品A-e 的PL 圖譜;(b)樣品A-e 的帶隙分析圖Fig. 7. (a) PL spectra of sample A-a and sample A-e; (b)band gap analysis spectra of sample A-e.
3.4 四方結(jié)構(gòu)Mg 摻雜GaN 納米線場(chǎng)發(fā)射性能研究
圖8 為樣品A-a 和樣品A-e 的場(chǎng)發(fā)射性能測(cè)試結(jié)果. 依照分析慣例, 我們規(guī)定樣品的開(kāi)啟電場(chǎng)為其發(fā)射電流密度達(dá)到10 μA/cm2時(shí)所對(duì)應(yīng)的電場(chǎng)強(qiáng)度. 如圖8(a) 所示, 樣品A-a 和樣品A-e 開(kāi)啟電場(chǎng)分別為6.4 V/μm 和5.2 V/μm. 且隨著電場(chǎng)強(qiáng)度的增加, 樣品A-e 可以產(chǎn)生更高的電流密度.如圖8(b) 所示, 樣品A-a 和樣品A-e 的 F-N 曲線在較高場(chǎng)強(qiáng)可以擬合為一條直線, 這表明電子通過(guò)量子遂穿效應(yīng)逸出樣品表面. 采用經(jīng)典F-N(Fowler-Nordheim)理論[52]來(lái)對(duì)樣品的場(chǎng)發(fā)射性能進(jìn)行分析, 其表達(dá)式如下:

圖8 樣品A-a 及樣品A-e 的(a) J-E 曲線; (b) F-N 曲線Fig. 8. (a) J-E curves; (b) F-N curves of sample A-a and sample A-e.

其中:J為發(fā)射電流密度(μA/cm2);b為場(chǎng)增強(qiáng)因子;E為外加電場(chǎng)(V/μm);F為功函數(shù)(eV).
由(1)式可以得到F-N 曲線中的直線部分斜率的表達(dá)公式[53]:

GaN 的功函數(shù)為4.1 eV, 代入(2)式可以得到樣品A-a 和A-e 場(chǎng)增強(qiáng)因子分別為1364 和1674, 表明樣品A-e 表現(xiàn)出更好的場(chǎng)發(fā)射性能. 四方結(jié)構(gòu)Mg 摻雜GaN 納米線可以表現(xiàn)出更良好的場(chǎng)發(fā)射性能, 其主要原因如下: Mg 元素的引入改變了GaN 納米線的形貌, 并導(dǎo)致了能帶結(jié)構(gòu)的變化, 影響其場(chǎng)發(fā)射電流密度的變化. 由于在生長(zhǎng)過(guò)程中Mg 摻雜誘導(dǎo)GaN 納米線自催化生長(zhǎng), 使其側(cè)壁產(chǎn)生鋸齒狀邊緣. 在場(chǎng)發(fā)射測(cè)試過(guò)程中, 納米線側(cè)壁鋸齒狀邊緣可以提高電子集聚密度, 在鋸齒狀尖端形成強(qiáng)電場(chǎng), 降低了表面勢(shì)壘[38], 有可能增大了納米線的有效發(fā)射面積[22,54], 提升了納米線場(chǎng)發(fā)射過(guò)程中的電流密度. 在場(chǎng)發(fā)射測(cè)試過(guò)程中隨著電場(chǎng)強(qiáng)度的逐漸增大, 較大的焦耳熱會(huì)導(dǎo)致納米線結(jié)構(gòu)破壞[22], 使其場(chǎng)發(fā)射性能下降, 而四方結(jié)構(gòu)納米線有著較好的熱穩(wěn)定性[21,55], 使得四方結(jié)構(gòu)GaN 納米線在高場(chǎng)強(qiáng)下表現(xiàn)出更好的場(chǎng)發(fā)射性能.通過(guò)XPS 分析可知, 樣品A-e 表面有較多的O 存在, 其中一部分進(jìn)入GaN 晶格與Mg 形成共摻雜的雜質(zhì)O, 另一部分為納米線表面吸附O[22], 使得納米線表面與其內(nèi)部形成異質(zhì)結(jié)構(gòu), 產(chǎn)生帶隙彎曲[56], 降低材料表面功函數(shù), 提高了場(chǎng)發(fā)射性能.通過(guò)PL 分析可知, 樣品A-e 存在Mg-O 共摻雜能級(jí), 相較未摻雜GaN 納米線Mg-O 共摻雜會(huì)導(dǎo)致導(dǎo)帶低下移, 降低材料的電子親和勢(shì), 降低了場(chǎng)發(fā)射表面勢(shì)壘[57]. 綜上所述四方結(jié)構(gòu)Mg 摻雜GaN納米線表現(xiàn)出更好的場(chǎng)發(fā)射性能.
4 結(jié) 論
本文采用MPCVD 系統(tǒng)制備出四方形截面的Mg 摻雜GaN 納米線. 通過(guò)調(diào)節(jié)Mg 摻雜比例, 可以將GaN 納米線在截面形貌間調(diào)控. Mg 摻雜GaN 納米線長(zhǎng)度為15—20 μm, 隨著Mg 摻雜比例升高, 納米線直徑可由50 nm 增長(zhǎng)為300—500 nm, 其截面形貌也由三方轉(zhuǎn)變?yōu)樗姆浇Y(jié)構(gòu). 納米線直徑增長(zhǎng)以及截面形貌轉(zhuǎn)變是由于Mg 摻雜提高了納米線側(cè)壁的生長(zhǎng)速度, 使其在VLS 生長(zhǎng)模式結(jié)束后進(jìn)行自催化VS 生長(zhǎng). 并且孿晶界面處提供了較低的形核位點(diǎn), Ga、Mg 原子以及N 等離子體延孿晶界逐層堆疊, 與三方結(jié)構(gòu)納米線對(duì)稱生長(zhǎng), 最終形成四方結(jié)構(gòu)納米線. Mg 摻雜導(dǎo)致GaN 納米線PL 圖譜中主發(fā)光峰紅移至386 nm,在可見(jiàn)光區(qū)可觀察到Mg 摻雜及O 雜質(zhì)形成的深能級(jí)發(fā)光峰. 四方結(jié)構(gòu)Mg 摻雜GaN 納米線開(kāi)啟電壓為5.2 V/μm, 表現(xiàn)出優(yōu)于三方結(jié)構(gòu)未摻雜GaN 納米線的性能, 可能由于Mg 元素?fù)诫s改變GaN 納米線結(jié)構(gòu), 其側(cè)壁鋸齒狀表面增加了有效發(fā)射面積, 以及Mg-O 共摻雜導(dǎo)致的功函數(shù)降低.研究結(jié)果為GaN 納米線形貌的可控生長(zhǎng)以及新型納米線器件設(shè)計(jì)與制作提供新的技術(shù)手段.

