功率MOSFET管結電容測試條件研究
李飛 常婷婷
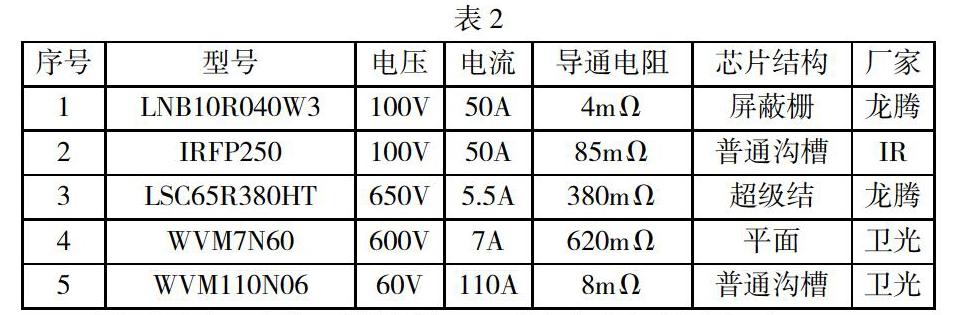
摘要:MOSFET的寄生電容是決定動態參數的根本原因,能否準確測得各級間電容值對生產應用有至關重要的意義。通過對四種不同結構的MOSFET進行電容測試,發現電容與測試頻率、電壓的變化趨勢,制定合理的電容測試的方法。
關鍵字:結電容、反向傳輸電容、特征頻率、負電容效應
引言
所有功率半導體的核心基于PN結設計制造的,當N型和P型半導體結合后,在結合面處的兩側形成空間電荷區,也稱為耗盡層,當PN結兩端的電壓變化的時候,PN結的空間電荷區的電荷也發生改變。在MOSFET器件實際的生產和應用過程中,怎樣選擇合適的測試條件得到合理的結果指導生產應用使結電容測試更有意義。
1寄生電容位置
功率MOSFET器件有四種常用的結構,分別是:平面結構、普通溝槽結構、超級結結構、屏蔽柵結構。以最常用的平面工藝生產的溝槽結構為例。根據場效應管的結構其內部有三個內在的寄生電容:Gata和Source的電容CGS;Gata和Drain的電容CGD,也稱為反向傳輸電容、米勒電容,Crss;Drain和Source的電容CDS。
2現行測試標準
功率場效應晶體管結電容測試根據GB/T 4586-1994 半導體器件 分立器件 第8部分:場效應晶體管標準中規定的方法進行。
標準方法使用LCR電橋進行測試,該測試儀采用四端對測量。四端對測量方法在進行低阻抗和高阻抗測量方面具有明顯優勢。外屏蔽導體作為測試信號電流(此電流沒有接地)的返回路徑。相同的電流流入中心導體和外部屏蔽導體(以相反的方向),但在導體的周圍不會產生外磁場(由內部電流和外部電流產生的磁場完全彼此抵消)。由于測試信號電流不會產生感應磁場,所以測試引線不會帶來由單根引線之間的自感或引起的附加誤差。
反向傳輸電容:Crss=CGD,MOSFET器件的寄生電容的測試條件行業一般規定為:VGS=0,VDS=BVDSS/2,f=1MHz,就是使用的測量電壓為額定電壓的一半,但是大多數廠家按VDS=25V電壓測試。
3電容的特征頻率
就場效應管自身而言,MOSFET器件電容的等效電路是由C,L,R,組成,宏觀的可以看成一個系統。因此,存在系統電磁兼容有諧振頻率,故就有了自諧振頻率值。
MOSFET器件的寄生電容的容值和自諧振頻率是芯片材料(包括電阻率、摻雜)與芯片構造所決定的。自諧振頻率與電容的容值成反比關系。因自諧振頻率區的容抗是最大的,做為濾波的電容應避開自諧振頻率段。但容值與頻率成反比,而容抗與容值成正比[N1]。在諧振頻率之前, 電容還保持著電容的特性, 而大于諧振頻率時,由于芯片版圖及鍵合線長度和導線電感的影響, 電容的作用將變成電感的作用。? ? ? 公式1,根據公式1可以計算系統的阻抗,如果把單只MOSFET看成一個體統時,此公式同樣適用。當公式1由于頻率f的大小改變,直接影響系統或器件測試的結果。當f變化使,則系統為“感性負載”;小于零則系統為 “容性負載”;等于零則系統為 “阻性負載”。f為系統的諧振頻率,在MOFET器件的寄生電容測試中為器件測試的自諧振頻率點。
MOSFET的電容都是非線性的變化的,是直流偏置電壓的函數。所有的MOSFET的寄生電容來源于偏置的氧化物電容和依賴于偏置的硅耗盡層電容的組合。由于器件里的耗盡層受到了電壓影響,電容CGS和CGD隨著所加電壓的變化而變化。電容隨著VDS電壓的增加而減小,尤其是輸出電容和反向傳輸電容。當電壓增加時,和VDS相關電容的減小來源于耗盡層電容減小,耗盡層區域擴大。然而相對于CGD,CGS受電壓的影響非常小,CGD受電壓影響程度是CGS的100倍以上。
在MOFET器件的寄生電容測試中VDS的電壓越大電容測量結果越小,實際應用時可根據器件BVDSS電壓及工作環境確定即可。目前僅剩下測試頻率的選擇,選擇一個合適的頻率點是測試的關鍵所在。
4不同結構測試
本文對4種不同結構的功率MOSFET器件進行,變化頻率進行研究。表2是試驗樣品的詳細情況[N5]。
本文選取表2內的五種樣品各一只進行寄生電容測試。由于Ciss、Coss電容是兩個部位容值之和,再者器件容量的變化主要取決于柵極的結構設計和工藝。本測試僅對Crss(G端與D端容值)容值在固定VDS電壓下改變頻率進行測試分析。
使用器件生產廠家給出結電容測試電壓VDS=25V、頻率從1KHz起步每次步進2KHz直至廠家規定的1MHz進行測試,每只器件測試5次求得算數平均值作為最終的測試結果。本結果使用日本JUNO公司生產的TDS-2000自動測試系統,該系統的電容測試模塊為安捷倫LCR測試儀E4980A,該儀器通過第三方校準。
WVM7N60代表的普通VD MOSFET與LSC65R380HT代表的高壓超級結 MOSFET器件的CRSS隨頻率變化曲線基本相似,走勢隨頻率的增加頻率緩慢下降。原因是這兩種結構的芯片柵極結構完全一樣,因此得出柵漏寄生電容隨頻率變化一致。
WVM110N06和IRFP250器件是不同廠家的普通 Trench結構。CRSS隨頻率變化曲線基本相似,走勢隨頻率的增加容值都有一個迅速下降的臺階,過了快速下降的頻率點后容值隨頻率增加而緩慢下降。原因是這種溝槽柵設計使得柵表面積過大而引起容值大于其他結構,該結構溝都有固定頻率在測試頻率未超過固定頻率時容值隨頻率變大而緩慢減小,在測試頻率為固定頻率時,容值斷崖式下降,之后緩慢下降。
對LNB10R040W3器件代表的分裂柵Trench結構使用VDS=50V和VDS=25V兩種電壓進行改變頻率測試。兩種電壓下的測試結果變化曲線基本相似,容值較普通Trench結果較小。分裂柵結構就是為了減小普通Trench的容值在柵極下部埋入了一塊與源極連接的一塊多晶硅來減小器面積從而降低寄生電容,因此該結構在測試時,當測試頻率增加到自諧振頻率附近時寄生電容迅速表達接下來在迅速轉變方向成為負電容且最大也就產生負電容效應。接下來,在頻率繼續變大時負電容緩慢向零靠近。在VDS=50V相同頻率點測得容值要比VDS=25V相同頻率點下的容值都小,且自諧振頻率也小。
結論
在MOSFET器件的寄生電容測試時,測試容值隨測試電壓增加而減小,因此建議業內都統一定位為VDS=25V,可以橫縱評定不同器件寄生電容的統一測試標準。測試頻率不能所有MOSFET器件一概而論,測試頻率都定為1MHz。不同結構的MOSFET器件在測試電容時,測試頻率要根據實際的結構確定,普通VD MOSFET與超級結 MOSFET可以選擇1MHz作為測試頻率點。普通 Trench測試頻率一定要高于容值快速下降的頻率點,也可選擇1MHz作為測試頻率點。分裂柵Trench器件測試頻率一定要小于自諧振頻率點。
參考文獻:
[N1]GBT 4586-1994 半導體器件 分立器件 第8部分:場效應晶體管
[N2] E4980A Precision LCR Meter Data Sheet 5989-4435EN

