化學機械拋光(CMP)過程中拋光盤溫度控制的分析研究
孫振杰,劉 濤,費玖海
(中國電子科技集團公司第四十五研究所,北京 101601)
在化學機械拋光過程中,溫度的變化對化學機械拋光的工藝性有顯著的影響,因此晶片在拋光過程中實施溫度控制是非常必要的,因此建立一種行之有效的拋光溫度控制方法,是CMP工藝研究的一個重要方面。
1 化學機械拋光的加工機理
如圖1所示,在化學機械拋光過程中,晶片粘貼在拋光頭(承載器)的下表面,拋光頭與拋光盤各自以一定的速度旋轉,在拋光壓力的作用下,晶片、拋光液和拋光墊彼此接觸,拋光過程中,由于機械摩擦的去除作用而產生大量的熱量,熱量的積累導致拋光盤表面溫度上升。
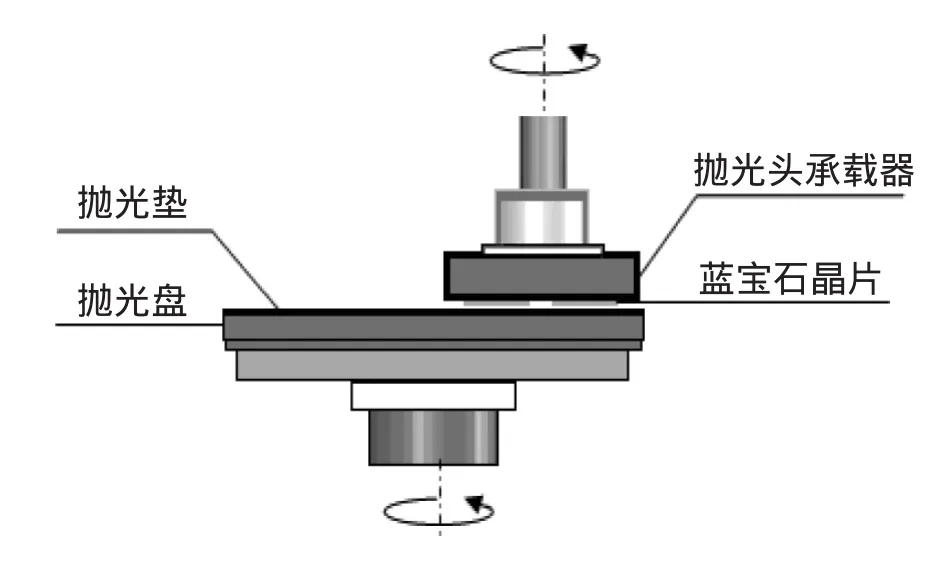
圖1 藍寶石拋光示意圖
2 溫度對拋光效果的影響分析
在化學機械拋光過程中,溫度對拋光效果的影響有以下幾個方面,一是使得拋光墊發生局部熱變形,改變了其彈性和全局平整度,從而改變了晶片表面壓力分布的均勻性,使得拋光過程中材料去除率一致性變差,最終導致拋光后晶片翹曲度、彎曲度指標降低,影響拋光效果;二是溫度過高使得粘接晶片的石蠟軟化,粘接力減小,出現晶片脫落和碎片現象;三是影響了拋光液與晶片之間的化學反應。
以藍寶石晶片(單晶Al2O3)拋光為例,拋光過程中,材料首先與化學拋光液中的堿性物質發生化學反應:

上述化學反應本身是一個放熱過程,化學反應產生的熱量,在一定程度上能夠促進和加快反應速度,從而加大材料的去除率,提高生產效率。但是,隨著熱量積累,過高的溫度有可能改變拋光液的化學組成,改變拋光液的pH值,降低反應速度,同時,溫度過高也會促使拋光液中納米粒子表面活性劑的分解脫離,從而導致晶片表面出現劃痕。因此在拋光過程中溫度必須在合適的范圍內,才能滿足藍寶石晶片的平整化要求。大量的拋光工藝實驗證明,藍寶石晶片的拋光溫度的最佳控制范圍應該在35℃~40℃。
通過實驗得到溫度對晶片粘接力的影響如圖2所示。

圖2 溫度對晶片粘接力
通過實驗得到溫度變化時拋光液pH值對拋光速率的影響如圖3所示
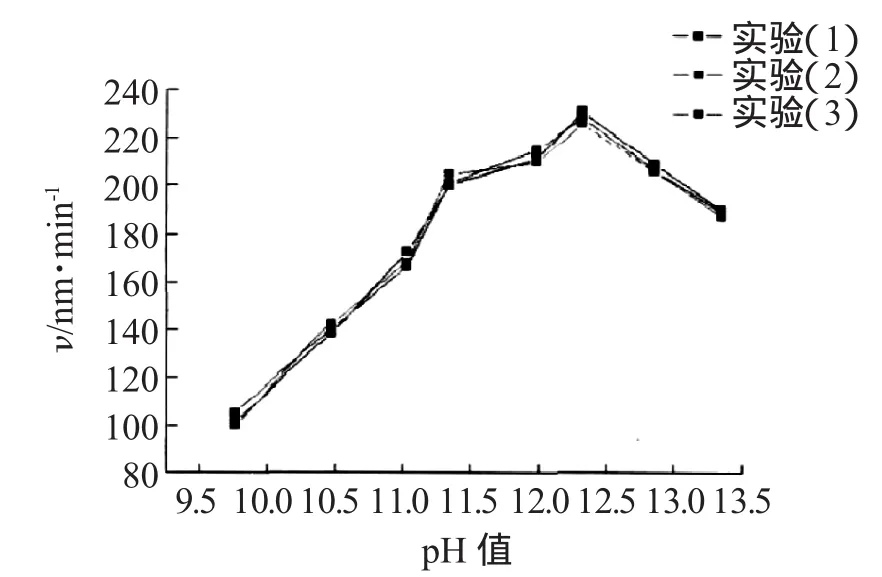
圖3 拋光液pH值對拋光速率的影響曲線
通過實驗得到溫度對拋光速率的影響曲線如圖4所示。

圖4 溫度對拋光速率的影響曲線
實驗曲線表明,當溫度低于25℃時,晶片的粘接力較大,但是拋光速率較低,隨著溫度的上升速率增加很快,當溫度高于40℃后,晶片的粘接力下降,拋光速率增長緩慢。
3 溫度控制系統的設計
為了獲得理想的拋光去除率和拋光效果,在化學機械拋光過程中通常采用一定的技術措施進行溫度控制,一種簡單而有效的方法就是采用拋光盤水冷卻的方式進行拋光溫度控制。
由圖1可知,拋光墊粘附于拋光盤表面,拋光過程中摩擦產生的熱量將通過拋光墊直接傳遞給拋光盤,導致拋光盤表面溫度升高,在拋光盤的內部設計一種循環通道,采用冷卻水在拋光盤內部循環流動的方法將拋光盤本身的熱量帶走,從而使拋光盤表面溫度降低,通過控制冷卻循環水的流量和循環時間,使整個系統的熱交換達到一種相對平衡狀態,使拋光盤表面溫度保持在一定范圍內,最終實現拋光過程中的溫度控制。
圖5為采用冷卻水循環的方法進行溫度控制的拋光盤內部結構圖,由圖可以看出,拋光盤內部水槽成蝶形,使得拋光過程中,主要工作區域的熱交換更趨向于均勻,有效避免了拋光盤局部溫度不一致的情況。

圖5 拋光盤結構圖
圖6為溫度控制原理示意圖,系統的工作原理是:置于拋光盤上方的溫度傳感器檢測到拋光盤溫度達到設定值時,通過PLC控制啟動水泵,從而把水箱中的冷卻水輸送到蝶形水道,經過循環后流回水箱。經過多次水的循環后,水箱中的水溫度改變,此時置于水中的溫度傳感器檢測達到設定值后,由進出水電磁閥和浮球液位開關共同控制水箱中的水能夠及時更換。
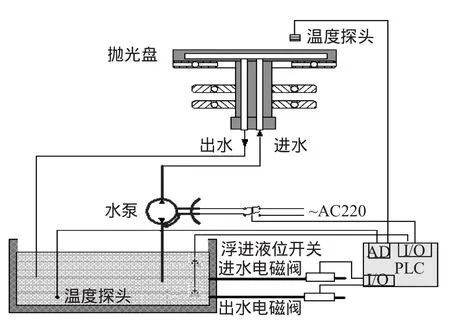
圖6 溫度控制原理圖
通過上述控制原理完成的溫度控制系統,在藍寶石晶片拋光實驗中進行了驗證,對拋光溫度控制的效果非常明顯,達到了設計要求。
4 藍寶石拋光溫度控制分析研究
前面已經介紹過,在化學機械拋光過程中,溫度控制的必要性以及溫度控制的最佳范圍。但是,不同的環境溫度對拋光溫度控制系統的要求也不同,不同室溫下,溫度控制情況也有差別,下面通過實驗進行說明。
4.1 室溫18℃時的拋光實驗
實驗過程中,為了研究室溫對拋光溫度的影響,我們分別采用不同的拋光參數組合進行拋光實驗,實驗結果數據顯示,在室溫18℃情況下,無論哪種拋光參數組合對應的拋光溫度基本上相同,如下表1所示。

表1 相同室溫(18℃)下不同拋光參數對應拋光墊溫度
上述拋光實驗過程中由于環境溫度較低,為了驗證環境溫度對拋光溫度的影響,拋光過程中未使用溫度控制系統,要將拋光溫度控制在35~38℃最佳的范圍內達到最佳拋光效果,溫度控制系統則需要對循環水進行加熱,以提高拋光墊表面的溫度。
4.2 室溫25℃時的拋光實驗
在室溫為25℃時,無論上述哪種參數組合,如果不使用溫度控制系統,都會造成拋光墊溫度過高,因此為了滿足拋光工藝要求,應該使用溫度控制系統采用冷卻水循環,以降低拋光墊表面的溫度。以下折線圖說明了在室溫25℃,溫度控制系統循環水溫度在23℃以下時,不同拋光參數對應的拋光墊溫度變化曲線。
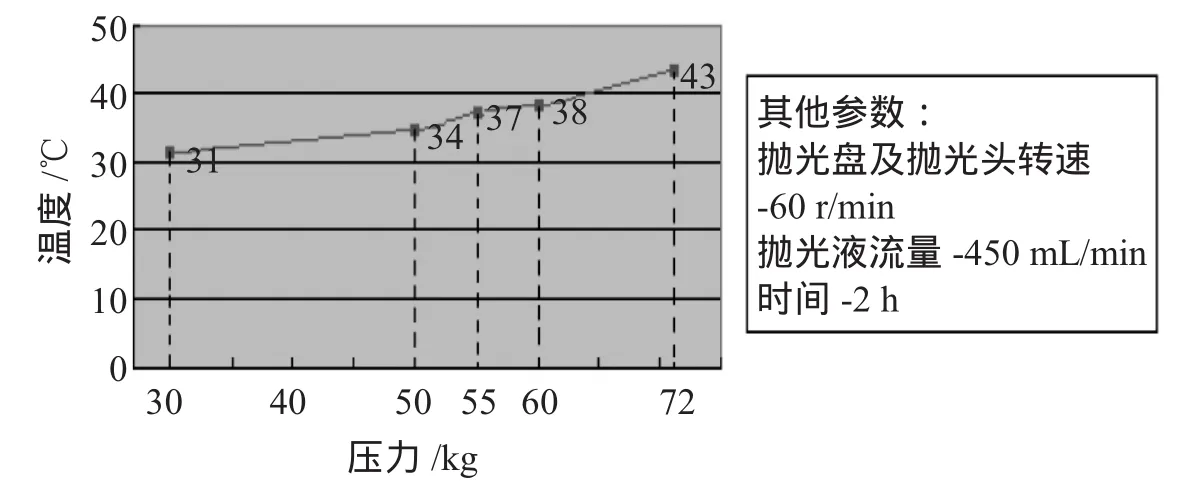
圖7 壓力與拋光墊溫度的關系
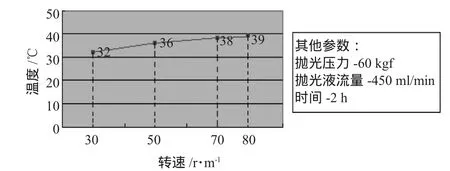
圖8 轉速與拋光墊溫度的關系
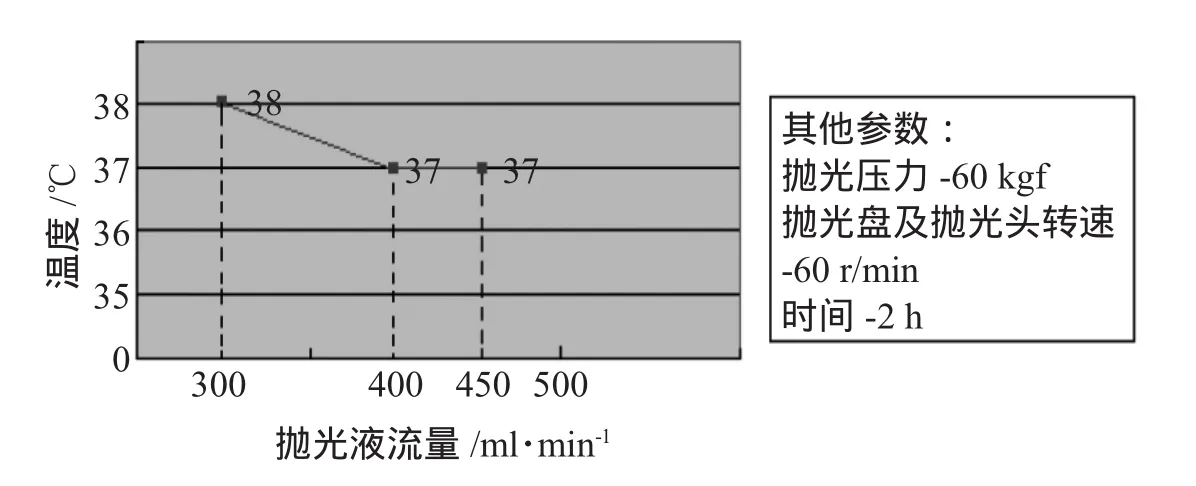
圖9 拋光液流量與拋光墊溫度的關系
由圖7、圖8和圖9可知,在嚴格控制循環水的溫度下,不論哪種拋光參數,拋光墊的溫度都基本控制在40℃之下,滿足化學機械拋光的要求。
通過上述兩組實驗可知,在拋光過程中溫度的控制是必要的,而且不同環境溫度對溫度控制的要求也不同。在實際的拋光過程中,一般拋光過程都是在室溫一定的凈化間內進行,因此拋光時只需考慮一種情況即可。
室溫25℃時,在未使用溫度控制系統進行拋光實驗,結果發現在拋光1 h左右,拋光墊溫度高達55℃,此時出現晶片脫落現象,使得實驗無法繼續進行。實驗再次證明了在拋光過程中,使用溫度控制系統的必要性。
5 結束語
影響拋光去除率和表面平坦化的因素有很多,通過實驗,我們知道對溫度進行控制是非常重要的,經過以上的研究分析,我們得到了一種切實可行的方法,完善了拋光中平坦化加工工藝方案,最終實現了均勻的拋光去除率。
[1]趙之雯,牛新環,檀柏梅,袁育杰,劉玉嶺.藍寶石襯底材料CMP拋光工藝研究[J].微納電子技術2006(1):19.
[2]王娟,檀柏梅,趙之雯,李薇薇,周建偉.藍寶石襯底片的拋光研究[J].電子工藝技術2005,26(4):229.
[3]H.L.Zhu,L.A.Tessaroto,R.Sabia.Chemical mechanical polishing(CMP)anisotropy in sapphire[J].Applied Surface Science,2004,236(1-4):120-130.

