Teradyne Ultra FLEX的測試程序調試
張 磊,張振華,楊純輝
(1.中國電子科技集團公司第四十七研究所,沈陽 110032;2.空軍駐遼寧地區軍事代表室,沈陽 110034)
1 引言
隨著大規模集成電路測試系統的出現,被廣泛應用在芯片測試領域,實現了高效率的集成電路產品驗證。Teradyne Ultra FLEX機臺是當今世界較為先進的大規模集成電路測試系統,我們以ATMEL公司的AT89S52芯片為例介紹在此機臺上的測試程序開發流程。
2 Ultra FLEX測試系統的硬件配置
Ultra FLEX機臺數字子系統有1024個測試管腳,數據速率 800Mbps/1000Mbps,時鐘頻率400MHz/500MHz,邊沿定位精度 ±80ps/±150ps,數據存貯深度256M,子程序存貯深度4K,向量定序存貯深度1M;PPMU每個管腳測量單元:V/I源和測量-1V~6V±50mA,每板64個精密時間測試單元,帶寬1GHz;交流子系統包括BBAC高精度寬帶交流源,Turbo AC高精度寬帶交流源,VHFAC高頻交流源,AWG6G微波信號源;直流子系統包括小功率源DC30,中功率源DC75,大功率源HEC Vs。
3 AT89S52電路特點
AT89S52是一種低功耗、高性能CMOS 8位微控制器,具有8K可編程Flash存儲器。使用Atmel公司高密度非易失性存儲器技術制造,與工業80C51產品指令和引腳完全兼容。片上Flash允許程序存儲器在系統可編程,亦適于常規編程器。在單芯片上,擁有靈活的8位CPU和在系統可編程Flash,使得AT89S52能夠為眾多嵌入式控制應用系統提供靈活、超有效的解決方案。
AT89S52具有以下功能特點:8K字節 Flash,256字節RAM,32位I/O口線,看門狗定時器,2個數據指針,三個16位定時器/計數器,一個6向量2級中斷結構,全雙工串行口,片內晶振及時鐘電路。另外,AT89S52可降至0Hz全靜態邏輯操作,支持兩種軟件可選擇節電模式。空閑模式下,CPU停止工作支持,允許RAM、定時器/計數器、串口、中斷繼續工作。掉電保護方式下,RAM內容被保存,振蕩器被凍結,單片機一切工作停止,直到下一個中斷或硬件復位為止。

圖1 AT89S52功能框圖
4 測試程序調試
AT89S52電路測試程序主要分為三部分進行調試:功能部分,直流部分,交流部分:
4.1 功能測試
測試AT89S52有兩種方式,一種是通過測試系統執行外部指令,此時EA=0。一種是通過測試系統對芯片串行編程或并行編程,先把要執行的指令寫入到內部FLASH存儲器中,然后再執行內部指令并通過測試碼點進行比對,此時EA=1。首先在TSB表中設置時間向量,然后在levels和DC Specs表中設置電源電壓,輸入電壓,在表PatSets中鏈接測試碼點文件,最后在測試系統Test Instances表中按Functional_T項進行測試。
4.2 直流測試
AT89S52共有16項直流參數,如表1所示。
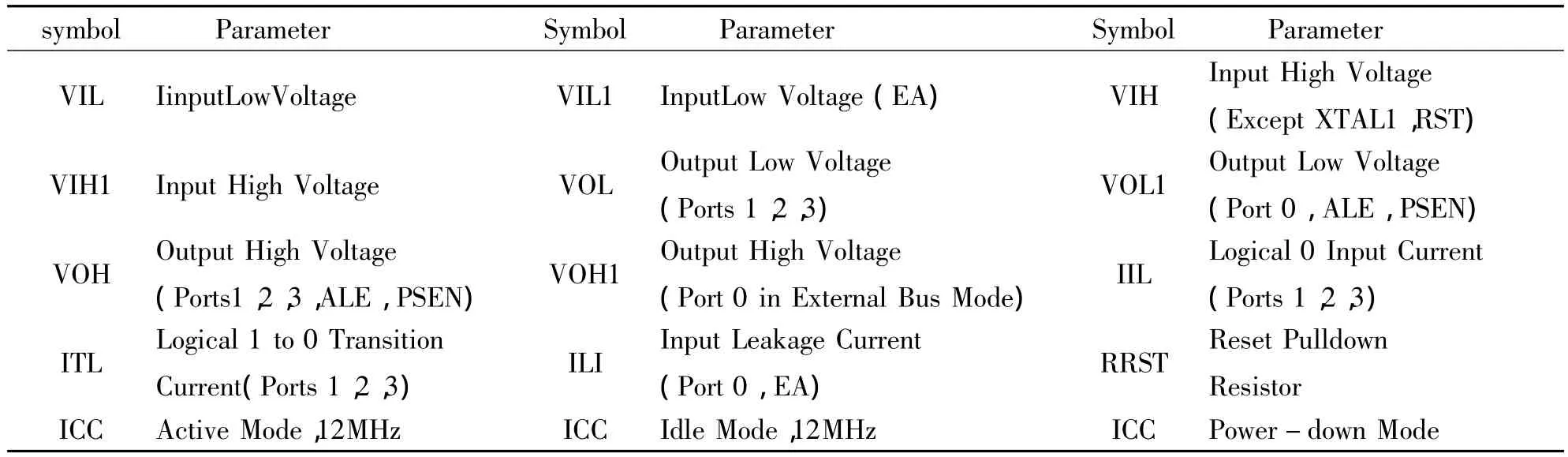
表1 直流參數表
4.2.1 VIH、VIH1、VIL、VIL1 參數測試
這四項參數為輸入電平,可以由測試系統直接給入參數手冊上面規定的值即可,然后通過功能驗證的方法進行測試。
4.2.2 VOL、VOL1、VOH、VOH1 參數測試
這四項參數為輸出電平,可以在Test Instances表中BoardPmu_T項上進行,選擇相關的測試管腳,進行參數設置,然后在選擇需要的測試Pattern,完成測試。
4.2.3 IIL、ITL、ILI、RRST
前三項測試輸入端電流,后一項測試復位電阻,都可以通過Test Instances表中PinPmu_T進行參數設置,然后強制電壓在所選管腳上,就可以得出電流值,其中RRST參數需要換算成電阻值。
4.2.4 ICC Active Mode、Idle Mode、Power-down Mode
這三項參數為動態電源電流、空閑模式電源電流和掉電模式下電源電流。在Test Instances表中PowerSupply_T項上進行,需要注意的是Idle Mode和Power-down Mode要在碼點中進行程序指令設置,P0口分別寫入指令758701和758702,使狀態進行匹配,即可進行測試。
4.3 交流測試
交流測試通常包括頻率,數據傳輸延遲時間,建立保持時間等相關參數。下面以tLLPL tLLIV tAVIV tPXIZ tPLAZ五項參數進行測試,選擇DC_Rise-Time_VBT項并設置好相關數值進行測試。具體波形如圖2所示。
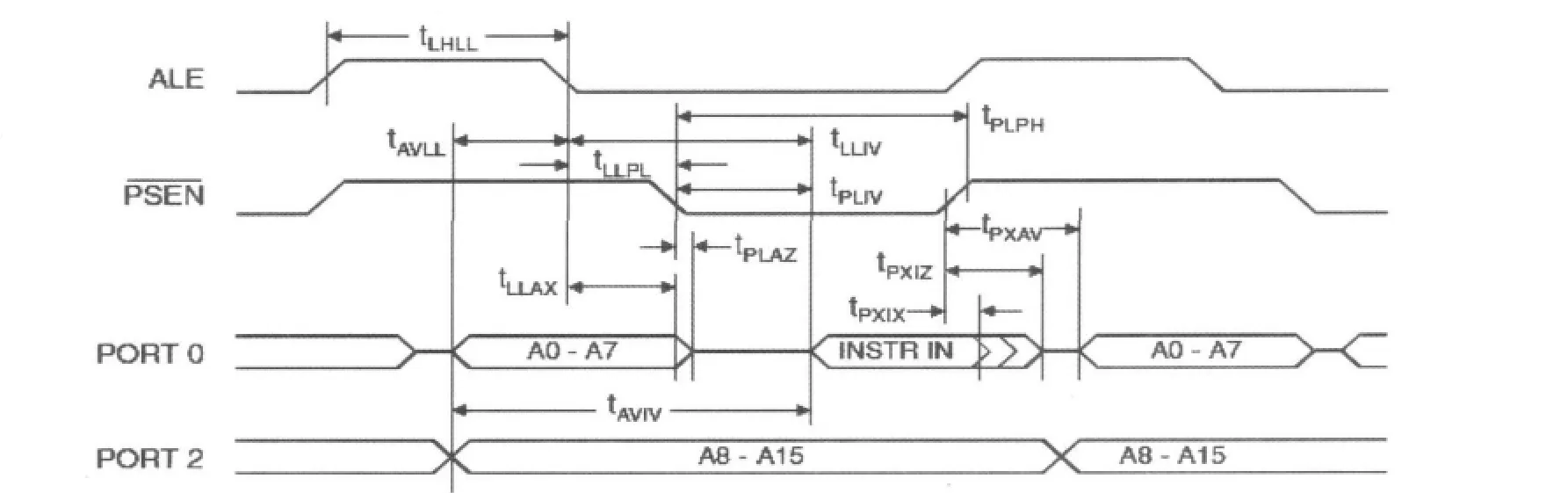
圖2 交流參數圖
4.4 測試流程
AT89S52電路的測試流程,如圖3所示。

圖3 測試流程圖
5 結束語
Teradyne Ultra FLEX是當今業內比較領先的集成電路測試系統,功能強大,測試精度高,覆蓋面廣,如何更加合理有效的使用,還需要測試人員進行不斷的摸索開發,從而使測試程序更加有效的運轉,提高科研及生產效率。
[1]Ultra Flex Mixed Signal Programming Student Manual[M/CD].Teradyne Inc 2009-2.
[2]《現代集成電路測試技術》編寫組.現代集成電路測試技術[M].北京:化學工業出版社,2005.

