一種根據晶圓移動量精確預測光刻膠日用量的方法
胡秀梅
(上海華力微電子有限公司,上海 200000)
一、概述
隨著半導體工業的迅速發展和工藝復雜性的日漸提高,準確預估物料的難度變得更大。而在半導體所有的化學品中,光刻膠是價格最貴的材料之一,但有效期卻最短(80%以上的光刻膠進廠后有效期僅有90天)。為了避免不必要的浪費,精確地預測光刻膠的日用量對半導體工廠的正常運行非常重要。
光刻膠的儲存有效期一般為六個月的有效期,并要求低溫冷藏。通常,在滿載的Fab里面需要用到的光刻膠會有30多種。一般地,光刻膠從出廠到運輸,經過進境報關和進口報關等一段時間后,剩余有效期僅為4~5個月,這對于安全庫存量的設置提出了非常高的要求。當安全庫存配置較高時,一旦客戶的需求有下降,就可能造成過剩的風險。反之,如果突然接到客戶的緊急訂單,最先缺料的可能就是光刻膠了。所以,如果有一種方法可以準確地預估每日所需要的光刻膠的使用量,不僅可以對光刻膠的安全庫存高低進行管理,同時,還可以清楚地預測到當有新訂單增加時,光刻膠的庫存會在某天出現供應短缺問題。
二、傳統的光刻膠用量計算方法
一般地,光刻膠需求量=單位晶圓所需要的光刻膠使用量×晶圓數量+機臺保養(Process Maintain,簡稱PM)所需的量。這種計算方法對于Fab的在制品的量非常穩定時或者滿載時是非常有意義的。但是,由于半導體產業存在著周期性波動,產品需求的在不同時間段差別較大,造成了在制品(WIP) 的數量非常不均衡,這種算法大大增加了精確預測光刻膠使用量的復雜度。一般地,為了對這種算法進行修正需參考過去3到6個月的實際用量,但是由于復雜多變的生產狀況,修正的結果并不是非常準確。除此之外,傳統的計算方法對光刻膠的具體進料時間受算法限制,無法準確估算到需要進料的日期,這對于有效期非常短的光刻膠來說是一種非常大的浪費。
三、精確的光刻膠用量計算方法
在12吋晶圓代工廠中,一般產品制程中大約要經過六百步(Step)到八百步。針對不同步驟,不同機臺,不同產品需要有不同的Recipe。在Fab中,Recipe是指機臺針對不同的產品和不同的步驟所定義的運行所需要的控制流程。精確預測光刻膠用量的基本方法是根據Recipe所設置的光刻膠的單位用量乘以該機臺預計的晶圓移動數(move),并加上機臺正常保養所需要的量。要做到這點,必須準確了解以下:(一)準確掌握當前的工廠(Fab)的在制品(WIP)在不同站點的數量;(二)對于未來一段時間內光刻機臺的晶圓的移動量(Move)的準確預估;(三)機臺正常保養的頻率和數量;(四)其它非常規光刻膠使用量的預測。
1 在制品(WIP,Work In Process)的數量和狀態
1.1 在制品WIP狀態和數量的獲得:
精確地統計WIP的數量和狀態是保證計算準確的前提。 現代化的半導體晶圓代工廠由于其自動化程度高,生產線都會配置一種MES(Manufactory Execute System,制造執行系統)系統。
由于光刻膠的計算僅和光刻層相關,故經過系統直接導出的WIP的狀態需要進行過濾和處理,把所有的WIP 統計成和光刻層相關的數量。這樣在進行基本的光刻膠用量設置時也僅需要以光刻層為基點。
1.2 本月預計下線計劃:
有了當天的WIP狀態和各產品的DPML后,還需要進一步了解本月是否還有需要下線的硅片,針對這部分下線計劃同樣需要進行按日維護. 一旦有新的Wafer下線,這部分很快就會成為新下線的在制品.
2 晶圓的移動量(Move)的準確預估
2.1 各產品DPML的設置:
有了當天的WIP 狀況以后,需要對未來一定時間(可根據實際情況設置,比如30天)的晶圓移動量(Move)進行預測。 這時,就需要引入一個叫DPML(Days Per Mask Layer,每光刻層所需要的天數)的參數。 一般地,DPML是根據Fab的制造能力,每個項目,甚至每個Layer都會有一些不同。在進行后續的WIP狀況預測時,必先對該參數進行設置。一般地,進行該參數設置時會考慮到機臺實際運行的瓶頸進行接近實際的設置。該參數設置得越小,對物料的需求要求進料時間越短,相應地預留的空間也就越大;反之,就會出現物料緊張的風險.
2.2 根據DPML 對未來一定時期內Move數的預估:
a).根據表1先針對項目對DPML進行相應的設置:
b).在表2中,第N天為MES中當前實際WIP 狀態值。根據第N天的值對未來若干天之后的WIP狀態進行預測:
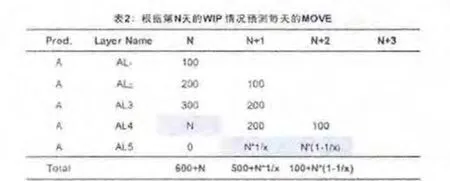
對于產品A的第ALn層Layer來說,第N+1天的Move數=AL(n-1)的move數×1/AL(n-1)的DPML;
有了以上 1 和 2 的結論之后,結合每層Layer光刻膠的使用情況(如表3),就可以快速地計算出某天光刻膠需要的量:
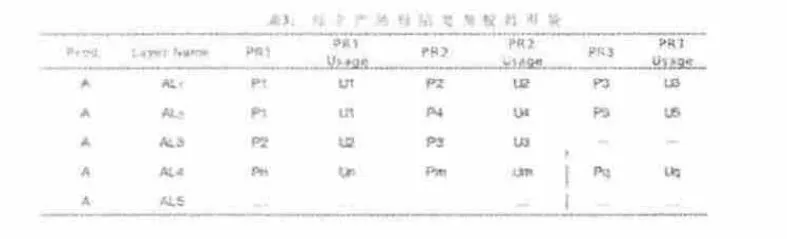
例如: 在第N+1天:
光刻膠P1 預計消耗量=第N+1天AL1的MOVE量*U1+第N+1天AL2的 move量*U1.
3 機臺正常保養的頻率和數量
3.1 光刻機噴頭的固定噴涂:
在光刻機臺沒有滿載時,為防止光刻機噴嘴干涸,需周期性地將光刻膠噴涂以保持噴頭暢通;這種周期性噴涂的頻率對低使用量光刻膠的影響很大,在機臺不滿載或者新品研發階段,這種使用量比正常的生產使用量可能還多;這部分需要根據工藝工程師對參數的設置,進行每月固定用量的設置;
3.2 光刻機固定時間Filter的更換:
一般地,光刻機中的Filter都有固定的壽命,一旦壽命到即需要更換。 在更換Filter時,一般對某種光刻膠會用量較大,這部分需要設備工程師對后續要更換Filter所需要消耗的光刻機進行預估,并把這部分的量加入到日預測的數據中。
4 非常規的光刻膠的使用量預測
除了以上介紹的光刻膠的常規使用情況, 實際操作中Fab還常常會遇到以下幾種情況可能需要增加光刻膠的使用量,且這些情況一般比較難于預測,如:
a光刻機末端過濾器的更換;
b硅片可能的返工率;
c為防止光刻機噴嘴干涸,需周期性地將光刻膠噴涂以保持噴頭暢通,這種周期性噴涂的頻率對低使用量光刻膠的影響很大,在機臺不滿載或者新品研發階段,這種使用量比正常的生產使用量可能還多;d為了解決硅片缺陷問題,經常需要吹洗光刻增加控擋片的使用,增加光刻膠的用量來排查缺陷;
5、月差異系數的修正
為了減少以上3.4所述非常規情況下的使用量對整體預測的波動, 一般地,系統需要每月根據實際使用情況和月初預測的情況進行對比分析, 列出其中的差異原因進行分析比對.根據最近3個月的差異情況相應地進行加權平均得出一個系數來進行修正。
如:最近三個月Yn-1,Yn, Yn+1三個的實際使用量,相對應的當月MOVE數分別為Mn-1,Mn, Mn+1, 而實際使用量分別為Wn-1,Wn, Wn+1, ,

(以上系數的修正基于Move數的預測偏差在±2%)
修正后當日光刻膠的使用量即為: wn= x*yn (假定wn為某日用量)。
結語
隨著半導體市場的變化多端,針對一些有效期短的材料制定日使用量監控是提高競爭力的重要途徑和手段.我們分析了如何根據Fab的實際運行能力設置相應的DPML,并根據該參數進行Move數的預測,并在此基礎上進行了光刻膠的日用量預測和在實際操作中對所遇到的偏差進行的相應修正。
[1]趙霽,丁麗麗.半導體制造業主生產計劃和物料需求計劃模型研究[J].期刊論文.
[2] Willian J,Steven.生產與運作管理[M].
[3]斯塔特勒,基爾戈.供應鏈管理與高級規劃—概念、模型、軟件與案例分析[M].北京:機械工業出版社,2005:38-41.

