薄膜互連線形狀參數對電遷移的影響
黃 飛,丁善婷,李婳婧
(湖北工業大學機械工程學院,湖北 武漢430068)
隨著熱光效應可調光衰減器VOA(Variable Optical Attenuator)的廣泛應用,其可靠性得到了越來越多的關注。加熱器芯片作為VOA器件的核心部件,其失效將影響整個器件的正常工作。通過BLACK方程和相關理論[1-2]可知,加熱芯片的失效主要是因金屬薄膜互連線的電遷移失效造成的。然而除環境溫度和加載電流等因素的影響外,互連線的形狀參數也會對其壽命產生影響。本文主要針對加熱模塊中金屬薄膜互連線的形狀參數對其壽命的影響進行研究。使用恒流源對試驗樣品施加恒定電流,實時監控樣品的電壓值,計算樣品的電阻變化率,進而得到影響互連線壽命的形狀參數,由此提出產品優化方案。
1 試驗
互連線是VOA器件加熱模塊的重要組成部分,本身可靠性較高。如果在正常條件下進行壽命試驗,周期長,成本高。而根據相關理論[3]可知,隨著環境溫度的升高和加載電流的增加,互連線的使用壽命將會有所下降。因此在不改變失效機理的前提下,使用較高水平的應力條件,不僅能降低試驗周期和成本,還能得到較理想的試驗結果。通過前期試驗的結果和樣品的物理化學性質,選取環境溫度150℃,加載電流500mA,進行試驗。
1.1 試驗設計
試驗設計如圖1所示。互連線樣品放置在恒溫試驗箱(保持環境溫度為150℃)中進行加電試驗,使用恒流源給樣品施加恒定電流500mA,實時監控電壓值變化。此系統在不中斷試驗的情況下,能夠實時獲取電壓的變化,通過歐姆定律可以直觀和準確地獲得互連線的失效規律。
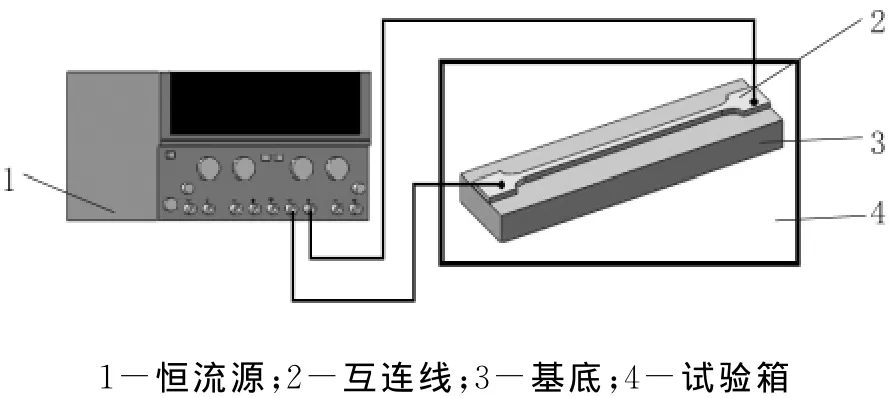
圖1 試驗系統結構圖
1.2 試驗樣品
根據相關要求,薄膜互連線由Au制作而成,使用Si片作為襯底,Si片上涂覆SiO2薄膜作為絕緣層。圖2a所示為VOA加熱模塊的實物圖,由10根相同的Au薄膜互連線組成,每根互連線相互獨立,不受影響。在設計樣品掩膜板時,由于本試驗樣品結構的特殊性,為了試驗的方便和結果的準確性,根據實際樣品的結構特點簡化試驗樣品(圖2b)。

圖2 試驗樣品
2 討論
電遷移失效是Au薄膜互連線的主要失效機理,將引起互連線局部材料因耗損而出現空洞,或引起材料堆積而出現小丘或晶須,最終導致突變失效,嚴重影響互連線的壽命。
2.1 外觀變化
經過試驗,得到各個結構的互連線失效圖(圖3)。由圖3中可觀察到三種樣品出現了相同的外觀變化:都出現熔斷且橫貫整個互連線,而且熔斷位置均出現在互連線與電極連接的圓弧區域附近。
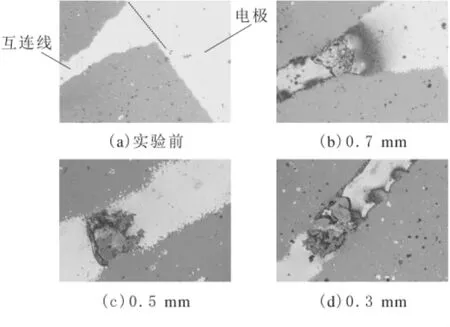
圖3 互連線外觀變化
2.2 壽命
試驗完成后,對每一種樣品的多個樣本試驗數據實施標準化處理(圖4a)。由圖4a可知,不同形狀參數樣品壽命的曲線趨勢均由快速增長階段、穩定階段以及加劇失效階段這三個階段組成,而且這三個階段的壽命曲線與文獻[4-5]關于銅薄膜互連線電遷移的失效規律基本一致。試驗中使用的三個形狀參數0.3mm、0.5mm、0.7mm 互連線的壽命分別為120h,158h和218h。由圖4b可知,隨著形狀參數的增加,互連線的壽命相應增加。

圖4 不同形狀參數互連線的壽命曲線
3 分析與結論
在試驗前,使用的試驗樣品經檢查沒有出現破損或斷裂等情況,完全符合實驗設計樣品所需。在環境溫度為150℃、加載電流為500mA的試驗條件下,進行壽命加速試驗后,試驗樣品均出現熔斷且壽命曲線走勢基本一致。
1)電遷移一般發生互在連線與電極連接的圓弧區。試驗樣品均出現熔斷且失效位置相同。這是由于試驗中電遷移致使原子發生遷移,隨著原子遷移不斷累積并會形成空洞,最終橫貫整個互連線致使電路開路;熔斷位置均出現在溫度梯度最大處[6-7],而本樣品的溫度梯度最大處正是互連線與電極連接的圓弧區,所以此處會出現熔斷。
2)互連線失效壽命取決于穩定階段持續時間的長短。樣品剛開始試驗時,由于環境溫度上升和電流加載產生大量的焦耳熱使薄膜互連線溫度上升,從而導致電阻也隨之上升,且隨著時間的推移電阻逐漸趨于穩定。在應力作用下,空洞逐步積累致使互連線電阻緩慢增長或基本不增長,這也是缺陷逐漸積累的過程;最后在經過穩定階段長時間的高溫和強電流作用下,空洞已經增大到與金屬線寬度相當的程度,致使互連線電阻迅速上升,并快速發生失效。
3)互連線的壽命與其形狀參數有關。即互連線與電極連接處的圓弧半徑越大,互連線的壽命越長,且變化規律與電遷移理論相一致。
[1] 尹立孟,張新平.電子封裝微互連中的電遷移[J].電子學報,2008,36(08):1610-1614.
[2] Black J R.Electromigration failure modes in aluminum metallization for semiconductor devices[J].Proceedings of the IEEE ,1969 ,57(09):198-203.
[4] Black J R.Electromigration-a brief survey and some recent results[J].IEEE Transactions on Electronic Devices,1969,16(04):338-347.
[5] 盧秋明.金屬互連線的可靠性研究[D].上海:復旦大學,2009.
[6] Schwarzenberger A P,Ross C A,Evetts J E,et al.Electromigration in the presence of a temperature gradient:experimental study and modeling[J].Journal of Electronic Materials,1988,17(05):473-478.
[7] Nguyen H V,Salm C,Krabbenborg B,et al.Effect of thermal gradients on the electromigration lifetime in power electronics[C].IEEE 42nd Annual International Reliability Physics Symposium,2004:619-620.

