MCM封裝技術新進展
2016-04-21 09:03:25胡燕妮
電子與封裝
2016年3期
關鍵詞:工藝
胡燕妮
(武漢船舶職業技術學院,武漢430000)
?
MCM封裝技術新進展
胡燕妮
(武漢船舶職業技術學院,武漢430000)
摘要:MCM封裝是多芯片組件,它可以將裸芯片在Z方向疊層,更加適合電子產品輕、薄、短、小的特點。介紹了MCM封裝技術的3種分類——MCM-L、MCM-C及MCM-D。其中MCM-L成本低且制作技術成熟,但熱傳導率及熱穩定性低。MCM-C熱穩定性好且單層基板價位低,但難以制成多層結構。MCM-D為薄膜封裝技術的應用,它也是目前電子封裝行業極力研究、開發的技術之一。最后討論了MCM封裝技術在多芯片組件等方面的最新進展。
關鍵詞:封裝;MCM-L;MCM-C;MCM-D
1 引言
近年來,隨著新技術的發展,尤其是封裝技術的迅猛發展,MCM集成電路尤其是低成本的消費類MCM集成電路已經大批量進入市場。MCM可以將裸芯片在Z方向疊層,這樣就可以更加適合電子產品輕、薄、短、小的特點。
這就是MCM封裝產生的背景。
2 MCM封裝技術現狀
2.1 MCM封裝技術概述
MCM封裝即多芯片組件,如圖1所示,其內部結構圖如圖2所示,它使用多層連線基板,再以打線鍵合、載帶自動鍵合技術或控制塌陷芯片連接方法將多個IC芯片與基板連接,讓它們成為具有特定功能的組件。其主要優點是電路連接密度及封裝效率更高;且與SMT相比,MCM封裝提升了可靠度,SMT封裝如圖3所示。其缺點是制造成本高,功率提升速度慢,且沒能根本解決KGD(Known Good Die已知之良好芯片)來源問題。
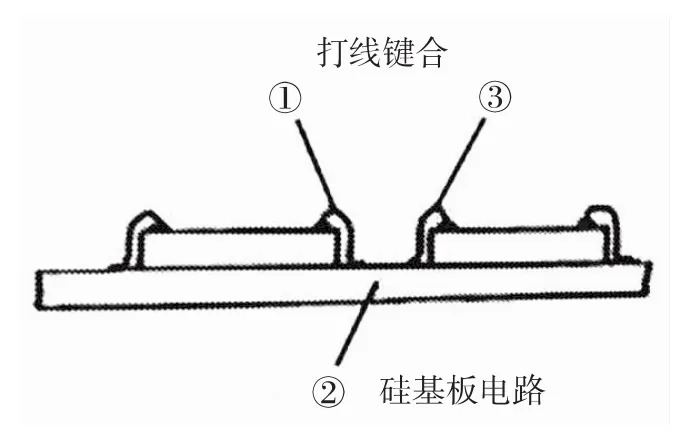
圖1 MCM封裝
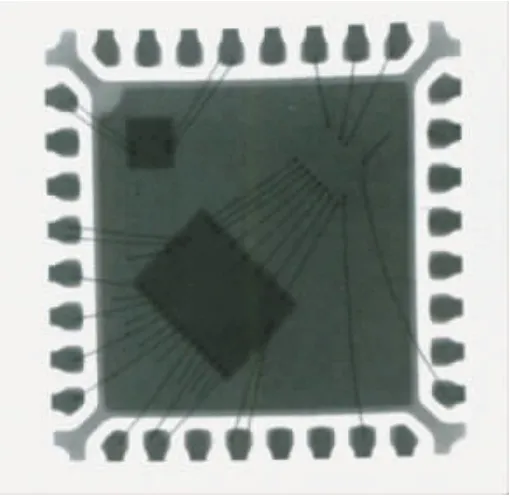
圖2 MCM內部結構圖

圖3 SMT封裝
MCM封裝技術可以分為3類:疊層型多芯片組件(MCM-L);共燒陶瓷型多芯片組件(MCM-C),其中的LTCC技術是MCM封裝中最有發展前途的一種;……
登錄APP查看全文
猜你喜歡
中國特種設備安全(2022年5期)2022-08-26 09:19:32
礦產綜合利用(2020年1期)2020-07-24 08:50:40
山東冶金(2019年6期)2020-01-06 07:45:54
收藏界(2019年2期)2019-10-12 08:26:06
世界農藥(2019年2期)2019-07-13 05:55:12
世界農藥(2019年2期)2019-07-13 05:55:10
模具制造(2019年3期)2019-06-06 02:11:00
山東工業技術(2016年15期)2016-12-01 05:30:59
銅業工程(2015年4期)2015-12-29 02:48:39
新疆鋼鐵(2015年3期)2015-11-08 01:59:52

