聚焦離子束加工技術(shù)在元器件可靠性領(lǐng)域中的應(yīng)用研究
崔 帥,曹德峰,李志勇,陳 斌(1. 上海微小衛(wèi)星工程中心,上海 201203; 2. 中國(guó)科學(xué)院微小衛(wèi)星重點(diǎn)實(shí)驗(yàn)室,上海 201203)
?
聚焦離子束加工技術(shù)在元器件可靠性領(lǐng)域中的應(yīng)用研究
崔 帥1,2,曹德峰1,2,李志勇1,2,陳 斌1,2
(1. 上海微小衛(wèi)星工程中心,上海 201203; 2. 中國(guó)科學(xué)院微小衛(wèi)星重點(diǎn)實(shí)驗(yàn)室,上海 201203)
摘要:FIB技術(shù)通過(guò)截面加工實(shí)現(xiàn)部分失效樣品的原位觀察,通過(guò)截面加工獲得的圖像獲取相關(guān)信息;能夠進(jìn)行TEM制樣,是材料微分析領(lǐng)域中不可缺少的分析技術(shù);能夠進(jìn)行納米器件加工,是微加工領(lǐng)域的一種新型技術(shù)。FIB技術(shù)可操作性強(qiáng)、樣品損傷小,對(duì)航天型號(hào)元器件可靠性質(zhì)量保證技術(shù)具有一定的指導(dǎo)意義。
關(guān)鍵詞:FIB;結(jié)構(gòu)分析;失效分析;TEM制樣
sample preparation
引言
航天型號(hào)用元器件是航天型號(hào)工程的基礎(chǔ)。元器件可靠性的高低已經(jīng)成為制約航天型號(hào)工程可靠性的關(guān)鍵因素之一。由于航天型號(hào)工程的高可靠性、低風(fēng)險(xiǎn)度以及不可維修性等特點(diǎn),在型號(hào)工程研制及系統(tǒng)調(diào)試方面需要進(jìn)行大量的可靠性試驗(yàn)。通過(guò)進(jìn)行可靠性試驗(yàn),為了暴露因元器件選用及使用、產(chǎn)品設(shè)計(jì)以及系統(tǒng)集成方面的質(zhì)量缺陷,以提高型號(hào)工程的可靠性,保證航天型號(hào)工程的高可靠運(yùn)行。
就目前國(guó)內(nèi)國(guó)際元器件級(jí)可靠性質(zhì)量保證技術(shù)而言,通用技術(shù)主要有元器件補(bǔ)充篩選試驗(yàn)、破壞性物理分析(DPA)、結(jié)構(gòu)分析(CA)、失效分析(FA)以及應(yīng)用驗(yàn)證等。結(jié)構(gòu)分析是近幾年航天型號(hào)工程逐漸推廣的新型技術(shù)。該技術(shù)可以從材料、生產(chǎn)工藝等方面對(duì)元器件進(jìn)行分析,對(duì)元器件可靠性起著至關(guān)重要的作用。在結(jié)構(gòu)分析中,需要觀察芯片截面,掌握器件生產(chǎn)工藝,檢驗(yàn)器件工藝對(duì)可靠性的影響。目前,裸芯片截面加工主要有兩種方式:一為裸芯片截面研磨加工工藝,二為聚焦離子束(Focused ion beam,簡(jiǎn)稱FIB)截面加工。二者各有利弊。Si基器件截面觀察,兩種方式均可進(jìn)行。然而,對(duì)于部分特殊工藝(如GaAs基器件),由于材料為脆性材料,觀察芯片截面只能通過(guò)FIB截面加工技術(shù)。部分需要截面觀察器件需要借助投射電子顯微鏡(TEM),采用FIB加工技術(shù)為TEM制樣。本文就雙束聚焦離子束加工技術(shù)進(jìn)行分析,探討其在集成電路的應(yīng)用研究,對(duì)航天型號(hào)可靠性工程具有極其深刻的指導(dǎo)意義。
1 設(shè)備組成及原理構(gòu)成
雙束FIB由掃描電子顯微鏡和聚焦離子束兩個(gè)部分構(gòu)成。目前商用系統(tǒng)的離子源多數(shù)采用液相金屬離子源(Liquid Metal Ion Source,LMIS),金屬材質(zhì)為鎵(Gallium,Ga)。在離子束加工過(guò)程中,外加電場(chǎng)于液態(tài)金屬離子源,使液態(tài)鎵形成細(xì)小尖端,再加上負(fù)電場(chǎng)(Extractor)牽引尖端的Ga,而導(dǎo)出Ga離子束,以電透鏡聚焦,經(jīng)過(guò)一連串變化孔徑(Automatic Variable Aperture,AVA)可決定離子束的大小,再經(jīng)過(guò)二次聚焦至試片表面,利用物理碰撞來(lái)達(dá)到切割之目的,完成微納米級(jí)材質(zhì)的加工[1]。而后在電子束下對(duì)樣品進(jìn)行觀察并配備能譜分析(EDS)探頭進(jìn)行成分分析。單束FIB檢測(cè)系統(tǒng)如圖1所示,雙束FIB檢測(cè)系統(tǒng)示意圖如圖2所示。雙束FIB是目前國(guó)內(nèi)國(guó)際市場(chǎng)較為先進(jìn)的設(shè)備。與傳統(tǒng)的單束FIB相比,雙束FIB增加了掃描電子顯微鏡(SEM)功能,優(yōu)勢(shì)體現(xiàn)為加工后樣品能及時(shí)觀察、能夠?qū)κ骷M(jìn)行原位觀察等。
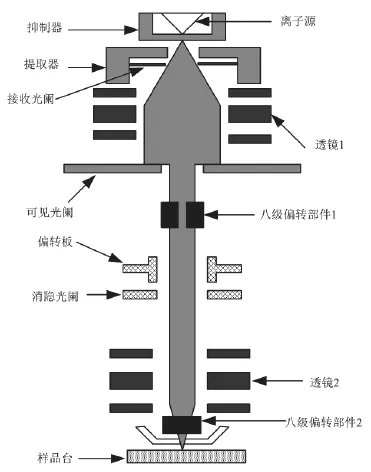
圖1 單束FIB檢測(cè)系統(tǒng)
2 FIB的應(yīng)用
2.1 原位失效分析
雙束FIB的一個(gè)基本應(yīng)用是解析樣品缺陷,進(jìn)行失效分析。相比較單束聚焦離子束而言,雙束電鏡可以利用掃描電鏡作為常規(guī)的表征工具對(duì)缺陷部位高分辨表征和精確定位,然后將樣品傾斜至垂直于聚焦離子束,用聚焦離子束來(lái)定點(diǎn)加工出一個(gè)光滑的截面。由于掃描電鏡和聚焦離子束鏡筒呈一定的角度的夾角,掃描電鏡可以原位對(duì)缺陷部位進(jìn)行分析。
目前半導(dǎo)體行業(yè)失效分析定位技術(shù)有多種,如EMMI、ORBICH、SDL單一技術(shù)或是組合技術(shù)等,它們的測(cè)量領(lǐng)域不同,對(duì)不同器件采用不同的測(cè)量技術(shù)。如某些技術(shù)能夠量測(cè)微安量級(jí)電流,但是精度達(dá)不到納安級(jí)電流量測(cè)。有些技術(shù)能夠?qū)δM電路進(jìn)行定位,有些能夠?qū)?shù)字電路失效定位。在某些失效器件中,F(xiàn)IB切割技術(shù)也可以進(jìn)行失效定位,進(jìn)行原位測(cè)量,該技術(shù)和芯片截面加工的原理相同。
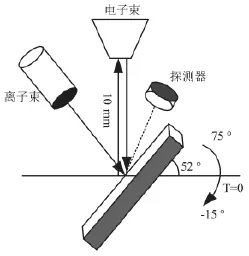
圖2 雙束FIB檢測(cè)系統(tǒng)示意圖
在雙束FIB中,大束流的聚焦離子束可以實(shí)現(xiàn)快速加工;掃描電鏡的高分辨能力可以較為容易地表征樣品的精細(xì)結(jié)構(gòu),束流調(diào)節(jié)范圍很寬,可以對(duì)失效部位進(jìn)行快速X射線元素分析[2]。目前市場(chǎng)上雙束在電子束找到失效點(diǎn),能精確定位,離子束進(jìn)行切割,電子束實(shí)時(shí)進(jìn)行觀察,不僅能得到失效點(diǎn)的清晰圖形,而且大大節(jié)約了時(shí)間。圖3(a)為某集成電路失效器件表面形貌,制備的薄膜表面出現(xiàn)鼓包現(xiàn)象(箭頭所指區(qū)域)。表3(b)為(a)圖所指區(qū)域經(jīng)過(guò)FIB截面加工后的形貌。可以看出,薄膜制備工藝存在空洞缺陷。
2.2 TEM樣品制備
就目前半導(dǎo)體行業(yè)集成電路TEM樣品制備技術(shù)而言,主要有以下兩類:其一,機(jī)械研磨拋光。需要分析的塊體材料樣品先后通過(guò)機(jī)械研磨拋光、離子減薄技術(shù),獲取所需觀察區(qū)域,從而在透射電鏡下進(jìn)行材料分析。相關(guān)研究已發(fā)表較多的學(xué)術(shù)論文。但此加工技術(shù)有其局限性,主要表現(xiàn)在:樣品表面易受到污染;制備技術(shù)重復(fù)率低,對(duì)于脆性材料的加工難于進(jìn)行;制備納米級(jí)厚度的材料顯得無(wú)能為力;耗費(fèi)時(shí)間較多。其二,聚焦離子束截面加工技術(shù)[3-5]。
與傳統(tǒng)的機(jī)械研磨加工技術(shù)相比,F(xiàn)IB截面加工技術(shù)有無(wú)可比擬的優(yōu)點(diǎn),表現(xiàn)在:①樣品表面一般不易受到污染。傳統(tǒng)的機(jī)械研磨拋光技術(shù)在制備TEM樣品時(shí),由于研磨過(guò)程中顆粒鑲嵌等問(wèn)題,在后續(xù)的清洗工藝中也難于全部去除,制備的樣品通常會(huì)受到污染;②制備的樣品重復(fù)高,尤其對(duì)于脆性材料能夠順利加工;③在工藝合適的前提下,能夠制備納米級(jí)厚度的材料進(jìn)行分析,對(duì)于某些表面敏感的樣品能夠做到“零損傷”;④整個(gè)樣品制備過(guò)程較為省時(shí)。一般對(duì)于加工一個(gè) 10 μm寬度的透射電鏡樣品,用雙束聚焦離子束修補(bǔ)系統(tǒng)一般來(lái)說(shuō)1~2 h既能完成,其樣品厚度能夠達(dá)到幾十納米,而采用機(jī)械研磨拋光技術(shù)制備的器件最低要10~12 h;⑤對(duì)于一些加工界面的樣品(如非金屬和金屬界面、不同的金屬之間的界面),傳統(tǒng)方法難于加工。表現(xiàn)在:傳統(tǒng)方法制備的器件表面厚度一致性較差,通常出現(xiàn)在被加工器件一側(cè)較薄而另一側(cè)較厚,甚至?xí)?dǎo)致界面的開(kāi)裂,使分析工作難于進(jìn)行。但是運(yùn)用聚焦離子束已經(jīng)專業(yè)的加工模式,能很好的解決上述問(wèn)題[6,7]。
采用FIB加工技術(shù)制備TEM樣品中,較高的離子束能量會(huì)造成器件被加工部位的非晶化,合理選擇加工工藝能夠最大限度地減小非晶化。本文以Si為例,探索了30 kV、5 kV、2 kV條件下加工的樣品TEM形貌,如圖4所示。

圖3 FIB截面加工圖像
聚焦離子束的制備樣品采用一般是30 kV加工到100 nm左右的薄片,然后再用低電壓進(jìn)行減薄,以降低高電壓的離子束對(duì)樣品的損失。2 kV的離子束加工后對(duì)樣品的非晶損傷可降低到1~2 nm,便于觀察分析。非晶化層形成的原因是:離子注入單晶半導(dǎo)體的表面,深入幾個(gè)、幾十個(gè)原子層的距離后與單晶原子發(fā)生碰撞,把原子撞擊出點(diǎn)陣位置,在點(diǎn)陣位置產(chǎn)生一個(gè)空位,被擠出的原子停留在晶格之間,形成一個(gè)間隙原子。空位—間隙原子不斷積累起來(lái),形成可觀察到的晶格損傷。相關(guān)研究表明,當(dāng)點(diǎn)缺陷密度達(dá)到1022/ cm3時(shí),原先的單晶變成非晶態(tài)[6]。
2.3 納米器件加工
納米器件制作工藝最為關(guān)鍵的因素是納米尺度材料的加工,目前主要有聚焦離子束和電子束曝光技術(shù),等。最小圖形尺寸已經(jīng)達(dá)到10 nm,甚至更小。利用這些技術(shù)可以比較容易地加工獲得納米量級(jí)的微細(xì)結(jié)構(gòu)。
采用FIB技術(shù)進(jìn)行納米器件加工,利用的是離子質(zhì)量較大的功能,加速聚焦后的離子轟擊材料表面會(huì)發(fā)生濺射,采用逐點(diǎn)掃描的方式對(duì)材料微區(qū)表面進(jìn)行刻蝕加工。被加工材料的刻蝕深度由離子束流大小、刻蝕面積和刻蝕時(shí)間等參數(shù)決定,而刻蝕的形狀由離子束的掃描范圍所決定。
采用FIB技術(shù)進(jìn)行周期性微納米器件結(jié)構(gòu)加工,目前主要有兩種加工方案:一種是通過(guò)改變束斑與束斑之間的重疊度,使能量在空間具有周期性的不均勻分布,從而制備出規(guī)則的納米結(jié);另一種是通過(guò)引入位圖圖形,對(duì)加工過(guò)程進(jìn)行控制,從而得到與位圖相同的結(jié)構(gòu)[1]。后種方法的原理是圖形的顏色與離子束斑在每一掃描點(diǎn)的駐留時(shí)間存在對(duì)應(yīng)關(guān)系,即不同顏色的區(qū)域有不同的離子劑量(刻蝕深度),實(shí)現(xiàn)器件能夠較好加工的目的。此外,在FIB設(shè)備中引入位圖,還可以在材料表面加工出任意形狀的結(jié)構(gòu)。圖5為采用FIB加工技術(shù)沉積Pt點(diǎn)陣圖形,沉積的Pt表面較為平整。
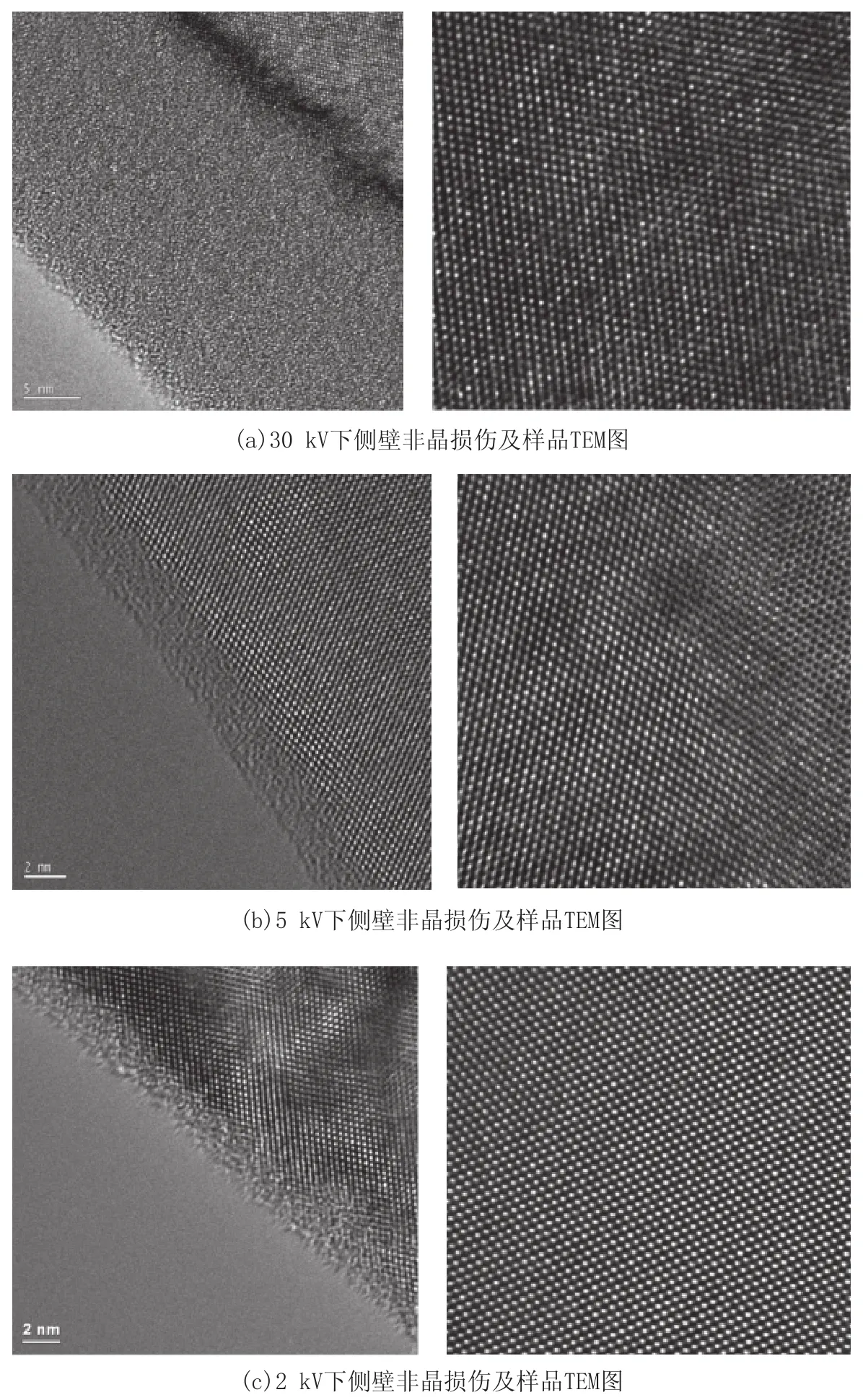
圖4 不同工作電壓下Si表面圖像

圖5 離子束沉積的Pt點(diǎn)陣
3 結(jié)論
本文以航天型號(hào)工程用元器件可靠性為重點(diǎn),介紹了雙束FIB在失效分析、TEM制樣以及新型納米器件加工中的應(yīng)用,得出以下結(jié)論:
1)FIB技術(shù)能夠?qū)崿F(xiàn)失效樣品的原位觀察,通過(guò)截面加工獲得的圖像獲取相關(guān)信息,定位精確、減少時(shí)間且不會(huì)引入新的失效模式;
2)FIB技術(shù)能夠進(jìn)行TEM制樣,相對(duì)于傳統(tǒng)制樣技術(shù)具有較大優(yōu)勢(shì),是材料微分析領(lǐng)域中不可缺少的分析技術(shù);
3)FIB技術(shù)能夠進(jìn)行納米器件加工,是微加工領(lǐng)域的一種新型技術(shù)。
參考文獻(xiàn):
[1]錢海霞. 微米/納米加工中的聚焦離子束技術(shù)[J]. 廣東化工, 2009, 36(7):84-86.
[2]陳雷明,李培剛,符秀麗,等. FIB快速加工納米孔點(diǎn)陣的新方法[J].物理學(xué)報(bào), 2005,54(2):582-586.
[3]李明,段淑卿,郭強(qiáng),等. TEM樣品制備輔助研究介質(zhì)層可靠性失效機(jī)理[J]. 半導(dǎo)體技術(shù), 2009, 34(5):498-501.
[4]張啟華,趙燕麗,高強(qiáng),等. “楔形”TEM樣品的機(jī)械研磨制備技術(shù)[J]. 半導(dǎo)體技術(shù), 2010, 35(3):248-251.
[5]戴嘉維,孔明. 薄膜截面的TEM樣制備[J]. 理化檢驗(yàn), 2006, 42(5):239-241.
[6]徐星亮. 聚焦離子束刻蝕誘導(dǎo)液滴形成及其遷移[D]. 成都:電子科技大學(xué), 2014.
[7]王貞. 對(duì)TEM原理及應(yīng)用的研究[D]. 天津:天津大學(xué), 2010.
[8]褚維群,郭煒. TEM樣品制備中離子束對(duì)樣品的損傷分析[J]. 計(jì)算機(jī)技術(shù)與發(fā)展, 2008,18(2):223-225.
中圖分類號(hào):V461
文獻(xiàn)標(biāo)識(shí)碼:B
文章編號(hào):1004-7204(2016)02-0026-05
作者簡(jiǎn)介:
曹德峰,男,碩士研究生學(xué)歷,工程師,上海微小衛(wèi)星工程中心元器件可靠性中心工作,主要從事航天型號(hào)元器件失效分析工作。
Application of Focused Ion Beam Processing Technology in Reliability Field
CUI Shuai1,2, CAO De-feng1,2, LI Zhi-yong1,2, CHEN Bin1,2
(1. Shanghai Engineering Center for Microsatellites, Shanghai 201203; 2. Key laboratory for Microsatellites, Shanghai 201203)
Abstract:By cross-section machining technique, partial failure components were observed using Focused Ion Beam, some of the relevant information was obtained. As an indispensable analytical technique, it can carry out micro-analysis of material, Transmission Electron Microscope sample preparation and fabricate nano-devices. As a new technology, it has little damage to the sample and be useful in micromachining field. The reliability quality assurance technology of aerospace model components has some certain guiding significance.
Key words:focused ion beam; construct analysis; failure analysis; transmission electron microscope

