Ga N薄膜外延過程的動力學蒙特卡洛仿真
馮蘭勝,過潤秋,張進成
(1.西安電子科技大學機電工程學院,陜西西安 710071; 2.西安電子科技大學微電子學院,陜西西安 710071)
Ga N薄膜外延過程的動力學蒙特卡洛仿真
馮蘭勝1,過潤秋1,張進成2
(1.西安電子科技大學機電工程學院,陜西西安 710071; 2.西安電子科技大學微電子學院,陜西西安 710071)
為更好研究GaN材料的生長機理,提出了一種在金屬有機物化學氣相淀積系統中生長GaN的化學反應生長模型,并結合動力學蒙特卡羅方法模擬了垂直噴淋式金屬有機物化學氣相淀積系統中GaN的生長過程.模擬結果表明,在垂直噴淋式金屬有機物化學氣相淀積系統中生長GaN時,首先發生加合反應,隨著反應物逐步接近高溫襯底,再轉變為熱解反應,最終生成GaN.GaN的生長速率隨溫度的升高而升高,而襯底的表面溫度均勻性會直接影響最終材料的表面形貌.文中還在動力學蒙特卡羅方法中模擬了反應粒子在襯底表面的擴散和脫附過程,這些過程均主要受溫度的影響,并影響材料的表面形貌和生長速率.
Ga N;動力學蒙特卡羅;反應模型;反應動力學
Ga N是重要的寬帶隙半導體材料,在光電器件、高功率器件等眾多領域有著廣泛的應用.金屬有機物化學氣相淀積(Metal Organic Chemical Vapor Deposition,MOCVD)方法是制備GaN材料的主要手段之一.為提高GaN的材料質量,國內外很多學者針對MOCVD生長GaN材料的生長動力學過程進行了大量研究.文獻[1-2]中的fluent軟件對垂直噴淋式MOCVD中生長Ga N的氣體流動、表面反應過程、襯底溫度分布以及生長速率進行了模擬;文獻[3-5]使用分子動力學方法、離散傅里葉變換(Discrete Fourier Transform,DFT)等方法在分子運動層面分析了Ga N生長過程;文獻[6-9]對Ga N生長過程中的化學反應路徑和反應過程進行了分析,并使用fluent方法或者動力學蒙特卡羅(Kinetic Monte Carlo,KMC)方法進行了分子層面的模擬.目前,對于GaN生長過程的模擬主要分為宏觀參數模擬和微觀分子運動模擬兩大類.宏觀參數模擬主要用來模擬反應過程中反應物的氣體流動、化學反應濃度分布等過程;微觀分組運動模擬主要用來模擬分子在襯底表面的吸附、擴散、脫附等過程.筆者在前人化學反應模型的基礎上,提出了一種簡化的專門針對垂直噴淋式MOCVD系統生長GaN的化學反應模型,使用KMC方法模擬GaN化學反應過程,同時包含了分子在襯底表面的擴散和脫附過程,對Ga N分子的運動及變化過程進行了仿真.
1 化學生長模型
Ga N生長過程中的實際化學反應過程非常復雜,目前很難通過實驗確定其詳細的化學反應過程及相關參數.因此,筆者提出了一種簡化的化學反應模型,忽略掉復雜的過渡反應細節,突出關鍵反應步驟,比較完整地復現了GaN生長中各種反應物質的主要變化過程,同時保證了模擬的準確性和快速性.Ga N在MOCVD中的化學反應過程因具體反應條件而有所不同,大體可分為加合反應過程和熱解反應過程.
1.1加合反應
三甲基鎵和氨氣混合后,在常溫下可發生加合反應生成加合物,主要產物為Ga(CH3)3∶NH3,該反應為可逆反應,Ga(CH3)3∶NH3將進一步生成Ga(CH3)2NH2.實測表明,Ga(CH3)3∶NH3彼此結合進一步形成環狀物的可能性很小.因此,在文中的反應模型中,加合反應主要生成物為Ga(CH3)2NH2和Ga (CH3)3∶NH3.
1.2熱解反應
在溫度升高到500℃以上時,三甲基鎵會逐步釋放甲基.首先,高溫TMGa(Ga(CH3)3)首先釋放一個甲基生成DMGa(二甲基鎵Ga(CH3)2),而后繼續釋放甲基形成MMGa(單甲基鎵GaCH3).由于DMGa釋放甲基生成MMGa的活化能相較于TMGa生成DMGa的活化能小得多,所以只要反應溫度能夠使TMGa熱解成DMGa時,基本上DMGa都會熱解為MMGa.因此,隨著溫度的升高,主要生成Ga N的反應物為MMGa.在垂直式MOCVD中,在襯底上方有一個高溫過渡層,因此,在過渡層中形成的主要反應物為MMGa,此時主要的反應過程應為熱解反應.
文中所涉及的MOCVD設備為西安電子科技大學自行研制的120型MOCVD.該反應室為垂直噴淋式,其模型如圖1所示.
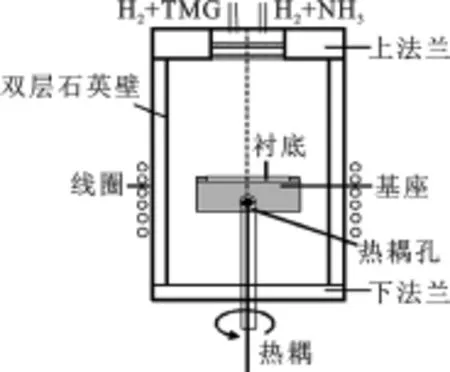
圖1 120型MOCVD反應室結構圖
在反應物剛剛進入反應室的階段時,溫度較低,因此,在材料生長過程中首先進行的是加合反應,而后隨著反應物逐漸接近高溫襯底,又開始出現熱解反應.根據以上過程,文中所采用的化學反應模型如表1所示.
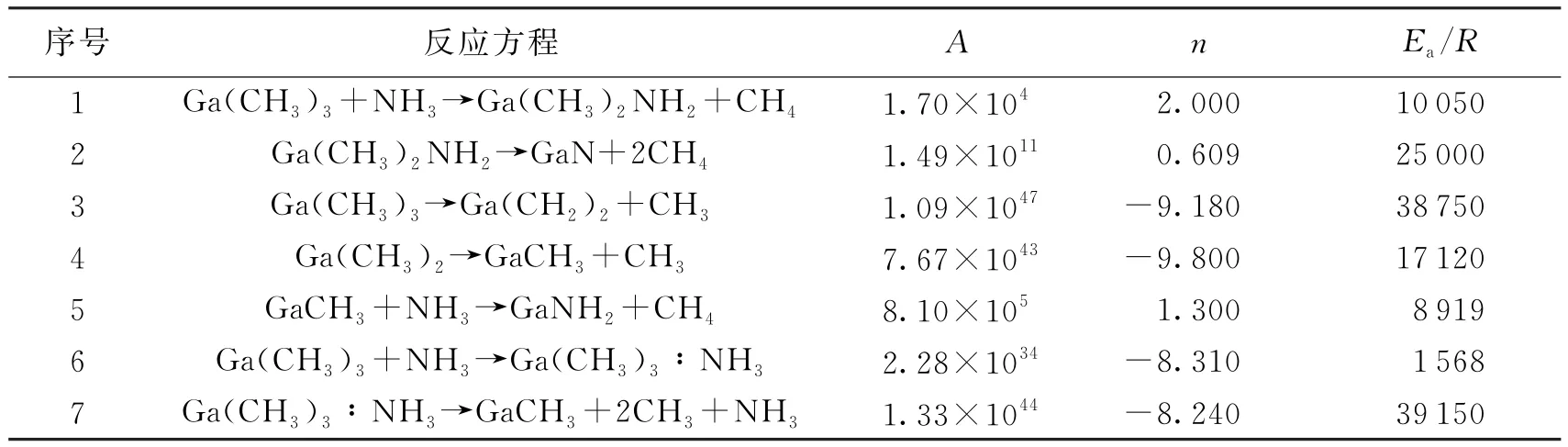
表1 GaN化學反應列表
表1中每種化學反應的反應速率均遵循Arrhenius公式:k=ATnexp(-Ea/(RT)),指前系數A在反應2,3,4,7中的單位為cm3/(mol·s),在反應1,5,6中的單位為s-1;n為溫度指數;Ea為反應發生所需要的活化能,單位為kcal/mol;R為理想氣體常數.模擬中所有化學反應所涉及的反應分子在未固化到襯底材料內之前均為氣態,所有反應在氣態下完成.
2 模型的模擬驗證
MOCVD材料生長過程的數值模擬有多種方法,KMC方法將微觀粒子動力學和基于隨機統計過程的蒙特卡羅方法相結合,可在一定的時間范圍和空間范圍對材料生長過程中的各種微觀粒子行為進行模擬,并獲取最終生成材料的相關數值特征,是一種重要的材料生長模擬方法.
文中所模擬的材料生長過程主要包括各種反應物到達襯底表面發生的各種化學反應過程以及在表面進行熱擴散、脫附反應物的物理運動過程.
熱擴散是反應粒子在吸附到襯底表面后不斷在表面發生遷移的過程,是材料生長中的一個重要過程.在材料生長過程中,反應粒子(包括在化學反應模型中反應生成的各種粒子)首先吸附到襯底表面,然后在襯底表面不斷遷移,并不斷反應生成最終的材料或者遷移出襯底隨尾氣排出反應室.反應粒子的熱擴散與反應粒子所在位置的襯底粒子類型、襯底形貌、襯底溫度有關.熱擴散與溫度的關系可表示為

其中,Es表示發生擴散前后系統的能量差,T1為反應溫度.
當前粒子所在位置的襯底形貌決定了粒子發生擴散的概率和擴散方向.首先根據當前位置形貌和可能擴散到的最終位置形貌判斷在每個方向發生擴散所需要的能量差,再按照概率確定擴散方向.
粒子的脫附是反應粒子離開襯底表面并隨載氣排出反應室的過程,脫附速率可表示為

其中,Ea表示粒子在襯底表面的吸附能,一般情況下,Es=(1/6~ 1/2)Ea;T2為反應溫度.
當前粒子所在位置的襯底粒子類型決定了當前所有可以發生的化學反應列表.在模擬的每一步,根據當前離子所在位置的襯底粒子類型,為當前所模擬的粒子建立一張所有可以發生的化學反應列表.當前可以發生的化學反應為N項,列表中的每一種反應都有一定的發生概率,選擇其最終發生哪一種化學反應的方法是,首先按照均勻分布的原則隨機產生一個在(0.0,1.0)范圍內的隨機數m;而后,再根據

選擇化學反應表格中的第n項反應作為當前粒子要發生的反應,反應后更新系統狀態,重新進行下一步模擬,直到粒子最終固化到襯底上或者擴散出模擬區域為止.式(3)中每個化學反應模型的反應速率k均遵循Arrhenius公式,即

其中,R為理想氣體常數,T3為反應溫度.
模擬過程中,假設襯底范圍為100×100的矩形晶格平面區域,以映射襯底的整體表面晶格面積.同時根據實際生長過程中反應物流量對比關系,設置進入反應室的NH3與TMGa的比例為2 000∶1,并假設NH3和TMGa都能均勻地到達模擬的襯底區域上方參加材料的生長.首先,建立單個反應粒子從進入反應室開始,直到在襯底發生反應生成材料或者排出反應室外的整個過程;然后,根據粒子流量比進行大量粒子行為的統計計算;最后,形成一定流量下的反應過程模擬.
任一單個粒子的模擬過程如圖2所示.

圖2 KMC模擬流程圖
文中根據提出的化學反應模型以及KMC模擬流程圖,開發出基于KMC方法的GaN生長過程模擬軟件,對西安電子科技大學120型MOCVD生長GaN材料過程進行模擬.
3 模擬結果與討論
3.1溫度與化學反應過程的關系
首先在不同的反應溫度下對所建立的化學反應模型進行模擬.結果表明,在低溫時主要發生聚合反應,在低于500℃的范圍內,生長速率很低,這主要是由于最終生成GaN的化學反應在這個溫度范圍內很難發生,此時基本不發生熱解反應,產生的物質主要為聚合物.隨著溫度的升高,熱解反應在所有化學反應中的比重明顯升高,GaN的生成速率加快,模擬出的生長速率的最高值出現在1 100℃處.隨著溫度的進一步升高,襯底表面發生的脫附運動明顯上升,導致生長速率有所下降.圖3為GaN生長速率與生長溫度的關系曲線.圖3中橫坐標為襯底溫度,縱坐標單位為每秒淀積的原子層數(ML).

圖3 生長速率與生長溫度的關系曲線
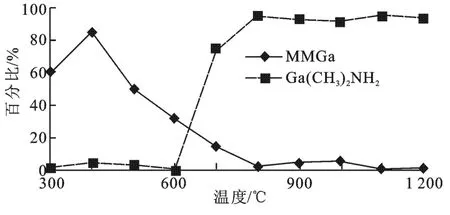
圖4 MOCVD系統中MMGa和Ga(CH3)2NH2濃度與溫度的對應關系
在KMC的模擬過程中,可對模擬的每一個粒子的最終狀態進行記錄,包括其最終是否淀積在襯底表面或者通過脫附排出反應室,未脫附的情況下通過一系列化學反應所形成的粒子種類,最終淀積的坐標位置等信息.通過對淀積在襯底上的粒子類型進行統計,發現在襯底溫度逐漸升高的過程中,MMG(Ga(CH3))的比重逐漸升高,而Ga(CH3)2NH2和Ga(CH3)3∶NH3的比重逐漸降低,表明在低溫時,加合反應占主要地位,而在高溫時,熱解反應占主要地位.圖4為MMGa和Ga(CH3)2NH2的濃度隨溫度的變化結果.
3.2表面形貌的模擬結果
文中所描述的GaN材料表面形貌主要是通過對模擬區域內所有淀積在襯底上的粒子進行統計,得出在不同坐標處的生長高度,從而模擬出各個坐標處GaN生長材料的生長厚度.
由于實際的MOCVD系統中襯底表面溫度并非完全均勻,而實際的襯底表面溫度分布很難準確測得,而溫度對生長速率又有很大影響,因此,根據實際襯底溫度分布規律,假設襯底表面的溫度分布曲線,如圖5(a)中所示.在此前提下使用KMC進行模擬.模擬結果表明,在溫度較高的區域,GaN的生長速率在溫度低的區域生長快,如圖5(b)中所示.在反應物充足的前提下,材料的厚度隨溫度的升高而變大.而曲線中的極值點可能是由于仿真過程中統計的隨機分子數量不足所致.但整體上累積的分子數量是與溫度成正比的.襯底表面溫度的一致性是保證Ga N材料生長厚度一致性的重要前提.

圖5 GaN生長厚度在非均勻襯底溫度下的分布
4 結束語
筆者提出了一個簡化的GaN生長過程的化學反應模型,并使用KMC方法對GaN生長過程中的化學反應過程、擴散過程和脫附過程進行了模擬.模擬結果表明,在所涉及的120型垂直噴淋式MOCVD系統生長Ga N的過程中,反應氣體進入到反應室內部后,隨著溫度的逐漸升高,首先會發生加合反應生成聚合物,而后發生熱解反應產生MMGa,最終在襯底表面生成GaN.GaN的生長速率隨著溫度的升高而升高.同時,在襯底上進行反應的同時,還伴隨著反應粒子的擴散和脫附過程.通過KMC方法,模擬得到了在該模型下Ga N生長過程中各種反應物粒子的變化過程和分布規律,為進一步的研究打下了基礎.
[1]TSENG C F,YEN T.Transport Phenomena and the Effects of Reactor Geometry for Epitaxial Ga N Growth in a Vertical MOCVD Reactor[J].Journal of Crystal Growth,2015,432:54-63.
[2]ZHANG Z,FANG H S.Influencing Factors of GaN Growth Uniformity Through Orthogonal Test Analysis[J].Applied Thermal Engineering,2015,91:53-61.
[3]ZHOU A,XIU X Q.Effect of Lattice Defects on the Property of GaN Crystal:Amolecular Dynamics Simulation Study [DB/OL].[2015-10-10].http://www.sciencedirect.com/science/article/pii/S0749603615302445.
[4]KEMPISTY P,STRAK P.DFT Study of Ammonia Desorption from the GaN(0001)Surface Covered with NH3/NH2Mixture[J].Journal of Crystal Growth,2014,403:105-109.
[5]TOKOI H.Development of GaN Growth Reaction Model Using Ab Initio Molecular Orbital Calculation and Computational Fluid Dynamics of Metalorganic Vapor-phase Epitaxy[J].Journal of the Electrochemical Society,2012,159(5):270-275.
[6]于海群.GaN沉積的化學反應動力學進展[J].材料導報A:綜述篇,2012,26(9):21-24. YU Haiqun.The Progress of Chemical Reaction Kinetics with GaN Deposition[J].Materials Review A:Review Article,2012,26(9):21-24.
[7]王國斌,張永紅,王懷兵.氮化鎵生長反應模型與數值模擬研究[J].人工晶體學報,2010,139(S1):160-163. WANG Guobin,ZHANG Yonghong,WANG Huaibing.Reaction Model and Numerical Simulation of Gallium Nitride Growth[J].Journal of Synthetic Crystals,2010,139(S1):160-163.
[8]PARIKH R P,ADOMAITIS R A.An Overview of Gallium Nitride Growth Chemistry and Its Effect on Reactor Design: Application to a Planetary Radial-flow CVD System[J].Journal of Crystal Growth,2006,286(2006):259-278.
[9]FU K,FU Y,HAN P.Kinetic Monte Carlo Study of Metal Organic Chemical Vapor Deposition Growth Dynamics of GaN Thin Film at Microscopic Level[DB/OL].[2015-10-11].http://dx.doi.org/10.1063/1.2927389.
(編輯:齊淑娟)
簡 訊
2016年度“高等學校學科創新引智計劃”(簡稱“111計劃”)新建基地評審工作結束.我校申報的“移動互聯網安全創新引智基地”獲批立項.該引智基地依托密碼學國家重點學科及網絡與系統安全陜西省重點實驗室,密切關注移動互聯網安全領域的國際發展動態,結合國家中長期科技發展的需要,以“移動互聯網安全”為主方向,重點在密碼及安全協議理論、無線網絡安全以及云計算安全理論與方法等領域進行基礎理論、關鍵技術和應用研發等合作研究工作.截止目前,我校共有五個“111計劃”學科創新引智基地,分別為:智能信息處理科學與技術學科創新引智基地、現代無線信息網絡基礎理論與技術學科創新引智基地、寬禁帶半導體與微納電子學創新引智基地、電子裝備機電耦合理論與關鍵技術學科創新引智基地、移動互聯網安全創新引智基地.
摘自《西電科大報》2015.12.12
Kinetic Monte Carlo simulation of GaN epitaxy
FENG Lansheng1,GUO Runqiu1,ZHANG Jincheng2
(1.School of Mechano-electronic Engineering,Xidian Univ.,Xi’an 710071,China; 2.School of Microelectronics,Xidian Univ.,Xi’an 710071,China)
A chemical reaction mode about GaN epitaxy in MOCVD is presented.We simulate the growth process of Ga N in the vertical-spray MOCVD system on this mode using the KMC mothod.The result shows that adductive reaction mostly occurs at a lower temperature and pyrolytic reaction mostly occurs at a high temperature.And the growth rate increases with increasing temperature.This feature determines the surface morphology of the material.We also include the diffusion and desorption process of the reaction particle by the KMC method.These processes depend mostly on temperature and ultimately affect the surface morphology of the GaN material.
Ga N;kinetic Monte Carlo(KMC);reaction model;reaction kinetics
TN204
A
1001-2400(2016)03-0167-05
10.3969/j.issn.1001-2400.2016.03.029
2015-11-11
國家自然科學基金資助項目(61334002);國家重大科技專項資金資助項目(2011ZX01002-001)
馮蘭勝(1978-),男,講師,西安電子科技大學博士研究生,E-mail:fenglansheng001@163.com.

