反射式變摻雜負電子親和勢GaN光電陰極量子效率研究?
喬建良徐源 高有堂 牛軍 常本康
1)(南陽理工學院電子與電氣工程學院,南陽 473004)
2)(南京理工大學電子工程與光電技術學院,南京 210094)
(2016年10月8日收到;2016年11月23日收到修改稿)
反射式變摻雜負電子親和勢GaN光電陰極量子效率研究?
喬建良1)?徐源2)高有堂1)牛軍1)常本康2)
1)(南陽理工學院電子與電氣工程學院,南陽 473004)
2)(南京理工大學電子工程與光電技術學院,南京 210094)
(2016年10月8日收到;2016年11月23日收到修改稿)
從變摻雜負電子親和勢(NEA)GaN光電陰極材料的光電發射機理入手,給出了反射式變摻雜NEA GaN光電陰極內建電場和量子效率的計算公式.利用初步設計的變摻雜NEA GaN光電陰極,介紹了變摻雜NEA GaN陰極的激活過程和激活光電流的變化特點.結合國內外典型的變摻雜NEA GaN陰極的量子效率曲線,分析了GaN光電陰極量子效率曲線的特點.結果顯示:由于內建電場的存在,反射式變摻雜NEA GaN光電陰極量子效率在240 nm處即可達到56%,在較寬的入射光波長范圍內,陰極具有相對平穩的量子效率,量子效率值隨入射光子能量的增加而增加,并且量子效率曲線在閾值附近表現出了明顯的銳截止特性.
GaN,光電陰極,變摻雜,量子效率
1 引 言
近年來,隨著GaN晶體生長技術的不斷突破,作為第三代半導體材料的典型代表,GaN在白光照明、紫外探測、真空電子源等領域的應用越來越廣泛.相比較傳統的紫外光電陰極如CsI和CsTe光電陰極,GaN光電陰極具有更加寬泛平穩的紫外光譜響應特性,加上靈敏度高、暗電流小、響應波段可通過加入A l或In調節等優點,新型紫外GaN光電陰極引起了越來越多的關注[1?4].
負電子親和勢(NEA)光電陰極的量子效率受到材料本身性能和制備技術等多方面的影響,在材料生長水平的限制下,為進一步提高陰極量子效率,變摻雜技術應運而生,并成功應用于GaAs光電陰極.相對于均勻摻雜,采用變摻雜技術使得陰極在量子效率上取得了明顯突破[5,6].在變摻雜GaAs光電陰極研究的基礎上,近年來我們探索將變摻雜技術應用到GaN光電陰極上,也取得了不錯的效果[7].
針對NEA光電陰極的變摻雜技術,由于研究時間較短,變摻雜材料的光電發射機理、激活工藝、表面模型、穩定性等理論仍然亟待完善.針對不同陰極材料,陰極結構設計、摻雜方式、摻雜濃度等關鍵因素仍需繼續研究優化.在這樣的背景下,本文針對反射式變摻雜GaN光電陰極,研究了變摻雜GaN光電陰極的內建電場、光電發射機理以及量子效率特性,為下一步深入研究采用變摻雜技術的NEA GaN光電陰極奠定了基礎.
2 變摻雜NEA GaN光電陰極的內建電場
對NEA光電陰極材料,變摻雜技術可以在材料體內形成內建電場,內建電場促進光生電子的輸運,進而提高電子逸出概率,最終陰極的量子效率相應地得到提高.因此,變摻雜技術對陰極性能的貢獻本質上在于內建電場.
對NEA GaN變摻雜陰極材料,采取體內p型摻雜濃度高、表面摻雜濃度依次降低的方式,使材料的摻雜濃度從體內到表面形成依次降低的梯度變化.圖1給出了一種變摻雜NEA GaN陰極材料的能帶結構示意圖,圖中Eg為陰極材料的禁帶寬度,EV為價帶頂,EC為導帶底,EF為費米能級, Evac為真空能級.能帶結構示意圖給出的是四層梯度變摻雜結構,從體內到表面的摻雜濃度依次為NA1,NA2,NA3和NA4.層間過渡區域的厚度依次為d1,d2和d3.

圖1 變摻雜NEA GaN陰極材料能帶結構示意圖Fig.1.The energy band structu re for varied dop ing NEA GaN photocathode.
由圖1可見,變摻雜NEA GaN陰極材料的能帶不僅有與均勻摻雜類似的表面附近向下彎曲的現象,而且相對于均勻摻雜結構具有能帶由體內向表面整體發生向下彎曲的現象.即在不同摻雜濃度區域的界面處,能帶也產生了向下的彎曲現象[8,9].這是由于在各個界面處費米能級的拉平效應所致.
變摻雜技術優化了陰極材料的能帶結構,其對陰極性能的貢獻本質上在于體內產生的內建電場.向下彎曲的能帶結構在材料內部形成一個電場,在光電子由材料體內向表面的輸運過程中,內建電場起促進作用.所以對變摻雜光電陰極,光電子將以擴散加漂移的運動模式進行輸運,這樣可使更多的光電子輸運至光電陰極表面附近,從而使光電子的逸出概率增到極限值,最終帶來變摻雜光電陰極量子效率的提高.
如圖1所示,因激活時銫、氧的覆蓋形成了兩個表面勢壘即勢壘I、勢壘II,材料價帶中的電子在紫外光的激發下,獲得足夠的能量躍遷到導帶,在內建電場的作用下通過擴散運動和漂移運動向陰極表面輸運,到達表面附近的電子通過隧道效應隧穿表面勢壘,由于負電子親和勢特性,隧穿表面勢壘的電子可以比較容易地逸出到真空,完成了光電發射過程.
一般地,設EF為p型陰極材料的費米能級, EV為p型陰極材料的價帶能級,NA為p型陰極材料的摻雜濃度,NV為陰極材料的價帶有效狀態密度,則室溫下p型光電陰極材料的費米能級與其p型摻雜濃度的關系如(1)式所示:

式中k0為玻爾茲曼常數,T是絕對溫度.
在變摻雜NEA GaN光電陰極中,在體內由于存在p型摻雜濃度的變化,從材料體內向表面能帶形成了一個向下彎曲的彎曲量.如圖1所示,設摻雜濃度NA1和NA2之間的濃度過渡區域的厚度為d1,因為摻雜濃度NA1>NA2,可以得到該處因摻雜濃度差引起的能帶彎曲量的大小ΔE,如(2)式所示:

進一步得到采用梯度變摻雜技術在該濃度變化區域的兩端產生的電勢差VD,如(3)式所示:

因該區域的厚度為d1,則其平均電場強度E如(4)式所示:

由(4)式可知,在梯度變摻雜NEA GaN光電陰極體內的各個濃度變化界面處,都會形成一個電場,電場強度的大小由該區域的寬度和兩個相鄰區域的摻雜濃度決定.
需要說明的是,p型GaN晶體的生長技術曾是困擾業界的難題,一般地,GaN晶體樣品有效的空穴載流子濃度比理論設計的p型摻雜濃度要低,即(4)式中摻雜濃度NA1和NA2的實際值要比最初設計的小些,這會影響到平均電場強度E的大小,具體量化計算時應該考慮.
根據現有的材料生長技術水平,合理設置層數和各層p型摻雜濃度,就能夠得到比較理想的內建電場.理論上若采用指數變摻雜技術,可得到一個勻強內建電場[10].總的來說陰極材料從體內到表面由于摻雜濃度的變化,會形成一個對光電子輸運起促進作用的內建電場,內建電場的方向由材料表面指向材料體內,體內產生的光電子運動到該區域時,其向表面的運動就會被電場加速,光電子在原有的擴散作用與內建電場的加速作用下向材料表面輸運.
3 反射式變摻雜NEA GaN光電陰極量子效率公式
在多數紫外探測領域,紫外光的幅度一般處于微弱級別,所以用于該領域的GaN光電陰極就要具備較高的光譜靈敏度.GaN陰極光譜靈敏度S(λ)一般指單色紫外光照射下每單位輻射功率(1W)陰極所產生的光電流,陰極的光譜響應曲線就是由紫外響應波段內特定波長單色紫外光對應的光譜靈敏度構成.一般地,實際測量時GaN陰極的光譜響應常用量子效率Y(λ)來表示,量子效率表示單位入射光子產生的光電子數,量子效率Y(λ)與光譜靈敏度S(λ)的關系表示為[11,12]

其中普朗克常數h=6.626068×10?34J·s,光速c= 3×108m/s,電子電荷量e=1.6021892×10?19C,光譜靈敏度S(λ)單位采用m A/W,入射光子的波長λ以nm為單位.實際測量時,可以通過測量紫外光的輻射功率、光電流得到陰極光譜靈敏度,再由(5)式計算出陰極的量子效率.
設n1(x)是陰極材料發射層中產生的電子濃度,x是材料發射層內某點到陰極表面的距離,Dn是電子擴散系數,μ是材料內的電子遷移率,LD是電子擴散長度,τ1是少數載流子壽命,Te是陰極發射層厚度,I0是入射光強度,α1是陰極材料對入射光的吸收系數,R是陰極對入射光的反射率.對變摻雜NEA GaN光電陰極,考慮到材料內部的內建電場E,擴散漂移方程可表示為[10,13]

其中邊界條件為

邊界條件中SV是后界面復合速率,通過求解,可得反射式變摻雜NEA GaN光電陰極的量子效率公式如下:

式中

對均勻摻雜陰極材料,內建電場E為0,量子效率可表示為

如果SV=0且Te=∞,可簡化得到(10)式.

這與反射式均勻摻雜NEA GaN光電陰極的量子效率公式一致.
4 反射式變摻雜GaN光電陰極量子效率實驗
對于NEA光電陰極的激活,傳統“yo-yo”激活法采用的Cs源、O源交替斷續的激活工藝存在不便控制等缺點.實驗研究發現,激活過程中若保持Cs源一直處于開啟狀態,可使Cs在整個激活過程中處于過量狀態,可阻止O的過量對偶極層形成的影響,進而能提高陰極的穩定性.目前國內進行NEA光電陰極的激活常采用Cs源持續、O源斷續的方式進行.
實驗使用的p型變摻雜GaN光電陰極的摻雜元素為Mg,通過金屬氧化物化學氣相沉積外延生長得到,襯底采用藍寶石,A lN作為緩沖層,GaN發射層均分為4層,每層厚度為45 nm,總厚度為180 nm.從體內到表面p型摻雜濃度依次減小,分別為1×1018,4×1017,2×1017,6×1016cm?3.
利用NEA光電陰極激活與評估實驗系統對變摻雜GaN光電陰極樣品進行了激活實驗,激活采用氘燈作為光源,樣品表面光功率約為50μW,激活室真空度為1.6×10?7Pa.激活時使用的低逸出功材料為固態的Cs源和O源,引入時均有一個預熱過程,Cs源電流由小到大調整到約1.8 A時,產生明顯的光電流.激活光電流隨時間的變化情況如圖2所示,光電流曲線的整體變化情況與早期均勻摻雜GaN光電陰極激活情況基本一致.激活一開始,光電流隨著Cs的導入逐漸增長,到達極值,然后又有下降趨勢,Cs激活過程包括陰極表面偶極層的形成、偶極層的飽和等階段以及Cs過量時出現的“Cs中毒”現象.
在GaN光電陰極激活的Cs,O交替階段,將固態O源的電流從小逐漸增大到約1.55 A,光電流值又開始上升,光電流達到極大值時斷O,光電流繼續增大,導入O后經過幾個Cs源持續,O源斷續的循環后光電流幾乎不再增長,表明激活完成.實驗發現第一次的Cs/O循環,光電流增長明顯,隨后的Cs/O交替激活對光電流的貢獻較小.
激活后原位測試了變摻雜GaN光電陰極的光譜響應,得到的量子效率曲線如圖3所示.入射光波長在240—354 nm(對應光子能量5.17—3.5 eV)的范圍內,具有相對平坦的量子效率值,而且量子效率值隨光子能量的增加而增加,在5.17 eV(對應240 nm)處達到了測試的最大值56%,比同等條件下測得的均勻摻雜GaN陰極量子效率最大值37% (對應230 nm)提高了不少[14].

圖2 變摻雜NEA GaN光電陰極光電流曲線Fig.2.The photocurrent curve for varied dop ing NEA GaN photocathode.

圖3 變摻雜NEA GaN光電陰極量子效率曲線Fig.3.The curve of quantum effi ciency for varied dop ing NEA GaN photocathode.
激活后測得的量子效率與入射光能量及波長的對應關系見表1,由于實驗條件的限制,國內變摻雜陰極測試結果對應的波長下限值僅為240 nm.量子效率的提高歸因于變摻雜材料內部的內建電場,內建電場提高了輸運到陰極表面附近的電子的數量和能量,促使更多的電子逸出到真空.變摻雜GaN陰極的量子效率曲線在閾值3.4 eV處表現出明顯的銳截止特性.
加利福尼亞大學伯克利分校空間科學實驗室采用梯度摻雜方法制備了變摻雜GaN光電陰極,實驗樣品采用30 nm厚的A lN緩沖層,p型材料采用梯度摻雜,體內最高摻雜濃度大于1019cm?3.反射模式下得到的量子效率曲線如圖4所示,在120—350 nm的入射光波長范圍內,量子效率相對平穩,數值隨著入射光波長的減小而增大.量子效率在120 nm處高達80%,在130 nm處為70%,在350 nm處,尚有接近10%的量子效率,在閾值點365 nm附近,也表現出明顯的銳截止特性,閾值帶外響應很低,截至點約在380 nm處[15].通過對比表明,量子效率曲線的整體變化規律與國內測試結果符合得較好.

表1 變摻雜NEA GaN光電陰極量子效率與入射光能量及波長的對應關系Tab le 1.The correspond ing relationship of quantum effi ciency to the incident light energy and wavelength for varied dop ing NEA GaN photocathode.

圖4 加利福尼亞大學空間科學實驗室制備的變摻雜GaN光電陰極量子效率曲線Fig.4.The quantum effi ciency curve for varied doping GaN photocathode from University of California, Space Sciences Laboratory.
5 變摻雜GaN光電陰極量子效率特性討論
變摻雜GaN光電陰極量子效率的這種平穩特性是傳統紫外陰極如CsI,CsTe所不具備的,傳統的CsI,CsTe紫外陰極是基于正電子親和勢特性的,輸運到陰極表面的電子必須具有足夠大的能量,穿過較高的表面勢壘才能逸出到真空,這就從本質上限制了此類光電陰極的量子效率,量子效率不會太高,而且暗噪聲也比較大.CsI陰極量子效率極不平穩,CsTe陰極最高量子效率僅略大于10%.另一方面,材料本身的局限性如禁帶寬度等特性的限制,使得CsI陰極的響應波段在100—200 nm之間, CsTe陰極在120—300 nm之間,響應波段還不能像GaN光電陰極那樣方便調節.CsI,CsTe紫外光電陰極與GaN光電陰極量子效率的對比如圖5所示[16].
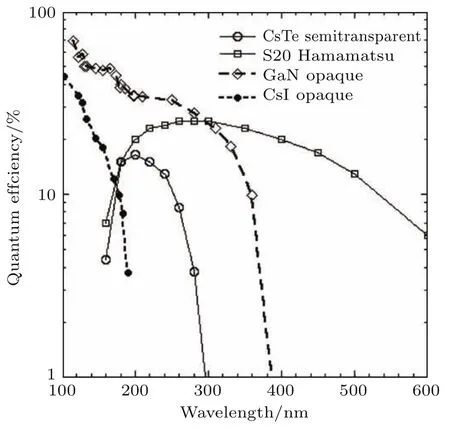
圖5 CsI,CsTe紫外光電陰極與GaN光電陰極量子效率比較Fig.5.The quantum effi ciency com parison between CsI,CsTe UV photocathode and GaN photocathode.
由圖3和圖4給出的變摻雜GaN光電陰極量子效率曲線可知,在GaN陰極響應的紫外波段約100—400 nm的范圍內,量子效率隨入射光波長的增大而減小.造成這種現象的主要原因有以下兩點.一是入射光中長波段對應光子的能量相對較小,與這部分入射光子對應的激發到導帶中的光電子數量較少,導帶中的光電子能量也較小,而光電子能否順利隧穿表面勢壘其能量起決定作用.這就造成了對應長波段入射光激發的光電子被輸運到表面并成功逸出的數量沒有短波段多,進而其對應的量子效率也較低.二是對于在反射模式下工作的陰極,入射光是從陰極前表面進入的,而陰極材料內部對光子的吸收深度隨入射光波長的增大而增大,即入射光波長越長,被吸收的光子越靠近遠離表面的后界面處,這里產生的一部分光電子要么被復合掉,要么在壽命期內無法到達表面附近,最終影響到長波段對應的電子表面逸出概率,造成量子效率的降低.
變摻雜GaN陰極的量子效率曲線顯示:在閾值3.4 eV處曲線表現出明顯的銳截止特性,即在350—380 nm區間內,量子效率曲線快速下降.這種特性印證了成功激活后變摻雜GaN陰極材料的負電子親和勢特性,原因如下:光子能量大于GaN禁帶寬度約3.4 eV的入射光子才有可能將價帶中電子激發到導帶,通過激活獲得的負電子親和勢特性可使導帶中產生的光電子比較容易地逸出表面,所以能量大于3.4 eV的入射光對應的量子效率明顯提高,而對能量低于3.4 eV的入射光,理論上外光電效應現象不會發生,對應的光電發射現象來源于其他因素.所以負電子親和勢特性可通過量子效率曲線的銳截止特性反映出來.
對變摻雜GaN光電陰極,上述量子效率曲線在3.4 eV的閾值處表現出的明顯的銳截止特性對提高紫外探測器的靈敏性、有效抑制虛警探測是至關重要的,這和均勻摻雜陰極是一致的,變摻雜技術的應用在提高陰極量子效率的同時,并沒有消弱陰極的銳截止特性.
從圖5可以看出:在波長400 nm處,本文測試的變摻雜GaN陰極量子效率約為0.16%,加利福尼亞大學空間科學實驗室制備的變摻雜GaN光電陰極在波長380 nm處還有1%的量子效率,在400 nm處量子效率約為0.1%,這是材料p型重摻雜的結果.原因如下:對進行了p型重摻的變摻雜GaN材料,隨著摻雜濃度的提高,p型摻雜的雜質能級與GaN自身的價帶發生了重疊效應,這種重疊效應使得GaN材料的禁帶寬度變小,造成材料能帶的帶尾拖長,同時禁帶壓縮變小,造成原閾值由3.4 eV向長波方向偏移,直到3.1 eV處還有光譜響應.
6 結 論
NEA GaN光電陰極的優良性能使得這類陰極具有美好的發展前景,在微光探測、紫外探測、真空電子源等領域將獲得廣泛應用.本文結合變摻雜陰極的光電發射機理,給出了變摻雜GaN光電陰極的內建電場公式和量子效率公式,結果表明在特定條件下變摻雜與均勻摻雜陰極的量子效率公式是一致的.在反射模式下對一種變摻雜GaN陰極進行了激活,討論了激活過程中光電流曲線的特點,原位測試了激活后的量子效率,結合國內外的研究結果討論了變摻雜GaN陰極量子效率的特性,并和傳統的紫外光電陰極進行了對比,發現變摻雜GaN陰極在較寬的波段內具有平坦的光譜響應和高探測靈敏度要求的銳截止特性.由于附加了內建電場,變摻雜陰極的光電發射性能大大提高,在陰極材料性能處于極限的情況下采用變摻雜技術,為進一步提高陰極量子效率找到了較好的解決方案.
[1]Yang Y F,Fu R G,M a L,W ang X H,Zhang Y J 2012 Acta Phys.Sin.61 128504(in Chinese)[楊永富,富容國,馬力,王曉暉,張益軍2012物理學報61 128504]
[2]M achuca F 2003 Ph.D.D issertation(Stan ford:Stanford University)
[3]W ang X H,Shi F,Guo H,Hu C L,Cheng H C,Chang B K,Ren L,Du Y J,Zhang J J 2012 Chin.Phys.B 21 087901
[4]Du X Q,T ian J,Zhou Q F 2011 Spectroscop.Spect. Anal.31 1606(in Chinese)[杜曉晴,田健,周強富2011光譜學與光譜分析31 1606]
[5]Zhang Y J,Niu J,Zhao J,X iong Y J,Ren L,Chang B K,Q ian Y S 2011 Chin.Phys.B 20 118501
[6]Zhang Y J,Chang B K,Yang Z,Niu J,Zou J J 2009 Chin.Phys.B 18 4541
[7]Li B,Chang B K,Xu Y,Du X Q,Du Y J,Fu X Q, W ang X H,Zhang J J 2011 Spectroscop.Spect.Anal.31 2036(in Chinese)[李飆,常本康,徐源,杜曉晴,杜玉杰,付小倩,王曉暉,張俊舉2011光譜學與光譜分析31 2036]
[8]N iu J,Qiao J L,Chang B K,Yang Z,Zhang Y J 2009 Spectroscop.Spect.Ana l.29 3007(in Chinese)[牛軍,喬建良,常本康,楊智,張益軍 2009光譜學與光譜分析 29 3007]
[9]Yang Z,Chang B,Zou J,Qiao J,Gao P,Zeng Y,Li H 2007 Appl.Opt.46 7035
[10]Zou J J,Chang B K,Yang Z 2007 Acta Phys.Sin.56 2992(in Chinese)[鄒繼軍,常本康,楊智 2007物理學報56 2992]
[11]Hao G H,Chang B K,Chen X L,W ang X H,Zhao J,Xu Y,Jin M C 2013 Acta Phys.Sin.62 097901(in Chinese) [郝廣輝,常本康,陳鑫龍,王曉暉,趙靜,徐源,金睦淳2013物理學報62 097901]
[12]W ang X H,Chang B K,Zhang Y J,Hou R L,X iong Y J 2011 Spectroscop.Spect.Anal.31 2655(in Chinese)[王曉暉,常本康,張益軍,侯瑞麗,熊雅娟2011光譜學與光譜分析31 2655]
[13]Li B 2013 Ph.D.Dissertation(Nan jing:Nanjing University of Science and Technology)(in Chinese)[李飆2013博士學位論文(南京:南京理工大學)]
[14]W ang X H 2013 Ph.D.D issertation(Nan jing:Nan jing University of Science and Technology)(in Chinese)[王曉暉2013博士學位論文(南京:南京理工大學)]
[15]Siegm und O H W,Trem sin A S,Vallerga J V,M cPhate J B,Hull J S,M alloy J,Dabiran A M 2008 Proc.SPIE 7021 70211B
[16]Siegm und O,Vallerga J,M cPhate J,M alloy J,Trem sin A,M artin A,U lm er M,Wessels B 2006 Nucl.Instrum. M eth.Phys.Res.A 567 89
PACS:79.60.–i,72.80.Ey,73.61.Ey,73.20.AtDOI:10.7498/aps.66.067903
Quantum effi ciency for refl ection-m ode varied dop ing negative-electron-affi n ity GaN photocathode?
Qiao Jian-Liang1)?Xu Yuan2)Gao You-Tang1)Niu Jun1)Chang Ben-Kang2)
1)(School of E lectronic and E lectrical Engineering,Nanyang Institute of Technology,Nanyang 473004,China)
2)(School of E lectronic Engineering and Optoelectronic Techniques,Nanjing University of Science and Technology, Nanjing 210094,China)
(Received 8 O ctober 2016;revised m anuscrip t received 23 Novem ber 2016)
As a new kind of ultraviolet photocathodem aterial,the negative-electron-affi nity(NEA)GaN photocathode needs to further im p rove its photoem ission performance and the stable performance in practical app lications.Under the lim it of GaN photocathodem aterial grow th level,how to further im p rove the quantum effi ciency of cathode is an im portant problem.The varied doping technology can help to solve the prob lem under such circum stances.According to the photoem ission m echanism of varying doping NEA GaN photocathode m aterial,the built-in electric field formulas and the quantum effi ciency formu las for refl ection-m ode varied doping NEA GaN photocathode are given.The prelim inary structure of varied doping NEA GaN photocathode is designed.The varied dopingmaterial sam p le is divided into four layers according to the doping concentration.Using the self-developed experim ental equipm ent,the varied doping GaN photocathode sam p le is activated w ith Cs/O.The activation process and the change characteristics of photocurrent for varied doping NEA GaN photocathode are discussed.At the beginning,the photocurrent is increased steady w ith the introduction of Cs,then the“Cs kill”phenom enon appears in the p resence of excessive Cs.A fter the introduction of O,the photocurrent value starts to rise again.The spectral response of varied doping GaN photocathode is tested in situ after activation,and the quantum effi ciency values ranging from 240 nm to 354 nm are obtained.On the basis of the obtained experim ental resu lts of quantum effi ciency,combining to the typical quantum effi ciency curve from University of California,the characteristics of quantum effi ciency curves are analyzed.The resu lts show that the quantum effi ciency value for refl ection-m ode varied doping NEA GaN photocathode can reach 56%at 240 nm because of the built-in electric field,yet the quantum effi ciency m aximum value for uniform doping GaN photocathode is only 37%at 230 nm.The tested quantum effi ciency maximum value of varied doping NEA GaN photocathode is im proved much m ore than that of the uniform doping GaN photocathode.In a w ider range of the incident light wavelength,the quantum effi ciency of varied doping NEA GaN photocathode is relatively stable,and the excellent properties of varied doping GaN photocathode are confi rmed.The reason why the value of quantum effi ciency decreases w ith the increase of incident light wavelength is given.First,the photon energy decreases w ith the increase of incident light wavelength. Second,the incident light is absorbed from the front surface of cathode for reflection m ode.In addition,the quantum effi ciency curves of varied doping GaN photocathode show obvious sharp cut-off characteristics near the threshold,and the sharp cut-off characteristic is necessary for high detection sensitivity.The p roperty of negative electron affi nity for varied doping GaN cathodematerial after successfu l activation is also proved by the sharp cut-off feature.
GaN,photocathode,varied doping,quantum effi ciency
10.7498/aps.66.067903
?國家自然科學基金(批準號:61371058)資助的課題.
?通信作者.E-m ail:q jlqsy@sohu.com
*Pro ject supported by the National Natural Science Foundation of China(G rant No.61371058).
?Corresponding author.E-m ail:qjlqsy@sohu.com

