壘層厚度對InGaN/GaN多量子阱電注入發光性能的影響及機理
黃佳琳, 易淋凱, 周 梅*, 趙德剛
(1. 中國農業大學 應用物理系, 北京 100083;2. 中國科學院半導體研究所 集成光電子學國家重點實驗室, 北京 100083)
1 引 言
氮化鎵(GaN)及Ⅲ族氮化物系列的材料(包括AlN、GaN、InN及合金)屬于第三代半導體,在光電子學和微電子學領域都有重要的應用價值[1-5],尤其是GaN基藍光發光二極管(LED)及激光器的成功研制[6]使得GaN材料成為固態照明領域中的研究熱點。相比于傳統光源,GaN基LED具有發光效率高、實用壽命長、環保節能、使用靈活、發光均勻等優點,經過多年的發展,目前GaN基LED已經成功走向市場,但如果要獲得更高發光效率的GaN基LED器件,不僅需要進一步改進材料質量、工藝及封裝技術,還需要從器件結構上進行優化。InGaN/GaN多量子阱是GaN基LED器件的發光核心區域,研究結構參數對InGaN/GaN量子阱電注入發光影響的機理有助于提高LED及其他發光器件性能。
本文研究了InGaN/GaN(阱層In組分約為10%)多量子阱壘層(GaN層)的厚度對電注入發光性能的影響,并闡述了其機理。實驗結果表明,當壘層厚度在6~24nm范圍內時,適當增加壘厚,發光強度增強,而且在大電流注入下增加更多,我們認為,這可能是由于極化效應的影響,增加壘層厚度能夠抑制電子泄漏,使得發光效率增大,另外,增加壘層厚度也會增加InGaN阱層的局域態深度,從而也能增強量子阱的發光強度。
2 材料結構及生長過程
圖1是本文測試所采用的材料結構示意圖,在c面藍寶石襯底上采用金屬有機化學氣相沉積(MOCVD)方法進行材料外延生長。材料結構主要有p-GaN層、InGaN/GaN多量子阱層、n-GaN層及藍寶石襯底。Ga源、N源、Mg源分別為TMGa、NH3、Cp2Mg,載氣為H2。n-GaN層由約20nm的GaN緩沖層(LT-GaN)、900nm厚的非故意摻雜的GaN層(u-GaN)及重摻硅的n型GaN層(n+-GaN)依次生長組成,然后在n-GaN層上生長InGaN/GaN多量子阱層,量子阱數目為3個,其中InGaN阱厚約為2.7nm、In組分大約為10%,GaN壘厚分別為6,12,24nm,最后再生長摻鎂的p-GaN層。3個樣品的阱層條件完全相同,只是壘層厚度不一樣。材料生長完以后采用快速熱退火工藝激活p型雜質。本文通過改變外加注入電流的大小,研究了GaN層壘厚對InGaN/GaN量子阱電注入發光性能的影響,并分析了其機理。
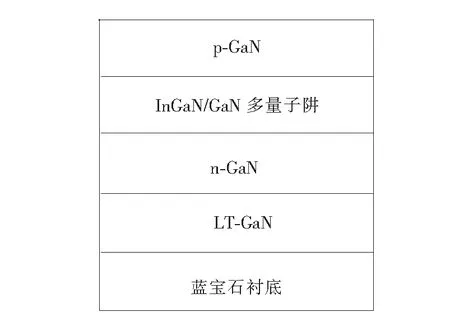
圖1 InGaN/GaN量子阱樣品材料結構示意圖
Fig.1Schematic diagram of InGaN/GaN multiple quantumn well (MQWs) samples
3 結果與討論
我們把壘層厚度分別為6,12,24nm的量子阱樣品編號分別取為A、B、C。圖2為樣品A、B和C在5mA的注入電流下的電致發光(EL)光譜曲線,其中A、B、C的發光峰分別位于413.5,412.3,417.8nm,峰值相對強度分別為332,466,535。顯然,從圖中可以看出,樣品C的電注入發光峰最強,而樣品A的電注入發光峰最弱。我們還對電熒光的發光峰強度進行了積分,樣品A、B、C的積分強度分別為934,1800,2323。3個不同壘厚的InGaN/GaN量子阱樣品,特別是A和C的電熒光測試結果明顯地表明:在相同的注入電流下,壘越厚,發光峰值的光強越大。
為了進一步研究發光強度隨注入電流的關系,通過改變不同注入電流得到了相應的電熒光譜。圖3是量子阱樣品A、B、C電注入發光光強積分強度與注入電流的關系,可以看出,無論在小電流還是大電流的注入下,樣品A的發光最弱,樣品C的發光最強。隨著壘層厚度的增加,InGaN/GaN量子阱的電注入發光強度增強更顯著。在1mA注入電流下,樣品A、B、C的電致發光光強積分強度依次為934,1800,2323;在20mA注入電流下,樣品A、B、C的電致發光光強積分強度依次為7840,11283,24170。這表明,不同壘厚的電注入發光光強積分強度在1mA的注入電流下差距不大,但隨著注入電流的增大,差距也隨著變大。隨著注入電流的增加,雖然這些量子阱樣品的電注入發光強度都增大,但是壘層厚度厚的樣品(特別是樣品C)發光強度增加幅度更大,顯然,增加壘層厚度可以改善InGaN/GaN量子阱在大電流注入條件下的電注入發光性能。
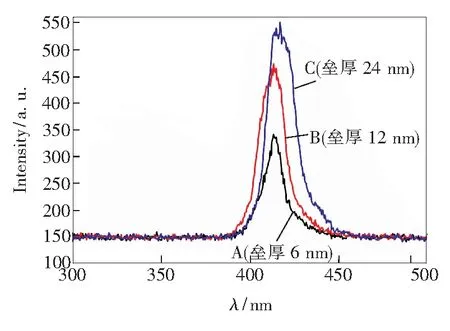
圖2不同壘厚InGaN/GaN量子阱在5mA注入電流下的電致發光光譜
Fig.2Electroluminescence spectra of InGaN/GaN multiple quantum wells with different barrier thickness at a fixed5mA injection current
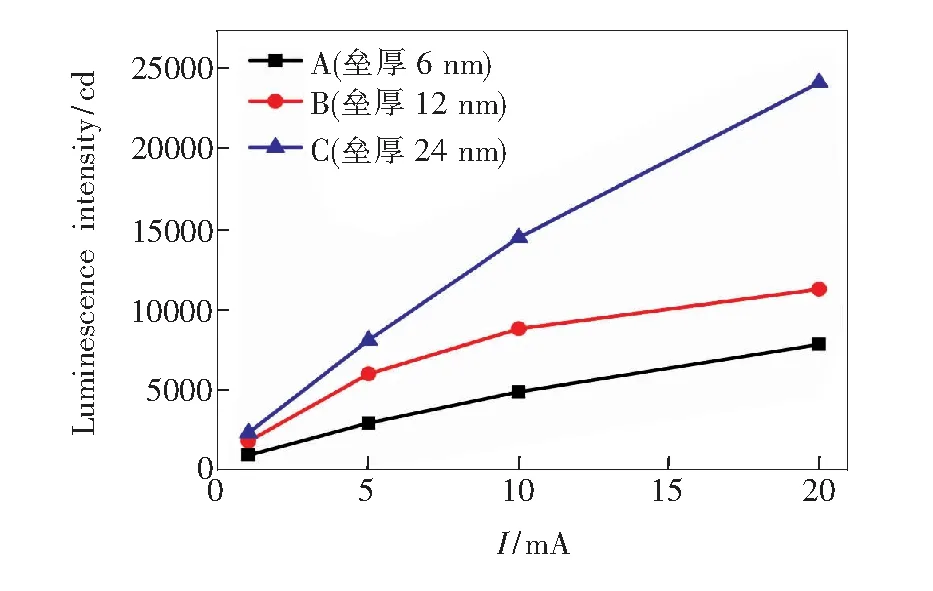
圖33個不同壘厚的InGaN/GaN量子阱樣品的電注入發光強度與注入電流的關系
Fig.3Dependences of the electroluminescence intensity on injection current for three samples with different barrier thickness
我們知道,c面藍寶石襯底上生長的GaN基材料具有很強的極性,也就是具有很強的極化電場[7-9]。圖4是考慮到極化電場后的InGaN/GaN量子阱能帶結構示意圖,可以看出,由于極化效應,GaN壘層和InGaN阱層的能帶都發生傾斜。其中InGaN阱層和GaN壘層的能帶分別向相反方向傾斜。GaN中的極化效應可以分為兩種,即自發極化和壓電極化。其中自發極化與應力無關, 而壓電極化與應力有關。當壘層增大時,應力也隨之增大,因此極化效應增強。壘層越厚,量子阱的能帶傾斜就越大。從A、B、C3個樣品在5mA注入電流下的發光峰位來看,壘層越厚則波長越長,也說明隨著壘層厚度的增加,阱層中極化效應增強,能帶傾斜加劇。如果從阱層能量最低處到壘層能量最高處作為電子跳出阱層所需要克服的勢壘,那么隨著壘層厚度的增加,除了勢壘加寬以外,勢壘高度也增大,電子克服勢壘、跳出阱層的幾率減小,電注入阱層的電子向外的泄漏就會減少。理論計算已經證明了增加壘層厚度可以減小InGaN/GaN量子阱的泄漏電流[10-12]。正是由于厚壘的樣品電子泄漏少,使得更多的載流子滯留在阱中,用于輻射復合發光的載流子增多,所以壘層較厚的樣品發光強度更大。而且,隨著注入電流的增加,電子泄漏的問題一般就會更加嚴重。由于壘層厚的樣品抑制電子泄漏效果更好,所以隨著注入電流的增加,發光強度增加也會更顯著,而壘層薄的樣品在高注入下電子更容易泄漏,所以光強隨電流增大而產生的增幅就相對較小。

圖4考慮極化效應后的InGaN/GaN多量子阱能帶結構示意圖。圖中虛線箭頭之間的距離大致表示阱中的電子向外泄漏時必須克服的勢壘高度。
Fig.4Conduction band and valence band of InGaN/GaN mutiple quantum wells after considering polarization effect. The dashed arrows schematically show the barrier height needed for electron leakage away from MQWs.
我們還對樣品A和C的發光峰位進行了研究。在圖2中,壘層厚的樣品C的峰值波長大于壘層薄的樣品A,其原因可能是如上所述,樣品C的勢阱中極化電場更大,相應的斯塔克效應更強,導致發光波長產生較大的紅移。圖5是InGaN/GaN量子阱樣品A和C的發光峰位隨注入電流變化的關系,在1mA的注入電流下,樣品A和C的峰位分別為413.8nm和419.1nm;在5mA的注入電流下,樣品A和C的峰位分別為413.5nm和417.8nm;在10mA的注入電流下,樣品A和C的峰位分別為413.6nm和417.4nm;在20mA的注入電流下,樣品A和C的峰位分別為413.8nm和417.2nm。從圖中可以看到,對于樣品C(壘厚24nm),隨著注入電流的增大,發光峰位明顯地向短波方向移動,峰位出現了藍移現象。而對于樣品A(壘厚6nm),隨著注入電流的增加,發光峰位移動不明顯。對于這個現象,我們認為還是可以用圖4的能帶結構模型進行解釋:由于極化的存在會在耗盡區內的量子阱阱層中產生一個與內建電場方向相反的極化電場[13],隨著注入載流子的增多,多量子阱中電子和空穴電荷產生的電場力對內建電場的屏蔽作用增強[14],在一定程度上減小了能帶的傾斜程度,減小了電場引起的斯塔克效應,載流子躍遷發光產生的光子能量增加,所以壘厚24nm的量子阱樣品發光峰隨著注入電流的增加發生藍移。而對于壘層較薄的樣品情況就略有不同,此時因為電子跳出阱層所需克服的勢壘較小,載流子泄漏較多,阱中的電子和空穴電荷產生的庫侖電場力對極化電場的屏蔽作用不那么明顯,所以壘厚為6nm的樣品發光峰位隨著注入電流的增加變化不大。
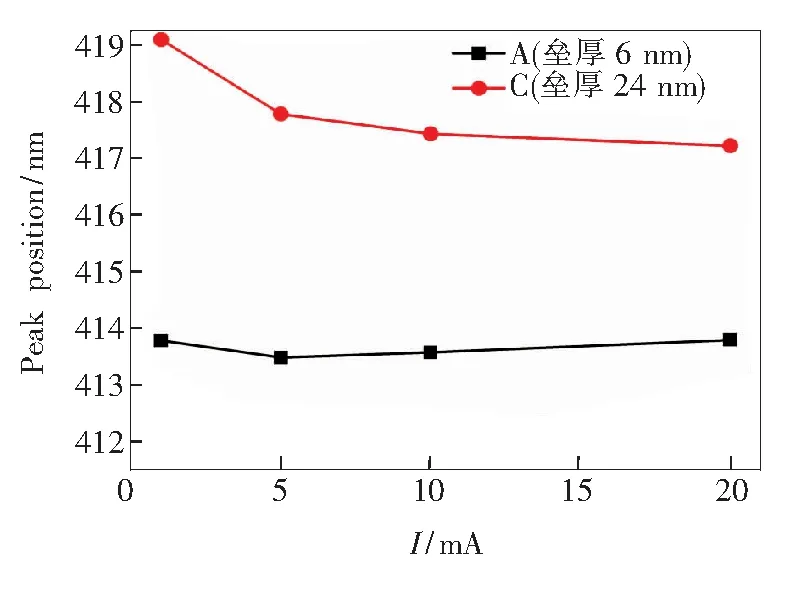
圖5兩個不同壘厚InGaN/GaN量子阱的發光峰位與注入電流的關系
Fig.5Dependences of emission peak position on injection current for two samples with different barrier thickness
我們發現,壘層厚度也會影響量子阱的電注入發光光譜半高寬,圖6是InGaN/GaN量子阱樣品A、B和C發光光譜半高寬隨注入電流的變化關系(用EL光譜測試發光峰的半高寬)。在1mA的注入電流下,樣品A、B和C的半寬高分別為15.7,17.1,18.2nm;在5mA的注入電流下,樣品A、B和C的半寬高分別為16.8,18.2,19.3nm;在10mA的注入電流下,樣品A、B和C的半寬高分別為16.7,19.3,20.0nm;在20mA的注入電流下,樣品A、B和C的半寬高分別為16.7,19.4,20.8nm。從圖6可以看出,在相同注入電流的情況下,隨著壘厚的增加,半寬高逐漸變大;且隨著注入電流的增大,樣品A(壘厚為6nm)的半高寬幾乎不再變化,而樣品B(壘厚為12nm)和樣品C(壘厚為24nm)的樣品半高寬還在增大,且樣品C的半高寬增幅顯然比樣品B大。一般認為,InGaN量子阱存在不同深度的局域態[15-16],它們對量子阱的發光躍遷具有非常重要的影響。發光峰的半高寬與注入的非平衡載流子在這些局域態的分布緊密相關。 在注入電流較小的情況下,載流子容易只分布在深局域態中,此時光譜相對較窄;當注入電流增加時,更多的載流子可能填充進入淺局域態中,從而造成發光光譜的展寬[17]。在壘層厚度較厚的樣品B和C中能清楚地看到這個現象。然而,在壘層很薄的情況下(如樣品A的情況),注入電流較高時量子阱中的電子比較容易發生泄漏。當注入電流很小時,只有較少的電子,主要都分布在較深的局域態,所以發光峰半寬度較小。而當注入電流增大時,注入電子比較容易泄漏出去,所以此時光譜并沒有發生明顯的展寬。發光峰位和光譜半高寬隨注入電流變化的結果,再次說明了增加壘層厚度可能會減小電子泄漏。
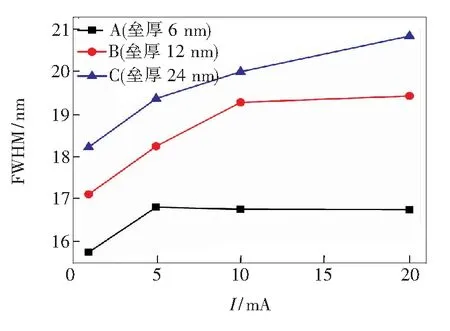
圖63個不同壘厚的InGaN/GaN量子阱的半高寬與注入電流的關系
Fig.6Dependences of FWHM on injection current for three samples with different barrier thickness
上述研究結果表明:適當增加壘層厚度,可以增加InGaN/GaN量子阱的發光強度,而且隨著注入電流的增加,壘厚的樣品電熒光發光強度增加更加明顯,其主要原因可能是由于極化效應的存在,量子阱具有傾斜的能帶,增加壘層厚度可以有效抑制注入電子的泄漏。隨著注入電流的增加,壘厚的InGaN/GaN量子阱發光峰出現明顯的藍移,而且發光光譜出現明顯的展寬,而壘薄的樣品藍移和光譜展寬都不明顯,同樣可能是由于壘厚的InGaN/GaN量子阱樣品注入電子泄漏小所致。另外,除了壘厚可以抑制載流子泄漏以外,增加壘層厚度,還會引起InGaN阱層局域態深度的增加[18]。這些局域態由富In的團簇形成,在壘的生長過程中,由于應力或其他作用,更多的In原子會向團簇聚集,形成In組分更高的InGaN,從而造成了更深的局域態,如果InGaN阱層局域態深度增加,InGaN/GaN量子阱的發光強度也會增大,同時隨著注入電流的增加,發光峰半高寬會增加,發光峰位也會出現藍移。我們認為,上述現象應該是電子泄漏減小和局域態深度增加共同作用的結果。
但是,如果壘層太厚的話,應力也會太大,從而引起InGaN層材料生長質量的惡化,可能使材料的發光強度降低。同時,由于極化的增強,量子限制斯塔克效應增強[19]會降低發光強度。另外,壘層太厚,也會導致載流子在各個阱中的分布很不均勻,尤其是空穴的注入會更困難,也會導致發光強度降低。所以,勢壘層也不能太厚。總的來說,當壘層厚度在6~24nm范圍內時,壘層厚度如果增加適當,不僅可以減小電子泄漏,而且還會增加阱層局域態的深度,對提高量子阱的發光強度有利,從而改善InGaN/GaN量子阱電注入發光性能。
4 結 論
本文研究了不同壘厚對InGaN/GaN量子阱電注入發光性能的影響,并討論了機理。從實驗結果發現,當GaN壘層的厚度從6nm增大到24nm時,隨著注入電流的增加,適當增加壘厚,不僅可以顯著增加發光強度,而且使得發光峰出現明顯的藍移、光譜展寬。由于極化效應的存在,增加壘層厚度會使得能帶的傾斜加劇,載流子躍出阱層所需克服的勢壘增加,減少電子泄露,增加了載流子限制能力從而影響了發光效率、峰位和光譜寬度。增加壘層厚度還會增加阱層的InGaN局域態深度,也會增加發光強度。研究結果表明,當壘層厚度在6~24nm范圍內時,適當增加壘層厚度可以提高InGaN/GaN量子阱的電注入發光性能。
[1] HARDY M T, FEEZELL D F, DENBAARS S P,etal.. Group Ⅲ-nitride lasers: a materials perspective [J].Mater.Today, 2011, 14(9):408-415.
[2] JIANG L R, LIU J P, TIAN A Q,etal.. GaN-based green laser diodes [J].J.Semicond., 2016, 37(11):111001.
[3] SUN Q, YAN W, FENG M X,etal.. GaN-on-Si blue/white LEDs: epitaxy, chip, and package [J].J.Semicond., 2016, 37(4):044006.
[4] JING K, FENG M, JIN C,etal.. GaN grown on nano-patterned sapphire substrates [J].J.Semicond., 2015, 36(4):043004.
[5] YANG J, ZHAO D G, JIANG D S,etal.. Different variation behaviors of resistivity for high-temperature-grown and low-temperature-grown p-GaN films [J].Chin.Phys. B, 2016, 25(2):027102.
[6] NAKAMURA S. The roles of structural imperfections in InGaN-based blue light-emitting diodes and laser diodes [J].Science, 1998, 281(5379):956-961.
[7] BERNARDINI F, FIORENTINI V,VANDERBILT D. Spontaneous polarization and piezoelectric constants of Ⅲ-Ⅴ nitrides [J].Phys.Rev. B, 1997, 56(16):10024-10027.
[8] SCHMIDT M C,KIM K C, SATO H,etal.. High power and high external efficiency m-plane InGaN light emitting diodes [J].Jpn.J.Appl.Phys., 2007, 46(4-7):L126-L128.
[9] KIM K C, SCHMIDT M C, SATO H ,etal.. Study of nonpolar m-plane InGaN/GaN multiquantum well light emitting diodes grown by homoepitaxial metal-organic chemical vapor deposition [J].Appl.Phys.Lett., 2007, 91(18):181120.
[10] 周梅, 趙德剛. InGaN/GaN量子阱壘層和阱層厚度對GaN基激光器性能的影響及機理 [J]. 物理學報, 2016, 65(7):077802.
ZHOU M, ZHAO D G. Barrier and well thickness designing of InGaN/GaN multiple quantum well for better performances of GaN based laser diode [J].ActaPhys.Sinica, 2016, 65(7):077802. (in Chinese)
[11] 趙玲慧, 張連, 王曉東,等. 基于InGaN/GaN多量子阱雙波長發光二極管生長及發光性能 [J]. 光子學報, 2013, 42(10):1135-1139.
ZHAO L H, ZHANG L, WANG X D,etal.. Growth and optical properties of InGaN/GaN dual-wavelength light-emitting diodes [J].ActaPhoton.Sinica, 2013, 42(10):1135-1139. (in Chinese)
[12] 李正凱, 嚴啟榮, 羅長得, 等. GaN壘層厚度漸變的雙藍光波長發光二極管 [J]. 光子學報, 2013, 42(7):757-762.
LI Z K, YAN Q R, LUO C D,etal.. Dual-blue wavelength light-emitting diodes based on varied GaN barrier thickness [J].ActaPhoton.Sinica, 2013, 42(7):757-762. (in Chinese)
[13] SALA F D, CARLO A D, LUGLI P,etal.. Free-carrier screening of polarization fields in wurtzite GaN/InGaN laser structures [J].Appl.Phys.Lett., 1998, 74(14):2002-2004.
[14] 顧曉玲,郭霞,梁庭,等. 雙波長GaN基發光二極管的電致發光譜特性研究 [J]. 物理學報, 2007, 56(9):5531-5535.
GU X L, GUO X, LIANG T,etal.. The electroluminescence spectra of dual wavelength GaN-based light emitting diodes [J].ActaPhys.Sinica, 2007, 56(9):5531-5535. (in Chinese)
[15] O’DONNELL K P, MARTIN R W, MIDDLETON P G. Origin of luminescence from InGaN diodes [J].Phys.Rev.Lett., 1999, 82(1):237-240.
[16] SCH?MIG H, HALM S, FORCHEL A,etal.. Probing individual localization centers in an InGaN/GaN quantum well [J].Phys.Rev.Lett., 2004, 92(10):106802.
[17] LIU W, ZHAO D G, JIANG D S,etal.. Effect of localization states on the electroluminescence spectral width of blue-green light emitting InGaN/GaN multiple quantum wells [J].J.Vac.Sci.Technol. A, 2015, 33(6):061502.
[18] LIANG M M, WENG G E, ZHANG J Y,etal.. Influence of barrier thickness on the structural and optical properties of InGaN/GaN multiple quantum wells [J].Chin.Phys. B, 2014, 23(5):054211-1-5.
[19] ZHAO D G, JIANG D S, ZHU J J,etal.. An experimental study about the influence of well thickness on the electroluminescence of InGaN/GaN multiple quantum wells [J].J.AlloysCompd., 2010, 489(489):461-464.

