研磨面平尺的相移干涉測量方法
王青,顧洋
(南京理工大學,江蘇 南京210094)
1 相移干涉儀的測量原理
相移干涉儀是一種高精度的數字化測量儀器,在近二十年發展快速,已經成為平晶測量的主要儀器。


圖1 菲索型相移干涉儀主機光學原理圖

圖2 相移干涉儀原理框圖
(1)
所以初始相位為
(2)
當忽略干涉腔中空氣折射率不均勻性時,兩個平面在(x,y)點的高程(小數部分)為
(3)
由于式(2)中含有減法和除法,所以干涉場中背景光強、固定噪聲、面陣探測器的不一致性等影響均自動消除,這是移相干涉測量的一大優點。而高密度的采樣點陣,決定了兩個相鄰采樣點上的高程差異不會超過半個波長,因此可以通過加減半個波長的方法來克服式(2)中的相位躍變影響。
一般來說,等傾干涉儀[1]的測量精密(測量點)但不準確(全面域)、等厚干涉儀[2]則相反,準確(全面域)但不精密(無法獲得單個點的值)。如圖3所示,對比于等傾干涉儀的稀疏測量點,相移干涉儀在單個測量點位上具有同樣的精密度;對比于等厚干涉的干涉條紋判讀方法,相移干涉儀在全面形測量上具有同樣的準確度。
2 利用相移干涉儀的拼接測量方法
用相移干涉儀測量長尺寸被測件時,最簡單的方法是制造一臺口徑達到相應長度的干涉儀(300~500 mm)。然而相移干涉儀在口徑從Φ150 mm上升到Φ300 mm時,干涉儀主機的價格上升了2.5倍,標準平晶價格上升了5倍。因此使用Φ150 mm相移干涉儀,使用拼接或斜入射測量方法進行測量是性價比最高的。
從子孔徑數目和測量精度兩個方面來說,200~300 mm的長平晶或研磨面平尺是少數適合用子孔徑拼接方法進行測量的原件之一。在Φ150 mm測試口徑下,其子孔徑分布如圖4所示。
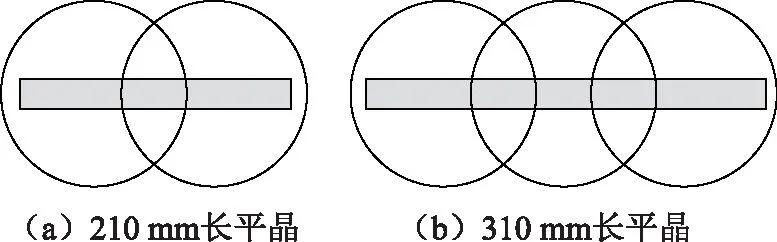
圖4 長平晶測量中的子孔徑分布
如果不考慮標準平晶的面形誤差,或已經對標準平晶誤差進行了修正[3],那么可以認為在重疊區域的2次測試結果差異只與傾斜調整有關,即
W2(x,y)-W1(x,y)=ax+by+c
(4)
式(4)中有3個未知量,如果分別對重疊區域進行消傾斜操作,則可以得到兩個波前各自的傾斜系數(a1,b1,c1)和(a2,b2,c2),于是相對調整差異就可以得到
(5)
子孔徑2的所有有效測試區域,按(Δa,Δb,Δc)消除與子孔徑1的相對傾斜系數后,就可以進行坐標平移,并將兩次測得結果統一,獲得被測件全口徑的面形數據。圖5為300 mm研磨面平尺的三個子孔徑測試結果,表1為按研磨面平尺檢定規程[4]的采樣數據(直接采樣值,未消傾斜)和拼接結果。拼接的流程為:兩端子孔徑端點對準(橫向及高度)→兩端子孔徑傾斜調整(由重疊點計算傾斜量)→拼接,獲得11個數據→消傾斜(端點歸零)。
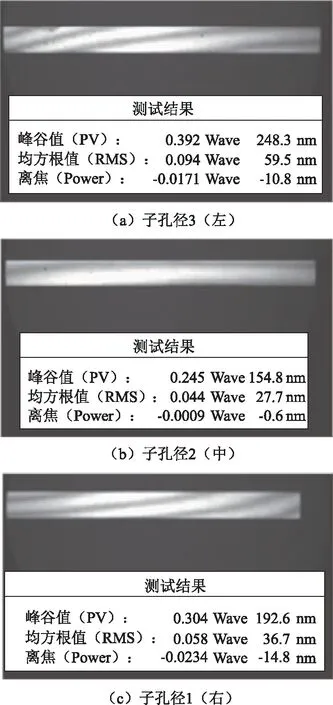
圖5 研磨面平尺測量實測
注:子孔徑偏移量100 mm,右端留空

表1 研磨面平尺測量采樣數據與拼接結果
注:平面度為0.346 μm
3 利用相移干涉儀的斜入射測試方法
通過將長方形被測件的傾斜放置,可以使較小口徑(如Φ150 mm)的干涉儀輸出光束覆蓋全部被測表面,即斜入射測試方法。斜入射測試需要使用一對圓平晶:一個為非鍍膜普通標準平晶,另一個為高反射的標準反射鏡(反射率需匹配被測件的斜入射反射率),測試光路如圖6。

圖6 研磨面平尺的斜入射測試
在斜入射測試中,干涉儀的準直光經過研磨面平尺待測表面反射兩次,因此研磨面平尺的測試結果WL(x,y)并非是相移干涉儀直接獲得的波前W0(x,y)。如圖7所示,當表面凹凸變化為h時,光程變化為Δ=AB-AC。考慮到光線的入射角度為θ,則有根據三角函數的變換,有
(6)
于是,一個進行轉換的比例系數就可以確定了。
(7)

圖7 斜入射測試中的比例變換
式(7)中,入射角θ是一個重要的參數,一般有兩種方法來獲得:一是直接測量角度值,如制造一個帶圓光柵的調整架;二是通過圖像分析方法,獲得長方形被測表面在x方向上的壓縮比。后一種方法簡單易行,通過標定干涉儀的像素格值和測量研磨面平尺干涉圖像在橫向上所占的像素值就可以了。
(8)
式中:D為干涉儀口徑;L為研磨面平尺的長度;P1和P2分別為在干涉圖像上干涉儀口徑與研磨面平尺的圖像像素數目。
于是式(7)可寫成
(9)
斜入射測量的干涉圖與測試結果如圖8所示,表2給出了轉換過后的結果。

圖8 斜入射測試干涉圖與三維圖
本次測量過程,在像素坐標下,橫向采樣得到干涉儀孔徑位置為33~332、研磨面平尺位置為37~322。
因此P1=332-33=299,P2=322-37=285;于是
注:平面度為0.391 μm
4 測量結果的分析
采用相移干涉儀對研磨面平尺的2種測量過程,可以仿照研磨面平尺的檢定規程進行測量不確定度估算,如表3所示。

表3 測量不確定度概況和估算(L=300 mm)
研磨面平尺的拼接測試和斜入射測試差異為0.045 μm,截面的輪廓一致性好,如圖9所示,兩種測量方法的歸一化偏差[5]En值小于1,說明測量結果在合理預期之內。

圖9 利用相移干涉儀的兩種方法的研磨面平尺測量結果
[1] 國家質量監督檢驗檢疫總局,國家標準化管理委員會.JJG 661-2004平面等傾干涉儀檢定規程[S].北京:中國計量出版社,2004.
[2] 徐德衍,王青,高志山,等.現行光學元件檢測與國際標準[M].北京:科學出版社,2009.
[3] 王青,徐新華,陳磊,等.一種子孔徑拼接系統中系統誤差的修正方法:201110106489.7[P].
[4] 國家質量監督檢驗檢疫總局,國家標準化管理委員會.JJG 740-2005 研磨面平尺檢定規程[S].北京:中國計量出版社,2005.
[5] 國家質量監督檢驗檢疫總局,國家標準化管理委員會.JJF 1117-2010 計量比對技術規范[S].北京:中國計量出版社,2010.

