集成電路組裝過程中裸芯片目檢不合格類型與原因分析
周安琪,張育赫,王麗丹
(中國電子科技集團公司第四十七研究所,沈陽110032)
1 引 言
芯片目檢是集成電路質量控制的重要環節,貫穿在整個組裝過程中。為了保證軍用集成電路的質量,我國制訂了國軍標。通過執行軍用集成電路質量檢驗標準,集成電路的壽命與可靠性穩步提高。裸芯片檢驗是集成電路組裝的第一步,須嚴格按照GJB548B 方法2010.1 內部目檢標準進行[1]。
以20 個批次的代表芯片為研究對象,通過目檢和統計分析,歸納出裸芯片目檢不合格的主要類型。進一步開展不合格原因分析,提出過程優化控制方法并加以實施,確保每個批次的裸芯片目檢不合格率明顯下降。
2 目檢方式及判據
對待檢裸芯片采用隨機抽取的方式,隨機抽取A、B、C、D、E 五種不同型號芯片,選取每種型號芯片的4 個批次,每個批次抽取50 只為統計樣本,在電子顯微鏡下75~150 倍進行目檢,按照GJB548B-2010.1 對該20 批次共計1000 只裸芯片進行目檢,統計樣本如表1 所示。
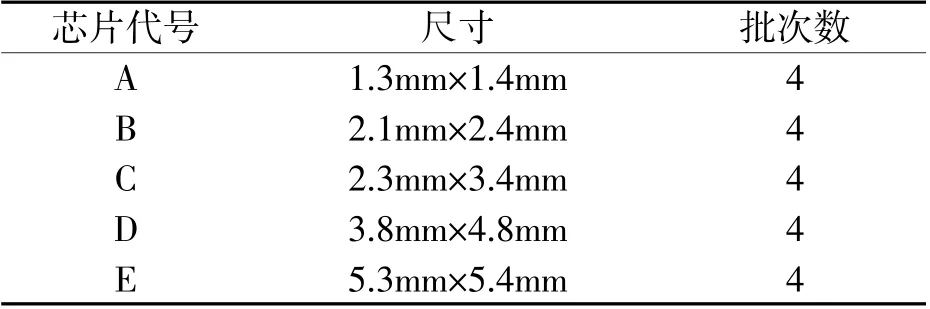
表1 統計樣本表
3 主要不合格類型
3.1 芯片表面金屬化劃傷及裂紋
按GJB548B 方法2010.1 規定,劃片槽內裂紋長度超過25 微米且除鍵合區和梁式引線以外,金屬化層的劃傷沿長度方向暴露出下層鈍化層,使保留的未被破壞的金屬寬度小于原始金屬條寬的50%,均判定為不合格[2]。
金屬化層的劃傷主要是芯片儲存、傳遞、組裝過程中人為因素造成的。劃傷使金屬化層的有效導電截面積減小,因此電流承載能力下降,導致該處金屬同其他正常部位相比容易出現過流熔斷。另外,在使用過程中由于受到損傷的金屬化層部位的有效導電截面減小,使該處的實際電流密度增加,所以更容易發生電遷移導致鋁條開路失效[3]。
3.2 芯片金屬化層圖形缺陷
GJB548B 方法2010.1 中規定,金屬化層中的空洞使未受破壞的部分小于原始金屬條寬度的50%或金屬化層出現隆起、起皮或起泡現象不得接收。
芯片金屬化層圖形缺陷多發于芯片制造工藝過程中,是先天即存在的薄弱環節[4]。空洞或原始金屬條寬度不足,不僅僅會導致單個芯片的電性能問題,更有可能引發整個批次的共性問題,應比照芯片圖紙對線條進行全局性的檢查。
3.3 芯片表面污物
GJB548B 方法2010.1 中規定,芯片表面的液滴、化學污斑、油墨或光致抗蝕劑跨接了未被玻璃鈍化層覆蓋的任何金屬化層或裸露的半導體本體區域為不合格。
如果沾污橋聯了電路內部不同電位的工作區,可能導致電路內部工作材料間的漏電增加或短路;如果多余物含有腐蝕性物質,可能導致金屬化層腐蝕;如果沾污材料足夠厚,可能影響芯片的局部散熱。這些因素,都會對元器件服役過程中的使用壽命和可靠性造成很大程度的影響[5]。
3.4 芯片嵌入多余物
GJB548B 方法2010.1 中規定,在芯片表面上附著或嵌入的多余物,橋聯了包括金屬化層在內的有源電路元件,除非用暗場照明下的高放大倍數驗證它僅是附著而不是嵌入。
該種情況可能導致電路內部工作材料間的意外短路,對電路的性能造成影響。此外,對于應用在高加速環境中的元器件,對密封腔體內部多余物有額外的要求,芯片粘附的顆粒物可能在應用中脫離,并產生較高的動能損傷鍵合引線等關鍵部位[6]。
4 統計與分析
4.1 主要不合格類型統計
根據隨機抽取的20 個批次的芯片,共1000 只芯片的統計,可以得到總體的不合格類型分布,如表2 所示,主要不合格類型圖例如圖1 所示。

表2 主要不合格類型統計表

圖1 主要不合格類型圖例
4.2 主要不合格類型的機理分析
從表2 中可以看出,芯片表面污物是導致芯片目檢不合格的最主要因素之一。進一步對A、B、C、D、E 五種芯片統計不合格數量,分別為5 只、6 只、8只、7 只和8 只,表現出較為均勻的分布,說明該種不合格現象具有共性。需要對供應商和組裝生產線進一步加強控制。
芯片表面金屬化劃傷也是較為多發的典型不合格類型之一,A、B、C、D、E 五種芯片不合格數量,分別為8 只、6 只、7 只、4 只和2 只。隨著芯片面積的增大,劃傷數量呈現遞減的趨勢。通過魚骨圖分析,發現在夾取芯片過程中,工具使用控制不當是引起芯片劃傷的主要原因因素。
芯片多余物的來源較多,一方面是可移動組裝多余物,例如芯片粘接材料的顆粒、鍵合絲尾線等,可直接用工具、氣體等輔助手段使其于芯片剝離[7];另一方面是高溫烘焙、固化時,固定在芯片表面的不可移動多余物,需嘗試在不損傷芯片的前提下使用堅硬工具剔除[8]。
5 控制措施及效果
基于上述分析,可制定如下控制措施:
(1) 對芯片拾取、傳遞、保存等環節進行優化處理,嚴格控制工作環境的潔凈度、溫濕度,同時對于靜電進行控制,防止顆粒物吸附到裸芯片表面。
(2) 用吸筆拾取到裸芯片放置托盤中代替人工用鑷子夾取裸芯片到玻璃板上,條件允許情況下可采用全自動粘片設備,避免人工粘片夾取時對芯片的損傷。
實際施行上述優化控制措施后,發現對于裸芯片劃傷、污物、多余物不合格現象有顯著減少,但是對于芯片嵌入多余物和芯片金屬化層圖形缺陷問題沒有明顯改善。優化前后的對比如圖2 所示。

圖2 優化前后對比圖
6 結 束 語
裸芯片目檢是集成電路質量檢驗中的重要環節。以若干批次的芯片為研究對象,通過目檢和統計,分析了裸芯片目檢的主要不合格類型。進一步研究了目檢不合格原因,提出并實施了過程優化控制方法,使各批次的裸芯片目檢不合格率明顯下降。

