磁控濺射法制備的MoOx薄膜材料特性
王效坤,房偉華,劉 飛
(合肥京東方光電科技有限公司,安徽 合肥 230012)
1 引 言
在TFT-LCD行業,低反射率材料得到越來越廣泛的應用,如在黑矩陣(BM)技術、觸摸屏的表面黑化等方面[1-4]。在一些特殊應用場合,比如應用在航空電子設備中的液晶顯示器, 要求在寬視角范圍內具有高亮度、低反射、高對比度等性能[5]。然而,液晶顯示屏因其結構或組裝的需要,在屏幕邊緣不可避免地會有一部分無法顯示的邊框區域,目前市面上常見的無邊框技術、超窄邊框技術,其本質上仍然是一種窄邊框技術[6]。邊框的存在會降低整個顯示屏的視覺效果[7]。一種解決方案是,使其在黑色狀態下更暗,提高整個面板的對比度,可明顯改善顯示效果[8-9]。
窄邊框工藝中,一般選擇TFT層反置的結構設計,黑化層沉積在金屬層的下面。比如黑化層搭載8 Mask工藝:黑化層(低反層)/柵極(Gate)→ACT→GI→SD→Organic(Resin)→1stITO→PVX→2ndITO[10]。低反射技術方案主要有a-Si/SiNx復合膜結構,雙層SiNx復合膜結構,MoNb/MoNbOx疊層結構以及鉬(及其合金)的氧化物薄膜等方式。其中,a-Si/SiNx復合膜結構和雙層SiNx復合膜結構需要增加a-Si和SiNx的多次沉積、曝光以及非金屬層的刻蝕工序,對產能影響較大,且反射率相對較高。而MoNb/MoNbOx疊層結構不但工序多,產能影響大,MoNb層與MoNbOx之間還容易發生側向“底切”現象,刻蝕性差。氧化鉬薄膜則具有反射率低,可以采用濕法刻蝕的方式與作為柵極的金屬層一同刻蝕,具有工藝簡單,量產性高的特點。
氧化鉬薄膜可以采取鉬靶材在磁控濺射成膜過程中通入氧氣的方式制備,但是氧氣的控制以及和鉬的反應是難點,容易出現反應不充分及不均勻的情況。而采用鉬(及其合金)和氧以一定比例制備的MoOx靶材來制備MoOx薄膜,則可以很好地解決此問題。本實驗中,MoOx靶材購買自PLANSEE(其中含有質量分數約8%的Ta元素,MoOx中x值約2.7)。使用交流磁控濺射沉積法在玻璃基板表面沉積MoOx薄膜,并在MoOx薄膜上沉積不同的金屬層。通過掃描電子顯微鏡(SEM)和X射線衍射(XRD)設備分析膜面的結構特征,通過百格測試的方式測試其和不同金屬層及玻璃基板之間的粘附力,采用四探針設備(4-point probe)測試其方塊電阻(Rs),采用TOHO的薄膜應力測試儀測試薄膜應力,通過CM-700d分光測色計測試其反射率(Reflectivity)和色差,分析探討MoOx及其搭配金屬層復合膜的特性,為其在TFT-LCD行業的應用提供參考。
2 實 驗
本文采用ULVAC的SMD-1800V型立式磁控濺射鍍膜機在玻璃基板表面沉積MoOx薄膜,本底真空度小于5.0×10-4Pa,氬氣純度為99.999 9%,購買自Air Liquid。玻璃基板購買自東旭光電科技股份有限公司,其尺寸為1 850 mm×1 500 mm,厚度為0.5 mm。成膜工藝如表1所示,成膜溫度為常溫。
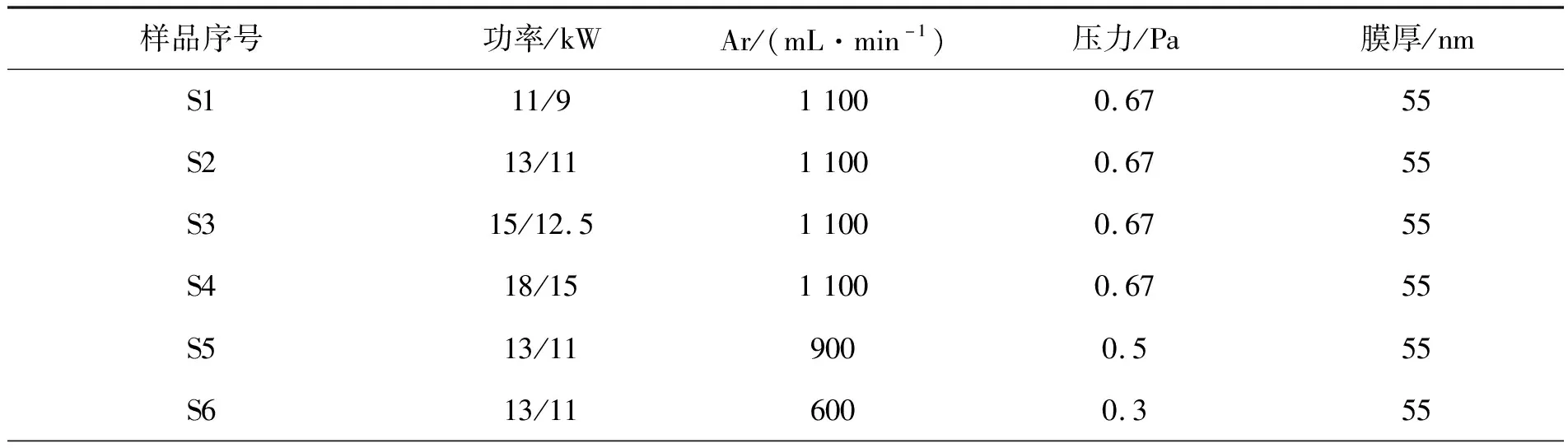
表1 MoOx樣品制備條件

續 表
測試各成膜條件樣品以及搭配玻璃基板和不同金屬層的特性。本文所采用的四探針測試儀是NAPSON的RS-1300型;薄膜應力測試儀為TOHO的 FLX-2320-S型;場發射掃描電鏡(FE-SEM)為Hitachi的S-4800型;X射線衍射儀(XRD)為Bruker D4 Endeavor型,2θ掃描范圍20°~80°;使用的光學測試設備為CM-700d分光測色計。
3 實驗結果與討論
3.1 Rs測試結果分析
方塊電阻Rs反應的是材料的電學性能。圖1是在成膜壓力0.67 Pa、不同功率條件下制備的55 nm MoOx薄膜Rs變化趨勢圖。由圖可知,Rs隨著成膜功率的增加而降低,同金屬層及ITO具有相同的規律,原因推測為功率增加,濺射離子能量增加,轟擊出的靶材原子能量增大,成膜更致密,導電性更好。
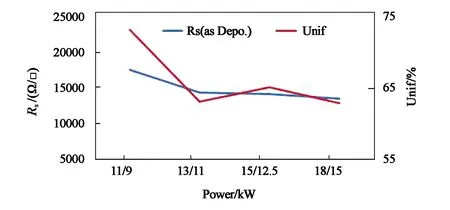
圖1 Rs隨成膜功率變化趨勢圖
圖2是在成膜功率13/11 kW、不同成膜壓力條件下制備的55 nm MoOx薄膜Rs變化趨勢圖。由圖可知,Rs隨著成膜壓力的增加而增大。

圖2 Rs隨成膜壓力變化趨勢圖
從MoOx的Rs測試結果看,其值遠遠大于金屬層和ITO層,和柵極金屬層搭配時,其電學影響可以忽略不計。此外,MoOx薄膜Rs值的均勻性很差,分析可能原因為在成膜過程中,玻璃基板周邊位置因Ar氣流等原因導致了較多的氧元素損失,周邊位置Rs較中間位置偏低許多,但是對光學特性基本沒有影響。
3.2 應力測試結果分析
薄膜中存在殘余應力是薄膜生產、制備過程中的普遍現象。所有薄膜幾乎都處于某種應力狀態之中,而殘余應力的存在會對薄膜性能及其生產性能產生影響[11]。薄膜沉積在基體以后,薄膜處于應變狀態,若以薄膜應力造成基體彎曲形變的方向來區分,可將應力分為拉應力(Tensile stress)和壓應力(Compressive stress)。拉應力是當膜受力向外伸張,基板向內壓縮、膜表面“下凹”,薄膜因為有拉應力的作用,薄膜本身產生收縮的趨勢,如果膜層的拉應力超過薄膜的彈性限度,則薄膜就會破裂甚至剝離基體而翹起。壓應力則呈相反的狀況,膜表面產生外凸的現象,在壓應力的作用下,薄膜有向表面擴張的趨勢。如果壓應力到達極限,則會使薄膜向基板內側卷曲,導致膜層起泡。
薄膜應力測試儀的測試原理為在晶片(Wafer)上沉積MoOx薄膜,測量薄膜沉積引起的晶片曲率的變化,根據晶片的彈性模量,通過彈性方程計算得到應力。圖3是成膜壓力0.67 Pa、不同功率條件下制備的55 nm MoOx薄膜應力變化趨勢圖。其中0°指平行于玻璃短邊方向,90°平行于玻璃長邊方向。從測試結果可以看出,測試結果為負值,為壓應力,且隨著成膜功率的增大而增大。

圖3 應力隨成膜功率變化趨勢圖
圖4是成膜功率13/11 kW、不同成膜壓力條件下制備的55 nm MoOx薄膜應力變化趨勢圖。測試結果同樣為負值,為壓應力,隨著成膜壓力的增大而減小。

圖4 應力隨成膜壓力變化趨勢圖
綜合圖4、圖5測試結果可知,在一定的成膜條件下,MoOx薄膜均呈現出壓應力,其數值并不大。玻璃基板角部(Corner)位置的應力值要大于中部(Center)位置,其中一個可能的原因是,角部位置磁場更強,等離子體密度更大,沉積膜層更致密導致。
3.3 SEM和XRD測試結果分析
圖5是在玻璃基底上,在功率13/11 kW、成膜壓力0.67 Pa的條件下沉積單層55 nm的MoOx薄膜的SEM圖。MoOx為黑色透明薄膜,與玻璃基底比較相近,從SEM測試圖片看,其界面并不明顯。觀測其結構,無可見晶狀結構。為便于對MoOx薄膜結構進行SEM分析研究,可在MoOx薄膜和玻璃基板之間沉積結構差別較大的底膜,比如金屬層,便于區分界面,并適當提高需要測試的膜層厚度。
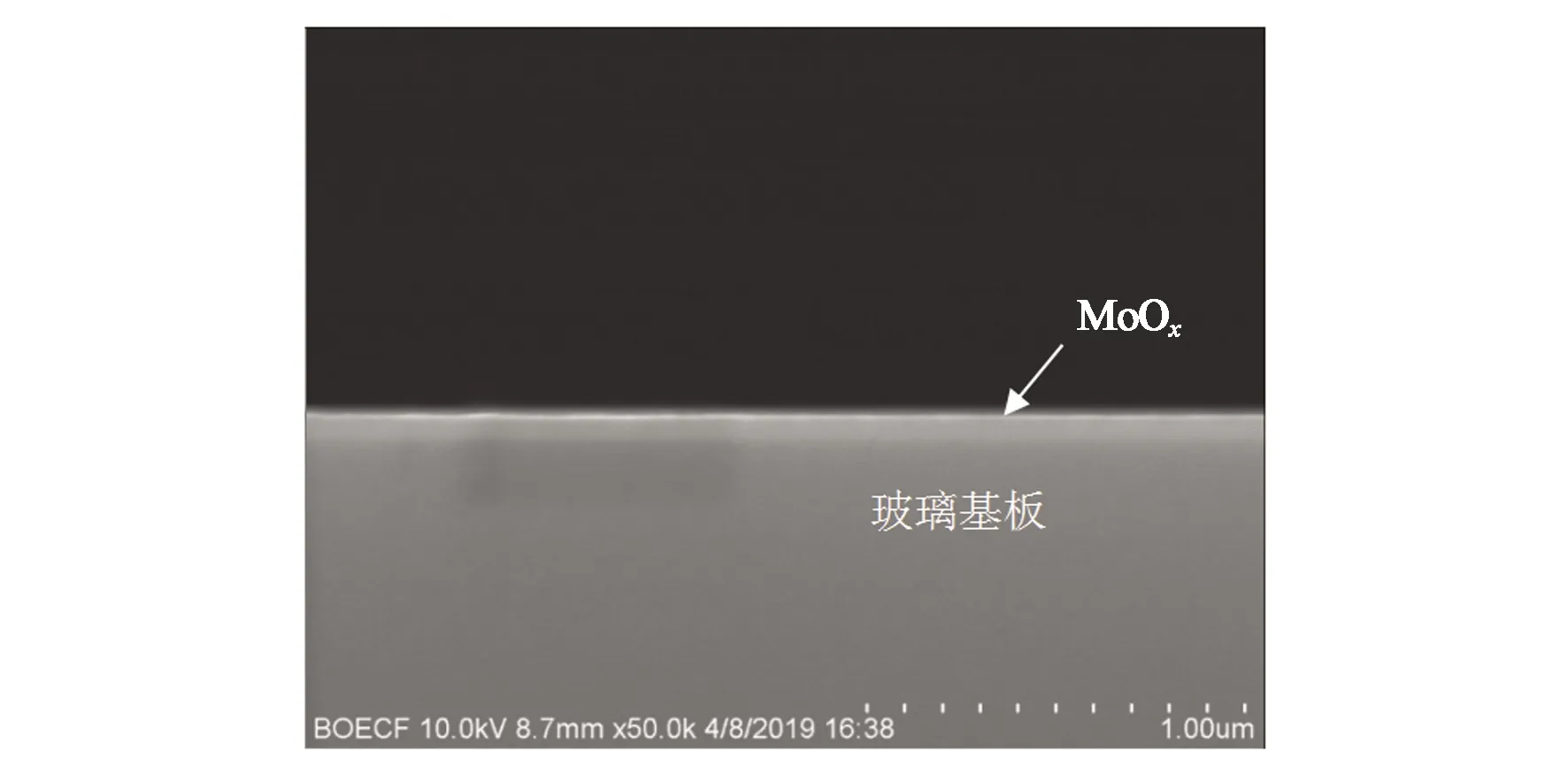
圖5 MoOx薄膜SEM圖
圖6是在成膜功率13/11 kW、成膜壓力0.67 Pa的條件下沉積單層55 nm MoOx薄膜的XRD圖譜,為平滑的曲線,沒有發現特征峰,說明制備出的MoOx薄膜為非晶結構[8]。這和 Schmidt等人的研究結論一致。成膜功率和成膜壓力等對MoOx薄膜膜質結構是否有影響,本文沒有做進一步的研究。
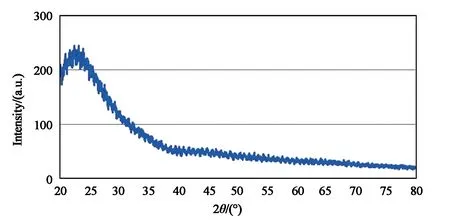
圖6 MoOx薄膜的XRD圖譜
3.4 粘附力測試結果分析
MoOx薄膜粘附力測試是通過百格測試的方式。如圖7,在玻璃基板上沉積55 nm的MoOx薄膜,并在薄膜上分別沉積Al/Mo(260/80 nm)、Mo/Al/Mo(15/300/80 nm)、Mo(220 nm)、Cu/MTD(200/20 nm)和MTD/Cu(20/200 nm)等柵極常使用的金屬層。在測試樣品上劃10×10個約1 mm×1 mm小網格,每一條劃線深及測試膜層底部,并將測試區域的碎片刷干凈。使用3M610號膠紙牢牢粘住被測試小網格,在垂直方向迅速扯下(以不扯碎玻璃樣品為準)膠紙。
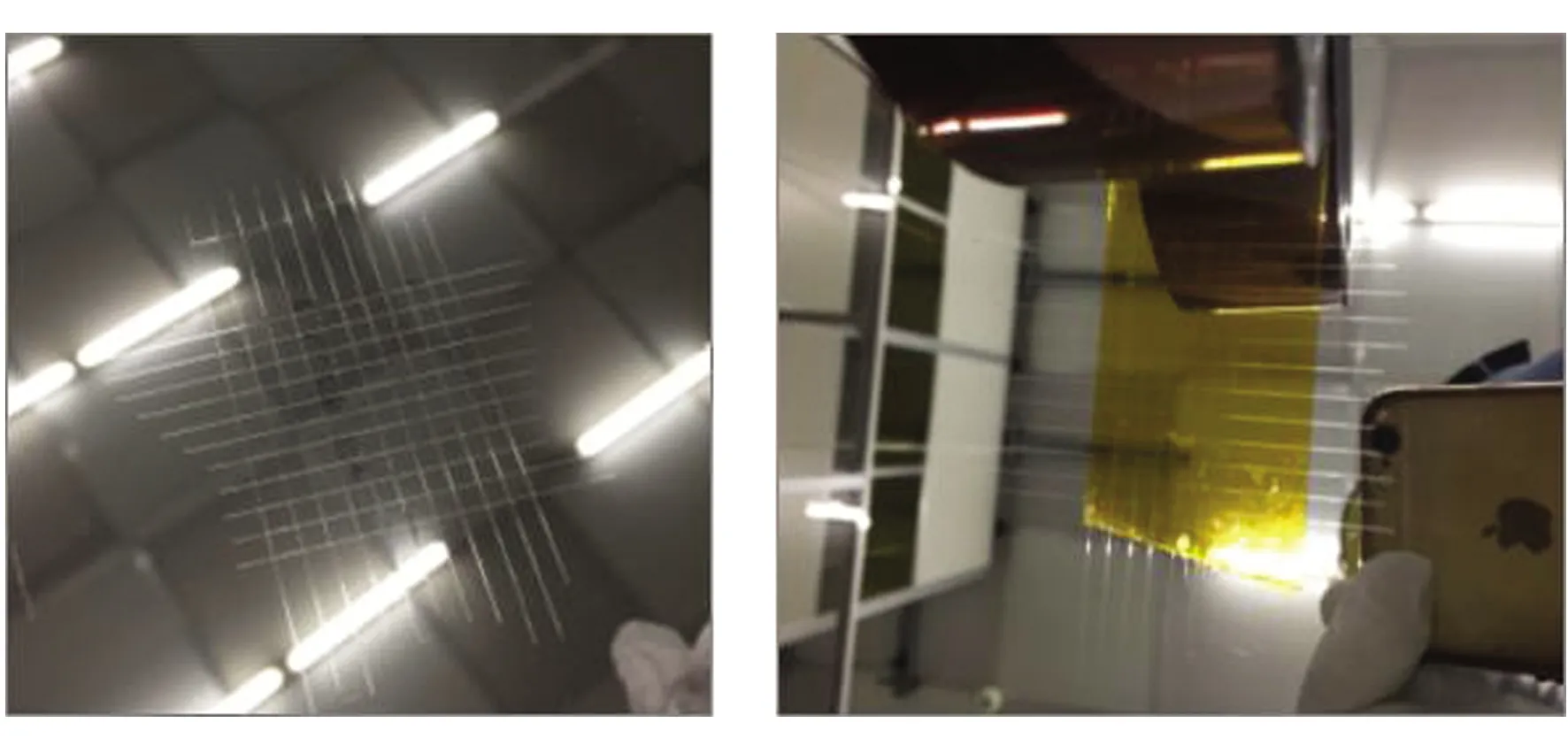
圖7 粘附力測試方式
圖8是百格測試結果。其中,MoOx和玻璃基板之間的粘附性很好,無MoOx膜層剝落的發生。在MoOx和Al金屬常用的搭配中,MoOx與Al之間的粘附性好,與Mo之間的粘附性很差:搭配Al/Mo只有極少量膜層剝落的發生;搭配Mo/Al/Mo有部分膜層剝落;搭配單層Mo,整片膜層剝落。在和Cu金屬常用的搭配中,MoOx和Cu之間的粘附性較好,和MTD之間的粘附性較差:搭配Cu/MTD有少量膜層剝落;搭配MTD/Cu,可見大面積膜層的剝落。

圖8 MoOx薄膜和不同金屬材料粘附性測試結果
總結測試結果:MoOx和玻璃基板之間粘附性很好,生產上可以在玻璃上直接沉積MoOx薄膜。MoOx和Al系常用金屬搭配中,粘附性Al/Mo>Mo/Al/Mo>單層Mo;與Cu系常用金屬搭配中,粘附性Cu/MTD>MTD/Cu。考慮到MTD、MoNb等同為Mo的合金靶,可以預見,MoOx和MoNb等Mo合金材料具有和Mo及MTD相似的粘附性。
3.5 反射率測試結果分析
反射率是MoOx薄膜作為低反材料在窄邊框工藝應用過程中的重要技術參數。在反置的TFT結構設計中,是從TFT側即玻璃基板背部一側體現視覺效果的(圖9),故本文的反射率和色差數據是MoOx薄膜搭配金屬層,并從玻璃基板側測得的,如圖10所示。

圖9 低反材料MoOx在窄邊框結構設計應用

圖10 反射率測試方式
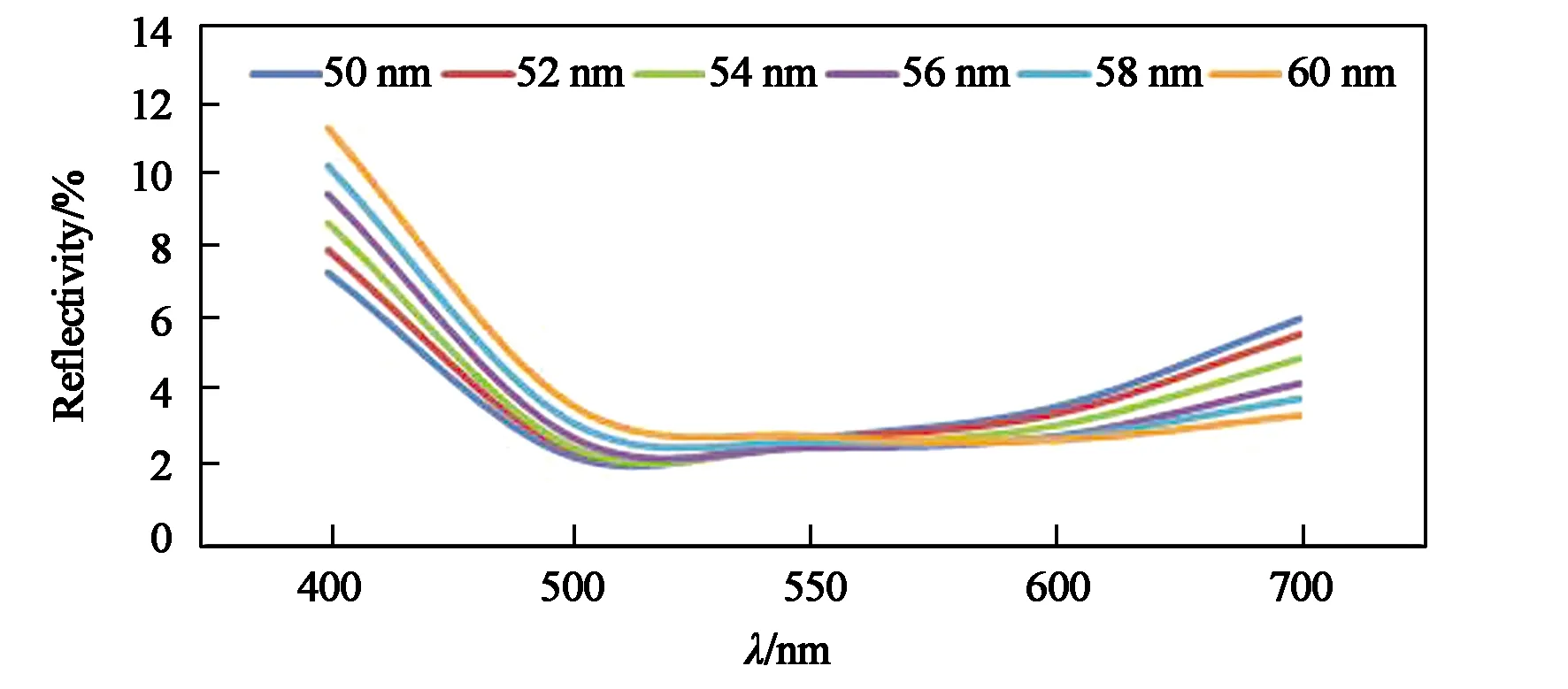
圖11 不同厚度MoOx搭配Mo/Al/Mo的反射率
圖11是在成膜功率13/11 kW、壓力0.67 Pa的條件下制備的不同厚度的MoOx薄膜搭配Mo/Al/Mo(15/300/80 nm)的反射率測試數據。從中可以看出,隨著MoOx薄膜厚度的增加,長波段光波對應的反射率降低,短波段光波對應的反射率增加。此現象推測與光的干涉效應有關。當從MoOx薄膜表面反射出的光波和金屬層表面反射的光波在傳播方向、頻率和振動方向相同,相位趨于相反時,光波會發生相互干擾和抵消。MoOx厚度增加時,長波段光波發生干擾和抵消現象增多,由此產生長波段光波反射率降低的現象。

圖12 不同功率制備MoOx(55 nm)搭配Mo/Al/Mo的反射率

圖13 不同成膜壓力制備MoOx(55 nm)薄膜搭配Mo/Al/Mo的反射率
圖12是在成膜壓力0.67 Pa、不同沉積功率條件下制備的55 nm MoOx薄膜搭配Mo/Al/Mo(15/300/80 nm)的反射率測試數據。從中可以看出,MoOx薄膜的成膜功率對反射率基本無影響。圖13是在成膜功率13/11 kW、不同成膜壓力條件下制備的55 nm MoOx薄膜搭配Mo/Al/Mo(15/300/80 nm)的反射率測試數據。由圖可知,MoOx薄膜的成膜壓力對反射率也基本沒有影響。
綜合圖11~圖13的測試結果可知:MoOx薄膜搭配金屬層復合膜的反射率和MoOx的厚度相關性大,與其成膜功率、壓力等工藝條件相關性小。
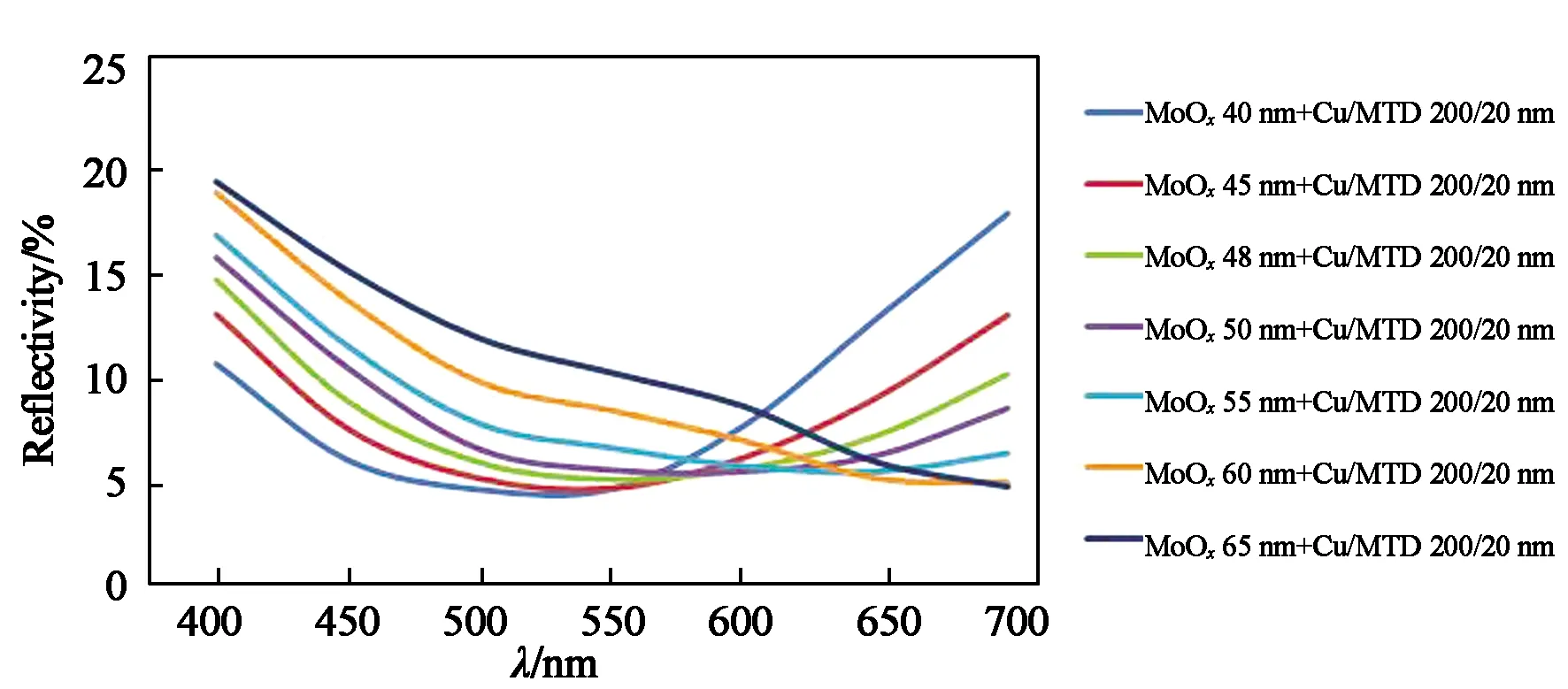
圖14 不同厚度MoOx薄膜搭配Cu/MTD的反射率
圖14是在成膜功率13/11 kW、壓力0.67 Pa的條件下制備的不同厚度的MoOx薄膜搭配Cu/MTD(200/20 nm)的反射率測試數據。從中可以看出,同搭配Mo/Al/Mo一樣,隨著MoOx薄膜厚度的增加,長波段光波對應的反射率降低,短波段光波對應的反射率增加。對比圖14和圖11可知,MoOx薄膜搭配不同的金屬材料,其反射率曲線不同。搭配Cu/MTD時,不同厚度MoOx薄膜的反射率曲線最低點對應的光波波長更長,分析原因可能為Cu/MTD界面反射的光波中長波段光波比例較Mo/Al/Mo反射的光波高,此部分光波和MoOx薄膜表面反射出的長波段光波相互干擾和抵消導致。可見,MoOx薄膜搭配的金屬種類對其反射率影響同樣較大。
圖15是相同厚度的55 nm MoOx薄膜和不同厚度的Cu/MTD搭配時的反射率曲線。從中可知,金屬層的厚度對反射率的影響不大。

圖15 MoOx薄膜和不同厚度Cu/MTD的反射率
3.6 色差測試結果分析
MoOx薄膜在反置TFT產品的應用上,除了反射率之外,色差是另一個重要的性能參數,且不同的客戶可能會有不同的色差喜好,測試色差的影響因素很有必要。
圖16是不同厚度的MoOx薄膜搭配Al/Mo及Cu/MTD復合膜的CIE Lab色空間坐標圖。從中可以看出,MoOx搭配不同的金屬層,其呈現出的色差不同。MoOx搭配Al/Mo時,隨著MoOx薄膜厚度的增加,b*值向負方向變化,a*值變化不大,即由黃褐色逐漸向偏藍方向變化;MoOx搭配Cu/MTD時,隨著MoOx薄膜厚度的增加,a*值逐漸減小并向負方向變化,b*值向負方向輕微下降,即由紅褐色逐漸向偏藍方向變化。
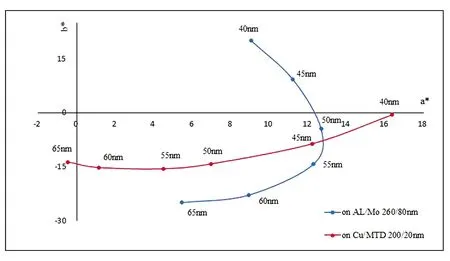
圖16 不同厚度MoOx薄膜和不同金屬的CIE Lab色坐標
圖17是55 nm的MoOx薄膜搭配不同厚度的Cu/MTD的CIE Lab色空間坐標圖。從中可以看出,隨著Cu薄膜厚度的增加,其坐標值幾乎無變化;b*值只是向負方向極輕微下降(即向偏藍方向變化),但其變化幅度很小。可見,同反射率一樣,金屬層厚度對復合膜色差的影響同樣不大。

圖17 MoOx薄膜和不同厚度Cu/MTD的CIE Lab色坐標
4 結 論
本文分析了磁控濺射法在不同功率、不同成膜壓力條件下制備的MoOx薄膜及搭配金屬層的特性,結果表明:常溫條件下磁控濺射法制備的MoOx薄膜是一種非晶結構的黑色透明導電膜,其方塊電阻值很大,搭配金屬層時可以忽略;MoOx薄膜呈壓應力狀態,隨成膜功率的增大而增大,隨成膜壓力的升高而降低。MoOx薄膜材料和玻璃之間的粘附性較好,可以直接沉積無需打底膜;和Al、Cu之間的粘附性較Mo及Mo合金材料好。MoOx和金屬層組成復合膜時,其反射率和色差主要由MoOx的厚度以及金屬材料的種類決定。

