LDMOS器件抗輻射關鍵工藝研究
劉 旸,于姝莉
(中國電子科技集團公司第四十七研究所,沈陽110032)
1 引言
功率MOS器件,特別是LDMOS(Laterally Diffused Metal Oxide Semiconductor,橫向擴散金屬氧化物半導體)器件的漏極、柵極和源極都在芯片表面,容易和低壓MOS及TTL器件形成工藝集成,因此廣泛地應用于開關穩(wěn)壓電源、驅動器等功率集成電路領域,目前已經(jīng)成為電力電子器件發(fā)展的主流。同時,電源作為電子電力系統(tǒng)必不可少的模塊,在航空、航天、核電等輻射環(huán)境中應用非常廣泛[1]。為了保證電壓類及驅動類電子元器件在復雜的輻射環(huán)境下可以穩(wěn)定工作,開展LDMOS器件抗輻射工藝的研究極為必要。
2 LDMOS器件輻射失效
2.1 器件結構
LDMOS是一種雙擴散結構的功率器件,縱向工藝結構如圖1所示[2]。多晶硅電極伸展至漂移區(qū)的場區(qū)SiO2上方,成為場區(qū)極板。延伸的場區(qū)極板能夠起到弱化漂移區(qū)表面電場的作用,有助于提高LDMOS器件的擊穿電壓[3-4]。
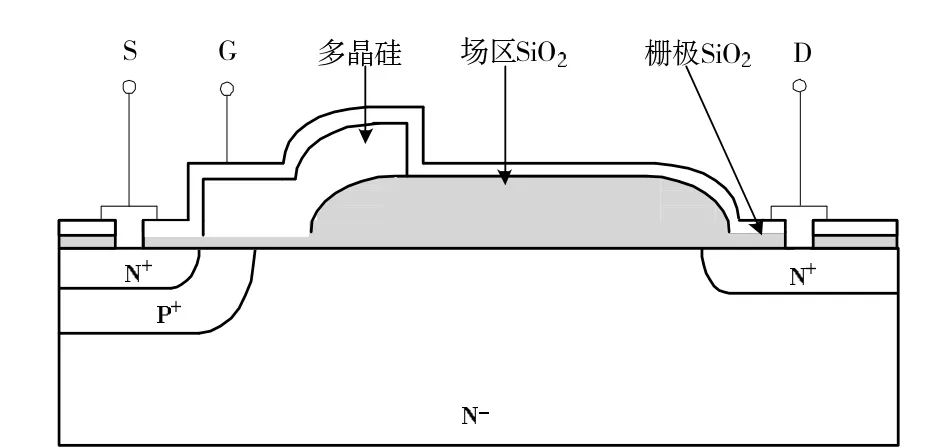
圖1 LDMOS結構
2.2 輻射失效機理
LDMOS器件的結構決定了多晶硅電極下方存在較厚的SiO2。在輻射環(huán)境中,電離輻射會在SiO2中激發(fā)出電子-空穴對,電子空穴對的復合速度低于產(chǎn)生速度。在無外加電應力的情況下,未能及時被電子復合的空穴會被陷阱俘獲形成感生界面陷阱電荷。在施加電應力的情況下,輻射感生的電子空穴對在電場的作用下被分開。由于電子的遷移率要高于空穴的遷移率,電子被電場迅速掃出,而部分未與電子復合的空穴則會被陷阱所俘獲,進而形成更多界面陷阱電荷或氧化層陷阱電荷[5-6]。
在輻射環(huán)境下形成的界面陷阱電荷和氧化層陷阱電荷會造成LDMOS器件柵氧化層的耐壓能力下降。在柵極施加電壓時,多余的正電荷會變成額外施加到柵端的電場,使器件的閾值電壓負向漂移,造成器件失效[7-8]。
3 抗輻射關鍵工藝研究
輻射環(huán)境下SiO2層產(chǎn)生的電子空穴對中,未能及時被電子復合的空穴被陷阱俘獲形成的缺陷陷阱電荷是LDMOS器件在輻射環(huán)境中失效的原因之一,即增加SiO2層對空穴的復合能力,能夠提高LDMOS器件的抗輻射加固能力。因此,可以考慮在熱氧化生長過程中增加氧化層內的負電荷含量,增加空穴被復合的機率,提高LDMOS器件的抗輻射能力。工藝線生產(chǎn)過程中常用的Cl-,是一種很好的負電荷來源。
根據(jù)熱運動原理,環(huán)境溫度越高,原子運動速度越快,得到的能量也越高,運動中的原子在接近另一個原子時,若吸引能大于排斥能,兩個原子就結合在一起,形成共價鍵。因此,當原子動能不足時,兩個原子的鍵合能越低,就越容易形成共價鍵。Si-Cl化合物為分子結構,鍵合能為3.75eV,而SiO2為原子結構,Si-O鍵合能為4.25eV。因此,SiO2生長環(huán)境中含有Cl-離子時,Si會先與Cl-反應生成Si-Cl化合物,再與O2反應生成SiO2。而當SiO2生長溫度足夠低時,生長的氧化層中會固化大量的Cl-離子,達到增加氧化層內負電荷數(shù)量的目的。
SiO2生長方式有干氧氧化、H2/O2合成、水汽氧化三種。由于水汽氧化生長的氧化層致密度太低,目前已經(jīng)棄用。干氧氧化方式生長的SiO2具有致密性高、針孔密度低的優(yōu)點,但所需的熱氧化溫度也較高。常規(guī)采用的熱氧化工藝氧化溫度達到1000℃以上。這種溫度下,能夠形成穩(wěn)定的Si-O鍵,但無法留存足夠的Cl-離子。H2/O2合成方式生長的SiO2雖然致密性不如干氧氧化,但可以在更低的溫度下生長SiO2。由于生長溫度更低,SiO2內留存的Cl-離子數(shù)量也更多。可保證氧化層均勻性的熱氧化爐最低爐溫為850℃,因此,設計選用850℃下H2/O2合成的方式生長抗輻射加固SiO2。
具體工藝加工流程設計如下:
通入高純N2→升溫至850℃→載片舟出爐→裝入晶圓片→載片舟入爐→停止N2輸入并通入O2→通入反偏二氯乙烯→停止反偏二氯乙烯輸入→5分鐘后通入H2→停止H2輸入→停止O2輸入并通入高純N2→載片舟出爐→取出晶圓片。
由于反偏二氯乙烯與H2同時存在于管道中會生成HCl,造成生長的SiO2質量下降,因此需將反偏二氯乙烯與H2分不同時段通入。
工藝設計完成后,用干氧氧化和抗輻射氧化的方式分別制備SiO2層,采用C-V電荷測試的方式評估氧化層中的氧化層固定電荷Qf和可動離子電荷Qm數(shù)量。測試結果如表1所示:

表1 C-V電荷測試結果
由表1的測試結果可知,抗輻射氧化工藝所生長的氧化層內的正電荷數(shù)量明顯下降,在個別測試區(qū)域甚至并出現(xiàn)了固定電荷為負值的情況,此種情況表明在氧化層內固定了大量的負電荷,達到工藝開發(fā)的預期。
4 輻照實驗驗證
分別采用原工藝和新開發(fā)工藝制備LDMOS器件。采用原工藝加工的N型和P型LDMOS器件各2只,分別編號為N1Q~N2Q和P1Q~P2Q;選取采用新開發(fā)工藝加工的N型和P型LDMOS器件封裝6只,分別編號為N1H~N3H和P1H~P3H。將所選取的10只試驗電路同時進行總劑量輻照試驗。實驗結果如表2及表3所示。
由表2和表3的實驗結果可見,采用新設計工藝的6只LDMOS電路在總劑量輻照試驗后閾值電壓和擊穿電壓的變化量均未超過10%。而采用原工藝的4只LDMOS電路在總劑量輻照試驗后N型LDMOS已經(jīng)耗盡,P型LDMOS的閾值電壓變化率在50%以上,因此證明新設計工藝有效,驗證了將負電荷固定在氧化層中可以提高SiO2抗輻射加固能力。

表2原工藝LDMOS器件輻照實驗結果

表3新工藝LDMOS器件輻照實驗結果
5 結束語
在對LDMOS器件在輻射環(huán)境中的失效機理的分析中可以預見,在氧化層中固定負電荷能夠提高降低輻射環(huán)境中SiO2的缺陷電荷產(chǎn)生數(shù)量,進而提高LDMOS器件抗總劑量能力。通過實驗驗證,采用新工藝制造的器件抗總劑量能力確實高于原工藝,理論的正確性與實用性得到驗證,也為高壓產(chǎn)品抗輻射加固研究提供了有力的技術參考。

