配置不同類型探測(cè)器的X射線熒光測(cè)厚儀對(duì)比研究
尹麗晶,武利會(huì),陳美靜
(1.中國(guó)電子科技集團(tuán)公司第十三研究所,石家莊 050051; 2.國(guó)家半導(dǎo)體器件質(zhì)量監(jiān)督檢驗(yàn)中心,石家莊 050051)
引言
作為半導(dǎo)體元器件表面防腐的重要手段,金屬鍍層的質(zhì)量直接關(guān)系著電子元器件的工作性能、壽命和可靠性。因此,對(duì)鍍層厚度的準(zhǔn)確測(cè)量越來越受到生產(chǎn)單位和檢測(cè)機(jī)構(gòu)的關(guān)注。作為評(píng)價(jià)鍍層質(zhì)量的重要參數(shù),鍍層厚度只有在一定的范圍內(nèi)才能起到作用,符合使用要求:太薄影響表面性能達(dá)不到目的,太厚會(huì)造成浪費(fèi)和應(yīng)力過大。因此,對(duì)鍍層厚度進(jìn)行準(zhǔn)確檢測(cè)十分重要,受到生產(chǎn)和檢測(cè)機(jī)構(gòu)越來越多的關(guān)注。目前金屬鍍層厚度的測(cè)量方法主要分為無損法和破壞法兩類。根據(jù)相關(guān)標(biāo)準(zhǔn)的規(guī)定[1],無損法有X射線光譜法和反向散射法等,破壞法包括橫斷面顯微鏡法(金相切片法)、稱量法和陽極溶解庫(kù)倫法等。
1 X射線熒光分析法
X射線熒光分析法,具有被測(cè)樣品不受破壞,分析迅速、準(zhǔn)確,便于實(shí)現(xiàn)自動(dòng)分析檢測(cè)等優(yōu)點(diǎn),成為目前工業(yè)上應(yīng)用最為廣泛的方法之一。
1.1 X射線熒光分析的基本原理
X射線熒光分析法的工作原理為采用高能X射線轟擊鍍層表面,將電子逐出原子形成空穴,由外層電子來填充這個(gè)空穴,多余的能量就會(huì)以X射線熒光的形式釋放,使被測(cè)鍍層產(chǎn)生X射線熒光(也稱為二次X射線),如圖1所示。由于X射線熒光譜線為各種元素所特有,通過對(duì)X射線熒光譜線的收集和分析,以其波長(zhǎng)確定所測(cè)元素,根據(jù)其光的強(qiáng)度和能量確定鍍層的厚度[2]。
1.2 X射線熒光測(cè)厚儀的基本結(jié)構(gòu)
能量色散型X射線熒光測(cè)厚儀主要由X射線發(fā)生器、檢測(cè)系統(tǒng)、信號(hào)處理系統(tǒng)3部分構(gòu)成。其核心部件包括X射線管、濾波器、準(zhǔn)直器、探測(cè)器、多通道脈沖分析器(MCA)等,如圖2所示。各部分均在鍍層厚度測(cè)試過程中發(fā)揮著重要作用。
X射線管:在熱電離作用下產(chǎn)生一次射線用于激發(fā)樣品;
一次濾波器:提高信噪比,改善檢測(cè)下限;
準(zhǔn)直器:限制激發(fā)的射線光斑的大小,提供滿足樣品需求的射線光斑;

圖1 X射線熒光原理圖
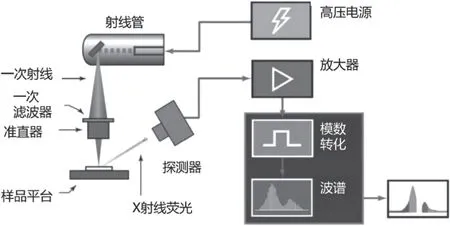
圖2 X射線熒光測(cè)厚儀構(gòu)成示意圖
探測(cè)器:檢測(cè)樣品表面被一次射線激發(fā)出的X射線熒光,記錄信號(hào)強(qiáng)度;
MCA:根據(jù)探測(cè)器收集的X射線熒光能量分配到相應(yīng)的通道中進(jìn)行累積分析。
2 不同類型探測(cè)器對(duì)比
作為X射線熒光測(cè)厚儀的重要組成部分,探測(cè)器是一種變換能量形式的裝置,能夠把X射線光子信號(hào)轉(zhuǎn)換成可計(jì)量測(cè)定的電脈沖信號(hào)。目前市場(chǎng)上使用的探測(cè)器按照結(jié)構(gòu)主要分為兩大類:氣態(tài)探測(cè)器和固態(tài)半導(dǎo)體探測(cè)器。封氣正比計(jì)數(shù)器是典型的氣態(tài)探測(cè)器,其原理是以X射線的光電效應(yīng)為基礎(chǔ)把X射線轉(zhuǎn)換成可測(cè)量的電壓脈沖,脈沖幅度與X射線能量成正比。固態(tài)半導(dǎo)體探測(cè)器主要包括Si-PIN二極管探測(cè)器和硅漂移探測(cè)器(SDD),X射線光子入射到探測(cè)器后形成一定數(shù)量的電子-空穴對(duì),電子-空穴對(duì)在電場(chǎng)作用下形成電脈沖,脈沖幅度與X射線光子的能量成正比。在一段時(shí)間內(nèi),來自樣品的熒光X射線依次被半導(dǎo)體探測(cè)器檢測(cè),得到一系列幅度與光子能量成正比的脈沖,經(jīng)放大器放大后送到多通道脈沖分析器(MCA)。
2.1 氣態(tài)和固態(tài)半導(dǎo)體探測(cè)器
氣態(tài)探測(cè)器和固態(tài)半導(dǎo)體探測(cè)器在性能上有著比較明顯的差異,如表1所示,在分辨率性能和計(jì)數(shù)率方面,SDD>Si-PIN>封氣正比計(jì)數(shù)器;環(huán)境溫濕度對(duì)封氣正比計(jì)數(shù)器影響較大,容易造成峰位漂移,對(duì)SDD和Si-PIN探測(cè)器影響較小;在使用壽命方面,固態(tài)半導(dǎo)體探測(cè)器明顯優(yōu)于氣態(tài)探測(cè)器;在儀器成本方面,SDD探測(cè)器則遠(yuǎn)高于其他兩種。

表1 不同類型探測(cè)器參數(shù)對(duì)比
元素分辨率是X射線熒光測(cè)厚儀的重要參數(shù)之一,分辨率數(shù)值越低,測(cè)厚儀對(duì)元素的檢測(cè)下限越低,對(duì)微量元素的檢測(cè)能力越高,并且能夠在譜圖分析時(shí)有效排除元素之間的相互干擾。
圖3顯示的是氣態(tài)探測(cè)器和固態(tài)半導(dǎo)體探測(cè)器對(duì)同一樣品進(jìn)行測(cè)量時(shí)收集形成的譜圖,橙色為氣態(tài)探測(cè)器(封氣正比計(jì)數(shù)器)所獲得的譜峰,綠色為固態(tài)半導(dǎo)體探測(cè)器(Si-PIN)所獲得的譜峰,可以看到,氣態(tài)探測(cè)器所獲取的譜峰重疊現(xiàn)象嚴(yán)重,這會(huì)對(duì)之后的分析計(jì)算過程造成很大影響,進(jìn)而影響測(cè)厚儀對(duì)鍍層厚度的準(zhǔn)確測(cè)量。

圖3 氣態(tài)探測(cè)器和固態(tài)半導(dǎo)體探測(cè)器獲得的譜峰對(duì)比
2.2 Si-PIN和SDD探測(cè)器
氣態(tài)和固態(tài)半導(dǎo)體探測(cè)器的性能差異明顯,而對(duì)于同為固態(tài)半導(dǎo)體探測(cè)器的Si-PIN和SDD探測(cè)器,在分辨率性能方面也存在不同。圖4展示了Si-PIN和SDD探測(cè)器獲得的Fe、Cr和Ni元素譜圖,在相同的測(cè)試條件下,SDD探測(cè)器顯示出了更高的信號(hào)靈敏度,收集到了更多的有效信號(hào)用于分析計(jì)算,這在改善測(cè)厚儀的輕元素信號(hào)靈敏度和穩(wěn)定性方面都有著重要作用。
有數(shù)據(jù)顯示,典型的SDD探測(cè)器在分辨率方面的性能遠(yuǎn)遠(yuǎn)超過典型的Si-PIN二極管探測(cè)器[3],如圖5。例如,在峰值時(shí)間10 μs,操作溫度-25 ℃的條件下,典型的SDD探測(cè)器在峰值為5.9 keV時(shí)能夠達(dá)到136 eV的半峰寬(FWHM)分辨率,這比在相同的操作條件下的Si-PIN二極管探測(cè)器優(yōu)化了52 eV。更高的分辨率能夠在XRF分析中檢測(cè)到信號(hào)更低的元素。

圖4 Si-PIN和SDD探測(cè)器獲得的譜峰對(duì)比

圖5 PIN二極管探測(cè)器和高端SDD探測(cè)器的典型分辨率隨峰值時(shí)間的變化。所有測(cè)試操作溫度均為-25 ℃,能量為5.9 keV,使用Fe-55源照射。SDD探測(cè)器所用數(shù)據(jù)來自KETEK GmbH的公開數(shù)據(jù)[4]。
3 鍍層厚度測(cè)試及分析
3.1 金屬鍍層結(jié)構(gòu)
為了提高產(chǎn)品鍍層的防護(hù)能力和抗腐蝕效果,越來越多的電子元器件生產(chǎn)廠家采用復(fù)合金屬鍍層的結(jié)構(gòu),以鎳金復(fù)合鍍層為例,其鍍層結(jié)構(gòu)如圖6所示[5]。由于復(fù)合金屬鍍層的特殊性,使用X射線熒光測(cè)厚法無法對(duì)每一鍍層的厚度進(jìn)行區(qū)分。按照生產(chǎn)檢驗(yàn)環(huán)節(jié)對(duì)鍍層厚度測(cè)量的要求,需要對(duì)鍍金層總厚度和鍍鎳層總厚度進(jìn)行測(cè)量。這需要試驗(yàn)人員在實(shí)際測(cè)試過程中根據(jù)待測(cè)樣品的情況建立能夠滿足要求的測(cè)試程序,并通過標(biāo)準(zhǔn)片進(jìn)行校準(zhǔn)測(cè)試,才能夠得到較為準(zhǔn)確的測(cè)試結(jié)果。
3.2 鍍層厚度測(cè)試方法
工業(yè)生產(chǎn)中的實(shí)際樣品,其金屬鍍層厚度各有差異,無法在測(cè)試前得到其準(zhǔn)確厚度,因此本文采用經(jīng)過計(jì)量的標(biāo)準(zhǔn)片模擬復(fù)合鍍層結(jié)構(gòu)進(jìn)行測(cè)量,以鎳金復(fù)合鍍層為模擬對(duì)象。由于大部分金屬外殼采用鐵、鐵鎳或鐵鈷鎳(可伐)作為基體材料,同時(shí)為了排除基材中的鎳對(duì)鍍層中的鎳造成影響,選用鐵的純?cè)仄瑸榛摹8鶕?jù)常見的鎳金復(fù)合鍍層厚度范圍,確定待測(cè)樣品的鍍層結(jié)構(gòu)為2.1 μm Au/4.63 μm Ni/0.24 μm Au/0.91 μm Ni/Inf Fe(2.34 μm Au/5.54 μm Ni/ Inf Fe)。試驗(yàn)前,根據(jù)樣品情況建立合適的測(cè)試程序,并用標(biāo)準(zhǔn)片進(jìn)行校準(zhǔn)測(cè)量,使測(cè)試程序處于正常狀態(tài)。試驗(yàn)過程中,為了盡量排除其他因素對(duì)結(jié)果的影響,使用的三臺(tái)X射線熒光測(cè)厚儀為同一廠家生產(chǎn),除探測(cè)器外其他各項(xiàng)參數(shù)調(diào)整為一致,使用相同的測(cè)試程序進(jìn)行試驗(yàn),在相同的條件下重復(fù)測(cè)試5次。將三臺(tái)儀器編號(hào)為1#(封氣正比計(jì)數(shù)器)、2#(Si-PIN探測(cè)器)和3#(SDD探測(cè)器)。

圖6 鍍層結(jié)構(gòu)示意圖
3.3 測(cè)試結(jié)果及分析
使用三臺(tái)配置不同型號(hào)探測(cè)器的X射線熒光測(cè)厚儀標(biāo)準(zhǔn)片模擬的符合鍍層進(jìn)行測(cè)量,分別測(cè)量了其鍍金層總厚度(總Au)和鍍鎳層總厚度(總Ni),結(jié)果分別見表2~4。測(cè)試用標(biāo)準(zhǔn)片的總Au厚度為2.34 μm,總Ni厚度為5.54 μm,分別對(duì)三組測(cè)試數(shù)據(jù)的平均值、標(biāo)準(zhǔn)偏差、相對(duì)標(biāo)準(zhǔn)偏差和極差進(jìn)行了計(jì)算,從數(shù)據(jù)結(jié)果可以明顯看出,相比于氣態(tài)探測(cè)器(1#),固態(tài)半導(dǎo)體探測(cè)器(2#和3#)在測(cè)試結(jié)果的準(zhǔn)確性和穩(wěn)定性方面表現(xiàn)出明顯的優(yōu)勢(shì)。同時(shí),就固態(tài)半導(dǎo)體探測(cè)器而言,SDD探測(cè)器的測(cè)試結(jié)果比Si-PIN探測(cè)器更為準(zhǔn)確和穩(wěn)定,但兩者之間的差異遠(yuǎn)小于與封氣正比計(jì)數(shù)器之間的差異。

表2 1#測(cè)試結(jié)果

表3 2#測(cè)試結(jié)果

表4 3#測(cè)試結(jié)果
4 結(jié)論
作為X射線熒光測(cè)厚儀的重要組成部分,探測(cè)器直接影響到測(cè)厚儀的分辨率、穩(wěn)定性和使用壽命。氣態(tài)探測(cè)器的各方面性能均不及固態(tài)半導(dǎo)體探測(cè)器,不推薦使用;SDD探測(cè)器性能優(yōu)于Si-PIN探測(cè)器,但在考慮成本的情況下,也可選擇Si-PIN探測(cè)器,同時(shí)通過選擇有效的測(cè)試程序、延長(zhǎng)分析時(shí)間等方法來優(yōu)化測(cè)試結(jié)果。

