GaN基垂直腔面發射激光器的研究進展
應磊瑩,梅 洋,張保平
(廈門大學電子科學與技術學院,福建 廈門 361005)
垂直腔面發射激光器(VCSEL)是一種出光方向垂直于晶圓表面的半導體激光器.與傳統的側面出光的邊發射激光器(EEL)相比,VCSEL有更短的諧振腔與更小的器件尺寸,因此其閾值電流低,能實現單縱模工作以及高速調制.同時,VCSEL的激光光束具有極好的圓形對稱特性,能與光纖進行高效耦合.垂直腔面發射出光的器件結構使其可以被制備成高密度的二維器件陣列,實現更高的輸出功率[1].
VCSEL早期研究主要集中在紅光與近紅外波段.1977年東京大學的Iga首次提出VCSEL的構想[2],此后在1979年與1987年,他所在研究組在77 K溫度下分別實現了首支GaInAsP/InP與GaAs/AlGaAs的電注入脈沖激射VCSEL[3-4],并于1989 年實現了GaAs/AlGaAs VCSEL的室溫連續激射[5].在這之后GaAs基VCSEL便開始迅速發展,在1997年實現了最早的商業化應用.目前近紅外波段的GaAs基VCSEL已經在高速以太網、短距離光通信、數據中心以及超級計算機中的光互聯、光纖局域網等應用領域中占據了絕大部分市場.2018年,Apple公司iPhone X(https:∥www.apple.com.cn)所搭載的基于VCSEL陣列的三維面部識別傳感器則為VCSEL開辟了一個新的廣闊應用領域,深度傳感也被業界認為是VCSEL技術從工業界轉向消費領域的一個重大突破.此外VCSEL也在醫療、紅外照明、激光雷達、原子鐘等方面有著廣泛的應用.
與GaAs基VCSEL的迅速發展并且成功實現商業化應用相比,GaN基VCSEL前期的發展較為緩慢,這與GaN材料本身的特性直接相關.GaN是一種第三代半導體材料,具有寬禁帶、直接帶隙、高發光效率、高振子強度等優點,通過調整合金組分,其發光波長可以覆蓋整個可見光范圍,因此是制備發光二極管(LED)以及激光二極管(LD)等光電器件的理想材料[6].但是早期GaN材料面臨著高質量外延生長與p型摻雜的難題,極大地限制了GaN基光電器件的發展.直到20世紀90年代,赤崎勇、天野浩與中村修二等使用低溫成核層以及兩步生長法制備出高質量的GaN單晶薄膜,并且解決了p型摻雜的難題,GaN基光電器件才開始迅速發展[7-9].2014年他們三人因在GaN基藍光LED中做出的卓越貢獻被授予諾貝爾物理學獎.此后GaN基VCSEL開始逐步發展并吸引了眾多研究者的注意,陸續有眾多跨國企業和科研單位參與到器件的研發.企業主要來自日本,包括日亞化學工業株式會社(簡稱日亞)[10-12]、松下電器產業株式會社(簡稱松下)[13]、索尼[14-16]和史丹利電器公司[17-19];科研單位包括臺灣交通大學(NCTU)[20-24]、加州大學圣巴巴拉分校[25-31]、洛桑理工大學[32]、廈門大學[33-35]、名城大學[36-39]、耶魯大學[40]等.這也進一步說明了GaN基VCSEL具有極為誘人的應用前景.本文對照目前已經發展成熟的GaAs基VCSEL的發展狀況,綜述了GaN基VCSEL的應用領域、發展現狀以及技術路線,并著重介紹了近年來GaN基綠光VCSEL所取得的一系列研究進展,最后簡述了GaN基VCSEL所面臨的技術挑戰.
1 GaN基VCSEL的應用領域
GaN基VCSEL的發光波長主要在可見光波段,因此相比于近紅外波段的GaAs基VCSEL有著獨特的應用領域.其應用集中在半導體激光照明、可見光通信、激光投影與顯示、高密度光存儲、生物醫療、原子鐘等[22].
在激光照明領域,與EEL相比,VCSEL更加適用于需要高度方向性光源的應用場景,比如酒店、劇場、博物館等的情景照明、汽車與飛機頭燈等.而且VCSEL出光方向為表面垂直出光,與現有成熟的LED制備與封裝技術兼容,另外VCSEL可集成為高密度二維陣列,有望提供比單管EEL更高的發光功率.
在可見光通信方面,階躍型塑料光纖在570,650和780 nm附近為低損耗窗口,因此黃綠光波段GaN基VCSEL可用于塑料光纖通信,且其具有比LED以及EEL更大的調制帶寬[41].另外,470~540 nm波段是光在海水中傳播的低損耗窗口,因此藍綠光與綠光GaN基VCSEL也可應用于對海探測以及水下光通信領域[42].GaN基VCSEL在可見光通信中另一個重要應用為自由空間可見光通信,也被稱為光保真(LiFi)[43].作為LiFi系統的光源,GaN基VCSEL可以達到比LED與EEL更高的調制速率,因此有更強的競爭力.
在激光投影與顯示應用中,GaN基VCSEL發光波長可以完整覆蓋紅綠藍三基色,同時又有較好的方向性以及小發散角,因此非常適用于激光投影與顯示.由于其單色性,GaN基VCSEL可以覆蓋更廣的色域,實現更高的色彩飽和度.使用多個不同波長的綠光VCSEL,配合藍光與紅光VCSEL光源,理論上基本可以覆蓋全部色域,實現真正的全色顯示.另外,GaN基VCSEL的小體積以及低功耗也會使其更加適用于可移動或可穿戴電子設備如手機、智能手表、智能眼鏡等終端所集成的微投影設備中.
2 GaN基VCSEL的發展現狀與技術路線
GaN基VCSEL的研究最早開始于1995年,東京工業大學的Honda等[44]對GaN基VCSEL的閾值特性進行了相關計算.1996年,ATMI公司[45]報道了首個光泵GaN基VCSEL激射.
2008年,NCTU的Lu等[24]制備出世界上第一支電注入GaN基VCSEL,該器件實現了77 K溫度下連續激射,激射波長為462.8 nm,閾值電流密度為1.8 kA/cm2.此后日亞、松下、索尼、洛桑理工大學、廈門大學、名城大學、耶魯大學等研究單位都相繼報道了電注入GaN基VCSEL的室溫連續激射.至今,GaN基VCSEL已經成功覆蓋了從紫光至黃綠光的光譜范圍[35],最大單管光功率為24 mW[46],并且已經實現了發光功率超過1 W的藍光VCSEL陣列[17].
GaN基VCSEL中諧振腔所用反射鏡可分為混合分布布拉格反射鏡(DBR)結構和雙介質膜DBR結構.混合DBR結構中的上反射鏡為介質膜DBR,下反射鏡為氮化物DBR.而雙介質膜DBR結構中的上下反射鏡均為介質膜DBR.在已經商業化的GaAs基VCSEL中,上下兩個反射鏡全部為外延生長的AlAs/GaAs DBR.這是因為GaAs與AlAs晶格匹配,制備高反射率與高晶體質量的AlAs/GaAs DBR較為容易,這也是其能夠快速實現商業化的重要原因[2].但是在GaN基半導體材料系統中難以找到晶格匹配且同時具有高折射率差的兩種半導體材料,因此生長出具有高晶體質量、高反射率的氮化物DBR極為困難.為此,GaN基VCSEL通常采用混合DBR結構或者雙介質膜DBR結構.
2.1 混合DBR結構GaN基VCSEL
目前正在進行電注入混合DBR結構GaN基VCSEL研究的科研小組主要有NCTU、洛桑理工大學、名城大學以及史丹利電器公司.2008年NCTU報道的首支電注入GaN基VCSEL便采取了混合DBR結構[24],其下反射鏡為AlN/GaN DBR.由于GaN與AlN之間有約2.4%的晶格失配,他們在DBR內部插入AlN/GaN超晶格層進行應力調控,最終成功生長出無裂紋且反射率超過99.4%的氮化物DBR,如圖1所示.2012年,洛桑理工大學報道了具有41.5對Al0.8In0.2N/GaN的電注入混合DBR結構GaN基VCSEL[32],如圖2所示.當In組分為0.18時,AlInN與GaN晶格匹配,因此可以交替外延生長多層Al0.8In0.2N/GaN而不產生裂紋和缺陷.此后基于AlInN/GaN混合DBR結構的GaN基VCSEL的研究主要集中在名城大學與史丹利電器公司.通過優化DBR外延生長條件,名城大學實現了反射率分別高達99.9%與99.4%以上的紫光與綠光AlInN/GaN DBR[39].2016年名城大學報道了具有40對Al0.82In0.18N/GaN的混合DBR結構GaN基VCSEL,之后他們又連續報道了使用寬量子阱有源區[36]、具有導電性的AlInN/GaN的混合DBR結構VCSEL[37].2018年,史丹利電器公司與名城大學在器件中引入橫向SiO2波導層,使得器件最大輸出功率提升至6 mW[18].2019年,通過增加諧振腔長度改善了器件的散熱性能,器件光功率又大幅度提升至22 mW以上,并且器件最高工作溫度達到110 ℃[19].同年8月,他們又報道了16×16的VCSEL陣列[17],該陣列最大輸出功率達到1.19 W,同時具有良好的光束特性.
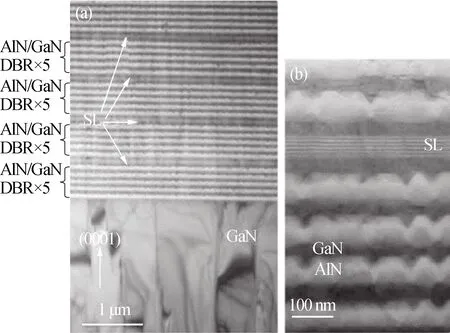
圖1 NCTU制備的插入超晶格的AlN/GaN DBR的透射電鏡圖[24]
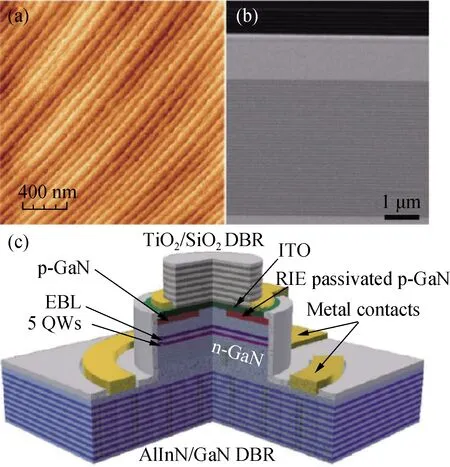
(a)表面原子力顯微鏡圖;(b)截面掃描電鏡(SEM)圖;(c)器件結構示意圖.
除了普通結構的氮化物DBR之外,新墨西哥大學于2019年報道了具有多孔結構下DBR的GaN基VCSEL[47],如圖3所示.制備下DBR時依次生長16對非摻雜/重摻雜的GaN外延層,之后使用電化學腐蝕方式在重摻雜GaN中形成納米孔洞.此種方式外延生長工藝更為簡單,且較大的折射率差能使得納米孔洞DBR具有較寬的高反帶.2020年,耶魯大學報道了具有導電的多孔結構下DBR的GaN基VCSEL室溫脈沖激射[40],電流從下DBR通過時并未對器件閾值特性與斜率效率產生不良影響,器件閾值電流密度42 kA/cm2,輸出功率0.12 mW.

圖3 新墨西哥大學所報道的納米孔DBR結構GaN基VCSEL[47]
2.2 雙介質膜DBR結構GaN基VCSEL
雙介質膜DBR結構VCSEL根據其制備方式有以下幾種不同結構,如圖4所示.圖4(a)為通過襯底轉移方式制備,此種方式需要去除原始襯底并將半導體薄膜進行轉移,增加了工藝復雜性,但同時也完全避開了外延生長氮化物DBR所面臨的困難.目前采用此種技術路線的研究單位主要有日亞、松下、廈門大學、NCTU、加州大學圣巴巴拉分校.圖4(b)和(c)分別為使用側向外延以及在襯底側直接制備球面形DBR的器件結構示意圖,目前索尼采用這兩種技術路線.
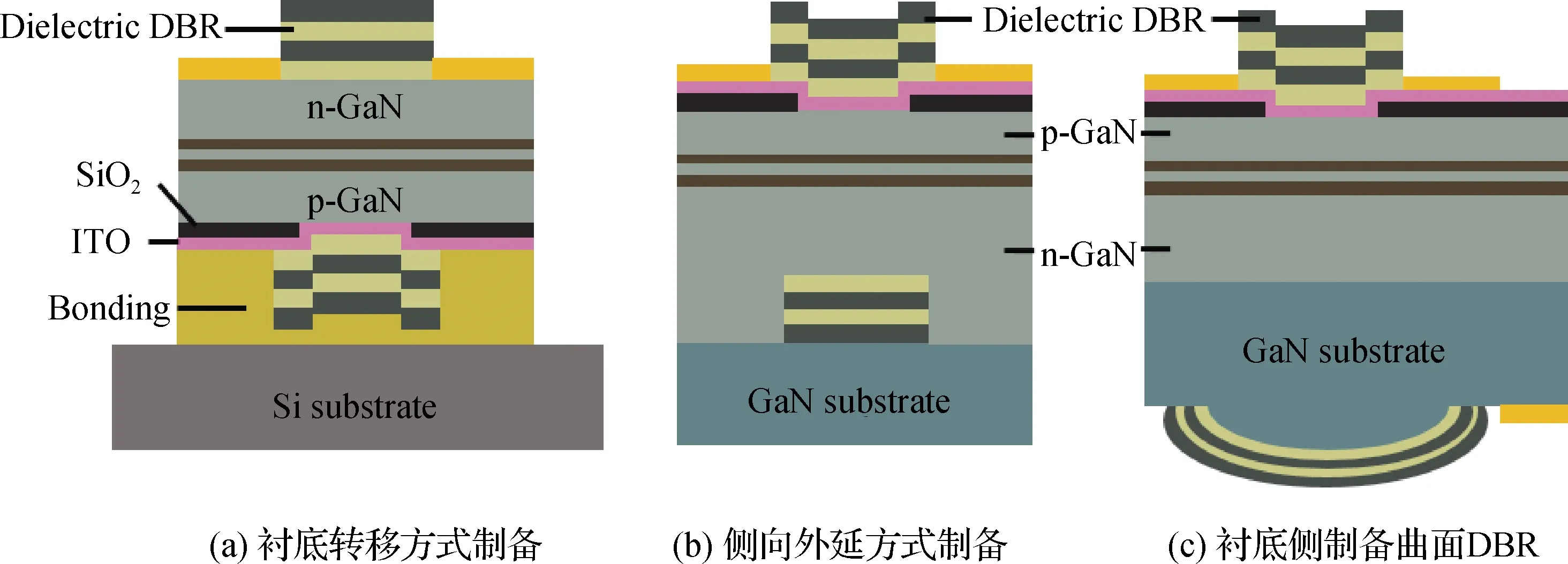
圖4 雙介質膜DBR GaN基VCSEL結構示意圖
2008年日亞報道了第一個雙介質膜DBR結構GaN基VCSEL,如圖5所示[10].上下兩個反射鏡分別為7與11.5對SiO2/Nb2O5介質膜DBR,激射波長414 nm,閾值電流密度13.9 kA/cm2,輸出功率0.14 mW.之后使用GaN襯底改善晶體質量,器件的發光功率提升至0.7 mW[12],并且實現了發光波長在503 nm的綠光VCSEL室溫脈沖激射[11].2014年,廈門大學[33]報道了具有類似結構的GaN基VCSEL,器件發光波長為422 nm,閾值電流密度為1.2 kA/cm2;進一步通過使用InGaN量子點作為有源區并且使用Cu襯底改善散熱性能,實現了綠光GaN基VCSEL的低閾值室溫連續激射,發光波長分布在479.6~565.7 nm之間,覆蓋了大部分綠光的范圍[34-35];同樣,利用InGaN量子阱中的局域態,并配合諧振腔效應,在2018年又報道了發光波長在493 nm的綠光VCSEL室溫連續激射[48].2020年NCTU報道了首個上反射鏡為介質膜光柵結構的電注入GaN基VCSEL[49-50],如圖6所示.器件下反射鏡為12對SiO2/Ta2O5介質膜DBR,上反射鏡由條形納米TiO2光柵構成.發光波長為405 nm,閾值電流Ith為25 mA.光柵上反射鏡使得器件具有優異的偏振特性.
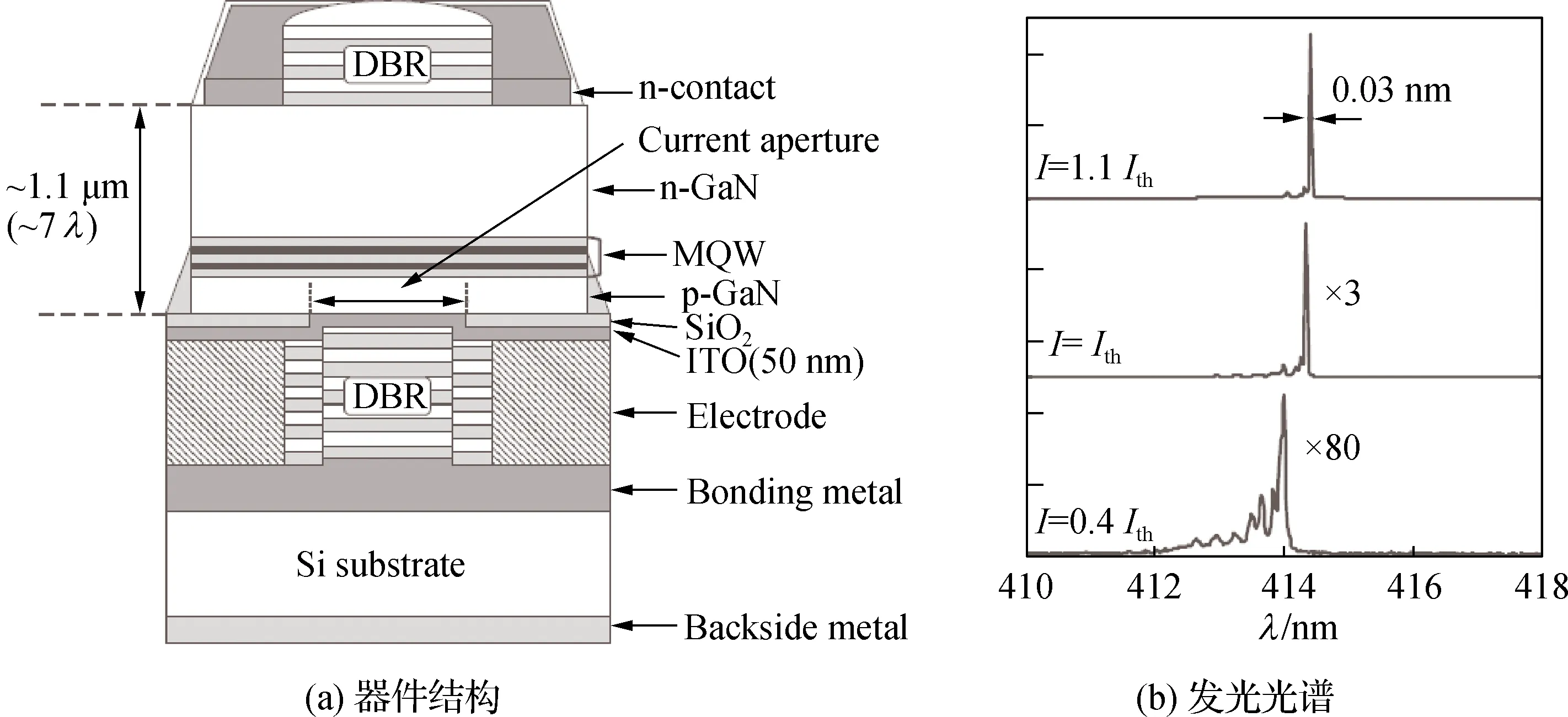
圖5 日亞所報道的雙介質膜DBR結構GaN基VCSEL[10]
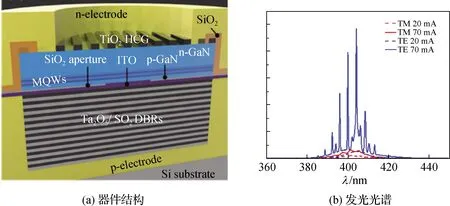
圖6 NCTU所報道的具有光柵結構上DBR的雙介質膜DBR GaN基VCSEL[49-50]
加州大學圣巴巴拉分校的相關研究主要集中在半極性與非極性GaN材料.與極性面(c面)InGaN量子阱相比,非極性面(m面)的量子阱有著更小的量子限制斯塔克效應(QCSE)、更低的透明載流子濃度以及更高的增益,同時器件發光也具有良好的偏振特性[51].2012年,他們報道了第一個非極性GaN基VCSEL[28],如圖7所示.外延襯底為m面GaN襯底,器件制備時使用電化學腐蝕的方式將襯底去除.在之后的2014—2018年間,他們又相繼報道了偏振度100%[27]、具有離子注入電流限制孔徑[29]、具有光化學腐蝕形成的空氣間隙型電流限制孔徑[30]、具有隧道結電流擴展層等不同結構的非極性GaN基VCSEL[25-26,31].2016年他們率先嘗試了對GaN基VCSEL進行高速調制測試,器件的-3 dB帶寬達到1 GHz[52].
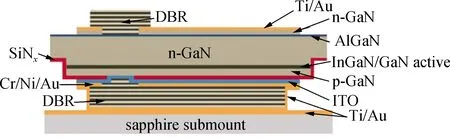
圖7 加州大學圣巴巴拉分校報道的非極性GaN基VCSEL[28]
為了避免襯底轉移過程中復雜的器件工藝,索尼在2015年與2018年分別報道了側向外延[16],以及在襯底側制備球面DBR[53]來進行器件制備的方法.側向外延是在生長半導體薄膜之前,先在GaN襯底上制備圖形化的介質膜DBR,之后通過調控外延生長條件將DBR掩埋在GaN外延層中,如圖8所示.但是側向外延需要較為苛刻的生長條件,且在橫向生長閉合的界面處位錯密度較大.直接在GaN襯底背面制備曲面介質膜反射鏡的器件結構如圖9所示,DBR分別位于p-GaN側與GaN襯底側,因此不需要將GaN襯底去除.由于腔長較長,需要使用曲面DBR對光場加以橫向束縛,減小衍射損耗[15].之后通過優化限制孔徑尺寸以及諧振腔長度,2019年索尼又分別實現了器件閾值電流為亞毫安量級以及最大輸出功率為15 mW具有曲面DBR結構的VCSEL[15,54].
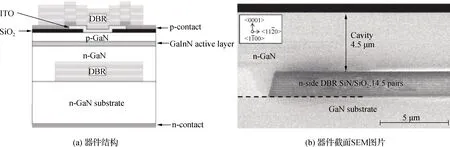
圖8 索尼報道的通過側向外延方式制備的雙介質膜DBR GaN基VCSEL[16]
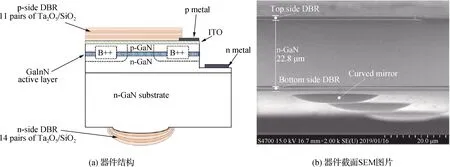
圖9 索尼報道的襯底側具有曲面介質膜DBR的GaN基VCSEL[53]
3 綠光GaN基VCSEL
綠光是三基色之一,因此綠光VCSEL在微投影、全色激光顯示、增強現實(AR)、虛擬現實(VR)等領域有著非常重要的應用.綠光波段也處于塑料光纖以及海水的低損耗窗口,因此可以應用于塑料光纖通信以及水下可見光通信.此外,綠光VCSEL在生物醫療領域也有很好的應用前景[55].
但是與藍光和紫光GaN基VCSEL相比,綠光GaN基VCSEL面臨著更大的挑戰與困難.在綠光波段,高質量、高發光效率的InGaN量子阱的生長更為困難[8].綠光量子阱中的高In組分會使InGaN與GaN之間的晶格失配增大,造成較高的缺陷密度以及較大應力.同時,綠光量子阱外延生長需要更低的溫度,晶體質量更難保證.量子阱中的缺陷會增加載流子的非輻射復合,而較大應力所形成的壓電極化電場會帶來QCSE,降低發光效率.InGaN量子阱在綠光波段發光效率降低,這也被稱為“綠光帶隙”[56].2010年,日亞第一次報道了發光波長接近綠光的電注入GaN基VCSEL[11],但是其發光波長僅為503 nm,器件只能工作在脈沖注入條件下,而且閾值電流較大.
3.1 綠光InGaN量子點VCSEL
針對綠光GaN基VCSEL中所面臨的困難,2017年,廈門大學的研究小組采用一種新的方式來制備綠光GaN基VCSEL[34,57],采用InGaN量子點代替量子阱作為有源區,并且使用電鍍Cu襯底改善器件的散熱特性,最終成功實現了綠光GaN基VCSEL的低閾值室溫連續激射.器件結構及照片如圖10所示.
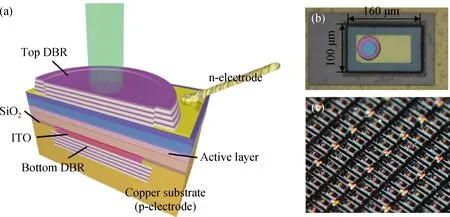
(a)器件結構;(b)器件電管照片;(c)器件陣列照片.
使用量子點作為有源區能夠有效降低激光器閾值,提高器件溫度穩定性[58-59].量子點中的電子具有脈沖函數狀的分立的態密度分布,因此具有比體材料以及量子阱更高的微分增益.此外,載流子被局域在量子點中,減小了被缺陷與位錯等非輻射復合中心俘獲的概率,量子點在一定程度下能夠實現“缺陷免疫”[60].另一方面,量子點在外延生長過程中通常是以應力驅動的S-K(Stranski-Krastanow)模式生長,因此量子點生長過程中存在應力釋放,其內部的壓電極化電場與QCSE也會得到減弱,發光性能進一步提升.
基于InGaN量子點制備的GaN基VCSEL發光光譜以及電流-電壓-光功率特性如圖11所示.3個不同的器件在不同波長處展現出多縱模或單縱模發光,波長覆蓋480~560 nm范圍的綠光波段.圖12為廈門大學綠光InGaN量子點VCSEL與國際其他研究小組研究結果的對比,使用InGaN量子點制備出覆蓋綠光波段、閾值最低的GaN基VCSEL.

圖11 綠光InGaN量子點VCSEL的電致發光光譜(a~c)及對應的電流-電壓-光功率特性曲線(d~f)[34]
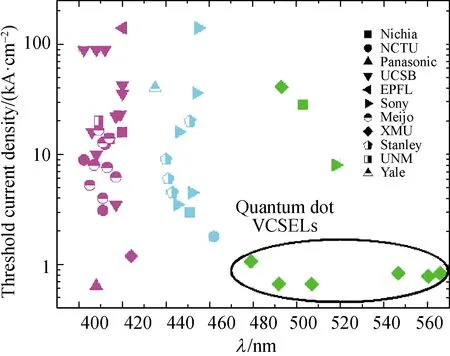
圖12 綠光量子點VCSEL器件特性與量子阱VCSEL器件特性的橫向對比[34]
3.2 基于局域態的綠光GaN基VCSEL
2018年,廈門大學又報道了基于藍光量子阱中局域態的綠光GaN基VCSEL室溫連續激射[48],器件同樣為雙介質膜DBR結構,器件性能如圖13所示.器件發光波長主要分布在493 nm,閾值電流為32 mA,最大輸出功率約180 μW.器件使用2對發光波長在460 nm的藍光In0.18Ga0.82N/GaN(2.5 nm/6 nm)量子阱為有源區,通過量子阱中的富In局域態,并配合諧振腔效應實現了綠光波段激射.這種方式避免了生長高In組分量子阱的問題,為綠光GaN基VCSEL的制備提供了新的思路.

圖13 廈門大學報道的局域態綠光VCSEL的發光特性[48]
3.3 半極性綠光GaN基VCSEL

器件閾值電流-電壓-光功率特性以及發光光譜如圖14所示,閾值電流1.8 mA,激射波長515 nm.通過使用綠光VCSEL配合藍光和紅光VCSEL,他們也首次實現了全VCSEL產生的白光.
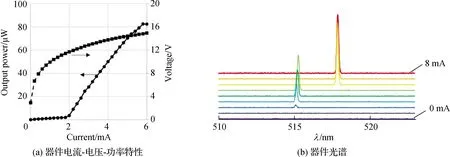
圖14 索尼報道的半極性綠光GaN基VCSEL發光特性[61]
4 GaN基VCSEL所面臨的技術挑戰
4.1 高質量高電導率氮化物DBR的外延生長
名城大學以及史丹利電器在基于AlInN/GaN混合DBR結構的GaN基VCSEL中已經取得較大進展.但是AlInN/GaN DBR的外延生長仍然面臨著較大挑戰.這是因為AlN與InN的合適生長溫度以及氣壓都有著巨大差異:AlN的合適生長溫度一般在1 300 ℃ 以上,而InN則小于700 ℃;AlN的合適生長壓強約為10 kPa,而InN為100 kPa.AlInN是AlN與InN的合金材料,因此合適的生長條件極為苛刻,且生長窗口很窄[39].另一方面,AlInN的生長速率較慢,雖然目前名城大學與史丹利電器已經將其生長速率提升至了0.5 μm/h[39],但生長40對AlInN/GaN DBR仍需要10 h以上,生產成本較大.另外,Al0.82In0.18N的熱導率非常低,只有約4.3 W/mK[62],這也會極大影響器件散熱特性.另外一個需要解決的問題就是氮化物DBR的導電性.因為高電導率氮化物DBR難以制備,目前普遍采取腔內接觸電極結構使注入電流繞過下DBR.但是這會造成電流擁堵效應,影響器件性能.名城大學采用調制漸變摻雜的方法實現了具有導電性的AlInN/GaN混合DBR結構的VCSEL室溫連續激射,但是與下DBR不導電的VCSEL相比,性能在一定程度上有所惡化,說明導電性氮化物DBR還有很大的優化空間.
4.2 光場的橫向限制
GaAs基VCSEL中的橫向光場限制是通過對AlAs進行氧化形成Al2O3孔徑來實現.但是這種氧化工藝在GaN基材料體系中極難實現,需要特別的器件設計以及制備工藝來對光場進行橫向限制.目前已有的做法為在p-GaN表面制備開有小孔的掩埋SiO2橫向波導層.但是有計算表明,器件工作時SiO2波導層下表面的感應電荷所形成的勢場會加劇電流在p-GaN中的橫向擴散,影響有源區的有效增益[63].2020年,史丹利電器與名城大學開發了更為簡單的橫向光場限制結構[46].他們使用電感耦合等離子體刻蝕(ICP)將p-GaN刻出具有5 nm高的圓柱形臺面,ICP刻蝕過的p-GaN區域則形成了高阻狀態,無需絕緣層來進行電流限制.凸起的p-GaN圓柱臺面能實現光場的橫向限制,器件結構如圖15所示.他們通過此種方式得到了目前GaN基VCSEL中最大的單管輸出功率24 mW(連續電流驅動下),且器件的工作溫度提升至140 ℃.目前圓柱形臺面的的高度還有待進一步優化以期取得更好的橫向光場限制效果.

圖15 史丹利電器所報道的納米高度圓柱形凸臺限制結構VCSEL及器件特性[46]
4.3 p-GaN側的電流擴展
與GaAs基半導體不同,p-GaN往往具有較大的體電阻.為了使電流能均勻注入限制孔徑,必須在p-GaN表面備電流擴展結構.目前常用的方法為沉積銦錫氧化物(ITO)透明導電層,或者外延生長隧道結來進行電流擴展.但是ITO層有較大的光吸收,材料本身也比較昂貴;生長隧道結則會使外延工藝更為復雜,因此還需尋找更為簡單有效的電流擴展方式.
4.4 高質量有源區的外延生長
雖然目前GaN基VCSEL已經取得較大單管輸出功率,但性能較好的器件需使用GaN單晶襯底來進行外延生長以減小晶體缺陷密度.目前GaN單晶襯底仍然較為昂貴,占據器件制備的大部分成本.因此還需不斷優化外延工藝,以在更廉價的襯底如藍寶石上獲得更高質量的有源區材料.
5 總 結
自從2008第一支電注入器件被成功制備以來,GaN基VCSEL已經取得了巨大的進展.目前在紫光(約400 nm)波段、藍光(約450 nm)波段以及綠光(500~560 nm)波段都已經實現了室溫連續激射.藍光器件最大單管輸出功率已經達到24 mW,VCSEL陣列輸出功率已經達到1 W以上,從輸出功率來說藍光GaN基VCSEL目前已經達到實用化水平.當然,GaN基VCSEL仍面臨著諸多挑戰,世界范圍內的研發人員正在努力解決晶體質量、器件壽命、生產成本以及晶圓大面積均勻性等問題.這些技術問題解決之后,GaN基VCSEL必將迎來商業化應用,也勢必會給人們生活的方方面面帶來巨大的影響.
致謝:特別感謝中國科學院蘇州納米技術與納米仿生研究所劉建平研究員在材料外延方面的支持.

