鋁摻雜對(duì)硼化鋯薄膜微結(jié)構(gòu)及電學(xué)性能的影響
孟 瑜,彌娟莉,李 雷
(1.西安文理學(xué)院 陜西省表面工程與再制造重點(diǎn)實(shí)驗(yàn)室,西安 710065;2.西安文理學(xué)院 西安市智能增材重點(diǎn)實(shí)驗(yàn)室,西安 710065)
0 引言
過(guò)渡金屬(TM)硼化物因具有優(yōu)異的力學(xué)性能、耐蝕性、抗高溫氧化等特點(diǎn),廣泛應(yīng)用于諸多領(lǐng)域,如微電子元器件、刀具、航空航天發(fā)動(dòng)機(jī)組件等[1-3]。該類化合物通常具有六方AlB2型晶體結(jié)構(gòu),其中B原子在六方密排的過(guò)渡金屬層之間形成石墨狀蜂窩薄片。過(guò)渡金屬與B原子之間的強(qiáng)共價(jià)/離子結(jié)合以及蜂窩B薄片內(nèi)的共價(jià)結(jié)合使該類化合物具有較高的熔點(diǎn)、硬度和強(qiáng)度,TM原子之間的金屬結(jié)合為其提供了良好的導(dǎo)電性[4]。二硼化鋯(ZrB2)作為代表材料,具有高熔點(diǎn)(3 245℃)、高硬度(22 GPa)、低熱膨脹系數(shù)(5.9×10-6K-1)和低電阻率(4.6μΩ·cm)等優(yōu)點(diǎn),可用作高溫結(jié)構(gòu)陶瓷材料、薄膜材料、復(fù)合材料、電極材料等[5-7]。
ZrB2薄膜的制備方法主要有化學(xué)氣相沉積(CVD)技術(shù)[8]和磁控濺射沉積技術(shù)[9-10]。利用CVD制備的ZrB2薄膜中C和O元素的含量較高,因而,薄膜具有較高的表面電阻率,且內(nèi)部結(jié)構(gòu)較疏松,性能受到影響[11]。相比于CVD,磁控濺射技術(shù)是一種更具應(yīng)用前景的沉積方法,具有薄膜表面平整、結(jié)合力好、厚度均勻、結(jié)構(gòu)致密、可控性更好的特點(diǎn)[12]。但是在用磁控濺射法制備ZrB2薄膜的過(guò)程中,Zr與B原子都對(duì)O原子有極強(qiáng)的親和力,導(dǎo)致所制得的薄膜容易被氧化,更傾向于生成ZrO2和B2O3,而非生成具有化學(xué)計(jì)量比的ZrB2[13]。研究表明,在硼化鋯薄膜沉積過(guò)程中摻入金屬元素(Ag、Ta、Cr等),可以對(duì)薄膜成分和微結(jié)構(gòu)進(jìn)行調(diào)控,從而改善其性能[14-16]。
本文采用磁控共濺射沉積技術(shù)在ZrB2薄膜中摻入不同含量的Al元素,研究Al摻雜對(duì)ZrB2薄膜沉積速率、化學(xué)結(jié)合狀態(tài)、表面和截面形貌、成分、物相結(jié)構(gòu)及電學(xué)性能的影響規(guī)律。
1 實(shí)驗(yàn)方法
利用JGP560V型高真空磁控濺射設(shè)備在p型Si(100)基底上沉積鋁摻雜的硼化鋯薄膜。采用的Al靶和ZrB2靶的純度均為99.95%,Al靶用射頻濺射,ZrB2靶用直流濺射。沉積室本底壓力為4.0×10-4Pa,通入Ar流量為80 mL/min。固定ZrB2靶的濺射功率為80 W,調(diào)節(jié)Al靶濺射功率分別為20、30、40 W進(jìn)行薄膜制備,工作氣壓為4.7 Pa,濺射時(shí)間為1 h。
利用X射線光電子能譜儀(XPS,Thermo-Scientific K-Alpha)分析薄膜的化學(xué)結(jié)合狀態(tài),使用原子力顯微鏡(AFM,美國(guó)Bruker)和掃描電子顯微鏡(SEM,Nova NanoSEM 450)觀察薄膜的表面和截面形貌,利用圖像標(biāo)尺測(cè)量薄膜截面厚度,并根據(jù)截面厚度與沉積時(shí)間計(jì)算薄膜沉積速率,采用掃描電鏡附帶的EDS能譜儀測(cè)試薄膜成分,使用掠入射X射線衍射(GIXRD,XRD-7000,島津)表征薄膜的物相結(jié)構(gòu),用四點(diǎn)探針測(cè)試儀(FPP,RTS-9)測(cè)定薄膜的表面電阻率。
2 結(jié)果與討論
2.1 XPS譜圖分析
利用XPS技術(shù)分析Zr-Al-B薄膜中各組成元素的化學(xué)鍵合狀態(tài),C1s峰校正值為284.6 eV。如圖1所示,Al 2p的結(jié)合能峰位在74 eV左右,證明Al與O結(jié)合生成Al2O3[17]。

圖1 不同Al濺射功率下Zr-Al-B薄膜的XPS能譜Fig.1 XPS spectra of Zr-Al-B thin films at different Al sputtering power
由圖1(a)(c)(e)可知,隨著Al濺射功率的增加,Al 2p的XPS譜峰的相對(duì)峰面積有所增加,表明Al含量增加。從圖(b)(d)(f)可以看出,除了Zr-B結(jié)合外,大部分Zr和B原子被氧化。隨Al含量增加,Zr原子的峰位向低結(jié)合能偏移,表明氧化程度有所降低;隨著Al濺射功率的增加,更多的Al原子與氧原子結(jié)合,促使Zr原子與B原子結(jié)合。
2.2 薄膜表面及截面形貌分析
圖2(a)(b)(c)是不同Al濺射功率下的Zr-Al-B薄膜的SEM表面形貌圖。可以看出,薄膜表面平整致密,無(wú)明顯缺陷,隨Al濺射功率增加,薄膜表面的顆粒尺寸逐漸增大。圖2(d)EDS能譜圖顯示薄膜組成元素主要為Al、Zr、B和O四種元素,與XPS結(jié)果一致。圖3(a)(b)(c)是不同Al濺射功率下Zr-Al-B薄膜的SEM截面形貌圖。當(dāng)Al濺射功率分別為20、30、40 W時(shí),薄膜厚度分別為237、308、510 nm,可以看出,薄膜厚度均勻,結(jié)構(gòu)致密,且呈現(xiàn)柱狀晶結(jié)構(gòu)。

圖2 不同Al濺射功率下Zr-Al-B薄膜的SEM表面形貌圖和EDS能譜圖Fig.2 Surface morphology and energy spectrum diagram of Zr-Al-B thin films deposited at different Al sputtering power
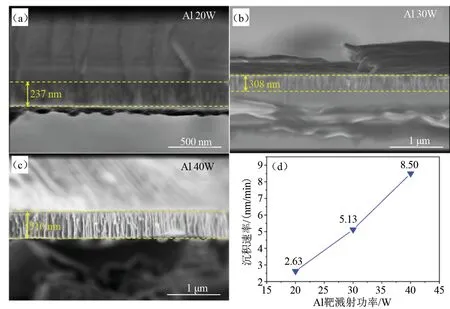
圖3 不同Al濺射功率下Zr-Al-B薄膜的SEM截面圖和沉積速率Fig.3 Cross section morphology and deposition rate of Zr-Al-B thin films deposited at different Al sputtering power
此外,三組薄膜與基底結(jié)合界面清晰平整,表明結(jié)合良好。薄膜沉積速率如圖3(d)所示,分別為2.63、5.13和8.5 nm/min,隨濺射功率增大呈現(xiàn)上升趨勢(shì)。
圖4為不同Al濺射功率下Zr-Al-B薄膜的AFM形貌圖,(a)(b)(c)為薄膜的三維圖,(d)(e)(f)為對(duì)應(yīng)的平面圖,測(cè)量區(qū)域?yàn)?.8μm×7.8μm。三種功率對(duì)應(yīng)的薄膜表面粗糙度均方根Rq分別為3.68、5.19和2.05 nm,當(dāng)Al濺射功率為30 W時(shí),均方根值最大。結(jié)合圖3中SEM表面形貌可知,Zr-Al-B薄膜表面較為平整。

圖4 不同Al濺射功率下Zr-Al-B薄膜的AFM圖Fig.4 AFM morphology of Zr-Al-B thin films at different Al sputtering power
2.3 薄膜的物相結(jié)構(gòu)分析
ZrB2和Zr-Al-B薄膜的XRD衍 射圖如圖5所示。由圖可知,兩種薄膜均為多晶結(jié)構(gòu),并以ZrB2(001)為擇優(yōu)取向。對(duì)于純ZrB2薄膜,圖中2θ為25.58°、32.06°、41.02°分 別 對(duì) 應(yīng)ZrB2(001)、ZrB2(100)和ZrB2(101)衍射峰[18],Zr-Al-B薄膜由ZrB2和Al2O3兩相組成,隨Al濺射功率的增加,ZrB2(001)和Al2O3(104)衍射峰強(qiáng)度均呈減弱趨勢(shì),表明隨Al含量的增加,薄膜晶化程度降低。

圖5 不同Al濺射功率下Zr-Al-B薄膜的XRD譜圖Fig.5 XRD patterns of Zr-Al-B thin films at different Al sputtering power
2.4 薄膜電學(xué)性能分析
利用EDS能譜儀和四點(diǎn)探針測(cè)試儀對(duì)不同濺射工藝下Zr-Al-B薄膜的成分和表面電阻率進(jìn)行測(cè)試分析,結(jié)果如圖6所示。Zr-Al-B薄膜中Al/Zr原子比與沉積過(guò)程中設(shè)置的Al靶和ZrB2靶的濺射功率比接近,表明可以通過(guò)調(diào)節(jié)靶材的功率調(diào)控薄膜成分,進(jìn)一步調(diào)控薄膜結(jié)構(gòu)和性能。從薄膜表面電阻率變化曲線可以看出,純ZrB2薄膜的電阻率為0.119Ω。
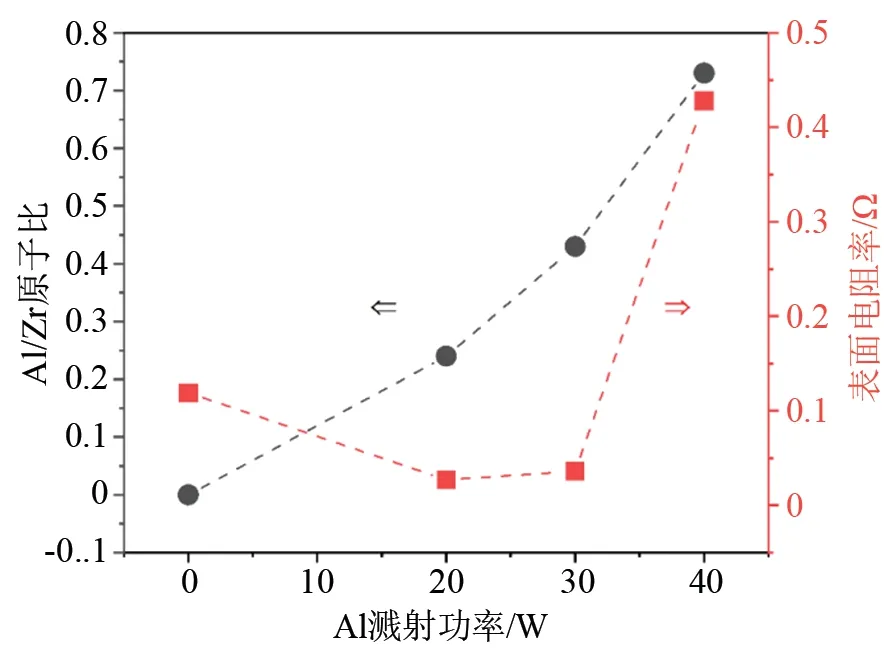
圖6 Zr-Al-B薄膜的Al/Zr原子比和表面電阻率Fig.6 Atomic ratio of Al/Zr and surface resistivity of Zr-Al-B thin films
隨Al/Zr原子比的增加,Zr-Al-B薄膜表面電阻率呈現(xiàn)先降低后升高的趨勢(shì)。當(dāng)Al/Zr原子比為0.25時(shí),薄膜表面電阻率最小為0.027Ω,結(jié)合XRD圖可知,此時(shí)ZrB2和Al2O3晶粒尺寸較大,晶界數(shù)量少,晶界對(duì)電子的散射作用小,減小了薄膜表面電阻率。當(dāng)Al/Zr原子比為0.5時(shí),薄膜表面電阻率最大為0.428Ω。表面電阻率增加的原因是:隨著Al/Zr原子比的提高,Al含量增加,結(jié)合圖1中XPS結(jié)果分析可以看出,高電阻的Al2O3成分增加導(dǎo)致薄膜表面電阻率增大。
3 結(jié)論
利用磁控共濺射技術(shù)在Si(100)基底上沉積不同Al含量的Zr-Al-B薄膜,并研究了Al摻雜對(duì)薄膜結(jié)構(gòu)和電學(xué)性能的影響,主要結(jié)論如下:
(1)制備的薄膜表面平整,厚度均勻。Zr-Al-B薄膜為多晶結(jié)構(gòu),隨著Al/Zr原子含量比的增加,薄膜結(jié)構(gòu)從純ZrB2晶相轉(zhuǎn)變?yōu)閆rB2和Al2O3復(fù)合相。
(2)隨Al/Zr原子比增加,薄膜表面電阻率呈現(xiàn)先減小后增大趨勢(shì),最小為0.027Ω,最大為0.428Ω。

