3DG111F等四種雙極晶體管空間總劑量效應研究
代佳龍,馮偉泉,趙春晴,沈自才,鄭慧奇,丁義剛,劉宇明,牟永強
(北京衛星環境工程研究所,北京 100094)
0 引言
空間粒子輻射環境是誘發航天器異常和故障的主要原因之一。這些帶電粒子與航天器及其所應用的電子元器件、材料等相互作用,產生多種空間輻射效應,從而影響航天器的正常、穩定工作,甚至飛行安全。
隨著我國航天事業的蓬勃發展,用于衛星、飛船的電子元器件不但要求高性能,而且更要求高可靠性。雙極晶體管(BJT)具有良好的電流驅動能力、線性度、低噪聲以及優良的匹配特性,以其高速、耐久性以及功率控制能力一直備受關注,常用于空間系統,包括運算放大器、比較器以及電壓調整器等。空間輻射環境對 BJT會造成累積電離損傷總劑量效應(TID)。總劑量與航天器的運行軌道、姿態(傾角)、軌道的高度及太陽活動峰年密切相關。此外,不同廠家、不同工藝、甚至同一工藝不同批次生產的元器件對電離輻射損傷都具有不同的敏感性。
空間總劑量效應可以用鈷源γ射線來模擬。鈷源產生的γ射線與物質作用時,主要是產生康普頓效應。該效應產生的電子引起物質電離,同時發生能量沉積;這些沉積在元器件中的能量會使元器件性能參數發生退化。該效應與空間帶電粒子輻射環境產生的總劑量效應是等效的,因此可以在地面用鈷源γ射線來模擬空間總劑量效應。
本文對3DG111F等4種雙極晶體管進行總劑量輻照試驗、測量、并對試驗結果分析。研究旨在為單機總劑量效應引起的故障原因分析提供試驗依據。
1 空間粒子輻射環境
空間粒子輻射環境由地球輻射帶、太陽耀斑、銀河宇宙線的高能粒子組成。地球輻射帶(亦稱范·艾倫帶)主要由地球磁場俘獲電子(能量低于7 MeV)和質子(能量低于500 MeV)構成,分為內輻射帶和外輻射帶。內輻射帶為赤道平面約 600~10 000 km高度的區域,主要成分是高能質子,最大通量密度位置在2Re(Re為地球半徑)處,電子的能量低于5 MeV,最大通量密度位置在1.5 Re。外輻射帶為赤道平面約10 000~60 000 km高度的區域,主要是由電子組成(比內輻射帶電子通量密度高10倍)。
NASA開發的AE/AP系列模型[1]是地球輻射帶的基本模型,也是目前最常用的模型。按照LEO和GEO的空間B-L坐標,AP8和AE8模型給出了 100 keV~500 MeV范圍內的質子、40 keV~7 MeV范圍內的電子的全方向的通量的估計值。模型區分了太陽活動最大和最小的條件:對于質子,太陽活動最小時的通量大于太陽活動最大時通量;電子的情況則正好相反。AP8和AE8模型不包括地磁亞暴或短期太陽變化導致的輻射通量的瞬時變化。空間質子通量密度隨質子能量降低而升高,直到最低能量100 keV。AP8模型是根據探測數據建立的,由于探測低能質子的傳感器技術難度較大,AP8模型沒有低于100 keV的數據,實際上是存在的[2]。銀河宇宙線(galaxy cosmic rays)由來自銀河系各個方向的高能帶電粒子流組成,其成分為:85%的質子(氫核),14%粒子或氦核,1%重離子(Z>4),Z>26的重離子很少,能量范圍在10 GeV以下。銀河宇宙線在太陽活動周期谷年時最大。銀河宇宙線粒子相比地球輻射帶而言通量很小,但由于其能量非常高,屏蔽一般不起作用。太陽耀斑(solar flares)往往伴隨著大量高能粒子的噴發,主要為高能質子(90%),能量為10~1 000 MeV,也包括少量的α粒子和重離子。噴發時會造成粒子通量的增加,通常會持續幾個小時到一周以上,但典型情況下持續2~3 d。
輻射環境模型取AE8(min)、AP8(min)和JPL1991年太陽耀斑質子,計算低地球軌道(500 km/28°)電離總劑量為 1.2 krad(Si)/a,對于地球同步軌道(35 780 km/0°)電離總劑量為52 krad(Si)/a[3]。星上器件在空間接收的輻射劑量率范圍一般為10-4~10-2rad(Si)/s,地面試驗如果使用此劑量率進行模擬,將耗費大量的時間,所以在工程應用上需采取加速試驗方法。
2 總劑量輻照試驗
2.1 輻照器件與測試參數
輻照器件:高頻小功率三極管 3DG111F,高頻三極管3DG162J,高頻三極管3DG180C,小功率三極管3DK9H共4種。其中,每種4只,共16只,放置在一塊電路板上,使用“零插力插座”固定器件,避免了大量測試造成管腳損壞。
測試參數是電流增益HFE和飽和管壓降VCES。
1)HFE是共發射極正向電流傳輸比靜態值,即晶體管集電極電流IC與基極電流IB的比值,它表征晶體管的放大能力。根據各型號試驗樣品生產廠家提供的器件手冊,試樣的參數合格判據標準取值范圍見表1。

表1 各器件電流增益HFE取值范圍Table 1 Range of current gain(HFE) for various devices
2)VCES為晶體管的集電極—發射極飽和管壓降,指晶體管進入飽和區工作狀態,集電極電流不隨基極電流增加而增加時的集電極—發射極壓降。VCES的大小跟晶體管的制造工藝關系密切。根據各型號試驗樣品生產廠家提供的器件手冊,試樣合格判據標準取值范圍見表2。

表2 各器件飽和管壓降VCES取值范圍Table 2 Range of VCES for various devices
參數測量分別在試驗前、試驗過程中和試驗后進行,共測量10~12次。為保證試驗精確性,按照美軍標MIL-STD-883要求,每次測試時間在輻照后2 h內完成。
2.2 偏置電路
輻照期間晶體管加15 V直流電壓,發射結正偏,單一晶體管偏置電路示意圖見圖1。
晶體管正常工作狀態為IB=0.1 mA,IC=1 mA,VCES=70 mV。經電路模擬測得的結果為:IB=0.1 mA,IC=0.988 mA,VCES=68.193 mV,符合正常工作狀態要求。
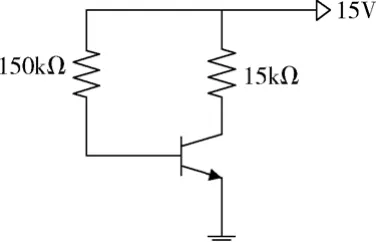
圖1 輻照偏置電路示意圖Fig. 1 Schematic diagram of radiation bias circuit
2.3 輻射源及輻照均勻性分析
輻射源選取北京輻射中心(位于北京師范大學內)60Co γ放射源,源結構為豎直棒源結構,直徑為12 mm, 棒高度為48 cm, 活度為3 000 Ci,輻照電路板在源棒高度中心位置,距源棒740 mm。輻照裝置的結構布局如圖2所示。

圖2 輻照裝置結構布局圖Fig. 2 Layout of the structure for radiation device
根據GJB 5422—2005總劑量輻照試驗標準建議,選擇輻照劑量率為 1 rad(Si)/s,均勻性小于10%,輻照總劑量為器件全部失效時的劑量。
γ放射源在空氣中的吸收劑量率的計算公式[4]為
式中:A表示放射源的活度;τ表示照射率常數;R表示測量點中心到放射源中心的距離;Kd表示考慮到放射源本身衰變的校正系數。由于鈷源的半衰期為 5.27 a,在短時間的試驗中,其由于半衰問題引起的誤差可以不予考慮,我們可以得到簡化公式:

由于該放射源為豎直放置的柱狀源,其在線路板垂直方向上的分布是均勻的,故只需要考慮水平方向上的不均勻性。設試件板寬為200 mm,輻照空間內的輻照劑量率分布關系如圖3所示。

圖3 劑量率計算示意圖Fig. 3 Sketch map of calculation for dose rate
圖3中R表示放射源中心與試件板中心的距離,Dmax和Dmin分別表示輻照區域最大和最小的劑量率,放射源中心到輻照區域最遠的距離為

由不均勻度定義

取最大值,則為

將公式(2)和公式(3)代入公式(5)有

求解得:R≈212 mm。
試驗過程中,線路板位置 R=740 mm,達到1 rad(Si)/s的輻照劑量,滿足均勻性要求。
2.4 輻照試驗流程
詳細的試驗流程見圖4所示。

圖4 輻照試驗流程圖Fig. 4 Flow chart of irradiation testing
3 試驗結果
3.1 晶體管3DG111F
通過試驗發現晶體管增益HFE出現明顯降低,達到120 krad(Si)劑量后,#1、#2器件HFE從155下降到120,相比初始值降低了30%;#3器件從135下降到117,#4器件從137下降到105。以上數據說明該參數對輻照非常敏感(如圖5)。
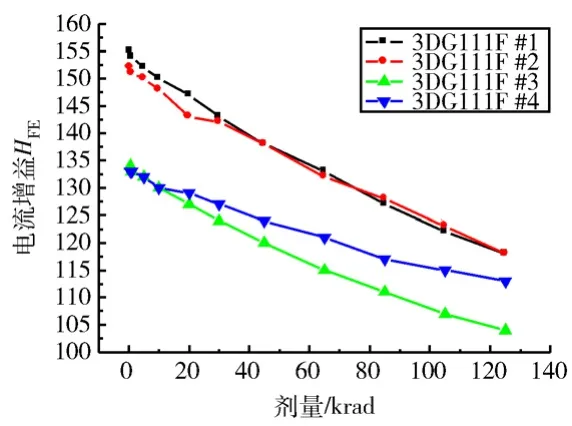
圖5 3DG111F參數HFE變化曲線Fig. 5 Curve of 3DG111F parameter HFE ’s variation
參數 VCES則出現不同程度的增大的情況(如圖6):#1器件由67 mV升到77 mV,#2器件本身飽和管壓降VCES為128 mV,明顯大于其他3個器件的VCES,說明存在個體差異,輻照后由128 mV升到129 mV;#3器件由62 mV上升到73 mV;#4器件由65 mV上升到69 mV。
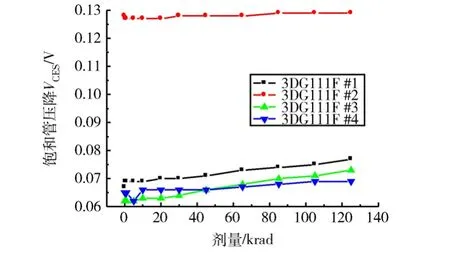
圖6 3DG111F參數VCES變化曲線Fig. 6 Curve of 3DG111F parameter VCES ’s variation
3.2 晶體管3DG162J
對于晶體管3DG162J,參數HFE下降非常明顯,劑量達到5 krad(Si)后,4個器件的HFE參數均低于55,說明器件已經失效,其抗總劑量水平非常差(見圖7)。
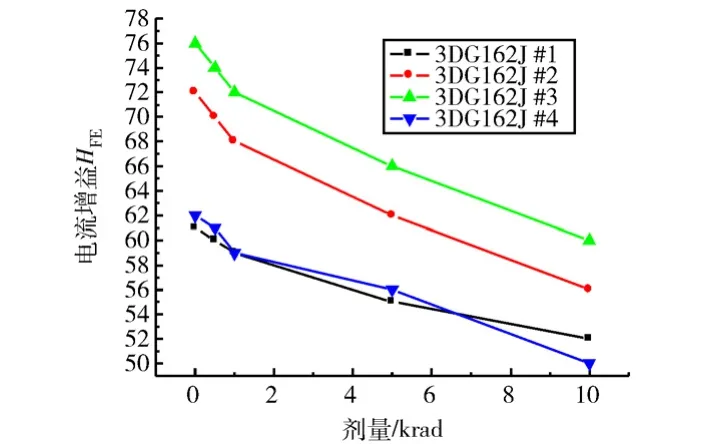
圖7 3DG162J參數HFE變化曲線Fig. 7 Curve of 3DG162J parameter HFE ’s variation
參數VCES出現不同程度的升高,該參數的失效判據是大于0.5 V,而器件在達到120 krad(Si)輻照后未失效,但其對總劑量的敏感性很大,隨劑量增大VCES增大明顯: #1器件由130 mV上升到149 mV,#2器件由150 mV上升到185 mV,#3器件由209 mV上升到263 mV,#4器件由111 mV上升到175 mV(見圖8)。
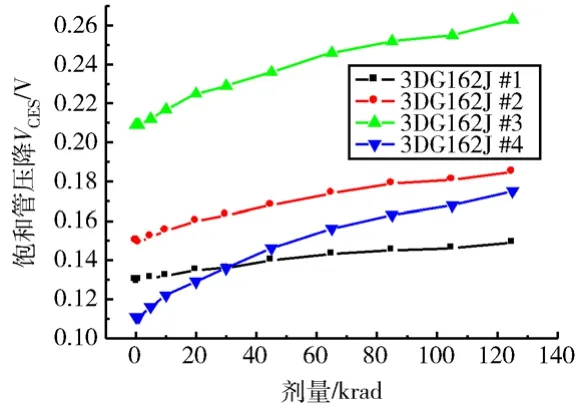
圖8 3DG162J參數VCES變化曲線Fig. 8 Curve of 3DG162J parameter VCES ’s variation
3.3 晶體管3DG180C
試驗發現達到 120 krad(Si)劑量后,晶體管3DG180C增益HFE出現明顯降低:#1器件從86下降到82,#2器件從92下降到79,#3器件從84下降到78,#4器件從84下降到78。HFE參數對輻照非常敏感。圖9中除2#外,其他曲線出現先上升后下降的原因是某些器件在試驗初始階段出現了輕微的退火,參數性能有一定的恢復。
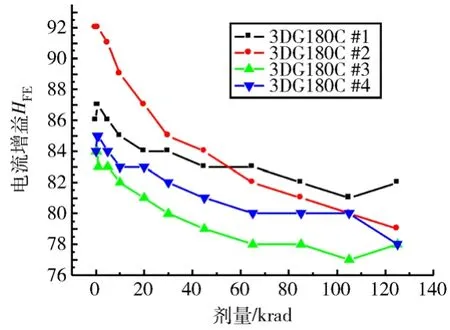
圖9 3DG180C參數HFE變化曲線Fig. 9 Curve of 3DG180C parameter HFE ’s variation
該器件的VCES隨輻照劑量增大而變化較小(如圖10所示),但變化具有波動性,說明該參數的變化不完全取決于劑量的變化,跟器件本身特性和工藝也有關。
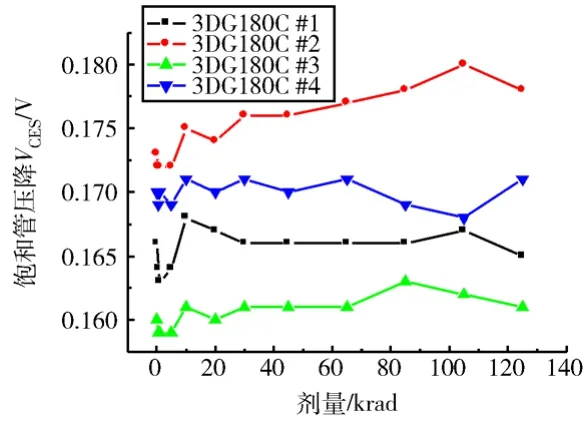
圖10 3DG180C參數VCES變化曲線Fig. 10 Curve of 3DG180C parameter VCES ’s variation
3.4 晶體管3DK9H
對于器件3DK9H,試驗發現其增益HFE略有降低,達到120 krad(Si)劑量后,#1器件從33.4下降到31,#2器件從35.8下降到31.4,#3器件從33.6下降到31,#4器件從34.3下降到31.2。但HFE參數變化幅度較小,說明該器件對輻照不敏感(圖11)。
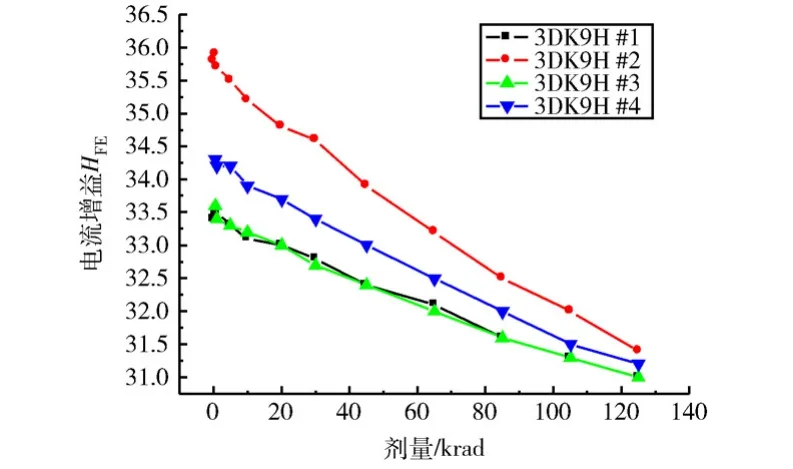
圖11 3DK9H參數HFE變化曲線Fig. 11 Curve of 3DK9H parameter HFE ’s variation
參數VCES出現不同程度的增大的情況:#1器件由257 mV變化到260 mV,#2器件由255 mV升到261 mV,#3器件由264 mV上升到269 mV,#4器件由267 mV上升到269 mV。該器件的VCES隨輻照劑量增大而增大,在40~80 krad(Si)劑量區間增大幅度明顯;在達到110 krad(Si)輻照劑量后,出現一定的恢復(如圖12)。該器件的VCES變化較其他型號的器件出現多次反復,這說明在輻照過程中該參數變化不完全取決于劑量的增加,而跟器件的本身特性和工藝有關。
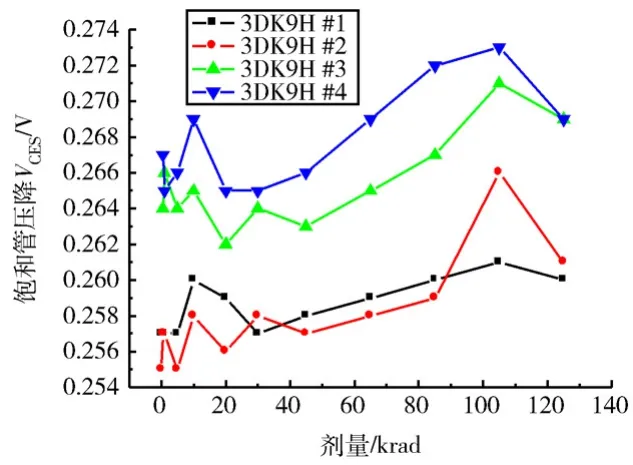
圖12 3DK9H參數VCES變化曲線Fig. 12 Curve of 3DK9H parameter VCES ’s variation
4 分析與討論
從4種器件的γ射線輻照效應結果,我們可以看到4種器件的HFE參數隨輻照劑量的增加而有不同程度的退化:3DG111F、3DG162J與3DG180C這3種三極管在120 krad(Si)劑量輻照后,參數指標下降達到30%,退化非常明顯; 3DK9H的HFE參數退化較小,在 120 krad(Si)輻照劑量時僅下降11%,可見其抗總劑量能力較高。
對于4種器件的參數VCES,同樣隨著輻照劑量的增加而出現退化:3DG111F、3DK9H和3DG180C均隨劑量增加而增加,增加幅度比較小,但變化具有一定波動性,對輻照不夠敏感;3DG162J則隨輻照劑量增加而增大非常明顯,最高較初始值增大57%,性能退化明顯,表明該型號器件參數 VCES對輻照較敏感。
γ射線與物質相互作用的主要效應是康普頓散射效應、光電效應和電子對效應。60Co源γ射線的平均能量是 1.25 MeV,其康普頓散射效應占優。康普頓散射是光子與核外電子發生非彈性碰撞,光子把部分能量轉移給電子使其電離,產生電子-空穴對,而能量降低了的光子沿著與原運動方向不同的角度散射出去,當散射光子能量超過電離閾值時,會繼續產生電離作用。對于雙極器件,均采用SiO2絕緣層,電離輻射直接的結果使整個SiO2絕緣層內引入附加的正俘獲電荷及在 Si/SiO2界面產生界面態[5]。
電離輻射在SiO2中產生電子-空穴對,無電場時,這些電子-空穴對將重新復合;存在電場時,電子-空穴逃逸復合的幾率增加,逃逸復合的電子-空穴對被氧化物中以及 Si/SiO2界面處的缺陷所俘獲的概率很大,由于電子在氧化物中的遷移率要遠高于空穴,因此這些沒有復合的大部分電子在氧化物中電場的作用下漂向電極,而大部分移動緩慢的空穴則被氧化物陷阱俘獲形成正氧化物電荷,氧化物俘獲正電荷分布于SiO2靠近Si/SiO2界面處約若干nm厚的薄層內,其改變了表面勢位。
界面態的形成則是電離輻射在Si/SiO2界面的SiO2一側使部分 SiO2價鍵斷裂,另外電離空穴或H+到達界面引起相互作用,產生隨機分布的3價硅原子,破壞了硅晶格勢場的周期性,將硅導帶、價帶中的部分能態擾動至禁帶中,在界面處引入了界面態。表面態可帶負電,也可帶正電,取決于和本征費米能級的關系。
雙極晶體管增益HFE倒數的表達式為
式中:IRB為基區體復合電流,即注入電子通過基區時復合的電流;ID為由基區擴散入發射區的多數載流子電流;IRG為發射極—基極耗盡層的復合電流;IS為表面復合電流;ICBO為集電極—基極反向電流。
Si/SiO2界面性能退化而使器件失效的γ射線總劑量約為體內位移損傷引起失效的總劑量的1/50[5]。對于雙極器件的電離輻射效應而言,以表面損傷為主,即不考慮IRB隨輻射的變化;而ID受輻射的影響可忽略不計。電離輻射在界面產生的正電荷俘獲和界面態,引起輕摻雜的基區表面耗盡,降低了少數載流子壽命,也使載流子表面復合速度增加,所以IRG和IS隨著劑量的增加而增加,導致雙極晶體管增益HFE隨劑量增加而退化,最終導致器件失效。
5 結論
空間粒子輻射會引起雙極晶體管氧化物俘獲電荷和表面態密度增加,使表面勢位增加,引起輕摻雜的基區表面耗盡,使載流子表面復合速度增加。復合速度的大量增加使晶體管增益HFE隨劑量增加而明顯下降,當試驗輻照劑量達到120 krad(Si)時,除晶體管3DK9H外,其他3種雙極晶體管全部失效,表明雙極晶體管的HFE對總劑量輻照非常敏感。而它們的飽和管壓降 VCES隨輻射劑量增大也發生一定退化,在劑量達到 120 krad(Si)時,飽和管壓降VCES增大5%左右,沒有像增益HFE那樣嚴重。通過上述試驗研究,了解了這些器件的總劑量退化特性,為下一步進行含有這些器件的單機總劑量試驗結果分析提供了依據。
(
)
[1] Bolin J A. Comparative analysis of selected radiation effects in medium earth orbits[D]. Naval Postgraduate School, California, USA, 1997
[2] Q/W 510A—2008, 地球靜止軌道粒子輻射環境模型選用指南[S]
[3] 于慶奎, 唐民, 朱恒靜, 等. 用10 MeV質子和鈷60 γ射線進行CCD空間輻射效應評估[J]. 航天器環境工程. 2008, 25(4): 391
[4] 清華大學工程物理系. 輻射防護概論[M], 1997-07: 59-65
[5] 陳盤訓. 半導體器件和集成電路的輻射效應[M]. 北京:國防工業出版社, 2005: 96-97

