圖形反轉方法制備MEMS器件電極的研究*
彭自求,王 軍,袁 凱,蔣亞東
(電子科技大學光電信息學院, 電子薄膜與集成器件國家重點實驗室,成都 610054)
微電子機械系統(MEMS)技術具有體積小、價格低廉、精度高、性能穩定、可靠性高、耗能低、多功能和智能化等優點,因而在眾多領域中有著廣泛的應用[1]。在MEMS器件的制備過程中,制作均勻性好、性能優越的金屬電極,對器件性能的影響極大。
對于離子轟擊難以刻蝕的金屬材料,傳統的電極圖形的制備一般采用濕法腐蝕,即蒸鍍、濺射金屬薄膜,然后在金屬上覆蓋掩膜圖形,再通過腐蝕液對金屬進行腐蝕。但該方法不易控制,難以制備細線條且均勻性較好的金屬電極,而且容易產生殘留。而采用剝離技術來制作金屬電極則不存在以上問題,有利于制備性能優異的器件。
目前,剝離技術主要有圖形反轉法、氯苯浸泡法、負性光刻膠法、多層掩膜剝離法等方法。但由于氯苯有毒,對人體有害,對設備要求極高[2];負性光刻膠存在分辨率不高和溶脹問題[3];多層掩模剝離法在常規的工藝和設備條件下難以應用[4],所以圖形反轉法成為研究和應用的熱點[5-8]。
正性光刻膠經紫外線照射后發生光化學反應,化學鍵斷裂重組,曝光的區域會溶于顯影液,未曝光的區域不溶,形成的圖形與掩模版上圖形相同。負性膠性質則相反,其得到的圖形與掩模版上圖形相反。而圖形反轉是利用光刻膠的特殊化學性質,用正性光刻膠來實現用負性光刻膠得到的光刻圖形[9]。
利用AZ5214膠的圖像反轉性質,對形成倒臺面圖形的機理進行了分析和討論,通過改變前曝光時間,反轉烘溫度和時間得到最佳的金屬層剝離的倒臺面光刻膠圖案,最終得到了符合要求的電極線條。
1 實驗
實驗采用的襯底為6 inch單晶硅硅片,光刻膠為AZ-5214,顯影液為RZX-3038。勻膠、顯影機為DǜNA700,光刻機為Nikon的NSR2005i9C。
首先讓硅襯底在120 ℃環境中烘烤,去除水分。然后HMDS氣相成底膜,以增加表面的粘附性。采用靜態滴膠涂膠,然后涂膠臺高速運動將膠涂均勻。涂膠后在熱板上進行前烘,去除光刻膠中的溶劑成分。待硅片冷卻后進行首次曝光,光經過掩膜版后照射到硅片表面的光刻膠,使其發生化學變化。曝光后用熱板對已曝光硅片進行反轉烘,烘烤過程中被曝光區域再次發生化學反應而失去光敏特性。待硅片冷卻后再進行泛曝光,此次曝光下光源和硅片之間沒有掩膜版。曝光完成后進行顯影、清洗,并最終在120 ℃氛圍中固化堅膜。
光刻膠形成“倒臺面”圖形后,將基片置于磁控濺射儀器內制備NiCr金屬。濺射完成后,將硅片置于丙酮內,輔以超聲清洗對其進行剝離。剝離完成后清洗,即完成了NiCr金屬電極的制備。圖一分別是光刻反轉后的圖案、濺射金屬后的圖案和剝離完成后的圖案。

圖1 電極制備各階段金像顯微圖
2 結果與討論
2.1 圖像反轉機理分析及仿真
AZ5214光刻膠主要由3部分組成:光敏成分、樹脂、溶劑。經光照后的區域光敏成分轉變成羧酸,親水,可溶于堿性顯影液中。在反轉烘步驟中,高溫使得光刻膠中的咪唑與以上產生的酸發生交聯反應,產生不溶于堿液的酰胺類化合物。反轉烘溫度相對較高,曝光的區域發生的交聯反應比未曝光的區域中多得多,結果在泛曝光后掩模曝光區域比未掩模曝光區域溶解性低,從而實現了曝光區域的圖像反轉[10-11]。
光刻膠因各種輻射源的輻照所引起的的化學反應基本上可分為光化學反應和輻射化學反應兩種。紫外光對AZ5214光刻膠引發的是光化學反應。光的吸收可按 Beer定律和Lambert定律進行。 Beer定律指出,被吸收的光的數量和吸收物質的濃度成正比。Lambert定律指出,入射光所能被吸收的百分比和光的強度無關。凡是厚度相等的連續介質層都吸收同樣百分率的入射光。根據 Lambert-Beer定律, Dill等人對正膠的光化學反應機理進行了定量的研究[12],根據Dill理論,當光無反射透過光刻膠時,可將光強的變化用下式描述:

其中I為光強(單位mJ), X為該點到光刻膠與空氣接觸面的距離(單位μm), ai為第i種成分的摩爾濃度(單位mol/L), mi為第i種成分的每摩爾光吸收系數。
對于AZ5214正膠來說,需要考慮三種吸收成分:光敏成分(PAC)、樹脂、反應生成物。其中光敏成分在光學曝光過程中生成反應生成物,這一過程將減少膠膜對光的吸收,由式(1)可得I(x, t)光強隨深度x和曝光時間t的分布:

其中a1、a2、a3分別為光敏成分、樹脂、反應生成物的摩爾吸收常數。 m1(x, t)、m2(x, t)、m3(x, t)分別為光敏成分、樹脂、反應生成物的摩爾濃度。
光敏成分濃度m1(x, t)隨深度x和時間t的變化由下式描述:

其中C為光敏成分的分解系數。在光化學反應中,一摩爾光敏成分分解可得到一摩爾反應生成物,而樹脂不會發生分解,因此可將此光化學反應的初態設為:

式(4)表示初始光強;式(5)為光敏成分的初始濃度;式(6)表明反應過程中樹脂濃度保持不變;式(7)表明一摩爾光敏成分分解可得到一摩爾反應生成物。
將(4)、(5)、(6)式代入(2)式得:

定義:

由以上變換, (2)、(3)兩式可化為:

根據曝光條件,在曝光以前,初始條件為:

相應的邊界條件為:

當A、B、C及I0的值確定后,結合邊界條件和初始條件可求出光強隨深度和時間的變化I(x, t)及光敏成分隨深度和時間的變化M(x, t)。
在以上分析的基礎上對AZ5214光刻膠的曝光機理進行了模擬仿真,假設光刻膠厚度為3 μm,初始光強為6 000 m J,經過t0=200 ms的曝光后在顯影得到光刻膠側壁的形狀。代入邊界條件和初始條件后算得光強隨深度和時間的變化I(x, t)及光敏成分濃度隨深度和時間的變化M(x, t)。光強隨時間位置的變化關系如圖2(a)所示。光敏成分隨時間位置的變化關系如圖2(b)所示。
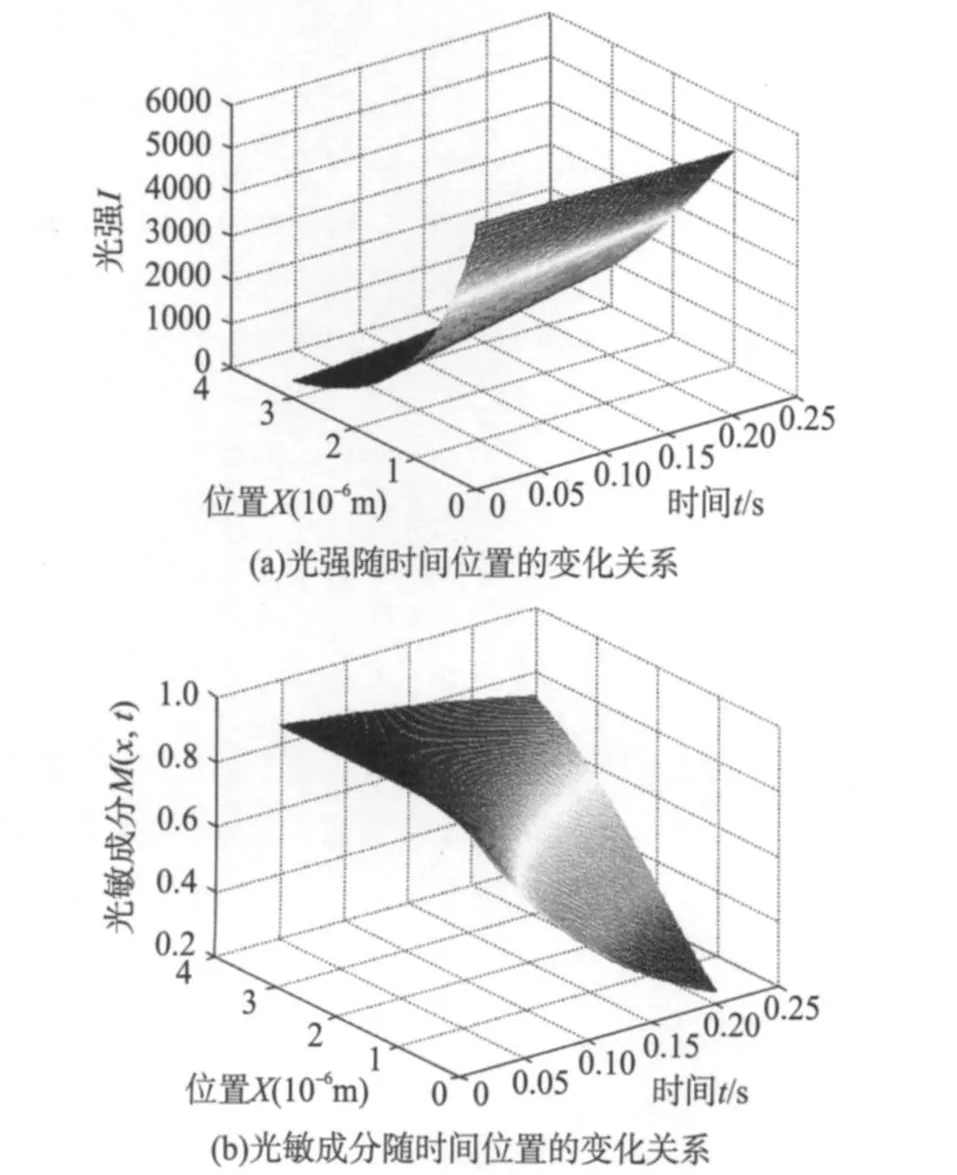
圖2 光強和光敏成分隨時間位置變化關系
同時,可以得出前曝光后光敏成分濃度M(x, t)與位置的關系,如圖3(a)所示。由Dill等人提出的光敏成分濃度對應顯影速率的關系[12],可得出顯影速率D(x, t)和位置的關系曲線,如圖3(b)。在反轉烘過程中,原本可以在顯影中溶解的羧酸與咪唑發生交聯反應而生成了難溶的酰胺類聚合物,在假設生成的羧酸完全反應的情況下(即反轉烘溫度和時間充足),泛曝光后的光敏成分濃度可以用M′(x,t)=1-M(x, t)表示,其對應的顯影速率D′(x, t)和位置的關系曲線如圖3(c)。因此,顯影后的光刻膠截面將形成“上寬下窄”的倒“八”字倒臺面圖形。

圖3 光敏成分濃度M(x, t)和顯影速率D(x, t)對應位置關系
2.2 前曝光時間和泛曝光時間對倒臺面影響
實驗證明,不同的前曝光時間和泛曝光時間組合,將影響反轉效果。為了達到良好的倒臺面效果,前曝光時間和泛曝光時間需要合理的分配。由實驗可得出,在一定曝光強度,反轉烘溫度相同條件下,若前曝光與泛曝光時間之比太小,則容易產生浮膠,留膜率低;若二者比值太大,會導致線條底部變寬,側壁的內傾角度很小,斷面的倒梯形形狀不明顯,濺射金屬時斷面處容易粘連,最終不能有效的分離開。由實驗確定二者比值為0.1左右,內傾角度在60 ℃時,剝離出的電極較好。選取膠厚所對應的前曝光時間,則泛曝光時間也可確定。實驗中采取的轉速為4 000 轉/m in,膠厚為1.1 μm,選取前曝光時間和泛曝光時間為200 ms和2 s。
2.3 反轉烘對倒臺面影響
反轉烘的作用是使前曝光區域產生的羧酸發生交聯反應,改變在顯影液中的溶解能力。交聯反應須在一定的溫度下進行,所以,若溫度過低,則曝光部分交聯反應不充分,溶解性能改變不多,從而在泛曝光后,掩膜曝光區域也會部分溶于顯影液中,導致留膜率降低,圖形反差不大。若溫度過高,類似于前烘溫度過高,導致未曝光區域的光敏感特性下降,無法完全溶于顯影液中,從而圖形無法實現反轉。圖4在前曝光與泛曝光時間相同條件下改變反轉烘溫度得到的倒臺面。
由圖4中可知,反轉烘溫度為105 ℃時內傾嚴重,容易在顯影或剝離時脫落。而反轉烘溫度為115 ℃時倒臺面傾角約為60°,制作完成的電極線條均勻、無脫落。

圖4 AZ5214膠光刻圖形的掃描電鏡圖
3 結論
根據理論推導和仿真結果,得出了光刻膠的顯影模型。利用AZ5214 光刻膠的特殊性質, 可知剝離方法可以有效地解決金屬電極的制備問題。從實驗結果得出,當前曝光與泛曝光時間之比為0.1,反轉烘溫度為115 ℃時,可以得到傾角約為60°的光刻膠倒臺面,并最終制備精度達到1 μm寬的MEMS器件中的金屬NiCr電極。
[ 1] 李旭輝.MEMS發展應用現狀[ J] .傳感器與微系統, 2006, 5:7-9.
[ 2] Hatzakis M, Canavello B J, Shaw JM.Single-Step Optical Lift-Off process[ J].IBM Journal of Research and Development,1980, 24:452-460.
[ 3] 田民波,劉德民.薄膜科學與技術手冊[ M] .北京:機械工業出版社, 1991:85-91.
[ 4]LIC, Richards J.A high Resolution Double Layerphotoresist Structure for Lift-Off technology[ C] //Wash D C:International Electron DevicesMeeting, 1980:412-414.
[ 5] 陳德鵝,吳志明,李偉,等.圖形反轉工藝用于金屬層剝離的研究[ J] .半導體技術, 2009, 6:535-538.
[ 6] 史錫婷,陳四海,何少偉,等.剝離技術制作金屬互連柱及其在MEMS中的應用[ J].半導體技術, 2005, 12:15-18.
[ 7] 何熙.紅外微測輻射熱計結構優化設計與制備[ D] .廈門大學, 2008:40-45.
[ 8] 陳光紅,于映,羅仲梓,等.AZ5214E反轉光刻膠的性能研究及其在剝離工藝中的應用[J] .功能材料, 2005, 36(3):431-433.
[ 9] 韓階平,侯豪情,邵逸凱.適用于剝離工藝的光刻膠圖形的制作技術及其機理討論[ J].真空科學與技術, 1994, 5:215-219.
[ 10] 王軍,楊剛,蔣亞東,等.圖形反轉工藝制作OLED器件的陰極分離器[ J] .發光學報, 2007, 2:198-202.
[ 11] Spak M, Mammato D, Jain S, et al.Mechanism and Lithographic Evaluation of Image Reversal in AZ5214 Photoresist[ C] //Ellenville:Seventh International Technlcal Conference on Photopolymers, 1985:15-23.
[ 12] Frederick H Dill, William P Hornberger, Peter SHauge, et al.Characterization of Positive Photoresist[ J] .IEEE Trans on Electron Devices, 1975, 22:445-452.

