納米銀膏與微米銀膏燒結連接對比
朱 穎 唐善平
(北京航空航天大學 機械工程及自動化學院,北京100191)
閆劍鋒 鄒貴生
(清華大學機械工程系,北京100084)
錫鉛合金由于其優良的性能而廣泛用于電子工業的芯片封裝[1-2].然而鉛及其合金有毒,相關禁鉛法令也陸續頒布.目前,國內外中低溫無鉛電子封裝連接材料主要是以Sn為基體的無鉛釬料.現有的高溫無鉛釬料由于性能及可靠性均不及高鉛釬料,且無法直接利用現有的回流焊工藝實現封裝,故高溫服役條件下的電子器件的互連材料及工藝需進一步研究[3-6].同時隨著大功率器件如大功率 LED器件、混合動力汽車等迅速發展[7],迫切需要一種能夠低溫封裝、高溫服役并能保持高可靠性的無鉛電子封裝材料.
近來國內外提出用納米金屬燒結封裝電子芯片的方案引起了廣泛關注,其基本原理是利用納米金屬顆粒的高表面能、低熔點特性來實現低溫低壓燒結封裝[8].基于此原理,納米銀膏低溫燒結連接成為近年的研究熱點.納米銀膏燒結封裝具有低溫低壓燒結特性,且燒結層理論上可耐960℃以下的高溫,同時銀具有良好的導電導熱及延展性,故可用于高溫電子產品的封裝.
目前,國際上已有將納米銀膏用于電子封裝的研究,如Minoru Maruyama等利用納米銀實現了硅二極管芯片與銅基板的連接,其測試表明可靠性高于傳統Pb-5Sn封裝的芯片[9].國內,鄒貴生、齊昆等分別對納米銀膏燒結性能及其燒結粘接的可靠性進行了研究[10-11].微米銀膏作為電子封裝材料已得到應用,與納米銀膏燒結連接相比,微米銀膏銀顆粒的尺寸較大,其燒結溫度較高或燒結壓力較大[12],燒結連接特性也有一定差異,故二者在相同條件下的燒結連接強度及其連接機理尚需進一步研究.本文用自行制備的納米銀膏與微米銀膏實現了鍍銀銅塊的燒結連接,并對納米銀膏與微米銀膏在相同連接條件下的接頭剪切強度、斷口形貌及顯微組織進行了對比研究.
1 實驗材料與方法
以乙二醇為還原劑,聚乙烯吡咯烷酮為保護劑,通過加熱還原AgNO3制得納米銀,銀膏的具體制備方法見文獻[13],然后利用其進行燒結連接.為降低實驗成本,連接試樣分別用直徑為6 mm和10 mm的鍍銀銅圓柱代替封裝芯片及基板,銅塊高度均為5 mm,連接表面鍍銀,如圖1所示.接頭的剪切強度用熱/力物理模擬試驗機Gleeble 1500D來測定,剪切示意圖如圖2所示.納米銀膏中的Ag為直徑20~80 nm的球形顆粒,如圖3a所示.微米銀膏是用商業銀粉按納米膏相同有機成份配制而成.微米銀膏由1~3 μm的不規則多面體(圖3b)Ag顆粒構成.在連接實驗中,先在兩個被連接鍍銀銅圓柱的待連接面均勻涂覆銀膏,然后將小鍍銀銅圓柱對接于大銅圓柱上面,于250℃直接燒結連接.具體燒結工藝參數如下:燒結溫度為250℃,燒結壓力為2~5MPa,燒結氣氛為大氣,保溫時間為5 min.
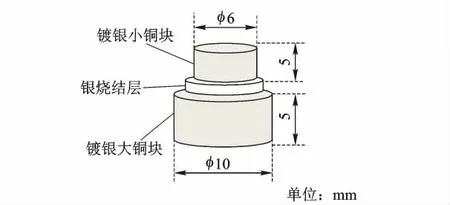
圖1 試樣尺寸

圖2 剪切示意圖
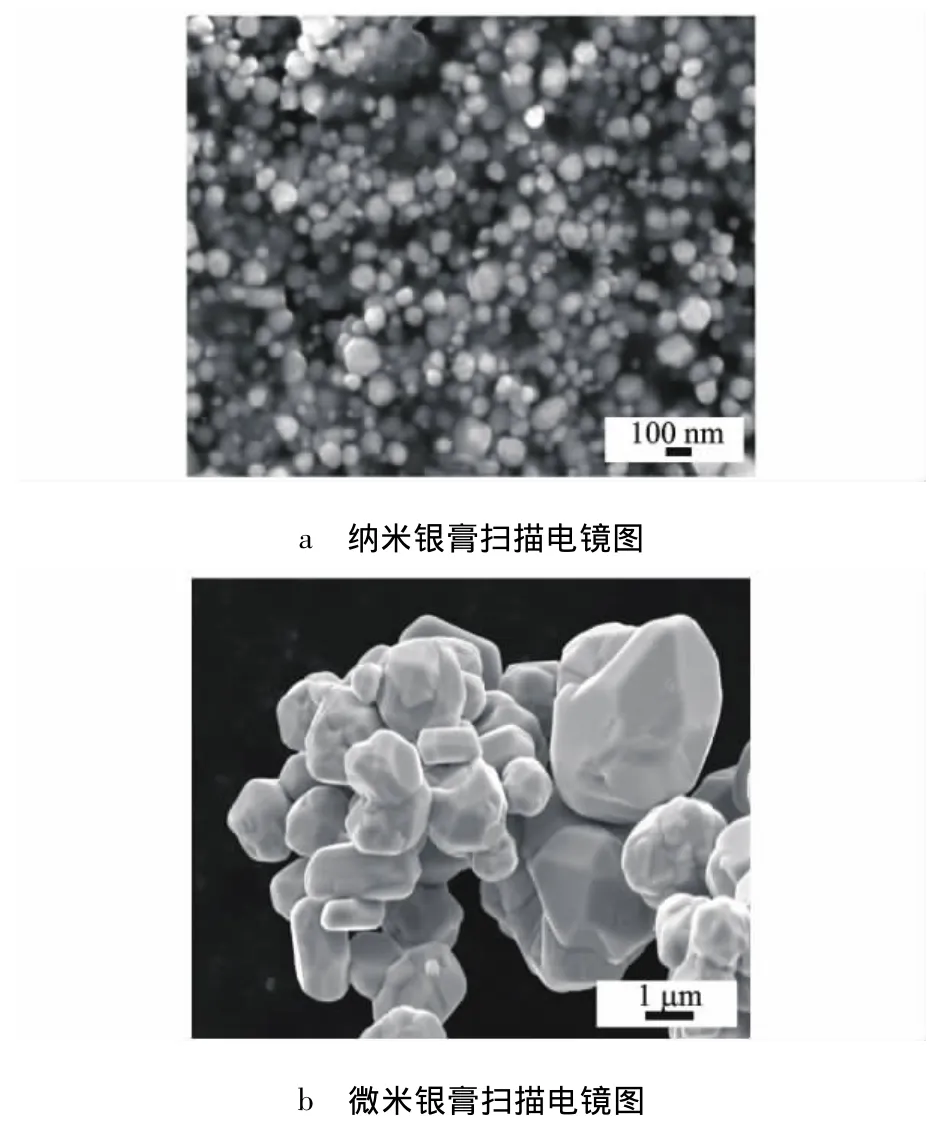
圖3 銀膏的微觀形貌的掃描電鏡圖
2 結果與討論
2.1 納米銀膏與微米銀膏的燒結接頭剪切強度
為對比分析納米銀膏與微米銀膏燒結連接強度的差異,將微米銀膏與納米銀膏在相同條件下燒結連接鍍銀銅塊.圖4為上述接頭的剪切強度,圖中誤差棒為同一壓力下3個試樣中最大剪切強度與最小剪切強度.實驗表明微米銀膏在5 MPa條件下燒結接頭的剪切強度僅有4 MPa,而相同條件下,納米銀膏燒結接頭的剪切強度可達到38 MPa,為前者的9倍多.可見,與微米銀膏燒結連接鍍銀銅塊相比,納米銀膏在低燒結壓力條件下其剪切強度有明顯優勢.

圖4 微米銀膏與納米銀膏的接頭剪切強度
2.2 納米銀膏與微米銀膏燒結接頭的斷口及分析
圖5為納米銀膏、微米銀膏在250℃,5 MPa,5 min燒結剪切后的斷口形貌.納米銀燒結接頭從燒結層發生斷裂,如圖5a所示.進一步研究發現,納米銀燒結層呈多微孔狀結構(圖5b),該微孔結構有利于被連接電子器件在溫度變化過程中應力的釋放,可延長器件的使用壽命[14].而微米銀膏燒結連接斷口與納米銀膏燒結連接斷口明顯不同,其主要從燒結層與鍍銀層界面間斷開(圖5c).進一步分析發現,由于微米銀顆粒尺寸較大,銀顆粒間未實現大面積融合,僅有小部分小顆粒尺寸的銀出現了燒結頸縮,且燒結后顆粒間的孔隙粗大(圖5d),其剪切強度較低.

圖5 納米銀膏、微米銀膏的接頭斷口
納米銀膏與微米銀膏接頭顯微組織分析表明,在相同連接條件下,納米銀燒結層組織均勻質密,燒結接頭的連接界面顯示鍍銀層與納米銀燒結層形成了較好結合,見圖6a.由于納米銀膏中只有金屬銀及有機物,因此,燒結層中不存在釬焊接頭中類似的金屬間化合物,但部分燒結區域可能存在小量燒結過程中未完全揮發的有機物,它們可能會碳化后以C的形式存在(圖6b).由于燒結層主要由銀構成,因此相對傳統封裝材料,納米銀燒結接頭的導電導熱性能更好[7].微米銀膏由于銀顆粒尺寸較大表面能低,在低溫低壓下燒結較困難[15],僅局部區域實現燒結,連接界面間難以形成連續的冶金結合,易在鍍銀層與燒結層界面間形成微小裂紋(本質是未焊合)(圖6c中區域(1)),使得界面間的連接強度較低.故其連接界面的冶金結合呈現非連續性,燒結層呈現為粗大的孔隙狀,如圖6c所示.與納米銀膏燒結接頭成份類似,微米銀膏燒結層主要以純銀為主 (圖6d).

圖6 納米銀膏、微米銀膏的接頭界面掃描電鏡圖及能譜分析
3 結論
1)納米銀膏在250℃燒結溫度、5min保溫時間及2~5 MPa的燒結壓力作用下,能夠實現燒結連接.在相同燒結條件下,納米銀膏燒結接頭比微米銀膏燒結接頭具有更高的剪切強度.
2)納米銀膏和微米銀膏的燒結接頭顯微組織顯示,納米銀膏接頭燒結層與鍍銀層結合較好,接頭燒結層為多微孔組織,有利于延長電子器件的使用壽命;微米銀膏接頭燒結層則孔隙粗大,孔隙率高,且燒結接頭界面處存在裂紋,降低了接頭剪切強度.EDS分析顯示,兩種接頭的主要成份是Ag,可提高接頭的導電導熱性能,有利于接頭的高溫服役性能.
References)
[1]朱笑鶤,婁浩煥,瞿欣,等.電子封裝面臨無鉛化的挑戰[J].電子與封裝,2005,5(5):2-8 Zhu Xiaokun,Lou Haohuan,Qu Xin,et al.The challenge of changeover to lead-free in electronic packaging[J].Electronics& Packaging,2005,5(5):2-8(in Chinese)
[2]安榮,劉威,杭春進,等.電子封裝與組裝焊點界面反應及微觀組織研究進展[J].電子工藝技術,2011,32(6):321-325 An Rong,Liu Wei,Hang Chunjin,et al.Sn-based solder reaction and microstructure in electronic packaging and assembly[J].E-lectronics Process Technology,2011,32(6):321-325(in Chinese)
[3]馬良,尹力夢,冼健威,等.高溫電子封裝無鉛化的研究進展[J].焊接技術,2009,38(5):6-10 Ma Liang,Yin Limeng,Xian Jianwei,et al.Research advancement of high temperature lead-free electronic packaging[J].Welding Technology,2009,38(5):6-10(in Chinese)
[4]李聰,陳繼兵,安兵,等.微連接焊點熱循環可靠性的研究進展[J].電子工藝技術,2011,32(6):316-320 Li Cong,Chen Jibing,An Bing,et al.Review on reliability of micro-solder joints subjected to thermal cycling[J].Electronics Process Technology,2011,32(6):316-320(in Chinese)
[5]鄒貴生,閆劍鋒,母鳳文,等.微連接和納連接的研究新進展[J].焊接學報,2011,32(4):107-112 Zou Guisheng,Yan Jianfeng,Mu Fengwen,et al.Recent progress in microjoining and nanojoining[J].Transactions of the China Welding Institution,2011,32(4):107-112(in Chinese)
[6]楊艷,尹立孟,冼健威,等.綠色電子制造及綠色電子封裝材料[J].電子工藝技術,2008,29(5):256-261 Yang Yan,Yin Limeng,Xian Jianwei,et al.Green manufacturing of electronics and materials for green electronic packaging[J].Electronics Process Technology,2008,29(5):256-261(in Chinese)
[7] Morita Toshiaki,Ide Eiichi,Yasuda Yusuke,et al.Study of bonding technology using silver nanoparticles[J].Japanese Journal of Applied Physics,2008,47(8):6615-6622
[8] Bufat Ph,Borel J P.Size effect on the melting temperature of gold particles[J].Physical Review A,1976,13(6):2287-2298
[9] Minoru Maruyama,Ryo Matsubayashiet,Hiroaki Iwakuro,et al.Silver nanosintering:a lead-free alternative to soldering[J].Applied Physics A,2008(93):467-470
[10]閆劍峰,鄒貴生,李鍵,等.納米銀焊膏的燒結性能及其用于銅連接的研究[J].材料工程,2010(10):5-8 Yan Jianfeng,Zou Guisheng,Li Jian,et al.Study on the sintering characteristics and application in Cu bulk bonding of Agnanoparticle paste[J].Journal of Materials Engineering,2010(10):5-8(in Chinese)
[11]齊昆.納米銀焊膏低溫燒結粘接可靠性研究[D].天津:天津大學化工學院,2007 Qi Kun.A study of interconnection reliability for low-temperature sintered nano-silver paste[D].Tianjin:School of Chemical Engineering and Technology,Tianjin University,2007(in Chinese)
[12] Bai John G,Zhang Zhiye Zach,Jesus N,et al.Low-temperature sintered nanoscale silver as a novel semiconductor device metalized substrate interconnect material[J].IEEE Transactions on Components and Packaging Technologies,2006,29(3):589-593
[13] Yan Jianfeng,Zou Guisheng,Wang Xiaoyu,et al.Large-scale synthesis of Ag nanoparticles by polyol process for low temperature bonding application[C]//2011 International Conference on Electronic Packaging Technology&High Density Packaging.Shanghai:IEEE/IEE Electronic Library(IEL),2011:254-259
[14] Bai John G,Lu Guoquan.Thermomechanical reliability of lowtemperature sintered silver die attached sic power device assembly[J].IEEE Transactions on Device and Materials Reliability,2006,6(3):436-441
[15] Zhang Zhiye,Lu Guoquan.Pressure-assisted low-temperature sintering of silver paste as an alternative die-attach solution to solder reflow[J].IEEE Transactions on Electronics Packaging Manufacturing,2002,25(4):279-283

