確定性測(cè)試矢量生成的低功耗設(shè)計(jì)
李 鵬,顏學(xué)龍,孫 元
(桂林電子科技大學(xué)電子工程與自動(dòng)化學(xué)院,廣西桂林541004)
隨著深亞微米工藝技術(shù)的發(fā)展,集成電路的工藝尺寸日益減少,電路節(jié)點(diǎn)的物理可訪問(wèn)性正逐步削弱以至于消失,這使得電路和芯片的測(cè)試變得尤為困難,以往依賴自動(dòng)測(cè)試儀器ATE(Automated Test Equipment)方法,因其傳輸帶寬和存儲(chǔ)容量的制約,已經(jīng)增加了大量測(cè)試成本。內(nèi)建自測(cè)試BIST(Built-in Self Test)擺脫了對(duì)昂貴ATE設(shè)備的依賴,僅僅依靠片上的資源完成對(duì)電路的測(cè)試[1-2]。傳統(tǒng)的內(nèi)測(cè)試方法如窮舉/偽窮舉測(cè)試、偽隨機(jī)測(cè)試、確定性測(cè)試等方法,在測(cè)試時(shí)間、故障覆蓋率、測(cè)試功耗和硬件開(kāi)銷等方面都值得改進(jìn),許多學(xué)者針對(duì)測(cè)試矢量生成結(jié)構(gòu)的這些綜合因素提出了解決方案,如文獻(xiàn)[3-4]提出了一種低功耗DS-LFSR測(cè)試生成方案,方案不僅提高了故障覆蓋率,而且還降低了部分測(cè)試功耗;文獻(xiàn)[5]提出一種雙模式的低功耗LFSR結(jié)構(gòu),該結(jié)構(gòu)在不降低故障覆蓋率的條件下,減少了超過(guò)70%的測(cè)試功耗;文獻(xiàn)[6-7]提出了一種矢量插入結(jié)構(gòu),在保證一定故障覆蓋率的前提下,通過(guò)降低原有的矢量對(duì)間的漢明距離,來(lái)減少測(cè)試功耗;文獻(xiàn)[8]提出了一種基于格雷碼的電路自測(cè)試序列的分配算法,方案根據(jù)電路的基本輸入權(quán)重,合理分配格雷序列的跳變位,測(cè)試具有較高的故障覆蓋率,而且更大程度上降低了測(cè)試功耗。
本文提出一種基于確定性矢量的低功耗測(cè)試生成方案,通過(guò)可配置反饋網(wǎng)絡(luò)的LFSR來(lái)完成確定性測(cè)試矢量的生成,以保證有很高的故障覆蓋率,并通過(guò)外圍的單翻轉(zhuǎn)矢量的生成邏輯,在欲生成的確定性測(cè)試矢量間插入單一翻轉(zhuǎn)的測(cè)試矢量,以降低被測(cè)電路的各類功耗。對(duì)ISCAS’85基準(zhǔn)電路的實(shí)驗(yàn)結(jié)果表明:該測(cè)試方案能得到很高的故障覆蓋率,而且測(cè)試功耗降低明顯。
1 可配置反饋網(wǎng)絡(luò)的LFSR結(jié)構(gòu)
傳統(tǒng)的LFSR可以產(chǎn)生隨機(jī)性較好的測(cè)試矢量,然而這類矢量只能檢測(cè)出被測(cè)電路中的隨機(jī)矢量可測(cè)性故障(Random Pattern Detectable Faults),而電路中的一部分抗隨機(jī)性故障(Random Pattern Resistant Faults)需要借助固定的算法,產(chǎn)生一些有針對(duì)性的矢量才能夠被檢測(cè)[9]。可配置反饋網(wǎng)絡(luò)的LFSR作為一種混合測(cè)試生成結(jié)構(gòu),既能生成確定性測(cè)試矢量,又能生成偽隨機(jī)性測(cè)試矢量,本文正應(yīng)用了該結(jié)構(gòu),以生成Atalanta工具模擬產(chǎn)生的一組確定性矢量集,以提高單位測(cè)試時(shí)間內(nèi)的故障覆蓋率。
1.1 確定性測(cè)試矢量的生成結(jié)構(gòu)
可配置反饋網(wǎng)絡(luò)的LFSR的結(jié)構(gòu)如圖1所示,各個(gè)觸發(fā)器的輸入是由觸發(fā)器輸出經(jīng)反饋異或配置和選擇反向器配置得到(合并稱“反饋配置”)。

圖1 可配置LFSR結(jié)構(gòu)
該電路的各個(gè)輸入Vi可用含有r個(gè)觸發(fā)器輸出的邏輯變量QL1(n),QL2(n),…,QLr(n)和反向配置邏輯變量Ci表示成二元域內(nèi)的線性非齊次方程:

其中aki為第k個(gè)觸發(fā)器反饋接入第i位輸入Vi的配置節(jié)點(diǎn),aki∈{0,1},k、i=1,2,…,r.aki=1 時(shí),表示反饋接入異或門,反之表示無(wú)反饋接入;Ci為非門控制,Ci∈{0,1},Ci=1時(shí)表示通過(guò)非門接入輸入,反之則直通輸入;QLi為第i位觸發(fā)器輸出。如果按確定性測(cè)試矢量集的順序,將待生成的測(cè)試矢量的第i位從第1個(gè)序列到第s個(gè)序列依次代入到方程(1)中,即可得到矩陣方程(2),這里的表示第i位的第x個(gè)測(cè)試序列的次態(tài)值,x=1,2,…,s并有=V(x+1)i。并記 CNi=(a1i,a2i,…,ari,Ci)為該位的反饋配置向量,對(duì)應(yīng)于式(2)中的各個(gè)部分,可簡(jiǎn)記為:b=A·CNi,其中b為確定性矢量在第i位的次態(tài)值,A中Vxi為確定性矢量的現(xiàn)態(tài)值,s為確定性測(cè)試集的大小。

如果方程(2)有解,說(shuō)明該確定性測(cè)試集的第i位序列可以完全通過(guò)反饋配置向量CNi得到;反之,說(shuō)明該反饋配置向量只能生成原確定性測(cè)試集在第i位中的一部分序列,而另一部分需要重新代入式(1),構(gòu)造新的矩陣方程,尋求新的配置向量,直到全部測(cè)試集可解為止。故生成完整的確定性測(cè)試集,可能需要對(duì)原測(cè)試集進(jìn)行劃分,進(jìn)而得到多個(gè)反饋配置向量。
1.2 確定性測(cè)試矢量的劃分
圖2為多通道的可配置LFSR結(jié)構(gòu),完整的確定性測(cè)試集被劃分為p個(gè)子集,而每個(gè)子集由相應(yīng)的配置向量作用一定的時(shí)鐘來(lái)生成,其中配置通道的個(gè)數(shù)和配置向量的作用時(shí)鐘都需要對(duì)原測(cè)試矢量的劃分來(lái)決定,矢量劃分的理論基礎(chǔ),就是非齊次方程組的有解判定定理。

圖2 多通道的可配置LFSR結(jié)構(gòu)
定理1非齊次線性方程組

定理2設(shè)η是非齊次方程組的一個(gè)特解,ξ1,ξ2,…,ξn-r,是其導(dǎo)出組的基礎(chǔ)解系,則非齊次方程組(3)的通解為 η +k1ξ1+k2ξ2+ … +kn-rξn-r,其中r=R(A),k1,k2,…,kn-r為任意常數(shù)。
推論若R(A)=R(A|b)=n時(shí),方程組(3)有唯一解;若R(A)=R(A|b)<n時(shí),方程組(3)有無(wú)窮多解,其通解為 η +k1ξ1+k2ξ2+ … +kn-rξn-r;若R(A)≠R(A|b)時(shí),方程組(3)無(wú)解。
根據(jù)上述的定理1和推論可知:方程組(3)中只有當(dāng)R(A)=R(A|b)時(shí),才可以求出其配置向量CNi,若R(A)≠R(A|b),則需要對(duì)原測(cè)試進(jìn)行劃分,劃分的步驟為:
(1)將方程組(2)中的增廣矩陣(A|b),做行初等變換(二元域內(nèi)的模2加),使每行第一個(gè)非零元素下面的數(shù)為0。
(2)找出增廣矩陣(A|b)中A陣全為0,而b中不為零的行,即使R(A)≠R(A|b)的行,那么該行即為原測(cè)試集的一個(gè)劃分點(diǎn)。
(3)將原測(cè)試集在該劃分點(diǎn)之后的測(cè)試矢量重新代入方程(2),并重復(fù)步驟(1)(2),直到剩余的測(cè)試矢量全部可解。
劃分子集的多少,即為配置通道的個(gè)數(shù),而劃分子集的長(zhǎng)度(子集中包含測(cè)試矢量的個(gè)數(shù))就是每個(gè)配置向量的作用時(shí)鐘數(shù)。
1.3 反饋配置向量的優(yōu)化
根據(jù)定理(2)可知,非齊次方程可能存在多組解,而解結(jié)構(gòu)的不同,整個(gè)結(jié)構(gòu)的硬件開(kāi)銷也隨之不同,因此為了獲得較少的硬件開(kāi)銷,必須對(duì)方程的通解進(jìn)行尋優(yōu)。
對(duì)于反饋配置向量 CNi=(a1i,a2i,…,ari,Ci),其中各個(gè)元素取值為0或1,向量中的“1”元素對(duì)應(yīng)著配置網(wǎng)絡(luò)中的門結(jié)構(gòu),因此要使門結(jié)構(gòu)最少,應(yīng)以尋找通解中“1”最少的一組解向量作為限制條件,同時(shí)因非門比異或門的硬件開(kāi)銷要小,所以還可以在含“1”最少的通解中,盡量選擇Ci=1的解,作為該位最優(yōu)配置解進(jìn)行解空間內(nèi)的尋優(yōu),尋優(yōu)步驟為:
(1)求出矩陣方程的基解(ξ1,ξ2,…,ξN)和特解η。
(2)將基解矩陣(ξ1,ξ2,…,ξN)T做初等行變換,使每行第一個(gè)非0元素以下和以上的各行對(duì)應(yīng)元素為 0,得(ξ'1,ξ'2,…,ξ'N)T。
(3)計(jì)算 η 中含“1”的個(gè)數(shù),記I(η),并在 ξ1',ξ2',…,ξN'中找出與 η 重復(fù)度最大的基 ξ'r1,做運(yùn)算η1= η⊕ξ'r1。
(4)計(jì)算I(η1),并比較I(η)和I(η1)。若I(η)<I(η1),則 η 即為最優(yōu)通解,算法停止;若I(η)≥I(η1),則在余下的 ξ'1,ξ'2,…,ξ'r1-1,ξ'r1+1,…,ξ'N中找出與 η1重復(fù)度最大的基 ξ'r2,重復(fù)(3)(4)兩個(gè)步驟。
(5)在已尋得的所有最優(yōu)通解中,盡量選擇末位為“1”的通解。
2 低功耗測(cè)試生成的設(shè)計(jì)
2.1 測(cè)試功耗的產(chǎn)生與衡量標(biāo)準(zhǔn)
在集成電路測(cè)試過(guò)程中,往往因測(cè)試矢量的相關(guān)性較低,電路節(jié)點(diǎn)的翻轉(zhuǎn)密度高,使得測(cè)試功耗要比正常工作時(shí)的功耗高出數(shù)倍[5-6],巨大的功耗聚集的熱量不僅會(huì)縮短器件壽命甚至燒毀器件,而且還會(huì)嚴(yán)重影響測(cè)試質(zhì)量。CMOS電路中的功耗來(lái)源主要分為靜態(tài)功耗和動(dòng)態(tài)功耗兩種,其中的動(dòng)態(tài)功耗約占總功耗的90%,因此減少動(dòng)態(tài)功耗是降低系統(tǒng)功耗的有效途徑。對(duì)于被測(cè)電路,當(dāng)連續(xù)輸入測(cè)試矢量對(duì)TPk=(Vk-1,Vk)時(shí),定義在該區(qū)間的功耗Evk可表示為式(4):

式中i包括電路中所有的節(jié)點(diǎn),F(xiàn)i為該節(jié)點(diǎn)的扇出數(shù),C0為單位輸出的負(fù)載電容,VDD代表電源電壓,S(i,k)為矢量對(duì)TPk引起節(jié)點(diǎn)i翻轉(zhuǎn)的次數(shù),因電源電壓和單位輸出負(fù)載電容是定值,S(i,k)×Fi是功耗分析中唯一可變因素,稱S(i,k)×Fi為TPk作用在節(jié)點(diǎn)i上的WSA(Weighted Switching Activity),考慮電路總的測(cè)試向量集 TP=(V1,V2,…,Vn),k=1,2…,n-1。整個(gè)電路總功耗、平均功耗和峰值功耗都可以用WSA進(jìn)行衡量,對(duì)應(yīng)表達(dá)是依次為式(5)~式(7):

從上面的分析不難發(fā)現(xiàn),被測(cè)電路的總功耗可以通過(guò)減少測(cè)試集長(zhǎng)度來(lái)降低,也可通過(guò)減少測(cè)試節(jié)點(diǎn)的翻轉(zhuǎn)來(lái)降低;在總功耗一定的情況下,增加測(cè)試集長(zhǎng)度,可以降低平均功耗;電路的峰值功耗只能通過(guò)減少測(cè)試節(jié)點(diǎn)的翻轉(zhuǎn)來(lái)降低。而這里被測(cè)電路內(nèi)部節(jié)點(diǎn)的翻轉(zhuǎn),正比于其輸入矢量的翻轉(zhuǎn)密度[3],因此,減少測(cè)試矢量的翻轉(zhuǎn)是降低被測(cè)電路各類功耗的有效方法。
2.2 低功耗測(cè)試結(jié)構(gòu)
為了在不改變已生成的測(cè)試矢量基礎(chǔ)上,得到矢量間單一翻轉(zhuǎn)的測(cè)試矢量,可以采用如圖3所示的LP-TPG(Low Power-Test Patterns Generation)結(jié)構(gòu)[7],通過(guò)比較原有的相鄰測(cè)試矢量,并用環(huán)形移位寄存器(CSR)按位依次檢測(cè)比較結(jié)果,最后得到單翻轉(zhuǎn)矢量進(jìn)行插入。這樣就保證了總功耗不變的情況下,增加了測(cè)試序列長(zhǎng)度,從而降低平均功耗和峰值功耗。
由于隨著被測(cè)電路輸入端的增多,LP-TPG結(jié)構(gòu)的硬件開(kāi)銷也會(huì)變得很大,因此做如圖4的改進(jìn),圖中應(yīng)用了可配置LFSR結(jié)構(gòu)替換了傳統(tǒng)的LFSR,并利用了三個(gè)總線選擇器就節(jié)省了原LP-TPG近一半的硬件開(kāi)銷。結(jié)構(gòu)中可配置LFSR分為兩個(gè)部分,即高n/2位(模塊A)和低n/2位(模塊B)(如果被測(cè)電路輸入端為奇數(shù)位,則將最中間的觸發(fā)器同時(shí)并入A、B兩個(gè)模塊),并將兩部分的現(xiàn)、次態(tài)異或向量分時(shí)段送入n/2位的LP-TPG,原LP-TPG結(jié)構(gòu)中的CSR輸出over信號(hào),需要經(jīng)歷高n/2位、低n/2位兩次溢出計(jì)數(shù)后(couter=2),才能輸出over’信號(hào),并在下一個(gè)clk來(lái)臨時(shí),使可配置LFSR工作。此外總線選擇信號(hào)也具備以下邏輯:當(dāng)en=1時(shí),高位進(jìn)入翻轉(zhuǎn)檢測(cè),低位保留現(xiàn)態(tài)值,即en1=0,en2=0,此時(shí)LP-TPG結(jié)構(gòu)中的couter=1;當(dāng)en=0時(shí),低位進(jìn)入翻轉(zhuǎn)檢測(cè),高位保留次態(tài)值,即en1=1,en2=1,此時(shí)couter=2并返回0值。
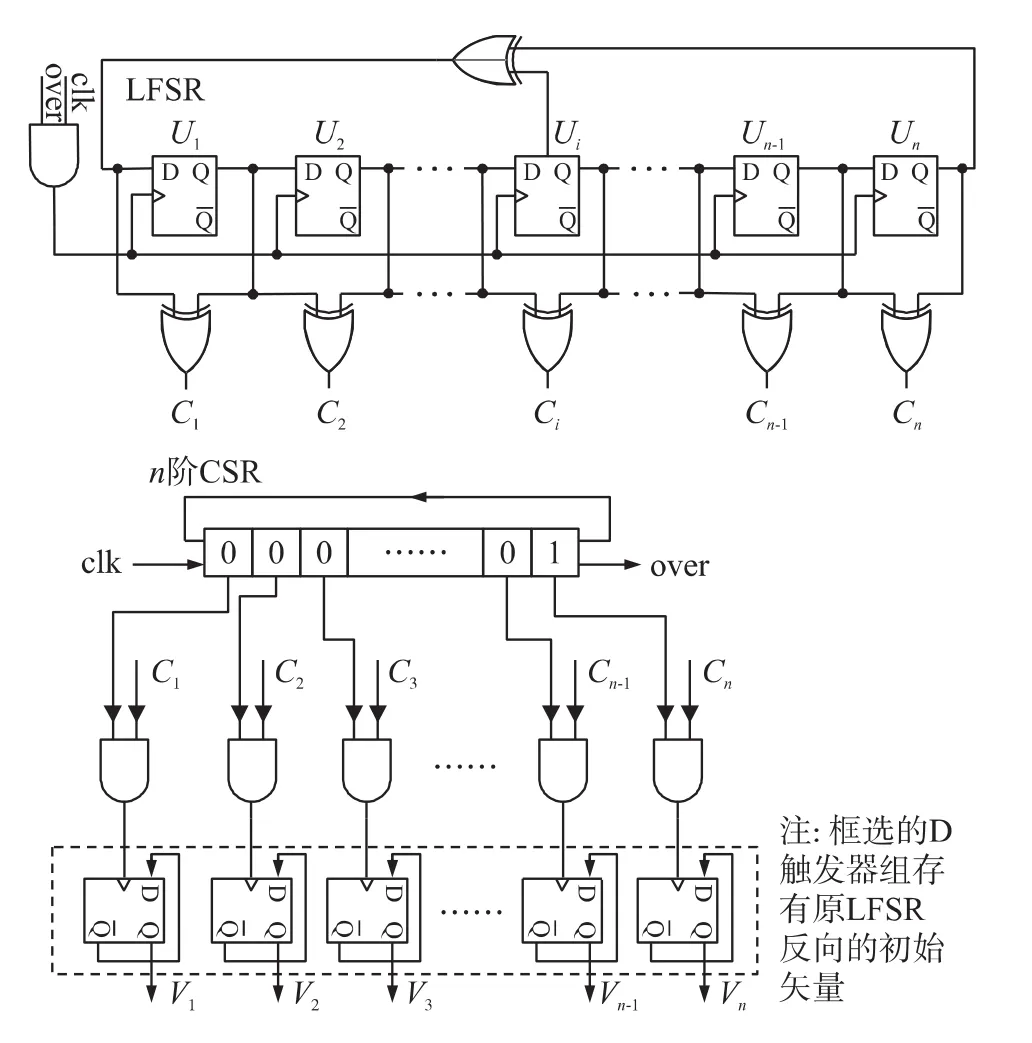
圖3 LP-TPG結(jié)構(gòu)

圖4 基于可配置LFSR的低功耗測(cè)試生成結(jié)構(gòu)
3 實(shí)驗(yàn)及驗(yàn)證
以ISCAS’85實(shí)驗(yàn)中的C17電路為例,利用Atalanta工具對(duì)該電路進(jìn)行故障模擬,在隨機(jī)數(shù)生成器的初始種子為“1358079950”時(shí),得出的確定性矢量如表1所示,按照式(2),將全部位的序列代入到式(2)中,得到矩陣方程(8),并對(duì)該矩陣方程作矢量劃分(式中用虛線標(biāo)出)和通解優(yōu)化處理,最優(yōu)配置結(jié)果如表2所示。

表1 C17電路的確定性矢量

表2 C17電路確定性矢量的優(yōu)化配置
按照矢量劃分原理所得到方程個(gè)數(shù),加載上述配置至圖4所示結(jié)構(gòu),并作用相應(yīng)的時(shí)鐘數(shù),即可在CUT的輸入端得到表3所示的低功耗測(cè)試矢量。

表3 C17電路的低功耗測(cè)試矢量
實(shí)驗(yàn)對(duì)組合電路集ISCAS’85的其他電路也進(jìn)行了確定性矢量的模擬和單一翻轉(zhuǎn)矢量的插入處理,并和文獻(xiàn)[6]進(jìn)行了測(cè)試長(zhǎng)度、電路WSA和故障覆蓋率的比較,如表4所示,實(shí)驗(yàn)中使用了C代碼模擬了DS-LFSR測(cè)試生成過(guò)程和上述結(jié)構(gòu)測(cè)試生成過(guò)程并進(jìn)行WSA的計(jì)算,并應(yīng)用了故障仿真工具fsim進(jìn)行了故障覆蓋率的計(jì)算。
實(shí)驗(yàn)結(jié)果表明,文中提出的低功耗測(cè)試生成方法,總功耗和平均功耗相對(duì)于DS-LFSR方案有大幅度的降低,峰值功耗也有所降低,除此之外,本文方案的測(cè)試集長(zhǎng)度較小,故障覆蓋率也有所提高。
由于本文方案使用的是確定性測(cè)試矢量的生成結(jié)構(gòu),因此相對(duì)于文獻(xiàn)[6-7]的隨機(jī)性測(cè)試,是在保證故障覆蓋率的前提下,減少了大量隨機(jī)測(cè)試的冗余矢量,同時(shí)插入了單一翻轉(zhuǎn)的測(cè)試矢量,進(jìn)而降低測(cè)試的各類功耗。該結(jié)構(gòu)適合任意組合電路的測(cè)試。不足之處是本文LFSR的配置網(wǎng)絡(luò)相對(duì)于傳統(tǒng)LFSR額外增加了一部分硬件開(kāi)銷。

表4 ISCAS’85電路上的實(shí)驗(yàn)結(jié)果
4 結(jié)論
本文提出了一種高故障覆蓋率的低功耗測(cè)試生成結(jié)構(gòu),結(jié)構(gòu)利用可配置LFSR作為混合測(cè)試矢量生成器,以提高故障覆蓋率,同時(shí)借助已生成矢量的現(xiàn)、次態(tài)異或值,按位逐一插入單跳變矢量,使得系統(tǒng)的各類功耗得到降低。針對(duì)LP-TPG結(jié)構(gòu),本文利用了異或矢量的分塊處理方法,在不影響原LPTPG工作的前提下,減少了一部分硬件開(kāi)銷。經(jīng)過(guò)對(duì)ISCAS’85電路的實(shí)驗(yàn),表明了該結(jié)構(gòu)不僅能很大程度上,降低被測(cè)電路總功耗和峰值功耗,而且能夠保證在很高的故障覆蓋率的情況下,減少測(cè)試集長(zhǎng)度以縮短測(cè)試時(shí)間,提高故障檢測(cè)效率,因此對(duì)推動(dòng)低功耗BIST技術(shù)具有一定的意義。
[1]李鑫,梁華國(guó),陳田,等.基于折疊計(jì)數(shù)器的低功耗確定BIST方案[J].儀器儀表學(xué)報(bào),2011,32(12):1-5.
[2]吳義成,梁華國(guó),李松坤,等.一種基于自選擇狀態(tài)的折疊計(jì)數(shù)器BIST方案[C]//第六屆中國(guó)測(cè)試學(xué)術(shù)會(huì)議論文集,中國(guó)合肥,2010.
[3]Wang S,Gupta S K.DS-LFSR:A BIST TPG for Low Switching Activity[C]//IEEE Transactions on Computer-Aided Design of Integrated Circuits and Systems,2002,21(6):842-851.
[4]談恩民,葉宏,施文康.低功耗BIST設(shè)計(jì)中的加權(quán)DS-LFSR測(cè)試生成方法研究[C]//中國(guó)儀器儀表與測(cè)控技術(shù)交流大會(huì),中國(guó)四川,2007
[5]Zhang Zhe,Hu Chen,Xiang Wangxue,et al.A Low BIST Methodology Based on Two-Mode LFSR[J].Chinese Journal of Electron Devices,2004,27(4):705-709.
[6]何蓉暉,李曉維,宮云戰(zhàn).一種低功耗BIST測(cè)試產(chǎn)生器的方案[J].微電子學(xué)與計(jì)算機(jī),2003,20(2):36-39.
[7]談恩民,宋勝東,施文康.單/雙跳變向量插入式低功耗BIST設(shè)計(jì)方法[J].微電子學(xué)與計(jì)算機(jī),2007,24(7):183-185.
[8]孫海珺,王宣明,盧曉博,等.一種基于格雷碼的電路自測(cè)試序列分配算法[J].計(jì)算機(jī)學(xué)報(bào),2011,34(9):1697-1704.
[9]Chen C I H,George K.Configurable Two Dime-Nsional Linear Feed Back Shifter Registers for Parallel and Serial Built-In Self-Test[J].IEEE Trans,Instrumentation and Measurement,2004,53(4):1005-1014.

