氧化鎵薄膜的制備及其日盲紫外探測性能研究
劉 浩,鄧 宏*,韋 敏,于永斌,陳文宇
(1.電子科技大學電子薄膜與集成器件國家重點實驗室,四川成都 610054;
2.電子科技大學信息與軟件工程學院,四川成都 610054;
3.電子科技大學計算機科學與工程學院,四川成都 610054)
氧化鎵薄膜的制備及其日盲紫外探測性能研究
劉 浩1,鄧 宏1*,韋 敏1,于永斌2,陳文宇3
(1.電子科技大學電子薄膜與集成器件國家重點實驗室,四川成都 610054;
2.電子科技大學信息與軟件工程學院,四川成都 610054;
3.電子科技大學計算機科學與工程學院,四川成都 610054)
采用射頻磁控濺射方法在藍寶石單晶襯底上沉積氧化鎵(Ga2O3)薄膜,并通過光刻剝離工藝(Lift-off)制備了金屬-半導體-金屬結構的Ga2O3日盲紫外探測器。對不同溫度下沉積的Ga2O3薄膜分析表明,在800℃下獲得的薄膜結晶質量最好,薄膜的導電性則隨著沉積溫度的上升先增大后減小。在800℃制備的β-Ga2O3薄膜的可見光透光率大于90%,光學吸收邊在255 nm附近。在10 V偏壓下,探測器的暗電流約為1 nA,光電流達800 nA,對紫外光響應迅速。器件的響應度達到0.3 A/W,260 nm波長處的響應度是290 nm波長對應響應度的40倍,可實現日盲紫外波段的探測。
β-Ga2O3;射頻磁控濺射;紫外探測
1 引 言
β-Ga2O3作為一種直接帶隙氧化物半導體材料,室溫下禁帶寬度約為4.9 eV,對應波長為250 nm,恰好處在日盲(200~280 nm)紫外波段[1],在宇宙探索、導彈追蹤、火焰預警等領域都有廣泛的應用價值。目前,主要用于日盲探測的材料有Al-GaN、ZnMgO、金剛石、β-Ga2O3等。AlGaN要實現日盲探測,需要較高的Al組分,但是很難制備高Al且質量很高的薄膜[2]。纖鋅礦結構的ZnMgO也面臨同樣的問題,摻Mg含量過高時無法保證晶格完好[3]。金剛石由于禁帶寬度過大(~5.45 eV),不能實現對整個日盲波段的探測且價格昂貴。Ga2O3作為一種二元氧化物材料,完美的單晶較容易獲得,制備方法簡單,物理化學性質穩定,禁帶寬度為4.7~4.9 eV,被認為是制備日盲光電探測器最為理想的材料之一。近年來,無論是Ga2O3單晶,還是Ga2O3薄膜和納米線,都有用于日盲紫外探測器的報道[4-5]。目前而言,利用β-Ga2O3薄膜制備探測器在實際應用方面更具潛力和價值。
β-Ga2O3薄膜的制備方法有很多,如分子束外延(MBE)[1]、溶膠-凝膠法(Sol-gel)[6]、磁控濺射[7-8]、脈沖激光沉積(PLD)[9]、金屬有機物化學氣相沉積(MOCVD)[10]等。由于射頻磁控濺射具有生長速度快、工藝重復性好、可大面積生長等優點,故本文采用射頻磁控濺射方法沉積薄膜。為了獲得高結晶質量的β-Ga2O3薄膜,實驗以藍寶石(0001)單晶為襯底,在不同溫度下沉積Ga2O3薄膜,研究沉積溫度對薄膜結晶質量和光電性能的影響,并在此基礎上制備了MSM結構的日盲紫外光電器件。
2 實 驗
2.1 儀器與方法
實驗用(0001)藍寶石作為制備Ga2O3薄膜的基片,將封裝于1000級包裝內的5 mm×5 mm× 0.5 mm基片取出,依次用丙酮、無水乙醇和去離子水超聲清洗10 min后,氮氣吹干。采用純度為99.999%的氧化鎵陶瓷靶,在不同襯底溫度下,通過射頻磁控濺射沉積厚度約為200 nm的Ga2O3薄膜。沉積過程中,工作壓強為0.6 Pa,濺射沉積時間為2 h。沉積結束后,樣品在腔體中原位退火30 min。采用Lift-off工藝和電子束蒸發,在薄膜上蒸鍍Ti/Au叉指電極,厚度為250 nm,叉指寬度為0.05 mm,長度為3 mm,間距為0.1 mm,器件有效感光面積為12.5 mm2。為了減少界面接觸電阻,形成良好的歐姆接觸,將樣品在500℃保溫10 min。
2.2 材料表征
采用英國Bede公司生產的D1型XRD(Cu Kα射線,λ=0.154 06 nm)對薄膜結構進行表征;采用美國 Perkin-Elmer公司的 Lambda 750UV/ VIS/NIR紫外-可見分光光度計對薄膜的光學特性進行測量;采用光強13×10-6W/cm2的汞燈(波長254 nm)和安捷倫4155B半導體參數分析儀對薄膜紫外光電性能進行測試;采用DSR-100紫外光響應測試系統對器件紫外光響應度進行測試。
3 結果與討論
3.1 XRD結果分析
圖1為不同襯底溫度下制備的Ga2O3薄膜的XRD圖。襯底溫度為500℃的樣品沒有出現與氧化鎵對應的衍射峰,表明低溫沉積時,被Ar離子轟擊的靶材原子在到達基片后,沒有得到足夠的表面遷移能量,島狀生長形成非晶相。溫度增加到700℃后,樣品的XRD譜中分別在18.95°、38.40°、59.19°處出現衍射峰,對應于β-Ga2O3的晶面,同屬一個晶面組,與Ga2O3的標準卡片JCPDS No.43-1012基本符合,表現出明顯的擇優取向。隨著襯底溫度的上升,這一晶面組的衍射峰強度逐漸增大,這與Oshima等的研究結果一致[1]。針對衍射峰研究發現,其半高寬(FHWM)先由700℃時的0.165°減小到800℃時的0.095°,又逐漸增大到1 000℃時的0.110°。晶粒尺寸可根據公式(1)計算得到:

式中D、λ、β、θ分別為晶粒尺寸、X射線入射波長(λ=0.154 06 nm)、FHWM和布拉格衍射角,計算結果見表1。當襯底溫度增加到1 000℃時,在衍射峰 FHWM增大的同時,在30.05°、 57.64°和60.54°分別出現晶面衍射峰。這說明溫度過高時,晶體的擇優取向減弱,晶格的有序性降低,Ga2O3開始沿著不同的取向生長。

圖1 不同襯底溫度下沉積的Ga2O3薄膜的XRD圖Fig.1 XRD patterns of Ga2O3thin films deposited at various temperatures
表1 不同襯底溫度下制備的Ga2O3的β(402)衍射峰半高寬和晶粒尺寸Table 1FHWMand grain size of Ga2O3thin filmsdeposited at various temperatures

表1 不同襯底溫度下制備的Ga2O3的β(402)衍射峰半高寬和晶粒尺寸Table 1FHWMand grain size of Ga2O3thin filmsdeposited at various temperatures
Temperature/℃ FHWM/(°) Grain size/nm 500 - -700 0.165 53.9 800 0.095 88.6 900 0.102 82.5 1 000 0.110 74.5
3.2 透射光譜分析
圖2為不同襯底溫度下制備的Ga2O3薄膜的紫外-可見透射光譜。500~900℃下沉積的薄膜在可見光部分的光透過率均大于80%,且在240~300 nm之間出現了陡峭的光學吸收邊,與Ga2O3晶體的禁帶寬度相對應。500℃下制備的樣品的光學吸收邊出現在280 nm,透射光譜在330 nm出現的吸收峰對應于氧空位能級,表明薄膜內部空位缺陷較多,結晶質量差[11]。當溫度升高到700℃后,薄膜的光譜曲線則比較平滑,可見光透過率在90%以上,光學吸收邊向短波長方向移動,薄膜結晶質量變好,這與XRD的分析結果是一致的。襯底溫度達到1 000℃時,薄膜吸收邊出現在235 nm,發生非常明顯的藍移。許多研究者認為這是由于高溫沉積,藍寶石基片與Ga2O3薄膜發生反應,半徑更小的Al離子在Ga2O3內部產生擴散,與Ga原子發生替位,使晶格常數減小,導致禁帶寬度展寬[4,12]。圖3是Ga2O3薄膜的(αhv)2隨光子能量hv變化的曲線。Ga2O3作為直接帶隙半導體材料[13-15],滿足以下方程
(αhv)2=B(hv-Eg), (2)其中,α是吸收系數,hv是光子能量,Eg是光學帶隙。以hv為橫坐標,(αhv)2為縱坐標,作(αhv)2隨hv變化的曲線,曲線的切線與橫軸的交點即薄膜材料的禁帶寬度Eg。可以看出,隨著襯底溫度的升高,Ga2O3的光學禁帶寬度變寬。
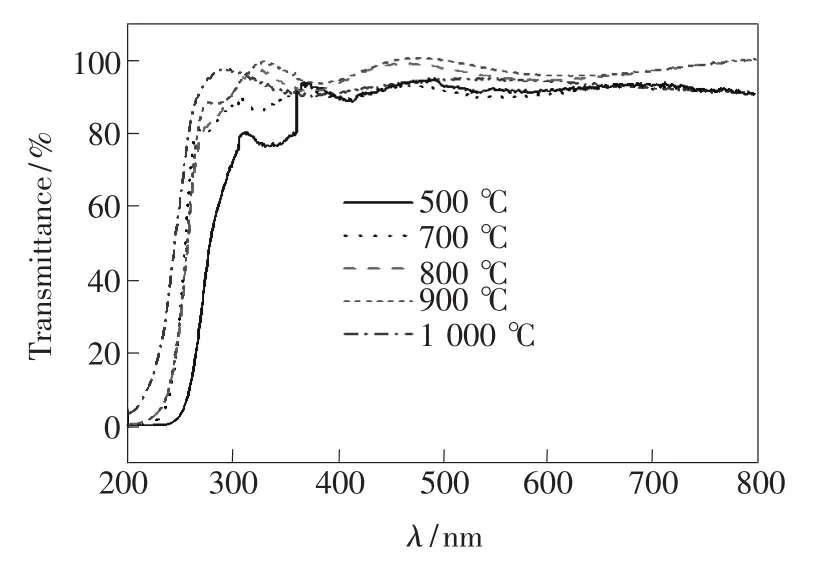
圖2 不同襯底溫度下制備的Ga2O3薄膜的紫外-可見透射光譜Fig.2 Transmittance spectra of Ga2O3thin films deposited at various temperatures

圖3 Ga2O3薄膜的(αhv)2隨光子能量hv變化的曲線Fig.3 (αhv)2vs.photon energy hv of Ga2O3thin films deposited at various temperatures
3.3 電性能分析
利用四探針法測量薄膜的電阻率,得到電阻率隨襯底溫度變化的曲線,如圖4所示。當襯底溫度為500℃時,薄膜的電阻率太大,無法測量。襯底溫度高于700℃后,電阻率迅速下降。800℃沉積的薄膜電阻率最低,約為347Ω·cm。電阻率的變化與薄膜的結晶狀況密不可分。當襯底溫度較低時,被氬離子轟擊的靶原子到達基片后不能得到足夠高的能量做表面遷移,致使薄膜以島狀生長為主,內部存在大量缺陷,阻礙載流子的遷移,所以電阻率很大。溫度高于700℃后,靶原子在自身能量和基片對應的能量作用下,有足夠的能量在基片表面擴散遷移,晶粒合并長大,由島狀生長轉變成層狀生長,Ga2O3由非晶相轉變為β相。故襯底溫度升高后,結晶質量提高,內部缺陷減少,晶粒逐漸變大,晶界散射作用減少。這是導致電阻率明顯下降的主要原因[16-18],與XRD的分析結果一致。

圖4 Ga2O3薄膜電阻率隨沉積溫度變化的曲線Fig.4 Resistivity as a function of deposition temperature
3.4 紫外光電響應性能研究
采用Lift-off工藝和電子束蒸發在薄膜表面制作Ti/Au叉指電極,制備基于Ga2O3薄膜的MSM結構紫外光電探測器(圖5插圖)。在無光照、405 nm和254 nm波長光照下分別測得薄膜探測器的I-V特性曲線,如圖5所示。可以明顯地發現,電流隨電壓呈線性變化,說明Ga2O3薄膜與Ti/Au電極之間形成了良好的歐姆接觸。黑暗條件下和405 nm光照下的I-V曲線基本重合,10 V偏壓下的電流約為1 nA,薄膜對可見光基本沒有表現出敏感特性。而在254 nm紫外光照射下,同樣偏壓下的光電流達到了800 nA,光暗電流比接近3個數量級。圖6為Ga2O3薄膜MSM結構探測器的紫外響應度曲線。探測器的響應波長處在日盲紫外區域,10 V偏壓下的探測器的最大響應度為0.3 A/W,出現在260 nm,是290 nm波長處響應度的40倍。可見探測器對波長大于290 nm的波段基本沒有響應,具有良好的紫外選擇性,有效地避免了非日盲紫外波段對探測器性能的干擾。這應當歸因于β-Ga2O3的寬禁帶特性,結果與圖2中的透射光譜相吻合。
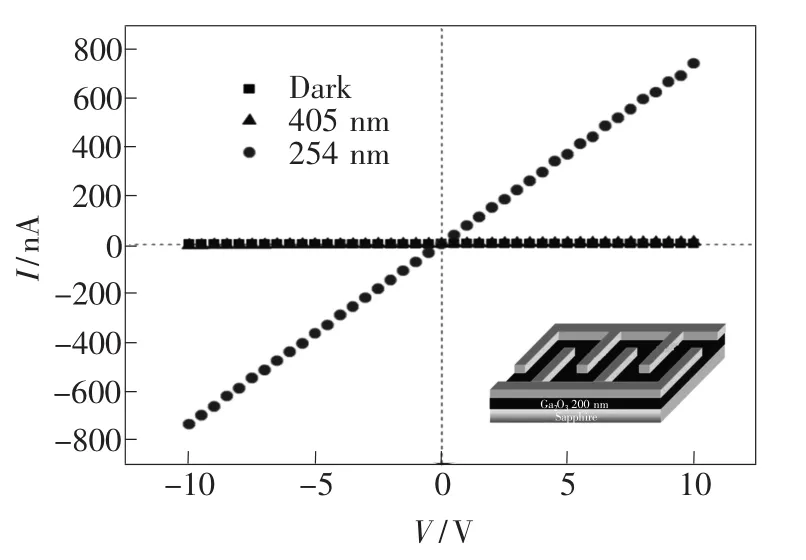
圖5 薄膜探測器在無光、405 nm和254 nm光照下的I-V特性曲線。Fig.5 I-V characteristics ofβ-Ga2O3thin film MSM photodetectors in dark,under 405 nm and 254 nm light, respectively.The inset is the structure of MSM photodetectors.

圖6 β-Ga2O3薄膜MSM器件的紫外響應度曲線Fig.6 Photo responsivity ofβ-Ga2O3thin film MSM photodetectors

圖7 254 nm光照開關響應時間曲線。(a)5次光開關的響應時間曲線;(b)1次光開關的響應時間曲線放大圖。Fig.7 Time-dependent photoresponse of MSM photodetectors under 254 nm illumination.(a)Response curve for five times light on/off switch.(b)Enlarge view of the rise/decay edge for one time light on/off switch.
圖7(a)是Ga2O3薄膜探測器在254 nm汞燈照射下的10 V偏壓下的響應時間曲線。汞燈每隔10 s開/關一次,經過多個循環開關之后,依然表現出穩定的光電特性。暗電流保持在1 nA左右,飽和光電流約為800 nA。圖7(b)為圖7(a)的局部放大圖,可以看出,汞燈開啟,薄膜電流的上升時間約為1 s;汞燈關閉,電流迅速降到1 nA左右,時間僅為0.08 s。這是由于800℃襯底溫度下沉積的薄膜內部的載流子陷阱較少,光生載流子主要來源于價帶與導帶之間的電子躍遷,而陷阱中心“捕獲”和“釋放”載流子的這個緩慢過程作用較小[15],所以器件的響應速度較快,并且抑制了持續光電導現象。從圖7可見,光電流上升達到飽和的時間較長,下降時間明顯小于上升時間(汞燈光源開啟時間約為0.15 ms)。
4 結 論
采用射頻磁控濺射方法在藍寶石基片上沉積Ga2O3薄膜,在襯底溫度達到700℃后,薄膜由非晶相轉化為以 β-Ga2O3為主的多晶結構,沿晶面組擇優生長。隨著襯底溫度的升高,晶粒變大,從而晶界數量減少,電阻率下降。同時,光學禁帶隨著襯底溫度的上升而增大,光學吸收邊發生藍移,800℃時在255 nm處出現陡峭的光學吸收邊,可見光透過率在90%以上。基于以上薄膜制備的紫外探測器在10 V偏壓下,暗電流約為1 nA,光電流達800 nA。最大響應度為0.3 A/W(260 nm),是290 nm波長對應響應度的40倍。對254 nm紫外汞燈開關的響應時間分別為1 s(上升)和0.08 s(下降),可實現日盲紫外波段的探測。
[1]Oshima T,Okuno T,Fujita S.Ga2O3thin film growth on c-plane sapphire substrates bymolecular beam epitaxy for deepultraviolet photodetectors[J].Jpn.J.Appl.Phys.,2007,46(11)∶7217-7220.
[2]RazeghiM.Short-wavelength solar-blind detectors-status,prospects,andmarkets[J].Proc.IEEE,2002,90(6)∶1006-1014.
[3]Yang W,Hullavarad SS,Nagaraj B,etal.Compositionally-tuned epitaxial cubic MgxZn1-xO on Si(100)for deep ultraviolet photodetectors[J].Appl.Phys.Lett.,2003,82(20)∶3424-3426.
[4]Kokubun Y,Miura K,Endo F,et al.Sol-gel preparedβ-Ga2O3thin film for ultraviolet photodetectors[J].Appl.Phys. Lett.,2007,90(3)∶031912-1-3.
[5]Kang H C.Heteroepitaxial growth ofmultidomain Ga2O3/sapphire(0001)thin films deposited using radio frequencymagnetron sputtering[J].Mater.Lett.,2014,119∶123-126.
[6]Feng P,Zhang JY,LiQ H,et al.Individualβ-Ga2O3nanowires as solar-blind photodetectors[J].Appl.Phys.Lett., 2006,88(15)∶153107-1-3.
[7]Li Y B,Tokizono T,Liao M Y,et al.Efficient assembly of bridgedβ-Ga2O3nanowires for solar-blind photodetection [J].Adv.Funct.Mater.,2010,20(22)∶3972-3978.
[8]Ramana C V,Rubio E J,Barraza CD,et al.Chemical boding,optical constants,and electrical resistivity of sputter-deposited gallium oxide thin films[J].J.Appl.Phys.,2014,115(4)∶043508-1-7.
[9]Ou S L,Wu D S,Fu Y C,etal.Growth and etching characteristics of gallium oxide thin films by pulsed laser deposition [J].Mater.Chem.Phys.,2012,133∶700-705.
[10]Du X J,MiW,Luan CN,etal.Characterization of homoepitaxialβ-Ga2O3films prepared bymetal organic chemical vapor deposition[J].J.Cryst.Growth,2014,404∶75-79.
[11]Zhang J,Jiang F H.Catalytic growth of Ga2O3nanowires by physical evaporation and their photoluminescence properties [J].Chem.Phys.,2003,289∶243-249.
[12]Goyal A,Yadav B S,Thakur O P,et al.Effect of annealing onβ-Ga2O3film grown by pulsed laser deposition technique [J].J.Alloys Compd.,2014,583∶214-219.
[13]Rebien M,Henrion W,Hong M,et al.Optical properties of gallium oxide thin films[J].Appl.Phys.Lett.,2002,81(1)∶250-252.
[14]Sinha G,Adhikary K,ChaudhuriS.Sol-gel derived phase pureα-Ga2O3nanocrystalline thin film and its optical properties [J].J.Cryst.Growth,2005,276(1)∶204-207.
[15]Guo D Y,Wu ZP,Li PG,etal.Fabrication ofβ-Ga2O3thin films and solar-blind photodetectors by laser MBE technology[J].Opt.Mater.Express,2014,4(5)∶1067-1076.
[16]Orita M,Hiramatsu H,Ohta H,et al.Preparation of high conductive,deep ultraviolet transparentβ-Ga2O3thin film at low deposition temperatures[J].Thin Solid Films,2002,411(1)∶134-139.
[17]Kumar SS,Rubio E J,Martinez G,etal.Structure,morphology,and optical properties of amorphous and nanocrystalline gallium oxide thin films[J].J.Phys.Chem.C,2013,117(8)∶4194-4200.
[18]Vemuri R S,BharathiK K,Gullapalli SK,etal.Effectof structure and size on the electrical properties ofnanocrystalline WO3films[J].ACSAppl.Mater.Interf.,2010,2(9)∶2623-2628.

劉浩(1990-),男,河北保定人,碩士研究生,2013年于河北工業大學獲得學士學位,主要從事Ga2O3薄膜材料的研究。
E-mail:haoliu929@163.com

鄧宏(1963-),男,四川江油人,教授,博士生導師,1986年于電子科技大學獲得碩士學位,主要從事ZnO材料及器件的研究。
E-mail:hdeng@uestc.edu.cn
Preparation and Ultraviolet Detection Performance of Ga2O3Thin Film s
LIU Hao1,DENG Hong1*,WEIMin1,YU Yong-bin2,CHENWen-yu3
(1.State Key Laboratory ofElectronic Thin Films and Integrated Devices, University ofElectronic Science and Technology ofChina,Chengdu 610054,China; 2.School of Information and Software Engineering,University ofElectronic Science and Technology ofChina,Chengdu 610054,China; 3.School ofComputer Science and Engineering,University of Electronic Science and Technology ofChina,Chengdu 610054,China)
*Corresponding Author,E-mail:hdeng@uestc.edu.cn
Gallium oxide(Ga2O3)thin filmswere depsited by radio frequencymagnetron sputtering on sapphire(0001)substrateswith a range of substrate temperatures from 500 to 1 000℃.The norphological characteristics,optical bandgaps,electrical properties and photoresponsivity of the grown thin filmswere researched.With the increasing of the growth temperature,the crystallinity and conductivity of the films increase at first and then decrease slightly.Ultraviolet-visible spectra indicate that the transmittance ofβ-Ga2O3film depsited on 800℃ is over than 90%,and it's absorption edge is located at about255 nm,meaning that the optical bandgap was about 4.8 eV.Themetalsemiconductor-metal photodetector based onβ-Ga2O3film shows dark current of~1 nA and photocurrent of~800 nA under 254 nm light illumination at10 bias voltage.Themaximum responsivity of the photodetector is 0.3 A/W at260 nm,40 times asmuch as the responsivity at290 nm.
β-Ga2O3;RFmagnetron sputtering;UV detector
O484.4
:A
10.3788/fgxb20153608.0906
1000-7032(2015)08-0906-06
2015-05-28;
:2015-07-29
中央高校基金(ZYGX2013J041);電子薄膜與集成器件國家重點實驗室創新基金(KFJJ201303)資助項目

