高性能系統的氮化鎵熱分析
2016-03-07 02:03:48DylanMurdockMarkC.Woods
電子產品世界
2016年1期
Dylan Murdock Mark C.Woods
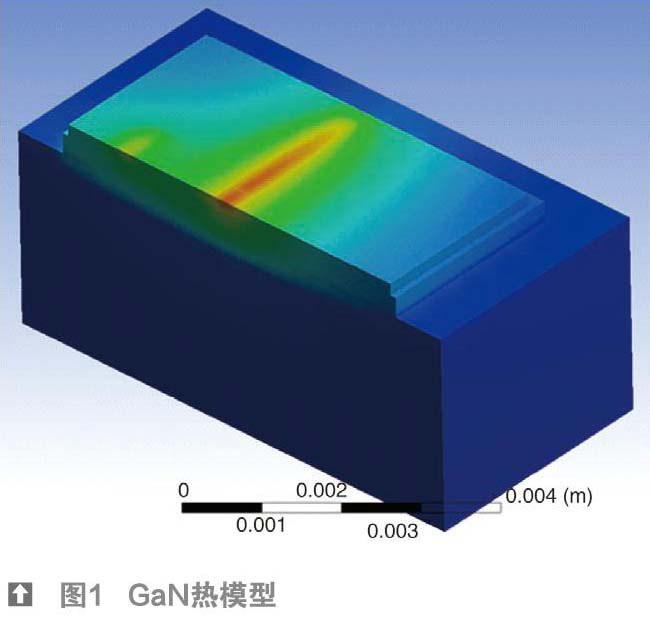


摘要:本論文討論了Qorvo公司針對高性能微波GaN HEMT器件和MMIC采用的基于建模、實證測量(包括微區拉曼熱成像)和有限元分析(FEA)的綜合熱設計方法,該方法極為有效,且經過實證檢驗。通過適當解決FEA的邊界條件假設和紅外顯微鏡的局限問題,無論在產品還是最終應用層面上,所得到的模型計算結果都比基于較低功率密度技術的傳統方法的精度更高。
關鍵詞:熱建模;熱分析;芯片貼裝方法;Qorvo公司
DOI:10.3969/j.issn.1005-5517.2016.1.003
系統對放大器輸出功率的要求越來越高,這推動了固態技術的持續進步。與此同時,推動技術進步的應用也取得了長足的發展。僅僅數年前的十幾瓦功率要求現已增加到五十瓦以上。碳化硅基氮化鎵(GaN-on-SiC)現已成為一種出色的器件制造技術,與傳統砷化鎵(GaAs)贗晶型高電子遷移率晶體管(pHEMT)技術相比,具有高功率密度(典型值大于SW/mm)、高漏極工作電壓(典型值為20V至48V),及大體相當的增益和漏極效率特性。在較小的電路面積內獲得更多功率的要求促進了GaN功率放大器產品的發展:這類產品無論在產品層面還是系統層面都面臨著散熱難題。
為了充分了解GaN技術的熱影響,人們開發了一種包括芯片級電氣建模、實證測量和有限元分析在內的多要素方法。本文將分四部分討論這種GaN熱分析方法:
熱建模和實證測量,包括微區拉曼測量;
熱分析,包括有限元分析(FEA)、紅外顯微鏡的使用和局限,以射頻測試輔助驗證;
芯片貼裝方法,包括考慮環氧樹脂相比焊接方式產生的接觸電阻和影響器件工作溫度的芯片貼裝性能;……
登錄APP查看全文

