980nm多量子阱激光器有源層的優化分析
葉磊 張殿堯 李曉東 楊渝川 張天
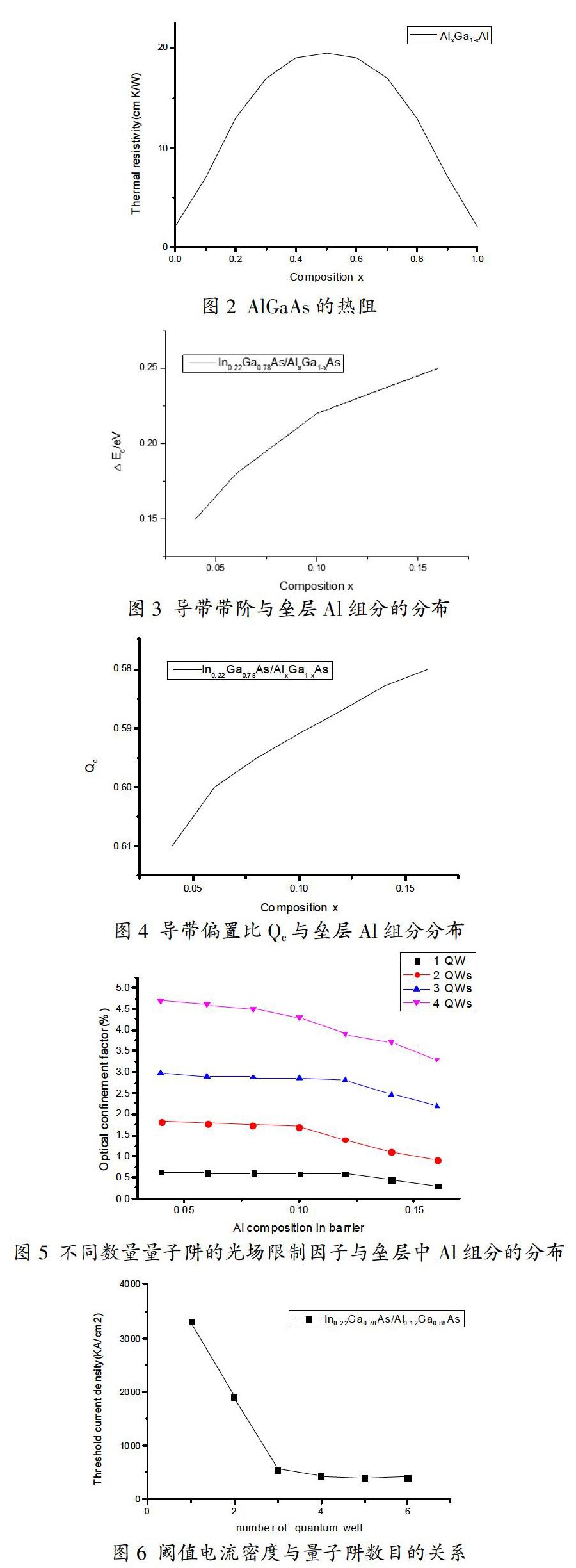

摘 要:980nm波長量子阱激光器常用的有源層材料體系為InGaAs/AlGaAs體系。理論計算與仿真結果表明當有源層量子阱的個數為三個并且壘層材料的鋁組分為0.12時,能夠獲得較低的閾值電流。
關鍵詞:有源層結構;980nm;多量子阱;半導體激光器
1 概述
為了獲得更低的閾值電流和更高的出光功率,文中對載流子的泄露和不均衡的載流子分布以及光場限制因子進行分析,并且對量子阱的數目以及壘層材料中的鋁組分進行優化仿真,得到最優的輸出特性。
2 理論分析
2.1 載流子的泄漏電流
電子電流從N型層注入到量子阱并和量子阱中的空穴復合,因此電子電流密度在量子阱中減小。泄漏電流即是從量子阱中溢出的電流。泄漏電子電流對激光器的光學性能有很大的負面影響。有幾種方法可以抑制泄漏電流,如增加勢壘層的高度(增大帶隙),在有源層與上波導層之間增加一層電流阻擋層都可以有效地抑制泄漏電流。
2.2 載流子分布不均勻
多量子阱激光器有源區的光特性很大程度上受到載流子分布不均勻的影響。增加壘層鋁組分使得勢壘高度變大,這將使載流子分布對光特性產生的影響更加放大,惡化光特性。載流子分布不均勻也會導致有源區光增益受到影響。為了提高激光器的性能,導帶偏置比越靠近0.5左右,載流子分布不均勻的影響將越小。
2.3 光場限制因子
其中E(y)表示光場垂直于結平面的分布。激光器的光場限制因子受壘層、阱層材料的結構參數影響。小的光場限制因子會導致量子阱激光器所需的光增益增大,導致閾值電流密度變大。
2.4 閾值電流密度
其中,Nw表示阱層數目,J0是透明電流密度,ai表示內部損耗,L表示激光器腔長,R1,R2分別表示激光器端面反射率,G0表示材料增益,ΓN表示光場限制因子。
3 仿真結果與分析
3.1 載流子泄漏電流
文章主要是討論有源區的優化,因此,從增加勢壘高度的方法出發來抑制泄漏電流。勢壘高度可有導帶帶階△Ec反映。器件波導層采用AlGaAs材料。電導越小器件的串聯電阻越大,由此激光器的閾值電流也隨之增大。
如圖1知高Al組分的AlGaAs材料電導率小電阻大,因此將波導層中Al組分取0.18.
溫度特性是激光器的一個重要指標,如圖2可以看出AlGaAs材料隨溫度的變化趨勢,其在低Al組分的情況下熱阻較小,取低Al組分對激光器的輸出特性有益。
如圖3可知,隨著壘層鋁組分的增大,量子阱中導帶帶階隨之線性增大,為了更好地限制載流子,Al組分越高越好,但是壘層帶隙高于波導層帶隙會抑制載流子注入量子阱,綜合上述考慮壘層中鋁組分取0.12左右比較適合。
3.2 載流子分布不均勻
如圖4,隨著Al組分的增加,導帶偏置比逐漸向0.5靠攏,綜合導帶帶階、AlGaAs的電導和熱阻,壘層Al組分取0.12較合適。
3.3 光場限制因子
圖5顯示了不同量子阱數目的有源層的光場限制因子隨著壘層Al組分的變化分布圖,不難看出隨著量子阱數目的增多,光場限制因子逐漸增大,對特定數目的量子阱,其光場限制因子隨著壘層Al組分的增加而減小,而當Al組分在0.12左右時減小的幅度最大。
3.4 量子阱數目
由圖5可知量子阱數目的增加有利于光場限制因子的增大,提高激光器的輸出特性。綜合上面的考慮,取壘層Al組分為0.12,壘層厚度為10nm阱層In組分為0.22,阱層厚度為7.6nm,圖6為該有源層結構閾值電流密度與量子阱數目的關系分布。
由圖可看出閾值電流密度開始隨著量子阱個數的增加急劇減小,當量子阱個數超過3個時,閾值電流密度不再急劇減小,而是隨著量子阱個數的增加出現緩慢增加,考慮到要實現半導體激光器的低閾值激射和激光器的制作技術,量子阱的個數最終取3。
4 結束語
精確計算了量子阱中導帶價帶的能級分布,由此確定了阱層材料中In組分為0.22并且阱厚7.6nm時,仿真結果顯示峰值波長981nm。綜合考慮AlGaAs材料的熱阻和電導,確立波導層材料Al組分取0.2,并針對載流子泄漏和其分布不均勻惡化激光器的輸出特性來分別提高壘層的帶階和導帶偏置比。理論計算了不同量子阱數目時各Al組分對應的光場限制因子,并得出當量子阱數目為3個,壘層Al組分取0.12時得到最低的閾值電流密度。
參考文獻
[1]Xiaohong T, Zhongliang Q, Huei L P. Large post-growth energy band-gap tuning of the 980 nm high power laser diode structures[C]Electrical and Electronics Engineering (ELECO), 2013 8th International Conference on. IEEE,2014:453-457.
[2]Vurgaftman I, Meyer J R, Ram-Mohan L R. Band parameters for III-V compound semiconductors and their alloys[J]. Journal of applied physics,2001,89(11):5815-5875.
[3]華玲玲,楊陽.應變量子阱能帶偏置的分析與計算[J].激光與光電子學進展, 2013,50(5):168-175.
[4]張艷.808-nm 垂直腔面發射激光器的結構設計與研制[D].中國科學院研究生院,2011.
[5]棲原敏明.半導體激光器基礎[M].周南生,譯.北京:科學出版社,2002.
[6]Osbourn G C. Strained layer superlattices from lattice mismatched materials[J]. Journal of Applied Physics, 1982, 53(3): 1586-1589.
[7]Lang R,Kobayashi K. External optical feedback effects on semiconductor injection laser properties[J]. Quantum Electronics, IEEE Journal of, 1980,16(3):347-355.
[8]劉安平,韓偉峰,黃茂,等.InGaAs/GaAs應變量子阱結構在1054nm激光器中的應用[J]. 強激光與粒子束,2010,7:1665-1667.
[9]Mei T. Interpolation of quaternary III-V alloy parameters with surface bowing estimations[J]. Journal of applied physics,2007,101(1):013520-013520-6.
[10]Zhang J, Tansu N. Optical gain and laser characteristics of InGaN quantum wells on ternary InGaN substrates[J].Photonics Journal,IEEE, 2013,5(2):2600111-2600111.
[11]江劍平.半導體激光器[M].北京:電子工業出版社,2000,2.
[12]P. W. A. Mcllory, a. Kurobe, and Y. Uematsu. Analysis and application of theoretical gain curves to the design of multi-quantum-well lasers[J].Quantum. Electron.,1985,QE-21:1958-1963.
[13]J. Minch, S. H. Park, T. Keating, et al. Theory and Experiment of InGaAsP and InGaAlAs Long-Wavelength Strained Quantum-Well Lasers [J]. Quantum Electronics,1999,35(5): 771-782.
[14] Duan L H, Fang L, Zhang J, et al. Fabrication and characteristics of high speed InGaAs/GaAs quantum-wells superluminescent diode emitting at 1053 nm[J]. Semiconductor Science and Technology,2014,29(5):055004.
[15]林琳,陳宏泰,等.976nm非對稱波導結構高效率半導體激光器[J].微納電子技術,2012.
作者簡介:葉磊(1990-),男,漢族,碩士,主要從事半導體激光器方面的研究。

