中高溫GaN插入層厚度對藍光LED光電性能的影響
劉青明, 盧太平*, 朱亞丹, 韓 丹, 董海亮,尚 林, 趙廣洲, 趙 晨, 周小潤, 翟光美, 賈志剛,梁 建, 馬淑芳, 薛晉波, 李學敏*, 許并社
(1. 太原理工大學 新材料界面科學與工程教育部和山西省重點實驗室, 山西 太原 030024;2. 太原理工大學 新材料工程技術研究中心, 山西 太原 030024)
?
中高溫GaN插入層厚度對藍光LED光電性能的影響
劉青明1,2, 盧太平1,2*, 朱亞丹1,2, 韓 丹1,2, 董海亮1,2,尚 林1,2, 趙廣洲1,2, 趙 晨1,2, 周小潤1,2, 翟光美1,2, 賈志剛1,2,梁 建1,2, 馬淑芳1,2, 薛晉波1,2, 李學敏1,2*, 許并社1,2
(1. 太原理工大學 新材料界面科學與工程教育部和山西省重點實驗室, 山西 太原 030024;2. 太原理工大學 新材料工程技術研究中心, 山西 太原 030024)
利用金屬有機氣相化學沉積(MOCVD)技術在藍寶石圖形襯底上生長GaN基藍光LED,并系統研究了不同中高溫GaN插入層厚度對其光電性能的影響。利用芯片測試儀和原子力顯微鏡(AFM)表征了GaN基藍光LED外延片的光電性能以及表面形貌。當中高溫GaN插入層厚度從60 nm增加至100 nm時,V形坑尺寸從70~110 nm增加至110~150 nm。當注入電流為20 mA時, LED芯片的光功率從21.9 mW增加至24.1 mW;當注入電流為120 mA時, LED芯片的光功率從72.4 mW增加至82.4 mW。對V形坑尺寸調控LED光電性能的相關物理機制進行了分析,結果表明:增大V形坑尺寸有利于增加空穴注入面積和注入效率,進而提高LED器件的光功率。
氮化鎵; LED; V形坑; 空穴注入效率
1 引 言

在MOCVD外延過程中,超晶格的In組分對溫度較為敏感,導致產品的一致性不能得到很好的保證;而且超晶格的生長速度較慢,亦會導致外延成本增加。與超晶格工藝相比,通過改變中高溫GaN插入層厚度來控制V形坑尺寸的方法更具可行性,其生長工藝較為簡單,生長速率更快,更有利于控制產品成本。本文通過控制中高溫GaN插入層厚度來調控V形坑的尺寸,并對V形坑的形成機制以及載流子輸運機理進行了討論。實驗結果表明,增大V形坑尺寸可以提高空穴的注入效率,進而提高LED的光功率以及外量子效率。
2 結果與討論
圖1為藍寶石圖形襯底上生長的GaN基藍光LED外延結構示意圖,樣品A的中高溫GaN插入層厚度為60 nm,樣品B為100 nm。
圖2為室溫下樣品A、B在注入電流為20 mA時測得的EL光譜。樣品A、B的峰值波長和半高寬分別為454.1 nm和22.6 nm、455.0 nm和24.2 nm。以上數據表明:當中高溫GaN厚度從60 nm增加至100 nm時,LED外延片的峰值波長紅移0.9 nm,半峰寬展寬1.6 nm,EL積分強度增加約11.5%,這可能與插入層厚度增加、V形坑尺寸變大、載流子注入效率增加、輻射復合效率得到提高有關[21-22]。
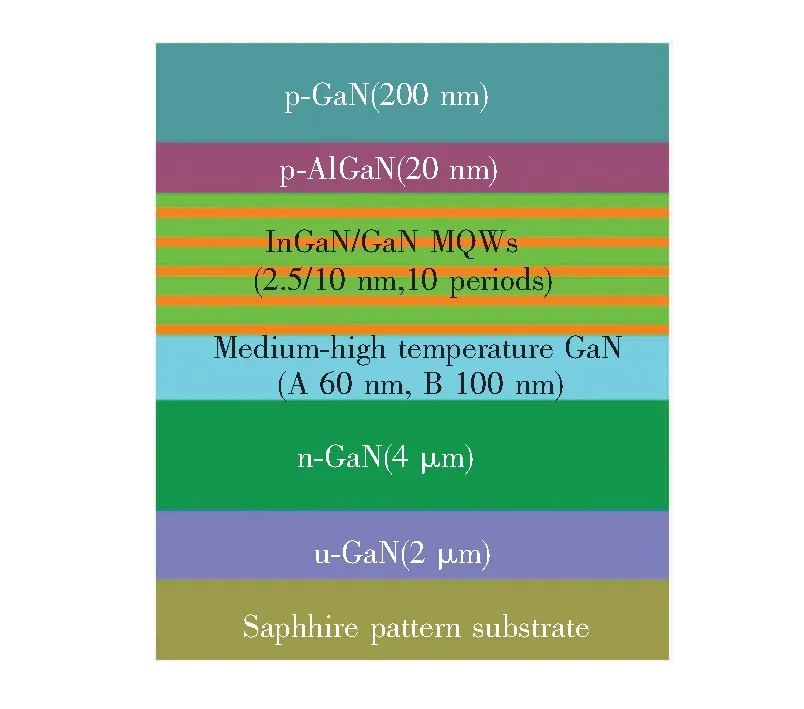
圖1 藍寶石圖形襯底上生長GaN基藍光LED外延結構示意圖
Fig.1 Schematic epitaxial structure of GaN-based blue LEDs grown on patterned sapphire substrate

圖2 樣品A、B在20 mA注入電流下的EL光譜。
圖3為樣品A、B的I-V曲線。在注入電流為20 mA時,樣品A、B的正向偏壓分別是3.18 V和3.13 V;在注入電流為120 mA時,樣品A、B的正向偏壓分別為4.35 V和4.25 V。實際二極管可以看作一個理想二極管和等效電阻串聯而成,其電壓-電流方程[23]可近似寫成:
(1)
其中I為輸入電流,Is為反向飽和電流,q為電子電荷,V為輸入電壓,R為等效串聯電阻,n為二極管理想因子,k為玻爾茲曼常數,T為熱力學溫度。為方便描述,上述公式可變形為:
(2)

圖3 樣品A、B的I-V曲線。
經計算,樣品A、B的串聯電阻分別為9.2 Ω和8.1 Ω。即隨著中高溫GaN插入層厚度增加,樣品B的正向偏壓和串聯電阻均變小,這可能與V形坑的尺寸變化有關。若V形坑尺寸增大,載流子注入效率增加,則正向偏壓降低,串聯電阻減小[24-25]。
圖4是樣品A、B的峰值波長和半峰寬隨注入電流的變化圖。由圖4可知,隨著注入電流的增加,峰值波長先藍移后輕微紅移,半高寬逐漸展寬。當注入電流從1 mA增加至40 mA時,樣品A、B的峰值波長分別從459.2 nm藍移至452.7 nm, 458.9 nm藍移至454.7 nm,分別藍移了6.5 nm和4.2 nm。樣品B的藍移量較小,這可能與V形坑尺寸變大、量子阱內應力變小有關[21]。當注入電流從40 mA增加至120 mA時,樣品A、B的峰值波長由于熱效應而產生輕微紅移。隨著注入電流從1 mA增加至120 mA,載流子的注入效率逐漸增加,能帶填充效應增強,引起半峰寬展寬[22,26]。在同一注入電流下,樣品B的半峰寬大于樣品A,這可能與V形坑尺寸增大使載流子注入效率增加、能帶填充效應更強有關(詳細說明見圖7)。
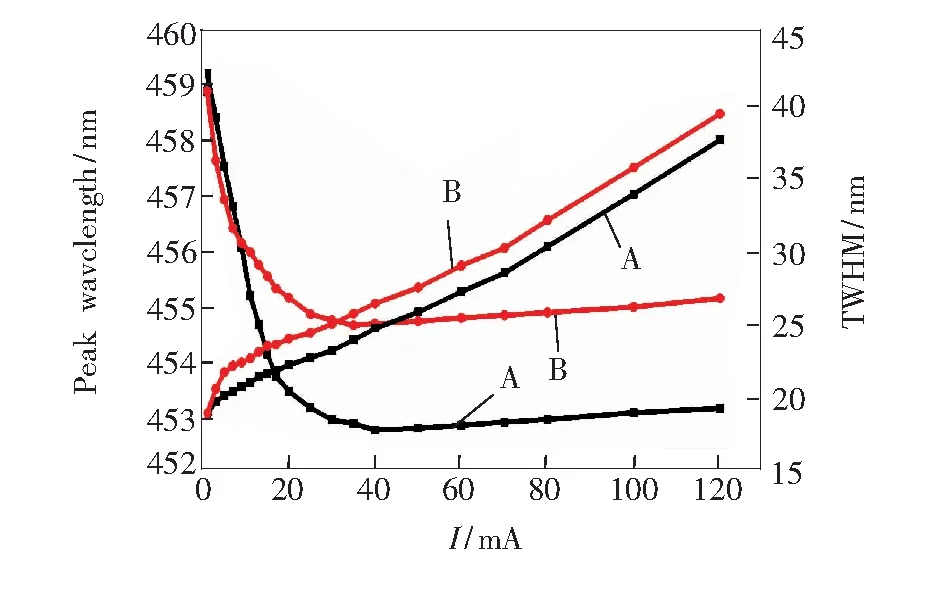
圖4 樣品A、B的峰值波長及半峰寬隨注入電流的變化圖。
Fig.4 Peak wavelength and full width at half maximum (FWHM) of sample A and Bvs. forward current
圖5是樣品A、B的光功率及外量子效率隨注入電流的變化圖。在相同注入電流下,樣品B的光功率及外量子效率均大于樣品A。當注入電流為20 mA時,樣品A、B的光功率分別為21.9 mW和24.1 mW,樣品B的光功率及外量子效率比樣品A分別提高了10.0%和12.2%。當注入電流為120 mA時,樣品A,B的光功率分別為72.4 mW和82.4 mW。樣品B的光功率及外量子效率比樣品A分別提高了13.8%和16.1%。這可能與中高溫插入層厚度增加使V形坑尺寸增大、空穴注入效率提高有關(詳細說明見圖7)。
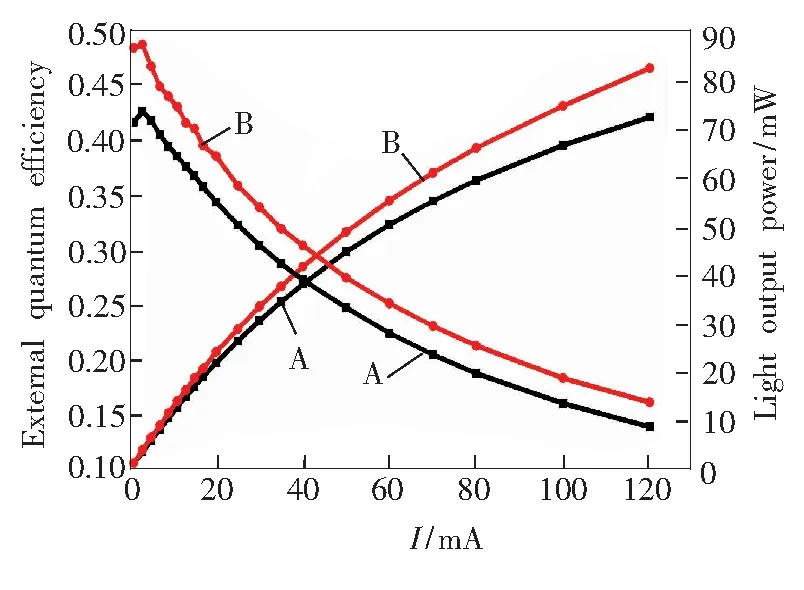
圖5 樣品A、B的光輸出功率及外量子效率隨注入電流的變化圖。
Fig.5 Light output power and calculated EQE of sample A and Bvs. forward current
圖6為樣品A、B的AFM圖像,掃描范圍為2 μm×2 μm,掃描模式為輕敲模式。圖像中均可觀察到明顯的二維臺階流生長模式,均存在較小黑點和較大六角形坑。其中較小的黑點為位錯露頭,較大的六角形坑為V形坑[27]。經統計,樣品A的V形坑尺寸分布為70~110 nm,樣品B為110~150 nm。這說明隨著中高溫GaN插入層厚度的增加,V形坑尺寸明顯增大,這與之前通過改變超晶格周期數來控制V形坑尺寸的報道類似[20-21],但超晶格生長工藝對溫度要求較為嚴格,生長速率也較慢,因此本文方法更具優勢。

圖6 樣品A(a)、B(b)的AFM圖像。
為更好地說明V形坑尺寸變化對LED光電性能的影響,圖7給出了具有不同V形坑尺寸的GaN基LED的結構示意圖。GaN基LED器件中V形坑形成原因主要有以下兩點:一是外延層之間由晶格失配和熱失配引起的應力會產生大量位錯[28],在位錯處易形成V形坑[29];二是低溫生長時,Ga原子遷移能力較低,有效遷移時間較長,導致表面生長不平整而形成V形坑[30]。而在后續高溫p-GaN生長過程中,參與生長的Ga原子能量增加,原子表面遷移率增大,有助于V形坑合并,從而形成平整的表面[17]。
與傳統LED器件相比,含有V形坑的LED器件在空穴輸運上有兩大優勢:第一,空穴注入面積占優。V形坑為倒金字塔結構,p型層面積大,n型層面積小,因此空穴在注入面積上占有優勢。第二,空穴濃度占優。空穴在倒金字塔結構的V形坑中輸運可能為壓縮模式,即隨著空穴往V形坑底部輸運,運輸面積逐漸減小,空穴濃度逐漸增高[17]。更重要的是,V形坑中的空穴還可通過側壁量子阱注入到c面量子阱中。首先,V形坑內存在側壁量子阱,側壁量子阱中的In含量比c面量子阱低,故側壁量子阱勢壘高于c面量子阱,此高勢壘可阻止空穴被位錯等非輻射復合中心所捕獲[19,31]。其次,側壁量子阱較薄,只有c面量子阱厚度的1/3[15,32],在300 K下,空穴能量較高,較易從側壁量子阱中隧穿至c面量子阱,從而提高了空穴注入效率,彌補了空穴在濃度上的不足,使得空穴與電子的濃度更為匹配[33-36]。
本文中的樣品A和B,由于外延層中應力的積累以及Ga原子表面遷移率較低而在位錯處形成V形坑(圖7)。除中高溫GaN插入層厚度不同外,樣品A、B的其余生長工藝均一致,因此V形坑在中高溫GaN插入層中產生的幾何位置應該相當。由于樣品B的插入層較厚,V形坑為倒金字塔結構,所以樣品B中的V形坑尺寸較大,即空穴注入面積較大;更重要的是,樣品B中的V形坑更深,因而由側壁量子阱注入至靠近n-GaN 的c面量子阱中的空穴數目增多,使得空穴濃度分布更均勻,注入效率增加,電子和空穴的輻射復合效率得到提高[33-36]。這與本文中V形坑尺寸變大、正向偏壓降低、光輸出功率及外量子效率提高等結果相吻合。
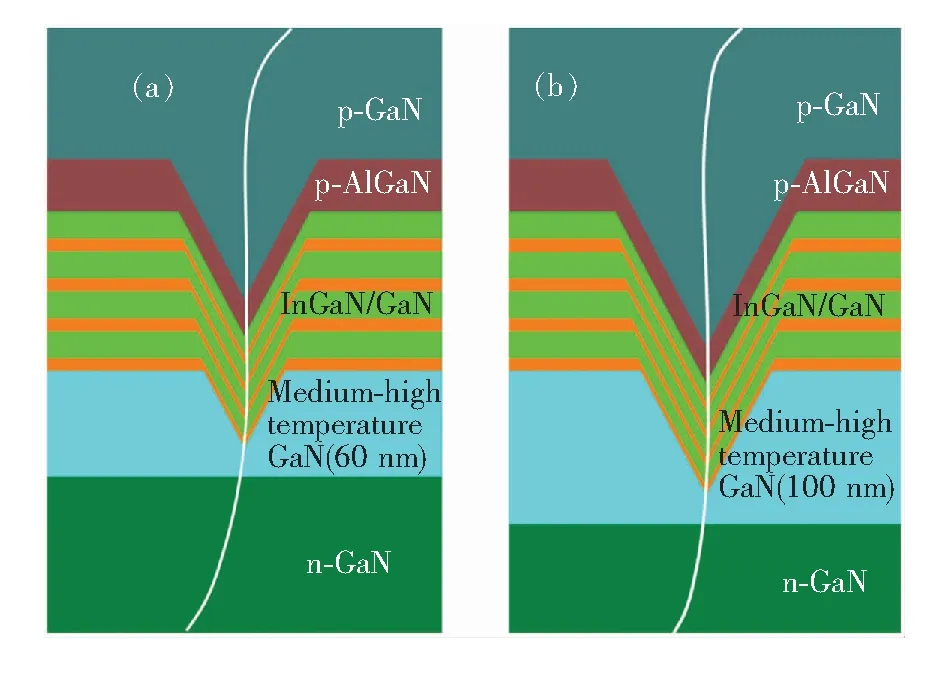
圖7 具有不同V形坑尺寸的樣品示意圖。(a)樣品A;(b)樣品B。
Fig.7 Schematic of the epitaxial structure with different V-shaped size.(a) Sample A. (b) Sample B.
3 結 論
采用MOCVD法生長了具有不同厚度中高溫GaN插入層的GaN基藍光LED,通過調整GaN插入層的厚度來控制LED外延層中V形坑的尺寸。當中高溫GaN插入層厚度從60 nm增加至100 nm時,V形坑尺寸從70~110 nm增加至110~150 nm。當注入電流為20 mA時,正向偏壓從3.18 V降低至3.13 V,光輸出功率提高了10.0%;當注入電流為120 mA時,光輸出功率提高了13.8%。V形坑尺寸的增大可以使空穴注入面積增加,且V形坑深度的增加使空穴更易注入至靠近n-GaN的c面量子阱中,改善了c面量子阱中的空穴濃度分布,增加了空穴注入效率,提高了LED的光電性能。本文方法具有工藝簡單、成本低廉的優點,更適合于工業化生產。
[1] DUPUIS R D, KRAMES M R. History, development, and applications of high-brightness visible light-emitting diodes [J].J.LightwaveTechnol., 2008, 26(9):1154-1171.
[2] LU T P, LI S T, ZHANG K,etal.. The advantage of blue InGaN multiple quantum wells light-emitting diodes with p-AlInN electron blocking layer [J].Chin.Phys. B, 2011, 20(9):098503-1-4.
[3] 李正凱,嚴啟榮,羅長得,等. GaN壘層厚度漸變的雙藍光波長發光二極管 [J]. 光子學報, 2013, 42(7):757-762. LI Z K, YAN Q R, LUO C D,etal.. Dual-blue wavelength light-emitting diodes based on varied GaN barrier thickness [J].ActaPhoton.Sinica, 2013, 42(7):757-762. (in Chinese)
[4] SHANG L, LU T P, ZHAI G M,etal.. The evolution of a GaN/sapphire interface with different nucleation layer thickness during two-step growth and its influence on the bulk GaN crystal quality [J].RSCAdv., 2015, 5(63):51201-51207.
[5] NAKAMURA S, SENOH M, IWASA N,etal.. High-power InGaN single-quantum-well-structure blue and violet light-emitting diodes [J].Appl.Phys.Lett., 1995, 67(13):1868-1870.
[6] PEARTON S J, ZOLPER J C, SHUL R J,etal.. GaN: processing, defects, and devices [J].J.Appl.Phys., 1999, 86(1):1-78.
[7] LU L, GAO Z Y, SHEN B,etal.. Microstructure and origin of dislocation etch pits in GaN epilayers grown by metal organic chemical vapor deposition [J].J.Appl.Phys. 2008, 104(12):123525-1-4.
[8] BROWN P D. TEM assessment of GaN epitaxial growth [J].J.Cryst.Growth, 2000, 210(1-3):143-150.
[9] PONCE F A, MAJOR Jr J S, PLANO W E,etal.. Crystalline structure of AlGaN epitaxy on sapphire using AlN buffer layers [J].Appl.Phys.Lett., 1994, 65(18):2302-2304.
[10] LU T P, LI S T, LIU C,etal.. Advantages of GaN based light-emitting diodes with a p-InGaN hole reservoir layer [J].Appl.Phys.Lett., 2012, 100(14):141106-1-3.
[11] LIANG M M, WENG G E, ZHANG J Y,etal.. Influence of barrier thickness on the structural and optical properties of InGaN/GaN multiple quantum wells [J].Chin.Phys. B, 2014, 23(5):054211-1-5.
[12] PAN C C, YAN Q M, FU H Q,etal.. High optical power and low-efficiency droop blue light-emitting diodes using compositionally step-graded InGaN barrier [J].Electron.Lett., 2015, 51(15):1187-1189.
[13] CHUNG H J, CHOI R J, KIM M H,etal.. Improved performance of GaN-based blue light emitting diodes with InGaN/GaN multilayer barriers [J].Appl.Phys.Lett., 2009, 95(24):241109-1-3.
[14] 胡金勇,黃華茂,王洪,等. ITO表面粗化提高GaN基LED芯片出光效率 [J]. 發光學報, 2014, 35(5):613-617. HU J Y, HUANG H M, WANG H,etal.. Light-output enhancement of GaN-based light-emitting diodes with surface textured ITO [J].Chin.J.Lumin., 2014, 35(5):613-617. (in Chinese)
[15] HANGLEITER A, HITZEL F, NETZEL C,etal.. Suppression of nonradiative recombination by V-shaped pits in GaInN/GaN quantum wells produces a large increase in the light emission efficiency [J].Phys.Rev.Lett., 2005, 95(12):127402-1-4.
[16] CHICHIBU S F, UEDONO A, ONUMA T,etal.. Origin of defect-insensitive emission probability in In-containing (Al, In, Ga) N alloy semiconductors [J].Nat.Mater., 2006, 5(10):810-816.
[17] 吳小明. 含V形坑的Si襯底GaN基藍光LED發光性能研究 [D]. 南昌:南昌大學, 2014. WU X M.StudyonTheLuminescencePropertiesofV-pit-containingGaNBasedBlueLEDsonSiSubstrate[D]. Nanchang: Nanchang University, 2014. (in Chinese)
[18] TOMIYA S, KANITANI Y, TANAKA S,etal.. Atomic scale characterization of GaInN/GaN multiple quantum wells in V-shaped pits [J].Appl.Phys.Lett., 2011, 98(18):181904-1-3.
[19] OKADA N, KASHIHARA H, SUGIMOTO K,etal.. Controlling potential barrier height by changing V-shaped pit size and the effect on optical and electrical properties for InGaN/GaN based light-emitting diodes [J].J.Appl.Phys., 2015, 117(2):025708.
[20] KIM J, CHO Y H, KO D S,etal.. Influence of V-pits on the efficiency droop in InGaN/GaN quantum wells [J].Opt.Express, 2014, 22(S3):A857-A866.
[21] SONG T L. Strain relaxation due to V-pit formation in InxGa1-xN/GaN epilayers grown on sapphire [J].J.Appl.Phys., 2005, 98(8):084906.
[22] LU T P, MA Z G, DU C H,etal.. Temperature-dependent photoluminescence in light-emitting diodes [J].Sci.Rep., 2014, 4:6131.
[23] CHEUNG S K, CHEUNG N W. Extraction of Schottky diode parameters from forward current-voltage characteristics [J].Appl.Phys.Lett., 1986, 49(2):85-87.
[24] QUAN Z J, WANG L, ZHENG C D,etal.. Roles of V-shaped pits on the improvement of quantum efficiency in InGaN/GaN multiple quantum well light-emitting diodes [J].J.Appl.Phys., 2014, 116(18):183107.
[25] HSU C C, WU C K, LI C K,etal.. 3D finite element strain analysis of V-shaped pits in light emitting diodes [C].ProceedingsofTheInternationalConferenceonNumericalSimulationofOptoelectronicDevices,ChinaTaipei:Taipei, 2015:7-8.
[26] ZHAO Y K, YUN F, WANG S,etal. Modulating dual-wavelength multiple quantum wells in white light emitting diodes to suppress efficiency droop and improve color rendering index [J].J.Appl.Phys., 2015, 118(14):145702.
[27] SCHENK H P D, VENNéGUèS P, TOTTEREAU O,etal.. Three-dimensionally nucleated growth of gallium nitride by low-pressure metalorganic vapour phase epitaxy [J].J.Cryst.Growth, 2003, 258(3-4):232-250.
[28] 郭瑞花,盧太平,賈志剛,等. 界面形核時間對GaN薄膜晶體質量的影響 [J]. 物理學報, 2015, 64(12):123705-1-6. GUO R H, LU T P, JIA Z G,etal.. Effect of interface nucleation time of the GaN nucleation layer on the crystal quality of GaN film [J].ActaPhys.Sinica, 2015, 64(12):123705-1-6. (in Chinese)
[29] SHIOJIRI M, CHUO C C, HSU J T,etal.. Structure and formation mechanism of V defects in multiple InGaN/GaN quantum well layers [J].J.Appl.Phys., 2006, 99(7):073505.
[30] SON K S, KIM D G, CHO H K,etal.. Formation of V-shaped pits in GaN thin films grown on high temperature GaN [J].J.Cryst.Growth, 2004, 261(1):50-54.
[31] WU X M, LIU J L, QUAN Z J,etal.. Electroluminescence from the sidewall quantum wells in the V-shaped pits of InGaN light emitting diodes [J].Appl.Phys.Lett., 2014, 104(22):221101-1-5.
[32] CAO X A, STOKES E B, SANDVIK P M,etal.. Diffusion and tunneling currents in GaN/InGaN multiple quantum well light-emitting diodes [J].IEEE.ElectronDev.Lett., 2002, 23(9):535-537.
[33] QUAN Z, LIU J L, FANG F,etal.. A new interpretation for performance improvement of high-efficiency vertical blue light-emitting diodes by InGaN/GaN superlattices [J].J.Appl.Phys., 2015, 118(19):193102.
[34] LI Y F, YUN F, SU X L,etal.. Deep hole injection assisted by large V-shape pits in InGaN/GaN multiple-quantum-wells blue light-emitting diodes [J].J.Appl.Phys., 2014, 116(12):123101.
[35] LI Y F, YUN F, SU X L,etal.. Carrier injection modulated by V-defects in InGaN/GaN multiple-quantum-well blue LEDs [J].Jpn.J.Appl.Phys., 2014, 53(11):112103.
[36] ZHAO Y K, LI Y F, HUANG Y P,etal.. Efficiency droop suppression in GaN-based light-emitting diodes by chirped multiple quantum well structure at high current injection [J].Chin.Phys. B, 2015, 24(5):056806-1-5.

劉青明(1990-),男,山東臨沂人,碩士研究生,2012年于濟南大學獲得學士學位,主要從事GaN基藍光LED外延及器件的研究。
E-mail: 497258449@qq.com

盧太平(1986-)男,重慶人,博士,講師,2014年于中國科學院物理研究所獲得博士學位,主要從事Ⅲ族氮化物外延生長以及微電子、光電器件的研究
E-mail: lutaiping@tyut.edu.cn

李學敏(1956-)男,美籍華人,博士,教授,1994年于美國里海大學獲得博士學位,主要從事化合物半導體材料和器件開發及應用方面的研究。
E-mail: xueminli@tyut.edu.cn
Effect of Medium-high Temperature Interlayer Thickness on The Optical and Electrical Properties of Blue Light Emitting Diodes
LIU Qing-ming1,2, LU Tai-ping1,2*, ZHU Ya-dan1,2, HAN Dan1,2, DONG Hai-liang1,2, SHANG Lin1,2, ZHAO Guang-zhou1,2, ZHAO Chen1,2, ZHOU Xiao-run1,2, ZHAI Guang-mei1,2, JIA Zhi-gang1,2, LIANG Jian1,2, MA Shu-fang1,2, XUE Jin-bo1,2, LI Xue-min1,2*, XU Bing-she1,2
(1.KeyLaboratoryofInterfaceScienceandEngineeringinAdvancedMaterials,MinistryofEducation,TaiyuanUniversityofTechnology,Taiyuan030024,China;2.ResearchCenterofAdvancedMaterialsScienceandTechnology,TaiyuanUniversityofTechnology,Taiyuan030024,China)
GaN-based blue light emitting diodes (LEDs) were grown on patterned sapphire substrates by metal-organic chemical vapor deposition (MOCVD) method, and the medium-high temperature GaN interlayer with different thickness was grown between the multiple quantum wells layer and n-GaN layer. The Optical and electrical properties and surface morphology of LEDs were characterized by LED test system and atomic force microscopy(AFM), respectively. When the thickness of the medium-high temperature GaN interlayer increases from 60 nm to 100 nm, the size of V-pit enlarges from 70-110 nm to 110-150 nm. Meanwhile, the light output power of the chip increases from 21.9 mW to 24.1 mW with the injection current of 20 mA, and 72.4 mW to 82.4 mW with the injection current of 120 mA. In order to better illustrate the influence mechanism of the size of V-pits on the photoelectric properties of the LEDs, the schematic structures with different V-shaped pit sizes are demonstrated. The analyzing results for the LED samples show that the increase of the V-pit size is beneficial to enhance the hole injection area and injection efficiency. Thus, the light output power of the LED device is improved.
GaN; LED; V-pits; hole injection efficiency
2016-02-23;
2016-03-31
國家自然科學基金(21471111,61475110,61404089,61504090); 山西省基礎研究項目(2014011016-6,2014021019-1,2015021103); 電子薄膜與集成器件國家重點實驗室開放課題(KFJJ201406); 山西省科技創新重點團隊項目(2012041011); 山西省高等學校科技創新項目(2015131); 浙江省重點科技創新團隊(2011R50012); 浙江省重點實驗室項目(2013E10022)資助
1000-7032(2016)07-0829-07
TN383+.1; TN364+.2
A
10.3788/fgxb20163707.0829
*CorrespondingAuthors,E-mail:lutaiping@tyut.edu.cn;xueminli@tyut.edu.cn

