AlN間隔層厚度對AlGaN/GaNHEMT器件電學特性的仿真研究
劉劭璠 張明蘭
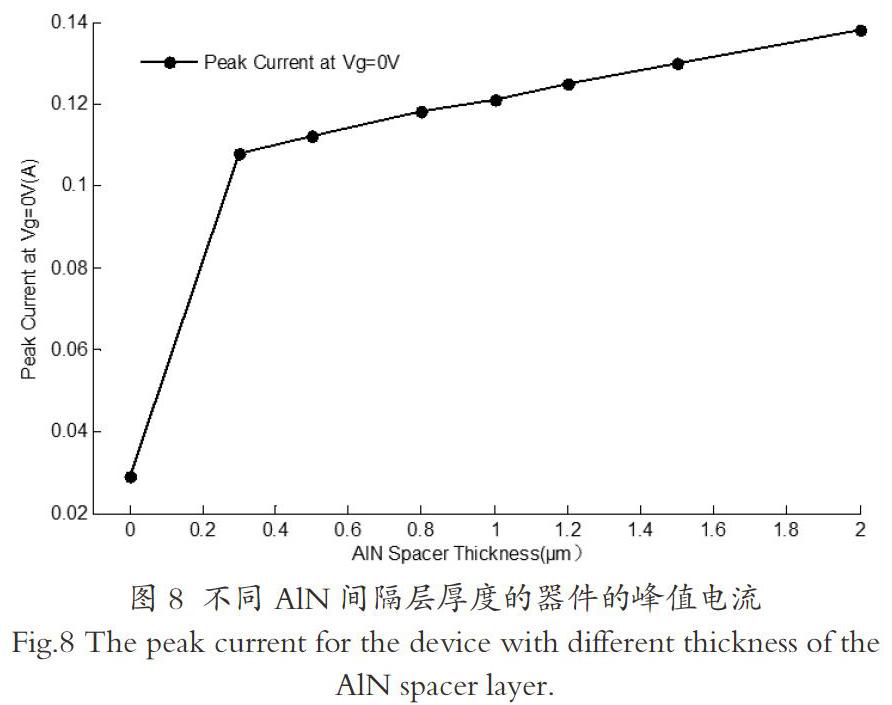


摘 要:二維電子氣(2DEG)特性決定了AlGaN/GaN高電子遷移率晶體管(HEMT)性能。為了提高器件的2DEG密度、遷移率和漏電流,本文采用AlGaN和GaN之間引入一層薄的AlN間隔層的方法。使用Silvaco仿真工具模擬了不同AlN間隔層厚度對載流子濃度、遷移率和量子阱深度的影響。器件仿真結果表明:在HEMT器件中插入薄AlN間隔層可以增加載流子濃度和遷移率,并加大了導帶不連續性。另外,器件的電子遷移率在AlN厚度為0.2nm時取得最大值,而載流子濃度和漏電流隨AlN層厚度增加而持續上升。
關鍵詞:HEMT;間隔層;遷移率;載流子濃度;仿真
中圖分類號:TN323.3 文獻標識碼:A
Abstract:Two-dimensional electron gas(2DEG) property is crucial for performance of AlGaN/GaN high electron mobility transistor (HEMT).Introduction of AlN spacer layer in between AlGaN and GaN layer is one of the way to improve 2DEG density,mobility,and drain current. Carrier concentration, mobility and quantum well depth for different AlN spacer thickness was simulated by using Silvaco simulation tool.Our device simulations showed that carrier concentration,mobility are enhanced on introduction of AlN spacer layer in HEMT.In addition,our simulation showed that the mobility of 2DEG attains maximum value at the 0.2nm thick AlN layer but carrier concentration and drain current increase with spacer thickness.
Key words:HEMT;Spacer layer;mobility;carreier concentration;simulation
EEACC:2560
1 引言
基于GaN的高電子遷移率晶體管(HEMTs)具有寬禁帶(3.4eV)、高擊穿電場(約3V/cm)和很強的自發極化和壓電極化等優點,氮化物材料優秀的基礎物理性質使它在高頻率、高功率微波應用方面引人注目。為了提高高功率開關器件的性能,獲得低導通電阻,需要提高載流子濃度和遷移率的乘積。而對于AlGaN/GaN HEMT器件來說,在AlGaN和GaN之間的大導帶不連續性,包括自發極化和壓電極化的極化的存在形成一個三角勢阱,限制了二維方向上的AlGaN/GaN界面高密度電子(1013cm-2量級)。
這些年來,為了提高載流子濃度和遷移率的乘積,出現了很多辦法。對AlGaN勢壘層進行Si摻雜是增加溝道中薄膜電子密度的有效方法。但是許多實驗小組表示由于Si摻雜造成的電荷增加低于總電荷的25%。所以通過對AlGaN勢壘層進行Si摻雜增加薄膜電子密度中的電勢是有限的。另一中更有效的增加薄膜電子密度的方法是提高AlGaN勢壘層中Al的含量,勢壘中的Al含量越高,自發極化和壓電極化就越強,于是感應得到更高的薄膜電子密度。但是隨著Al摩爾分數的增加,AlGaN層的表面質量退化,電子遷移率會下降,這是由于AlGaN勢壘層中的合金無序散射的影響。
而Shen等人經過努力在AlGaN勢壘層和GaN緩沖層之間插入一層薄的AlN界面層,來提高HEMT結構的電學特性。在極化作用下,該插入層能夠提高AlGaN勢壘層和GaN溝道層的有效導帶帶階,一方面能夠形成更深而窄的量子阱,有利于提高溝道電子密度;另一方面還能夠抑制滲入到AlGaN中的二維電子氣所受的合金無序散射,提高溝道電子遷移率。
AlN間隔層的另一個作用是減少了肖特基柵正向電流,可以使晶體管在更高柵極電壓下工作。使AlGaN/AlN/GaN HEMTs的漏電流高于傳統的AlGaN/GaN HEMTs。此外,AlN層的厚度對遷移率也很重要。當厚度改變,極化場和導帶不連續性改變,也影響了2DEG相關的濃度和遷移率。
因此,我們需要去了解在高功率器件中間隔層的臨界厚度,研究更高AlN間隔層厚度使遷移率減小的真實原因。這方面報道已經有部分報道,但是關于AlGaN/AlN/GaN HEMTs器件的仿真研究還很少。
在本文中,通過基于數值計算的silvaco軟件來研究不同AlN間隔層厚度對AlGaN/AlN/GaN HEMT電學特性的影響。討論了功率器件的間隔層最大臨界厚度。
本文安排如下:
在第二章節中,我們介紹了用來研究不同AlN間隔層厚度對AlGaN/AlN/GaN HEMT的影響的器件結構和模擬設置。在第三章節,我們報告了結果,檢驗了由AlN間隔層厚度決定的傳輸特性。在第四章節,我們描述了結論。
2 仿真方法
本文研究的物理器件是在不同溫度下使用金屬有機化學氣相淀積而成的,襯底為藍寶石。完成整個生長流程需要氨(NH3)、三甲基鎵(TMGa),三甲基鋁(TMAl)作為先導物,氫氣作為運載氣體。
首先生長AlN成核層,再生長3μm厚非摻雜的GaN緩沖層,然后是各種厚度(0-2nm)的薄AlN間隔層,在頂上生長25nm厚的非摻雜的AlGaN勢壘層,Al的摩爾分數在30%。整個外延層在高溫下生長。
圖1(a)是無AlN間隔層的傳統結構,而圖1(b)帶有AlN間隔層,除了AlN間隔層厚度,兩種結構使用相同的器件參數。在圖1(b)中,AlN間隔層厚從0到2nm變化。因為在AlGaN和GaN之間插入薄AlN間隔層可以加強對2DEG的限制。所以我們可以估算電子輸運特性的變化,間隔層影響了與2DEG濃度和遷移率有關的輸運載流子。
器件性能主要依賴各種類型散射機制影響的載流子遷移率,如合金無序散射(在低溫和室溫下,三元化合物中的電子散射)、表面粗糙度散射(低溫)等。在這些散射機制中,當載流子濃度很高,處在低溫和室溫時,合金無序散射是主要限制因素。AlN的二元化合物屬性使合金無序散射相對降低。而且,AlN提高了量子阱深度和勢壘,更好的限制了電子溢出溝道。所以,在我們的器件仿真中,電子遷移率模型考慮2個部分;一個是影響傳輸特性的低電場遷移率模型,另一個是氮化物特有的高電場遷移率模型。
這里μ是低電場遷移率,vsat是飽和速度,E是電場,Ec,a,n1,n2是模型參數。器件的電流特性由求解薛定諤方程和泊松方程的自洽解得到。最后通過silvaco軟件中的Tonyplot輸出結果。
3 結果和討論
本章節中通過仿真軟件的ATLAS器件仿真得到了傳統AlGaN/GaN HEMT器件和AlGaN/AlN/GaN HEMT器件的遷移率和電子濃度。我們比較了傳統結構HEMT和帶有AlN間隔層結構的HEMT的優劣。本章節比較了兩種器件的電學特性。
圖2表示提出的AlGaN/AlN/GaN HEMT器件和傳統結構器件的導帶分布圖。AlGaN/GaN異質結界面之間的薄AlN間隔層產生了更大的有效的導帶不連續性,這是因為載流子穿過間隔層時,強壓電和自發極化場導致電勢下降。
通過器件仿真的方法分析了AlN間隔層厚度器件量子阱深度的影響,結果如圖3所繪。當間隔層厚度增加時,導帶不連續性變大。
圖4表示不同AlN間隔層厚度對器件的量子阱深度的影響。結果表明,在AlGaN/AlN/GaN HEMT中,當AlN間隔層達到2nm時,2DEG深度增加了56%。
相對禁帶窄的GaN材料和寬禁帶的AlGaN材料的異質結界面產生的2DEG是限制量子阱中電子溢出的重要機制,它會產生很高的電子濃度和電子遷移率。據發現,在AlN/GaN異質結構中的帶有AlN的勢壘層中的強極化場會導致2DEG薄膜密度數值很高。
圖7 表示器件電子遷移率受AlN層厚度變化的影響,厚度從0上升到0.2nm,遷移率隨之增加,這是由于粗糙度散射和合金散射很低。但是薄AlN間隔層處的高載流子濃度導致2DEG分布向界面移動。它導致界面粗糙度散射和2DEG中的庫侖散射增加。結果,AlN間隔層厚度超過0.2nm,遷移率下降。
圖8表示柵壓為0V時的漏電流峰值。我們都知道漏電流是結合了遷移率和電子濃度的結果。據報道,當AlN層厚度達到一定值時,載流子濃度占主導作用,超過這個定值后遷移率占主導作用,AlN層厚度超過這個定值后,峰值電流會下降。但是由于本文中AlN層厚度變化對遷移率影響甚微,電子濃度的作用更加明顯,所以峰值電流依然增加。
4 結論
本文研究了不同AlN間隔層厚度影響的AlGaN/AlN/GaN HEMT的2DEG傳輸特性。插入AlN間隔層使電子濃度大大提高,且依賴于AlN間隔層的厚度。傳輸特性的臨界AlN層厚度為1.2nm。取AlN層厚度為0至2nm,電子濃度保持增長趨勢。而當厚度達到1.2nm時,電子遷移率開始下降,從而在漏電流上表現為:AlN層厚度達到1.2nm之前,漏電流會隨著厚度增加,達到1.2nm后,逐漸下降。因此對于本器件來說,最優AlN間隔層可厚度為1.5nm,適合應用于高速、高功率開關器件。
參考文獻:
[1] Luo W, Wang X, Xiao H, et al. Growth and fabrication of AlGaN/GaN HEMT based on Si (111) substrates by MOCVD [J]. Microelectronics Journal, 2008, 39(9): 1108-1111.
[2] Kranti A,Haldar S,Gupta R S.An accurate charge control model for spontaneous and piezoelectric polarization dependent two-dimensional electron gas sheet charge density of lattice-
mismatched AlGaN/GaN HEMTs[J]. Solid-State Electronics, 2002, 46(5): 621-630.
[3] Yu E T, Sullivan G J, Asbeck P M, et al. Measurement of piezoelectrically induced charge in GaN/AlGaN heterostructure field-effect transistors[J]. Applied Physics Letters, 1997, 71(19): 2794-2796.
[4] Hsu L, Walukiewicz W. Effect of polarization fields on transport properties in AlGaN/GaN heterostructures[J]. Journal of Applied Physics,2001,89(3):1783-1789.
[5] Wu Y F, Kapolnek D, Ibbetson J P, et al. Very-high power density AlGaN/GaN HEMTs[J]. IEEE Transactions on Electron Devices,2001,48(3):586-590.
[6] Wu Y F, Keller B P, Fini P, et al. High Al-content AlGaN/GaN MODFETs for ultrahigh performance[J]. IEEE Electron Device Letters,1998,19(2):50-53.
[7] Xie J, Ni X, Wu M, et al. High electron mobility in nearly lattice-matched Al In N/Al N/Ga N heterostructure field effect transistors[J].Applied Physics Letters,2007,91(13):132116.
[8] Miyoshi M, Egawa T, Ishikawa H, et al. Nanostructural characterization and two-dimensional electron-gas properties in high-mobility Al Ga N/Al N/Ga N heterostructures grown on epitaxial AlN/sapphire templates[J]. Journal of applied physics, 2005, 98(6): 063713.
[9] Ambacher O, Smart J, Shealy J R, et al. Two-dimensional electron gases induced by spontaneous and piezoelectric polarization charges in N-and Ga-face AlGaN/GaN heterostructures[J]. Journal of applied physics, 1999, 85(6): 3222-3233.
[10] Lenka T R, Panda A K. Characteristics study of 2DEG transport properties of AlGaN/GaN and AlGaAs/GaAs-based HEMT[J].Semiconductors,2011,45(5):650-656.
[11] 郝 躍,張金風,張進成.氮化物寬禁帶半導體材料與電子器件[M].北京:科學出版社,2013.1.
基金項目:河北省自然科學基金資助項目(F2014202046)

