拋光轉速對砷化鎵雙面拋光片表面平整度的影響
李穆朗
(中國電子科技集團公司第四十六研究所 天津300220)
0 引 言
砷化鎵是繼硅之后的第二代半導體材料,適用于制作高速、高頻、大功率及發光電子器件,是制作高性能微波、毫米波器件及發光器件的優良材料,被廣泛應用于雷達通訊、精確制導、新一代衛星通信等裝備系統。受制造成本因素的驅動,砷化鎵晶片尺寸逐漸增大,晶片厚度向超薄化發展,對其面型精度的要求也不斷提高。晶片總厚度變化量(TTV)是檢驗加工水平的一項重要指標,并直接影響后續各項應用產品的最終質量。
1 拋光方式的選取
CMP是砷化鎵晶片加工的主要方式,其基本原理是砷化鎵晶片在一定壓力下,以拋光液(含有 SiO2磨粒的氯系溶液)作為去除介質,依靠機械磨削和化學腐蝕的交替作用完成拋光[1-2]。目前CMP技術主要分為單面拋光和雙面拋光。單面拋光主要針對單面拋光片,在進行雙拋片加工時,單面拋光技術對于晶片總厚度變化的控制是比較困難的,而在雙面拋光過程中,晶片被置于游星輪內,在內外齒圈的帶動下轉動,同時上下拋光盤反向旋轉,對晶片正背面同時進行均勻去除,如圖1。

圖1 雙面拋光機工作示意圖Fig.1 Working diagram of double-sided polishing machine
2 實驗材料與設備
2.1 實驗材料
本文實驗中所用砷化鎵均為 VGF法生長的 N型<100>晶片,直徑(100±0.1)μm,片厚度為(700±5)μm,電阻率≥5,kΩ·cm。
2.2 實驗與測試設備
2.2.1 實驗設備
實驗使用的拋光設備為 SPEEDFAM 公司生產的 9B-5L/P(3MOTOR)雙面拋光機。9B-5L/P拋光機主要應用于 2~4,in砷化鎵晶片的雙面拋光,其內齒圈半徑為 100,mm,齒數 100,外齒圈半徑為325,mm,齒數 280。根據機型與盤面直徑,拋光機每次可拋光6~10片。拋光布選用美國Rodel公司生產的 SubaⅣ拋光布,實驗采用氯系拋光液,pH值 10~12,硅膠顆粒粒徑 85,nm。拋光后對晶片進行清洗去除表面殘留的拋光液和有機雜質。
2.2.2 測試設備
實驗使用的測試設備為美國康寧公司生產的Autoselect 8020幾何參數測試儀,主要進行晶片表面幾何參數的高精度檢測,并輸出三維表面形貌及TTV分布圖。
3 實驗方案
本實驗主要討論不同拋光盤及內外齒圈轉速對砷化鎵拋光片總厚度變化的影響,拋光液主要成分為氯系氧化劑、SiO2膠體和水,拋光壓力固定,各拋10片。
方案一:設定內、外齒圈轉速比為 1.8∶1,內齒圈固定轉速為18,rpm,外齒圈固定轉速為10,rpm,上下盤轉速按比例1∶2.5,轉速逐漸增加,如表1。

表1 不同拋光盤轉速設定Tab.1 Speed setting for different discs
方案二:設定上、下盤轉速比為 1∶2.5,上盤固定轉速為 13,rpm,下盤固定轉速 32.5,rpm,內外齒圈轉速按比例1.8∶1,轉速逐漸增加,如表2。

表2 不同內外齒圈轉速設定Tab.2 Different speed settings of inner and outer ring gear
4 結果和討論
圖2、3為不同轉速對晶片去除速率的影響。
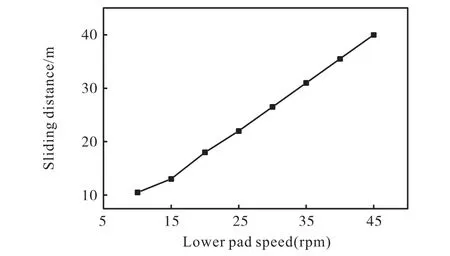
圖2 不同拋光盤轉速下的去除速率Fig.2 Removal rates of different disc rotating speeds

圖3 不同內外齒圈轉速下的去除速率Fig.3 Removal rates at different speeds of inner and outer ring gears
由圖可以看出,當內外齒圈轉速固定時,隨著拋光盤轉速值增加,拋光去除率不斷增加,且成正比關系。當拋光盤轉速固定時,隨著內外齒圈轉速值增加,拋光去除速率增加略有減小,但減小幅度很小。綜合分析圖2和圖3,內外齒圈轉速對材料去除速率的影響較小,拋光盤轉速對材料去除速率影響較大,且拋光盤轉速對于去除速率的影響較內外齒圈轉速更加明顯。
圖 4和圖 5分別為不同拋光盤轉速下拋光片的表面全局平整度和局部平整度結果,其中在圖5中每個小方格內的數字表示砷化鎵晶片表面上 20,mm×20,mm范圍內的局部平整度。

圖4 不同拋光盤轉速下晶片全局平整度(a、d、g轉速從小到大)Fig.4 The overall flatness of the chip(the speeds of a,d,g vary from low to fast)at different discs at the rotational speed of the discs

圖5 不同拋光盤轉速下晶片局部平整度(a、d、g轉速從小到大)Fig.5 The local flatness of the chip(the speeds of a,d,g vary from low to fast)at the rotational speed of different discs

表3 a、d、g組拋光盤轉速下幾何參數Tab.3 Geometric parameters of a,d and g groups at the rotational speed of discs
從表 3可見,采用a組轉速組合進行拋光,平均全局平整度為 1.192,μm,邊緣局部平整度平均值為0.790,μm。而采用較高轉速后,從圖 4和 5可以看出拋光砷化鎵片兩中心平整度均變化不大,而邊緣平整度增加明顯,提高了整體表面平整度。這主要是由于晶片的運動軌跡主要集中在拋光布中心的環狀區域內,轉速越快對拋光布中心的磨損越嚴重,相對中心晶片邊緣的去除速率就會加快[3]。
對比三組轉速組合拋光砷化鎵晶片的表面幾何參數,由于內外齒圈轉速對材料去除速率的影響較小,因此優化拋光盤轉速可使拋光軌跡更加均勻,從而有效改善砷化鎵雙拋片的表面質量,尤其是晶片邊緣的局部平整度,滿足由于集成電路線寬變小帶來的對砷化鎵雙拋片表面平整度的更高要求。
5 結 論
砷化鎵雙拋片CMP過程是化學與機械交互作用的過程,化學作用在晶片表面形成的氧化層需要通過晶片與拋光布及磨粒的機械作用去除,因此根據固定轉速比對拋光盤和內外轉速進行實驗,結果表明拋光去除量與拋光盤轉速成正比,內外齒圈轉速對于去除速率影響較小。
砷化鎵雙拋過程中,晶片的運動軌跡主要集中在拋光布中心的環狀區域內,較高的拋光盤轉速會造成拋光布中心部分的磨損,導致邊緣去除速率高于中心,進而增加晶片的表面平整度。
[1]孫禹輝,康仁科,郭東明,等. 化學機械拋光中的硅片加持技術[J]. 制造技術,2004,29(4):10-14.
[2]庫黎明,李耀東,周旗鋼,等. 雙面拋光工藝中壓力對 300,mm硅片表面形貌的影響[J]. 稀有金屬,2006,30(12):134-137.
[3]杜家熙,蘇建修,萬秀穎,等. 單晶硅片化學機械拋光材料去除特性[J]. 北京科技大學學報,2009,31(5):608-611.

