Si基雙色碲鎘汞材料阻擋層生長及表征
高 達,王經緯,王 叢,許秀娟
(華北光電技術研究所,北京 100015)
1 引 言
前期的工作中以Si基中波、短波HgCdTe材料工藝為基礎,建立了Si基中/短波雙色HgCdTe材料工藝,并獲得了預期的材料參數和較好的晶體質量。然而在研究過程中發現,雙色HgCdTe材料缺陷普遍比單色HgCdTe材料缺陷大,缺陷直徑普遍大于20 μm。通過缺陷成因分析,發現大缺陷的產生是阻擋層生長溫度高于短波層材料的生長溫度造成。為了獲得更好的Si基雙色HgCdTe材料晶體質量,需要對阻擋層生長工藝進行持續優化。
準平面雙色結構利用多層外延技術,通過刻蝕,以并列的方式構成獨立的兩個不同響應波段的pn結。為了防止不同吸收層的光生載流子擴散到另一吸收層,避免形成波段之間的串音,在兩個吸收層之間生長一層高組分的阻擋層。所設計的阻擋層參數決定了其對串音的阻擋效果。在實際的工藝過程中發現,阻擋層材料參數的表征有一定的困難。為了獲得材料參數控制精確的雙色HgCdTe材料,必須對現有的雙色材料表征工藝進行改進。
因此,Si基中短波雙色HgCdTe材料的阻擋層的生長與表征,是獲得材料參數控制精確、晶體質量良好的中短波雙色材料的關鍵所在。
2 材料生長工藝設計及表征
2.1 Si基中短波雙色HgCdTe材料生長
實驗所用設備為芬蘭DCA P600分子束外延系統,系統配有CdTe源、Te源和閥控Hg源,所用CdTe/Si復合襯底為本實驗室生長[1-2],如圖1所示。

圖1 生長后的CdTe/Si復合襯底照片Fig.1 Photograph of CdTe/Si composite substrate
CdTe復合襯底在裝入MBE系統進行HgCdTe生長前,先使用0.5%的溴甲醇腐蝕20 s,然后使用大量甲醇沖洗,最后使用高純氮氣吹干后裝入設備;襯底在Loadlock中180 ℃除氣3 h后即可使用。生長過程中使用RHEED對生長表面進行實時監控樣品表面溫度監控使用高溫計,通過這兩種在線測試方法可以即時的調整和優化生長參數;組分控制是在考慮粘附系數修正的情況下,依據公式:
來調整HgCdTe薄膜中Cd的組分。

圖2 Si基雙色HgCdTe材料結構示意圖Fig.2 The schematic of dual band HgCdTe heterostructure
采用的Si基中短波雙色HgCdTe材料結構為疊層結構,如圖2所示,使用MBE生長多層HgCdTe外延獲得雙色材料。由于阻擋層生長組分高、厚度薄的材料參數要求,和其在結構中所處的位置,決定了阻擋層生長質量不僅決定了能否減少串音的產生,也影響著整個雙色材料的晶體質量。阻擋層相較短波、中波HgCdTe組分更大,也就意味著阻擋層工藝中的Hg/Te比、生長溫度均需要根據阻擋層的組分進行調整。
2.2 阻擋層生長工藝優化方案
前期的工藝開發中,我們借鑒短波HgCdTe材料工藝參數,設計阻擋層工藝[3-4]。考慮到生長溫度的變化既可以獲得適合阻擋層的生長溫度,同時又影響著Hg的粘附系數。阻擋層生長工藝中的Hg/Te比沿用短波工藝參數,僅通過提高短波工藝參數中的生長溫度獲得適合阻擋層生長的材料工藝。并獲得了較好晶體質量的中短波雙色HgCdTe材料。但是此生長工藝方案中的阻擋層生長溫度高于短波層材料的生長溫度會造成雙色HgCdTe材料大缺陷的產生。
為了解決這個問題,分析了短波層和阻擋層的工藝特色。首先是阻擋層生長工藝特點:相對短波層較高的生長溫度和較低的Hg/Te比;其次是需要保證短波層晶體質量。綜合阻擋層和短波層生長工藝的特色,提出了兩個解決大缺陷問題的方案,如表1所示。方案一:提高生長溫度的同時提高Hg束流,另外提高Te束流來保證較低的Hg/Te比。方案二:僅降低Hg/Te比來獲得較為適合阻擋層的生長工藝。

表1 阻擋層生長工藝優化方案Tab.1 optimization scheme of the growth of barrier
按照三個阻擋層工藝方案進行了三次Si基中短波雙色HgCdTe材料工藝,獲得了三片Si基中短波雙色HgCdTe材料如圖3所示。
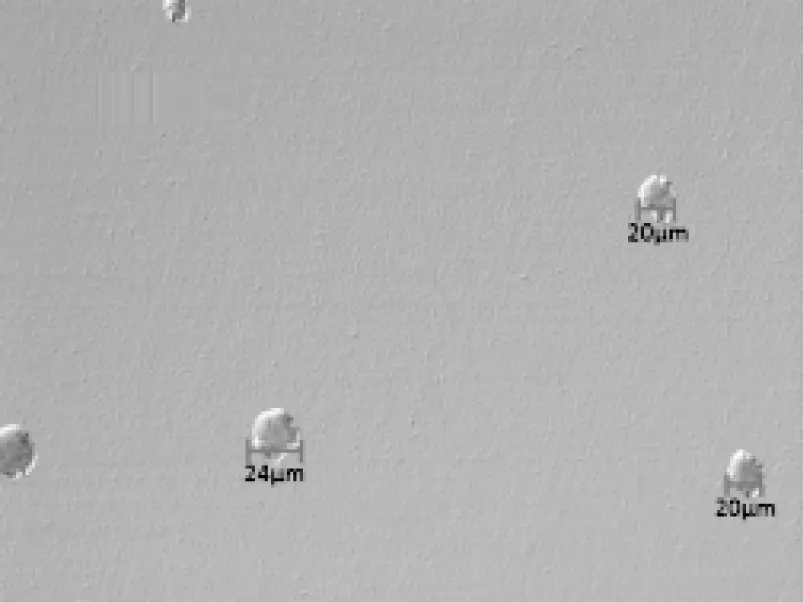
(a)原方案

(b)方案一
原生長工藝方案獲得的雙色HgCdTe材料缺陷直徑普遍大于20 μm,這種大缺陷對器件性能,尤其是盲元率和表面漏電,造成一定的影響。為了獲得缺陷直徑小于10 μm的雙色HgCdTe材料,我們需要更加優化的雙色HgCdTe阻擋層工藝。方案一獲得的雙色材料缺陷直徑略有降低,但是仍然在10 μm以上,此方案仍不能完全解決大缺陷的問題。按照方案二進行的雙色材料,成功的將缺陷大小降低到10 μm以內,缺陷密度也是這三個生長工藝中最少的。可以判斷,方案二的阻擋層生長工藝更加適合雙色材料工藝,能夠解決大缺陷的問題,并一定程度上優化了材料質量。
2.3 阻擋層表征方案
現階段阻擋層的表征手段使用FTIR數據模擬,并通過SEM測量雙色材料截面驗證,獲得雙色材料多層的參數,但是由于阻擋層組分大、厚度薄,參數模擬時誤差相對較大。獲得的數據模擬值與設計值有較大出入,亟需尋找新的表征手段進行阻擋層參數的表征。
FTIR獲得的光譜圖可以直接獲得的材料參數為中波層組分,分別通過腐蝕材料測量FTIR光譜圖,SEM掃描材料截面,可以獲得材料短波層組分和各層厚度,如圖4~圖6所示。但是阻擋層的組分無法直接獲得。

圖4 Si基中短波雙色HgCdTe材料測試及模擬結果Fig.4 FTIR date simulation

圖5 腐蝕不同厚度傅里葉變換紅外光譜圖對比Fig.5 Comparison of FTIR date with different thickness
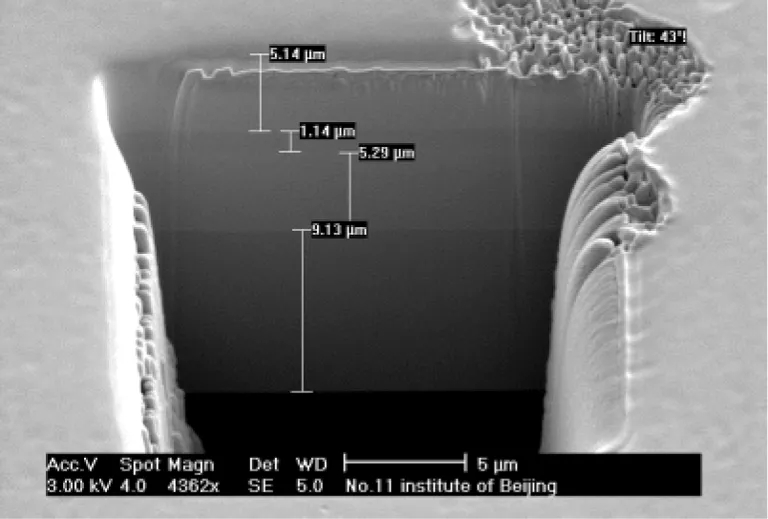
圖6 SEM截面圖Fig.6 SEM profile of dual band HgCdTe
為了獲得阻擋層組分信息,需要使用光致發光技術。光致發光技術是一項對材料,尤其是半導體材料進行無損檢測的經典手段。通過對吸收系數的研究來對光致發光譜進行研究,并且和實驗結果進行對照,對光致發光譜中的峰進行研究。首先在77 K條件下對雙色材料進行光致發光譜的測量,僅僅獲得了中波層吸收峰的數據,波數1781 cm-1如圖7所示。波數對應HgCdTe組分為0.286,FTIR測量獲得的組分基本相同,如表2中所示。但是由于中波層厚度較高,光致發光無法獲得阻擋層材料的信息,因此需要對材料進行腐蝕處理。

圖7 77 K下雙色HgCdTe材料光致發光譜Fig.7 PL date of dual band HgCdTe at 77 K表2 PL與FTIR測量組分結果對比Tab.2 Comparison of PL date and FTIR date

PLFTIR中波層組分0.2860.285
中波層厚度為5.15 μm,腐蝕掉4.9 μm后在77 K條件下對雙色材料進行光致發光譜的測量。不僅能夠得到中波層吸收峰,阻擋層吸收峰參數也表征了出來。阻擋層吸收峰波數3523 cm-1對應HgCdTe組分為0.422,如圖8所示。在FTIR數據模擬中,阻擋層組分為0.41,與PL測量得到的組分相差較大。阻擋層組分設計值為0.45~0.5,實際獲得的組分為0.422,相對較小。在之后的工藝中,應當調節響應參數,提高阻擋層組分。

圖8 腐蝕前和腐蝕后77 K下雙色HgCdTe材料光致發光譜Fig.8 Comparison of corrosion and uncorrosion PL date of dual band HgCdTe at 77 K
3 結 論
通過阻擋層優化方案設計,成功地將缺陷大小降低到10 μm以內,成功地解決了出現的大缺陷問題。并且材料質量獲得了一定的提升,缺陷密度降低到2000 cm-2以內。開創性地使用PL測量雙色HgCdTe材料阻擋層組分信息,自此完整地建立了雙色HgCdTe材料參數的測試體系,能夠準確地獲得多層HgCdTe材料每一層的組分、厚度信息,為材料參數控制,材料結構設計奠定了堅實的基礎。

