直流磁控濺射生長(002)擇優取向A lN薄膜及其光致發光
呂 偉,劉 俊,趙鵬宇,李健亮,李思達,沈龍海
(沈陽理工大學理學院,遼寧沈陽 110159)
1 引 言
氮化鋁(AlN)屬于Ⅲ族氮化物半導體材料,具有最寬的直接帶隙結構(禁帶寬度為6.2 eV)[1]、較高的熱導率(320 W/(m·K))和擊穿場強(10 kV/m)[2]、良好的化學穩定性[3]以及較高的聲表面波(SAW)傳輸速度等優異的特性。AlN這些優異的物理化學性能使得AlN薄膜有著廣闊的應用前景,例如:AlN薄膜可以作為緩沖層,外延生長高質量的GaN或SiC薄膜[4];AlN薄膜是GHz級(SAW)和體聲波(BAW)器件的優選材料[5];AlN薄膜是良好的發光材料和稀土摻雜發光基體材料[6]。
AlN薄膜的生長方法有化學氣相沉積(MOCVD)[7]、磁控濺射(PVD)[8]以及脈沖激光沉積(PLD)[9]等。其中,磁控濺射具有設備簡單、實驗參數易于控制以及可以在低溫下成膜等優點[10-11],被廣泛應用于半導體薄膜的制備。磁控濺射的工藝參數與薄膜結構的關系備受研究者關注。Imran等研究了直流濺射功率對AlN薄膜擇優取向的影響[12],隨著直流濺射功率的增大有利于AlN薄膜(002)擇優取向的生長;Taurino等研究了濺射總氣壓對AlN薄膜擇優取向轉變的影響[13],濺射總氣壓越小,越有利于AlN薄膜沿c軸擇優取向生長,隨著濺射總氣壓的增大,薄膜取向從(002)向(100)轉變;Zang等研究了襯底溫度對AlN薄膜結構和性能的影響[8],濺射過程中襯底溫度對薄膜晶體質量有重大影響,溫度越高越有利于結晶質量的提高。在AlN晶體的生長過程中由于氣體純度、襯底表面雜質及本底真空等因素的影響一定會引入雜質和缺陷,形成與缺陷能級相關的復合缺陷能級發光。目前,AlN通常被作為深紫外發光器件和稀土摻雜半導體發光材料的優選材料,但是關于AlN晶體缺陷能級的發光機制卻沒有統一的定論,存在很多爭議,因此,研究AlN薄膜缺陷發光機制對其在發光器件上的應用具有重要意義。
目前,氮氣含量對直流反應磁控濺射制備AlN薄膜微觀結構的影響的研究還很少,由于制備方法不同,AlN晶體缺陷能級發光也呈現出多樣性和復雜性的特征。本文采用直流反應磁控濺射在玻璃襯底上生長了AlN薄膜,研究了氮氣含量對AlN薄膜的晶體結構取向以及表面形貌的影響,并測量了不同條件下生長的AlN薄膜在405 nm激光激發下的PL光譜,討論了AlN薄膜的光致發光機制。
2 實 驗
本文采用直流反應磁控濺射的方法在玻璃襯底上生長了AlN薄膜,靶材是直徑 50 mm厚4 mm的高純鋁靶(99.999%);工作氣體為高純氬氣,純度99.999%;反應氣體為高純氮氣,純度為99.999%;襯底為玻璃。實驗制備前,先把基片放在酒精中超聲波清洗15 min,并在30 Pa的氬氣氛圍下輝光清洗10 min。濺射前對靶材預濺射10 min,去除表面氧化層。
生長參數如表1所示。其中氮氣含量是通過質量流量計來調節的,保持氣體總流量90 mL/min的條件下,分別改變氮氣流量和氬氣流量,并通過下列公式計算氮氣含量:

其中,F(N2)和F(Ar)分別為N2和Ar氣體流量,單位為mL/min。

表1 AlN薄膜生長參數Tab.1 Deposited parameters of AlN film
3 結果與討論
3.1 AlN薄膜XRD分析
圖1為不同氮氣含量下沉積的AlN薄膜的XRD譜。從圖1可以看出,在不同的氮氣含量下制備得到的AlN薄膜均出現了(002)和(103)衍射峰,其中(002)衍射峰強度遠遠大于(103)衍射峰強度,即制備得到的AlN薄膜具有良好的c軸擇優取向。衍射峰的半高寬(FWHM)是衡量薄膜結晶質量的標志之一,通常情況下,XRD譜中最強衍射峰的FWHM越小,薄膜結晶質量越好[14]。從圖1中可以明顯看出氮氣含量為66.7%時,FWHM最小,薄膜結晶質量最好,通過 origin數據分析軟件進行高斯多峰擬合得到FWHM為0.28°。不同氮氣含量下AlN薄膜的平均晶粒尺寸可以根據謝樂公式計算得到:

其中,D⊥為沿 c軸(002)晶向的晶粒大小,λ=0.154 056 nm,B 為 FWHM 的值[15],θ為(002)峰的XRD衍射角,計算結果如表2所示。從表2中可以看出,氮氣含量為66.7%時晶粒尺寸最大。

圖1 不同氮氣含量下生長的AlN薄膜的 XRD譜。(a)φ(N2)=66.7%;(b)φ(N2)=75%;(c)φ(N2)=80%。Fig.1 XRD spectra of AlN films deposited under various nitrogen concentrations.(a) φ(N2)=66.7%.(b)φ(N2)=75%.(c)φ(N2)=80%.

表2 不同氮氣含量下生長的AlN薄膜的(002)峰結構參數Tab.2 (002)peak structure parameters of AlN films deposited under various nitrogen concentrations
在不同氮氣含量下都生長出了具有(002)擇優取向的AlN薄膜,根據余志明等的研究[16]表明,氮氣含量在50% ~80%范圍內有利于(002)擇優取向的生長,本文的實驗條件與此相符,這表明氮氣含量在這一范圍內的變化對薄膜擇優取向沒有明顯作用,但對薄膜的結晶度有明顯作用。造成這一現象的可能原因是:在氮氣含量為66.7%時,Ar+具有較高的濺射產額并且濺射出來的Al原子具有較高的能量,到達襯底表面時有較大的表面遷移能,生長出成核密度高、晶粒尺寸較大以及結晶質量較好的AlN薄膜;當氮氣含量為75%時,濺射氣體中的Ar+含量降低,導致被濺射出來Al原子能量降低,同時也導致了到達襯底表面的Al原子數量減少。Al原子到達襯底表面時,表面遷移能較小,且由于N含量的升高抑制Al原子表面擴散,縮短了Al原子的擴散距離,降低了Al原子的重排能力,最終導致晶粒尺寸的減小和結晶度下降;當氮氣含量為80%時,Ar+含量進一步降低,N原子含量進一步升高,Al原子到達襯底表面很快與N原子凝結成核,抑制Al原子表面擴散和重排,導致Al原子不斷沿著垂直于襯底表面的方向堆積,促進了薄膜(002)取向的生長,改善了薄膜的結晶性能。
3.2 AlN薄膜表面形貌分析
圖2是不同氮氣含量下的AlN薄膜的掃描電鏡(SEM)圖。從圖2中可以看出,不同氮氣含量下,薄膜表面形貌均呈現小顆粒密堆積排列,無明顯大顆粒存在,顆粒尺寸大概在20 nm左右。當氮氣含量為66.7%時,薄膜表面顆粒堆積比較均勻,無明顯的起伏現象。當氮氣含量為75%時,薄膜表面出現一些形狀大小不一的小島,顆粒堆積的均勻程度明顯下降。當氮氣含量進一步升高時,薄膜表面呈現形狀大小接近的小島,薄膜表面形貌均勻程度得到改善。

圖2 不同氮氣含量下生長的AlN薄膜SEM圖。(a)φ(N2)=66.7%;(b)φ(N2)=75%;(c)φ(N2)=80%。Fig.2 SEM images of AlN film deposited under various nitrogen concentrations.(a) φ(N2)=66.7%.(b) φ(N2)=75%.(c)φ(N2)=80%.
造成以上結果可能的原因是:在氮氣含量為66.7%時,Ar+含量較大,濺射出來的Al原子能量較高,附著在襯底表面時依舊有足夠的能量遷移和重排,從而薄膜表面比較均勻;當氮氣含量為75%時,被濺射出來的Al原子能量降低沒有足夠的能量去遷移和重排,導致薄膜表面堆積不均勻,呈現出大小不一的小島狀;當氮氣流量進一步增大時,被濺射出來的Al原子能量進一步減小且受到N原子含量的抑制,在襯底表面不斷堆積,使薄膜表面呈現出堆積狀的小島。
3.3 光致發光(PL)光譜測試
圖3為不同氮氣含量條件下生長的AlN薄膜的光致發光光譜。由圖3可知,不同氮氣含量條件下生長的AlN薄膜在550 nm處均有較強的發光峰,在大約590,620,650 nm處也有較弱的缺陷能級發光峰,如圖3虛線所示,隨著氮氣含量增高,缺陷發光峰越來越明顯。為了更好地確定在大約590,620,650 nm處缺陷能級發光峰的位置,對氮氣含量為80%的PL光譜進行高斯擬合,擬合結果如圖4虛線所示。從圖中可以清楚地看出,這3處發光峰分別位于589,614,654 nm處。

圖3 波長為405 nm的激光激發的不同氮氣含量下的AlN薄膜的光致發光光譜。(a)φ(N2)=66.7%;(b)φ(N2)=75%;(c)φ(N2)=80%。Fig.3 PL emission spectra of AlN films with different nitrogen concentrations excited by laser at 405 nm wavelength.(a) φ(N2)=66.7%.(b) φ(N2)=75%.(c)φ(N2)=80%.
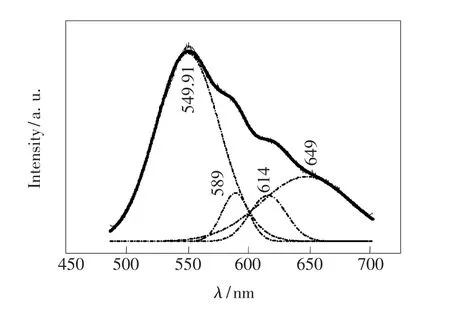
圖4 波長為405 nm的激光激發的氮氣含量為80%的AlN薄膜的PL發光光譜Fig.4 PL emission spectra of AlN film with nitrogen concentration of80%excited by laser at405 nm wavelength
AlN的本征禁帶寬度6.2 eV,所以AlN薄膜產生的這幾個發光峰都是由禁帶中缺陷能級之間以及缺陷能級與價帶和導帶之間的躍遷輻射產生的。在磁控濺射生長AlN的過程中,不可避免地會產生缺陷和引入雜質,例如氮空位(VN)、鋁空位(VAl)以及氧原子占據N的位置(ON)等。根據Chichibu[17]和 Sedhain[18]等研究者的研究結果表明,VAl形成的缺陷能級位于價帶頂1.6~2.78 eV的范圍內。因此550 nm(2.25 eV)的發光峰可歸因于VAl產生的缺陷能級向價帶頂的躍遷。在589 nm(2.11 eV)、614 nm(2.02 eV)以及654 nm(1.90 eV)處的發光峰可分別歸因于ON-ON缺陷對[19]向 VAl-2ON[20]產生的復合缺陷能級的躍遷、導帶向與氧有關的雜質能級(IO)間的躍遷[21]以及VAl-ON深能級上的電子躍遷到價帶[22],由此構建的AlN薄膜缺陷能級發光機制如圖5所示。

圖5 AlN薄膜禁帶中的發光機制Fig.5 Luminescencemechanism of AlN films in the forbidden band
由于所有的AlN薄膜都是在氮氣含量大于1的條件下生長得到的,所以會產生大量的VAl缺陷能級,即在PL光譜中,所有AlN薄膜在550 nm處都有較強的發光峰。隨著氮氣含量的增加,濺射出來的粒子能量較弱,對襯底表面的轟擊作用減弱,襯底表面有更多的氧雜質含量殘留,從而導致AlN薄膜氧雜質含量增加。當氮氣含量達到80% 時,濺射出來的粒子能量最弱,氧雜質含量達到最大,因此在589,614,654 nm處與氧有關的缺陷能級之間的發光峰更加明顯。
4 結 論
采用直流反應磁控濺射法在不同氮氣含量條件下生長了沿(002)擇優取向的AlN薄膜,薄膜表面均呈小顆粒密堆積排列,顆粒尺寸在20 nm左右。隨著氮氣含量增加,薄膜表面顆粒從均勻堆積向小島狀堆積轉變。當氮氣含量為66.7%時,可以得到結晶質量相對較好和晶粒尺寸相對較大的AlN薄膜。不同氮氣含量條件下生長的AlN薄膜在550 nm左右都有較強的發光峰,并且隨著氮氣含量的增大,在589,614,654 nm處的缺陷發光峰越來越明顯。

