鈍化層質量問題分析研究
于姝莉
(中國電子科技集團公司第四十七研究所,沈陽110032)
1 引 言
對于半導體器件而言, 管芯表面覆蓋的鈍化層是器件的最終機械保護層,不僅可以起到電極之間的絕緣作用,還能減弱和穩定半導體材料的多種表面效應, 防止管芯受到塵埃、水汽、酸氣或金屬顆粒的沾污。鈍化層的制備一般是在特定的工藝流程中采用CVD 工藝(Chemical Vapor Deposition, 化學氣相沉積)生長SiO2或Si3N4到晶片上[1],所以晶片的制造工藝條件和封裝工藝技術對于鈍化層的質量和絕緣能力都非常重要。因前期鈍化工藝不良而引起后步封裝測試問題的案例在實際生產中時有發生。
2 問題出現與初步排查
某產品在封裝過程中,在完成合金粘片[2]以后,發現金屬布線上方鈍化層出現凸起現象,同時部分區域出現鈍化層缺失,如圖1 所示。在顯微鏡100 倍放大視野下觀察,見到PAD 點周圍的寬鋁線附近存在異常凸起,呈不均勻分布且有著清晰的邊界。個別凸起處可見鈍化層已經缺失,裸露出下方的金屬層。經核查鏡檢記錄確證,該電路在合金粘片前的鏡檢時并未發現類似現象,初步斷定該質量問題為合金、粘片過程所誘發。
該產品的鈍化層為SiO2、Si3N4復合構造,由于Si3N4材料本身應力比較大,推測可能由于鈍化加工過程出現某種異常導致了Si3N4層應力釋放不完整,造成鈍化層異常[3-4]。
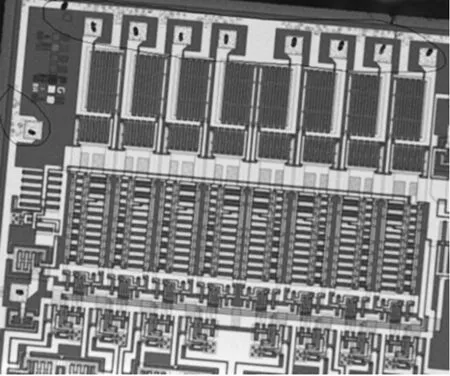
圖1 鈍化層異常
對該批次產品進行逐一鏡檢,確認存在鈍化層凸起、缺失現象的部位均在電路最外圈較寬的金屬布線上,電路內部沒有類似現象。抽取3 只失效現象較明顯的電路進行失效分析。出現鈍化層凸起問題的電路,在劃片后目檢時均未出現異樣,真到合金粘片完成后才會出現鈍化層凸起現象,且鈍化層凸起處形貌完整,未出現邊緣裂紋,失效現象不符合鈍化層損傷失效。初步排除因鈍化層質量問題導致的失效,問題原因應在鈍化層下方。
3 失效分析
3.1 能譜測試
采用VEGA3 掃描電子顯微鏡對樣品凸起和缺失區域分別進行能譜分析[5]。由圖2 所示為電鏡下的鈍化層缺失處分析點。從圖中可以明顯看出,鈍化缺失處邊緣清晰、無裂紋現象[6],SiO2和Si3N4分層清晰可見,兩層鈍化層均已缺失。
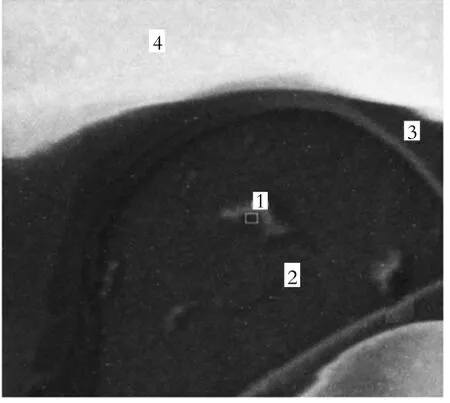
圖2 鈍化層缺失處SEM 分析區域
在進一步的分析中,選取如圖2 所示的四個定位點,采用5keV 能量進行分析,分析具體結果如表1 所示。

表1 鈍化缺損處分析結果
分析點“1”處為鈍化缺失區域內的重度缺陷區,經分析與點“2”處的成分相近,均以鋁金屬為主,可以證明鈍化層缺失區域內的鈍化層成份已完全失去。分析點“3”、“4”兩處為鈍化層完整區域,5keV 能量下只能分析表層氮化硅成份。經測試,鈍化層成分正常,無氧含量超標現象;表層氮化硅也沒有觀察到質量問題。
如圖3 所示為鈍化層凸起處分析點,此處在電鏡圖像中呈現不規則鼓起狀,邊緣平滑。在增加能量后,表面開始破損,出現圖中的黑色條狀區域,凸起區域逐漸塌縮至圖中呈現的狀態。為確認此類鈍化凸起的形成原因,分別采用5keV、10keV 能量對凸起區域的氟、氯、氫含量進行分析。分析具體結果如表2 所示。

圖3 鈍化層凸起處SEM 分析區域

表2 鈍化層凸起處SEM 分析結果
在5keV 能量下,以表層氮化硅為分析對象,測試結果表明其成份符合氮化硅比例要求。在10keV能量下,分析對象為鈍化層下方的空間,得知其主要成份為金屬鋁。測試過程中并未在樣品中發現大量水汽或腐蝕性氣體成分。
3.2 原因分析
可能造成這一鈍化層異常的原因包括:
a) 鈍化層下存在腐蝕性氣體,在接觸水汽后,腐蝕了氧化層,形成孔洞;
b) 鈍化層下聚集有水汽,經高溫后,體積腫脹而鼓起;
c) 由于金屬鋁與鈍化層的熱膨脹系數不一致,從合金粘片的420℃下降至室溫后,鈍化層內集聚的熱應力未能完全釋放。
由圖4 中可見,鈍化層缺失處金屬完整,沒有變色、發烏,證明金屬未經過腐蝕。經能譜分析確認,也未發現大量腐蝕性元素存在,加工過程正常,不存在質量問題。第一種原因可以排除。

圖4 鈍化層缺失處能譜分析區域
正常情況下,SiO2存在親水性,場區內無金屬布線處應聚集更多的水汽。鈍化凸起處均在金屬布線上,未靠近金屬邊緣,且能譜分析未發現過量的氫元素存在,排除加工過程或儲存過程受潮問題。
合金粘片過程中,需要操作人員用手工擦動的方式完成芯片與管殼粘接,又對芯片施加了應力。過度的應力聚集很可能是產品表面出現異常現象的主因,不能排除。
3.3 失效現象復現
為最終確認應力來源,進行以下實驗:在同一晶圓片上選取兩個芯片分別進行300℃導電膠粘接工藝模擬和420℃加熱模擬。
300℃導電膠粘片后芯片表面情況如圖5 所示。實驗完成后發現,經過300℃烘焙15min 的芯片未發生變化,而在420℃加熱爐上放置20s 的芯片已經出現鈍化凸起,現象與失效產品完全一致,失效復現成功,此次鈍化層質量問題的起因被準確定位。

圖5 300℃導電膠粘片后芯片表面
在導電膠粘接工藝中,產品有在烘箱內冷卻降溫的過程,令電路有足夠的時間進行熱應力釋放[7];而在合金粘片工藝中,粘片完成后,直接取下電路令其自然冷卻,這樣就導致了壓力更加容易聚集[8]。該電路中的應力來源為熱應力,也就是造成此次鈍化層質量問題出現的原因。
4 結 束 語
以某產品出現的一起鈍化層質量問題為案例展開實際分析,通過目檢、鏡檢、能譜分析等手段提供數據支撐,結合實際工藝條件最終發現問題所在,經過實驗使問題再次復現,確定了問題的起因,徹底解決了此次鈍化層質量問題,對避免在未來生產中再次出現同類問題提供了保障,有力地提高了集成電路產品生產的可靠性。

