高能質子輻照導致電荷耦合器件性能退化研究
李 鈺, 文 林, 周 東, 李豫東, 郭 旗
(1. 北京理工大學 光電學院, 北京 100081; 2. 中國科學院 新疆理化技術研究所, 烏魯木齊 830011)
電荷耦合器件(charge-coupled devices, CCD)是一種高靈敏、低噪聲的光電成像器件,被廣泛應用于遙感、氣象及天文等空間光電衛星和光學載荷[1-8]。由于人造衛星所處的空間軌道存在地球輻射帶、太陽質子事件及銀河宇宙射線等輻射環境,輻射效應導致參數退化是影響CCD空間應用性能及可靠性的重要因素,尤其是地球輻射帶中高能質子導致的位移損傷效應[4,9-10]。地球輻射帶是圍繞地球的帶電粒子俘獲帶,由地磁場捕獲帶電粒子而形成,主要由高能質子和高能電子組成,其中,質子能量最高為500 MeV。質子輻照產生的位移損傷效應導致CCD暗電流和電荷轉移效率等參數退化,對CCD的成像性能產生嚴重影響[11]。因此,對于應用于空間環境中的CCD,必須開展輻射效應地面模擬試驗,評估CCD參數和成像性能在高能質子輻照下的退化情況。由于空間應用的CCD一般位于衛星殼體內,受衛星外殼屏蔽及光學載荷鏡頭等的影響,質子能譜分布發生變化。如對于某LEO軌道的地球輻射帶質子能譜分布情況進行粗略計算,當Al屏蔽球殼厚度為2.54 mm時,質子能譜分布的峰值能量約為30 MeV;當Al屏蔽球殼厚度為12.7 mm時,質子能譜分布的峰值能量約為60 MeV[12]。隨著屏蔽材料厚度增加,質子能譜分布的峰值能量變得更大。由于空間典型軌道環境中低能質子成分更豐富,因此,無屏蔽材料的電子元器件主要受空間低能質子位移損傷效應的影響,而有屏蔽材料的電子元器件受低能質子輻射的影響很小,受高能質子輻射的影響更為嚴重。經衛星外殼屏蔽后,質子能譜分布的峰值能量約為60 MeV。對寬能譜范圍質子輻射導致的位移損傷效應進行準確預測,可通過對寬能譜范圍內每個能量的質子進行位移損傷效應試驗來實現。然而,在地面模擬試驗中,受質子加速器裝置能量可調范圍和機時等的限制,考慮成本和時間等因素,質子位移損傷效應評估只能選某一個或幾個能量的質子進行輻照試驗,然后普遍采用非電離能損(non-ionizing energy loss, NIEL)等效方法對測試結果進行內插和外推以獲得完整的損傷譜[13]。
然而,使用NIEL等效方法仍然存在一些問題,如高能質子入射導致復雜位移損傷缺陷產生的情況及可見光成像器件CCD的熱像素問題[14-18]。受質子加速器裝置質子能量可調范圍的限制,能量高于60 MeV的質子輻照導致CCD位移損傷效應的報道較少。本文基于西安200 MeV質子應用裝置(Xi’an 200 MeV Proton Application Facility, XiPAF)的質子輻照條件,開展了能量高于60 MeV的質子輻照試驗,獲得了高能質子輻照導致CCD性能退化的典型結果,提出了高能質子輻照試驗中需重點考察CCD的熱像素退化情況。
1 輻照試驗
試驗樣品為一款2K×1K像素的行間轉移面陣CCD器件,在XiPAF上完成60 MeV和100 MeV質子輻照試驗,輻照期間CCD所有管腳短接并接地,電偏置狀態為零偏置,試驗樣品編號和質子輻照條件列于表1。

表1 質子輻照試驗條件Tab.1 Irradiation test conditions
分別在質子輻照前和輻照后對CCD進行參數測試,主要測試的參數為暗電流、電荷轉移效率、飽和輸出電壓和熱像素,測試系統原理圖及實物圖分別如圖1和圖2所示。
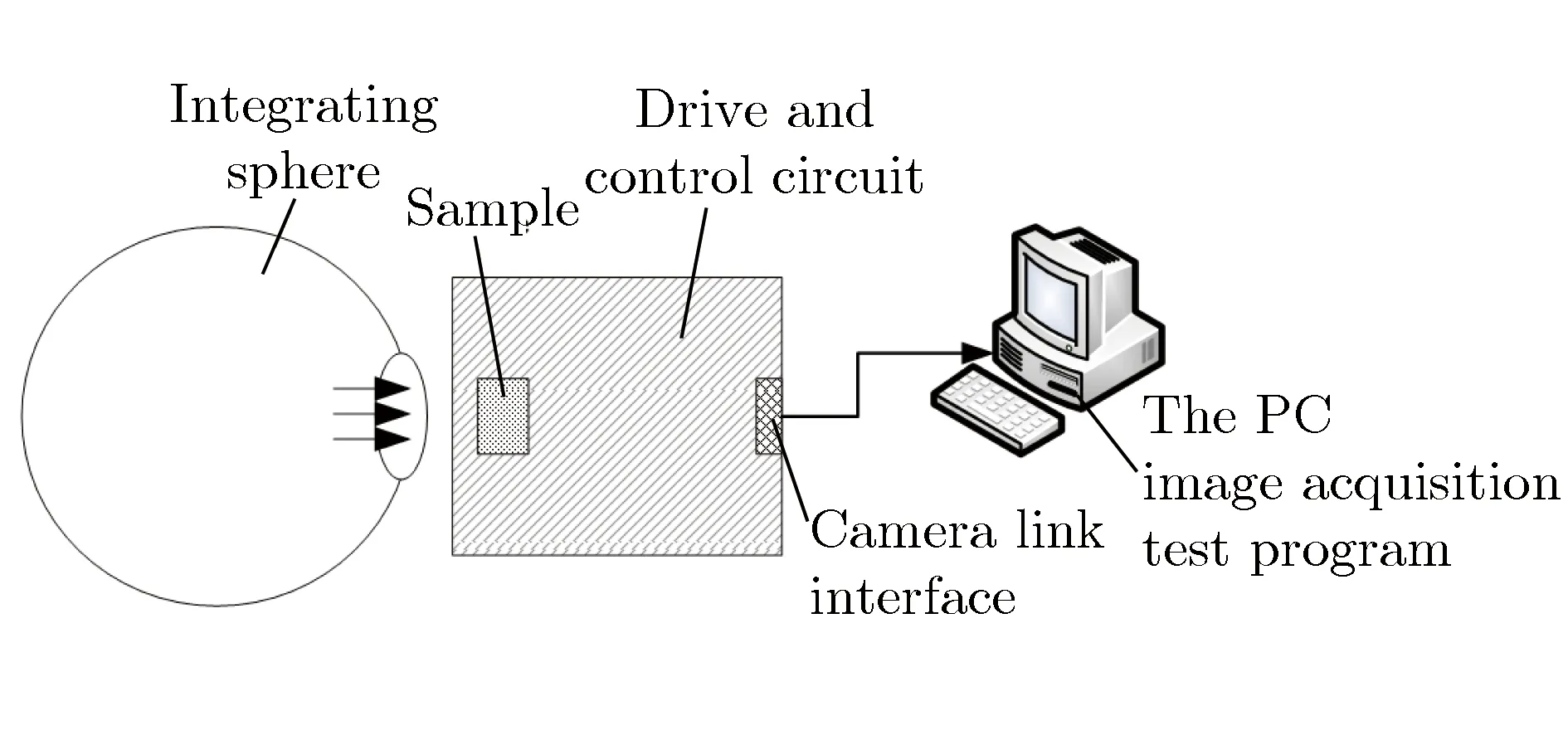
圖1 CCD參數測試裝置原理圖Fig.1 Schematic diagram of CCD parameter test equipment

圖2 CCD參數測試現場裝置實物圖Fig.2 CCD parameter test equipment
除因光照產生的電子外,可見光成像器件CCD會因熱激發產生電子-空穴對,即無光照時,CCD內也會因熱激發產生電子,即暗電流。暗電流是指在無光照條件下,CCD的輸出信號隨積分時間線性增加。暗電流的測試主要是測試CCD輸出信號與曝光時間的變化關系。在規定條件下,通過改變CCD的積分時間,測試對應積分時間下的輸出信號,然后以積分時間為橫坐標,輸出信號為縱坐標,由測試數據給出散點圖,并按最小二乘法,擬合出一條直線,該直線的斜率為CCD單位時間的暗信號,即暗電流。
CCD正常工作時,電荷包在勢阱之間順序轉移。電荷包經像元轉移后存在電荷損失,電荷包電量會減小,損失的電荷則成為后序尾像元中的延遲電荷。CCD兩個相鄰轉移柵極之間有效信號電荷轉移的效率稱為電荷轉移效率。由于電荷轉移過程中損失的電荷成為后序尾像元中的延遲電荷,因此,可采用延遲的電荷(第1個拖尾像元或1組像元)來導出CCD的電荷轉移效率。即在均勻光照條件下,光信號均勻地注入CCD,產生一個均勻的圖像。將圖像讀出后,使用額外的時鐘周期將損失的電荷產生的拖尾像元或通過掃描像素信號讀出,并除以傳輸次數和光場下像素中的信號,則得到電荷轉移損失率ε,電荷轉移效率η可表示為
η=1-ε
(1)
CCD的光響應輸出信號是曝光量和曝光時間的線性函數。因此,在一定的輻照強度下,增加積分時間可改變入射曝光量。在一定的輻照強度下,可見光圖像傳感器輸出信號的最大值為飽和輸出信號,用電壓值表示即稱為飽和輸出電壓。在一定的光照條件下,通過改變積分時間,測出對應曝光量下的輸出信號,然后以曝光量為橫坐標,輸出信號為縱坐標,由測試數據給出散點圖,并按最小二乘法,分別對線性區及飽和區擬合出2條直線,2條直線的交點的縱坐標即為器件的飽和輸出信號,轉換為電壓值即為飽和輸出電壓。
熱像素是CCD的暗信號尖峰。在CCD工作過程中,由于存在熱激發,在沒有光注入的情況下,CCD依然會出現信號電荷,這種信號稱為暗信號,輻射產生的缺陷在CCD像元內分布不均勻導致暗信號分布出現尖峰,即熱像素。N個像素的平均暗信號可表示為
(2)
其中,μd為N個像素的平均暗信號;μd,i為第i個像素的暗信號。在暗場條件下,CCD某些像素的暗信號μd,i高于像素的平均暗信號μd一定倍數R,則認為此像素為熱像素。由此可以得到N個像素內的熱像素數目NH為
(3)
其中,
(4)
在實際測試中,一般使用R=1.5作為判定熱像素的條件。
2 試驗結果與分析
質子輻照試驗采用質子的能量為60 MeV和100 MeV,由于輻照試驗現場測試條件的限制,輻照偏置狀態僅選用零偏,即器件所有管腳短接后接地,輻照試驗中CCD器件開帽,確保質子能量和注量不會因為封裝材料的阻擋發生歧離。試驗中,CCD的位移損傷效應敏感參數暗電流和電荷轉移效率均出現退化,對位移損傷效應不敏感的飽和輸出電壓沒有明顯變化。輻照注量為5×1010cm-2時,60 ,100 MeV質子輻照前后CCD的暗電流退化情況分別如圖3和圖4所示。由圖3可見,輻照前CCD的暗電流為10.15 mV·s-1,輻照后暗電流增加到258.51 mV·s-1。由圖4可見,輻照前CCD的暗電流為8.65 mV·s-1,輻照后暗電流增加到24.59 mV·s-1。

圖3 輻照注量為5×1010 cm-2時, 60 MeV質子輻照前后CCD的暗電流退化情況Fig.3 The dark current degradation ofCCD before and after 60 MeV proton irradiation withirradiation dose of 5×1010 cm-2

圖4 輻照注量為5×1010 cm-2時,100 MeV質子輻照前后CCD的暗電流退化情況Fig.4 The dark current degradation ofCCD before and after 100 MeV proton irradiation withirradiation dose of 5×1010 cm-2
只對位移損傷效應敏感的參數電荷轉移效率的退化情況為:60 MeV質子輻照前為0.999 850,輻照后退化為0.999 768;100 MeV質子輻照前為0.999 867,輻照后變為0.999 869。100 MeV質子輻照后,電荷轉移效率沒有產生明顯的變化。表2所列為不同能量質子輻照下電荷轉移效率的變化情況。

表2 不同能量質子輻照下電荷轉移效率退化情況Tab.2 Degradation of charge transfer efficiency(CTE) underproton irradiation of different energies
將其他所有能量的質子輻照試驗結果中電荷轉移效率的變化量及電荷轉移效率隨NIEL的退化率進行同一尺度下的計算和比較,可見,電荷轉移效率隨NIEL的退化率基本保持不變,表明在衡量電荷轉移效率退化情況時,CCD的位移損傷效應可以在NIEL尺度下進行歸一化的統計和預測。
輻照注量為5×1010cm-2時,60,100 MeV質子輻照前后CCD的飽和輸出電壓退化情況如圖5和圖6所示。由圖5和圖6可見,60,100 MeV質子輻照前后沒有觀察到飽和輸出電壓的明顯退化。以前研究發現,飽和輸出電壓是電離總劑量效應的敏感參數,對位移損傷不敏感[19]。圖5和圖6所示結果表明,輻照注量為5×1010cm-2時,60,100MeV質子導致的輻射損傷以位移損傷為主。

圖5 輻照注量為5×1010 cm-2時, 60 MeV質子輻照前后CCD的飽和輸出電壓退化情況Fig.5 The saturation output voltage degradation ofCCD before and after 60 MeV proton irradiation withirradiation dose of 5×1010 cm-2

圖6 輻照注量為5×1010 cm-2時, 100 MeV質子輻照前后CCD的飽和輸出電壓退化情況Fig.6 The saturation output voltage degradation ofCCD before and after 100 MeV proton irradiation withirradiation dose of 5×1010 p·cm-2
以上研究發現,CCD的質子輻照試驗參數退化率隨質子能量的變化在NIEL尺度下保持一致,即若采用NIEL尺度對不同能量的質子輻照產生的位移損傷劑量進行歸一化,則器件參數的退化情況不依賴于質子能量,僅與總的NIEL的大小有關。
必須注意的是,以上參數均是器件的宏觀參數,損傷程度依賴于質子在器件內沉積的總能量。但對于CCD和CMOS圖像傳感器等光電成像器件,還有一種微觀參數,熱像素,其退化程度與質子在器件材料中能量沉積的個體差異有關,因此僅憑借NIEL的大小不足以評估器件的位移損傷效應。熱像素的質子輻射效應現象首先從圖像傳感器像素陣列的3維圖中發現,圖7和圖8分別為輻照注量為5×1010cm-2時,60,100 MeV質子輻照前后CCD像素陣列暗場下輸出信號的3D圖。其中,有尖刺的一半圖像為輻照后的像素。由圖7和圖8可見,輻照后,像素中出現大量的尖刺,稱為暗信號尖峰,即熱像素。尖刺的數目和灰度值水平分布沒有一定的規律,依賴于每個像素內質子能量沉積的隨機分布,與NIEL沒有對應關系。

圖7 輻照注量為5×1010 cm-2時, 60 MeV質子輻照前后CCD像素陣列暗場下輸出信號的3D圖Fig.7 3D image of the output signal of the CCD pixel arraywithout illumination before and after 60 MeV proton irradiation with fluence of 5×1010 cm-2

圖8 輻照注量為5×1010 cm-2時, 100 MeV質子輻照前后CCD像素陣列暗場下輸出信號的3D圖Fig.8 3D image of the output signal of the CCD pixel arraywithout illumination before and after 100 MeV proton irradiation with fluence of 5×1010 cm-2
輻照注量為5×1010cm-2時,60,100 MeV質子輻照前后CCD像素陣列暗場下的熱像素分布如圖9和圖10所示。其中,亮點為熱像素,沒有亮點的部分為輻照前的圖像。由圖9和圖10可見,盡管是不同能量的質子輻照導致的現象,但進行比較,由于熱像素分布不均勻,當截取的區域不同時,熱像素的統計結果顯著不同。因此,對于熱像素這樣表征圖像傳感器像素間微觀差異的參數,不能采用NIEL尺度進行評估,而應針對具體器件類型,采用指定的質子能量,并選擇與應用有關的特性參數進行輻照試驗評估。

圖9 輻照注量為5×1010 cm-2時,60 MeV質子輻照前后CCD像素陣列暗場下的熱像素分布Fig.9 Hot pixels distribution of CCD pixel array withoutillumination before and after 60 MeV proton irradiation with fluence of 5×1010 cm-2

圖10 輻照注量為5×1010 cm-2時,100 MeV質子輻照前后CCD像素陣列暗場下的熱像素分布Fig.10 Hot pixels distribution of CCD pixel array withoutillumination before and after 100 MeV proton irradiation with fluence of 5×1010 cm-2
3 小結
CCD是目前空間光電衛星及光學載荷上廣泛采用的一種高靈敏、低噪聲的光電成像器件,高能質子導致的位移損傷效應是CCD空間應用面臨的主要威脅。為保障空間應用的可靠性,必須基于具體軌道環境的質子能譜分布情況,進行CCD位移損傷效應地面模擬試驗評估。然而,地面模擬試驗條件及敏感參數還需進行深入研究。本文針對空間環境中高能質子輻射導致CCD性能退化評估的問題,通過開展能量高于60 MeV的質子輻照試驗,考察了CCD的重要性能參數暗電流和電荷轉移效率受質子輻照的退化情況及質子輻照后CCD的熱像素產生情況。研究發現:高能質子輻照導致CCD性能退化的敏感參數包括暗電流、電荷轉移效率和熱像素,飽和輸出電壓對質子輻照不敏感;輻照注量為5×1010cm-2,60 MeV和100 MeV的質子輻照后,暗電流和電荷轉移效率出現了一定程度的退化,然而,更加顯著的退化表現為產生了大量的熱像素。通過采用NIEL等效分析發現:60 ,100 MeV質子輻照導致暗電流和電荷轉移效率的退化可通過NIEL進行等效,輻照注量相同的情況下,質子能量越低,其在CCD內產生的位移損傷劑量越大,暗電流和電荷轉移效率退化越嚴重;而熱像素產生則不能等效,輻照注量相同的情況下,60 MeV質子導致的熱像素沒有顯著地多于100 MeV質子,另一方面,質子輻照后圖像中熱像素的分布不均勻,圖像不同區域內熱像素的數量明顯不同。因此,在進行高能質子輻照導致CCD性能退化評估時,需重點考察熱像素產生情況,且需針對實際應用的輻射環境,采用合適的質子能量進行更具針對性的輻照試驗。
致謝
感謝西北核技術研究所王忠明給予的指導和幫助。

