基于POLO鈍化接觸結(jié)構(gòu)的晶硅電池技術(shù)及其研究進展
張?zhí)旖埽∮拢绖偅瑓?翔,高嘉慶,張 博,楊愛靜,劉軍保,李躍恒,林 濤
(1.青海黃河上游水電開發(fā)有限責任公司西安太陽能電力分公司,西安 710100;2.西安理工大學自動化與信息工程學院,西安 710048)
0 引 言
能源危機的逐漸加劇使世界在未來幾十年將轉(zhuǎn)向開發(fā)可再生能源,據(jù)國際可再生能源機構(gòu)(IRENA)預計,到2050年可再生能源在發(fā)電中的占比份額將達到86%,成為全球最大的能源載體,而光伏的年度新增裝機量將達到360 GW[1],因此對高效太陽能電池的需求將會大幅度增加。過去幾十年全球約90%的太陽能電池技術(shù)是基于鋁背表面場(Al-BSF)設(shè)計[2]。雖然這種電池結(jié)構(gòu)制作工藝相對簡單,但是電池轉(zhuǎn)換效率普遍低于20%[3-4]。隨著技術(shù)的進一步發(fā)展,通過引入氧化鋁鈍化技術(shù)制備的發(fā)射極與背表面鈍化電池(passivated emitter and rear cell, PERC)產(chǎn)業(yè)化轉(zhuǎn)換效率超過23%,成為目前主流的產(chǎn)業(yè)化晶硅電池技術(shù)[2]。但是PERC電池技術(shù)中金屬與晶硅表面直接接觸產(chǎn)生的金屬復合限制了其進一步提升效率的潛力。為進一步提高電池的轉(zhuǎn)換效率,世界各研究機構(gòu)及企業(yè)開始紛紛布局下一代晶硅電池技術(shù),諸如背接觸結(jié)構(gòu)設(shè)計及異質(zhì)結(jié)技術(shù)等為晶硅電池提供了高轉(zhuǎn)換效率(最高可達26.7%的效率[5]),但是技術(shù)導入成本相對較高,且需要對當前主流的PREC電池制作設(shè)備、材料及工藝制程進行重大改變,產(chǎn)業(yè)升級困難。POLO結(jié)構(gòu)是基于晶硅基體表面依次生長一層極薄的界面氧化層與多晶硅(poly-Si)層所形成的鈍化接觸結(jié)構(gòu)。該鈍化接觸結(jié)構(gòu)不僅起到了良好的表面鈍化特性,同時避免了金屬與晶硅表面的直接接觸,極大地降低了金屬接觸區(qū)域的復合。理論研究表明,基于POLO技術(shù)的電池結(jié)構(gòu)理論效率可達28.7%[6],幾乎接近于晶硅電池的理論極限效率29.43%[7]。近年來ISFH、Fraunhofer及隆基等各研究機構(gòu)和廠商陸續(xù)刷新了基于POLO技術(shù)制備的隧穿氧化層鈍化接觸(TOPCon)電池的轉(zhuǎn)換效率,表1為基于POLO技術(shù)制備的晶硅太陽能電池轉(zhuǎn)換效率一覽表。由表1可知,n型TOPCon電池的實驗室效率高達25.70%[8],p型背結(jié)TOPCon電池的實驗室轉(zhuǎn)換效率為26.00%[9];天合、晶科及隆基等商業(yè)化廠商在Cz硅片上制作的產(chǎn)業(yè)化大面積TOPCon電池轉(zhuǎn)換效率超過24.5%;將POLO技術(shù)應用于叉指狀背接觸(IBC)電池制作獲得的實驗室電池轉(zhuǎn)換效率高達26.10%[10]。同時POLO結(jié)構(gòu)的制作只需要引入多晶硅沉積設(shè)備及增加部分濕法清洗設(shè)備。由此可見將POLO技術(shù)應用于晶硅電池的產(chǎn)業(yè)化生產(chǎn)不僅具有極高的效率提升潛力,而且易于將現(xiàn)有的主流PERC電池產(chǎn)線直接升級為TOPCon電池產(chǎn)線,具有很大的商業(yè)潛力。
1 POLO結(jié)構(gòu)載流子傳輸機理
POLO結(jié)構(gòu)中載流子越過界面SiOx層的方式主要是通過量子隧穿作用或直接穿過局部界面SiOx層形成的針孔(Pinhole)結(jié)構(gòu)而進行傳輸[15]。通常POLO結(jié)構(gòu)完成沉積后先經(jīng)高溫退火處理(退火溫度為1 050 ℃[16]),主要目的是在界面SiOx層形成一定比例的具有納米尺寸的Pinhole結(jié)構(gòu)[17],從而增強載流子的傳輸效應[18]。研究表明:在n+& p+poly-Si/SiOx結(jié)構(gòu)中界面SiOx層的厚度<2 nm時,電流通過Pinhole結(jié)構(gòu)及隧穿作用共同收集[19];當界面SiOx層的厚度>2 nm時,由于氧化層的厚度較厚以至載流子發(fā)生隧穿效應的幾率較小,載流子的傳輸主要是通過界面SiOx層局部形成的Pinhole結(jié)構(gòu)進行有效傳輸[20],載流子的傳輸方式如圖1(a)所示。Folchert等[21]通過實驗數(shù)據(jù)表明,當SiOx層的厚度為2.1 nm時,在1 050 ℃條件下退火后通過Pinhole結(jié)構(gòu)傳輸?shù)碾娏髡伎傠娏鞯陌俜直瘸^94%,作為比較,當生長的SiOx層厚度為1.7 nm時,同時在700 ℃下退火后通過Pinhole結(jié)構(gòu)傳輸?shù)碾娏髡伎傠娏鞯陌俜直炔坏?5%。
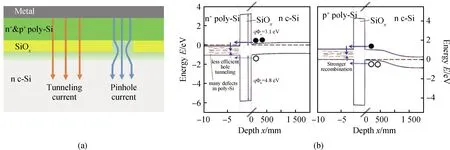
圖1 POLO結(jié)構(gòu)載流子的傳輸機理[22-23]Fig.1 Carrier transport mechanism of the POLO structure[22-23]
由圖1(b)POLO結(jié)構(gòu)的能帶圖可知,在n+-poly-Si/SiOx結(jié)構(gòu)中由于功函數(shù)不同致使界面處能帶產(chǎn)生彎曲,使得電子累積,而空穴無法累積;n+-poly-Si與硅基體之間的能帶差異可以使得電子隧穿后有足夠的能級可以占據(jù),更易于發(fā)生隧穿效應,而空穴占據(jù)的價帶邊緣位置處于n+-poly-Si的禁帶區(qū)域,不易發(fā)生隧穿效應。同理,在p+-poly-Si/SiOx結(jié)構(gòu)中由于功函數(shù)不同引起界面處能帶產(chǎn)生彎曲,使得空穴累積,而電子無法累積;p+-poly-Si與硅基體之間的能帶差異可以使得空穴隧穿后有足夠的能級可以占據(jù),更易于發(fā)生隧穿效應。但是界面SiOx層對電子的阻擋勢壘為3.1 eV,對空穴的阻擋勢壘為4.8 eV,界面氧化SiOx層對電子的阻擋勢壘明顯低于對空穴的阻擋勢壘。因此相比于p+-poly-Si/SiOx的鈍化結(jié)構(gòu),n+-poly-Si/SiOx結(jié)構(gòu)具有更加優(yōu)異的隧穿鈍化特性。
2 POLO結(jié)構(gòu)鈍化接觸特性的表征參數(shù)
為了量化表征POLO結(jié)構(gòu)對基體表面的鈍化特性,一般通過測試隱開路電壓值iVoc、表面復合電流密度值J0及有效少子壽命值τeff等來進行定量描述。這些參數(shù)值可通過特殊的結(jié)構(gòu)設(shè)計與制作,采用準穩(wěn)態(tài)光電導衰減的方法(WCT-120, Sinton Consulting)測試得到,其中iVoc、τeff與J0相關(guān)的公式為[24]:
(1)
(2)
式中:W為樣片厚度,τbulk為體少子壽命,τAuger為俄歇復合少子壽命,Δn為過剩載流子濃度,k為玻爾茲曼常數(shù),T為測試溫度,q為單元電荷,Nd為基體摻雜濃度,ni為本征載流子濃度。
當POLO結(jié)構(gòu)表面與金屬電極形成接觸時,接觸區(qū)域的復合電流密度值J0c及接觸電阻率值ρc用于表征金屬與半導體的接觸特性。為了定量表征POLO結(jié)構(gòu)鈍化接觸區(qū)域載流子的選擇特性, Brendel等[21,25]引入了載流子的選擇特性值S(或S10),且該值依賴于接觸電阻率ρc及接觸區(qū)域復合電流密度值J0c。
(3)
(4)
以電子選擇端載流子的選擇性為例,為獲得較高的電子選擇性,需保證端面電子具有遠大于空穴的電流密度和濃度梯度。其中J0c越小表示因空穴反向傳輸導致的復合越低,ρc越小表示電子傳輸?shù)碾娮钃p失越小[26]。
3 POLO結(jié)構(gòu)的制備
POLO結(jié)構(gòu)的制備主要包括:(1)生長界面SiOx層;(2)沉積本征非晶硅/多晶硅薄膜;(3)本征非晶硅/多晶硅薄膜的再結(jié)晶及摻雜;(4)氫化處理。圖2為POLO結(jié)構(gòu)的基本制作工藝流程與制備方法。在POLO結(jié)構(gòu)實際制作時通常將以上兩個或多個制作工藝集成于同一設(shè)備依次完成。

圖2 POLO結(jié)構(gòu)的基本制作工藝流程與制備方法Fig.2 Basic process flow and preparation method of POLO structure
3.1 界面氧化層的制備
界面氧化層是隔離多晶硅層與硅基體表面的關(guān)鍵界面層,在摻雜過程中起到抑制擴散的作用以減少過多的摻雜源在高溫下滲透進入硅基體的內(nèi)部,同時防止多晶硅薄膜直接沉積至硅基體表面[27]。除了極少數(shù)例外[28-29],SiOx薄膜(1~3 nm)一般充當界面氧化層。SiOx層的制備方式主要包括濕化學氧化方法(HNO3、O3等的氧化)、低溫熱氧化法(T=580~620 ℃)、等離子體原位生長法。濕化學氧化法是通過將樣片浸泡在溫度為110 ℃的熱硝酸溶液(68%,質(zhì)量分數(shù))中產(chǎn)生自限制的約1.4 nm的薄膜氧化層[30]或者置于溫度為60 ℃,體積分數(shù)比為3∶1的濃硝酸(68%,質(zhì)量分數(shù))與濃硫酸的混合溶液中形成SiOx薄層[31]。其次,紫外/臭氧光氧化和去離子水中臭氧氧化也可以進行界面SiOx層的制備[32]。低溫熱氧化法是在恒定溫度為550~650 ℃的氧氣氛圍中短時間熱生長形成SiOx層[27]。因低溫熱氧化法得到的SiOx層質(zhì)量高,致密性好,厚度易于控制,特別是當界面SiOx層的厚度超過1.5 nm時,低溫熱氧化法是應用最多的生長方式。
3.2 非晶硅/多晶硅層沉積
非晶硅/多晶硅的沉積主要包括低壓化學氣相沉積(LPCVD)[33]、等離子體化學氣相沉積(PECVD)、常壓化學氣相沉積(APCVD)及物理氣相沉積(PVD)等技術(shù)。當前產(chǎn)業(yè)化應用最為成熟的為LPCVD沉積技術(shù),該技術(shù)是通過在低壓石英管中熱裂解硅烷(550~650 ℃)的方式完成多晶硅層的沉積,LPCVD沉積設(shè)備反應腔截面如圖3所示。盡管該技術(shù)在單面沉積多晶硅層時會在片源的另一面產(chǎn)生多晶硅層的繞鍍,繞鍍的多晶硅層因寄生吸收效應會損失電流密度,且影響電池的外觀,但是只需要增加濕法清洗工藝去除繞鍍產(chǎn)生的多晶硅層就可以實現(xiàn)POLO結(jié)構(gòu)的制備。雖然LPCVD沉積技術(shù)由于濕法清洗工藝步驟引入增加了電池制程的復雜性,但是該技術(shù)沉積的多晶硅層厚度在片內(nèi)及片間均勻性好,電池端良率較高,工藝時間相對較短,生產(chǎn)效率高。同時LPCVD設(shè)備具有產(chǎn)能大、易于維護等優(yōu)勢,是一個比較成熟的設(shè)備,為目前TOPCon電池廠商布局的主流技術(shù)路線。
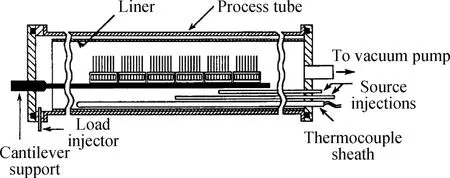
圖3 LPCVD沉積設(shè)備反應腔截面圖[33]Fig.3 Schematic cross section of LPCVD reactor[33]
PECVD技術(shù)是一種在低溫下(<500 ℃)等離子體裂解硅烷和其他前驅(qū)體的定向沉積技術(shù),且沉積速率快,可用于沉積氫化非晶硅(a-Si∶H)薄膜[26],PECVD沉積設(shè)備反應腔截面如圖4所示,盡管在a-Si∶H薄膜的沉積中高濃度的氫對鈍化特性的提升是必要的,但它容易導致沉積的多晶硅薄膜形成氣泡,特別是對于沉積較厚的非晶硅薄膜可能出現(xiàn)爆膜以及造成粉塵的污染。但是該技術(shù)可以有選擇性地單面生長無繞鍍的非晶硅薄膜,應用于POLO鈍化接觸電池制作中將不再需要濕法清洗工藝去除因繞鍍產(chǎn)生的非晶硅層,減少了部分濕法清洗工藝步驟。因此,光伏研究人員及設(shè)備制造廠商正在積極解決非晶硅薄膜沉積可能出現(xiàn)的爆膜及粉塵污染的問題,以期將PECVD沉積技術(shù)大規(guī)模應用于產(chǎn)業(yè)化生產(chǎn)[34]。而且目前許多研究機構(gòu)已經(jīng)報道了采用PECVD與LPCVD沉積技術(shù)制備的POLO鈍化接觸結(jié)構(gòu)獲得了相同的鈍化水平[27-28]。
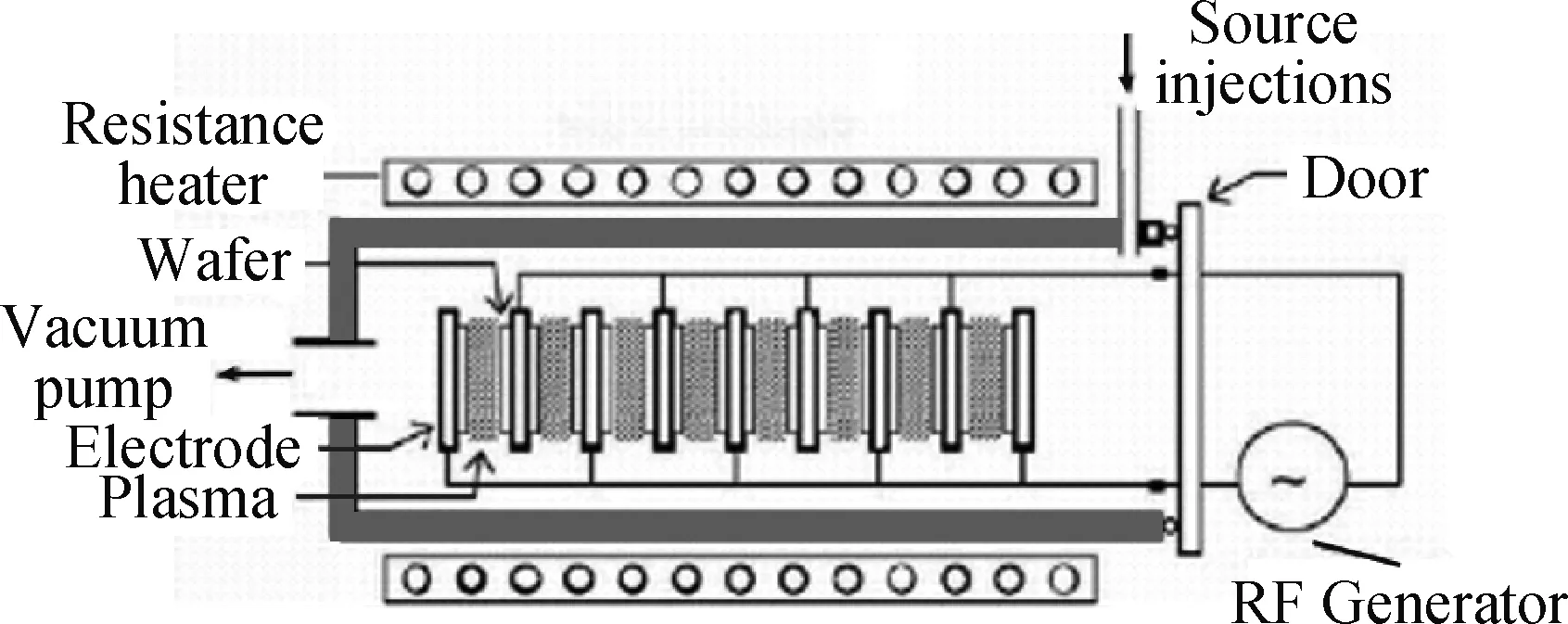
圖4 PECVD沉積設(shè)備反應腔截面圖Fig.4 Schematic cross section of PECVD reactor
同樣APCVD及熱絲CVD技術(shù)也可以用于多晶硅的沉積,但是這兩種沉積方式并不常見[35-36]。濺射或電子束蒸發(fā)PVD技術(shù)是一種很有潛力的單面沉積方法。與化學氣相沉積技術(shù)相比,PVD的主要優(yōu)點是沒有危險的前驅(qū)氣體(如硅烷、二硼烷等),能夠在低溫(室溫下)、低氫或無氫含量的情況下沉積致密薄膜(消除起泡問題)[37-38]。盡管該技術(shù)在工業(yè)上沉積多晶硅薄膜的應用仍處于發(fā)展階段,但該技術(shù)已經(jīng)在異質(zhì)結(jié)(SHJ)電池制作中用于沉積透明導電氧化物薄膜。相比于其他沉積技術(shù),PVD沉積不僅可以實現(xiàn)薄膜的單面沉積,而且沉積的膜層致密性高,是未來最具發(fā)展?jié)摿Φ亩嗑Ч璩练e技術(shù)[39]。
3.3 多晶硅層摻雜
多晶硅層的摻雜水平對poly-Si/SiOx結(jié)的電學特性有很大的影響。當多晶硅層摻雜源濃度較低(低于1019/cm3)時,復合電流密度值J0和接觸電阻率值ρc較高,然而表面較高的摻雜源濃度(高于1021/cm3)將導致界面氧化層的破壞及過多的摻雜源滲透進入硅基體內(nèi)部,增加poly-Si/SiOx結(jié)處的復合電流密度值J0。多晶硅摻雜方式分為原位摻雜與非原位摻雜。原位摻雜是將PH3、B2H6/BCl3與硅烷通過適當?shù)牧髁勘瓤刂圃诙嗑Ч璞∧こ练e過程中同時實現(xiàn)n型和p型多晶硅層的摻雜。然而原位摻雜由于摻雜源氣體的引入抑制了非晶硅的成膜速率,例如在LPCVD及PECVD沉積系統(tǒng)中,原位摻雜多晶硅的沉積速率比未摻雜多晶硅沉積速率低一個數(shù)量級,最終導致薄膜厚度橫向均勻性較差。另外它要兼容均勻性和方阻,所以控制難度較大。但是在PVD沉積技術(shù)中,原位摻雜可以通過使用固體源來實現(xiàn),例如,使用具有硼元素的靶材進行濺射的方法來實現(xiàn)原位摻雜。因此,PVD沉積系統(tǒng)通過原位摻雜的方式可以實現(xiàn)很好的摻雜源控制。非原位摻雜方式是首先沉積一層本征的多晶硅薄膜,然后再通過高溫熱擴散的方式實現(xiàn)多晶硅層的摻雜,常見的以POCl3蒸氣為n型摻雜源,以BBr3或BCl3蒸氣為p型摻雜源。此外,液體旋涂法或噴涂摻雜源,摻雜源墨水或摻雜源漿料還可用于形成圖形化的非原位摻雜。特別地采用離子注入的方式可以精確控制摻雜結(jié)深及橫向摻雜濃度的分布,ISFH采用該摻雜技術(shù)實現(xiàn)了高達26.1%晶硅太陽能電池轉(zhuǎn)換效率[6]。
如上所述,多晶硅薄膜的結(jié)晶程度、摻雜源穿透界面氧化層進入硅基體內(nèi)摻雜輪廓的控制以及界面氧化層的性能共同決定了poly-Si/SiOx結(jié)的電學性能,這些在很大程度上取決于摻雜源激活步驟的溫度和時間。
3.4 POLO結(jié)構(gòu)的氫化處理
摻雜的多晶層表面缺陷較多,需要進一步氫化處理以提高表面的鈍化特性。氫化處理最常用的方法是在晶硅表面沉積一層SiNx∶H薄膜、Al2O3薄膜或SiNx∶H薄膜與Al2O3疊層鈍化膜,然后再進行燒結(jié)處理使得膜層中的氫釋放出來達到鈍化的目的。特別是SiNx∶H薄膜不僅能鈍化晶硅表面,而且具有減反射作用。除此之外,水汽處理及混氫氣體退火均可以實現(xiàn)氫化處理[40]。研究表明POLO結(jié)構(gòu)表面沉積一層SiNx∶H薄膜后進行燒結(jié)氫化處理時,對于n型摻雜的POLO結(jié)構(gòu)與p型摻雜的POLO結(jié)構(gòu)燒結(jié)前后所表現(xiàn)的鈍化特性恰好相反,即SiNx∶H/n+-poly/SiOx鈍化結(jié)構(gòu)燒結(jié)后iVoc值略有降低(iVoc值下降2~5 mV),而對于SiNx∶H/p+-poly/SiOx鈍化結(jié)構(gòu)燒結(jié)后iVoc值有提升(iVoc值提升3~5 mV)[41],這一結(jié)果與本課題組先前的工作中得到的結(jié)論是一致的[42],但是造成這一現(xiàn)象的原因尚未形成統(tǒng)一的解釋。
4 POLO鈍化接觸結(jié)構(gòu)特性分析與研究進展
4.1 多晶硅層對光學吸收特性的影響
沉積的多晶硅層厚度對POLO結(jié)的性能具有顯著的影響。首先,摻雜的多晶硅與晶硅基體的吸收系數(shù)基本相同,多晶硅層吸收的光生載流子由于復合而產(chǎn)生了損失(盡管最近的一項研究表明,多晶硅層產(chǎn)生的少數(shù)載流子可能會被收集到[43]),研究數(shù)據(jù)表明:當POLO結(jié)應用于電池的前表面進行吸光時,多晶硅層的厚度每增加10 nm,由于寄生吸收效應產(chǎn)生的短路電流密度值損失0.4~0.5 mA/cm2[44];當POLO結(jié)應用于電池的背表面時,對于145 nm厚度的多晶硅層產(chǎn)生的短路電流密度值損失0.3~0.4 mA/cm2[45],且這一結(jié)果依賴于多晶硅層的摻雜濃度[46]。Reiter等[44]詳細研究了本征多晶硅層及不同摻雜水平條件下,n型與p型多晶硅層的光學吸收系數(shù),結(jié)果表明多晶硅層的摻雜濃度與該層對紅外波段的光吸收系數(shù)成正比。為了減小多晶硅層產(chǎn)生的寄生吸收損失,沉積的多晶硅層厚度通常小于200 nm,或選擇性地減薄或去除非金屬接觸區(qū)域的多晶硅層[47]。
4.2 表面形貌結(jié)構(gòu)對鈍化特性的影響
基體表面形貌結(jié)構(gòu)對POLO結(jié)表面復合電流密度的影響如圖5所示,每一個數(shù)據(jù)點代表了一項研究結(jié)果,由統(tǒng)計結(jié)果可知基于絨面結(jié)構(gòu)制作的POLO結(jié)表面復合電流密度值J0明顯大于基于拋光表面結(jié)構(gòu)獲得的復合電流密度值J0,即基于拋光表面制作的POLO結(jié)鈍化性明顯優(yōu)于基于絨面結(jié)構(gòu)制作的POLO結(jié),特別是對于p型摻雜的p+-poly/SiOx結(jié)構(gòu),基于絨面結(jié)構(gòu)制作的POLO結(jié)相比于基于拋光面結(jié)構(gòu)制作的POLO結(jié),其J0值至少增加了一個數(shù)量級;基于相同表面形貌結(jié)構(gòu)制作的POLO結(jié)構(gòu),n+-poly/SiOx結(jié)構(gòu)具有更低的J0值。由圖5可知基于絨面結(jié)構(gòu)制作的p+-poly/SiOx結(jié)J0值大于22 fA/cm2,而基于絨面結(jié)構(gòu)制作的常規(guī)p+摻雜結(jié)J0值可以小于15 fA/cm2[48-49]。因此絨面結(jié)構(gòu)上制作p+-poly/SiOx結(jié)其表面復合更高,這一結(jié)果也限制了絨面結(jié)構(gòu)上進行p+-poly/SiOx結(jié)的制作,特別是限制了將p+-poly/SiOx結(jié)直接應用于晶硅電池的前表面進行雙面TOPCon電池制作[50]。

圖5 基體表面形貌結(jié)構(gòu)對POLO結(jié)復合電流密度的影響[6]Fig.5 Influence of substrate surface morphology on the recombination current density of POLO structure[6]
4.3 POLO鈍化接觸結(jié)構(gòu)金屬化特性
POLO結(jié)構(gòu)中摻雜源濃度分布對接觸電極及接觸區(qū)域的復合影響至關(guān)重要。多晶硅層表面的摻雜濃度越高,則接觸電阻率值ρc越小;當多晶硅層表面摻雜濃度一致時,隨著摻雜源進入硅基體內(nèi)的結(jié)深增加,接觸區(qū)域的復合電流密度值J0c越小,同時非接觸區(qū)域的復合電流密度值J0逐漸增大[51]。對于金屬與多晶硅接觸區(qū)域的復合電流密度值J0c可以粗略估算為[52]:
(5)
式中:Ac為電極接觸面積,Ne是隨距電極距離x變化的有效摻雜率,Db為相應的少數(shù)載流子擴散系數(shù),式中的積分區(qū)間為整個摻雜薄層。由式(5)可知,POLO結(jié)構(gòu)中整個摻雜濃度分布薄層決定了復合電流密度值J0c的大小。當POLO結(jié)構(gòu)表面與金屬形成接觸時,隨著摻雜多晶硅層厚度的增加,復合電流密度值J0c將呈現(xiàn)逐漸減小的趨勢,且復合電流密度值J0c對n型摻雜多晶硅層的厚度更加敏感,這一結(jié)果已被實驗所證實[53]。其次,多晶硅層的摻雜類型不同,相應的金屬漿料的選型也決定了復合電流密度值J0c。研究數(shù)據(jù)表明采用燒穿型金屬漿料與多晶硅表面形成接觸時,銀漿與n型摻雜多晶硅表面接觸,銀鋁漿與p型摻雜多晶硅表面接觸時獲得的J0c值更小[41]。
4.4 POLO鈍化接觸結(jié)構(gòu)的研究進展
圖6為n型晶硅表面采用不同的摻雜結(jié)構(gòu)獲得的鈍化接觸特性。由圖6可知不同的摻雜結(jié)構(gòu)設(shè)計可以使接觸電阻率ρc基本達到同一數(shù)量級。常規(guī)的n+型摻雜結(jié)表面復合電流密度值J0為22 fA/cm2,金屬接觸區(qū)域復合電流密度值J0c為1 400 fA/cm2;重摻雜形成n++型摻雜結(jié),則金屬接觸區(qū)域復合電流密度值J0c可減小至500 fA/cm2左右,但是n++型摻雜結(jié)表面復合電流密度值J0n++增加至100 fA/cm2。然而,在晶硅表面采用n型摻雜的POLO結(jié)可以使得表面復合電流密度值J0低至1~3 fA/cm2,金屬接觸區(qū)域復合電流密度值J0c值降低至20~30 fA/cm2,n型摻雜的POLO結(jié)相比于常規(guī)的n型摻雜結(jié),其表面復合電流密度值J0與接觸區(qū)域復合電流密度值J0c均降低1~2個數(shù)量級。研究報道SERIS的Nandakumar等[34]基于PECVD設(shè)備制作的n型摻雜的POLO結(jié)構(gòu)獲得的表面復合電流密度值J0低至3 fA/cm2,同時金屬接觸區(qū)域復合電流密度值J0c低至20 fA/cm2。此研究結(jié)果是目前報道的金屬Ag電極與n+-poly-Si形成接觸后所獲得的復合電流密度值J0c的最小值。
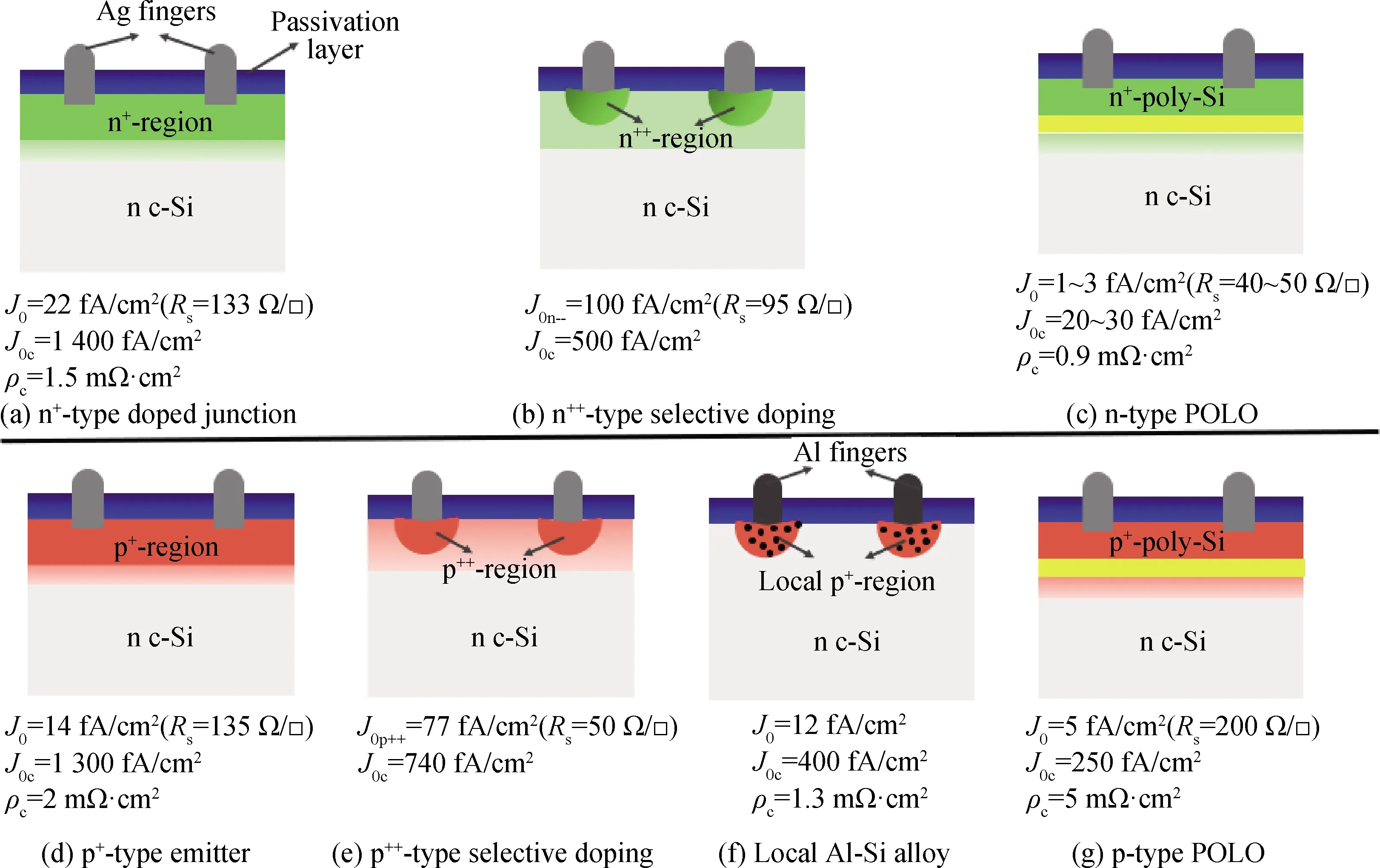
圖6 n型晶硅表面采用不同的摻雜結(jié)構(gòu)獲得的鈍化接觸特性[12,45,54-57]Fig.6 Passivation contact characteristics obtained by different doped structure based on n-type Si substrate[12,45,54-57]
常規(guī)的p+型摻雜結(jié)表面復合電流密度值J0為14 fA/cm2,金屬接觸區(qū)域復合電流密度值J0c為1 300 fA/cm2;重摻雜形成p++型摻雜結(jié),則金屬接觸區(qū)域復合電流密度值J0c可減小至740 fA/cm2左右,但是p++型摻雜結(jié)表面復合電流密度值J0p++增加至77 fA/cm2;金屬鋁電極與硅接觸形成p+型摻雜可以使得接觸區(qū)域復合電路密度值J0c降低至400 fA/cm2,同時表面復合電流密度值J0可減小至12 fA/cm2。但是在晶硅表面采用p型摻雜的POLO結(jié)可以使得表面復合電流密度值J0值達到5 fA/cm2,金屬接觸區(qū)域復合電流密度值J0c值減小至250 fA/cm2。不論是常規(guī)的p+型摻雜結(jié),還是金屬鋁與硅的直接接觸結(jié)構(gòu),p型摻雜的POLO結(jié)構(gòu)仍具有明顯的鈍化接觸優(yōu)勢。Sebastian等[58]基于p型硅片制作的p型POLO結(jié)構(gòu)采用商業(yè)化金屬漿料形成接觸可以使得接觸區(qū)域復合電流密度值J0c低至60 fA/cm2,接觸電阻率為4 mΩ·cm2,是當前報道的p型摻雜POLO結(jié)構(gòu)形成接觸獲得的最小J0c值。
5 POLO電池技術(shù)的難點
盡管POLO結(jié)構(gòu)具有優(yōu)異的表面鈍化接觸特性,但是基于該結(jié)構(gòu)的電池技術(shù)仍然存在以下技術(shù)難點:(1)多晶硅層的寄生吸收效應產(chǎn)生光學損失,特別是將POLO結(jié)應用于晶硅電池的吸光表面會大幅度降低電池的短路電流密度值,這一結(jié)果限制了POLO結(jié)構(gòu)在電池吸光表面的應用,為此有研究報道在雙面鈍化接觸電池結(jié)構(gòu)設(shè)計中將POLO結(jié)選擇性地應用于電池吸光表面的金屬接觸區(qū)域[47,59]。為解決這一技術(shù)難點在進行POLO結(jié)制作時可選用禁帶寬度較大(>1.12 eV)的SiCx膜層取代多晶硅膜層,或在多晶硅層沉積時摻入微量的O或C等元素,增大多晶硅層的禁帶寬度,減少光學寄生吸收損失[60-62]。(2)多晶硅層沉積過程中產(chǎn)生的繞鍍的清洗是限制POLO電池技術(shù)產(chǎn)業(yè)化效率與良率的關(guān)鍵點之一[63]。產(chǎn)生繞鍍的主要原因是當前產(chǎn)業(yè)化大多采用LPCVD方式沉積多晶硅層,多晶硅沉積時在舟的每個卡槽內(nèi)插雙片,片源背靠背放置,正是由于這種背靠背放置的片源之間存在縫隙,而且整個爐管內(nèi)的氛圍存在不均現(xiàn)象,導致片間正面繞鍍產(chǎn)生的多晶硅層薄厚不一,且繞鍍的多晶硅層在片內(nèi)呈現(xiàn)邊緣厚、中心薄的現(xiàn)象。在后續(xù)濕法清洗去除繞鍍產(chǎn)生的多晶硅層時,加強清洗易于產(chǎn)生片源繞鍍面中心位置拋光的現(xiàn)象,清洗程度不夠易產(chǎn)生邊角位置繞鍍的多晶硅層未徹底去除的情況。因此在清洗過程中不易找到合適的工藝窗口,繞鍍的多晶硅層殘留將影響電池的效率及良率。為解決這一技術(shù)難點,開發(fā)無繞鍍的多晶硅沉積方式是最有效的解決辦法之一,例如采用PECVD或PVD的方式單面沉積多晶硅層,目前已有不少設(shè)備廠商正在積極解決這一問題;另一方面也可以基于現(xiàn)有LPCVD設(shè)備在單個卡槽內(nèi)插單片雙面沉積多晶硅層,然后通過濕法清洗統(tǒng)一去除另一表面沉積的多晶硅層,盡管這一方式對產(chǎn)能有影響,但是同樣可以很好地解決由于繞鍍清洗不均勻產(chǎn)生的問題。(3)POLO結(jié)構(gòu)在金屬化過程中存在金屬漿料燒穿的風險。目前產(chǎn)業(yè)化POLO電池的金屬電極普遍采用絲網(wǎng)印刷燒穿型漿料的方式完成制作,通過該種方式形成歐姆接觸時,較薄的多晶硅層會增加金屬元素燒穿界面氧化層而進入硅基體的風險,從而增加接觸區(qū)域的復合電流密度值J0c,即當POLO結(jié)構(gòu)應用于電池的背表面場易于引起背表面的鈍化失效,若POLO結(jié)應用于電池的發(fā)射極區(qū)域易于引起短路。因此在POLO電池制作時可適當?shù)卦黾咏饘俳佑|區(qū)域多晶層的厚度或選用燒穿型較弱的金屬漿料;另一方面可以在POLO結(jié)構(gòu)表面直接電鍍金屬電極形成歐姆接觸,避免金屬漿料的燒穿風險。
6 結(jié)語與展望
本文主要綜述了POLO鈍化接觸結(jié)構(gòu)中載流子的傳輸機理、鈍化接觸特性量化參數(shù)表征的方法,對比了POLO結(jié)構(gòu)制備中界面氧化層生長,多晶硅層的沉積、摻雜及氫化處理的方法。最后分析了POLO結(jié)構(gòu)中多晶硅層的寄生吸收效應、硅基體表面形貌及多晶硅層摻雜濃度分布對鈍化接觸特性的影響,并簡述了POLO鈍化接觸技術(shù)的研究進展及當前POLO電池制作面臨的技術(shù)難點。由以上結(jié)果可知,常規(guī)的摻雜鈍化結(jié)構(gòu)鈍化晶硅表面獲得的復合電流密度值J0大于14 fA/cm2,金屬接觸區(qū)域復合電流密度值J0c大于1 300 fA/cm2;n型摻雜的POLO結(jié)構(gòu)鈍化晶硅表面獲得的復合電流密度值J0低至1 fA/cm2,金屬接觸區(qū)域復合電流密度值J0c低至20 fA/cm2;p型摻雜的POLO結(jié)構(gòu)鈍化晶硅表面獲得的復合電流密度值J0低至5 fA/cm2,金屬接觸區(qū)域復合電流密度值J0c低至60 fA/cm2。因此,POLO結(jié)構(gòu)具有更加優(yōu)異的表面鈍化特性及極小的金屬接觸復合。將POLO鈍化接觸技術(shù)應用于大面積晶硅太陽能電池制備獲得的電池轉(zhuǎn)換效率已超過24.5%,且制作過程可以承受高溫工藝,與當前主流的PERC晶硅電池產(chǎn)業(yè)化設(shè)備兼容性強,是未來極具產(chǎn)業(yè)化潛力的鈍化接觸技術(shù)方案。

