增強型Cascode 結構氮化鎵功率器件的高能質子輻射效應研究
白如雪 郭紅霞 張鴻 王迪 張鳳祁 潘霄宇 馬武英 胡嘉文 劉益維 楊業 呂偉 王忠明
1) (湘潭大學材料與工程學院,湘潭 411105)
2) (西北核技術研究所,西安 710024)
針對增強型共柵共源(Cascode)級聯結構和耗盡型AlGaN/GaN 功率器件,利用60 MeV 能量質子開展輻射效應研究.獲得了經質子輻照后器件電學性能的退化規律,并與常規耗盡型HEMTs 器件輻照后的電學性能進行了比較,發現增強型Cascode 結構器件對質子輻照更加敏感,分析認為級聯硅基MOS 管的存在是其對質子輻照敏感的主要原因.質子輻照使硅基MOS 管柵氧化層產生大量凈的正電荷,誘導發生電離損傷效應,使其出現閾值電壓負向漂移及柵泄漏電流增大等現象.利用等效(60 MeV 能量質子,累積注量1×1012 p/cm2)劑量的 60Co γ 射線輻射器件得到電離損傷效應結果,發現器件的電學性能退化規律與60 MeV 能量質子輻照后的退化規律一致.通過蒙特卡羅模擬得到質子入射在Cascode 型器件內誘導產生的電離能損和非電離能損,模擬結果表明電離能損是導致器件性能退化的主要原因.
1 引 言
作為第三代寬禁帶半導體材料的典型代表之一,氮化鎵(GaN)是一種直接帶隙的半導體材料,其在室溫下的禁帶寬度為3.4 eV[1?3].氮化鎵材料具有優異的材料特性,包括大的臨界擊穿電壓、大的電子飽和漂移速度和高熱導率等,這也使得氮化鎵基器件在高頻、大功率應用方面具有巨大潛力[4?6].同時,相比于GaAs 材料和Si 材料,GaN 材料的寬禁帶特性使其理論上抗輻射性能更好,在航空航天領域前景可觀[7?8].
質子是太陽宇宙射線和銀河宇宙射線的主要組分,質子輻射對氮化鎵基器件的影響不容忽視.近年來,國內外研究者針對AlGaN/GaN HEMT 器件的輻照損傷效應開展了一些研究[9?16].Keum 等[9]開展了增強型p-gate AlGaN/GaN HEMT 器件的5 MeV 質子輻照實驗,輻照損傷導致器件的閾值電壓負向漂移、飽和漏電流降低,分析認為這是由于輻照使p-gate 柵層空穴濃度降低所致;Wan 等[10]研究了低能質子輻照對商用增強型p-gate 氮化鎵器件的影響,在不同偏壓下,3.8 MeV 質子輻照使器件閾值電壓負向漂移、跨導減小,分析認為這些退化是因質子入射在AlGaN,AlGaN/GaN 界面或AlGaN 緩沖層引入缺陷所引起的;呂玲等[11]利用70 keV 和140 keV 質子輻照增強型AlGaN/GaN HEMTs 絕緣柵器件,輻照導致器件閾值電壓正向漂移,飽和漏電流急劇減小,柵泄漏電流增大,分析認為質子輻照在該器件溝道層、柵介質層及柵介質/勢壘層界面引入了不同程度的缺陷,絕緣柵的存在使器件對質子輻照更敏感;Floriduz 等[12]利用24 GeV/ C 質子輻照增強型混合漏極嵌入式柵極(HD-GIT)AlGaN/GaN 晶體管,輻照導致晶體管飽和漏電流減小,閾值電壓有微小的負漂,分析認為是質子輻照引入了缺陷.目前針對增強型氮化鎵功率器件的質子輻射效應研究較少,商用的增強型氮化鎵功率器件主要有Cascode 型氮化鎵功率器件、增強型絕緣柵(MIS-HEMTs)器件、增強型p-gate 氮化鎵功率器件.同時,對氮化鎵器件的輻射效應研究主要集中在低能質子部分,有實驗研究發現質子能量越小,器件因輻照損傷性能下降地越嚴重[17],但中高能質子輻照會使器件產生電離能損和非電離能損,電離能損對氮化鎵器件造成的性能損壞同樣不可忽視.
本文利用60 MeV 能量的質子,對增強型Cascode結構和耗盡型AlGaN/GaN 功率器件開展了輻照實驗.主要研究高能質子輻照對器件直流特性的影響,通過計算機仿真軟件模擬得到輻照誘導的電離能損和非電離能損,并利用等效劑量的60Coγ射線輻照器件得到電離損傷效應結果.為增強型Cascode 結構AlGaN/GaN HEMT 器件在極端輻射環境中的應用提供理論基礎.
2 實 驗
本實驗選用的樣品是共柵共源(Cascode)結構增強型AlGaN/GaN HEMT 器件,該器件由高壓耗盡型GaN HEMT 和低壓增強型Si MOSFET級聯構成,器件結構如圖1 所示.該器件不加柵壓且漏源電壓大于零時,工作在正向阻斷模態;當柵壓大于Si 基MOS 管的閾值電壓時,器件正向導通;一旦Si 基MOS 管反向導通,器件將工作在反向導通模態.又因為Si 基MOS 管的漏源電壓Vds_Si給GaN HEMT 的柵源電壓Vgs_GaN 提供負偏置電壓,因此控制Si 基MOS 管的通斷即可控制GaN HEMT 的通斷,從而實現常閉特性[18].由于硅基MOS 管的引入,器件具有更大的與驅動電路兼容的柵壓浮動,應用范圍更加廣泛.圖2 為器件開封裝圖.
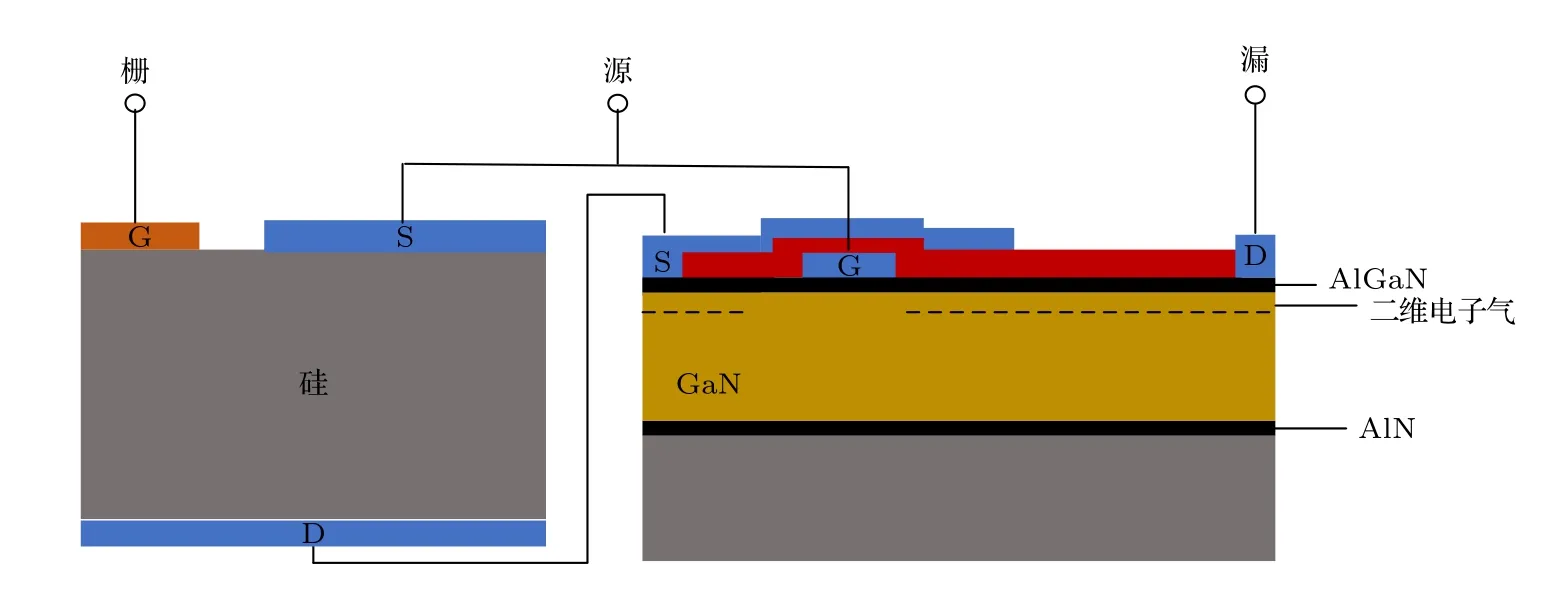
圖1 增強型Cascode GaN HEMT 器件結構圖Fig.1.Structure diagram of enhanced Cascode GaN HEMT device.
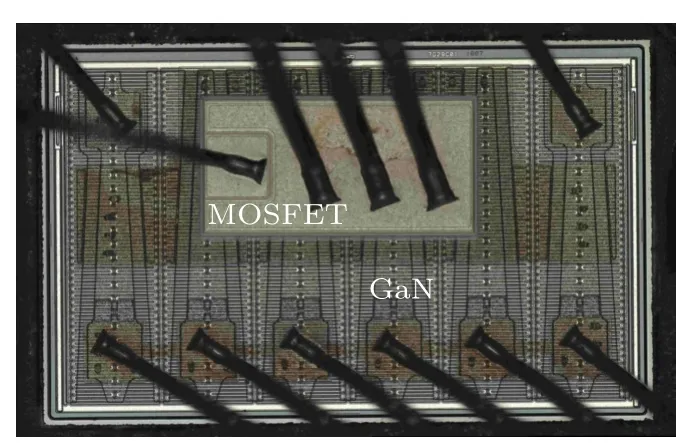
圖2 增強型Cascode 結構氮化鎵器件開封裝圖Fig.2.Internal equivalent circuit diagram of enhanced Cascode structure.
利用西安200 MeV 質子應用裝置開展增強型Cascode 結構和耗盡型AlGaN/GaN 功率器件質子輻照實驗,利用該裝置引出60 MeV 的準單能質子束流,質子注量達到1×1012p/cm2即停止輻照.輻照過程中,器件的3 個電極均接地.
3 實驗結果與理論分析
3.1 實驗結果
利用半導體參數分析儀Agilent B1500,對質子輻照前后的樣品進行離線電學性能測試,通過直流特性曲線獲得器件閾值電壓、最大跨導及柵泄漏電流等電學參數[19].發現增強型Cascode 結構氮化鎵器件的電學特性在質子輻照后有明顯退化.輻照前后的轉移特性曲線如圖3 和圖4 所示.
通常,在轉移特性曲線上,選擇跨導線密度最大值處做切線,該切線與橫軸的交點所對應的電壓稱為閾值電壓[19].圖3 給出了經60 MeV 能量質子輻照后,器件的閾值電壓及跨導變化.從圖3 可見,質子輻照后,器件閾值電壓出現明顯負向漂移,由4.2 V 減小至3.0 V,漂移了1.2 V,跨導峰值由0.324 S/mm 降至0.260 S/mm,降低了約19.75%;從圖4 可見,器件柵正向泄漏電流略微上升.

圖3 質子輻照前后增強型Cascode 結構AlGaN/GaN HEMT 器件閾值電壓及跨導曲線Fig.3.Threshold voltage and transconductance curve of Al-GaN/GaN HEMT devices of enhanced Cascode structure before and after proton irradiation.

圖4 質子輻照前后增強型Cascode 結構AlGaN/GaN HEMT 器件柵泄漏電流曲線Fig.4.Gate leakage current profile of AlGaN/GaN HEMT devices with enhanced Cascode structure before and after proton irradiation.
圖5 和圖6 給出了60 MeV 質子輻照前后,耗盡型AlGaN/GaN HEMT 器件的轉移特性曲線,從圖中可以看出質子輻照對耗盡型氮化鎵器件幾乎沒有影響.

圖5 質子輻照前后耗盡型AlGaN/GaN HEMT 器件閾值電壓及跨導曲線Fig.5.Threshold voltage and transconductance curve of depleted AlGaN/GaN HEMT devices before and after proton irradiation.
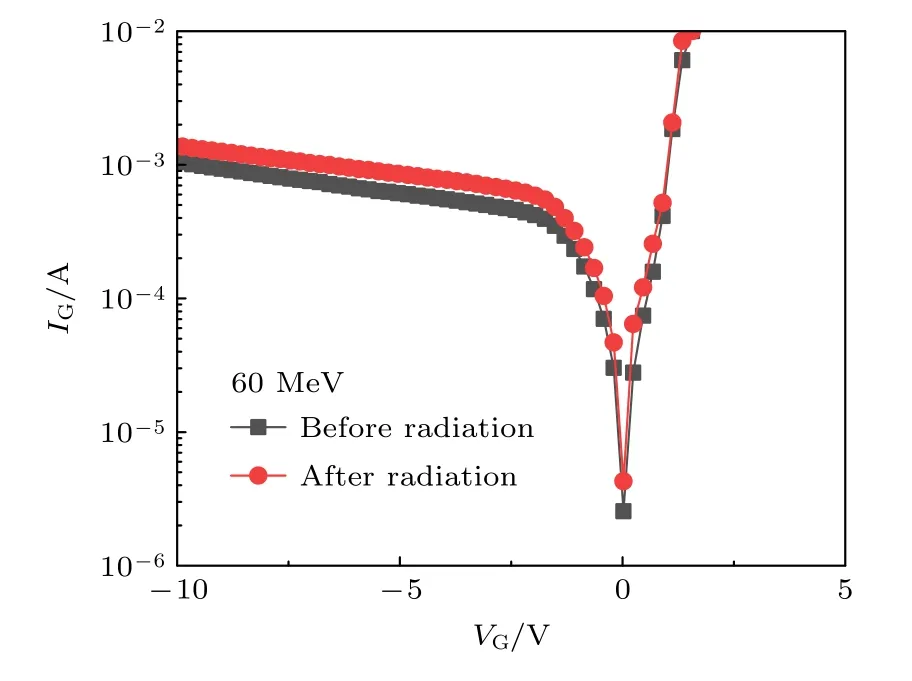
圖6 質子輻照前后耗盡型AlGaN/GaN HEMT 器件柵泄漏電流曲線Fig.6.Gate leakage current profile of depleted AlGaN/GaN HEMT devices before and after proton irradiation.
圖7所示為等效(60 MeV 能量質子,累積注量1×1012p/cm2)劑量的60Coγ射線輻照Cascode型器件轉移特性曲線變化,等效轉換公式為

質子能量為60 MeV 時,其LET 值為0.0086 MeV·cm2/mg,當注量達到1×1012p/cm2時,電離總劑量為137.6 krad(Si),劑量率為50 rad(Si)/s.從圖7 可見,經60Coγ射線輻照后,器件閾值電壓由4.15 V 減小到2.15 V,負向漂移了2 V;跨導峰值由0.335 S/mm 降至0.300 S/mm,降低了約10.45%.與質子輻照實驗結果相比(圖3),60Coγ射線輻照也會導致器件閾值電壓負向漂移,且漂移的更加嚴重,跨導也出現明顯下降.

圖7 60Co γ 射線輻照前后增強型Cascode 結構AlGaN/GaN HEMT 器件閾值電壓及跨導曲線Fig.7.Threshold voltage and transconductance curve of Al-GaN/GaN HEMT devices of enhanced Cascode structure before and after 60Co γ -ray irradiation.
3.2 實驗分析
通過對增強型與耗盡型器件質子輻照前后的電學特性變化比較發現,增強型Cascode 結構AlGaN/GaN HEMT 器件對質子輻照更為敏感,分析認為其敏感的主要原因是級聯的硅基MOS管在質子輻照后退化嚴重.由Cascode 結構的內部等效電路圖(圖8)可以看出,該器件最大的特點就是級聯了低壓增強型Si MOSFET 器件,且Cascode結構整體閾值電壓主要由Si 基MOS 管控制.MOSFET 管的閾值電壓Vth數學模型為[20]:
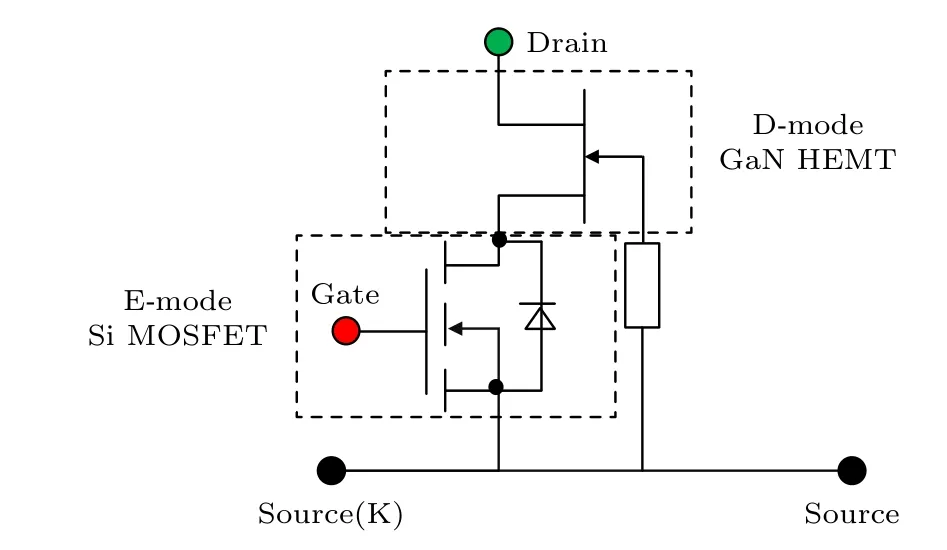
圖8 增強型Cascode 結構內部等效電路圖Fig.8.Internal equivalent circuit diagram of enhanced Cascode structure.

其中Not是氧化物陷阱電荷,Nit是界面陷阱電荷,COX是單位面積柵氧化層電容,εs是Si 的介電常數,NA是P 型溝道 區域的有效摻雜濃度,?Fp是P 型襯底的費米勢,?MS是金屬半導體功函數差,k是玻爾茲曼常數,T是絕對溫度,ni是Si 本征載流子濃度.Vth的負向漂移主要是由于質子輻照在柵氧化層中誘導產生大量電子-空穴對所引起的.由于電子在氧化層中的遷移率高于空穴,因此電子能夠在較短時間內離開柵氧化層,而大部分空穴緩慢的移向SiO2/Si 界面,被陷阱俘獲形成Not和Nit.又因為氧化物陷阱俘獲電荷的速度比界面陷阱快出幾個數量級[21],最終導致柵氧化層陷阱電荷Not比界面陷阱電荷Nit增長的多,使得Vth降低.
跨導(Gm)則指輸出端電流的變化值與輸入端電壓的變化值之間的比值,可以表示為[22]

Gm數值表示輸入端電壓(VGS) 對輸出端電流(IDS) 控制作用的強弱.跨導峰值的降低可以很好地評價柵區域的損傷程度.由圖(3)中跨導可以看出輻照后Cascode 結構器件柵控能力急劇下降.如圖4 所示,柵極泄露電流有所增加,分析認為,質子輻照在硅MOS 管中引入缺陷作為隧穿中心,加大了柵極電流的隧穿幾率.
對于增強型Cascode 結構氮化鎵功率器件而言,級聯的硅基MOS 管是其重要組成部分,實驗結果表明MOS 管對電離效應較敏感.當器件受到高能質子輻照時,硅基MOS 管內柵氧化層造成凈的正電荷增大使得閾值電壓降低,這也是引發器件電學特性特化的主要原因.閾值電壓的降低使器件的靜態功耗增大,甚至當器件在某個大小的柵壓信號下本應表現為關態時,在輻照后即可開啟,從而導致漏電增加甚至整個系統出現故障.大幅的閾值電壓漂移表明質子輻照嚴重影響該功率器件的工作能力.
綜上,高能質子輻照導致增強型Cascode 結構AlGaN/GaN HEMT 器件的電學性能出現明顯退化,大幅度的閾值電壓漂移說明質子輻照已經對該器件造成嚴重影響.高能質子輻照可以誘導產生電離損傷和非電離損傷,結合總劑量效應實驗結果(圖7)和上述公式分析,高能質子輻照產生的電離能損是使器件性能退化的主要原因.因此,高能質子輻照誘導產生電離能損對氮化鎵器件造成的性能損傷不容忽視.
4 輻射損傷模擬
本節利用仿真模擬軟件SRIM,計算質子輻照增強型Cascode 結構氮化鎵功率器件,誘導其產生的電離能損和非電離能損隨深度變化情況,仿真軟件采用蒙特卡洛(Monte Carlo)方法,模擬粒子在物質中運動的物理過程.本次計算采用106個粒子,入射質子從靶材表面中心垂直入射.利用聚焦離子束(FIB)對器件進行切片處理,進一步結合掃描電子顯微鏡(SEM)分析,最終得到了低壓功率MOSFET和耗盡型氮化鎵的器件結構及各部分材料成分,根據分析結果(如圖9 所示)構建仿真模型.
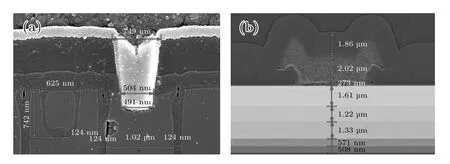
圖9 器件切片分析結果示意圖 (a)增強型硅基MOS 管;(b)耗盡型GaN 晶體管Fig.9.Schematic diagram of device slice analysis results:(a) Reinforced silicon-based MOS transistors;(b) depletiontype GaN transistors.
在硅基MOS 管中,柵氧化層以及Si/SiO2界面為電離輻射效應敏感區[23];在GaN HEMT 中,AlGaN/GaN 異質結界面為電離輻射效應敏感區[24].仿真計算結果如圖10 和圖11 所示.
從圖10 和圖11 可知,模擬60 MeV 質子輻照材料后,器件內同時產生電離能損和非電離能損.也可以明顯看出,在器件敏感區部分產生的電離能損遠高于非電離能損.無論是在Si MOS 還是在氮化鎵HEMT 中,相同深度下的電離能損都要比非電離能損高4 個數量級以上,耗盡型氮化鎵HEMT器件具有較強的抗電離損傷效應能力[25],137.6 krad(Si)的總劑量對應的電離損傷難以導致器件發生性能退化,本工作在實驗中使用的耗盡型氮化鎵HEMT 器件在質子輻照下也未發生退化.對于低壓Si MOS,由于氧化層以及Si/SiO2界面的存在,電離損傷誘導的氧化物陷阱電荷及界面態陷阱電荷會對其性能產生顯著的影響.在開展增強型Cascode結構AlGaN/GaN HEMT 功率器件的中高能質子輻照效應實驗時.在較高的質子累積注量下中高能質子對器件的電離損傷效應不容忽視.
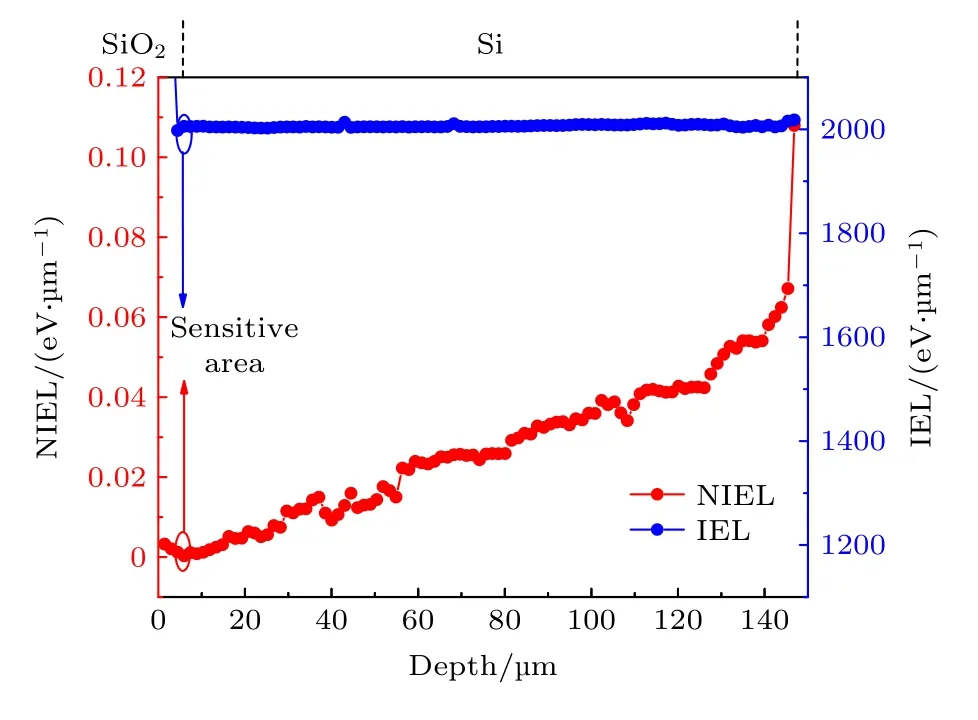
圖10 級聯硅基MOS 管中的電離能損和非電離能損隨深度的變化Fig.10.Ionization and non-ionization loss in cascaded silicon MOS transistors vary with depth.

圖11 級聯耗盡型AlGaN/GaN HEMT 中的電離能損和非電離能損隨深度的變化Fig.11.Ionization and non-ionization losses in cascaded depleted AlGaN/GaN HEMT vary with depth.
5 結 論
本文實驗工作針對增強型Cascode 結構AlGaN/GaN HEMT 功率器件開展了質子輻照效應研究,實驗結果表明在1×1012p/cm2的質子累積注量下,輻照導致Cascode 型器件閾值電壓負向漂移,由4.2 V 減小至3.0 V,漂移了1.2 V;跨導峰值由0.324 S/mm 降至0.260 S/mm,降低了約19.75%.與常規耗盡型AlGaN/GaN 功率相比,增強型Cascode結構器件因為級聯硅基MOS 管的存在會對質子輻照更加敏感,質子輻照導致硅基MOS 管產生電離損傷效應.利用等效(60 MeV 能量質子,累積注量1×1012p/cm2)劑量的60Coγ射線輻射器件得到電離損傷效應結果,發現等效劑量60Coγ射線輻照后,器件的電學性能退化規律與高能質子輻照后的退化規律一致.為進一步驗證實驗及結論的準確性,通過蒙特卡羅模擬得到輻射在該器件內誘導產生的電離能損和非電離能損,模擬結果表明電離能損誘導硅基MOS 產生氧化物陷阱電荷和界面態陷阱電荷,是增強型Cascode 結構AlGaN/GaN HEMT功率器件性能退化的主要原因.本文的相關研究成果可用于增強型Cascode 結構AlGaN/GaN HEMT 功率器件輻照機理分析及抗輻照加固設計方面.

