基于殼溫信息的功率器件可靠性分析
崔 曼 胡 震 張騰飛 周 巖 賈 蓉 劉俊杰
基于殼溫信息的功率器件可靠性分析
崔 曼1胡 震2,3張騰飛2周 巖2賈 蓉4劉俊杰5
(1. 北京理工大學(xué)信息與電子學(xué)院 北京 100081 2. 南京郵電大學(xué)自動化學(xué)院、人工智能學(xué)院 南京 210042 3. 蘇州帝奧電梯有限公司 蘇州 215200 4. 湖北汽車工業(yè)學(xué)院電氣與信息工程學(xué)院 十堰 442002 5. 長春理工大學(xué)計算機學(xué)院 長春 130022)
功率器件的焊料層易受到溫度波動逐步發(fā)生老化脫落,造成熱量無法快速消散而在芯片處積聚,引起芯片過熱損毀,造成功率器件突發(fā)失效,因此,焊料層老化的實時評估是實現(xiàn)功率器件可靠運行的重要保障。該文通過提出基于殼溫的焊料層老化評估方法,分析了焊料層老化影響的殼溫分布情況,建立了基于殼溫的基板二維溫度梯度模型對殼溫分布變化規(guī)律,研究了殼溫分布變化與熱阻抗的關(guān)聯(lián)情況,以焊料層老化程度作為中間變量,通過離線加速老化平臺采集殼溫分布和熱阻抗的演化信息,建立基板二維溫度梯度與熱阻抗關(guān)系的數(shù)據(jù)庫,在工程應(yīng)用中,通過布設(shè)在器件基板和散熱板之間的傳感器測量殼溫并計算二維溫度梯度,通過數(shù)據(jù)庫識別熱阻抗值對器件可靠性進行評估。在仿真和實驗的老化分析中,表征殼溫分布的二維溫度與熱阻抗的變化趨勢相同,當器件失效時,二維溫度梯度和熱阻抗分別增長了16.1%、20%和20.1%,表明二維溫度梯度與熱阻抗受焊料層老化影響是一致的,與現(xiàn)有的方法相比,該方法通過殼溫便可實現(xiàn)功率器件的可靠性評估。
功率器件 焊料層老化 可靠性 溫度梯度
0 引言
焊料層脫落是功率器件最重要的失效形式之一,作為層狀疊加結(jié)構(gòu)的功率器件,在運行過程中,由于各層材料的熱膨脹系數(shù)差異以及溫度分布的不均而產(chǎn)生熱-機械應(yīng)力[1-3]。熱-機械應(yīng)力的持續(xù)作用將造成焊料層產(chǎn)生裂紋或空洞等材料缺陷,從而降低焊料層傳遞熱量的有效面積,功率器件內(nèi)部熱傳遞阻抗增加,熱量在器件芯片處聚集等,造成芯片極度溫升使其無法正常工作,甚至造成損毀[4-7]。基于此,開展焊料層老化狀態(tài)的評估研究對功率器件可靠性評估具有一定的指導(dǎo)意義[8-11]。
近年來,國內(nèi)外專家學(xué)者對功率器件焊料層老化狀態(tài)進行了評估研究。目前,焊料層老化狀態(tài)的評估方法包括電參數(shù)法和熱參數(shù)法。電參數(shù)法通過監(jiān)測某些與器件老化程度相關(guān)的電特性參數(shù)的變化實現(xiàn)器件健康狀態(tài)的評估[12-14]。文獻[14]提出了基于功率變換器諧波電流的器件焊料層老化評估模型,由于電參數(shù)法對信號采集電路的動態(tài)響應(yīng)速度及測量精度要求較高,需要設(shè)計專門的信號采集電路,增加了電路的復(fù)雜程度,引起功率器件新的可靠性問題。
與電參數(shù)法相比,熱參數(shù)法無須設(shè)計專門的測量電路、且適用于任何封裝類型的模塊,實現(xiàn)簡單、經(jīng)濟性好,在實際中應(yīng)用十分廣泛[15-18]。文獻[15]提出了通過器件殼溫和散熱板溫度差值Dca的變化實現(xiàn)焊料層健康狀態(tài)的評估,而Dca的變化受到器件功率損耗值的影響,須建立不同工作狀態(tài)下功率損耗信息庫,造成監(jiān)測成本增加。為解決上述問題,文獻[16]提出采用器件基板至散熱板的熱阻抗ca對焊料層的老化程度進行評估,但ca的數(shù)值還依賴導(dǎo)熱脂和散熱板的老化狀態(tài),使得焊料層狀態(tài)評估的準確性降低。為優(yōu)化此方法,文獻[18]提出了基于器件基板溫度梯度的焊料層狀態(tài)評估模型,但此方法僅能實現(xiàn)焊料層某一方向上老化狀態(tài)的定性判斷。綜上所述,如何實現(xiàn)功率器件焊料層老化狀態(tài)評估的經(jīng)濟性和準確性還有許多問題需要研究。
本文提出了一種新型的基于殼溫的功率器件可靠性評估方法,通過器件的殼溫信息便可對焊料層的老化狀態(tài)做出評估,利用焊料層評估結(jié)果對功率器件可靠性做出判斷,與傳統(tǒng)方法相比,該方法具有經(jīng)濟性好、準確性高的優(yōu)點。
1 功率器件可靠性評估方法
1.1 殼溫信息的焊料層老化評估算法
通常功率器件由多個IGBT芯片組成,IGBT芯片作為熱源,是器件內(nèi)部全部熱量的來源。熱量在IGBT芯片上表面產(chǎn)生,并向下擴散到基板,如圖1所示。
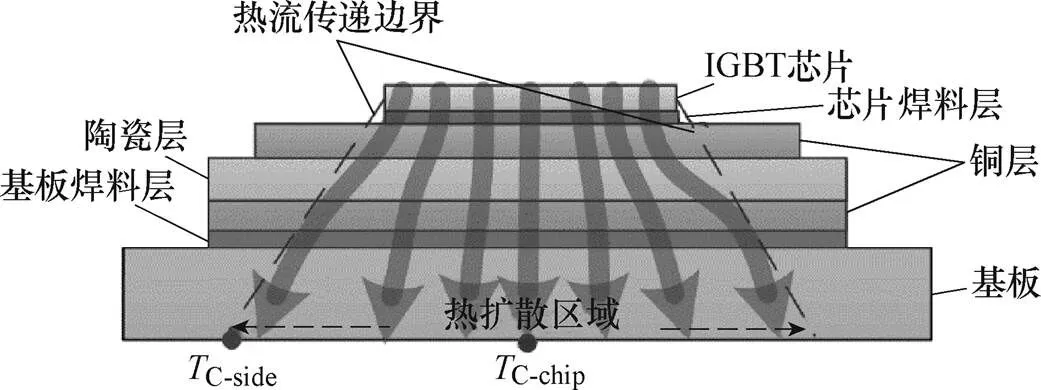
圖1 健康功率器件內(nèi)部熱流分布
考慮到器件散熱的熱擴散角度,基板上的溫度分布區(qū)域遠大于芯片的溫度分布區(qū)域。由于大部分熱量沿最佳的熱路徑(即垂直方向)向下傳播,因此基板底部表面的中心溫度遠高于其余區(qū)域,基板的溫度分布可認為是非均勻的。基板溫度分布的不均勻性程度可以用溫度梯度?的數(shù)值描述為

式中,C-chip和C-side分別為基板中心區(qū)域和邊緣區(qū)域的殼溫;為選定兩點間的距離。圖1中C-chip對焊料層老化造成的器件熱路徑的變化非常敏感,而C-side位于焊料層老化的起始區(qū)域。
焊料層老化情況的出現(xiàn)表明焊料層內(nèi)部已經(jīng)產(chǎn)生了裂紋。裂紋使得器件內(nèi)部的熱傳導(dǎo)區(qū)域收縮,老化功率器件內(nèi)部熱流分布如圖2所示。通常,裂紋起源于焊料層的邊緣區(qū)域,然后擴展到焊料層的中心區(qū)域,造成芯片處產(chǎn)生的熱量只能通過焊料層中心的無裂紋區(qū)域擴散到基板。上述情況導(dǎo)致基板中心區(qū)域的溫度不斷上升,其余區(qū)域溫度持續(xù)下降。最終,基板溫度分布的不均勻性進一步增強。描述溫度分布不均勻性的?值隨著焊料老化而增大。因此,?可以用來監(jiān)測焊料老化過程。
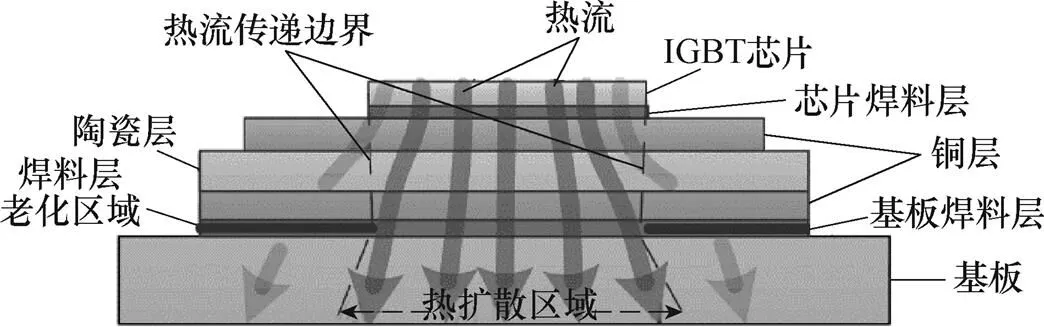
圖2 老化功率器件內(nèi)部熱流分布
此外,為消除器件的功率損耗對?數(shù)值的影響,可將?的數(shù)值按功率損耗歸一化為?T,即

式中,為器件的功率損耗。
在實際應(yīng)用中,焊料層裂紋的形成是十分復(fù)雜的。雖然裂紋通常從焊料層的邊緣開始形成,然后擴展到焊料層中心,但裂紋形成的位置是不確定的。因此,?T無法充分評價裂紋對焊料層老化的影響。為了更準確地表征焊料老化過程,可以從二維平面的兩個方向,即圖3所示的和方向,監(jiān)測基板溫度梯度的演變。兩個主要方向又分為四個方向,即-1,-2,-1和-2。?T,x1、?T,x2、?T,y1、?T,y2分別為底板層四個不同方向的溫度梯度,即

主方向的溫度梯度分別為?T,x和?T,y,即


圖3 基板底部表面溫度監(jiān)測分布圖
采用參數(shù)?T,x和?T,y,無論裂紋在焊料層哪個區(qū)域產(chǎn)生,都可以描述焊料層的老化程度。
1.2 功率器件可靠性分析方法
功率器件芯片至基板的熱阻抗值JC是一個可以定量表征器件焊料層老化程度的參數(shù),其依賴器件芯片處的溫度,在實際應(yīng)用中芯片溫度的獲取成本非常高。因此,以焊料老化程度為中間變量,通過離線加速老化試驗,采集器件老化過程中的溫度信息,采用式(3)和式(4)計算?T,x和?T,y,建立包含?T,x、?T,y與JC的數(shù)據(jù)庫。在器件運行過程中,通過?T,x和?T,y的計算值,采用查表法即可獲取JC數(shù)值,對器件的可靠性做出評價。表達式為

式中,為器件的健康可靠性;JC為器件實時的熱阻抗值;JC,original為器件健康狀態(tài)下的熱阻抗值,JC增長達到20%是器件失效的標準[19-21]。基于計算的值可實現(xiàn)器件可靠性的評估。
功率器件的老化試驗昂貴且耗時。當器件的溫度波動較低或器件的結(jié)溫不超過閾值時,器件的熱機械損傷非常小。從經(jīng)濟性角度出發(fā),加速老化試驗是評估器件可靠性的常用方法。加速老化試驗采用過載直流或交流將器件加熱至高溫,然后關(guān)閉電源,采用外部冷卻系統(tǒng)如空氣強制對流或水冷系統(tǒng)使器件的溫度快速下降。通過以上方法,器件會承受非常大的溫度波動,使得器件的熱-機械損傷快速增大。最終,器件的失效過程在很短的時間內(nèi)即可完成。在加速老化測試中,器件的健康表征參數(shù)?T,x、?T,y與JC數(shù)值在運行固定功率循環(huán)次數(shù)(如200次功率循環(huán))后被記錄。功率器件加速老化測試直到器件失效時停止。因此,?T,x、?T,y與JC的數(shù)據(jù)庫涵蓋了功率器件的全生命周期。?T,x、?T,y與JC之間的關(guān)系就通過數(shù)據(jù)庫構(gòu)建完成了。由于兩類參數(shù)之間的關(guān)系是非線性的,因此,無法采用數(shù)學(xué)方法進行描述。在實際運行中,根據(jù)?T,x和?T,y的計算信息,結(jié)合構(gòu)建的數(shù)據(jù)庫,可得到JC的值。與文獻[12-13]中描述的方法相比,本文所提出的方法只依賴殼溫,而殼溫僅須基板和散熱器之間的溫度傳感器即可獲得,因此,在經(jīng)濟性方面更有優(yōu)勢。
1.3 方法實現(xiàn)的流程
本方法實現(xiàn)流程如圖4所示。分為兩個階段實現(xiàn):第一階段,通過基板和散熱板之間的溫度傳感器測量殼溫,如圖3所示,采用式(3)和式(4)對基板溫度梯度?T,x和?T,y進行計算,并將計算值與健康器件的基板溫度梯度進行對比,判斷器件焊料層是否發(fā)生了老化;第二階段,根據(jù)離線功率循環(huán)試驗建立的?T,x、?T,y與JC的數(shù)據(jù)庫獲取器件老化的JC,基于JC數(shù)值采用式(5)對器件的可靠性進行評估。

圖4 方法實現(xiàn)流程
2 仿真驗證
通過有限元分析(Finite Element Analysis, FEA)實例對提出方法的有效性進行驗證。首先采用Pro/ENGINEER對SEMIKRON商用功率器件(SKM75GB123D)進行三維建模,并將三維模型導(dǎo)入Ansys軟件中進行有限元分析,如圖5所示。功率器件的工作條件如下:直流電壓DC=1 000 V,負載電流C=60 A,開關(guān)頻率sw=10 kHz,調(diào)制指數(shù)=1,功率因數(shù)PF=0.8,線路頻率0=50 Hz。

圖5 功率器件三維模型
為深入分析焊料層老化對功率器件熱特性的影響,通過以下六個老化場景來模擬焊料層老化的演變過程設(shè)計:①健康狀況;②焊料層出現(xiàn)0.5 mm裂紋的輕微老化狀態(tài);③焊料層出現(xiàn)1.0 mm裂紋的輕度老化狀態(tài);④焊料層出現(xiàn)1.5 mm裂紋的中等老化狀態(tài);⑤焊料層出現(xiàn)2.0 mm裂紋的重度老化狀態(tài);⑥焊料層出現(xiàn)2.5 mm裂紋的危險老化狀態(tài)。六種焊料層的老化狀態(tài)的示意圖如圖6所示。
考慮器件的工作條件,計算器件的功率損耗并將其加載到各老化狀態(tài)的器件芯片上,采用Ansys軟件進行瞬態(tài)熱分析。其中健康功率器件剖面的溫度分布云圖如圖7所示。由圖7可知,熱量生成處的芯片溫度最高,隨著與芯片距離的增大,溫度逐漸降低。芯片處的熱量向下擴散的角度約為45℃,經(jīng)過各層結(jié)構(gòu)的傳遞后,器件基板的溫度區(qū)域遠大于芯片處的溫度區(qū)域。
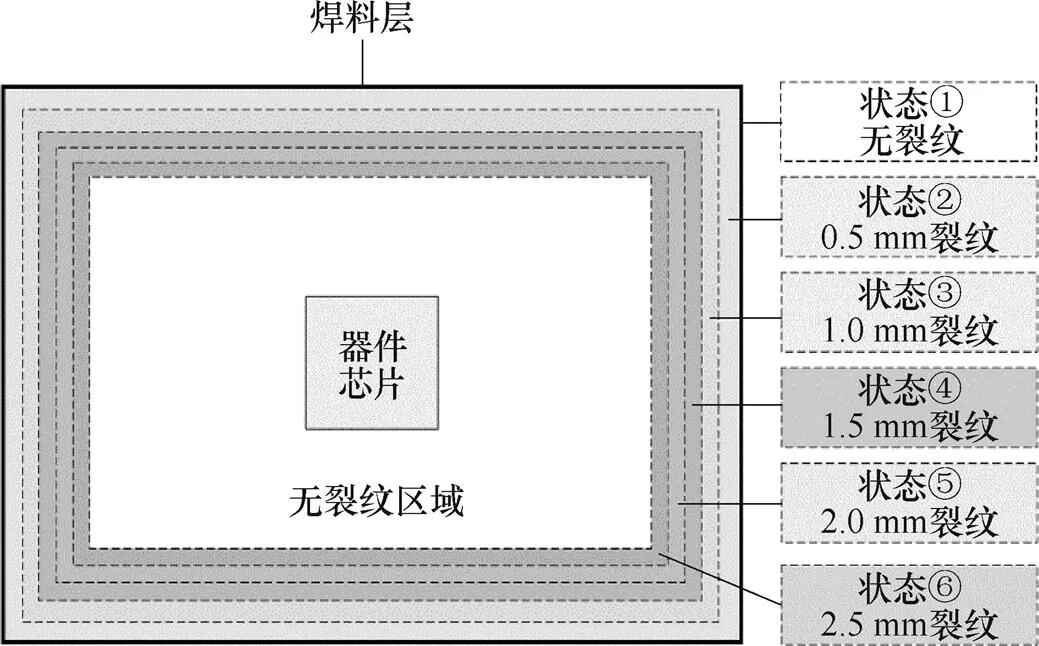
圖6 功率器件焊料層老化設(shè)計示意圖

圖7 健康功率器件剖面溫度分布云圖
老化狀態(tài)①和老化狀態(tài)⑥的功率器件的熱流分布如圖8所示。與健康功率器件相比,老化器件中的大部分熱量只能通過未老化的焊料層區(qū)域向基板層擴散,造成基板層涵蓋的溫度區(qū)域變小。由于器件內(nèi)部的熱量集中在基板層的中心區(qū)域,基板層中心區(qū)域的溫度不斷升高,而剩余區(qū)域的溫度不斷降低。因此,依賴基板層殼溫的?T,x和?T,y的值會發(fā)生變化。連續(xù)記錄六種老化情形下器件殼溫的演化,并采用式(3)和式(4)估算?T,x和?T,y的數(shù)值。表征焊料老化的熱阻抗JC為

式中,J為器件芯片的結(jié)溫。在瞬態(tài)熱分析過程中分別記錄不同老化狀態(tài)器件的J值,代入式(6)中可得JC。經(jīng)計算得到的?T,x、?T,y與JC的數(shù)值如圖9所示。
由圖9可知,?T,x、?T,y與JC隨焊料老化進程而不斷增大。當焊料層裂紋達到2.5 mm時,與健康的器件相比,?T,x增大約10.3%,?T,y增大約15.4%,JC增大約15.2%。這表明?T,x、?T,y與JC的值與焊料層的老化程度有關(guān)。由于焊料層的老化程度是唯一的,因此,?T,x、?T,y與JC之間的關(guān)系是唯一的。此外,?T,x和?T,y可描述任意位置的焊料層老化情況。
在工程應(yīng)用中,采集器件的殼溫信息計算?T,x、?T,y的數(shù)值,基于包含?T,x、?T,y與JC關(guān)系的數(shù)據(jù)庫確定JC的值,代入式(6)中計算器件的可靠性。六種老化狀態(tài)的功率器件的可靠性如圖10所示。由圖10可知,伴隨焊料層老化程度的加劇,功率器件的可靠性逐漸降低。與傳統(tǒng)的依賴器件結(jié)溫的JC計算方法相比,本方法只需知道器件殼溫信息便可獲取JC數(shù)值,進而評估器件的可靠性,在實際應(yīng)用中實現(xiàn)簡單、經(jīng)濟性好。

(a)老化狀態(tài)①下熱矢量圖和溫度分布圖

(b)老化狀態(tài)⑥下熱矢量圖和溫度分布圖
圖8 功率器件內(nèi)部熱流隨焊料層老化的演化趨勢
Fig.8 The evolution of heat flow during the solder aging process
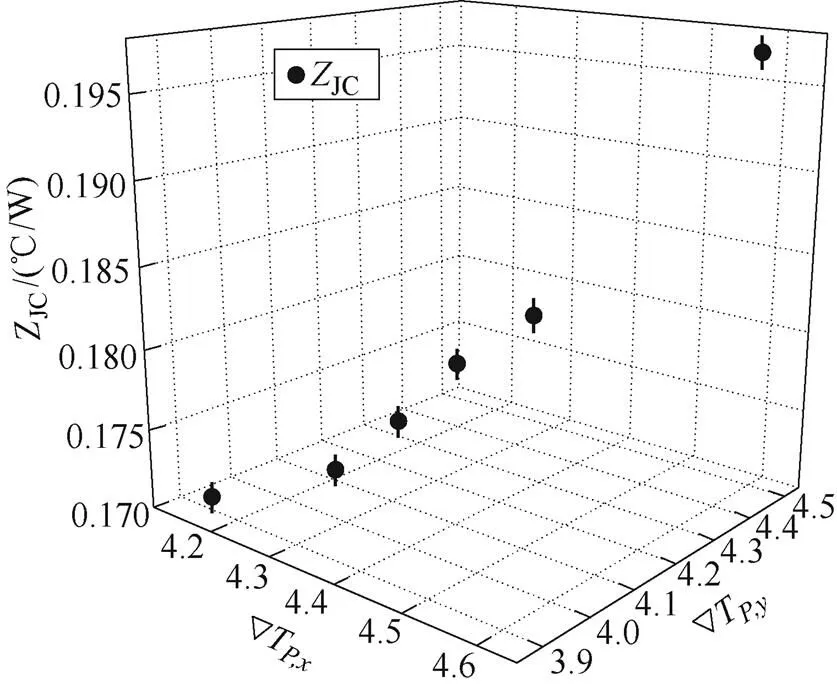
圖9 焊料層老化過程中?TP,x、?TP,y與ZJC的演化趨勢

圖10 器件可靠性的演化趨勢
3 實驗驗證
實驗配置如圖11所示,由塞米控生產(chǎn)的功率器件(SKM75GB123D),獲取溫度信息的紅外相機(紅外相機型號為Fotric 288,采樣頻率為30 Hz),測量器件電信號的錄波儀,功率器件驅(qū)動器,直流電源,鋁制散熱器以及LabVIEW數(shù)據(jù)采集系統(tǒng)等,其中鋁制散熱器上表面刻有用于安裝熱敏電阻的凹淺槽。

圖11 實驗設(shè)備示意圖
為快速獲取功率器件老化過程中殼溫演變信息,搭建器件加速老化測試平臺,首先采用45 A的直流電流對功率器件持續(xù)加熱至芯片結(jié)溫達到150℃左右,然后斷開直流電源采用強制風(fēng)冷將芯片結(jié)溫降至60℃。在一個循環(huán)周期內(nèi)功率器件承受的溫度沖擊為90℃。采用LabVIEW系統(tǒng)持續(xù)采集器件殼溫信息,并計算?T,x和?T,y的數(shù)值。此外,每200個循環(huán)周期中斷一次加速老化測試,采用紅外攝像頭記錄芯片結(jié)溫信息,并代入式(6)計算JC數(shù)值。當JC增長達到20%時終止器件的加速老化測試。加速老化測試過程中?T,x、?T,y與JC的演化如圖12所示。
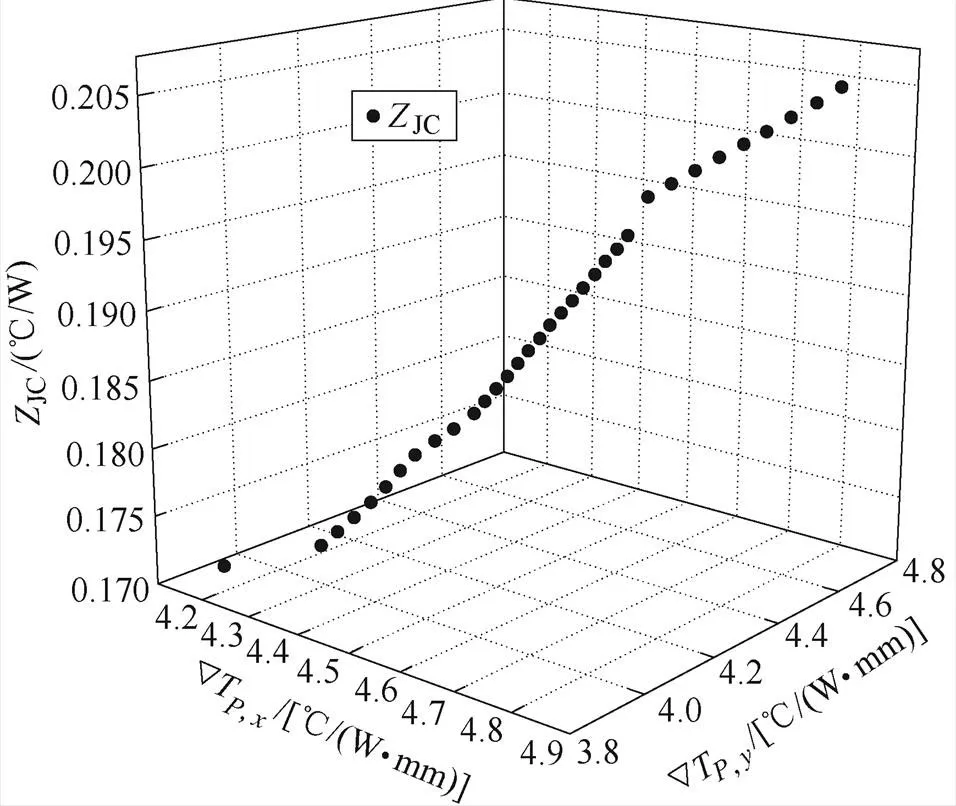
圖12 焊料層老化過程中?TP,x、?TP,y與ZJC演化趨勢
由圖12可以看出,?T,x、?T,y與JC隨著加速老化試驗的進行而持續(xù)增大。?T,x、?T,y與JC在測試結(jié)束時分別增加16.1%、20%和20.1%。上述結(jié)果表明,?T,x、?T,y與JC數(shù)值均依賴焊料層的老化程度。考慮到焊料層的老化程度是唯一的,因此?T,x、?T,y與JC之間的關(guān)系是唯一的,如圖12所示。因此,在實際應(yīng)用中,采集器件的殼溫信息計算?T,x、?T,y的數(shù)值,基于包含?T,x、?T,y與JC關(guān)系的數(shù)據(jù)庫確定JC的值,代入式(6)中計算器件的可靠度。加速老化測試期間功率器件的可靠度變化如圖13所示。由圖13可知,伴隨焊料層老化程度的加劇,功率器件的可靠性逐漸降低。

圖13 器件可靠性隨焊料層老化的演化趨勢
4 結(jié)論
本文研究了焊料層老化對殼溫分布的影響機制,有限元仿真結(jié)果表明了焊料層老化使得芯片熱流向下傳遞的區(qū)域變窄,當老化區(qū)域達到2.5 mm時,焊料層的熱傳遞區(qū)域減小近40%,熱傳遞區(qū)域的變化使得基板中心處的溫度不斷升高,而基板邊緣處的溫度不斷降低,最終導(dǎo)致基板殼溫分布的變化。
此外,本文提出了二維溫度梯度計算方法對基板殼溫分布的變化進行描述。在仿真部分中,當老化區(qū)域達到2.5 mm時,二維溫度梯度?T,x和?T,y分別增大了約10.3%、15.4%,而熱阻抗JC增大約15.2%;在實驗部分中,?T,x、?T,y與JC在加速老化測試結(jié)束時分別增加16.1%、20%和20.1%。上述結(jié)果表明,焊料層老化導(dǎo)致了基板殼溫分布的變化,進而造成二維溫度梯度的變化;同時二維溫度梯度與熱阻抗的變化保持一致。
因此,以焊料層老化程度作為中間變量,建立二維溫度梯度與器件熱阻抗關(guān)系的數(shù)據(jù)庫。在現(xiàn)場應(yīng)用中,通過布設(shè)在器件基板和散熱板之間的溫度傳感器采集殼溫,進而計算二維溫度梯度數(shù)值,基于數(shù)據(jù)庫識別的熱阻抗值對器件可靠性進行評估,本文的研究方法對工程應(yīng)用具有一定的指導(dǎo)作用。
[1] Gong Xiang, Qiao Wei. Bearing fault diagnosis for direct-drive wind turbines via current-demodulated signals[J]. IEEE Transactions on Industrial Electro- nics, 2013, 60(8): 3419-3428.
[2] Ribrant J, Bertling L M. Survey of failures in wind power systems with focus on Swedish wind power plants during 1997-2005[J]. IEEE Transactions on Energy Conversion, 2007, 22(1): 167-173.
[3] Luo Haoze, Chen Yuxiang, Sun Pengfei, et al. Junction temperature extraction approach with turn- off delay time for high-voltage high-power IGBT modules[J]. IEEE Transactions on Power Electronics, 2016, 31(7): 5122-5132.
[4] Yang Shaoyong, Xiang Dawei, Bryant A, et al. Condition monitoring for device reliability in power electronic converters: a review[J]. IEEE Transactions on Power Electronics, 2010, 25(11): 2734-2752.
[5] 王學(xué)梅, 張波, 吳海平. 基于失效物理的功率器件疲勞失效機理[J]. 電工技術(shù)學(xué)報, 2019, 34(4): 717-727.
Wang Xuemei, Zhang Bo, Wu Haiping. A review of fatigue mechanism of power devices based on physics-of-failure[J]. Transactions of China Electro- technical Society, 2019, 34(4): 717-727.
[6] 姚芳, 胡洋, 李錚, 等. 基于結(jié)溫監(jiān)測的風(fēng)電IGBT熱安全性和壽命耗損研究[J]. 電工技術(shù)學(xué)報, 2018, 33(9): 2024-2033.
Yao Fang, Hu Yang, Li Zheng, et al. Study on thermal safety and lifetime consumption of IGBT in wind power converters based on junction temperature monitoring[J]. Transactions of China Electrotechnical Society, 2018, 33(9): 2024-2033.
[7] Smet V, Forest F, Huselstein J J, et al. Ageing and failure modes of IGBT modules in high-temperature power cycling[J]. IEEE Transactions on Industrial Electronics, 2011, 58(10): 4931-4941.
[8] 王莉娜, 鄧潔, 楊軍一, 等. Si和SiC功率器件結(jié)溫提取技術(shù)現(xiàn)狀及展望[J]. 電工技術(shù)學(xué)報, 2019, 34(4): 703-716.
Wang Lina, Deng Jie, Yang Junyi, et al. Junction temperature extraction methods for Si and SiC power devices-a review and possible alternatives[J]. Transa- ctions of China Electrotechnical Society, 2019, 34(4): 703-716.
[9] 李輝, 劉人寬, 王曉, 等. 壓接型IGBT器件封裝退化監(jiān)測方法綜述[J]. 電工技術(shù)學(xué)報, 2021, 36(12): 2505-2521.
Li Hui, Liu Renkuan, Wang Xiao, et al. Review on package degradation monitoring methods of press- pack IGBT modules[J]. Transactions of China Elec- trotechnical Society, 2021, 36(12): 2505-2521.
[10] 陳宇, 周宇, 羅皓澤, 等. 計及芯片導(dǎo)通壓降溫變效應(yīng)的功率模塊三維溫度場解析建模方法[J]. 電工技術(shù)學(xué)報, 2021, 36(12): 2459-2470.
Chen Yu, Zhou Yu, Luo Haoze, et al. Analytical 3D temperature field model for power module con- sidering temperature effect of semiconductor voltage drop[J]. Transactions of China Electrotechnical Society, 2021, 36(12): 2459-2470.
[11] 張軍, 張犁, 成瑜. IGBT模塊壽命評估研究綜述[J]. 電工技術(shù)學(xué)報, 2021, 36(12): 2560-2575.
Zhang Jun, Zhang Li, Cheng Yu. Review of the lifetime evaluation for the IGBT module[J]. Transa- ctions of China Electrotechnical Society, 2021, 36(12): 2560-2575.
[12] Ji Bing, Song Xueguan, Cao Wenping, et al. In situ diagnostics and prognostics of solder fatigue in IGBT modules for electric vehicle drives[J]. IEEE Transa- ctions on Power Electronics, 2014, 30(3): 1535-1543.
[13] Zhou Shengqi, Zhou Luowei, Sun Pengju. Monitoring potential defects in an IGBT module based on dynamic changes of the gate current[J]. IEEE Transa- ctions on Power Electronics, 2013, 28(3): 1479-1487.
[14] Xiang Dawei, Ran Li, Tavner P, et al. Condition monitoring power module solder fatigue using inver- ter harmonic identification[J]. IEEE Transactions on Power Electronics, 2012, 27(1): 235-247.
[15] Xiang Dawei, Ran Li, Tavner P, et al. Monitoring solder fatigue in a power module using case-above- ambient temperature rise[J]. IEEE Transactions on Industry Applications, 2011, 47(6): 2578-2591.
[16] Wang Ze, Tian Bo, Qiao Wei, et al. Real-time aging monitoring for IGBT modules using case tempera- ture[J]. IEEE Transactions on Industrial Electronics, 2016, 63(2): 1168-1178.
[17] Hu Zhen, Du Mingxing, Wei Kexin. Online calcu- lation of the increase in thermal resistance caused by solder fatigue for IGBT modules[J]. IEEE Transa- ctions on Device and Materials Reliability, 2017, 17(4): 785-794.
[18] Hu Zhen, Du Mingxing, Wei Kexin, et al. An adaptive thermal equivalent circuit model for estimating the junction temperature of IGBTs[J]. IEEE Journal of Emerging and Selected Topics in Power Electronics, 2019, 7(1): 392-403.
[19] Coquery G, Lallemand R. Failure criteria for long term accelerated power cycling test linked to electrical turn off SOA on IGBT module. a 4000 hours test on 1200A-3300V module with AlSiC base plate[J]. Microelectronics Reliability, 2000, 40(8/9/10): 1665-1670.
[20] Tounsi M, Oukaour A, Tala-Ighil B, et al. Charac- terization of high-voltage IGBT module degradations under PWM power cycling test at high ambient temperature[J]. Microelectronics Reliability, 2010, 50(9/10/11): 1810-1814.
[21] Oh H, Han B, McCluskey P, et al. Physics-of-failure, condition monitoring, and prognostics of insulated gate bipolar transistor modules: a review[J]. IEEE Transactions on Power Electronics, 2015, 30(5): 2413-2426.
Reliability Analysis of Power Device Based on the Case Temperatures
12,32245
(1. School of Information and Electronics Beijing Institute of Technology Beijing 100081 China 2. College of Automation & College of Artificial Intelligence Nanjing University of Posts and elecommunications Nanjing 210042 China 3. Suzhou Di’ao Elevator Co. Suzhou 215200 China 4. College of Electrical & Information Hubei University of Automotive Technology Shiyan 442002 China 5. College of Computer Science Changchun University of Science and Technology Changchun 130022 China)
As the channel of heat transfers from the inside of the power device to the outside, the solder layer is vulnerable toaging and falling off due to the effect of temperature fluctuations. The heat cannot be dissipated quickly and accumulates in the chip, causing the chip to overheat and damage. As a result, the power device may fail suddenly. Real-time evaluation of solder aging is a vital guarantee for the operational reliability of power devices. The thermal impedance from the chip to the baseplate is a signal to characterize solder aging, and the measurement of junction temperature for estimating the thermal impedance is costly. From an economic point of view, this paper proposes a novel solder aging evaluation method based on the case temperatures. The case temperature distribution is sensitive to the solder aging. From this perspective, a two-dimensional temperature gradient monitoring algorithm based on case temperatures was modeled to describe the changes in case temperature distribution due to the solder aging. In addition, the relationship between the changes in case temperature distribution and thermal impedance was studied. With solder aging degree as the intermediate variable, the evolution of case temperature distribution and thermal impedance was recorded through an offline accelerated aging test. A database including information on two-dimensional temperature gradients and thermal impedance was built. In practical applications, the case temperature is measured by a thermistor sensor placed between the baseplate and the heatsink. Then the two-dimensional temperature gradient value is calculated. Based on the database, the thermal impedance value is identified to evaluate the reliability of the device. Finite-element simulation and experiment verify the effectiveness of the proposed method. The finite-element simulation results show that the heat transfer region of the chip becomes narrower due to the solder aging. When the aging region reaches 2.5 mm, the heat transfer area of the solder layer decreases by nearly 40%, and the change in the heat transfer area causes the temperature at the center of the baseplate to increase continuously. When the aging area reaches 2.5 mm, the two-dimensional temperature gradient?P,xand?P,yincreases by about 10.3% and 15.4%, respectively, and the thermal impedanceJCincreases by about 15.2%.The experimental results showed that?P,x,?P,y, andJCincreased by 16.1%, 20%, and 20.1% at the end of the accelerated aging test. The verification results show that the solder aging leads to a change in the temperature distribution of the baseplate, which leads to a change in the two-dimensional temperature gradient. As a result, the two-dimensional temperature gradient and thermal impedance are consistent with the solder aging. Compared with the existing methods, this method can realize the reliability evaluation of the device only with the case temperature, has a better economy, and gives some guidance for engineering applications.
Power device, solder aging, reliability, temperature gradient
TM46
10.19595/j.cnki.1000-6753.tces.220886
國家自然科學(xué)基金項目(62073173, 62203052, 61903126)、江蘇省高等學(xué)校自然科學(xué)研究面上項目(22KJB470007)、南郵電大學(xué)引進人才自然科學(xué)研究啟動基金項目(NY219153)和陜西省自然科學(xué)基金項目(2020JQ-814)資助。
2022-05-19
2022-06-06
崔 曼 女,1986年生,博士,研究方向為復(fù)雜系統(tǒng)建模與評估。E-mail: 15991637202@163.com
胡 震 男,1989年生,博士,講師,研究方向為電力電子設(shè)備故障的智能化診斷。E-mail: huzhen0111@njupt.edu.cn(通信作者)
(編輯 郭麗軍)

