重離子引起SiC MOSFET柵氧化物潛在損傷研究
于慶奎,曹 爽,張琛睿,孫 毅,梅 博,王乾元,王 賀,魏志超,張洪偉,張 騰,柏 松
(1.中國(guó)空間技術(shù)研究院 宇航物資保障事業(yè)部,北京 100029;2.國(guó)家級(jí)抗輻照應(yīng)用技術(shù)創(chuàng)新中心,北京 100029;3.南京電子器件研究所 寬禁帶半導(dǎo)體電力電子器件國(guó)家重點(diǎn)實(shí)驗(yàn)室,江蘇 南京 211111)
新一代航天器對(duì)高壓功率器件提出了迫切應(yīng)用需求,如新一代深空探測(cè)航天器的電推進(jìn)系統(tǒng)需要使用千伏以上的高壓功率器件[1],空間太陽(yáng)能電站能量轉(zhuǎn)換和傳輸系統(tǒng)需要使用高壓功率器件[2]。與硅器件相比,SiC器件的工作電壓達(dá)到千伏以上,且具有工作溫度高和功耗低的優(yōu)點(diǎn),在新一代航天器中有非常好的應(yīng)用前景[1,3]。航天器工作在空間輻射環(huán)境中,必須開(kāi)展抗輻射研究。國(guó)內(nèi)外對(duì)SiC MOSFET開(kāi)展了較多的單粒子效應(yīng)研究,發(fā)現(xiàn)重離子輻照下,其輻射效應(yīng)與入射離子線(xiàn)性能量傳輸(LET)和偏置電壓有關(guān),會(huì)出現(xiàn)的輻射效應(yīng)有:1) 氧化層潛在損傷;2) 離子引起漏電流(SELC);3) 單粒子燒毀(SEB)[4-6]。國(guó)際上對(duì)SiC MOSFET的SELC和SEB研究較多,文獻(xiàn)[6-7]研究指出當(dāng)入射離子LET大于10 MeV·cm2/mg,在約100 V漏源偏置電壓下,離子在SiC MOSFET柵氧化物中引入潛在損傷,在約200 V或更高偏置電壓下,發(fā)生SELC退化,SELC退化不可恢復(fù);在400 V左右偏置電壓下,離子會(huì)引起SEB。文獻(xiàn)[4,8-11]研究認(rèn)為離子引起的SiC MOSFET內(nèi)部永久損傷導(dǎo)致漏電流和擊穿電壓下降與入射離子LET和漏源偏置電壓有關(guān)。Yan等[12]研究了離子入射角度對(duì)漏電流的影響,指出垂直入射產(chǎn)生的漏電流損傷最嚴(yán)重。Peng等[13]研究認(rèn)為SELC與離子累積注量有關(guān)。關(guān)于SEB,Abbate等[14]研究認(rèn)為2個(gè)離子重復(fù)轟擊同一個(gè)位置,損傷積累,最終發(fā)生SEB。Liu等[15]通過(guò)仿真研究了增加高摻雜P+區(qū)有減緩SiC MOSFET發(fā)生SEB的作用。文獻(xiàn)[16-17]試驗(yàn)和仿真研究了SiC MOSFET的SELC和SEB機(jī)理。Robert等[18]根據(jù)SELC與入射離子注量和偏壓關(guān)系的研究結(jié)果,指出應(yīng)根據(jù)應(yīng)用條件,包括偏置電壓、軌道高度及壽命周期等,評(píng)估SELC的影響。總結(jié)國(guó)內(nèi)外研究進(jìn)展可得出,SiC MOSFET單粒子效應(yīng)和硅器件不同:SiC MOSFET在低電壓(如10%左右額定擊穿電壓)就會(huì)發(fā)生離子引起的SELC,并在柵氧化物中引入潛在損傷,離子引入的柵氧化物潛在損傷在柵應(yīng)力作用下會(huì)退化,引起單粒子?xùn)糯?SEGR),造成器件功能失效,在40%~50%額定擊穿電壓下會(huì)發(fā)生SEB,由于在柵氧化物中引起潛在損傷所需要的偏置電壓比引起SEB的更低,可得出SiC MOSFET柵氧化物單粒子效應(yīng)最敏感;在硅器件中,離子引起的SELC影響不顯著,幾乎在接近額定擊穿電壓或SEB閾值電壓時(shí),才會(huì)發(fā)生離子引起的SELC[7]。因此,需要開(kāi)展SiC MOSFET單粒子效應(yīng)研究,特別是離子引起氧化物潛在損傷的規(guī)律。在SiC MOSFET單粒子效應(yīng)評(píng)估中,應(yīng)適當(dāng)評(píng)估離子引起氧化物潛在損傷的影響,否則會(huì)導(dǎo)致錯(cuò)誤的評(píng)估結(jié)果,影響其可靠應(yīng)用。對(duì)于硅MOSFET,為了評(píng)估氧化物潛在損傷,現(xiàn)有的SEB和SEGR試驗(yàn)方法標(biāo)準(zhǔn)規(guī)定了輻照后柵應(yīng)力(PIGS)測(cè)試要求,要求PIGS測(cè)試柵應(yīng)力時(shí)間不少于1 s[19]。對(duì)于SiC MOSFET,為了準(zhǔn)確評(píng)估離子引起的氧化物潛在損傷對(duì)器件可靠性的影響,需要掌握SiC MOSFET柵氧化物損傷的變化規(guī)律和影響因素,包括與偏置電壓、入射離子LET和注量等之間的關(guān)系以及PIGS測(cè)試柵應(yīng)力時(shí)間要求等。
本文以4個(gè)生產(chǎn)廠的1 200 V SiC MOSFET為對(duì)象,在加速器上進(jìn)行重離子輻照,輻照中器件加電并實(shí)時(shí)原位測(cè)量電特性,輻照后進(jìn)行PIGS測(cè)試,研究離子引起的柵損傷隨偏置電壓、入射離子LET和注量以及PIGS測(cè)試柵應(yīng)力時(shí)間等的變化規(guī)律,為制定SiC MOSFET單粒子試驗(yàn)方法提供支持,同時(shí)為器件加固和空間應(yīng)用提供參考。
1 試驗(yàn)樣品和條件
試驗(yàn)樣品為平面結(jié)構(gòu)1 200 V SiC MOSFET,來(lái)自4個(gè)生產(chǎn)廠(以下分別稱(chēng)為A、B、C和R),均為非加固器件。輻照前,被試器件開(kāi)帽,露出芯片,并編號(hào)測(cè)試,電性能均合格。重離子試驗(yàn)在中國(guó)原子能科學(xué)研究院HI-13串列靜電加速器、中國(guó)科學(xué)院近代物理研究所回旋加速器HIRFL和哈爾濱工業(yè)大學(xué)300 MeV質(zhì)子重離子加速器SESRI上進(jìn)行。采用碳(C)、鍺(Ge)、鉭(Ta)、鉍(Bi)和鈾(U)離子,離子在芯片表面的LET在0.26~118 MeV·cm2/mg之間,在硅中射程均大于30 μm。
在離子輻照過(guò)程中,被試器件漏源間加50~600 V靜態(tài)偏置電壓,柵源短接,實(shí)時(shí)測(cè)量漏極和柵極漏電流IDS、IGS,根據(jù)產(chǎn)品手冊(cè)規(guī)定,當(dāng)IDS超過(guò)100 μA時(shí),判為器件失效;當(dāng)IGS超過(guò)100 nA,判為柵氧化層失效。輻照后,進(jìn)行PIGS測(cè)試。PIGS測(cè)試方法為施加?xùn)烹妷篤GS,從0 V開(kāi)始,以1 V為臺(tái)階增加到20 V,漏源電壓為0 V,測(cè)試IGS。除另有注明,柵應(yīng)力施加時(shí)間為1 s。重離子輻照試驗(yàn)和PIGS測(cè)試均在室溫下進(jìn)行。
2 試驗(yàn)結(jié)果和討論
2.1 SiC MOSFET重離子輻照試驗(yàn)結(jié)果
取樣品在加速器SESRI上進(jìn)行輻照試驗(yàn)。SESRI以12 s時(shí)間周期輸出離子,在12 s時(shí)間周期內(nèi),3 s時(shí)間有離子輸出,9 s時(shí)間無(wú)離子輸出。用重離子Bi,其能量為1 200 MeV,芯片表面LET為97.5 MeV·cm2/mg,注量率為5×103cm-2·s-1,分別在50 V和100 V漏源偏置電壓(柵源短接)下對(duì)4個(gè)生產(chǎn)廠的器件進(jìn)行注量為105cm-2的輻照。當(dāng)加速器輸出離子時(shí),漏極和柵極檢測(cè)到瞬態(tài)電流,測(cè)試結(jié)果列于表1。典型被試器件瞬態(tài)電流測(cè)試結(jié)果示于圖1,瞬態(tài)電流出現(xiàn)的時(shí)間間隔約為12 s,與加速器輸出離子的周期相吻合,因此,判斷是離子引起的瞬態(tài)電流(SETC)。由圖1可看出,A-176被試器件在100 V漏源偏置電壓下,無(wú)離子輻照時(shí)柵極漏電流IGS小于10 pA;有離子輻照時(shí),離子引起的柵極瞬態(tài)電流最大值約為500 pA,離子束停止,柵極漏電流基本恢復(fù)到初始值。無(wú)離子輻照時(shí),漏極漏電流IDS小于100 pA;有離子輻照時(shí),離子引起的漏極瞬態(tài)電流最大幅度約為25 nA,離子束停止,漏極漏電流基本恢復(fù)到初始值。

a——柵極;b——漏極圖1 被試器件A-176在100 V偏置電壓下Bi離子輻照中的瞬態(tài)電流Fig.1 Transient current measured for device A-176 during Bi ion irradiation at 100 V bias voltage

a——柵極;b——漏極圖2 被試器件A-178在200 V偏置電壓下Bi離子輻照中的漏電流Fig.2 Leakage current measured for device A-178 during Bi ion irradiation at 200 V bias voltage
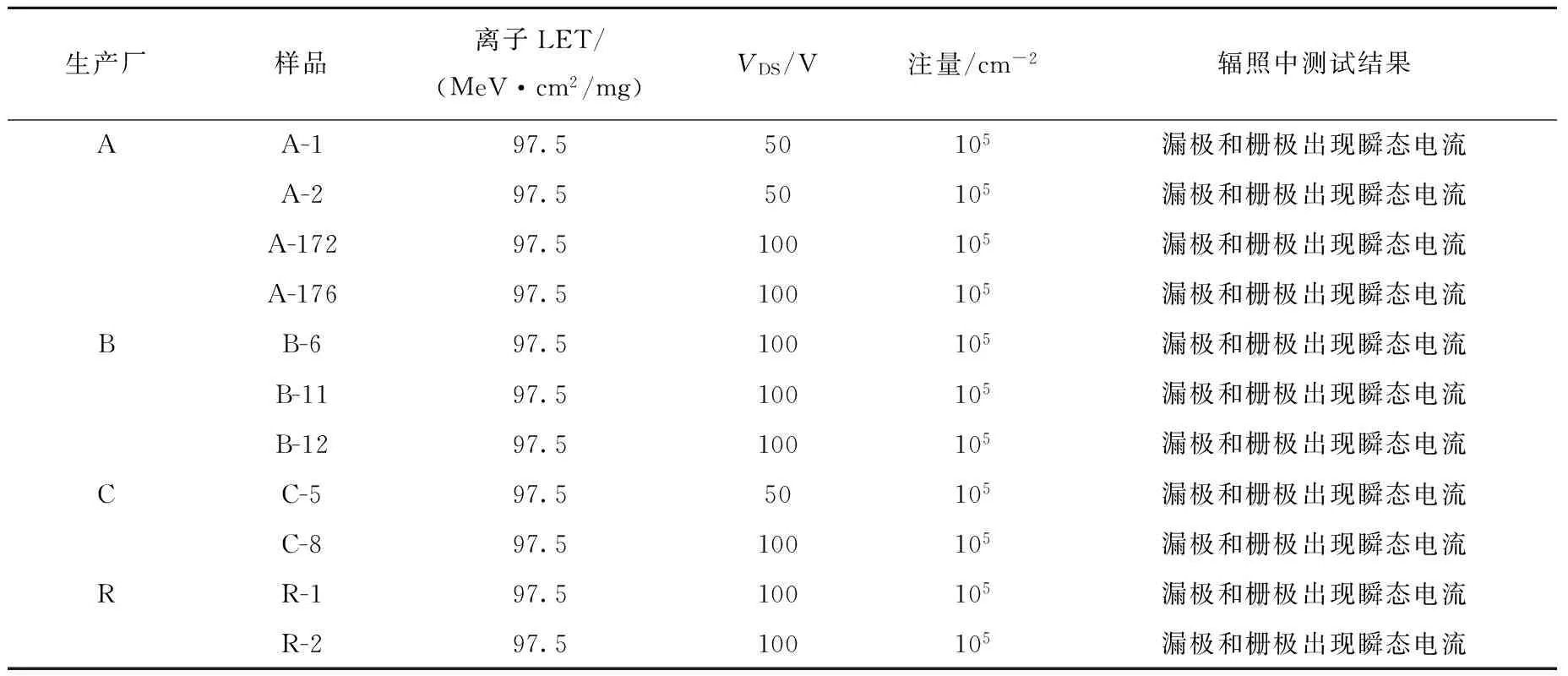
表1 1 200 V SiC MOSFET在50 V和100 V偏置電壓下重離子輻照測(cè)試結(jié)果Table 1 Test result of 1 200 V SiC MOSFET under heavy ion irradiation at 50 V and 100 V bias voltages
重新取樣品在加速器SESRI上用Bi離子、200 V漏源偏置電壓下輻照注量為105cm-2,測(cè)量到和入射離子相對(duì)應(yīng)的漏極和柵極漏電流階躍增加。典型被試器件漏電流階躍增加的測(cè)試結(jié)果示于圖2,可看出,漏電流約每12 s階躍增加,加速器離子輸出周期為12 s,因此判斷器件漏電流階躍增加是入射離子引起的SELC。試驗(yàn)結(jié)果表明,漏電流隨入射離子累積增加,離子束流停止,漏電流未恢復(fù),說(shuō)明離子在器件柵氧化層引入不可恢復(fù)的損傷,導(dǎo)致漏電流不恢復(fù)。
取樣品分別在HI-13串列靜電加速器、加速器HIRFL和SESRI上用C、Ge、Ta、Bi和U離子輻照。離子LET為0.26~118 MeV·cm2/mg,漏源偏置電壓為200~600 V。測(cè)試結(jié)果列于表2,當(dāng)離子LET為0.26 MeV·cm2/mg時(shí),被試器件未發(fā)生SEB或SEGR;當(dāng)離子LET為37~118 MeV·cm2/mg時(shí),被試器件發(fā)生SEB。試驗(yàn)結(jié)果驗(yàn)證了離子LET和偏置電壓增加,重離子會(huì)引起SiC MOSFET發(fā)生SEB。另外,200 V偏置電壓輻照離子注量106cm-2發(fā)生SEB,在相同LET下輻照離子注量105cm-2未發(fā)生SEB,表明離子引起的損傷與注量有關(guān)。
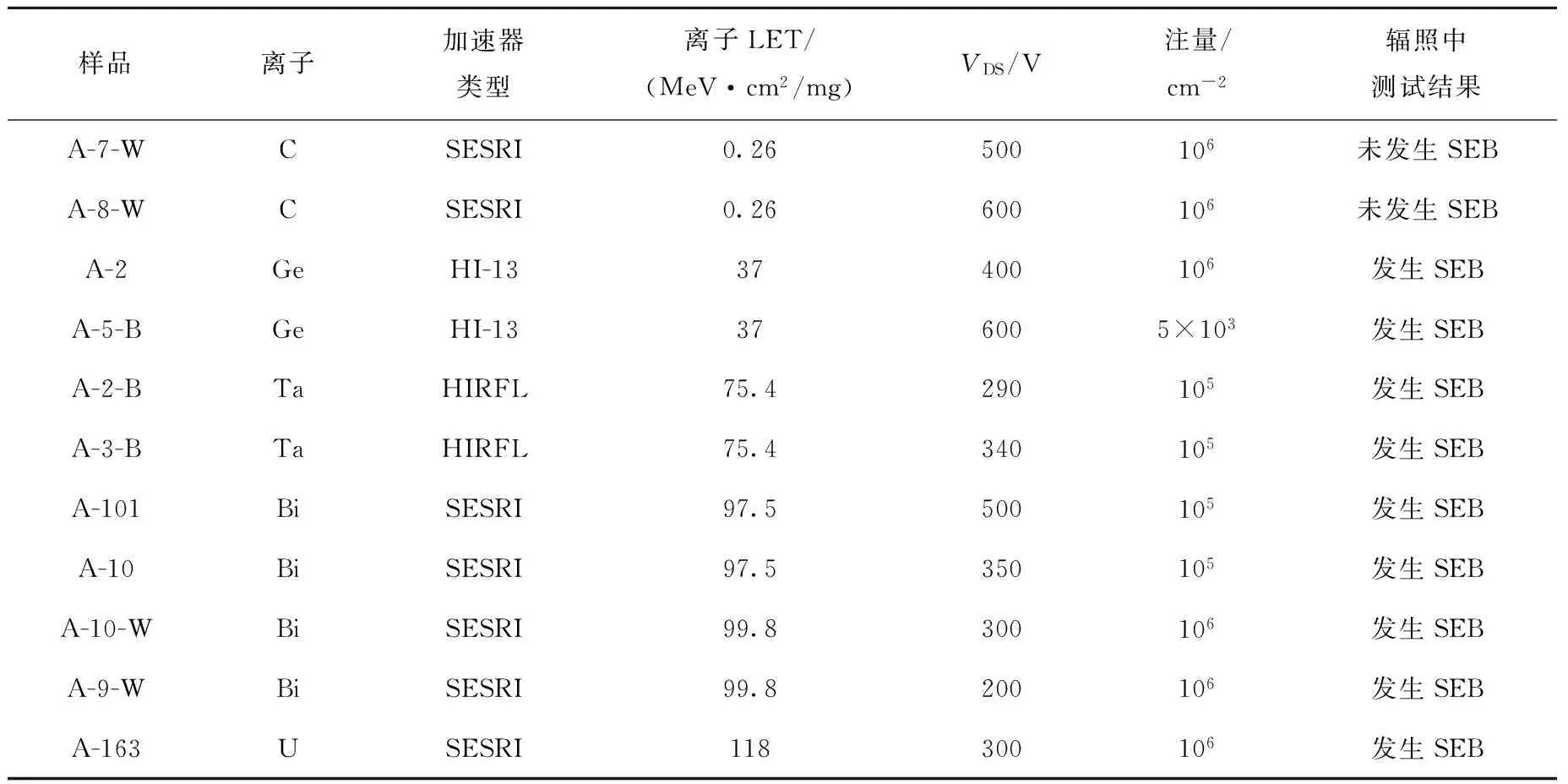
表2 1 200 V SiC MOSFET重離子引起SEB試驗(yàn)結(jié)果Table 2 Test result of SiC MOSFET SEB induced by heavy ions
2.2 PIGS測(cè)試結(jié)果
對(duì)重離子輻照過(guò)程中出現(xiàn)SETC的被試器件進(jìn)行PIGS測(cè)試。經(jīng)過(guò)50 V漏源偏置電壓下輻照注量105cm-2的器件,PIGS測(cè)試過(guò)程中柵漏電流無(wú)明顯變化,PIGS測(cè)試通過(guò);經(jīng)過(guò)100 V漏源偏置電壓下輻照注量105cm-2的器件,PIGS測(cè)試中柵漏電流均超過(guò)100 nA,柵失效。測(cè)試結(jié)果列于表3。典型器件PIGS測(cè)試過(guò)程中柵漏電流隨柵電壓的變化示于圖3。根據(jù)試驗(yàn)結(jié)果推斷,經(jīng)過(guò)100 V偏置電壓輻照注量105cm-2的被試器件,離子在柵氧化層中產(chǎn)生潛在損傷,在PIGS測(cè)試過(guò)程中,潛在損傷在柵電壓應(yīng)力作用下,進(jìn)一步退化,導(dǎo)致柵失效。根據(jù)50 V偏置電壓輻照的被試器件PIGS測(cè)試未出現(xiàn)柵失效、100 V偏置電壓輻照的被試器件PIGS測(cè)試出現(xiàn)柵失效,得出氧化物潛在損傷程度與輻照偏置電壓有關(guān)。

圖3 被試器件A-172 PIGS測(cè)試中柵漏電流隨柵電壓的變化Fig.3 Change of gate leakage current with gate bias voltage during PIGS test for device A-172

表3 出現(xiàn)SETC的器件PIGS測(cè)試結(jié)果Table 3 PIGS test result for device with SETC
為了進(jìn)一步驗(yàn)證氧化物潛在損傷程度與輻照偏置電壓有關(guān),取樣品A-143用Bi離子輻照,離子LET為97.5 MeV·cm2/mg,輻照后進(jìn)行PIGS測(cè)試,測(cè)試結(jié)果列于表4。在50 V漏源偏置電壓輻照后,PIGS測(cè)試柵電流無(wú)明顯變化;在75 V漏源偏置電壓輻照后,PIGS測(cè)試柵電流IGS增加1個(gè)數(shù)量級(jí),在100 V漏源偏置電壓輻照后,PIGS測(cè)試柵失效,試驗(yàn)驗(yàn)證了氧化物潛在損傷隨輻照偏置電壓增大而嚴(yán)重。

表4 SiC MOSFET在不同偏置電壓后PIGS測(cè)試結(jié)果Table 4 PIGS test result for SiC MOSFET irradiated at various bias voltages
2.3 氧化物潛在損傷與離子注量的關(guān)系
為了獲得柵氧化物潛在損傷與離子注量的關(guān)系,進(jìn)行了不同注量輻照試驗(yàn)。取樣品在加速器SESRI上用Bi離子輻照,離子能量為1 200 MeV,芯片表面LET為97.5 MeV·cm2/mg,注量率為5×103cm-2·s-1。在50 V漏源偏置電壓下分別輻照累積注量105、106和107cm-2,在每個(gè)累積注量下分別進(jìn)行PIGS測(cè)試。測(cè)試結(jié)果列于表5,輻照累積注量為105cm-2時(shí),PIGS測(cè)試柵漏電流無(wú)明顯變化;輻照累積注量為106cm-2時(shí),PIGS測(cè)試柵漏電流增加,IGS從pA量級(jí)增加到50 nA;輻照累積注量為107cm-2時(shí),PIGS測(cè)試柵漏電流IGS增大到1 μA,柵失效。測(cè)試結(jié)果表明離子引起的氧化物潛在損傷與離子注量有關(guān),呈現(xiàn)累積效應(yīng)。

表5 1 200 V SiC MOSFET輻照不同累積注量后PIGS測(cè)試結(jié)果Table 5 PIGS test result for SiC MOSFET irradiated at various fluences
2.4 氧化物潛在損傷與離子LET的關(guān)系
為了驗(yàn)證氧化物潛在損傷受離子LET的影響,取樣品采用C、Ge、Bi離子輻照,輻照中實(shí)時(shí)檢測(cè)被試器件IGS和IDS。輻照中未檢測(cè)到SEB和SEGR發(fā)生。輻照后PIGS測(cè)試結(jié)果列于表6。試驗(yàn)結(jié)果表明,入射離子LET增加,PIGS測(cè)試不通過(guò)的可能性增加,驗(yàn)證了氧化物潛在損傷的嚴(yán)重程度與入射離子LET具有正相關(guān)性。

表6 不同離子LET輻照PIGS的測(cè)試結(jié)果Table 6 PIGS test result with various LETs
2.5 柵應(yīng)力時(shí)間的影響
取樣品在HI-3串列靜電加速器上用Ge離子輻照,芯片表面LET為37 MeV·cm2/mg,離子在硅中射程為30 μm,注量率為2×103cm-2·s-1,輻照注量為105cm-2,漏源偏置電壓為200~300 V。輻照后進(jìn)行PIGS測(cè)試,測(cè)試結(jié)果列于表7。由表7可看出:在200 V偏置電壓下輻照的器件,觸發(fā)柵失效需要的柵應(yīng)力時(shí)間超過(guò)300 s;在250 V偏置電壓下輻照的器件,觸發(fā)柵失效需要的柵應(yīng)力時(shí)間為12~69 s;在300 V偏置電壓下輻照的器件,觸發(fā)柵失效需要的柵應(yīng)力時(shí)間為1 s。分析認(rèn)為,高偏置電壓下離子引起的潛在損傷嚴(yán)重,需要的柵應(yīng)力時(shí)間短,因此,得出PIGS測(cè)試需要的柵應(yīng)力時(shí)間與柵氧化物潛在損傷的嚴(yán)重程度有關(guān)。

表7 柵應(yīng)力時(shí)間的測(cè)試結(jié)果Table 7 Test result of gate stress time
2.6 分析討論
由試驗(yàn)結(jié)果可知,在50 V漏源偏置電壓下,隨注量增加離子可引起潛在損傷,在柵應(yīng)力作用下,會(huì)引起柵失效,低于文獻(xiàn)[6-7]給出的100 V潛在損傷閾值;PIGS測(cè)試柵應(yīng)力時(shí)間與損傷程度有關(guān),會(huì)超過(guò)300 s。因此,應(yīng)關(guān)注離子引起潛在損傷對(duì)器件可靠性的影響,進(jìn)行宇航用SiC MOSFET輻射效應(yīng)評(píng)估時(shí),需要針對(duì)性地進(jìn)行潛在損傷影響的評(píng)估。Abbate等[14]指出重離子引起SiC MOSFET失效機(jī)理是兩個(gè)以上離子重復(fù)轟擊同一位置,損傷累加,導(dǎo)致失效。該機(jī)理可以解釋重離子引起的SiC MOSFET輻照損傷具有累積效應(yīng),但在輻照注量105~107cm-2情況下,兩個(gè)離子重復(fù)擊中同一位置的概率很小,幾乎可忽略不計(jì),該機(jī)理不太有說(shuō)服力。分析認(rèn)為可能的失效機(jī)理是電荷累積引起的,高能離子在SiC中電離出電子-空穴對(duì),在SiC中形成一個(gè)瞬時(shí)導(dǎo)電路徑。圖4為高能離子在SiC MOSFET中電離出導(dǎo)電通路示意圖,在漏源加偏置電壓、柵源短接的情況下,該導(dǎo)電路徑的產(chǎn)生使得部分漏源偏置電壓也加在漏柵之間,電離產(chǎn)生的電子-空穴對(duì)在電場(chǎng)作用下分別朝相反的方向漂移,其中,空穴在柵氧化層下面聚集。在50~100 V漏源偏置電壓下輻照,入射離子電離的空穴在柵氧化層下面聚集,增加了柵氧化層上的電壓,導(dǎo)致氧化層內(nèi)電場(chǎng)增加,當(dāng)電場(chǎng)增加到足夠大時(shí),會(huì)在柵氧化層引入潛在損傷。柵極不同位置入射離子產(chǎn)生的電荷對(duì)氧化層內(nèi)電場(chǎng)增加具有疊加作用,因此,多個(gè)重離子引起的損傷具有累積效應(yīng)。在200 V偏置電壓下輻照,電荷在柵氧化層兩邊聚集的足夠多,導(dǎo)致氧化層內(nèi)電場(chǎng)過(guò)高,在柵氧化層引入不可恢復(fù)的損傷。

圖4 高能離子在SiC MOSFET中電離出導(dǎo)電通路示意圖Fig.4 Current path induced by heavy ions in SiC MOSFET
為進(jìn)一步解釋重離子造成SiC MOSFET柵極損傷的現(xiàn)象,使用Sentaurus TCAD仿真工具建立二維仿真模型。仿真器件結(jié)構(gòu)和關(guān)鍵參數(shù)列于表8。
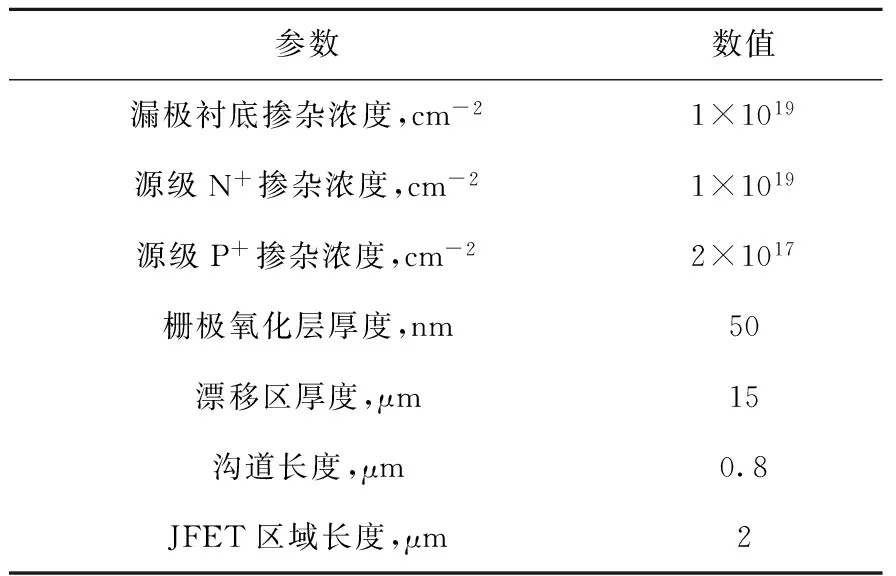
表8 TCAD仿真的主要參數(shù)Table 8 Main parameter for TCAD simulation
根據(jù)SiC MOSFET的材料特性,在仿真的物理模型中考慮不完全電離模型、禁帶變窄模型;對(duì)于載流子的輸運(yùn),考慮漂移擴(kuò)散模型;對(duì)于載流子的產(chǎn)生復(fù)合考慮SRH模型、俄歇復(fù)合和電場(chǎng)驅(qū)動(dòng)的雪崩擊穿模型;對(duì)于載流子遷移率,考慮摻雜模型、高電場(chǎng)飽和模型。由于需要仿真重離子入射,所以同時(shí)考慮了重離子模型,重離子對(duì)柵極損傷的最壞情況是離子從關(guān)態(tài)器件的柵極中心表面垂直入射,本文采用這一入射方式,重離子的主要參數(shù)列于表9。
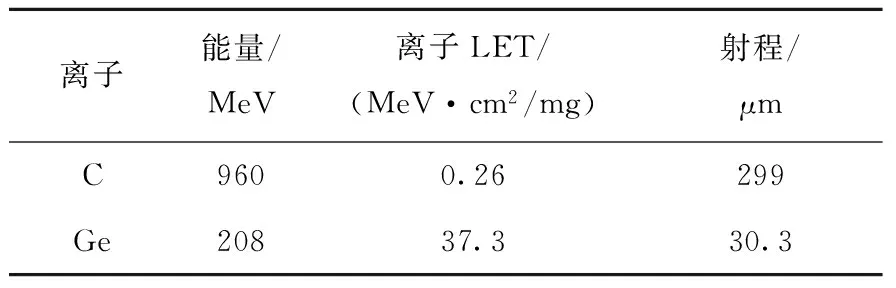
表9 仿真使用的離子參數(shù)Table 9 Main characteristic of heavy ions used in simulation
重離子射程保證可以穿過(guò)整個(gè)器件的漂移區(qū)(>15 μm),高斯分布徑跡半徑為0.05 μm,重離子的LET設(shè)置為0.25 pC/cm和0.02 pC/cm(相當(dāng)于SiC材料的37 MeV·cm2/mg和0.3 MeV·cm2/mg)。為研究重離子入射對(duì)柵極損傷的影響,仿真重離子入射時(shí)的瞬時(shí)電場(chǎng)分布情況,圖5為VDS=100 V、Ge離子入射時(shí)間t=4 ps時(shí),SiC MOSFET柵極區(qū)域的電場(chǎng)分布。重離子入射后,在軌跡周?chē)纬纱罅侩娮?空穴對(duì)的等離子柱,在強(qiáng)電場(chǎng)作用下,電子和空穴沒(méi)有復(fù)合,而是被電場(chǎng)驅(qū)動(dòng)產(chǎn)生瞬時(shí)電流,漏極電壓將會(huì)耦合到柵極上,導(dǎo)致柵極電場(chǎng)增大,這是重離子引起柵極損傷的重要原因。
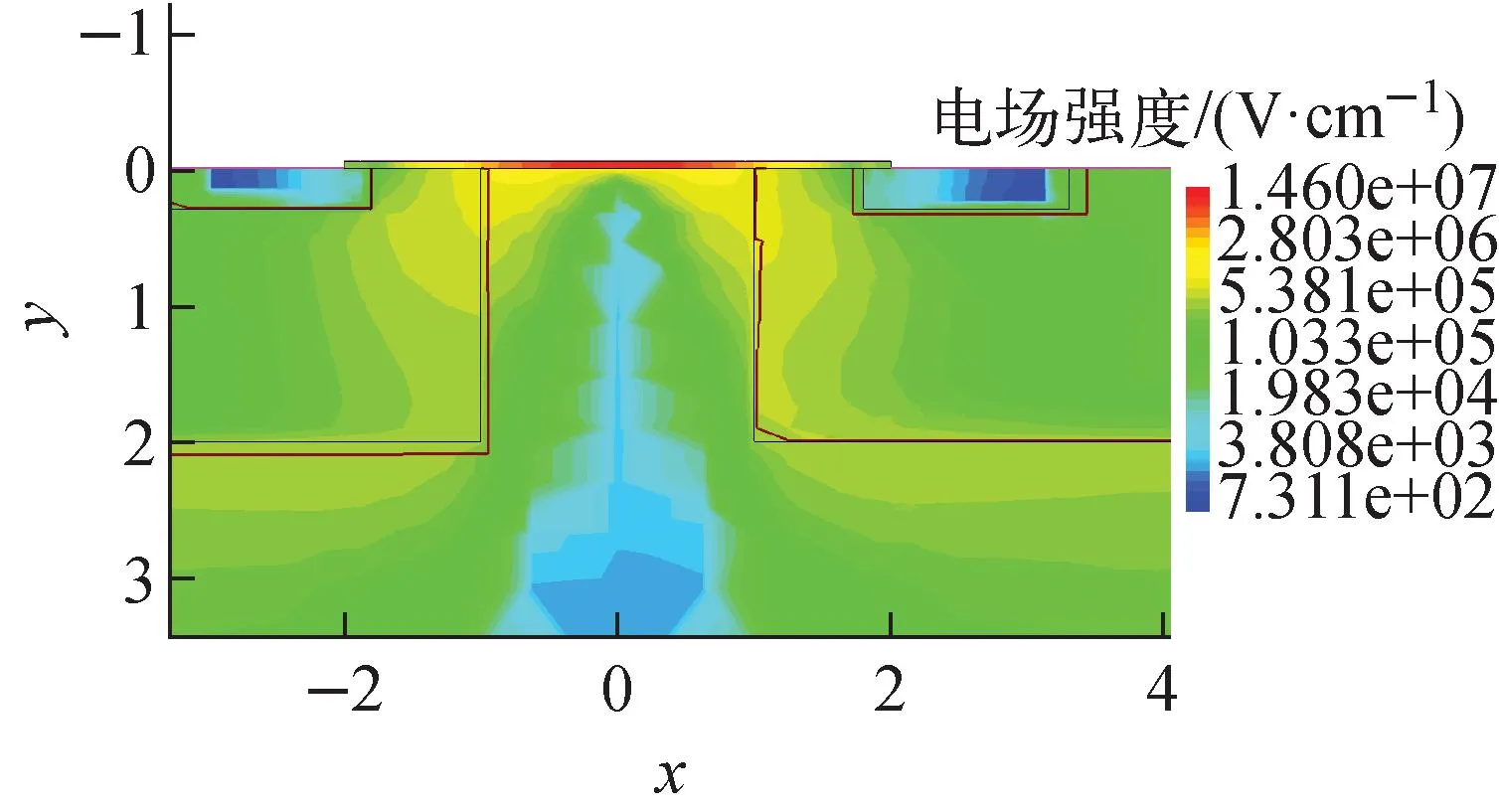
圖5 VDS=100 V、Ge離子入射時(shí)間t=4 ps時(shí)SiC MOSFET柵極區(qū)域的電場(chǎng)分布Fig.5 Electric field distribution in gate region of SiC MOSFET with VDS=100 V and Ge ion incidence time t=4 ps
仿真VDS=100 V和VDS=200 V偏置電壓時(shí)Ge離子入射SiC MOSFET的柵極電場(chǎng)隨時(shí)間的變化情況,結(jié)果如圖6所示。同一離子入射時(shí),不同偏置電壓下柵極電場(chǎng)EOX隨時(shí)間變化的趨勢(shì)相同,t=4 ps時(shí)柵極電場(chǎng)達(dá)到最高值,VDS=200 V時(shí)EOX_MAX=27.8 MV/cm,VDS=100 V時(shí)EOX_MAX= 14.7 MV/cm。柵極峰值電場(chǎng)隨偏置電壓升高,會(huì)導(dǎo)致更嚴(yán)重?fù)p傷產(chǎn)生。

圖6 VDS=100 V和VDS=200 V偏置電壓時(shí)Ge離子入射過(guò)程中SiC MOSFET柵極電場(chǎng)變化Fig.6 Change of gate electric field of SiC MOSFET during Ge ion incidence at VDS=100 V and VDS=200 V
研究入射離子LET對(duì)SiC MOSFET柵極損傷的影響,仿真VDS=100 V時(shí)Ge和C離子入射對(duì)柵極電場(chǎng)的影響,結(jié)果如圖7所示。在同一偏置電壓下,LET低的C離子導(dǎo)致的峰值電場(chǎng)EOX_MAX=6.7 MV/cm,LET高的Ge離子導(dǎo)致的峰值電場(chǎng)EOX_MAX=14.7 MV/cm,更高的LET會(huì)導(dǎo)致更嚴(yán)重的柵極損傷。

圖7 C離子(LET =0.26 MeV·cm2/mg)和Ge離子(LET =37 MeV·cm2/mg)入射過(guò)程中SiC MOSFET柵極電場(chǎng)的變化Fig.7 Change of gate electric field of SiC MOSFET during incidence of C ions (LET=0.26 MeV·cm2/mg) and Ge ions (LET=37 MeV·cm2/mg)
3 結(jié)論
用重離子輻照1 200 V SiC MOSFET,在50~100 V偏置電壓下離子引起柵氧化物潛在損傷,潛在損傷會(huì)引起柵失效;在200 V偏置電壓下離子引起的不可恢復(fù)的損傷;在200~600 V偏置電壓下離子引起SEB。試驗(yàn)和仿真分析確認(rèn)離子入射引起柵氧化物潛在損傷與偏置電壓、入射離子LET和注量等呈正相關(guān)。試驗(yàn)結(jié)果表明柵單粒子效應(yīng)最敏感,在約5%額定擊穿電壓下會(huì)發(fā)生離子引入的氧化物潛在損傷引起器件失效。在SiC MOSFET加固和空間應(yīng)用中,需要評(píng)估離子引起的氧化物潛在損傷的影響,應(yīng)根據(jù)軌道和任務(wù)周期確定試驗(yàn)用離子注量和偏置電壓,并確定適合的PIGS測(cè)試柵應(yīng)力時(shí)間。
感謝中國(guó)原子能科學(xué)研究院郭剛研究員團(tuán)隊(duì)、中國(guó)科學(xué)院近代物理研究所劉杰研究員團(tuán)隊(duì)和哈爾濱工業(yè)大學(xué)劉超銘副教授、王天琦副研究員、劉劍利研究員及其團(tuán)隊(duì)在重離子試驗(yàn)過(guò)程中給予的幫助。
- 原子能科學(xué)技術(shù)的其它文章
- 球形壓頭半徑對(duì)離子輻照后RAFM鋼硬度及力學(xué)性能提取的影響
- Laser-assisted Simulation of Dose Rate Effects of Wide Band Gap Semiconductor Devices
- 基于實(shí)驗(yàn)與仿真的SiC JFET單粒子效應(yīng)研究
- JFET區(qū)寬度對(duì)SiC MOSFET單粒子效應(yīng)的影響
- Effects of Strain Channel on Electron Irradiation Tolerance of InP-based HEMT Structures
- 一種新型高抗輻照可配置SOI器件技術(shù)

