有限元分析軟件在封裝結構變形影響中的應用
郝永平,盧繼奎,楊 芳
(沈陽理工大學CAD/CAM技術研究與開發中心,遼寧沈陽 110168)
0 引言
壓阻式加速度計采用的主要結構基本都是相同的[1],包括一個懸臂梁懸掛的質量塊,而懸臂梁連接到一個固定的外框上。封裝結構的變形會引起懸臂梁發生變形,從而影響微加速度計的性能。通常,封裝結構需要具有4種主要功能[2-3]:1)信號的輸入輸出端向外界的過渡手段;2)電源的輸入輸出同外界的過渡手段;3)散熱;4)保護器件不受外界環境的影響。Tanner等[4]曾對封裝好的加速度計在沖擊環境下的可靠性進行了很多實驗研究,Davies[5]提出了高g值加速度計封裝設計上的幾個原則,吳含琴等[6]曾對開關封裝結構熱形變對芯片性能的影響進行過研究,董健[7]對沖擊硅微機械加速度傳感器進行了封裝性能分析,但只進行了模態分析,沒有指出影響的具體數值。為此,引入有限元分析軟件Coventor Ware的Package模塊進行定量分析。
1 Coventor Ware簡介
有限元分析軟件Coventor Ware是目前分析MEMS結構的專業軟件,包括MEMS工藝的模擬、壓阻分析、壓電分析、靜電分析、電磁分析等,其中的Package分析模塊能對MEMS器件進行封裝分析,計算出封裝結構變形對封裝芯片性能的影響,并給出具體的影響值數值。
在Package分析模塊中,首先分析出傳感器工作時由于工作環境發生變化,封裝結構產生變形的情況,然后將封裝結構變形情況,施加在傳感器芯片上,從而分析出封裝結構變形對芯片性能的影響。
2 Package模塊的應用
本文采用Coventor Ware有限元分析軟件進行建模和仿真分析。該壓阻式加速度計,測量垂直于加速度計方向的重力加速度,量程為10 000~50 000 g。加速度計包含一個兩端固定梁,懸于支撐架上,梁中間有一質量塊,用于在承受加速度載荷時增加梁的變形。質量塊長 1 200μm,寬 640μm,兩端固定梁長和寬分別為6 400μm和420μm,厚度為300μm。壓阻材料嵌入質量塊與兩端固定梁連接處,建立的模型如圖1所示。本文的封裝方法采用文獻[7]中提供的思路進行封裝。封裝結構采用 TUNGSYEN-kyocera材料,這種材料相對于可伐合金有較好的散熱性、優良的電磁屏蔽性能以及良好的力學性能。用鈦絲連接芯片的鋁布線壓點和管腳,使它具有良好的延展性,用環氧樹脂粘結金屬基板與芯片。

圖1 加速度計芯片結構Fig.1 Structure of the acceleration sensor
模擬分析思路:首先利用Coventor Ware進行建模,然后借助Coventor Ware中Package分析模塊,分析出封裝結構由于工作環境發生變化而產生的變形,最后將得到的分析結果作為分析加速度計芯片時的初始條件,以此來模擬封裝結構變形對加速度計芯片性能的影響。分析示意圖如圖2所示。
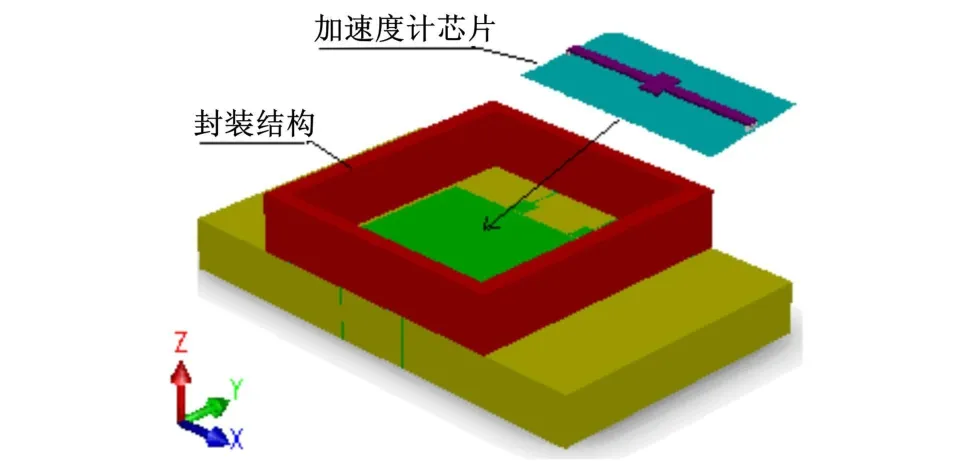
圖2 整體封裝示意圖Fig.2 Schematic diagram package
封裝殼體的材料參數和結構參數如表1和表2所示。

表1 封裝結構的材料參數Tab.1 Package of material parameters

表2 封裝結構的尺寸Tab.2 Package size
3 封裝結構熱形變對芯片的影響
芯片工作發熱有多種散熱機制,其中主要的是向襯底和封裝基板(包括熱沉)的熱傳導。熱量向外傳導時,由于封裝結構中各材料的熱膨脹系數不同,當發生變形時,其形變的大小很可能是不一致的,因而產生熱彈性應力。具體將表現為芯片表面的彈性正應變和彎曲,對芯片上開關器件的工作性能和可靠性產生明顯的影響[6]。
當加速度傳感器的工作環境溫度發生變化時,會引起封裝結構的變形,從而對芯片性能產生影響。溫度從280~440 K變化時,經過分析封裝結構的變形如圖3所示。

圖3 不同溫度下封裝結構最大變形量Fig.3 At different temperatures the structure of the largest package deformation
圖3 中曲線表明,封裝結構隨著溫度的升高變形隨之增加。
由于封裝結構發生熱形變時會引起芯片產生相應的變形,圖4示意了芯片所發生的位移變形。從圖中可以看出,芯片的最大變形量發生在質量塊附近,即壓阻材料的放置位置,因此會對芯片的性能產生影響。
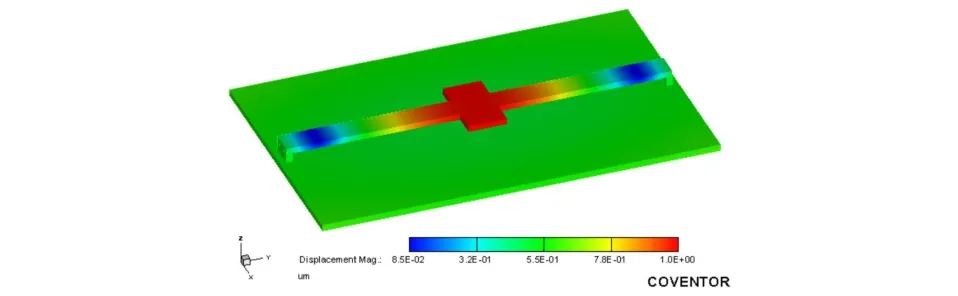
圖4 芯片變形圖Fig.4 Chip deformation map
電流輸出是壓阻式加速度計性能的一個重要指標,通過分析輸出電流的變化情況,就可以判別封裝機構在溫度變化是對芯片的影響。
在加速度計在正常工作時,取溫度變化范圍273~339K,計算了芯片的變形與電流的輸出,如表3所示。

表3 不同溫度下芯片的變形以及電流輸出情況Tab.3 chips at different temperatures and current output of the deformation of the situation
從表3的結果可以得出,溫度在339 K時,電流輸出為8.728 9×1010p A。在封裝結構不發生變形時,輸出電流為8.727 2×1010p A。電流的變化值為0.001 7×1010pA,誤差為0.019%。由此可以看出,溫度對該加速度計的性能影響很小。這是由于該加速度計的尺寸較大,溫度發生變化時對芯片的影響很小。
4 高過載沖擊對芯片性能的影響
對高g值加速度傳感器,量程為10 000~50 000 g,考慮封裝結構受到沖擊時對芯片的影響。當加速度計工作時,封裝結構的底部固定在被測件上,分析封裝殼體分別受到X、Y方向沖擊時對芯片的影響。
4.1 沿X方向沖擊載荷對芯片性能的影響
將封裝結構的底部固定,當整體受到50 000 g的沖擊,觀察其應力以及位移變化。圖5顯示了受到X方向沖擊時的封裝結構變形量,最大變形為0.09 μm,最大變形發生在封裝結構的頂部,對芯片影響不大。從圖6可以知道受到沖擊時,封裝結構最大應力為77 MPa,遠遠小于封裝材料的屈服應力,因此在高過載情況下,封裝結構滿足強度要求。封裝結構受到沖擊產生的變形對芯片的影響如圖7所示,可以看出芯片的最大變形僅為0.057μm,變形量很小,且最大變形發生在芯片的兩端,對壓阻部件的影響很小。根據表3的數據可以得出,芯片發生1.78μm的變形時對電流輸出只有0.032%的影響,故載荷沖擊芯片發生變形0.057μm時,對電流輸出的影響可以忽略。
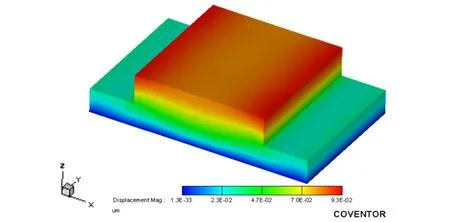
圖5 承受X方向沖擊時封裝結構變形Fig.5 Under the direction of theimpact of X package structure deformation

圖6 承受X方向沖擊時封裝結構應力分布圖Fig.6 Under the X direction of the impact of stress distribution package structure

圖7 承受X方向沖擊時芯片變形圖Fig.7 Under the direction of theimpact of X chart the chip deformation
4.2 沿Y方向沖擊載荷對芯片性能的影響
由于芯片沿X方向放置,因此在受到Y方向的沖擊時產生的影響與X方向受到沖擊的情況不同。圖8所示為封裝結構受到Y方向時的應力分布情況,可以看出在封裝結構的底部應力比較集中,最大應力為41 MPa,相對于X方向受到沖擊時應力減小了很多,這是因為在Y方向的受沖擊面積相對于X方向大,所以有助于減小應力。圖9為封裝結構受到Y方向的沖擊的變形圖,這與X方向受到沖擊時變形相似,但是最大變形只有0.012μm。圖10為芯片相應的位移變形圖,從圖中可以得出,最大的變形量為0.066μm,與X方向受到沖擊時的結果類似,因此可以忽略。
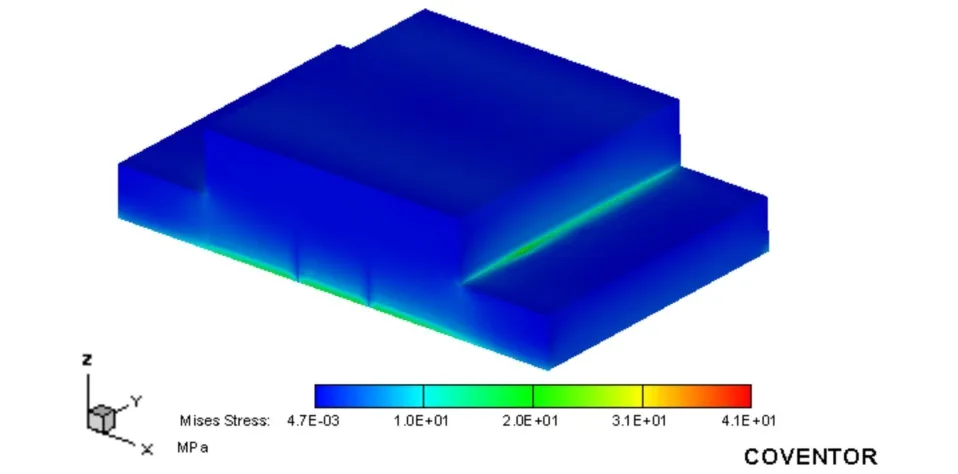
圖8 承受Y方向沖擊時封裝結構應力分布圖Fig.8 Under the Y direction of the impact of stress distribution package structure
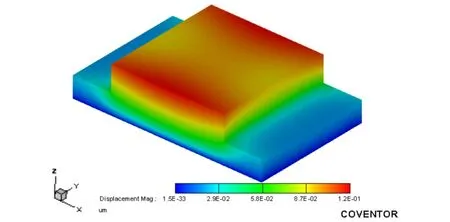
圖9 承受Y方向沖擊時封裝結構變形Fig.9 Under the direction of theimpact of Y package structure deformation
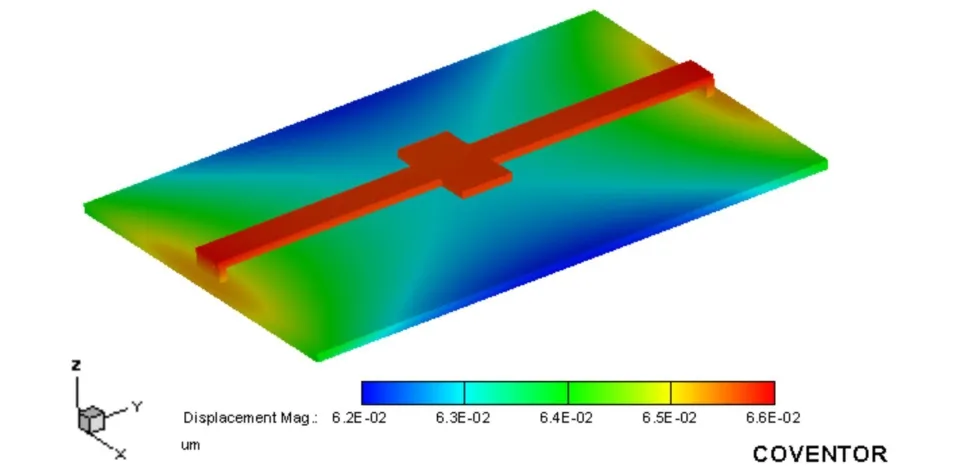
圖10 承受Y方向沖擊時芯片變形圖Fig.10 Under the direction of the impact of Y chart the chip deformation
分析結果表明:在常溫下,封裝結構變形對芯片性能的影響很小,誤差為0.019%;同時封裝結構受到沖擊時對芯片的影響很小,誤差最大為0.032%,在工作環境的溫度發生變化和受到沖擊時,加速度計可以正常工作。得出的結論與文獻[7]實驗結論一致:沖擊硅微機械加速度傳感器封裝結構在不影響傳感器測試精度的同時具有較好抗沖擊破壞能力。
5 結論
本文利用 Coventor Ware有限元分析軟件中Package模塊進行了封裝結構變形對壓阻式加速度計的性能影響分析。分析結果表明,溫度和沖擊作用于壓阻式傳感器封裝結構對傳感器的性能影響很小,均在萬分之一數量級,與前人的試驗結果吻合。
[1]陳雪萌,李昕欣,宋朝暉,等.一種新結構硅微機械壓阻加速度計[J].傳感技術學報,2005(3):500-503.CHEN Xuemeng,LI Xinxin,SONG Zhaohui,et al.A new structure silicon piezoresistive micromachined accelerometer[J].Chinese Journal of Sensors and Actuators,2005(3):500-503.
[2]O'neal Chad B,Mal she Ajay P,Singh Sushila B,et al.Challenges in the packaging of MEMS[C]//1999 International Symposium on Advanced Packaging Materials.1999:41-47.
[3]Jackson K A,屠海令.半導體工藝[M].萬群,譯校.北京:科學出版社,1999.
[4]Tanner DM,Waleaven J A,Helgesen K,et al.MEMS reliability in shock environments[C]//Proceedings of International Reliability Physics Symposium USA:San Jose,2000.
[5]Davies B R,Barron C C,Montague S,et al.High G MEMS Integrated Accelerometer[J].SPIE Proceedings,1997,3 046:52-62.
[6]吳含琴,廖小平,董喬華.MEMS開關封裝結構熱形變對芯片性能的影響[J].微納電子技術,2006(6):293-297.WU Hanqin,LIAO Xiaoping,DONG Qiaohua.Effects of thermal displacement of MEMS switch package structure on chip performance[J].Micronanoelectronic Technology,2006(6):293-297.
[7]董健.沖擊硅微機械加速度傳感器的封裝與封裝性能分析[J].傳感技術學報,2008(6):959-963.DONG Jian.Package of silicon micromachined shock accelerometer and package performance analysis[J].Chinese Journal of Sensors and Actuators,2008(6):959-963.

