利用激光干涉的方法制備亞微米光柵結構圖形襯底
文/北京景山學校高三(4班) 陳光旭指導科學家/陳弘
利用激光干涉的方法制備亞微米光柵結構圖形襯底
文/北京景山學校高三(4班) 陳光旭指導科學家/陳弘
納米材料從20世紀80年代開始受到了人們的廣泛關注,現已發展了納米金屬材料、納米半導體薄膜、納米陶瓷、納米磁性材料和納米生物醫學材料等。其中納米半導體薄膜材料的研究對半導體電子學、光子學有著非常重要的意義。圖形襯底作為薄膜材料的一個重要分支,在制造半導體和磁性材料中有多方面的潛在的應用價值,在開發新型器件中有著重要作用。圖形襯底中最基本的就是光柵結構,由于傳統半導體紫外曝光技術受到光的衍射作用限制,不適用于制作亞微米光柵結構圖形襯底,所以本人發明了利用激光干涉的方法制備亞微米光柵結構圖形襯底。
到底什么是亞微米光柵結構圖形襯底呢?它是指在光滑平整的拋光襯底面上刻蝕出具有幾百納米尺寸的周期性結構的襯底(如下圖所示,條紋圖形襯底和孔洞圖形襯底)。亞微米光柵結構圖形具有廣闊的應用價值,科研上可用于規則生長納米尺寸的點、線、柱等,研究半導體材料的量子限制效應,光子晶體的制作等;工業上可作為生長模板,生產高密度磁記錄材料、光電子材料、電池電極材料、太陽能電池材料等。
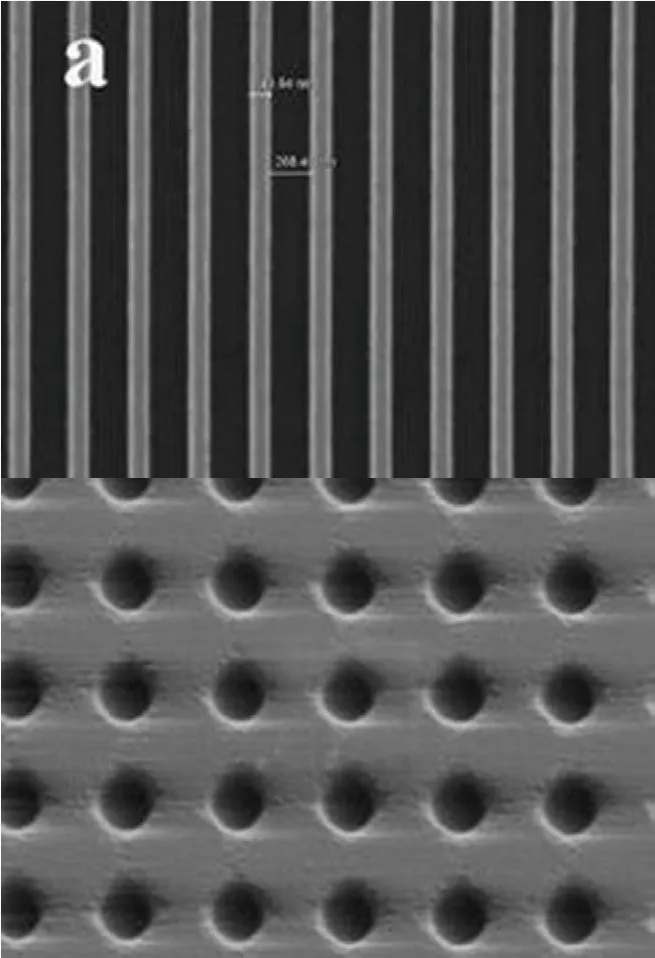
亞微米光柵結構圖形襯底的制作一般需要使用光刻技術。作為主要的光刻技術之一,傳統投影學光刻一直以來都是半導體工業發展的主流技術,但是諸多因素,如有限的數值孔徑、掩膜結構日漸復雜和透鏡光學材料等,都制約了傳統投影光學光刻的進一步發展,只能生產周期為微米尺度的圖形。如想進一步制備亞微米級別的材料,需要克服光的衍射問題。所以制作亞微米圖形襯底對微細加工技術提出了更高的要求,需要能以高分辨率(百納米級別)對周期圖形成像。以離軸照明技術(OAI),相移掩膜技術(PSM),光學臨近效應校正技術(OPC)為代表的分辨力增強技術(RET)在一定程度上提高了分辨力,推進了光刻極限,但仍然無法滿足制作亞微米光柵結構圖形襯底的要求。目前,制作亞微米光柵結構圖形襯底的常用制備方法是電子束曝光和聚焦離子束曝光的方法,但因其直寫時間長,設備昂貴等原因,僅能滿足科研的需要,無法應用在大規模的生產過程中。
無掩模激光干涉光刻 (Laser Interference Lithography, LIL)的方法采用相干光束干涉,利用容易得到的光源和抗蝕劑,無需掩模和昂貴的光刻透鏡就可得到亞微米及納米級的圖形,雖然很難用于任意圖形,但特別適合產生微器件的周期結構,正好符合制作亞微米光柵結構圖形襯底的基本要求。而且這種方法效率高,成本低,適宜大規模生產制作。因此利用激光干涉的方法制備亞微米光柵結構圖形襯底就成為了最佳選擇。
激光干涉原理為兩束相干激光光束在襯底上相遇形成干涉條紋,要形成穩定的干涉圖樣,兩光束需要滿足以下三個條件:1)相同的頻率;2)固定的光程差;3)相同的偏振方向。本人發明的利用激光干涉的方法制備亞微米光柵結構圖形襯底是將325nm紫外激光從激光器中射出后經光束分束器一分為二,分別經過空間濾波器,最終共同照射在旋涂過光刻膠的基底上,使基底曝光,得到干涉圖樣。為獲得不同周期的光柵,需要對光的入射角度進行調整(如下圖所示),這樣的結構更為簡單,光柵周期可在不改變光路的情況下方便調節,只需調節反光鏡即可。

襯底的制作共分九個步驟:首先,進行硅片清洗。采用丙酮、酒精、去離子水各5分鐘的超聲波清洗,去除有機及顆粒雜質,并將襯底片置于熱板上,在150℃的溫度條件下脫水烘焙5分鐘。其次,進行涂膠。使用國產正性光刻膠與正膠稀釋劑按1:4稀釋,使得膠厚在第一步達到1500rpm,第二步達到7000rpm,30秒的條件下處于70~100nm的范圍(經實驗驗證此范圍膠厚實驗效果最優)。第三,前烘。將涂膠后的片子置于熱板上,90℃溫度條件下烘烤2分鐘。第四,曝光。將前烘的片子置于角狀反射器的襯底臺上曝光,曝光功率0.8mw,時間60秒,得到光柵圖形。通過連續曝光兩次,兩次襯底片的角度互相垂直,可得到孔洞或點狀陣列。第五,后烘。將曝光后的片子置于熱板上110℃烘烤2分鐘。第六,顯影。將經過后烘過的片子置于稀釋后的顯影液(顯影液:去離子水=2:3)中顯影30秒。第七,堅膜。將烘后的片子置于熱板上,130℃烘烤2分鐘。第八,刻蝕。利用硝酸和氫氟酸的混合液刻蝕硅片,深度十幾納米,將光刻膠圖形轉移到襯底上。第九,去膠。利用丙酮去除有機的光刻膠,得到圖形襯底。
經過多次的實驗、制作與觀察,初步掌握了亞微米光柵結構圖形襯底的制作方法以及制作過程中的一些變量的控制以及技巧,如光路的控制、入射角度的控制、甩膠轉速以及顯影時間的控制等。在入射角為30.5°時制備出直徑為210nm的點陣,并在入射角度為15°、24°、33°、40.5°時成功制成了符合要求的幾百納米的光柵結構襯底。
利用激光干涉的方法制作亞微米光柵結構圖形襯底這一創新方法獲得“明天小小科學家”一等獎。
責編/畢海蛟

