0.18 μm MOS差分對(duì)管總劑量失配效應(yīng)研究
吳 雪,陸 嫵,王 信,郭 旗,張興堯,于 新
(1.中國(guó)科學(xué)院 特殊環(huán)境功能材料與器件重點(diǎn)實(shí)驗(yàn)室,新疆理化技術(shù)研究所,新疆 烏魯木齊 830011;2.新疆電子信息材料與器件重點(diǎn)實(shí)驗(yàn)室,新疆 烏魯木齊 830011;3.中國(guó)科學(xué)院大學(xué),北京 100049)
隨著半導(dǎo)體制造工藝技術(shù)的發(fā)展,器件特征尺寸逐漸向超深亞微米、納米尺寸發(fā)展,在實(shí)際制造工藝中,由于每一道工序的不確定性,設(shè)計(jì)標(biāo)稱相同的器件也會(huì)存在有限的失配,而器件特征尺寸的減小則使晶體管間的失配性能越來(lái)越差[1]。在高精度模擬電路設(shè)計(jì)中,晶體管之間的匹配性能非常關(guān)鍵,其對(duì)模擬電路的失調(diào)電壓、電流等均會(huì)帶來(lái)一定的影響[2-5]。因此小尺寸模擬電路的性能受其影響日趨嚴(yán)重。中國(guó)科學(xué)院上海微系統(tǒng)與信息技術(shù)研究所、新疆理化技術(shù)研究所等對(duì)深亞微米MOS晶體管均進(jìn)行了總劑量輻照試驗(yàn),結(jié)果表明:與微米工藝(0.5 μm以上)相比,深亞微米工藝MOS晶體管閾值電壓不再是輻射敏感參數(shù),而輻射感生漏電流仍是其薄弱環(huán)節(jié),其主要原因?yàn)楦綦x氧化層在輻照過(guò)程中引入了大量的陷阱電荷[6]。國(guó)外針對(duì)更小尺寸(100 nm以下)CMOS晶體管電離輻射效應(yīng)進(jìn)行了研究,結(jié)果表明:尺寸越小,其抗總劑量能力越強(qiáng),且閾值電壓變化越小[7-8]。任迪遠(yuǎn)等[4-5]對(duì)CMOS工藝運(yùn)算放大器進(jìn)行了60Co γ輻照、質(zhì)子輻照及室溫退火效應(yīng)的研究,結(jié)果表明:輻照引起運(yùn)算放大器中差分對(duì)管的匹配性能惡化是導(dǎo)致失調(diào)電壓、電源電壓抑制比等參數(shù)退化的主要原因。國(guó)內(nèi)外對(duì)半導(dǎo)體制造工藝引起的晶體管失配、失配模型及其對(duì)集成電路帶來(lái)的影響進(jìn)行了研究[9-11],但關(guān)于電離輻射環(huán)境下差分對(duì)管失配特性的研究鮮有報(bào)道,因此,本文以0.18 μm MOS差分對(duì)管為研究對(duì)象,對(duì)樣品輻照前后轉(zhuǎn)移特征曲線、閾值電壓、柵極電流等進(jìn)行測(cè)試、分析,研究深亞微米器件的失配特性,為進(jìn)一步了解深亞微米MOS差分對(duì)管失配隨輻照總劑量的變化情況及其對(duì)模擬電路帶來(lái)的影響奠定基礎(chǔ)。
1 總劑量輻照試驗(yàn)
試驗(yàn)樣品為同一批次國(guó)產(chǎn)標(biāo)準(zhǔn)工藝線0.18 μm NMOS、PMOS差分對(duì)管。樣品的寬度、長(zhǎng)度分別為100 μm、0.18 μm,采用STI隔離技術(shù),最大工作電壓為1.8 V。輻照試驗(yàn)在中國(guó)科學(xué)院新疆理化技術(shù)研究所60Co γ源上進(jìn)行,劑量率為0.510 4 Gy(Si)/s。輻照過(guò)程中,NMOS器件偏置條件為:VG=VD=1.8 V,VS=0 V;PMOS器件偏置條件為:VG=VD=0 V,VS=1.8 V。每次輻照完成后,對(duì)輻照樣品進(jìn)行轉(zhuǎn)移特征曲線測(cè)試,測(cè)試過(guò)程中同時(shí)對(duì)柵極電流進(jìn)行測(cè)試,確保試驗(yàn)樣品在輻照及測(cè)試過(guò)程中未發(fā)生柵極擊穿現(xiàn)象。曲線測(cè)試在KEITHLEY4200半導(dǎo)體綜合參數(shù)分析儀上進(jìn)行,每次測(cè)試過(guò)程不超過(guò)20 min,以減小測(cè)試所帶來(lái)的退火效應(yīng)。
2 試驗(yàn)結(jié)果與分析
2.1 柵極電流
圖1為NMOS及PMOS差分對(duì)管輻照前后柵極電流的變化(Ig1、Ig2分別為差分對(duì)管中第一、二只晶體管柵極電流)。輻照前,NMOS晶體管的柵極電流約為4×10-12A,且差分對(duì)管中兩只晶體管失配很小;當(dāng)輻照2 000 Gy(Si)時(shí),柵極電流增大到約4×10-11A,但柵極電流失配增大,且柵極電壓越大,晶體管失配越大。PMOS差分對(duì)管的輻照變化和NMOS一致。
本試驗(yàn)樣品柵氧化層厚度約為4 nm,盡管電離總劑量輻照會(huì)在柵氧化層中產(chǎn)生陷阱電荷,但由于柵氧化層足夠小,使柵極或Si/SiO2界面的電子會(huì)隧穿至柵氧化層中,這樣輻照產(chǎn)生的柵氧化層陷阱電荷會(huì)被中和,這也是柵極電流對(duì)總劑量輻照不敏感的原因。由于差分對(duì)管中不同晶體管在工藝制造過(guò)程中的差異,使輻照產(chǎn)生的柵氧化層陷阱電荷數(shù)量及隧穿過(guò)來(lái)的電子數(shù)量可能不同,從而導(dǎo)致CMOS差分對(duì)管的柵極電流匹配性能變差。盡管MOS差分對(duì)管的柵極電流失配隨輻照總劑量的增加而增大,但由于柵極電流變化很小,輻照到2 000 Gy(Si)后僅為10-11A,其變化在模擬電路應(yīng)用中基本可忽略,不會(huì)對(duì)高精度模擬電路造成影響[1]。
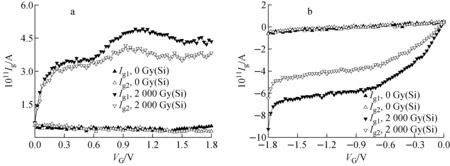
圖1 輻照前后NMOS(a)及PMOS(b)差分對(duì)管的柵極電流變化曲線
2.2 漏極電流
圖2為NMOS及PMOS差分對(duì)管的轉(zhuǎn)移特征曲線隨輻照總劑量的變化情況。從圖2可看出,輻照前,NMOS和PMOS差分對(duì)管的轉(zhuǎn)移特性曲線匹配性能均較輻照后的好,PMOS差分對(duì)管漏極電流ID幾乎未變化,匹配性能仍較好。對(duì)NMOS差分對(duì)管,當(dāng)輻照至600 Gy(Si)時(shí),兩只晶體管截止區(qū)漏級(jí)電流均增大,其失配亦增大,且隨輻照總劑量的增加截止區(qū)漏級(jí)電流持續(xù)增大并逐漸呈現(xiàn)飽和趨勢(shì)。從圖2還可看出,隨輻照總劑量的增加,NMOS差分對(duì)管中兩只晶體管截止區(qū)漏極電流的失配從截止區(qū)逐漸向飽和區(qū)過(guò)渡。這是因?yàn)椋?dāng)輻照總劑量較小時(shí),其感生漏極電流較小,與亞閾區(qū)、飽和區(qū)的漏極電流相比可忽略,故截止區(qū)先出現(xiàn)漏極電流失配;隨著輻照總劑量的增加,截止區(qū)漏極電流增大的幅度趨于飽和,而亞閾區(qū)和飽和區(qū)的漏極電流變化遠(yuǎn)未達(dá)到飽和,因此漏極電流的失配從截止區(qū)逐漸向飽和區(qū)過(guò)渡。
對(duì)于深亞微米MOS晶體管,雖柵氧化層厚度減小至幾nm,但隔離氧化層厚度仍有幾百nm,且隔離氧化層的質(zhì)量遠(yuǎn)不及柵氧化層,所以隔離氧化層是其輻照敏感區(qū)域。電離輻射會(huì)在隔離氧化層中產(chǎn)生大量電子空穴對(duì),電子被電場(chǎng)迅速掃出氧化層,留下帶正電的空穴,空穴被晶體管邊緣的STI隔離氧化層的陷阱捕獲,形成正氧化物陷阱電荷。隨著氧化物陷阱電荷的積累,最終在隔離氧化層形成一較大的電場(chǎng)。當(dāng)電場(chǎng)強(qiáng)度達(dá)到一定值時(shí),NMOS晶體管的隔離氧化層下P型襯底表面反型,源漏之間兩側(cè)寄生晶體管開(kāi)啟,形成漏電通道,從而導(dǎo)致漏電流的增加[12-13];而對(duì)于PMOS晶體管,由于其源、漏區(qū)均在N阱(N-Well)中,正氧化物陷阱電荷無(wú)法形成漏電通道,故其對(duì)總劑量輻照不敏感。在制作隔離氧化層時(shí),工藝步驟中刻蝕、氧化等出現(xiàn)的不均勻、不一致均會(huì)導(dǎo)致兩只晶體管隔離氧化層中的缺陷濃度、能級(jí)分布等的不同,從而導(dǎo)致缺陷在捕獲輻照產(chǎn)生的空穴形成氧化物陷阱電荷的不同,造成漏電流的失配在電離輻射環(huán)境下惡化。在模擬集成電路中,電流失配的增加會(huì)影響電流源、比例電流分配精度等,為消除這種影響,必須使過(guò)驅(qū)動(dòng)電壓達(dá)到最大。但當(dāng)過(guò)驅(qū)動(dòng)電壓增大時(shí),負(fù)載電阻失配及晶體管尺寸失配對(duì)失調(diào)的影響將增大,這對(duì)高精度模擬集成電路是不利的[1,9,14]。

圖2 NMOS(a)及PMOS(b)差分對(duì)管的轉(zhuǎn)移特性曲線隨輻照總劑量的變化
2.3 閾值電壓
傳統(tǒng)的恒流法提取閾值電壓對(duì)深亞微米晶體管已不再適用,本文根據(jù)MOS晶體管飽和區(qū)漏極電流的公式可得出飽和區(qū)漏電流和閾值電壓呈平方關(guān)系,對(duì)飽和區(qū)轉(zhuǎn)移特征曲線進(jìn)行線性擬合,提取樣品不同總劑量下的閾值電壓值。圖3為NMOS及PMOS差分對(duì)管的閾值電壓失配隨輻照總劑量的變化情況。由圖3可看出,輻照前NMOS兩只晶體管的閾值電壓差為0.94 mV,失配為0.2%(晶體管閾值電壓約為0.46 V),兩只晶體管匹配性較好,隨輻照總劑量的增加,閾值電壓差增大,輻照結(jié)束時(shí),兩只晶體管的閾值電壓差達(dá)50.17 mV,失配達(dá)10.9%。而PMOS差分對(duì)管的兩只晶體管失配在0.5%之內(nèi),最大閾值電壓差為2 mV,可見(jiàn)PMOS差分對(duì)管的失配對(duì)總劑量輻照不敏感。
閾值電壓VT可表示為:
式中:φMS為金屬半導(dǎo)體功函數(shù)差;QOX為氧化層中電荷數(shù)量;QA為溝道耗盡區(qū)電荷數(shù)量;φFP為襯底費(fèi)米勢(shì);COX為氧化層電容。
根據(jù)閾值電壓的定義,總劑量輻照前閾值電壓的失配與摻雜程度、柵氧化層及耗盡區(qū)電荷有關(guān),而這些參數(shù)在同一工藝制作的晶體管中存在誤差,進(jìn)而造成器件電參數(shù)的失配。總劑量輻照對(duì)溝道區(qū)及柵極中摻雜程度無(wú)影響,而是在柵氧化層中產(chǎn)生電子空穴對(duì),空穴會(huì)被氧化層中工藝造成的缺陷捕獲,進(jìn)而形成氧化物陷阱電荷及界面陷阱電荷;或被隔離氧化層中存在的缺陷捕獲,形成陷阱電荷,進(jìn)一步影響耗盡區(qū)電荷,上述兩種情況均會(huì)導(dǎo)致閾值電壓變化。在輻射環(huán)境中,由于不同晶體管工藝中存在的缺陷數(shù)量、能級(jí)的不同,導(dǎo)致捕獲輻射產(chǎn)生的空穴數(shù)量不同,從而使得晶體管失配增大。當(dāng)溝道長(zhǎng)度較小時(shí),總劑量輻照亦會(huì)導(dǎo)致晶體管有效溝道長(zhǎng)度變化,從而會(huì)引起飽和區(qū)漏電流的變化,進(jìn)一步造成漏電流的失配增加。在高精度模擬電路設(shè)計(jì)中,失配會(huì)引起集成電路的較大的直流失調(diào)、有限偶次失真及更低的共模抑制,且MOS晶體管閾值電壓的失配與溝道電容互相制約、互相對(duì)換。在0.6 μm工藝制作的晶體管中,1 mV的閾值電壓失配相當(dāng)于增大300 fF的溝道電容。若差動(dòng)對(duì)并聯(lián)較多(如在A/D轉(zhuǎn)換器中),則輸入電容變得過(guò)高,會(huì)嚴(yán)重降低速度且要求前級(jí)有較高的功耗,這均不利于集成電路的設(shè)計(jì)及應(yīng)用。根據(jù)文獻(xiàn)[6,12-13],深亞微米MOS晶體管閾值電壓的漂移量不會(huì)影響晶體管的導(dǎo)通和截止?fàn)顟B(tài),從而不會(huì)影響數(shù)字集成電路;但在高精度模擬集成電路中,失調(diào)電壓和差分對(duì)管中晶體管閾值電壓差呈正比,故輻射環(huán)境下閾值電壓的失配增大對(duì)高精度模擬電路的影響較嚴(yán)重。
3 結(jié)論
通過(guò)對(duì)0.18 μm MOS差分對(duì)管的總劑量效應(yīng)研究,可得出以下結(jié)論:1) 可通過(guò)閾值電壓、漏極電流來(lái)表征電離輻射環(huán)境下MOS差分對(duì)管失配特性;2) 輻照會(huì)引起NMOS差分對(duì)管閾值電壓、漏極電流失配增加;3) PMOS差分對(duì)管對(duì)總劑量輻照不敏感,輻照后閾值電壓和漏極電流均無(wú)明顯引起失配增加現(xiàn)象的出現(xiàn);4) 電離輻射環(huán)境下小尺寸MOS晶體管閾值電壓的變化在差分對(duì)管中不可忽略,在高精度模擬集成電路中,其關(guān)聯(lián)著電路參數(shù)及性能的變化。
參考文獻(xiàn):
[1] RAZAVI B. Design of analog CMOS integrated circuits[M]. New York: The McGraw-Hill Press, 2001.
[2] 劉簾曦,楊銀堂,朱樟明. 基于MOSFET失配分析的低壓高精度CMOS帶隙基準(zhǔn)源[J]. 西安電子科技大學(xué)學(xué)報(bào):自然科學(xué)版,2005,32(3):348-352.
LIU Lianxi, YANG Yintang, ZHU Zhangming. A low voltage and high accuracy CMOS bandgap reference by considering mismatch of MOSFETs[J]. Journal of Xidian University:Natural Science Edition, 2005, 32(3): 348-352(in Chinese).
[3] 趙光永. MOSFET失配的研究及應(yīng)用——高性能CMOS電荷泵的設(shè)計(jì)[D]. 南京:東南大學(xué)電子工程學(xué)院,2005.
[4] 任迪遠(yuǎn),陸嫵,郭旗,等. CMOS運(yùn)算放大器的輻照和退火行為[J]. 半導(dǎo)體學(xué)報(bào),2004,26(6):731-734.
REN Diyuan, LU Wu, GUO Qi, et al. Radiating and annealing on CMOS operation amplifier[J]. Chinese Journal of Semiconductors, 2004, 26(6): 731-734(in Chinese).
[5] 任迪遠(yuǎn),陸嫵,郭旗,等. CMOS運(yùn)算放大器的質(zhì)子和γ輻照效應(yīng)[J]. 核電子學(xué)與探測(cè)技術(shù),1997,17(5):370-373.
REN Diyuan, LU Wu, GUO Qi, et al. Radiation effects of protons and60Co γ rays on CMOS operation amplifier[J]. Nuclear Electronics & Detection Technology, 1997, 17(5): 370-373(in Chinese).
[6] 劉張李,胡志遠(yuǎn),張正選,等. 0.18 μm MOSFET器件的總劑量輻照效應(yīng)[J]. 物理學(xué)報(bào),2011,60(11):116103.
LIU Zhangli, HU Zhiyuan, ZHANG Zheng-xuan, et al. Total ionizing dose effect of 0.18 μm MOSFETs[J]. Acta Phys Sin, 2011, 60(11): 116103(in Chinese).
[7] McLAIN M, BARNABY H J, HOLBERT K E, et al. Enhanced TID susceptibility in sub-100 nm bulk CMOS I/O transistors and circuits[J]. IEEE Transactions on Nuclear Science, 2007, 54(6): 2 210-2 217.
[8] GONELLA L, FACCIO F, SILVESTRI M, et al. Total ionizing dose effects in 130 nm commercial CMOS technologies for HEP experiments[J]. Nuclear Instruments and Methods in Physics Research A, 2007, 582: 750-754.
[9] 羅嵐,趙光永,吳建輝,等. MOSFET失配的研究現(xiàn)狀與進(jìn)展[J]. 電子器件,2004,27(4):767-771.
LUO Lan, ZHAO Guangyong, WU Jianhui, et al. Status and recent progress of research on MOSFET mismatch[J]. Chinese Journal of Electron Devices, 2004, 27(4): 767-771(in Chinese).
[10] 龔俊平,馮全源. MOS晶體管失配模型研究及應(yīng)用[J]. 微電子學(xué)與計(jì)算機(jī),2009,26(11):47-50.
GONG Junping, FENG Quanyuan. Research and application on the mismatch model of MOS transistor[J]. Microelectronics & Computer, 2009, 26(11): 47-50(in Chinese).
[11] DIFRENZA R, LLINARES P, GHIBAUDO G. The impact of short channel and quantum effects on the MOS transistor mismatch[J].Solid-State Electronics, 2003, 47: 1 161-1 165.
[12] BARNABY H J. Total-ionizing-dose effects in modern CMOS technologies[J]. IEEE Transactions on Nuclear Science, 2006, 53(6): 3 103-3 121.
[13] JOHNSTON A H, SWIMM R T, ALLEN G R, et al. Total dose effects in CMOS trench isolation regions[J]. IEEE Transactions on Nuclear Science, 2009, 56(4): 1 941-1 949.
[14] DRENNAN P G, McANDREW C C. Understanding MOSFET mismatch for analog design[J]. Solid-State Circuits, 2003, 38(3): 450-456.

