基體負偏壓對類金剛石涂層結構和性能的影響
紀錫旺,許振華,賀莉麗,何利民,郝俊文,甄洪濱
(1北京航空材料研究院,北京100095;2華東理工大學 機械與動力工程學院,上海200237;3中航工業 南方航空工業(集團)有限公司,湖南 株洲412002;4賽屋涂層技術有限公司,天津300308)
類金剛石涂層(Diamond-Like Carbon Coating,DLC)是一種性質類似于金剛石的非晶碳膜,具有超高硬度、高彈性模量、低摩擦因數、高抗磨損性能,以及優異的光電物理性能和穩定的化學惰性。在機械領域已經被廣泛應用,作為零件耐磨保護層和刀具涂層已取得了良好使用效果。在光電學、聲學、醫學等領域有著廣闊的應用前景[1-4]。根據制備方法不同,類金剛石涂層可分為含氫和不含氫兩大類,因此,DLC也被稱為非晶碳膜和非晶含氫碳膜。對含sp3鍵較高的(通常大于70%)類金剛石涂層分別記為Ta:a-C和Ta:a-C:H,而對含sp3鍵較低的,則分別記為a-C和a-C:H[5]。
DLC涂層制備技術主要包括離子束沉積法、磁控濺射法、陰極電弧法、等離子體增強化學氣相沉積法、脈沖激光法等[6-8]。不同制備技術和工藝條件所得到的涂層性能和結構大相徑庭。在不同制備方法和工藝條件下得到的DLC涂層中sp3鍵含量相差甚大。碳離子之所以能形成sp3鍵是因其具有足夠的能量E,E的大小決定了sp3鍵含量。能量E的主要來源:產生碳離子時由電離源提供的能量E1;離子沉積時負偏壓提供的轟擊能量E2;沉積到基體表面的離子在溫度的作用下形成涂層,此時溫度提供能量E3,故E=E1+E2+E3。理想狀態下,當碳離子具備足夠大的能量時,sp3鍵含量最高。但實際涂層制備過程中,E對sp3的形成機制受制于E1,E2和E3的變化。而三者又分別來源于電離源、基體偏壓和沉積溫度這三個工藝參數。由此可見,電離源、基體偏壓和沉積溫度對形成sp3鍵至關重要。同時它們還對DLC涂層的表面形貌、厚度、界面結合強度、硬度等產生重要影響。目前,國內外關于此三種工藝參數對DLC涂層性能影響的研究較少,尤其從離子能量角度出發研究工藝參數對sp3鍵形成的影響作用機制尚存在諸多空白。
本工作利用DC-PECVD技術在YG8硬質合金基體上制備一系列DLC涂層。在同一實驗條件下,保持離子源、溫度及其他工藝參數不變,研究不同基體負偏壓對涂層形貌、結構、硬度和界面結合強度的影響規律。同時,探討基體負偏壓對sp3鍵形成的作用機制。
1 實驗
1.1 試樣制備
以YG8硬質合金為基體材料,尺寸為17mm×10mm×5mm;基體經拋光后用清水清洗5min,超聲波清洗20min,去離子水浸泡5min,最后經無水乙醇脫水并烘干后裝入真空室內的轉架上待用。制備涂層后,試樣采用電木粉熱相樣,經200,400,600,1000,1200#砂紙依次打磨,并用3μm的金剛石拋光膏拋光至鏡面,用清水沖洗干凈,烘干后觀察涂層截面SEM形貌。其余測試所用試樣只需用無水乙醇將表面清洗干凈并烘干即可。
1.2 實驗方法
采用DC-PECVD技術制備DLC涂層,兩個離子束源安裝于腔體內壁,以純度為97.00%的C2H2為反應氣體。待真空室內真空抽至5.0×10-3Pa以下時,使用純度為99.999%的Ar和1000V負偏壓,對基體進行30min濺射清洗;清洗后,將基體負偏壓增大到1100V,采用磁控濺射技術沉積Cr層20min作為過渡層;最后通入C2H2,流量50sccm持續240min,離子束電壓為1200V。在上述參數保持不變的條件下,通過采用800,900,1000,1100V和1200V的基體負偏壓制備出5種涂層。
1.3 性能測試
DLC涂層表面形貌的觀察在Nanoscope III a型原子力顯微鏡(AFM)和Quanta200型掃描電子顯微鏡(SEM)下進行,同時SEM觀察涂層截面形貌并且測量其厚度,每個試樣的涂層厚度在不同位置測量3次,取平均值;用RT200型粗糙度儀測試涂層的表面粗糙度,每個試樣測試10次取平均值;硬度采用Duramin型顯微硬度計測試,載荷為0.49N,保持時間為15s,在每個試樣的涂層表面測試5個點取平均值;采用WS-2005涂層附著力自動劃痕儀測試涂層界面結合性能,加載速率20N/min,最大載荷200N,劃痕速率5mm/min,劃痕長度設定為5mm;拉曼光譜測試采用RM2000型顯微共焦拉曼光譜儀,激光器波長514.5nm,顯微尺寸范圍1μm;采用X射線光電子能譜(XPS)對DLC的雜化鍵含量進行測試。
2 結果與討論
2.1 表面形貌
圖1分別是負偏壓為800,1000V和1200V時DLC涂層的SEM圖。由圖1(a)可知,當負偏壓為800V時,DLC涂層表面存在一些尺寸不規則的大顆粒。涂層表面的微觀形貌與涂層生長行為密切相關,涂層的生長一般可以分為兩個階段:首先,等離子體中的正離子和中性基團移向基體表面,在基體表面發生吸附并沉積反應;其次,具有高能量的離子在基體表面遷移擴散,等離子體中的活性氫也會對離子進行刻蝕[9]。負偏壓較低時往往導致活性氫能量降低,從而對涂層刻蝕作用較小,同時離子能量較低,使沉積離子遷移擴散能力減弱。因此所得涂層的有機相較多,涂層表面疏松、粗糙[10]。隨著負偏壓增大到1000V(圖1(b)),大顆粒尺寸明顯減小,并且小顆粒數量減少,表面變得光滑致密,粗糙程度降低。當偏壓為1200V時(圖1(c)),大顆粒全部消失,小顆粒數量顯著下降。這是因為偏壓增大使得離子對基體的轟擊能量增強,沉積離子在基體表面上流動性變強,擴散能力提高,涂層結構連續,致密度提高。圖2為不同負偏壓條件下DLC涂層的粗糙度。可知,涂層表面粗糙度在0.06~0.14μm之間,隨著負偏壓增大呈減小趨勢,該結果與圖1中所觀察到的現象是一致的。研究結果表明,適當提高基體負偏壓可有效改善涂層表面形貌并降低其表面粗糙度。

圖1 不同負偏壓下樣品的SEM 圖(a)800V;(b)1000V;(c)1200V Fig.1 Micrographs of samples with different negative bias voltages(a)800V;(b)1000V;(c)1200V

圖2 不同負偏壓下DLC涂層的粗糙度Fig.2 Roughness of DLC coatings with different negative bias voltages
2.2 涂層厚度
圖3是負偏壓為1000V時DLC涂層的橫截面形貌圖。圖4為負偏壓與涂層厚度的對應關系圖。由圖3的SEM橫截面形貌結果表明,涂層生長連續、致密,涂層/基體間的界面結合良好,無缺陷和分層現象,涂層厚度分布均勻性較好。
圖3,4可知,涂層厚度隨負偏壓增大呈先增大后減小趨勢,當負偏壓為1100V時涂層厚度最大值約為3.2μm。負偏壓增大使沉積離子轟擊能量增強,單位時間內沉積到基體表面的離子數量增多,涂層變厚。當負偏壓繼續增大至1200V,涂層厚度急劇下降到1.4μm。這是因為沉積離子轟擊能量過大,對涂層表面的粒子產生反濺射作用,導致涂層厚度逐漸減小。因此,適當的負偏壓有利于沉積離子向基體表面運動,吸附和擴散,從而沉積形成涂層。但是如果負偏壓值過大,由于入射能量增強,則導致周圍離子或基團被打散,從而使得涂層厚度下降。由此可見,涂層厚度可通過調節負偏壓大小進行控制。

圖3 負偏壓1000V時DLC涂層的SEM橫截面形貌Fig.3 Cross-sectional morphology of DLC coating with negative bias voltage of 1000V

圖4 負偏壓與涂層厚度的關系Fig.4 Relationship between negative bias voltage and thickness of coatings
2.3 涂層結構
圖5為在不同負偏壓下制備所得DLC涂層的Raman譜圖。可以發現,每個試樣的Raman光譜均呈現出典型的不對稱傾斜散射峰,這表明制備所得的是典型的DLC涂層。對每個Raman光譜進行高斯擬合,1580cm-1附近的是G(graphite)峰,1350cm-1附近的是D(disorder)峰。G峰代表石墨結構并且對應在C=C鏈或芳香烴環中每對sp2鍵的縱向振動;D峰只對應著環上的sp2鍵的橫向振動[11]。D峰和G峰的積分強度比ID/IG與sp2/sp3比值有著一定的關系[12],當ID/IG越小時sp3鍵的相對含量越多。G峰向低波數位置移動時說明,sp2鍵紊亂程度增加和sp3鍵相對含量的增大。通過ID/IG的變化和G峰位置偏移可以定性地分析sp3鍵的相對含量變化。
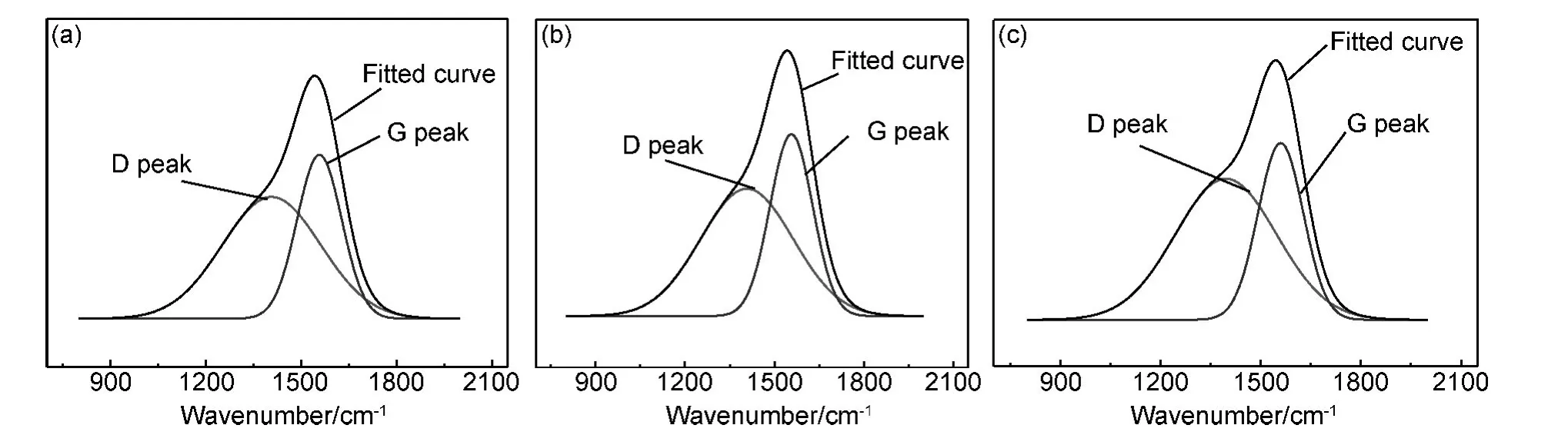
圖5 不同負偏壓下 DLC涂層的Raman光譜(a)800V;(b)1000V;(c)1200V Fig.5 Raman shift of DLC coatings with different negative bias voltages(a)800V;(b)1000V;(c)1200V
不同負偏壓下Raman光譜高斯擬合結果如表1所示。可知,負偏壓從800V增加到1000V,ID/IG值由1.63減小為1.5,同時G峰位置從1559cm-1移動到1555cm-1處。負偏壓繼續增大至1200V,ID/IG比值隨之從1.5增大到1.7,G峰位置從1555cm-1移動到1558cm-1。ID/IG積分強度比隨負偏壓增大呈先增大后減小趨勢,即sp3鍵的相對含量隨負偏壓增加先增大后減小。負偏壓增大導致沉積離子轟擊能量增加,此時形成的sp3鍵增多。當負偏壓超過1000V且繼續增大時對應的離子轟擊能量也進一步增強,但sp3鍵含量反而呈下降趨勢。

表1 不同負偏壓下Raman光譜擬合數據Table1 Fitted data of Raman shift under different negative bias voltages
為了進一步定量地分析DLC涂層中sp3鍵的含量,得到基體負偏壓與sp3鍵含量的函數關系,本工作采用XPS對其組分進行檢測(圖6)。根據實測曲線可知,sp3鍵含量均大于51%,負偏壓1000V時sp3鍵含量最高(約67.9%)。隨著負偏壓逐漸增大,sp3鍵含量先增大后減小。采用高斯擬合法對實測數據擬合(式(1)):

圖6 不同負偏壓下對應的sp3鍵含量Fig.6 Relationship between sp3 content and negative bias voltage

式中:sp3鍵含量最小值y0=0.5,擬合曲線最高峰橫坐標xc=943,w和A 均為常數,分別為245,53。對2式(1)求導得到曲線變化率xc)。當=0時,y達到最大值,處于最高峰位置,此時x=xc=943,即負偏壓943V時sp3鍵含量出現最大值。擬合曲線中最高峰位置與實驗數據最高峰位置相差Δx=56V,由此可初步推斷:在本實驗條件下,sp3鍵含量最高峰位置應該位于943~1000V之間。實測曲線與擬合曲線表明:基體負偏壓對sp3鍵形成作用有限,基體負偏壓過小或過大會導致sp3鍵含量降低,只有選取適當的負偏壓才會對形成sp3鍵最為有利。同時,基體負偏壓產生的轟擊能量E2對sp3鍵形成具有重要影響。理想狀態下,E2增大使總能量E也增大,E增大則sp3鍵含量升高。但研究結果顯示,雖然E2增加會導致E大幅度提高,但是sp3鍵含量卻呈下降趨勢,這是因為E2由負偏壓決定,負偏壓過度增大導致離子能量太高,使C—H鍵破裂,H元素從涂層中逸出產生石墨化[13],從而導致sp3鍵含量下降。因此,能量E2過度增加將導致sp3鍵含量降低。由此可見,當E1和E3固定不變時,總能量E對sp3鍵含量的影響受轟擊能量E2制約,只有選取合適的轟擊能量E2才能得到最高sp3鍵含量的DLC涂層。
2.4 顯微硬度
sp3鍵決定DLC涂層的力學性能,因此DLC涂層顯微硬度受sp3鍵含量影響。圖7為硬度與負偏壓的關系圖。可知,DLC涂層顯微硬度均在1700~2500之間,隨著負偏壓增大而先增加后減小;負偏壓為1000V時硬度達到最大值2500。此變化趨勢與圖6中sp3鍵含量的變化規律基本相符。故sp3鍵含量決定DLC涂層顯微硬度值。因此,DLC涂層顯微硬度值可通過基體負偏壓控制。

圖7 硬度與負偏壓的關系Fig.7 Relationship between hardness and negative bias voltage
2.5 界面結合性能

圖8 不同負偏壓下涂層劃痕SEM 形貌圖(a)800V;(b)1000V;(c)1200V Fig.8 Micrographs of the scratch track under different negative bias voltages(a)800V;(b)1000V;(c)1200V
圖8是負偏壓為800,1000V和1200V時涂層劃痕SEM形貌圖。采用劃痕法測試涂層界面結合性能,劃針壓入時,涂層與基體的變形不同步導致涂層沿著劃痕向兩邊形成整齊排列的小裂紋,呈魚骨狀。當劃針繼續壓入時達到臨近載荷,此時涂層在界面處發生脆性剝落,試樣在劃擦過程中會出現涂層變形、涂層與基體共同 變形和涂層剝落三個階段[14]。圖8(a)局部放大圖顯示,在劃痕初期的邊緣上出現了裂紋擴展,隨著劃痕載荷進一步增大,出現了起皺和脫落,這說明涂層/基體之間存在較大的內應力,使得涂層/基體的界面結合性能較差。當負偏壓為1000V時(圖8(b)),劃痕軌跡縱向呈現的涂層起皮現象不明顯,從局部放大圖可以看到該現象持續的痕跡最長,裂紋擴展數量最少。隨著載荷的增加,起皺和脫落面積比其余兩個試樣小,此涂層/基體之間的應力值最小,且結合性能最優。圖8(c)是負偏壓為1200V時的劃痕形貌,此時涂層劃痕軌跡邊緣出現涂層大面積起皮甚至脫落,裂紋擴展明顯且數量最多,這可能是涂層內應力過大導致涂層/基體間的結合性能變差。
圖9是結合強度與負偏壓的對應關系圖。負偏壓從800V增大到1100V時,涂層/基體間的結合力逐漸增大,當負偏壓為1100V時,涂層/基體間的結合力達到最大值60N。負偏壓繼續增大至1200V時,結合力反而降低,這與圖8的劃痕形貌所呈現的結果基本一致。因為負偏壓增大導致離子轟擊基體的能量增強,充足的能量足以使離子滲透涂層表面外層并誘發壓應力,同時提高了離子進入基體表面的能力,很容易形成致密的網絡微觀結構,增強了涂層與基體的結合。另一方面,如果涂層中的原子和基體結合很弱,那么,這些結合不緊密的原子會在高能量粒子的轟擊下反濺出來,只有和基體緊緊結合的原子才能沉積下來形成涂層,從而改善涂層/基體間的界面結合性能[15]。當負偏壓增長過大,由于高能量離子對基體的轟擊作用,可能會產生過大的內應力從而導致涂層的結合能力下降。由此可知,適當的離子轟擊有利于提高涂層/基體間的結合性能,但不宜過大。

圖9 結合強度與負偏壓的關系Fig.9 Relationship between adhesion and negative bias voltage
3 結論
(1)隨著負偏壓增大,涂層表面變得平整光滑、致密,大顆粒尺寸下降,小顆粒數量減少,粗糙程度降低。負偏壓為1000V時,sp3鍵含量最大,約為67.9%。負偏壓產生的轟擊能量E2過大將導致sp3鍵含量降低。只有選取合適的轟擊能量E2才能得到最高sp3鍵含量的DLC涂層。顯微硬度隨負偏壓的變化規律與sp3鍵含量變化規律基本相符,顯微硬度值由sp3鍵含量決定。
(2)涂層厚度、界面結合力隨負偏壓增大均先增大后減小,在負偏壓為1100V時分別達到最大值3.2和60N。在負偏壓為1000~1100V時,涂層具有最優綜合性能。
[1]OHGOE Y,HIRAKURI K K,SAITOH H,et al.Classification of DLC films in terms of biological response[J].Surface & Coatings Technology,2012,207:350—354.
[2]VENGUDUSAMY B,MUFTI R A,LAMB G D,et al.Friction properties of DLC/DLC contacts in base oil[J].Tribology International,2011,44(7-8):922—932.
[3]DAI Wei,KE P L,MOON M-W,et al.Investigation of the microstructure,mechanical properties and tribological behaviors of Ti-containing diamond-like carbon films fabricated by a hybrid ion beam method[J].Thin Solid Films,2012,520(19):6057—6063.
[4]MARTINEZ-MARTINEZ D,SCHENKEL M,PEI Y T,et al.Microstructure and chemical bonding of DLC films deposited on ACM rubber by PACVD[J].Surface & Coatings Technology,2011,205(Suppl 2):75—78.
[5]李敬財,何玉定,胡杜軍,等.類金剛石薄膜的應用[J].新材料產業,2004,124(3):39—42.LI J C,HE Y D,HU D J,et al.Application of DLC films[J].Advanced Materials Industry,2004,124(3):39—42.
[6]楊發展,王世慶,沈麗如,等.不同方法制備的類金剛石薄膜的XPS和Raman光譜的研究[J].光譜學與光譜分析,2011,31(7):1080—1083.YANG F Z,WANG S Q,SHEN L R,et al.XPS and Raman studies of diamond-like carbon films prepared by various deposition techniques[J].Spectroscopy and Spectral Analysis,2011,31(7):1080—1083.
[7]王雪敏,吳衛東,李盛印,等.脈沖激光沉積摻 W類金剛石膜的性能[J].稀有金屬材料與工程,2010,39(7):1251—1255.WANG X M,WU W D,LI S Y,et al.Properties of W doped diamond-like carbon films prepared by pulsed laser deposition[J].Rare Metal Materials and Engineering,2010,39(7):1251—1255.
[8]茍偉,李劍鋒,楚信譜,等.脈沖輝光PECVD制備DLC薄膜的結構和性能研究[J].真空科學與技術學報,2008,28(增刊1):33—37.GOU W,LI J F,CHU X P,et al.Microstructures and properties of diamond-like carbon films grown by plasma enhanced chemical vapor deposition[J].Chinese Journal of Vacuum Science and Technology,2008,28(Suppl 1):33—37.
[9]SCHENG Y H,WU Y P,CHEN J G,el a1.On the deposition mechanism of a-C:H films by plasma enhanced chemical vapor deposition[J].Surface & Coatings Technology,2000,135(1):27—33.
[10]常海波,徐洮,張治軍.直流負偏壓對類金剛石薄膜結構的影響[J].化學研究,2005,16(1):35—38.CHANG H B,XU Y,ZHANG Z J.Effect of direct current negative bias on the structure of diamond-like carbon films[J].Chemical Research,2005,16(1):35—38.
[11]宋貴宏,杜昊,賀春林.硬質與超硬涂層[M].北京:國防工業出版社,2007.159—162.SONG G H,DU H,HE C L.Hard and Superhardcoating[M].Beijing:National Defense Industry Press,2007.159-162.
[12]周順,嚴一心.脈沖真空電弧離子鍍在不銹鋼上沉積類金剛石薄膜的研究[J].真空,2005,42(2):15—18.ZHOU S,YAN Y X.Structure and mechanical properties of DLC films by pulsed vacuum arc ion deposition[J].Vacuum,2005,42(2):15—18.
[13]謝鵬,汪建華,王傳新,等.硬質合金刀具上的類金剛石薄膜硬度的研究[J].硬質合金,2008,25(4):257—260.XIE P,WANG J H,WANG C X,et al.Study on hardness of diamond-like carbon film on cemented carbide blades[J].Cemented Carbide,2008,25(4):257—260.
[14]石志峰,黃楠,孫鴻,等.鈦過渡層對類金剛石薄膜的膜基結合力以及摩擦學性能的影響[J].功能材料,2008,39(8):1340—1343.SHI Z F,HUANG N,SUN H,et al.Effects of different Ti-interlayer deposition time and bias voltage on the adhesive and tribological properties of DLC films[J].Journal of Functional Materials,2008,39(8):1340—1343.
[15]邵霄.TiC/DLC多層類金剛石薄膜的研究[D].西安:西安工業大學,2008.SHAO X.Study on TiC/DLC multilayer diamond-like carbon films[D].Xi’an:Xi’an Technological University,2008.

