半導(dǎo)體材料的微重力生長
尹志崗,張興旺,吳金良
(1.中國科學(xué)院半導(dǎo)體研究所 半導(dǎo)體材料科學(xué)重點實驗室,北京 100083)(2.中國科學(xué)院大學(xué)材料科學(xué)與光電技術(shù)學(xué)院,北京 100049)
?

半導(dǎo)體材料的微重力生長
尹志崗1,2,張興旺1,2,吳金良1
(1.中國科學(xué)院半導(dǎo)體研究所 半導(dǎo)體材料科學(xué)重點實驗室,北京 100083)(2.中國科學(xué)院大學(xué)材料科學(xué)與光電技術(shù)學(xué)院,北京 100049)
空間微重力環(huán)境提供了一個獨特平臺,以改進(jìn)地面材料性能、深入理解被地面重力掩蓋的晶體生長現(xiàn)象。半導(dǎo)體空間材料科學(xué)的主要進(jìn)展有:①基于對組分均勻的完美半導(dǎo)體的追求,人們對于晶體生長機(jī)理,特別是對流、溶質(zhì)傳輸及組分分凝的相互作用,有了更加深入的理解;②基于空間實驗結(jié)果,人們澄清了非接觸 Bridgman生長的內(nèi)在機(jī)理,并將之用于指導(dǎo)空間及地面實驗;③提出了新的微重力晶體生長技術(shù)并成功用于組分均勻半導(dǎo)體合金材料的制備。回顧了以上方面的研究進(jìn)展,并對半導(dǎo)體空間材料科學(xué)的未來挑戰(zhàn)進(jìn)行了展望。
微重力;浮力對流;Marangoni對流;Bridgman生長;非接觸生長
1 前 言
空間技術(shù)的進(jìn)步為材料科學(xué)的發(fā)展帶來了新的機(jī)遇。20世紀(jì)60年代末開始的空間材料生長實驗宣告了一門新學(xué)科——微重力材料科學(xué)的誕生。空間微重力環(huán)境為材料的生長、加工提供了新的自由度,同時有力地促進(jìn)了人們對材料生長基礎(chǔ)問題的認(rèn)識。微重力材料科學(xué)的研究目標(biāo)主要包括3個方面:通過抑制重力效應(yīng),制備地面無法得到的高性能材料;理解被地面重力效應(yīng)掩蓋的物理現(xiàn)象;改進(jìn)地面晶體生長工藝[1]。
半導(dǎo)體是信息社會的材料基礎(chǔ),也是空間材料科學(xué)最為重要的研究方向之一[2]。空間半導(dǎo)體材料生長實驗多采用以浮區(qū)法、Bridgman法為代表的熔體生長技術(shù)[3-5]。特別是Bridgman法,由于其簡單易行的優(yōu)點,是半導(dǎo)體空間材料科學(xué)實驗的主流方法。本文將主要圍繞Bridgman法展開,同時適當(dāng)兼顧目前有潛力的新生長技術(shù)。總的來講,半導(dǎo)體空間材料科學(xué)領(lǐng)域取得的主要進(jìn)展概括為如下3方面:
(1)基于抑制浮力對流、實現(xiàn)純擴(kuò)散生長的目標(biāo),科學(xué)家開展了多種半導(dǎo)體體系的空間生長實驗。通過這些工作,人們對于各種對流現(xiàn)象與溶質(zhì)輸運(yùn)、組分分凝之間的相互作用有了更加深入的理解,這些認(rèn)識反過來又極大地促進(jìn)了晶體生長學(xué)科的發(fā)展。
(2)通過微重力實驗發(fā)現(xiàn)了非接觸Bridgman生長這一現(xiàn)象,并認(rèn)識到其對于降低缺陷、提升晶體質(zhì)量的巨大意義。基于空地實驗結(jié)果,人們澄清了非接觸Bridgman生長的基本原理,并成功將之用于指導(dǎo)空間及地基晶體生長過程[6]。
(3)以移動加熱器法、移動液相區(qū)法及垂直梯度凝固法為代表的新的微重力晶體生長技術(shù)不斷涌現(xiàn),并成功制備了各種高質(zhì)量的半導(dǎo)體合金晶體。
本論文將立足于以上3個方面,介紹空間半導(dǎo)體材料科學(xué)近年來的發(fā)展概況。
2 通向純擴(kuò)散生長
2.1 微重力條件下的組分偏析與溶質(zhì)輸運(yùn)
根據(jù)經(jīng)典的Tiller理論,當(dāng)對流可以忽略而溶質(zhì)輸運(yùn)過程由擴(kuò)散控制時,可以實現(xiàn)穩(wěn)態(tài)生長,即固體組分為恒定值[7,8]。擴(kuò)散機(jī)制控制溶質(zhì)輸運(yùn)時,固體中的溶質(zhì)濃度分布符合以下關(guān)系(見式(1))[8]:
Cs(x)/C0=k+(1-k)[1-exp(-kRx/D)]
(1)
其中Cs(x)為距離初始位置x處固體中的溶質(zhì)濃度,C0起始狀態(tài)下熔體的平均溶質(zhì)濃度,k為平衡分配系數(shù),D溶質(zhì)在熔體中的擴(kuò)散系數(shù),R為生長速度。根據(jù)式(1),穩(wěn)態(tài)生長時(x足夠大)固體組分Cs(x)與C0一致。通常為表述實際情況與這一理想情況偏離的程度,定義有效分凝系數(shù)(見式(2))[8]:
keff=Cs/C0
(2)
當(dāng)keff不為1時,說明實際晶體生長過程偏離了純擴(kuò)散生長(熔體中溶質(zhì)輸運(yùn)只受擴(kuò)散規(guī)律支配),即產(chǎn)生了組分偏析。但是,由于浮力對流的影響,在地面環(huán)境下很難實現(xiàn)純擴(kuò)散生長。利用微重力環(huán)境,抑制浮力對流、制備組分均勻的完美晶體,是人們開展空間材料科學(xué)實驗的重要原因之一。
Witt等人基于InSb開展的微重力材料生長實驗表明,沿晶體軸向的雜質(zhì)分布均一,符合純擴(kuò)散生長的特征。類似的結(jié)果后來也多有報道[9-12]。但在空間生長的Ge晶體中,雜質(zhì)分布盡管在軸向是均勻的,但在徑向卻與期望結(jié)果有很大差距[10]。同樣,在GaAs及HgCdTe空間晶體中也觀察到了同樣的現(xiàn)象[11,12],其中HgCdTe晶體的徑向組分分布如圖1所示。這些結(jié)果揭示,空間晶體生長并不能簡單歸結(jié)為純擴(kuò)散過程,實際情況要復(fù)雜得多。在實際的空間飛行器中,重力水平雖較地面大幅降低,但卻遠(yuǎn)不是零。殘余重力(準(zhǔn)靜態(tài)加速度和動態(tài)加速度)的存在對于晶體生長過程有不可忽視的影響。穩(wěn)態(tài)生長需要在生長界面附近(邊界區(qū))的熔體中建立穩(wěn)定的溶質(zhì)濃度分布,任何對于這一平衡狀態(tài)的破壞,包括殘余重力引起的對流,都有可能導(dǎo)致組分偏析的出現(xiàn)。例如,Alexander 等[13]記錄了動態(tài)加速度的實時變化,首次發(fā)現(xiàn)了動態(tài)加速度與溶質(zhì)輸運(yùn)間的緊密聯(lián)系。不難理解,隨重力水平減小,沿軸向組分會逐漸逼近keff,組分最終會穩(wěn)定在C0。徑向組分分凝的特點與軸向有顯著差別,它隨重力水平及對流強(qiáng)度的變化并不是單調(diào)的。在無對流(無重力)及強(qiáng)對流(地面)兩種極限條件下,晶體組分沿徑向均分布均勻。殘余重力引起的弱環(huán)形對流不僅決定了熔體邊界區(qū)的局域溶質(zhì)分布,還會使徑向各點傳熱條件產(chǎn)生差異,因此會導(dǎo)致晶體徑向組分分布的明顯變化[14]。相對而言,殘余重力對軸向組分分布的影響并不顯著。這就導(dǎo)致了空間材料科學(xué)實驗中經(jīng)常觀察到的現(xiàn)象——軸向組分均勻,徑向偏析嚴(yán)重。
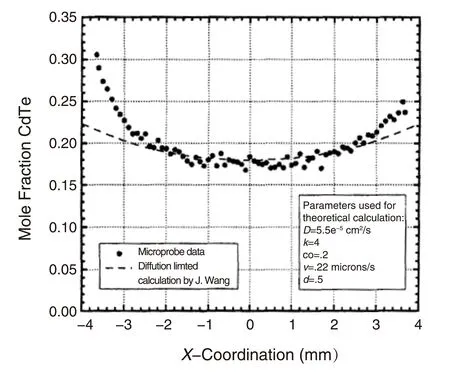
圖1 HgCdTe徑向組分分布圖;圖中虛線為根據(jù)擴(kuò)散生長機(jī)制計算所得[12]Fig.1 Radial composition profile of HgCdTe crystal. The dashed line indicates the calculated results according to the diffusion-controlled scheme[12]
人們開展了大量的計算模擬工作,旨在深入理解殘余重力對溶質(zhì)輸運(yùn)及分凝過程的影響。Naumann[15]建立了二維流場的解析模型,發(fā)現(xiàn)10-4g0(g0為地面重力加速度)的殘余重力就足以導(dǎo)致熔體中溶質(zhì)分布的劇烈變化,同時指出生長爐軸線與殘余重力矢量方向平行時可在一定程度上抑制這種影響。Alexander等[16]也得到了類似的結(jié)論。此外,他們的研究還揭示,動態(tài)加速度本身雖是一種瞬時作用,對溶質(zhì)輸運(yùn)過程的影響卻可持續(xù)~1000 s之久。Derby小組[17]近來發(fā)展了Bridgman生長的三維模型,將熔體對流、熱傳導(dǎo)、分凝及凝固等過程悉數(shù)納入,成功用來模擬、指導(dǎo)CdZnTe晶體的生長。Stelian等[18]給出了液-固界面演化的半經(jīng)驗表達(dá)式,得到了平直界面所需的動力學(xué)條件。該小組還仔細(xì)審視了動態(tài)加速度的頻率、幅度對于組分分凝的影響(如圖2),結(jié)果顯示:頻率恒定時,動態(tài)加速度幅度越大,偏析越嚴(yán)重;幅度恒定時,相對于高頻加速度,低頻加速度的影響更加致命[19]。理論模擬盡管不能完全再現(xiàn)空間生長過程,卻是理解微重力環(huán)境下對流、溶質(zhì)輸運(yùn)及組分分凝相互作用不可或缺的工具,對于具體的空間實驗設(shè)計也有著重要的指導(dǎo)意義。

圖2 殘余重力對熔體對流的影響,其中Umax對應(yīng)最大對流速度[19]Fig.2 Effect of the residual gravity on the melt convection, in which Umax is the maximum convective velocity[19]
2.2 Marangoni對流的影響
浮力對流的驅(qū)動力可以用Rayleigh數(shù)來表示(見式(3)):
Ra=gβΔTL3/αγ
(3)
式中g(shù)為重力加速度,β為熱膨脹系數(shù),ΔT為溫度梯度,L為熔池深度,α為熱擴(kuò)散系數(shù),γ為動力黏度。式(3)顯示,Rayleigh數(shù)與重力加速度成正比。可以預(yù)期,在微重力環(huán)境下浮力對流強(qiáng)度將大為降低。但是,Te摻雜GaSb空間晶體中觀察到了明顯的軸向組分分凝,這一結(jié)果顯然不能由殘余重力引起的浮力對流來解釋[20]。理論與實驗結(jié)果均指向Marangoni對流,一種在地面環(huán)境下經(jīng)常被重力效應(yīng)所掩蓋的現(xiàn)象。理論模擬證實,在浮力對流得到抑制且存在自由表面的情況下,對流強(qiáng)度可以完全由Marangoni對流主導(dǎo)[14]。實際測量顯示,在1.2 K/cm的徑向溫度梯度下,固-液界面附近的對流速度可高達(dá)0.5 cm/s,幾乎與地面條件下浮力對流引起的效應(yīng)相當(dāng)[14]。可以說,在許多微重力材料科學(xué)實驗中,Marangoni對流都與樣品在徑向及軸向的宏觀偏析現(xiàn)象密切相關(guān)。
Marangoni對流不僅會可造成宏觀偏析,還可導(dǎo)致微觀偏析的產(chǎn)生。在實驗上,微觀偏析主要表現(xiàn)為生長條紋,其形成主要與晶體生長過程中的溫度起伏或生長速率起伏引起溶質(zhì)濃度漲落造成的。一言以蔽之,微觀偏析與失穩(wěn)對流相關(guān),而與穩(wěn)態(tài)對流無關(guān)。生長條紋還是一種研究晶體生長機(jī)理的有力工具,可以用來表征生長界面的動力學(xué)演變過程[21]。在微重力環(huán)境下,Rayleigh數(shù)遠(yuǎn)小于穩(wěn)態(tài)-失穩(wěn)轉(zhuǎn)變臨界值,因此浮力對流一般不是生長條紋出現(xiàn)的主要原因。例如,在封閉表面的條件下,即使在動態(tài)加速度強(qiáng)度高達(dá)2×10-1g0,Ge∶Ga晶體生長過程中也未出現(xiàn)可分辨的生長條紋[14]。通常來講,空間生長的晶體樣品中若出現(xiàn)生長條紋,Marangoni對流是必須要考慮的因素。Marangoni對流的驅(qū)動力由Marangoni數(shù)來表示(見式(4)和式(5)):
MaT=αSTLΔT/αγ
(4)
MaC=αSCLΔω/Dγ
(5)
MaT和MaC分別為溫度驅(qū)動和組分驅(qū)動Marangoni對流對應(yīng)的Marangoni數(shù),αST和αSC分別為表面張力的溫度系數(shù)和溶質(zhì)濃度系數(shù),Δω為溶質(zhì)濃度差。在溫度漲落幅度為0.5~0.7 ℃,頻率小于0.5 Hz時,Schweizer等[22]發(fā)現(xiàn)Si的生長速度在1 mm/min的平均速度左右出現(xiàn)了明顯的起伏。觀察到的生長速度最高為4 mm/min,最小甚至可為負(fù)值(晶體回熔),因此晶體中出現(xiàn)了明顯的生長條紋(如圖3)。這是Marangoni對流造成微觀偏析的典型例子。若Marangoni對流是微觀偏析的主導(dǎo)因素,Marangoni數(shù)必須大于Ma2(Ma2為穩(wěn)定-失穩(wěn)Marangoni對流轉(zhuǎn)變臨界值)。確定Ma2的大小,是微重力Marangoni對流研究的重要內(nèi)容,眾多小組就此問題展開了研究。Cr?ll等[23]仔細(xì)測量了GaSb的臨界Marangoni數(shù),得到的Ma2值為375±125,與理論計算結(jié)果(355±90)非常吻合。對于Si和GaAs,實驗得到的Marangoni數(shù)分別為150±50 和~400[23]。基于這些結(jié)果,可以外推得到Ma2與Prandtl數(shù)(Pr,流體動力黏度與熱擴(kuò)散系數(shù)的比值)的對應(yīng)關(guān)系為(見式(6))[23]:
Ma2=2.2×104Pr1.32
(6)
這一關(guān)系式對于預(yù)測其它體系的微觀偏析行為具有重要指導(dǎo)意義。
由式(4)和(5)可知,Marangoni對流的驅(qū)動力與溫度梯度或濃度梯度線性相關(guān)。因此,降低溫度梯度或濃度梯度,是控制Marangoni對流的有效手段。但是,對于 Bridgman技術(shù)來說,溫度梯度是爐體的固有屬性,固-液界面附近熔體中的溶質(zhì)濃度梯度又是擴(kuò)散生長的必然結(jié)果,因此實際上這兩種方法并不可行。本課題組注意到中科院物理所、中國空間技術(shù)研究院蘭州物理所以及日本東京大學(xué)利用我國返回式衛(wèi)星搭載的GaSb空間實驗晶體盡管出現(xiàn)了自由表面,卻未觀察到可分辨的生長條紋[24-26]。作者認(rèn)為,未出現(xiàn)失穩(wěn)Marangoni對流的原因與GaSb表面薄的氧化物保護(hù)層有關(guān)。Tillberg等[27]基于Ge晶體的空間生長實驗結(jié)果,也強(qiáng)調(diào)了表面氧化層對于生長條紋的抑制作用。在不致引起晶體摻雜污染的前提下,引入惰性氧化層無疑是抑制自由表面形成,進(jìn)而調(diào)控Marangoni對流的可行手段。

圖3 微重力生長的Si單晶腐蝕照片,圖中由Marangoni對流引起的生長條紋清晰可見[22]Fig.3 Image of the etched μg0 crystal of Si, in which dopant striations induced by Marangoni convection are clearly visible[22]
2.3 抑制對流的途徑
如前所述,空間材料科學(xué)實驗的目的之一是利用微重力環(huán)境抑制對流,實現(xiàn)純擴(kuò)散生長,以便得到組分均勻分布的摻雜半導(dǎo)體或半導(dǎo)體合金。但是,由于殘余重力的存在及自由表面的出現(xiàn),浮力對流及Marangoni對流的影響仍舊不可忽視,通向組分均勻分布的完美半導(dǎo)體之路并不平坦。很顯然,對于空間材料科學(xué)來說,如何進(jìn)一步抑制對流是一個極其重要的課題。
很久之前,靜磁場就被認(rèn)為是與微重力類似的抑制對流的手段。例如,Cr?ll小組[28]詳細(xì)研究了磁場對于Si晶體生長過程的影響,發(fā)現(xiàn)施加磁場可以完全避免生長條紋的出現(xiàn)。但是,后續(xù)研究結(jié)果顯示,若通過靜磁場在地面環(huán)境下抑制對流,進(jìn)而實現(xiàn)由擴(kuò)散主導(dǎo)的溶質(zhì)輸運(yùn)過程,磁場強(qiáng)度至少需要達(dá)到若干個特斯拉[29]。強(qiáng)磁場會帶來2個弊端:①經(jīng)濟(jì)上代價太大;②會引起熱電磁對流等副效應(yīng)[29];因此在技術(shù)上并不現(xiàn)實。隨著研究的深入,微重力與弱磁場相結(jié)合作為一個可行的研究路徑受到關(guān)注,許多小組在這方面進(jìn)行了卓有成效的嘗試。例如,F(xiàn)ripp等[30]試圖利用軸向磁場抑制徑向?qū)α鞣至浚⒒诖怪盉ridgman方法進(jìn)行了數(shù)值模擬。結(jié)果顯示,在微重力條件下,只需數(shù)千高斯的磁場就足以有效抑制浮力對流效應(yīng)。Baumgartl 等[31]的結(jié)果也證實,磁場的強(qiáng)度及取向?qū)τ谄鋵嶋H使用效果有顯著的影響。Herrmann等[32]在微重力環(huán)境下進(jìn)行了GaAs晶體的生長,但由于施加磁場強(qiáng)度過小,效果并不特別明顯。從技術(shù)上而言,在空間飛行器上施加數(shù)千高斯的磁場稍顯奢侈。改靜磁場為旋轉(zhuǎn)磁場,或許是解決問題的可行辦法。與靜磁場不同,旋轉(zhuǎn)磁場的作用是產(chǎn)生強(qiáng)制對流,以補(bǔ)償熔體中已有的對流效應(yīng)。在俄羅斯Foton-M3衛(wèi)星上開展的Ge∶Ga晶體生長實驗中,旋轉(zhuǎn)磁場的施加使得生長條紋明顯變?nèi)鮗33]。Dold及合作者也在Ge∶Ga體系中發(fā)現(xiàn)了類似的結(jié)果[34]。
Lan等[35,36]通過系列模擬工作,研究了通過坩堝旋轉(zhuǎn)技術(shù)抑制動態(tài)加速度效應(yīng)、控制組分偏析的可行性。他們發(fā)現(xiàn),微重力環(huán)境下不高于20 r/min的旋轉(zhuǎn)速度即可產(chǎn)生與地面100 r/min相同的效果。計算結(jié)果進(jìn)一步顯示,在采用坩堝旋轉(zhuǎn)技術(shù)時,晶體軸向組分分布可接近純擴(kuò)散生長極限,而徑向偏析也能得到顯著改善。除此之外,該小組還考慮了偏心旋轉(zhuǎn)的可能影響,發(fā)現(xiàn)只要偏心角不過大,對晶體組分分布的影響基本可以忽略不計。
從式(3)中可以看出,Rayleigh數(shù)與L3及成正比,可以利用這一特點來設(shè)計實驗方案以抑制浮力對流。例如,將熔池深度降低一個量級,浮力對流水平將相應(yīng)地下降3個量級。此外,減小爐體溫場梯度,也能在一定程度上抑制浮力對流強(qiáng)度。Ostrogorsky[37-39]設(shè)計了下沉加熱器這一新穎的加熱模式,大幅降低了有效熔池深度,并減小了爐體溫場梯度,在地面條件下實現(xiàn)了Ge基和InSb基晶體的準(zhǔn)擴(kuò)散生長。隨后,進(jìn)一步簡化方案,利用高熱傳導(dǎo)材料石墨制備的下沉隔板替代下沉加熱器,也能起到類似的效果[40]。利用這一技術(shù),科學(xué)家在國際空間站開展了Te摻雜InSb及Zn摻雜InSb的生長工作,并取得了預(yù)料中的效果[41,42]。由于Marangoni數(shù)與L線性相關(guān),可以預(yù)期,下沉隔板法對于Marangoni對流不會特別有效。除了2.2節(jié)介紹的表面氧化層,更有效的抑制Marangoni對流的方法其實是設(shè)法消除自由表面。相關(guān)內(nèi)容會在3.3節(jié)略作討論。
3 非接觸 Bridgman生長
3.1 非接觸Bridgman生長的發(fā)現(xiàn)及其意義
1970年代Witt等[9]利用Bridgman法進(jìn)行InSb空間生長時,意外發(fā)現(xiàn)晶體外徑竟然明顯小于坩堝的內(nèi)徑。這顯然不是由熱脹冷縮所致,因為InSb在液-固轉(zhuǎn)變時通常會產(chǎn)生體積膨脹。這種現(xiàn)象被稱為非接觸生長(Detached Growth),其示意圖如圖4所示[43]。從概念上講,非接觸生長指的是晶體本身與器壁不接觸,而熔體絕大部分與器壁是接觸的。從純幾何的角度而言,非接觸生長需滿足熔體浸潤角與晶體生長角之和大于180°的條件[43]。一般的半導(dǎo)體材料與坩堝組合,很難滿足這一苛刻的條件。除InSb外,其它半導(dǎo)體,如 Ge、GaSb、CdTe等,也都在微重力環(huán)境下觀察到了非接觸生長現(xiàn)象[24,44]。盡管微重力環(huán)境并不總是導(dǎo)致非接觸生長,但非接觸生長確實可以稱得上是空間半導(dǎo)體Bridgman生長的典型特征之一。但在地面環(huán)境下,基于同樣的實驗條件、同樣的裝置,地面條件下卻總是難以觀察到非接觸生長。很顯然,非接觸出現(xiàn)與否與重力場有密切的關(guān)系。與空間情形相比,地面環(huán)境下熔體自身具有靜壓力,這可能是導(dǎo)致空間與地面實驗產(chǎn)生差異的原因。但是,其背后具體的機(jī)理,在很長時間內(nèi)都不是很清楚。

圖4 布里奇曼法溫場分布曲線(a),正常布里奇曼生長示意圖(b),非接觸布里奇曼生長示意圖(c),微重力環(huán)境下制備的Ge晶體照片(從中可以很清楚看到非接觸生長)(d),地面重力環(huán)境下生長的Ge晶體照片(e) [43]Fig.4 Temperature profile needed for Bridgman growth (a), schematic of Bridgman growth (b), schematic of detached Bridgman growth (in which α stands for the growth angle and θ is the contact angle of the melt) (c), Ge crystals grown by Bridgman method under microgravity (d) and on the ground (e) [43]
在常規(guī)Bridgman生長時晶體與坩堝壁是接觸的,由于晶體與坩堝材料熱膨脹系數(shù)的差異,晶體與坩堝壁之間會產(chǎn)生顯著的熱失配。例如,常用的石英坩堝熱膨脹系數(shù)約為5×10-7/K,要比多數(shù)半導(dǎo)體的熱膨脹系數(shù)小一個量級。晶體與坩堝間的熱失配會造成晶體中缺陷(特別是位錯)密度的顯著增加,使得晶體質(zhì)量大幅降低。熱失配嚴(yán)重時,甚至?xí)?dǎo)致微裂紋等宏觀缺陷的形成。實驗結(jié)果顯示,非接觸生長由于避免了晶體與坩堝壁之間的直接接觸,因此可以有效降低熱失配,進(jìn)而使晶體中位錯密度大大降低。根據(jù)Dold等[43]及Schweizer等[45]的報道,非接觸生長可使Ge晶體位錯密度下降約2個數(shù)量級。在空間生長的CdZnTe晶體中,也觀察到了類似的現(xiàn)象[46]。最驚人的結(jié)果來自InSb體系[44],空間非接觸生長的晶體位錯密度僅僅為2.5×10 /cm2,而地面常規(guī)樣品的位錯密度則高達(dá)104~105/cm2!低的位錯密度對于研制高性能器件的意義不言而喻。例如,陳諾夫等[3,47]基于低位錯密度的空間半絕緣GaAs單晶制造的低噪聲場效應(yīng)晶體管和模擬開關(guān)集成電路,其各項性能均超過了地面材料制造的相同器件。
3.2 非接觸生長機(jī)理
自20世紀(jì)90年代以來,通過Duffar等[48,49]的一系列理論及實驗工作,非接觸生長的原因才算徹底搞清楚。非接觸生長時晶體與器壁之間存在間隙,三相交界線與器壁之間依靠彎液面來連接。典型的Bridman非接觸生長時彎液面及晶體-器壁間隙附近的示意圖如圖5所示,在晶體-器壁間隙處(熔體下端)及熔體上端存在氣體(揮發(fā)所致)。根據(jù)拉氏方程,在彎液面兩側(cè)的壓力差為(見式(7))[49]:

圖5 非接觸生長彎液面區(qū)域示意圖。Pcold與Phot:熔體下端及上端的氣相壓力;h:熔體區(qū)高度;R0:坩堝的半徑;R1:彎液面曲率半徑;R2:彎液面曲率半徑(垂直于紙面方向)[48,49]Fig.5 Schematic of the meniscus region in the detached growth. Pcold and Phot are gas pressures below and above the melt, h is the height of the melt, R0 the radius of the crucible, and R1 and R2 are the meniscus radii (R1 in the plane of the figure, R2 in the plane perpendicular to R1)[48,49]
ΔP=σ=(1/R1+1/R2)
(7)
其中σ為表面張力。由圖5可知(見式(8)和式(9))[49]:
R1=-ds/dβ
(8)
R2=r/cosβ
(9)
在彎液面附近,ΔP可表示為坐標(biāo)z的方程(見式(10))[49]:
ΔP=ΔP0+zρg
(10)
其中ΔP0為三相點處的壓力差,ρ為熔體密度,g為重力加速度。綜合(7)~(10)式,有(見式(11))[49]:
dβ/ds-cosβ/γ=-ΔP/σ=-(Pcold-Phot)+ρg(h-z)/σ
(11)
很明顯,(11)式左端與彎液面的形狀有關(guān),右端第一項反映了熔體上、下端氣相壓力對彎液面形狀的影響,第二項則代表了重力的貢獻(xiàn)。利用(11)式,可以通過數(shù)值解析的方式對晶體生長的形態(tài)進(jìn)行預(yù)測。Kaiser等[50]對Ge晶體的Bridgman生長進(jìn)行了數(shù)值模擬,其中晶體生長角α選為11°,表面張力σ取為0.5969 N/m,結(jié)果如圖6所示。可以看到,α+θ< 180°時,晶體-坩堝間隙在ΔP≈ -200 Pa時取最大值。晶體-坩堝間隙當(dāng)ΔP<-200 Pa時急劇減小,在ΔP> -200 Pa時則緩慢地以對數(shù)關(guān)系衰減。根據(jù)Lyapunov穩(wěn)定性條件[48],晶體-熔體界面處的彎液面必需向氣相一側(cè)凸出,在動力學(xué)上才能夠穩(wěn)定存在。根據(jù)計算,ΔP> -10 Pa時彎液面為凹進(jìn)型,所以不利于晶體-坩堝間隙的穩(wěn)定存在[49]。綜合考慮以上因素,α+θ< 180°條件下穩(wěn)定的非接觸生長需要ΔP位于-200 ~ -100 Pa的區(qū)間。α+θ> 180°時,彎液面形狀在ΔP< 0 Pa時始終滿足Lyapunov動力學(xué)穩(wěn)定條件,理論上在該壓力區(qū)間均可實現(xiàn)非接觸生長[49]。但是,由于ΔP< -2000 Pa時晶體-坩堝間隙過小,與坩堝表面粗糙度在一個數(shù)量級,此時并不能出現(xiàn)非接觸生長。因此,α+θ> 180°條件下出現(xiàn)非接觸生長的ΔP范圍在-2000~0 Pa區(qū)間。
在重力環(huán)境下,熔體靜壓力對于ΔP有重要貢獻(xiàn)。半導(dǎo)體熔體密度通常在5 g/cm3左右,假設(shè)熔體區(qū)高度為10 cm,則熔體靜壓的貢獻(xiàn)約為-5000 Pa。由此可見,對于α+θ< 180°和α+θ> 180°兩種情況,ΔP取值都遠(yuǎn)遠(yuǎn)偏離了非接觸生長的條件。這樣,在地面實驗中很少能夠觀察到非接觸生長,也就不難理解了。另外,從圖6a和6b中還可以看出,接觸角越大,越有利于實現(xiàn)非接觸生長。鑒于非接觸生長在降低位錯等缺陷密度方面的巨大優(yōu)勢,人們期望在地面環(huán)境下也能夠?qū)崿F(xiàn)非接觸生長。

圖6 間隙寬度與彎液面兩側(cè)壓差的關(guān)系:(a) θ+α< 180°,(b) θ+α> 180°[48]Fig.6 Gap width as a function of pressure differential across the meniscus for θ+α< 180° (a) and θ+α> 180° (b) [48]
3.3 非接觸生長機(jī)理指導(dǎo)地面及空間實驗
根據(jù)上述討論,使熔體下端相對于熔體上端過壓,是實現(xiàn)地面非接觸生長的前提條件。根據(jù)具體情況,實現(xiàn)熔體下端過壓的途徑各有不同。具體而言,實現(xiàn)熔體下端過壓的方法主要有3種:①通過外部氣源實現(xiàn)過壓;②通過溫度梯度變化誘導(dǎo)過壓產(chǎn)生;③在熔體下端引入易揮發(fā)原料。第3種方法只對CdTe、GaAs等含有高飽和蒸汽壓組元的材料有效,適用范圍較為受限。前兩種方法具有通用性,適用于所有的半導(dǎo)體材料。第一種方法的核心在于兩端開口的安瓿結(jié)構(gòu),其熔體上端及下端分別通過開口與外部氣源相連接,因而這兩部分的氣體壓力可以由外部氣源獨立控制[48]。通過該方法,很容易使熔體下端的過壓抵消熔體靜壓力的貢獻(xiàn),使得體系滿足非接觸生長的壓力條件。隨著生長的進(jìn)行,熔體上下端空間此消彼長,因而兩端的壓差始終處于動態(tài)變化中,顯然不利于得到恒定的晶體直徑。為解決這一問題,Yeckel等[51]最近發(fā)展了線性及非線性的比例-積分反饋控制技術(shù),這一局限性有望得到解決。
第二種方法的核心思想最早由Szofran等[43]提出。在這一方法中,密封的安瓿中預(yù)先充入惰性氣體,之后加熱使原料區(qū)處于熔融狀態(tài)。在生長開始時,降低熔體上端處的溫度,這樣就可人為制造出熔體上下端的壓差。當(dāng)然,為實現(xiàn)這一目的,爐體必需具備多段爐絲加熱、各段可單獨控溫的能力。隨著生長的持續(xù)進(jìn)行,熔區(qū)-溫場對應(yīng)關(guān)系會逐漸改變,進(jìn)而破壞非接觸生長所需的條件。因此,安瓿上端的溫度應(yīng)隨著生長的進(jìn)行,不斷做出相應(yīng)的調(diào)整。Duffar等[52]在研究GaSb體系的非接觸生長時,提出了一種改進(jìn)的方案——在籽晶下端引入特殊設(shè)計的“氣體庫”,“氣體庫”氣壓可根據(jù)需要由溫度來調(diào)控。由于“氣體庫”與晶體區(qū)的溫度控制是獨立進(jìn)行的,這一方案可有效實現(xiàn)熔體下端過壓,且不影響晶體生長所需的最佳溫場曲線設(shè)置。基于溫度梯度變化誘導(dǎo)過壓的方法,人們實現(xiàn)了Ge晶體的非接觸Bridgman生長,得到的位錯密度約為2×102/cm2,比常規(guī)接觸生長得到的晶體降低了1到2個量級[45]。需要說明,非接觸生長本身并不罕見,常規(guī)的浮區(qū)法就可以做到。但是,非接觸Bridgman生長卻可以有效克服浮區(qū)法晶體直徑有限的缺憾,在制備低缺陷濃度半導(dǎo)體晶體方面仍具有巨大的吸引力。基于對非接觸生長機(jī)理的深刻理解,在地面環(huán)境下借助于非接觸Bridgman技術(shù)實現(xiàn)高質(zhì)量半導(dǎo)體晶體的生長,是空間材料科學(xué)最為引人矚目的成就之一。
半導(dǎo)體熔體是一種具有低Prandtl 數(shù)的流體,表現(xiàn)為高的熱導(dǎo)率和低的粘滯性。因此,在地面環(huán)境下一般很難獲得穩(wěn)定的自然對流。通過解析的方法,很難對隨機(jī)、失穩(wěn)的流形進(jìn)行嚴(yán)格求解,這既影響對于晶體生長過程的深入理解,也不利于導(dǎo)出精確的晶體生長參數(shù)。微重力條件盡管不能完全抑制自然對流,但多數(shù)情況下可以獲得穩(wěn)定的對流狀態(tài),為解決上述問題創(chuàng)造了難得的條件。但是,在自由表面出現(xiàn)的情況下,Marangoni對流這一地面次級效應(yīng)的作用會凸顯出來,使得問題復(fù)雜化。對于Bridgman方法來說,基于對自由表面(非接觸生長)出現(xiàn)原因的透徹理解,可以通過一定的手段有效消除Marangoni對流的影響。Ostrogorsky等[41,42]在國際空間站開展了Te摻雜InSb及Zn摻雜InSb晶體的批量生長工作。在該實驗中,安瓿中采用了改進(jìn)的活塞及彈簧機(jī)構(gòu),使得安瓿內(nèi)壓力條件避開了非接觸生長區(qū),因而抑制了自由表面的形成,最大限度降低了Marangoni對流的影響。為了實時觀察固-液界面的具體形態(tài),判斷自由表面有無形成,生長爐配備了原位觀察系統(tǒng)。該小組利用Tiller理論,由純擴(kuò)散生長起始瞬態(tài)的理論表達(dá)式擬合了所得的軸向組分分布曲線(如圖7)。結(jié)果顯示,摻雜組分分布與純擴(kuò)散生長的理論預(yù)期基本一致。同時,還得到了擴(kuò)散系數(shù)這一晶體生長參量的可信數(shù)值。

圖7 Te摻雜InSb雜質(zhì)分凝曲線(其中實線及虛線分別表示在擴(kuò)散系數(shù)為1×10-5 cm2/s 和2×10-5 cm2/s情況下的有限元計算結(jié)果)[41]Fig.7 Dopant segregation profile of the Te-doped InSb (the solid and dashed lines are based on finite element calculations using diffusion coefficients of 1×10-5 cm2/s and 2×10-5 cm2/s)[41]
4 空間晶體生長新方法
4.1 移動加熱器法
除了Bridgman方法外,其它的晶體生長方法,如移動加熱器法(Traveling Heater Method, THM),近年來也得到了越來越多的關(guān)注。THM又稱為移動溶劑區(qū)法,顧名思義,是一種采用局部區(qū)域熔融生長晶體的方法。但與Bridgman方法不同,THM本質(zhì)上是一種助熔劑法,通過助熔劑的添加來降低生長結(jié)晶溫度。HTM法示意圖如圖8所示[53],在籽晶和原料區(qū)之間夾有低熔點助熔劑,隨著生長界面不斷前移,助熔劑被不斷排向未熔融的原料區(qū),通過這個過程可實現(xiàn)晶體的連續(xù)結(jié)晶生長。在HTM方法中,原料區(qū)界面溫度要始終高于結(jié)晶界面,否則難以保持原料的持續(xù)熔化和晶體的連續(xù)生長。HTM法在近些年已成為空間半導(dǎo)體生長的主流技術(shù)手段之一,特別是在CdTe及CdZnTe研究方面,HTM法似乎有著不可替代的地位[54]。理論模擬揭示,通過在微重力環(huán)境下抑制對流,可以獲得更加穩(wěn)定的HTM生長界面和更加均勻的組分分布。Borisenko等[55]在俄羅斯Foton-M4衛(wèi)星上進(jìn)行的實驗表明,微重力確實有助于獲取組分均勻的CdZnTe晶體。相對于地面樣品,空間CdZnTe樣品具有更完美的晶體質(zhì)量((220)峰搖擺曲線半高寬僅為39.5 arc sec)、更少的富Te沉淀顆粒(數(shù)量下降4倍)、更好的半絕緣性(電阻率~109Ω cm),為高效離子輻射探測器的制備奠定了基礎(chǔ)。實驗還發(fā)現(xiàn),施加低頻弱旋轉(zhuǎn)磁場,有利于減少富Te沉淀相、提高CdZnTe的組分
均勻性及電學(xué)均一性[56]。理論研究肯定了低頻小磁場在促進(jìn)生長界面穩(wěn)定性、提高CdZnTe空間晶體質(zhì)量方面的有益作用,但也強(qiáng)調(diào),磁場是一把雙刃劍,在磁場強(qiáng)度較大時其副作用通常更加突出[57,58]。總的來講,HTM法的優(yōu)點是晶體生長可以在遠(yuǎn)低于熔點的溫度下進(jìn)行,在生長具有大偏析效應(yīng)、高蒸汽壓的材料時優(yōu)勢明顯;缺點在于溶質(zhì)濃度低,晶體生長速度偏慢。例如,對于CdZnTe,其生長依賴于通過熔化界面溶解的Cd、Zn向結(jié)晶界面的遠(yuǎn)距離連續(xù)傳輸,生長速度僅為3~5 mm/d。生長速度慢,無疑大大影響了HTM法的實用性。

圖8 THM方法原理示意圖[53]Fig.8 Schematic illustration of the THM method[53]
4.2 移動液相區(qū)法
移動液相區(qū)法(Traveling Liquidus-Zone Method,TLZ)是一種與HTM法類似的晶體生長技術(shù),亦采用三明治(籽晶區(qū)-低熔點區(qū)-原料區(qū))樣品安瓿結(jié)構(gòu),其中籽晶區(qū)與原料區(qū)為同一種材料(如圖9)[59,60]。TLZ法本質(zhì)上是一種熔體法,這是與作為溶液法的HTM的主要區(qū)別。因為這一特征,TLZ法在生長時液相區(qū)溶質(zhì)濃度相對更大,因此理論上具有更快的生長速度。加溫時,低熔點區(qū)融化,高熔點的籽晶區(qū)及供料區(qū)不斷溶解進(jìn)入液相區(qū),形成合金熔體;籽晶-熔體界面處溶質(zhì)飽和時,合金晶體生長便自然發(fā)生。此時界面處的質(zhì)量平衡方程為(見式(12))[60]:
(12)
其中CL和CS分別代表固-液界面兩側(cè)液相和固相中的溶質(zhì)濃度,R為自發(fā)生長速度,D為擴(kuò)散系數(shù)。假設(shè)CL只與溫度相關(guān),即CL=CL(T),則式(12)右側(cè)可寫作:
(13)
于是,式(12)變?yōu)椋?/p>
(14)
其中?T/?x為固-液界面處的溫度梯度,?CL/?T則依賴于溶質(zhì)分布,一般情況下較為復(fù)雜。當(dāng)忽略對流的影響,溶質(zhì)傳輸過程僅由擴(kuò)散決定時,界面處CL在給定溫度下可認(rèn)為取飽和值,即與液相線對應(yīng)的溶質(zhì)濃度一致。若固-液界面位置固定,式(14)右側(cè)在給定的溫度下將為定值。為確保固-液界面位置恒定,通常液相區(qū)以速度R向晶體生長的反方向移動。由上面的討論可知,在溶質(zhì)輸運(yùn)由擴(kuò)散主導(dǎo)時,移動液相區(qū)法可以得到組分均勻分布的晶體。假如CL>CS,則當(dāng)移動速度大于R時,晶體中溶質(zhì)濃度在軸向逐漸變小;而當(dāng)移動速度小于R時,晶體中溶質(zhì)濃度的變化趨勢相反。特別強(qiáng)調(diào),在重力場下,只有在體系徑向尺寸很小(可視為準(zhǔn)一維系統(tǒng))時,對流的影響才可近似忽略。當(dāng)體系徑向尺寸較大時,由于對流的影響,界面附近溶液很容易出現(xiàn)過飽和或欠飽和,上面討論的情況不再成立。因此,移動液相區(qū)法在地面原則上只能制備直徑很小的組分均勻晶體。根據(jù)Kinoshita等[59]的報道,TLZ法可成功生長直徑為1.5~2 mm的In0.3Ga0.7As單晶,但當(dāng)直徑增加時,晶體質(zhì)量及組分均勻性急劇變差。理論模擬表明[60],在晶體徑向尺寸增加時,如果籽晶采用熱傳導(dǎo)性更好的材料,同時降低坩堝的熱傳導(dǎo)系數(shù),組分分布的均勻性可以得到改善,這點今后的工作或許可以加以嘗試。
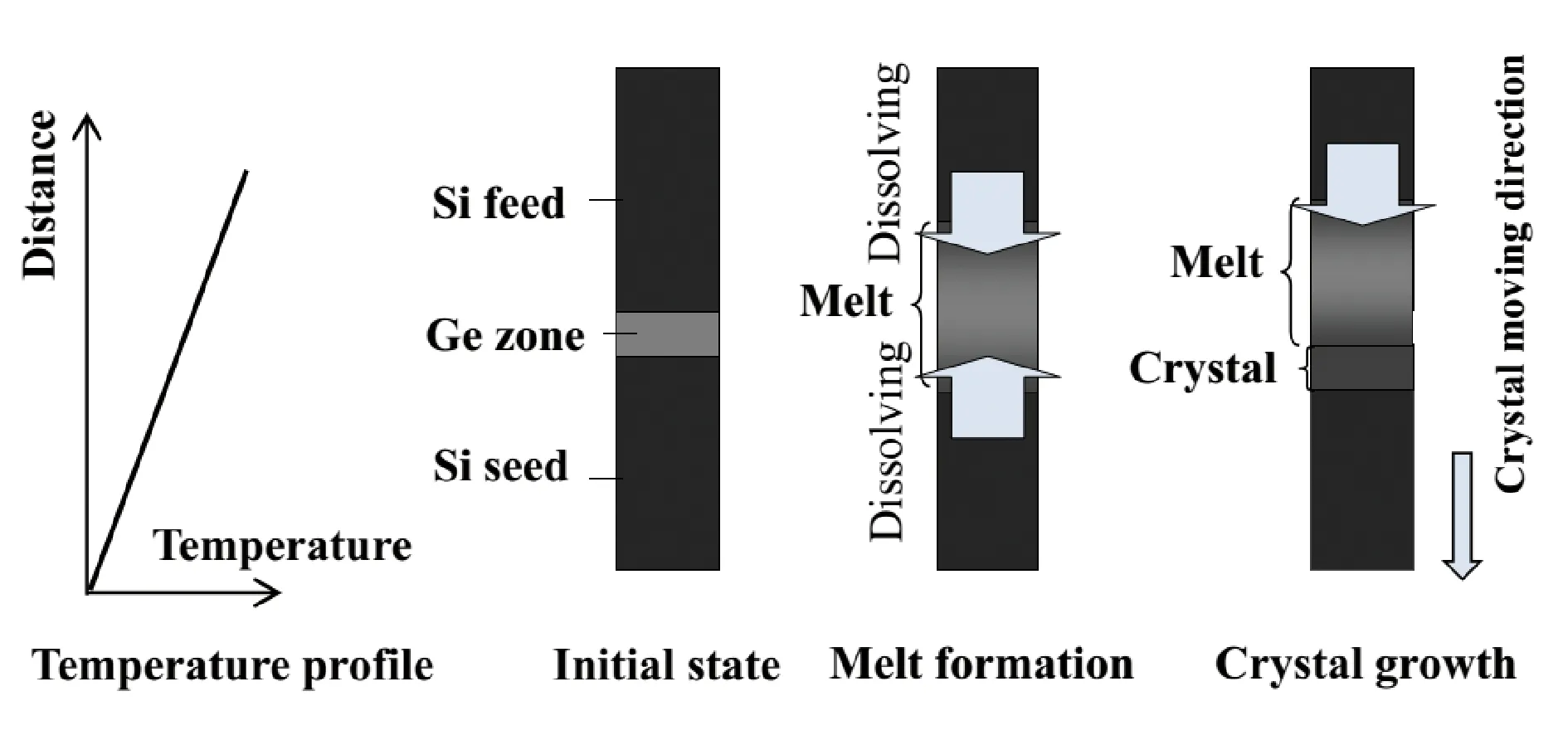
圖9 TLZ法生長晶體示意圖(以SiGe體系為例說明)[59,60]Fig.9 Schematic of the TLZ method (taking the SiGe system as an example)[59,60]
日本JAXA研究團(tuán)隊利用國際空間站實驗平臺開展了Si0.5Ge0.5晶體的TLZ生長工作[61],晶體生長爐的溫度梯度為9 ℃/cm,晶體直徑約10 mm,晶體提拉速度為0.1 mm/h,總的生長時間為117 h。得到的Si0.5Ge0.5晶體外形如圖10a所示,對應(yīng)的Ge組分二維分布見圖10b。由于籽晶外徑略小于BN坩堝內(nèi)徑,在生長時籽晶-坩堝間縫隙內(nèi)會有熔體滲入,滲入的熔體使得籽晶/晶體界面在接近晶體外緣處向籽晶一端凸進(jìn)。除晶體外緣區(qū)之外,其它區(qū)域的籽晶/晶體界面尖銳平直。總體而言,在所生長的區(qū)域內(nèi)(> 10 mm)內(nèi),無論徑向還是軸向,Ge組分分布都非常均勻。圖10c和10d進(jìn)一步給出了樣品Ge組分在軸向及徑向的分布情況,可以看出,組分波動在軸向小于2%,而在徑向則不大于1%。可以看出,TLZ法在微重力條件下制備組分均勻的半導(dǎo)體合金,具有其它技術(shù)難以比擬的優(yōu)勢。最近,Kinoshita等[62]發(fā)現(xiàn),相對于小的溫度梯度,大的溫度梯度更易導(dǎo)致多晶的出現(xiàn)。除溫度梯度外,同一小組[63]還對生長速度等其它生長參數(shù)對Si0.5Ge0.5生長過程的影響進(jìn)行了詳細(xì)研究。

圖10 SiGe樣品實物圖 (a),組分二維分布圖(b),軸向組分分布(c),徑向組分分布(d) [61]Fig.10 Outer view of the SiGe crystal (a), 2D Ge concentration map (b), axial concentration profiles (c) and radial concentration profile (d) [61]
4.3 垂直梯度凝固法
垂直梯度凝固法(Vertical Gradient Freezing Method, VGF)與TLZ方法原理類似[64],均采用了三明治構(gòu)型,不同之處在于采用VGF方法生長晶體時,晶體相對加熱區(qū)并不移動,而代之以固定溫度梯度下的緩慢降溫。如果降溫速度選取合適,使得固-液界面的溫度恒定,原則上也可以生長出組分均勻的多元半導(dǎo)體(假設(shè)液相始終飽和)。本質(zhì)上,VGF其實與TLZ是同一種方法。VGF不需要任何機(jī)械傳動機(jī)構(gòu),只需要精確的一維溫場控制即可實現(xiàn)晶體生長。在微重力環(huán)境下,任何的機(jī)械運(yùn)動都可能帶來g-顫動的問題,所以VGF在用于空間晶體生長實驗時,潛在的優(yōu)勢非常突出。VGF目前主要應(yīng)用于InxGa1-xSb晶體的微重力生長,典型的實驗結(jié)果如圖11所示[64]。所用的 GaSb、InSb晶錠為(111)取向,直徑為10 mm,皆由切氏法提拉而成。GaSb-InSb-GaSb三明治結(jié)構(gòu)密封于BN坩堝之中,樣品區(qū)兩端由石墨片固定。與地面樣品相比,空間樣品Ga組分空間分布明顯更均勻。另外,在地面由于強(qiáng)對流的存在,晶體籽晶/晶體界面極不規(guī)則,而空間晶體的界面就更加規(guī)則平直。為得到InGaSb的實際生長速度并研究生長過程中界面的動態(tài)演變過程,Inatomi等[21]采用了施加周期性加熱脈沖的方法,人為引入生長條紋,通過生長條紋的分布來間接推理上述信息。通過空地對比研究,他們得到如下結(jié)論:①在地面環(huán)境下,InGaSb的生長自籽晶邊緣開始,而空間晶體則沿籽晶徑向幾乎同時開始;②通過測量生長條紋間距,推測微重力條件下晶體生長速度略大于地面;③微重力條件下穩(wěn)態(tài)生長階段持續(xù)的距離比地面要大得多。同一小組[65]還研究了不同籽晶終止面的結(jié)晶生長規(guī)律,發(fā)現(xiàn)由于GaSb(111)B更易溶解,當(dāng)采用GaSb(111)B為籽晶時,InGaSb生長速度較使用GaSb(111)A籽晶更快。
5 結(jié) 語
微重力半導(dǎo)體材料科學(xué)實驗始于對完美晶體的追求。盡管美夢未能成真,微重力這一獨特平臺仍然從理論及實驗兩方面極大地促進(jìn)了半導(dǎo)體晶體生長技術(shù)的發(fā)展。利用微重力環(huán)境,人們將Marangoni對流從浮力對流的影響中分離出來,獨立予以研究,對于晶體生長相關(guān)的質(zhì)量輸運(yùn)過程有了深入的理解。對溶質(zhì)傳輸與各種對流形式之間相互作用的深刻認(rèn)識反過來又促進(jìn)了晶體生長技術(shù)的發(fā)展,人們開發(fā)了多種有效的對流控制技術(shù),在地面環(huán)境已經(jīng)實現(xiàn)了準(zhǔn)擴(kuò)散生長。基于微重力環(huán)境,人們發(fā)現(xiàn)了以非接觸 Bridgman生長為典型的一系列新的晶體生長現(xiàn)象,而對于這些現(xiàn)象的深入思考又帶來了地基晶體生長技術(shù)的巨大進(jìn)步。最近,以移動液相區(qū)法為代表的半導(dǎo)體合金生長技術(shù)取得了突破,所得空間晶體無論在軸向還是徑向,都無明顯偏析產(chǎn)生。盡管這些技術(shù)目前所生長的材料種類仍非常有限,但從原理上看,其可推廣性是確定無疑的。

圖11 空間樣品(a)及地面樣品(b)的外觀圖、熔區(qū)示意圖及Ga組分二維分布圖[64]Fig.11 Outside views, schematic representation of the dissolved area, and Ga composition profile around the center of the space-grown crystal (a), earth-grown crystal (b) [64]
經(jīng)過多年的發(fā)展與積累,今后微重力半導(dǎo)體材料科學(xué)的發(fā)展脈絡(luò)已經(jīng)隱約可見:①不以完美晶體為目標(biāo),著重于利用微重力這一特殊的工具,探索晶體生長的新現(xiàn)象,挖掘其背后的新機(jī)理;②重視硬件研發(fā),多段加熱、溫場精確可控、配備有各種原位監(jiān)控檢測裝置的生長爐是今后空間材料科學(xué)實驗的必然要求;③學(xué)科交叉愈來愈重要,微重力晶體生長方面的進(jìn)步離不開材料科學(xué)與流體物理的密切合作;④對于最近發(fā)展起來的半導(dǎo)體合金生長技術(shù)(如移動液相區(qū)法)進(jìn)行進(jìn)一步的微重力實驗驗證,并將之拓展至更多的材料體系。
References
[1] Benz K W, Dold P.JCrystGrowth[J], 2002, 237: 1638-1645.
[2] Chen Wanchun(陳萬春),Song Youting(宋友庭).SciTechnolRev(科技導(dǎo)報)[J], 2012, 30: 46-57.
[3] Chen N F, Zhong X R, Lin L Y,etal.ApplPhysLett[J], 2001, 78: 478-479.
[4] Wang Z G, Li C J, Cao F N,etal.JApplPhys[J], 1990, 67: 1521-1524.
[5] Lin L Y, Zhong X R, Chen N F.JCrystGrowth[J], 1998, 191: 586-588.
[6] Ebnalwaled A A, Duffar T, Sylla L.CrystResTechnol[J], 2013, 48: 236-244.
[7] Tiller W A, Jackson K A, Rutter J W,etal.ActaMet[J], 1953, 1: 428-437.
[8] Smith V G, Tiller W A, Rutter J W.CanJPhys[J], 1955, 33: 723-745.
[9] Witt A F, Gatos H C, Lichtensteiger M,etal.JElectrochemSoc[J], 1975, 122: 276-283.
[10]Witt A F, Gatos H C, Lichtensteiger M,etal.JElectrochemSoc[J], 1978, 125: 1832-1840.
[11]Bly J M, Kaforey M L, Matthiesen D H,etal.JCrystGrowth[J], 1997, 174: 220-225.
[12]Gillies D C, Lehoczky S L, Szofran F R,etal.JCrystGrowth[J], 1997, 174: 101-107.
[13]Alexander J I D, Garandet J P, Favier J J,etal.JCrystGrowth[J], 1997, 178: 657-661.
[14]Strelov V I, Kuranova I P, Zakharov B G,etal.CrystallogrRep[J], 2014, 59: 781-806.
[15]Naumann R J.JCrystGrowth[J], 1994, 142: 253-267.
[16]Alexander J I D, Ouazzani J, Rosenberger F.JCrystGrowth[J], 1989, 97: 285-302.
[17]Derby J J, Kwon Y, Pandy A,etal.AnnNYAcadSci[J], 2006, 1077:124-145.
[18]Stelian C, Duffar T.JCrystGrowth[J], 2005, 275: e585-e594.
[19]Stelian C, Duffar T.JCrystGrowth[J], 2005, 275: 175-184.
[20]Duffar T, Serrano M D, Lerin L,etal.CrystResTechnol[J], 1999, 34: 457-465.
[21]Inatomi Y, Sakata K, Arivanandhan M,etal.NPJMicrogravity[J], 2015, 1: 15011.
[22]Schweizer M, Cr?ll A, Dold P,etal.JCrystGrowth[J], 1999, 203: 500-510.
[23]Cr?ll A, Kaiser T, Schweizer M,etal.JCrystGrowth[J], 1998, 191: 365-376.
[24]Nishinaga T, Ge P, Huo C,etal.JCrystGrowth[J], 1997, 174: 96-100.
[25]Nakamura T, Nishinaga T, Ge P,etal.JCrystGrowth[J], 2000, 211: 441-445.
[26]Voloshin A E, Lomov A A, Nishinaga T,etal.JCrystGrowth[J], 2002, 236: 501-510.
[27]Tillberg E, Carlberg T.JCrystGrowth[J], 1990, 99: 1265-1272.
[28]Cr?ll A, Szofran F R, Dold P,etal.JCrystGrowth[J], 1998, 183: 545-553.
[29]Yesilyurt S, Vujisic L, Motakef S,etal.JCrystGrowth[J], 1999, 207: 278-291.
[30]Yao M W, Chait A, Fripp A L,etal.JCrystGrowth[J], 1997,173: 467-480.
[31]Baumgartl J, Müller G.JCrystGrowth[J], 1996, 169: 582-586.
[32]Herrmann F, Müller G.JCrystGrowth[J], 1995, 156: 350-360.
[33]Barmin I V, Senchenkov A S, Greif A,etal.Magnetohydrodynamics[J], 2009, 45: 325-331.
[34]Dold P, Benz K W.CrystResTechnol[J], 1997, 32:51-60.
[35]Lan C W, Tu C Y.JCrystGrowth[J], 2002, 237: 1881-1885.
[36]Lan C W.JCrystGrowth[J], 1999, 197: 983-991.
[37]Ostrogorsky A G.JCrystGrowth[J], 1990, 104: 233-238.
[38]Ostrogorsky A G, Sell H J, Scharl S,etal.JCrystGrowth[J], 1993, 128: 201-206.
[39]Dutta P S, Ostrogorsky A G.JCrystGrowth[J], 1999, 197: 749-754.
[40]Dutta P S, Ostrogorsky A G.JCrystGrowth[J], 2000, 217: 360-365.
[41]Ostrogorsky A G, Marin C, Churilov A,etal.JCrystGrowth[J], 2008, 310: 364-371.
[42]Ostrogorsky A G, Marin C, Volz M P,etal.JCrystGrowth[J], 2009, 311: 3243-3248.
[43]Cr?ll A, Volz M P.MRSBull[J], 2009, 34: 245-250.
[44]Regel L L, Wilcox W R.MicrogravitySciTechnol[J], 1998, XI/4: 152-166.
[45]Schweizer M, Cobb S D, Volz M P,etal.JCrystGrowth[J], 2002, 235: 161-166.
[46]Sylla L, Fauler A, Fiederle M,etal.IEEETNuclSci[J], 2009, 56: 1747-1751.
[47]Lin Lanying(林蘭英),Zhang Mian(張 綿),Zhong Xingru(鐘興儒),etal.SciChinaE[J], 1999, 42: 456-461.
[48]Duffar T, Dusserre P, Picca F,etal.JCrystGrowth[J], 2000, 211: 434-440.
[49]Palosz W, Volz M P, Cobb S.JCrystGrowth[J], 2005, 277: 124-132.
[50]Kaiser N, Cr?ll A, Szofran F R,etal.JCrystGrowth[J], 2001, 231: 448-457.
[51]Yeckel A, Daoutidis P, Derby J J.JCrystGrowth[J], 2012, 356: 33-45.
[52]Duffar T, Dusserre P, Giacometti N.JCrystGrowth[J], 2001, 223: 69-72.
[53]Peterson J H, Fiederle M, Derby J J.JCrystGrowth[J], 2016, 454: 45-58.
[54]Stelian C, Duffar T.JCrystGrowth[J], 2014, 400: 67-75.
[55]Borisenko E B, Kolesenikov N N, Senchenkov A S,etal.JCrystGrowth[J], 2017, 457: 262-264.
[56]Salk M, Fiederle M, Benz K W,etal.JCrystGrowth[J], 1994, 138: 161-167.
[57]Stelian C, Duffar T.JCrystGrowth[J], 2015, 429: 19-26.
[58]Li Z Y, Peterson J H, Yeckel A,etal.JCrystGrowth[J], 2016, 452: 17-21.
[59]Kinoshita K, Kato H, Iwai M,etal.JCrystGrowth[J], 2001, 225: 59-66.
[60]Adachi S, Kinoshita K, Takayanagi M,etal.JCrystGrowth[J], 2011, 334: 67-71.
[61]Kinoshita K, Arai Y, Inatomi Y,etal.JCrystGrowth[J], 2015, 419: 47-51.
[62]Kinoshita K, Arai Y, Inatomi Y,etal.JCrystGrowth[J], 2016, 455: 49-54.
[63]Kinoshita K, Arai Y, Inatomi Y,etal.IntJMicrogravitySciAppl[J], 2016, 33: 330213.
[64]Yu J, Liu Y, Pan X H,etal.MicrogravitySciTechnol[J], 2016, 28:143-154.
[65]Kumar V N, Arivanandhan M, Rajesh G,etal.NPJMicrogravity[J], 2016, 2: 16026.
(編輯 吳 琛)
Microgravity Growth of Semiconductor Materials
YIN Zhigang1,2, ZHANG Xingwang1,2, WU Jinliang1
(1.Key Lab of Semiconductor Materials Science, Institute of Semiconductors, Chinese Academy of Sciences, Beijing 100083, China)(2.College of Materials Science and Opto-Electronic Technology, University of Chinese Academy of Sciences, Beijing 100049, China)
The microgravity environment aboard the space provides a unique platform to synthesize materials with improved properties as compared with their terrestrial counterparts, and allows an in-depth understanding of crystal-growth-related phenomena that are masked by gravity on the earth. The main achievements in the microgravity growth of semiconductors are listed below: ①the seeking of perfect crystals with chemical homogeneity benefits a profound understanding on the crystal growth process, typically on the relationships among the convective flows, solute transport and chemical segregation; ②based on the microgravity experiments, the underlying mechanism of detached Bridgman growth was clarified and used to guide the space- and ground-based crystal growth processes;③new crystal growth schemes were proposed and implemented successfully to grow chemically homogeneous semiconductor alloys under microgravity. In this review, the main progresses in these aspects are summarized and the future challenges are discussed.
microgravity; buoyancy-driven convection; Marangoni convection; Bridgman growth; detached growth
2017-03-25
中國載人空間站工程(TGJZ800-2-RW024);中國科學(xué)院戰(zhàn)略性先導(dǎo)科技專項項目(XDA04020202-11, XDA04020411)
尹志崗,男,1976年生,副研究員,碩士生導(dǎo)師
張興旺,男,1972年生,研究員,博士生導(dǎo)師, Email:xwzhang@semi.ac.cn
10.7502/j.issn.1674-3962.2017.04.01
O782
A
1674-3962(2017)04-0241-11

