金屬有機物化學氣相沉積同質外延GaN薄膜表面形貌的改善?
李忠輝 羅偉科 楊乾坤 李亮 周建軍 董遜 彭大青 張東國 潘磊 李傳皓
(南京電子器件研究所,微波毫米波單片集成和模塊電路重點實驗室,南京 210016)
金屬有機物化學氣相沉積同質外延GaN薄膜表面形貌的改善?
李忠輝 羅偉科?楊乾坤 李亮 周建軍 董遜 彭大青 張東國 潘磊 李傳皓
(南京電子器件研究所,微波毫米波單片集成和模塊電路重點實驗室,南京 210016)
(2016年12月10日收到;2017年3月9日收到修改稿)
為了獲得高質量的GaN薄膜材料,研究了金屬有機物氣相沉積系統中GaN插入層對GaN襯底同質外延層表面宏觀缺陷和晶體質量的影響.研究發現,插入層生長溫度是影響GaN同質外延膜表面形貌和晶體質量的關鍵因素.由于生長模式與插入層生長溫度相關,隨著插入層生長溫度的降低,外延膜生長模式由準臺階流模式轉變為層狀模式,GaN同質外延膜表面丘壑狀宏觀缺陷逐漸減少,但微觀位錯密度逐漸增大.通過對插入層溫度和厚度的優化,進一步調控外延層的生長模式,最終有效降低了外延層表面的宏觀缺陷,獲得了表面原子級光滑平整、位錯密度極低的GaN同質外延膜,其X射線衍射搖擺曲線(002),(102)晶面半峰寬分別為125 arcsec和85 arcsec,表面粗糙度均方根大小為0.23 nm.
∶金屬有機物化學氣相沉積,同質外延GaN,插入層,生長模式
PACS∶61.05.cp,61.72.—y,68.55.J—,78.55.CrDOI∶10.7498/aps.66.106101
1 引 言
作為第三代寬禁帶半導體材料,GaN不僅具有寬帶隙(3.4 eV),而且還具有熱導率大、電子飽和速率高、擊穿場強大及熱穩定性好等特性,因此在制備高溫、高頻、高壓及大功率器件方面備受關注[1?5].基于AlGaN/GaN異質結的高電子遷移率晶體管器件還具有大擊穿電壓、高飽和電子速率、高2DEG濃度等優良特性[6?8].采用單晶GaN襯底進行同質外延具有缺陷密度低、無晶格失陪和熱失陪等優點,是GaN外延最理想的襯底.然而,由于GaN同質襯底制備較為困難,制約了其在GaN外延中的廣泛應用.近年來,隨著GaN襯底制備技術的發展,多家單位已經獲得了自支撐GaN襯底,世界許多大公司和研究機構在同質外延GaN器件的技術方面投入巨大的人力和物力進行研究.可以預見,GaN襯底在半導體微電子器件領域的應用將會更加廣泛.和異質外延技術不同,GaN襯底同質外延不受襯底晶格失配的影響,通常不需要進行低溫成核層的生長;但由于受襯底表面吸附雜質和拋光劃痕、損傷等影響,GaN襯底同質外延后表面形成大量金字塔形狀的微結構,引起表面起伏,形成丘壑型表面,造成材料表面質量下降,影響器件的性能[9?12].因此,GaN襯底同質外延技術中需要開發新技術、新工藝以改善外延層表面形貌,降低表面起伏,獲得表面平整光亮的氮化物薄膜.
為了去除襯底表面吸附的雜質離子從而獲得潔凈的襯底表面,研究者采用酸溶液化學腐蝕[13]、反應離子刻蝕[14]、原位熱分解[15]等方法對GaN襯底進行生長預處理,這些方法在提高同質外延膜的晶體質量、改善表面形貌方面有一定的效果.為了進一步解決同質外延形貌的問題,有學者研究發現當采用晶向偏角為0.4?,0.5?的c面GaN襯底時,能有效抑制表面金字塔形狀的微結構的形成,從而獲得高質量的外延層[10,11].與這幾種方法相比,本文提出了一種更簡單、有效改善外延層表面形貌的方法——中等溫度GaN插入層(IM-GaN),即在GaN高溫生長前,采用中等溫度(650—900?C)生長30—150 nm厚的GaN層,然后再進行高溫生長.早在2010年,Cho等[16]在氫化物氣相外延系統中采用AlN-藍寶石模板,通過引入IM-GaN的方法(生長溫度900?C,5μm厚)有效地改善了外層的形貌,表面粗糙度均方根(RMS)大小降低了近5倍.2013年,文獻[17]報道了在兩層高溫AlN薄膜之間引入厚度約20 nm的中等溫度插入層,使AlN外延生長模式由三維生長轉變為二維生長模式,從而提高了AlN外延層的表面質量.本文在借鑒以上工作的基礎上,將IM-GaN層的方法應用到GaN襯底的同質外延中,利用IM-GaN引入的層狀生長模式,改變同質外延層的表面形貌.本文著重研究IM-GaN生長溫度、生長厚度等因素對外延層表面形貌的影響,同時將結合X射線衍射、原子力探針掃描等測試方法對IM-GaN層與同質外延生長模式和晶體形貌之間的關系進行深入研究.
2 實 驗
實驗中的GaN樣品均采用Thomas Swan Scientific Equipment公司的金屬有機物化學氣相沉積(MOCVD)系統制備獲得.所使用的襯底為c面半絕緣自支撐GaN襯底,尺寸大小為10 mm×10 mm,襯底厚度約430μm.三甲基鎵(TMGa)作為外延生長過程中的Ga源,高純氨氣(NH3)作為N源.GaN襯底經過丙酮、乙醇和去離子水超聲清洗后,轉移入MOCVD系統中,在氨氣氣氛保護下升溫至1050?C進行300 s熱處理;降低反應室溫度至650—1000?C,進行IM-GaN生長;然后,再升溫至1050?C進行高溫GaN(HT-GaN)外延,生長壓力為300 Torr,N源和Ga源摩爾量V/III比為2500.為了對比分析IM-GaN層生長條件對外延層形貌和晶體質量的影響,采用不同的插入層生長溫度制備了A—D四個樣品,其中A,B,C,D樣品的插入層生長溫度分別為1050,1000,850,650?C,壓強為300 Torr,V/III比為3500,插入層厚度為50 nm.A—D四個樣品除了插入層生長溫度不同,其他處理工藝和生長條件均保持一致.
GaN薄膜的晶體質量、表面形貌分別利用高分辨三軸晶X射線衍射(Bruker D8 Discovery,XRD)、低溫光致發光(325 nm He-Cd激光器,PL)、原子力探針掃描顯微鏡(Digital Instruments Nanoscope III,AFM)和微分相差顯微鏡(Nikon Eclipse LV150 system,DICM)等設備系統進行研究和分析.
3 結果與討論
圖1是樣品A—D(插入層生長溫度從1050?C降低到650?C)的表面形貌DICM 圖像,其中插入層厚度為50 nm,外延層厚度均為2μm.如圖1(a)所示,樣品A在GaN襯底上直接進行高溫(1050?C)外延生長,從圖中可以觀察到外延膜表面起伏較大,呈現出密集的丘壑狀小山丘和劃痕,該類宏觀缺陷將會影響器件研制,導致器件性能下降.圖1(b)為樣品B的表面形貌,插入層生長溫度為1000?C,外延膜表面仍然呈現出大量的丘壑狀小山丘和劃痕,其表面形貌與圖1(a)相似,表面質量未得到較大改善.將插入層生長溫度進一步降低至850?C(樣品C),測試發現表面宏觀缺陷密度顯著下降,如圖1(c)所示.當插入層生長溫度降低至650?C時(樣品D),測試發現外延層表面宏觀缺陷完全消失,樣品呈現光亮平整的表面(見圖1(d)).

圖1 (網刊彩色)不同溫度GaN插入層對同質外延膜表面形貌的影響 (a)—(d)插入層生長溫度分別為1050?C,1000 ?C,850 ?C,650 ?CFig.1. (color online)Differential interference contrast microscopy(DICM)images of GaN homoepitaxy films with IM-GaN grown on different temperature:(a)1050 ?C;(b)1000 ?C;(c)850 ?C;(d)650 ?C.
為了分析插入層生長溫度對樣品晶體質量的影響,采用XRD分別對樣品A—D進行搖擺曲線(rocking curves)掃描測試,其(002)、(102)晶面半峰寬隨著插入層生長溫度的變化情況如圖2所示.從圖中可以觀察到隨著插入層生長溫度的降低,(002)、(102)半峰寬線性增加.眾所周知,(002)和(102)半峰寬大小分別反映外延層中螺位錯(或者混合位錯)和刃位錯密度的高低[18,19].圖2中半峰寬的增加說明外延層中位錯缺陷增多,即隨著插入層生長溫度的降低外延層中位錯密度增加.由此可見,當插入層溫度較高時,能獲得位錯密度較低的外延層,但表面起伏大,宏觀缺陷多,表面質量較差;當插入層溫度較低時,能有效抑制表面宏觀缺陷的形成,表面質量高,但會在外延層中引入較多的位錯缺陷,導致晶體質量下降.因此,插入層生長溫度的選擇需要兼顧考慮表面宏觀缺陷密度和位錯密度兩者,溫度不宜過高或者過低.
為了探究摻入層生長溫度影響外延層形貌的原因,采用AFM分別測試了樣品A和樣品D的表面微觀形貌.樣品A(1050?C GaN插入層)表面原子形貌如圖3(a)所示,外延層表面生長臺階清晰可見,但局部區域臺階發生扭曲、聚并,形成扭曲的臺階束,外延層生長模式呈準臺階流生長模式,AFM表面粗糙度RMS大小約0.96 nm(掃描面積為10μm×10μm).樣品D(650?C GaN插入層)表面原子形貌如圖3(b)所示,其外延層表面比樣品A更平整,RMS大小下降到0.59 nm,但生長臺階變得彎曲、模糊,同時還有少量位錯坑形成,該情況下外延生長呈層狀生長模式.

圖2 (網刊彩色)插入層溫度對XRD(002)和(102)晶面半峰寬的影響Fig.2.(color online)XRD FWHM values of(a)(002)and(b)(102)for four GaN sample.

圖3 (網刊彩色)插入層生長溫度對同質外延層表面形貌影響的AFM圖像 (a)高溫插入層;(b)低溫插入層;圖像掃描面積為10μm×10μm,其中插圖為1μm×1μmFig.3.(color online)AFM images of GaN homoepitaxyfilms:(a)High temperature intermediate layer;(b)low temperature intermediate layer.Scan area 10μm×10μm,the inset 1μm×1μm.
氮化物半導體材料的外延生長模式通常由襯底表面自由能、界面能和外延層的表面自由能大小來決定,GaN同質外延中除了常見的層狀生長模式、島狀生長模式和層-島生長模式[20]三種生長模式外,還有兩種新的生長模式(臺階流生長模式和臺階聚并生長模式)更為常見.其中臺階流生長模式由于能產生結構完整和平滑的表面,從而受到廣泛關注.臺階流生長模式是當襯底表面由于晶向偏角而形成臺階列的情況下,生長沿著臺階層鋪滿整個臺面,最終各個臺面完成一層生長后表面臺階狀況沒有發生變化,整個過程就像各個臺階平行向前流動一樣.當臺階不是單層生長,而是一群臺階聚并形成更高臺階的情況時,就是臺階聚并生長模式,此臺階聚并會增大表面粗糙度,影響材料性能,因此生長中應當避免[21].
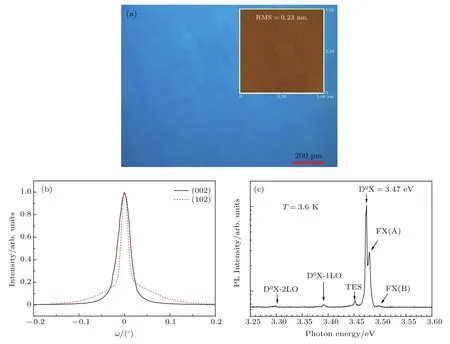
圖4 (網刊彩色)高質量的GaN同質外延膜,其中IM-GaN插入層生長溫度為850?C,厚度150 nm (a)光學顯微鏡圖像(插圖為5μm×5μmAFM的圖像);(b)XRD(002),(102)晶面雙晶搖擺曲線圖像;(c)低溫PL譜Fig.4.(color online)High quality GaN homoepitaxyfilms with 150 nm IM-GaN grown at 850?C:(a)DICM image;(b)XRD(002)and(102)rocking curves;(c)LT-PL spectra;the inset is the AFM image of 5μm×5μm scan area.
在MOCVD系統中進行GaN同質外延生長時,氣相中的活性反應粒子吸附到GaN襯底表面臺面上,通過原子的擴散遷移,最終抵達臺階邊緣,并在該處形成GaN并入晶格.原子擴散長度與公式exp[?EA/(2kBT)]成正比關系,其中EA是擴散勢壘,kB是玻爾茲曼常數,T是生長溫度[22].由于GaN襯底制備技術的不成熟,襯底翹曲將導致晶格發生扭曲,同時拋光過程中容易形成表面劃痕以及吸附雜質.當活性粒子在襯底表面遇到扭曲的晶格臺階和拋光劃痕時,其遷移運動將會受到表面擴散勢壘的阻礙,造成活性分子在該處聚集,形成更高的臺階束(如圖3(a)所示).隨著外延生長繼續,晶格扭曲和表面劃痕被進一步放大,導致表面粗糙度增大,最終形成圖2(a)中的丘壑和劃痕結構.晶核的典型距離和平均臺面寬度之比是區別層狀模式、臺階聚并模式和臺階流模式的關鍵參數,如果島間距離大于臺面寬度,生長就是臺階流.反之,如果島間距離小于臺面寬度,生長就是層-層模式[23].當襯底溫度由1050?C降低到650?C時,吸附原子在襯底表面上的擴散能力減弱,造成吸附原子在給定的時間內不能達到臺階邊緣,大量的吸附原子沉積在臺階臺面上形成核島,此情況下島間距離小于臺面寬度,于是生長轉變為層-層模式.在層狀生長模式下,襯底表面原有的臺階形貌將會被覆蓋,形成的表面平整,但原子臺階彎曲、交疊甚至模糊,晶格發生扭曲,位錯密度增加.正如圖3中的樣品D,通過IM-GaN層的生長,襯底表面原有的形貌(如原子臺階、劃痕、扭曲的晶格等)在層狀生長模式下發生改變,當插入層生長結束升溫至1050?C進行高溫生長時,由于GaN表面平直的臺階流形貌已經消失,故而只能重復IM-GaN層的表面形貌,GaN此時呈層狀生長模式,最終形成如圖3(b)的形貌.可見,IM-GaN插入層的引入對生長模式影響十分巨大,雖然可以有效地減少GaN表面的宏觀缺陷,但卻會引入新的位錯缺陷,降低外延層的晶體質量.
通過圖1和圖2的分析,發現IM-GaN層生長溫度為850?C時,外延層表面形貌既得到了部分改善,同時晶體質量并未發生大幅度的降低.為了獲得表面形貌和晶體質量兩者都好的GaN同質外延層,IM-GaN層生長溫度選擇為850?C,進一步優化該插入層厚度.實驗發現,當IM-GaN層厚度由50 nm增加到150 nm時,GaN同質外延膜表面的丘壑狀山丘、劃痕等宏觀缺陷進一步減少,最終完全消失,如圖4(a)所示.對該樣品進行AFM測試,樣品表面準直的原子臺階清晰可見,掃描面積5μm×5μm表面粗糙度RMS僅為0.23 nm(見4(a)插圖).XRD測試得到該GaN薄膜(002),(102)半峰寬分別為125 arcsec、85 arcsec(如圖4(b)所示),說明該外延材料具有較低的位錯密度.低溫(3.6 K)PL譜表明,材料具有較強的自由束縛激子FX(A)發光峰,且中性受主激子發光半峰寬大小僅為26 meV,說明該GaN外延層具有非常高的晶體質量.
4 結 論
本文研究了GaN插入層對GaN襯底同質外延層表面宏觀缺陷和晶體質量的影響,通過優化插入層生長溫度和厚度,獲得了高質量GaN同質外延材料,其XRD搖擺曲線(002)和(102)晶面FWHM分別為125 arcsec和85 arcsec,表面粗糙度RMS為0.23 nm.本文通過對比不同生長溫度插入層的GaN同質外延膜,發現隨著插入層生長溫度的降低,GaN同質外延膜表面宏觀缺陷逐漸減少,但位錯密度逐漸增大.同時,結合AFM測試對生長機制進行分析,發現低溫度插入層的生長導致外延膜生長模式由準臺階流模式轉變為層狀模式,通過插入層溫度和厚度的優化,進一步調控外延層的生長模式,最終有效降低了外延層表面的宏觀缺陷,獲得了表面原子級光滑平整、位錯密度極低的GaN同質外延膜.
[1]Palacios T,Chakraborty A,Rajan S,Rajan S,Poblenz C,Keller S,DenBaars S P,Speck J S,Mishra U K 2005 IEEE Elec.Dev.Lett.26 781
[2]Webb J B,Tang H,Rolfe S,Bardwell J A 1999 Appl.Phys.Lett.75 953
[3]Limb J B,Xing H,Moran B,McCarthy L,DenBaars S P,Mishra U K 2000 Appl.Phys.Lett.76 2457
[4]Qin P,Song W D,Hu W X,Zhang Y W,Zhang C Z,Wang R P,Zhao L L,Xia C,Yuan S Y,Yin Y A,Li S T,Su S C 2016 Chin.Phys.B 25 088505
[5]LiuY L,Jin P,Liu G,Wang WY,Qi Z Q,Chen C Q,Wang Z G 2016 Chin.Phys.B 25 087801
[6]Kikkawa T 2005 Jpn.J.Appl.Phys.44 4896
[7]Zhang J Q,Wang L,Li L A,Wang Q P,Jiang Y,Zhu H C,Ao J P 2016 Chin.Phys.B 25
[8]Duan X L,Zhang J C,Xiao M,Zhao Y,Ning J,Hao Y 2016 Chin.Phys.B 25 087304
[9]Killat N,Montes M,Paskova T,Evans K R,Leach J,Li X,?zgür ü,Morko? H,Chabak K D,Crespo A,Gillespie J K,Fitch R,Kossler M,Walker D E,Trejo M,Via G D,Blevins J D,Kuball M 2013 Appl.Phys.Lett.103 193507
[10]Oehlern F,Zhu T,Kappers M J,Kappers M J,Humphreys C J,Oliver R A 2013 J.Cryst.Growth 383 12
[11]Zhou K,Liu J,Zhang S M,Li Z C,Feng M X,Li D Y,Zhang L Q,Wang F,Zhu J J,Yang H 2013 J.Cryst.Growth 371 7
[12]Kizilyalli I C,Buiquang P,Disney D,Bhatia H,Aktas O 2015 Microelectron.Reliab.55 1654
[13]Kubo S,Nanba Y,Okazaki T,Manabe S,Kurai S,Taguchi T 2002 J.Cryst.Growth 236 66
[14]Leszczynskia M,Beaumont B,Frayssinet E,Knap W,Prystawko P,Suski T,Grzegory T,Porowski S 1999 Appl.Phys.Lett.75 1276
[15]Okada S,Miyake H,Hiramatsu K,Miyagawa R,Eryu O,Hashizume T 2016 Jpn.J.Appl.Phys.55 01AC08
[16]Cho Y,Ha J S,Jung M,Lee H J,Park S,Park J,Fujii K,Toba R,Yi S,Kil G S,Chang J,Yao T 2010 J.Cryst.Growth 312 1693
[17]Tian W,Yan W Y,Dai J N,Li S L,Tian Y,Hui X,Zhang J B,Fang Y Y,Wu Z H,Chen C Q 2013 J.Phys.D:Appl.Phys.46 065303
[18]Heying B,Wu X H,Keller S,Li Y,Kapolnek D,Keller B P,DenBaars S P,Speck J S 1996 Appl.Phys.Lett.68 643
[19]Heinke H,Kirchner V,Einfeldt S,Hommel D 2000 Appl.Phys.Lett.77 2145
[20]Scheel H J 2001 J.Cryst.Growth 211 1
[21]Tanabe S,Watanabe N,Uchida N,Matsuzaki H 2016 Phys.Status Solidi A 213 1236
[22]Corrion A L,Wu F,Speck J S 2012 J.Appl.Phys.112 054903
[23]Perret E,Highland M J,Stephenson G B,Streiffer S K,Zapol P,Fuoss P H,Munkholm A,Thompson C 2014 Appl.Phys.Lett.105 051602
PACS∶61.05.cp,61.72.—y,68.55.J—,78.55.CrDOI∶10.7498/aps.66.106101
*Project supported by the National Natural Science Foundation of China(Grant Nos.61505181,61474101,61504125),the National High Technology Research and Development Program of China(Grant Nos.2015AA016800,2015AA033300)and the National Key Research and Development Program of China(Grant No.2016YFB0400902).
?Corresponding author.E-mail:luowk688@163.com
Surface morphology improvement of homoepitaxial GaN grown on free-standing GaN substrate by metalorganic chemical vapor deposition?
Li Zhong-HuiLuo Wei-Ke?Yang Qian-Kun Li Liang Zhou Jian-Jun Dong Xun Peng Da-Qing Zhang Dong-Guo Pan LeiLi Chuan-Hao
(Science and Technology on Monolithic Integrated Circuits and Modules Laboratory,Nanjing Electronic Devices Institute,Nanjing 210016,China)
10 December 2016;revised manuscript
9 March 2017)
Free-standing GaN is generally regarded as an ideal substrate for GaN-based devices due to its advantage of low threading dislocation density(TDD)and good thermal conductivity.However,new surface features such as hillocks and ridges appear on the GaN homoepitaxyfilms.In this paper,the influences of the intermediate GaN(IM-GaN)layer on the surface defects and crystal quality of GaN homoepitaxyfilms grown on c-plane GaN substrates by metalorganic chemical vapor deposition are investigated.It is found that hexagonal hillocks and ridges on the surface can be avoided by inserting an IM-GaN layer grown at an intermediate temperature(650–850?C),prior to the growth of GaN at 1050?C.The results based on X-ray diffraction(XRD)measurements and differential interference contrast microscopy images demonstrate that the growth temperature of the IM-GaN layer has a significant influence on GaN homoepitaxy layer,which is one of the most critical parameters determining the surface morphology and crystal quality.As the IM-GaN growth temperature decreases from 1050?C to 650?C,thed densities of hillocks and ridges on the surface reduce gradually.While,the XRD full width at half maximum(FWHM)values of(002)and(102)peaks for the homoepitaxy films are increased rapidly,indicating the adding of the TDD in the films.The atomic force microscopy(AFM)images show that the quasi-step growth mode change into layer-layer growth mode with the growth temperature decreasing from 1050?C to 650?C during the IM-GaN layer growing.It is speculated that the growth mode is determined by the diffusion length of adatom on the growing surface,which is proportional to the growth temperature.In the case of IM-GaN grown at low temperature,the formation of hillocks can be suppressed by reducing the adatom diffusion length.Finally,High crystal quality GaN homoepitaxyfilms(2μm)without hillocks is achieved by optimizing the growth parameters of IM-GaN layer,which is about 150 nm in thickness and grown at 850?C.The crystal quality of GaN homoepitaxyfilm is assessed by XRD rocking curve measured with double-crystaloptics.The FWHMs of the(002)and(102)peaks are 125arcsec and 85arcsec respectively,indicating that rather low TDD is formed in thefilm.And well defined steps are observed on the image of AFM test,the root-mean square roughness value of the which is only about 0.23 nm for 5μm×5μm scan area.
∶metalorganic chemical vapor deposition,homoepitaxy GaN,intermediate layer,growth mode
?國家自然科學基金(批準號:61505181,61474101,61504125)、國家高技術研究發展計劃(批準號:2015AA016800,2015AA033300)和國家重點研發計劃(批準號:2016YFB0400902)資助的課題.
?通信作者.E-mail:luowk688@163.com
?2017中國物理學會Chinese Physical Society

