氧空位缺陷對PbTiO3鐵電薄膜漏電流的調控?
佘彥超 張蔚曦 王應 羅開武 江小蔚
1)(銅仁學院物理與電子工程系,銅仁 554300)
2)(湘潭大學物理與光電工程學院,湘潭 411105)
1 引 言
基于鐵電材料的鐵電存儲器具有讀寫速度快、抗疲勞性能好及能耗低等優點,被認為是新型信息存儲器備選之一[1,2].相比于塊體材料,鐵電薄膜性能更優良、更易向實用化方向發展,因此引起了物理、化學、材料等學科的關注[3?8].研究表明:能被薄膜極化、疇壁、晶格缺陷等調控的漏電流極大地影響著薄膜的電學性質[9?16].傳統認為增加薄膜厚度或者加入新的薄膜層如氧化鎂層等將大幅降低漏電流,但這又不利于器件的小型化(特別是納米級器件制備).研究發現,實驗條件對薄膜結構特征調控最顯著的就是以氧空位缺陷為代表的薄膜晶格缺陷.而在鐵電薄膜中氧空位缺陷將直接影響鐵電材料的局域極化強度和方向,進而改善漏電流.Jia和Urban[13]利用透射電子顯微鏡觀察到鈦酸鋇(BaTiO3)薄膜中存在32%的氧空位缺陷.通過摻雜改變薄膜晶粒大小和形貌來有效地抑制氧空位,進而提高漏電流特性,為不顯著增大薄膜厚度而改善漏電流性能提供了思路.基于此,本文重點探究雜質元素和氧缺陷空位對漏電流的耦合調控,即研究Cu,Fe,Al和V四種金屬陽離子摻雜對PbTiO3(PTO)鐵電薄膜中因氧空位缺陷引起的漏電流性質的影響.
2 計算方法與模型
本文采用基于密度泛函理論的VASP軟件包來實現Pt/PTO/Pt界面結構優化.計算中,采用投影綴加波法描述離子和電子之間的相互作用,而交換關聯函數采用廣義梯度近似下的Perdew-Burke-Ernzerhof(GGA-PBE)泛函[17,18]. 圖1為弛豫后的PTO鐵電薄膜結構模型.平面波截斷動能為450 eV.采用6×6×1 Monkhorst-PackK點網格[19,20].結構優化的收斂標準為所有原子間Hellmann-Feynman力均小于為防止層與層間的相互作用,PTO超包為即ab平面內是的超包;而在c方向上,采用15真空層.模擬計算前,先對界面進行了優化,以避免界面造成計算結果的不正確.本文主要采用基于密度泛函理論結合非平衡格林函數的Atomistix Toolkit(ATK 2008.10)[21]軟件來模擬其漏電流特性.基組采用的是雙ζ極化,交換關聯泛函同樣采用GGA-PBE泛函[18],截斷能量取150 Ry.對簡約布里淵區采用8×8×100的K點取樣.

圖1 Pt/PTO/Pt的結構示意圖(中間區域中黑色球、灰色球和紅色球分別表示Pb,Ti和O原子)(a)VASP弛豫的模型;(b)ATK中的計算模型Fig.1.Structure diagram of Pt/PTO/Pt.The black balls,gray balls and red balls respectively denote lead atoms,titanium atoms and oxygen atoms in the middle region:(a)VASP relaxation model;(b)the calculation model in ATK.
3 結果與討論
3.1 氧空位缺陷對漏電流的影響
氧空位缺陷在鐵電薄膜中的分布情況顯然對漏電流會有影響,所以首先探討氧空位缺陷的分布規律.如圖1(a)所示,沿PTO鐵電薄膜生長方向分別選取了用VO1—VO9表示的9種不同位置的氧空位缺陷.圖1(a)亦給出了VO4的原子結構模型.定義各種位置氧空位缺陷的形成能為

其中,E(defect)和E(perfect)分別表示含氧空位缺陷和完美PTO薄膜的總能,EO2為氧氣分子的總能.圖2給出了不同位置氧空位缺陷與其形成能之間的關系.一般而言,形成能越低的體系將越穩定[22,23].可以看出,氧空位缺陷在薄膜中間位置的形成能較高,隨著氧空位缺陷向界面處靠近其形成能逐漸降低.這表明氧空位缺陷比較容易向鐵電薄膜界面處擴散.這一結論與Scott等[24]在實驗上報道的結果完全一致.
根據上述結果,本文進一步研究了不同位置的氧空位缺陷對漏電流的影響,其模型如圖1(b)所示.根據結構的對稱性,本文僅給出了氧空位缺陷處在VO1—VO4時薄膜漏電流變化,如圖3所示.結果表明,由于氧空位缺陷的引入,PTO鐵電薄膜的漏電流大幅增加.而氧空位缺陷分布在薄膜中間位置時,漏電流增加的幅度最小.這主要是由于氧空位缺陷作為施主中心,提供了大量的載流子.而中間位置的氧空位缺陷形成能較高,難以穩定存在于中間區域.

圖2 氧空位缺陷位置與形成能的關系(1和9分別代表離界面最近的氧空位缺陷位置)Fig.2.Formation energy of oxygen vacancy defects in different positions.The labels of 1 and 9 respectively denote the nearest positions of oxygen vacancy defects to the interface.
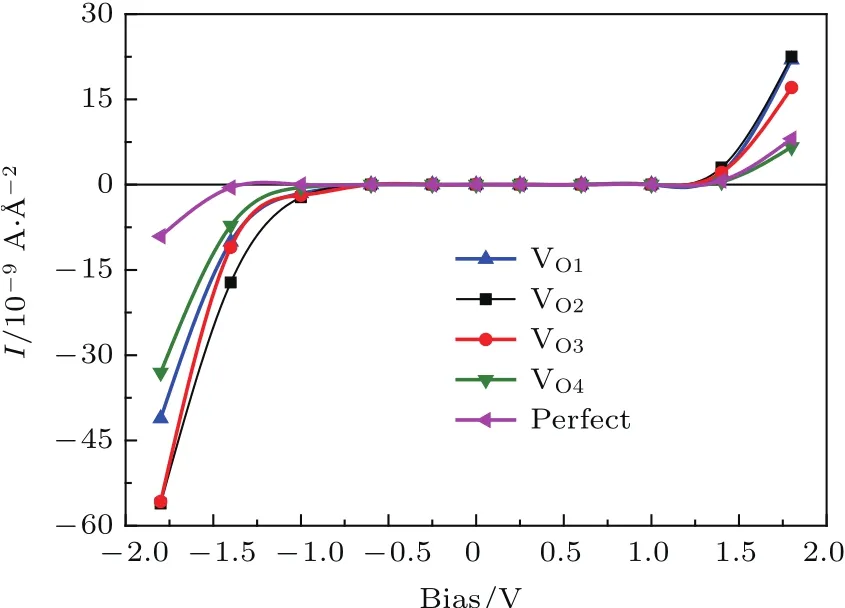
圖3 不同位置VO的I-V曲線(藍色、黑色、紅色和綠色曲線分別表示氧空位從界面到薄膜中間的I-V曲線,粉紅色曲線表示無氧空位缺陷的I-V曲線)Fig.3.The I-V curves of VOin different positions.Blue,black,red and green curves respectively denote the I-V curves of oxygen vacancy defects from interface to the middle of the thin film.The pink curve denotes the I-V curve of no oxygen vacancy.
3.2 陽離子摻雜對氧缺陷引起的漏電流的抑制
3.1節討論了氧空位缺陷引入了電子載流子從而導致漏電流的增大.而鐵電薄膜中摻雜陽離子同樣可能改變體系載流子濃度,進而影響漏電流大小.接下來本文探討以Cu,Fe,Al和V等四種陽離子摻雜調控因氧空位缺陷引起的鐵電薄膜漏電流的大小.首先有必要說明的是Fe,Al,V和Cu四種陽離子與Ti相比較,其價態、原子半徑大小相近,因此它們對Ti的替換是更可能的選擇[14,25].本文也分別計算了上述陽離子替換中間位置的Ti和陽離子嵌入氧空位系統的總能量,發現陽離子替換中間位置Ti的能量比嵌入氧空位的能量低0.64—1.39 eV.所以本文中主要討論Fe,Al,V和Cu對Ti的替位作用.如圖4所示,可以發現由于陽離子摻雜增加了薄膜內載流子濃度,進而使得鐵電薄膜的漏電流大幅增加.

圖4 單純陽離子摻雜對漏電流的影響(黑色、紅色、藍色和綠色曲線分別表示V,Fe,Cu和Al摻雜到薄膜正中間的I-V曲線,粉紅色曲線表示無陽離子摻雜的薄膜的I-V曲線)Fig.4.In fluence of only cation doping on leakage current.Black,red,blue and green curves respectively denote the I-V curves of adding V,Fe,Cu and Al to the middle of the thin film.The pink curve denotes the I-V curve of thin film of no cation doping.
隨后根據(1)式,計算相應的形成能,來探究陽離子摻雜對氧空位缺陷分布的影響.如圖5所示,考慮摻入Cu,Fe,Al和V四種陽離子分別替代中間區域的Ti原子的情況下氧空位缺陷在不同位置的形成能以避免界面效應的影響.以圖中橢圓虛線圈出部分為例,可以看出,與純凈的PTO鐵電薄膜的氧空位缺陷形成能相對比,氧空位出現在摻雜附近時,其形成能出現了明顯的變化.Fe摻雜時,氧空位在其附近的形成能升高;Al摻雜時,氧空位的能量沒有明顯變化;而Cu和V摻雜時,氧空位的能量在雜質附近的能量明顯變小.從能量上來看,Fe摻雜對氧空位有排斥作用,而Cu和V對氧空位有吸引作用,即意味著+2價的Cu離子和V離子摻雜替換掉+3價的Ti離子后形成陽離子空位,從而和氧空位缺陷導致的陰離子空位產生庫侖吸引作用,即Cu和V能夠俘獲在其附近的氧空位.

圖5 不同位置的氧空位缺陷在Cu,Fe,Al和V陽離子摻雜下的形成能,直線位置即為薄膜正中間位置Fig.5.Formation energies of different oxygen vacancy defects with different cation doping.
前面的研究表明,在Cu和V離子摻雜的情況下,氧空位不會從中間區域擴散到鐵電薄膜的界面處,而Fe和Al離子摻雜時,氧空位依然會從中間區域擴散到鐵電薄膜的界面處.這是由于氧空位在鐵電體中會形成施主中心,Cu和V是P型摻雜,對氧空位有吸引作用,正好中和了施主電子,同時俘獲遷移的氧空位,形成釘扎效應,從而避免遷移到界面處.Fe和Al是N型摻雜,對氧空位有排斥作用,所以依然會從中間區域擴散到鐵電薄膜的界面處.

圖6 摻雜對含氧空位缺陷的薄膜漏電流的影響(綠色曲線表示無摻雜含氧缺陷薄膜的I-V曲線;黑色、紅色、藍色和粉紅色分別表示摻雜V,Fe,Al和Cu含氧空位缺陷薄膜的I-V曲線)Fig.6.In fluence of doping on the leakage current of PTO thin film.The green curve denotes the I-V curve of oxygen vacancy defect thin film with no doping.The black,red,blue and pink curves respectively denote the I-V curves of oxygen vacancy defect thin films with V,Fe,Al and Cu doping.
接下來主要討論氧空位缺陷在摻入的Cu,Fe,Al和V四種陽離子附近(圖5中藍色橢圓框內的位置)鐵電薄膜的漏電流特性,如圖6所示.與純凈的PTO鐵電薄膜中的氧空位缺陷導致的漏電流相比,可以發現Fe,Al摻雜時,鐵電薄膜的漏電流明顯增大.這主要是由于Fe,Al摻雜是N型摻雜,主要依賴電子導電,Fe,Al摻雜增加了體系的電子濃度,從而增加了其漏電流.與之相對Cu和V摻雜時,薄膜的漏電流相對于無陽離子摻雜時大幅降低.這主要是由于Cu,V在體系中是P型摻雜,表現為空穴載流子.這將復合由氧空位缺陷所導致的電子載流子,使體系中的載流子濃度大幅降低,進而有效地降低了體系的漏電流.
進一步計算了沒有氧空位和摻雜的PTO薄膜,6號位置有氧空位但無摻雜的PTO薄膜,以及V,Fe,Al和Cu四種陽離子替換鐵電薄膜中間位置的Ti、氧空位在6號位置等體系的能帶結構(如圖7所示).通過分析能帶結構,發現沒有任何摻雜和氧空位時鐵電薄膜是絕緣的(如圖7(a)所示);當6號位置有一個氧空位時,體系變成電子摻雜的半導體,相對于完美體系的漏電流增大(如圖7(b)所示);從圖7(c)和圖7(d)可以看出,當Cu和V替換Ti時薄膜是P型摻雜,且由于Cu摻雜體系的空穴載流子比V摻雜體系空穴載流子少,主要增加了空穴載流子,將復合氧空位缺陷所導致的電子載流子,從而使得體系的載流子濃度大幅降低,進而降低了體系的漏電流.而對于Fe和Al替換Ti時,薄膜為N型摻雜,如圖7(e)和圖7(f)所示,Al摻雜體系的電子載流子比Fe摻雜體系的電子載流子多,原本鐵電薄膜氧空位依賴電子導電,Fe和Al摻雜增加了體系的電子濃度,進而增加了其漏電流.

圖7 (a)完美的鐵電薄膜的能帶結構;(b)6號位置有一個氧空位時的薄膜能帶結構;(c)—(f)分別是Cu,V,Fe和Al替換PTO鐵電薄膜中間位置的Ti和氧空位在6號位置的能帶結構Fig.7.(a)Band structure of the prefect PTO ferroelectric thin film;(b)band structure of the thin film with an oxygen vacancy in six location;(c)–(f)band structure of PTO thin films with Ti replaced by Cu,V,Fe and Al and oxygen vacancy in six location.
4 結 論
本文采用基于密度泛函理論結合非平衡格林函數的第一性原理方法,系統研究了PTO鐵電薄膜中由于氧空位缺陷與陽離子摻雜引起的漏電流特性.結果表明:無陽離子摻雜時氧空位缺陷難以在薄膜中間區域集中,且越靠近薄膜中間區域,氧空位缺陷對漏電流的影響越小.陽離子摻雜將增加薄膜內載流子濃度,使得鐵電薄膜的漏電流增加.在探究摻雜陽離子與氧空位缺陷對鐵電薄膜漏電流的耦合影響時發現,在固定摻雜陽離子的位置情況下,Fe和Al摻雜進一步增加氧空位缺陷在鐵電薄膜的電子載流子,從而薄膜內漏電流顯著提高;而Cu和V摻雜對氧空位缺陷有明顯的釘扎作用,并且能有效復合由氧空位缺陷所導致的電子載流子,從而有效抑制氧空位缺陷引起的漏電流;由于V的離子半徑相對于Cu更接近于Ti的離子半徑,因此V更容易實現摻雜來抑制氧空位缺陷引起的漏電流.這一結論對鐵電薄膜器件的設計及其應用有著重大的意義.

