絕緣體上硅金屬氧化物半導體場效應晶體管中輻射導致的寄生效應研究?
彭超 恩云飛 李斌 雷志鋒 張戰剛 何玉娟 黃云
1)(工業和信息化部電子第五研究所,電子元器件可靠性物理及其應用技術重點實驗室,廣州 510610)2)(華南理工大學電子與信息學院,廣州 510006)(2018年7月16日收到;2018年8月20日收到修改稿)
基于60Co γ射線源研究了總劑量輻射對絕緣體上硅(silicon on insulator,SOI)金屬氧化物半導體場效應晶體管器件的影響.通過對比不同尺寸器件的輻射響應,分析了導致輻照后器件性能退化的不同機制.實驗表明:器件的性能退化來源于輻射增強的寄生效應;淺溝槽隔離(shallow trench isolation,STI)寄生晶體管的開啟導致了關態漏電流隨總劑量呈指數增加,直到達到飽和;STI氧化層的陷阱電荷共享導致了窄溝道器件的閾值電壓漂移,而短溝道器件的閾值電壓漂移則來自于背柵閾值耦合;在同一工藝下,尺寸較小的器件對總劑量效應更敏感.探討了背柵和體區加負偏壓對總劑量效應的影響,SOI器件背柵或體區的負偏壓可以在一定程度上抑制輻射增強的寄生效應,從而改善輻照后器件的電學特性.
1 引 言
隨著絕緣體上硅(silicon on insulator,SOI)技術廣泛地應用在航天領域,其輻射效應受到了廣泛的關注[1?4].當電子元器件長期工作在輻射環境下時,伴隨著輻射劑量不斷累積將產生總劑量效應,表現為器件介質層中形成大量的陷阱電荷,最終導致器件性能的永久退化[5,6].由于SOI器件全介質隔離的結構,使得其對總劑量效應尤其敏感.
SOI金屬氧化物半導體場效應晶體管(metaloxide-semiconductor filed-effect transistor,MOSFET)器件中主要的介質層包括柵氧、淺溝槽隔離(shallow trench isolation,STI)和絕緣氧化埋(buried oxide,BOX)層.研究表明輻射感應的氧化層陷阱電荷正比于氧化層厚度[7].在深亞微米工藝下,器件的柵氧變得非常薄(小于10 nm),總劑量輻照在柵氧層中產生的影響有限,甚至可以忽略不計.但是STI和BOX氧化層通常都很厚,對總劑量效應非常敏感[8].國內外開展了大量STI和BOX層陷阱電荷對器件性能影響的研究,但大部分工作都是針對體硅器件單獨研究STI氧化層對總劑量效應的貢獻[9?13],或者針對無邊緣的SOI器件單獨研究BOX層對總劑量效應的貢獻[14?17],而且以輻照后器件電學性能退化的定性分析為主.實際上SOI器件的總劑量效應來自于STI和BOX層中陷阱電荷共同作用的結果,輻照后器件性能退化可能來自于兩者的共同貢獻,也可能僅僅來自于其中之一,對其加以區分將有助于開展針對性的加固措施.
SOI MOSFET器件中包含STI邊緣寄生晶體管和背柵寄生晶體管.盡管半導體器件工藝會盡量削弱這些寄生效應[18],但輻射感應的陷阱電荷卻會導致這些寄生效應的增強,從而對主晶體管的電學性能產生影響.本文重點研究了輻射對SOI器件中寄生效應的影響.針對不同尺寸SOI器件中觀察到的不同性能退化現象,結合物理模型和TCAD器件仿真給出了詳細的定性和定量分析,確定了導致SOI器件性能退化的機制;分別研究了背柵和體區加負偏壓對器件總劑量效應的影響.
2 實驗描述
實驗樣品采用130 nm部分耗盡SOI工藝制造,器件頂層硅厚度為80 nm,BOX層厚度為145 nm.因為在同一工藝下輸入/輸出器件比核心器件對總劑量效應更敏感,其性能退化更加明顯,因此本文實驗所用器件均為輸入/輸出N型金屬氧化物半導體(n-channel metal-oxide-semiconductor,NMOS)器件,寬長比為10μm/10μm,10μm/0.35μm,0.15μm/10μm,0.15μm/0.35μm.其柵氧厚度約為7 nm,工作電壓為3.3 V.場氧隔離采用高密度等離子體氧化物填充的STI.STI的底部與BOX層直接相連,構成全介質隔離結構.器件采用T型柵結構來實現體區引出.器件沿溝道長度和寬度方向的截面圖如圖1所示.該器件的源漏區貫穿整個頂層硅,與BOX層相連.由圖1(b)可看到,除了前柵主晶體管MFG外,該器件結構還包含一個背柵寄生晶體管MBG和一個STI寄生晶體管MSTI.寄生晶體管MBG和MSTI分別以BOX層和STI氧化層為柵氧,與主晶體管有相同的溝道長度.
輻照實驗采用60Co γ射線作為輻照源.劑量率為100 rad(Si)/s.輻照實驗所有測試樣品采用雙列直插陶瓷封裝.輻照過程中器件處于ON偏置狀態,即柵端加3.3 V正偏壓,漏端、源端、體接觸端和背柵接地.輻照前后利用Keithley 4200半導體參數分析儀測試器件的轉移特性曲線.所有測試在30 min內完成以避免輻照退火效應的影響;整個輻照和測試過程均在室溫下進行.本文中所有的閾值電壓均根據峰值跨導法提取,即器件閾值電壓為

其中Vg和Id為跨導最大值對應的柵端電壓和漏端電流,Vd為器件工作在線性區的漏端電壓.

圖1 SOI MOSFET器件結構 (a)沿溝道長度截面圖;(b)沿溝道寬度截面圖Fig.1.Device structure of SOI MOSFET:(a)Cross-section along channel length;(b)cross-section along channel width.
3 實驗結果與討論
3.1 輻射增強的寄生效應
圖2顯示了四種不同寬長比的SOI NMOS器件經ON偏置輻照后,前柵的轉移特性和跨導特性隨輻照劑量的變化.在轉移特性測試過程中,器件背柵和體接觸接地.經30 krad(Si)輻照后,器件關態漏電流(對應Vfg=0 V時的Ids)顯著增加,特別是對于寬長比為10μm/0.35μm的器件.但此時的泄漏電流受到前柵電壓的調制,表現為轉移特性曲線的亞閾值區出現“駝峰”現象[19].在30 krad(Si)以上,泄漏電流隨著總劑量的增加而繼續增加,而且亞閾值區的“駝峰”現象逐漸消失,表現為泄漏電流幾乎不受前柵電壓的控制.圖3顯示了輻照后器件關態漏電流隨總劑量的變化.在80 krad(Si)以下(對于10μm/0.35μm的器件為50 krad(Si)),關態漏電流近似隨總劑量呈指數增加.而在80 krad(Si)以上,關態漏電流隨總劑量緩慢增加,近似趨于飽和.當總劑量達到100 krad(Si)時,10μm/0.35μm,0.15μm/0.35μm,0.15μm/10μm和10μm/10μm四種不同尺寸器件的關態漏電流相比于輻照前分別增加了5.1×106,6.4×106,4.0×105和1.4×106倍.

圖2 不同寬長比(W/L)SOI器件輻照前后的轉移特性和跨導曲線 (a)W/L=10μm/0.35μm;(b)W/L=0.15μm/0.35μm;(c)W/L=0.15μm/10μm;(d)W/L=10μm/10μmFig.2.Transfer characteristics and transconductances of SOI n-MOSFETs with different width-length-ratio(W/L)before and after irradiation:(a)W/L=10μm/0.35μm;(b)W/L=0.15μm/0.35μm;(c)W/L=0.15μm/10μm;(d)W/L=10μm/10μm.

圖3 歸一化的關態漏電流隨總劑量的變化,其中歸一化的關態漏電流定義為輻照前后的關態漏電流之比Fig.3.Normalization o ff-state leakage current as a function of total dose. The normalization o ff-state leakage is defined as Idsat Vfg=0 after irradiation divided by the value before irradiation.
輻照后關態漏電流的增加與寄生晶體管的開啟有關.如圖1所示,一個SOI MOSFET可視為主晶體管MFG,STI寄生晶體管MSTI和背柵寄生晶體管MBG的并聯.輻照在STI氧化層或BOX層中產生的正陷阱電荷會降低寄生晶體管的閾值電壓,使得在Vfg=0 V時本來應該處于關斷狀態的寄生晶體管無法關斷,從而產生較大的關態漏電流.由于本實驗中觀察到的關態漏電流明顯受前柵電壓控制,輻照后關態漏電流的增加更可能來自于MSTI的開啟[19].這是因為器件多晶硅柵會覆蓋溝道附近的STI氧化層區域,前柵電壓的電場會延伸到STI氧化層,從而對STI寄生晶體管產生調制作用,但其對背柵寄生晶體管的影響可以忽略不計.當總劑量較小時,寄生晶體管MSTI的閾值電壓漂移也較小,在Vfg=0 V時寄生晶體管還未完全開啟,工作在亞閾值區.則此時器件關態漏電流可表示為[20]

當總劑量達到80 krad(Si)以上時,寄生晶體管MSTI完全開啟,此時關態漏電流可表示為

其中VT,STI為STI寄生晶體管的閾值電壓.可以看到,當總劑量較小、寄生晶體管未完全開啟時,VT,STI隨總劑量的增加而減小,關態漏電流表現為指數增加.當總劑量較大、寄生晶體管完全開啟時,VT,STI隨總劑量的增加而減小,關態漏電流表現為線性增加并趨于飽和.這與實驗觀察到的結果完全一致.
由圖2的跨導曲線可以看到,10μm/0.35μm,0.15μm/0.35μm和0.15μm/10μm三種尺寸的器件出現了明顯的閾值電壓漂移.100 krad(Si)時,三種器件的閾值電壓漂移分別為?41.1,?170.5和?83.8 mV.閾值電壓的減小同時導致了跨導峰值的增加.值得注意的是,10μm/10μm的器件在輻照后沒有出現類似的跨導變化,閾值電壓的漂移幾乎可以忽略.輻照導致的柵氧正陷阱電荷積累會導致器件的閾值電壓負向漂移.10μm/10μm的器件輻照后沒有出現跨導和閾值退化,證明柵氧中的輻射感應陷阱電荷可以忽略不計.由于四種器件具有相同的柵氧厚度,這也說明其他三種器件中觀察到的閾值電壓漂移不是來源于柵氧的輻射感應陷阱電荷.
在0.15μm/0.35μm和0.15μm/10μm兩種窄溝道器件中觀察到了最明顯的閾值電壓漂移.該閾值漂移可能來源于STI氧化層陷阱電荷導致的耗盡區電荷共享,如圖4(a)所示.對于一個SOI器件,其導通時由前柵電壓控制的耗盡區寬度為Xdm.輻照后,STI氧化層中的正陷阱電荷也會導致附近的有源區耗盡,該耗盡區寬度記為XSTI.在器件溝道寬度方向靠近STI的區域,兩個耗盡區之間存在電荷共享,這意味著前柵耗盡區并不完全由前柵電壓控制,有一部分受STI氧化層中的輻射感應陷阱電荷控制.假設無STI電荷共享時的柵控耗盡區為矩形區域,面積為(W×Xdm),耗盡區電荷量為Qb;共享耗盡區面積記為S0,考慮電荷共享時的有效柵控耗盡區面積則為(W×Xdm?S0),有效柵控耗盡區電荷量為Q′b.則有

輻照后,因電荷共享導致的閾值電壓漂移可表示為

其中,W為器件溝道寬度;εSi為硅的介電常數;NA為器件體區摻雜濃度;?F為費米電勢.XSTI會隨著總劑量的增加而增加,因此輻射導致的閾值電壓漂移也會隨總劑量的增加而增加.當STI寄生晶體管完全開啟時,XSTI達到最大值,可由下式計算:


圖4 (a)STI氧化層陷阱電荷導致的耗盡區電荷共享;(b)BOX層陷阱電荷導致的背柵耦合Fig.4.(a)Depletion region charge sharing induced by STI trapped-charge;(b)back gate coupling induced by BOX trapped-charge.
實驗器件的體區摻雜濃度NA近似為3×1017cm?3.根據(5)和(6)式,可計算溝道寬度W=0.15μm的器件中因STI電荷共享導致的最大閾值電壓為?125.4 mV;對于溝道寬度W=10μm的器件則為1.9 mV,可以忽略不計.這與實驗觀察到的結果一致.0.15μm/10μm器件觀察到的閾值漂移小于?125.4 mV,是因為其STI寄生晶體管還沒有完全開啟.0.15μm/0.35μm器件觀察到的閾值漂移大于?125.4 mV,是因為除了STI電荷共享外還有其他機制導致閾值電壓漂移,將在下文討論.
輻照后BOX層中的正陷阱電荷也會導致其附近的體區耗盡,形成背柵耗盡區Xbg,如圖4(b)所示.在器件閾值附近,如果背柵耗盡區Xbg與前柵耗盡區Xdm重疊,則部分耗盡器件變為全耗盡器件,即

此時,BOX層中的正陷阱電荷會耦合到前柵,導致器件閾值電壓負向漂移.對于本實驗所選用的體區摻雜濃度為3×1017cm?3器件,前柵和背柵的最大耗盡區寬度約為62.2 nm.兩者之和大于器件頂層硅厚度tSi(80 nm),理論上滿足發生背柵耦合的條件.Xbg會隨著BOX層中輻射感應陷阱電荷密度的增加而增加,直到達到最大耗盡區寬度.只有當Xbg增加到滿足(7)式時,背柵耦合才會發生,即觀察到閾值電壓漂移.
圖5(a)和圖5(b)顯示了ON偏置下不同柵長的SOI器件中輻射感生電荷密度在整個BOX層中的分布.該結果由Sentaurus TCAD仿真得到[21].圖中黃色區域代表輻射感生電荷較多的區域.可以看到,輻射感生電荷主要集中在BOX層與硅的界面附近.其中溝道區以下BOX層與體區界面附近的陷阱電荷對器件總劑量效應的影響最大.相比于長溝道器件(柵長為1μm),柵長為0.35μm的短溝道器件中,BOX層輻射感應電荷更加集中在此區域.圖5(c)顯示了BOX層與體區界面以下10 nm處,BOX層中的輻射感生電荷產生率沿溝道長度方向的分布.對應短溝道和長溝道器件,溝道中心位置以下的BOX層中輻射感生電荷產生率分別為1.0×1014cm?3·s?1和4.0×1013cm?3·s?1. 在相同的總劑量下,短溝道器件BOX層中更多的陷阱電荷形成,導致了短溝道器件更易發生背柵耦合.這可以解釋為何溝道長度為0.35μm的器件中觀察到了背柵耦合導致的閾值電壓漂移,而溝道長度為10μm的器件沒有觀察到.

圖5 BOX層中輻射感應電荷密度分布 (a)柵長L為0.35μm的器件;(b)柵長L為1μm的器件;(c)不同柵長器件中對應于切割線位置處的輻射感應電荷密度對比,其中橫坐標為歸一化距離,0和1分別對應于靠近源和漏的位置Fig.5.Radiation-induced charge distribution in BOX:(a)Device with gate length of 0.35μm;(b)device with gate length of 1μm;(c)radiation-induced charge density at the cutting line for devices with different gate lengths.The x-axis is normalization distance,where 0 and 1 correspond to the positions near source and drain,respectively.
可以得到結論,10μm/0.35μm器件輻照后的閾值電壓漂移主要來源于背柵耦合;0.15μm/10μm器件的閾值漂移來源于STI的電荷共享;而0.15μm/0.35μm器件受到兩種效應的共同作用,因此出現了最嚴重的閾值電壓退化.同樣工藝下,小尺寸器件對總劑量效應更敏感.
3.2 背柵負偏壓對寄生效應的影響
氧化層中輻射感應的正陷阱電荷導致了器件性能的退化,因此可以考慮在背柵施加負偏壓來抵消正陷阱電荷的影響,從而削弱寄生效應的影響.圖6(a)為經100 krad(Si)輻照后,10μm/0.35μm的SOI器件在不同背柵偏壓下的前柵轉移特性曲線.在轉移特性測試過程中,器件體接觸接地.輻照后,背柵負偏壓能有效抑制輻照誘發的器件泄漏電流.在?10 V的背柵負偏壓下,器件關態漏電相比于未加負偏壓的器件下降了四個數量級.
圖6(b)顯示了該器件輻照前后的背柵轉移特性曲線.在測試過程中,器件前柵和體接觸均接地.該背柵轉移特性曲線為背柵寄生晶體管和STI寄生晶體管轉移特性曲線的疊加.由于STI寄生晶體管閾值電壓更低,因此會先于背柵寄生晶體管開啟,表現為背柵轉移特性曲線上出現一個“駝峰”.輻照后,STI和BOX層中的大量正陷阱電荷分別導致STI和背柵寄生晶體管I-V曲線出現了明顯的負向漂移.當總劑量達到100 krad(Si)時,正是因為STI寄生晶體管在Vbg=0 V時開啟,其開啟電流疊加到正柵主晶體管,使得主晶體管關態漏電流增加.由圖6(b)可以看到,如果在?10—0 V范圍內給背柵施加一個負偏壓,可以使STI寄生晶體管由開啟狀態進入亞閾值狀態,使得疊加到主晶體管的關態漏電流降低(如圖6(a)所示).
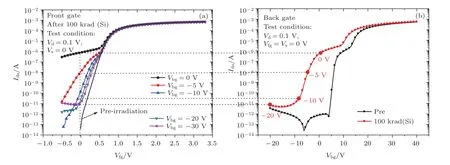
圖6 (a)100 krad(Si)輻照后不同背柵偏壓下10μm/0.35μm器件的前柵轉移特性曲線;(b)10μm/0.35μm器件輻照前后的背柵轉移特性曲線Fig.6.(a)Front gate transfer characteristics of 10μm/0.35μm device with different back gate biases after 100 krad(Si)irradiation;(b)back gate transfer characteristics of 10μm/0.35μm device before and after irradiation.
為了中和STI氧化層正陷阱電荷的影響,抑制STI寄生晶體管的開啟,所加的背柵負偏壓須滿足以下條件:

其中QSTI為STI氧化層中輻射感應的陷阱電荷密度,CSTI為STI寄生晶體管等效柵電容,tSTI為等效柵氧厚度.由于STI氧化層的特殊形貌,STI寄生晶體管的等效柵氧厚度并不是恒定值.如圖7所示,當背柵加偏壓時,其產生的電場開始于背柵,終止于體區,可近似認為以圖中O點為圓心呈圓弧分布[22].因此,STI寄生晶體管的等效柵氧厚度可以認為是沿電場方向的一段圓弧,如圖7中的tSTI,則有

其中td為從O點到STI側壁某點的距離,如圖7所示.由(8)和(9)式可以得到:在靠近背柵的STI底部區域,td較小,為了抑制STI寄生晶體管的開啟所需加的背柵負偏壓也小;在靠近STI頂部區域,td逐漸增加,為了抑制漏電所需的背柵負偏壓也越來越大.在本實驗中,背柵加?10 V的偏壓時,可以有效抑制STI底部區域的導電溝道.但背柵偏壓對STI頂部區域的影響要小得多,靠近STI頂部區域的寄生晶體管仍然開啟,從而產生泄漏電流.由于靠近前柵,該泄漏電流明顯受到前柵電壓的調制,因此表現為器件前柵轉移特性曲線亞閾值區出現“駝峰”現象.該實驗結果也從側面證明,STI底部區域的寄生導電是導致大劑量下器件關態漏電流增加的最主要原因,因此背柵負偏壓抑制了STI底部區域寄生晶體管開啟時器件的關態漏電流大幅下降.
由圖6(a)可以看到,在Vbg=?5 V下測試時,由于背柵耦合導致的閾值電壓負向漂移也會消失.實驗結果表明,可以利用背柵加負偏壓來中和BOX層正陷阱的影響.根據背柵耦合發生的條件可以推導出,當所加背柵負偏壓滿足如下條件時,能完全抑制輻射導致的背柵耦合效應:

其中CBOX為背柵寄生晶體管的單位面積柵電容;QBOX為BOX層中的輻射感應等效陷阱電荷密度;Qc為導致背柵耦合發生的臨界電荷密度,即當BOX層中的陷阱電荷密度為Qc時,SOI器件正好進入全耗盡狀態,滿足Xdm+Xbg=tSi.對于實驗用器件,可計算Qc=8.54×10?8C/cm2.根據100 rad(Si)輻照后背柵寄生晶體管的閾值電壓漂移,可提取出QBOX為1.19×10?7C/cm2.由(10)式可計算,經100 krad(Si)輻照后,在背柵加絕對值大于1.4 V的負偏壓即可消除輻射導致的背柵耦合效應.

圖7 背柵的STI寄生晶體管示意圖Fig.7.STI parasitic transistor at back gate.
3.3 體區負偏壓對寄生效應的影響
輻照后,STI寄生晶體管閾值電壓負向漂移,最終導致器件關態漏電流增加.STI寄生晶體管與主晶體管共用體區,因此可以考慮在體區加負偏壓,利用襯偏效應提高STI寄生晶體管的閾值,從而削弱總劑量效應的影響.

圖8 輻照前和50 krad(Si)輻照后不同體區偏壓下前柵器件的轉移特性曲線 (a)器件尺寸10μm/0.35μm;(b)器件尺寸10μm/10μmFig.8.Transfer characteristics of the front gate device with different body biases before and after 50 krad(Si)irradiation:(a)10μm/0.35μm device;(b)10μm/10μm device.
圖8顯示了輻照前后不同體區偏壓下SOI器件的轉移特性曲線.對于10μm/0.35μm的器件,輻照前Vb<0時的I-V曲線相比于Vb=0時發生了正向漂移.由于襯偏效應的影響,體區加負偏壓使得器件反型時的耗盡層寬度增加,從而導致了器件閾值電壓增加.當Vb=?0.6 V時前柵耗盡區已經增加到與頂層硅厚度相等,器件處于全耗盡狀態,|Vb|的增加無法導致耗盡區的繼續增加,I-V曲線不隨著|Vb|增加繼續向右漂移.輻照后體區負偏壓對10μm/0.35μm器件的轉移特性幾乎無影響.根據前面的分析,輻照后10μm/0.35μm的器件已經處于全耗盡狀態,體區負偏壓已經無法實現耗盡區寬度的調制,因此I-V曲線也沒有出現類似輻照前的正向漂移.與短溝道器件不同,10μm/10μm的器件體區加負偏壓會導致輻照后I-V曲線的正向漂移.這進一步驗證了前面的結果,10μm/10μm器件的體區在輻照后沒有全耗盡.因此能通過體區負偏壓調制耗盡區的寬度,從而增加正柵主晶體管和STI寄生晶體管的閾值電壓.STI寄生晶體管閾值的增加,導致50 krad(Si)輻照后器件關態漏電流減小了一個數量級.但由于SOI器件的頂層硅厚度(即體區厚度)為固定值且很薄,襯偏效應對STI寄生晶體管閾值電壓的調制范圍非常有限.

圖9 (a)輻照后溝道寬度為10μm的器件體區接地和接負偏壓時耗盡區的仿真結果;(b)體區接地和加負偏壓時,沿著切割線A和B處的輻射感應反型層電子密度;切割線A對應于STI邊緣,切割線B對應于遠離STI邊緣的體區內部,其中0μm對應于前柵溝道,0.1μm對應于背柵溝道附近Fig.9.(a)Simulation results of the deletion regions with body biased at 0 V and?1 V after irradiation;(b)electron density along cutting line A and B with different body biases.The cutting line A corresponds to the STI sidewall,cutting line B corresponds to the region far away from STI sidewall.Distance of 0μm corresponds to the front gate channel,and distance of 0.1μm corresponds to the BOX/body interface.
為了進一步驗證體區負偏壓對輻射效應的影響,圖9(a)給出了輻照后溝道長度為10μm的器件體區接地和接負偏壓時耗盡區的TCAD仿真結果.圖中顯示的仿真結構為沿溝道寬度方向的縱向切面二維結構.仿真過程中前柵和背柵接地.STI/體區和BOX/體區界面加上面密度為1×1012cm?2的固定正電荷用以模擬輻照感應的氧化層陷阱電荷.可以看到,STI和BOX中輻照感應的正陷阱電荷會導致STI邊緣和背柵附近的體區耗盡甚至反型,從而形成寄生導電溝道.當體區加?0.6 V的偏壓時,耗盡區展寬,導致此時中性體區消失,部分耗盡器件變成全耗盡.此時體區耗盡層寬度即為體區厚度,不受體區電壓的調節.圖9(b)顯示了體區負偏壓對STI邊緣和背溝道附近感應電子密度的影響.可以看到,在相同的陷阱電荷密度下,STI邊緣底部區域附近的電子密度遠大于頂部區域和BOX附近的電子密度.這是因為STI底部尖角導致電場的聚集,較大的電場強度導致更多的反型電子形成.這也說明STI寄生晶體管更易反型,側面驗證了輻照后器件的關態漏電流增加主要是由STI寄生導電造成的.體區加?0.6 V偏壓時,STI邊緣頂部區域附近的感應電子密度有所降低,而底部區域附近的感應電子密度與體區接地時的相差不多,這證明在STI寄生晶體管完全開啟(強反型)時,體區負偏壓對STI寄生晶體管的耗盡區調制非常有限.相對而言,體區負偏壓對背柵寄生晶體管耗盡區的調制作用更明顯,因此背溝道寄生導電有明顯的削弱.
4 結 論
本文針對不同尺寸的SOI器件開展了60Co γ射線總劑量輻照實驗.所有尺寸的器件在輻照后都出現了關態泄漏電流的增加,這與STI寄生晶體管的開啟有關.在總劑量較小時,STI寄生晶體管處于亞閾值狀態,導致關態漏電流隨總劑量呈指數增加;當總劑量足夠大時,STI寄生晶體管完全開啟,關態漏電流逐漸趨于飽和.輻射導致的閾值電壓漂移呈現出明顯的器件尺寸相關性.窄溝道器件因STI陷阱電荷共享產生明顯的閾值電壓漂移,短溝道器件的閾值漂移則來自于背柵閾值耦合,而大尺寸器件幾乎無閾值電壓漂移.SOI器件背柵負偏壓能有效中和氧化層陷阱電荷的影響,對器件關態漏電流和背柵耦合導致的閾值電壓漂移有一定的改善作用.體區負偏壓也能對寄生晶體管的閾值電壓進行調制,達到器件加固的目的,但受限于頂層硅的厚度,該調制作用非常有限.

