電子束輻照對鍺銻碲非晶薄膜影響的研究
王疆靖,蔣婷婷,田 琳,張丹利,張 偉
(西安交通大學 金屬材料強度國家重點實驗室 微納尺度材料行為研究中心,陜西 西安 710049)
1 前 言
隨著電子顯微技術的發展,透射電子顯微鏡越來越成為材料結構表征的一種不可或缺的手段。尤其是在場發射電子槍和球差校正器日漸普及的今天,透射電子顯微鏡的高分辨能力及高放大倍率等特點,使得研究人員可以高效獲取材料的組織形貌和結構特征等信息[1, 2]。但透射電子顯微鏡在為研究帶來便利的同時,作為光源的高能電子束也會不可避免地對材料造成一定影響[3],特別是對電子束敏感的材料,甚至會引起材料原子結構的改變[4, 5],因此如何減小透射電子顯微鏡中電子束對敏感材料的影響,一直是透射電子顯微技術中的焦點問題之一[6]。
透射電子顯微鏡在研究以硫族化物為主的相變材料時具有極大優勢。相變材料晶態和非晶態之間的物理性能差異巨大,因此在非易失性電學、光學數據存儲設備中具有重要應用[7-12],其各個相的原子結構及內部缺陷,對相變材料快速相變機理及電子性質的研究具有重要的意義[13-21]。在探索相變材料原子結構及缺陷的過程中,透射電子顯微鏡起到了至關重要的作用,從最初利用電子束衍射及高分辨像表征其晶體結構[22-24],到近期利用差校正的高角環形暗場像-掃描透射電子顯微實驗HAADF-STEM(high angle annular dark field-scanning TEM)觀察晶體相原子結構及內部缺陷[25-29],以及利用原子分辨率的能量色散X射線實驗EDX(energy dispersive X-ray)表征其元素分布[14, 30, 31],透射電子顯微鏡可以為相變材料的晶體結構甚至相變過程的研究提供最直觀的實驗證據[31-33]。
除了晶體相,非晶相的局部結構對于非晶相的穩定性及非晶-晶體相變機理的研究也至關重要,但由于非晶相中尺寸極小的局部結構及其對電子束的敏感性,目前關于透射電子顯微鏡表征GeSbTe非晶結構的報道并不多見。Hirata等近期利用透射電子顯微鏡的埃米束電子衍射結合局部反蒙特卡洛模型(local reverse Monte Carlo modeling)模擬,才直觀地探測出GeSbTe非晶材料的局部結構為畸變殘缺的八面體結構[34]。但與此同時,研究人員發現非晶相的GeSbTe、SiSbTe和TiSbTe等相變材料在電子束輻照下均會發生晶化[35-38],這使得上述關于非晶相結構的報道產生了一些爭議。在這種情況下,系統地研究電子束輻照對相變材料非晶相的影響,明確材料在電子束輻照下晶化的誘發條件,并進一步量化測量過程中電子束強度的安全閾值就成為了亟待解決的問題。
本文針對非晶相GeSb2Te4,利用透射電子顯微鏡在TEM模式下進行了不同程度的原位電子束輻照實驗,全面分析了不同電子束流對GeSb2Te4相變材料非晶相的影響,量化了電子束束流誘發材料相變的閾值,為GeSbTe材料非晶相的透射電子顯微鏡結構表征提供了有效的安全界限。
2 實 驗
為方便透射電子顯微鏡表征,本文利用磁控濺射技術分別在Si基底和覆蓋有超薄碳膜的銅載網上沉積了400和80 nm兩種不同厚度的GeSb2Te4非晶薄膜,并覆蓋了一層厚度約為3~5 nm的ZnS-SiO2層以防止樣品氧化。文中TEM模式下的輻照和結構表征工作是在JEOL-JEM-2100F場發射透射電子顯微鏡上完成的,其工作電壓為200 keV。
3 結果與討論
對GeSbTe薄膜來說,電學性能的測試通常是利用沉積在Si基底上的薄膜進行的,為了使結構表征的結果與性能測試相對應,本課題組首先對沉積在Si基底上的非晶薄膜進行了電子束輻照實驗。200 keV是透射電子顯微鏡表征材料結構的常用電壓,因此本課題組選擇了200 keV的加速電壓進行輻照。圖1a為沉積在Si基底上的GeSb2Te4非晶薄膜的明場像,圖中薄膜的邊緣部分為薄區,利用電子能量損失譜實驗EELS(electron energy loss spectroscopy)測試其厚度約為100 nm,電子束足以穿透樣品并進行形貌結構表征。圖中紅圈部分即為電子束輻照的非晶區域,可以看到薄區部分襯度相對均勻,邊緣比較平滑,插圖中的選區電子衍射(selected area electron diffraction,SAED)圖譜也呈現了非晶樣品典型的彌散環狀特征;電子束輻照后的TEM明場像如圖1b所示,從形貌上來看,薄膜邊緣凹凸不平,且有明顯的明暗襯度變化,插圖中的SAED圖譜也不再是彌散狀,取而代之的是由大量明銳斑點組成的環狀圖譜,這些明銳的斑點即為多晶的衍射圖譜,上述特征均說明電子束輻照區域的薄膜已經發生相變,由非晶相變成了晶體相,Zhou等在Ge2Sb2Te5中也觀察到類似現象[36],這在一定程度上說明常見的GeSbTe非晶薄膜在電子束輻照下皆有可能發生結晶化現象。圖1c為圖1b對應的TEM暗場像,暗場像是依靠衍射束成像,物鏡光闌套中特定的衍射斑,與該衍射斑晶體取向一致的晶粒會在圖像中呈現出較亮的襯度,因此利用暗場像可以很容易地觀察到圖像中的晶粒,圖1c紅圈中襯度明亮的區域均為GeSb2Te4晶體顆粒。

圖1 電子束輻照GeSb2Te4非晶薄膜實驗:(a,b) 沉積在Si襯底上的GeSb2Te4非晶薄膜在電子束輻照前后的明場像(紅圈所示即為輻照范圍,插圖為相應的SAED圖譜),圖a中的衍射斑為典型的非晶彌散環狀圖譜,圖b中則是由一些明銳斑點構成的同心圓,說明在電子束輻照下薄膜發生了非晶到多晶的轉變;(c)圖b對應的暗場像,紅圈區域中的亮點即為晶粒;(d~f)薄膜輻照5、15、23 min時的暗場像,隨著輻照的進行,晶粒尺寸也在變大,并最終達到10~20 nm。圖e中黃圈內的兩個晶粒在圖f中合并為一個晶粒,說明在輻照的過程中也發生了晶粒合并Fig.1 Electron beam irradiation in amorphous GeSb2Te4 film: (a, b) the bright field images of as-deposited and irradiated GeSb2Te4 film on Si substrate, respectively (the area inside the red cycle is the irradiation area, the inserts illustrate the corresponding SAED patterns), the SAED pattern shows diffusion halos in Fig.1a, while shows sharp concentric rings in Fig.1b, which indicates the amorphous structure of as-deposited film and the polycrystalline structure of irradiated film; (c) the corresponding dark field image of Fig.1b, the bright spots inside the red cycle are grains; (d~f) the dark field images of irradiation area with 5, 15, 23 min electron beam irradiation, respectively. same as c, the areas with brighter contrast are grains, the grain size increases with irradiation time, and eventually grows to 10~20 nm. Two different grains inside the yellow cycle in Fig.1e merge into one in Fig.1f, which suggests that grain merging happens during growth
鑒于暗場像更易于辨認晶體顆粒,本課題組選擇利用暗場像來記錄輻照過程中的結構變化。圖1d~1f記錄了電子束輻照5、15和23 min時的暗場像,同圖1c一樣,圖中襯度較亮的區域均為晶粒,可以看出隨著輻照時間的推移,薄膜中的晶粒不僅數目增多,尺寸也在增大。圖1e中黃圈所示區域的兩個不同晶粒,隨著輻照的進行,在圖1f中合并為一個晶粒,說明晶粒在長大過程中也伴隨著晶粒合并的現象。
確定了電子束輻照可以誘發GeSb2Te4非晶薄膜的晶化后,我們繼續對晶化過程及晶體結構進行進一步的分析。圖2利用TEM高分辨像和SAED圖譜記錄了GeSb2Te4非晶薄膜在電子束輻照下不同階段的形貌結構特征,輻照電壓為200 keV,電子束密度為6.25×1012m-2·s-1。圖2a為薄膜輻照前的高分辨像,其原子呈均勻無序的分布狀態,衍射斑也表現為彌散的環狀,可以確定是均勻的非晶相。經過5 min輻照后,圖2b中的高分辨像可以看到部分區域已經表現出明顯的晶體取向,如圖中白色虛線所示,對應區域的衍射圖譜雖然還是以彌散狀為主,但也可以觀察到一些明銳的斑點,說明薄膜中已經出現了晶核。與Zhu等利用電子束輻照誘導的Sb2Te3非晶薄膜以生長為主導的晶化機制[38]不同的是,當輻照進行到20 min時,圖1c中的高分辨像顯示GeSb2Te4薄膜中的晶粒不僅數量增多,尺寸也大小不一,說明在原有晶核生長的過程中不斷有新的晶核生成,這些特征均說明GeSb2Te4薄膜的晶化過程是由形核主導的。Kalb等觀察到GeSbTe材料在激光的熱效應下也是以形核主導的晶化機制[39],這在一定程度上說明在熱效應的作用下形核是GeSbTe材料結晶過程的重要機制之一。同時,圖中可以清晰地看到晶粒已經基本占據了整個畫面,且相應衍射圖譜中已經看不到彌散狀特征,而是由明銳的斑點組成的同心環狀圖譜,幾個主要的衍射環已經全部出現,說明此時GeSb2Te4已經基本完成晶化,形成比較穩定的多晶體結構。衍射圖譜的標定結果顯示晶化后的GeSb2Te4為立方相結構,統計的晶粒尺寸也都集中在10~20 nm之間,與文獻中退火實驗所測的立方相~19 nm 的晶粒尺寸相吻合[40],這也從側面證明了200 keV電子束輻照誘導下形成的晶粒為立方相晶體。

圖2 電子束輻照GeSb2Te4非晶薄膜晶化過程中的形貌結構表征:(a~c)輻照過程的高分辨像,插圖為相應的SAED圖譜。輻照前的高分辨像(圖a)均勻無序,衍射斑也呈現出彌散環狀特征,是標準的非晶相;5 min輻照之后,圖b部分區域可以觀察到明顯的晶體取向(如圖中白色虛線所示區域),衍射圖譜雖然還是以彌散環狀為主,但也觀察到一些明銳的斑點,說明薄膜已經開始發生晶化;隨著輻照進行到20 min,圖c中薄膜已經基本晶化完全。(d)分別展示了輻照誘導和退火結晶薄膜的SAED圖譜,兩者的主要衍射環一一對應,說明輻照誘導結晶的樣品為立方相Fig.2 HRTEM characterization of GeSb2Te4 crystallization process under electron beam irradiation:(a~c)HRTEM images with 0, 5, 20 minutes electron beam irradiation, the inserts are corresponding SAED patterns. HRTEM images shows a highly disordered structure without any sign of ordered clusters before irradiation, SAED patterns also illustrates diffusion halos, confirms the fully amorphous nature. With 5 min irradiation, some crystal orientation has been observed in Fig.2b, as marked with white dashed lines. Although the corresponding SAED pattern is still dominated by diffusion halos, some sharp spots can be observed, indicating that some areas of the film have crystallized. As the irradiation time increases to 25 min, the amorphous film crystallized almost completely in Fig.2c. (d)SAED patterns of irradiated crystalline film and thermal annealed crystalline film, respectively. These two SAED patterns match well with each other, indicating that irradiation-induced crystallized sample is in cubic phase
更重要的是,本課題組對同樣的非晶樣品在管式爐中150 ℃下進行了60 min的退火處理,隨后利用透射電子顯微鏡進行了結構表征,圖2d顯示了電子束輻照及退火處理所得多晶體的SAED圖譜對比圖,兩者主要的衍射環一一對應,說明輻照誘導和退火結晶得到的多晶相是一致的。Tomforde等也觀察到同樣的現象,并據此推斷GeSbTe的結晶化是由電子束的熱效應導致的[41],但電子束對材料的作用非常復雜,除了熱效應外,還有撞擊效應、離子化效應、濺射效應和靜電效應等[3],因此電子束輻照下GeSbTe的結晶化是否是由熱效應引起的,還需要進一步的研究。
明確了輻照誘導GeSb2Te4薄膜晶化的晶體結構之后,為進一步明確電子束束流誘發材料相變的條件,本課題組設計了一系列實驗進行探索。在200 keV下利用不同電子束束流對GeSb2Te4非晶薄膜進行輻照,圖3a中的強度為1.88×1012m-2·s-1,插圖中的傅里葉變換(fast fourier transform, FFT)圖譜可以看到當輻照進行到13 min時已經可以看到明顯的多晶斑點,說明13 min時薄膜已經開始晶化;圖3b中的電子束強度為1.25×1012m-2·s-1,比圖3a中稍小,直到輻照實驗進行到60 min,傅里葉變換圖譜中才觀察到多晶斑點的出現,而90 min時也沒有實現完全晶化,高分辨像中依然可以觀察到大量非晶區域,傅里葉變換圖譜中也保留了部分彌散環狀的特征;圖3c中的電子束強度則更小,為9.40×1011m-2·s-1,輻照90 min后的高分辨像中并沒有觀察到明顯的晶體取向,傅里葉變換圖譜也保持了彌散環狀的特征,說明薄膜依然沒有發生晶化。從上述實驗結果來看,GeSb2Te4非晶薄膜發生晶化所需時間隨著電子束強度的減小而增加,當強度減小到9.40×1011m-2·s-1時,薄膜在90 min內很難發生晶化。這一趨勢與Tomforde等在300 keV的透射電子顯微鏡中觀察到的實驗結果類似:GeSbTe非晶薄膜在電子束強度較低的觀察模式下并未晶化,而在電子束強度較高的轉換模式下迅速晶化[41]。

圖3 不同電子束束流強度下進行的GeSb2Te4非晶薄膜的輻照實驗:(a)1.88×1012 m-2·s-1,(b)1.25×1012 m-2·s-1,(c)0.94×1012 m-2·s-1(插圖為相應的FFT圖譜)。如實驗所示,GeSb2Te4非晶薄膜發生晶化所需時間隨著電子束強度的減小而增加,當強度減小到9.40×1011 m-2·s-1時,薄膜在90 min內很難發生晶化Fig.3 Electron beam irradiation experiments of amorphous GeSb2Te4 film under different electron beam density: (a) 1.88×1012 m-2·s-1, (b) 1.25×1012 m-2·s-1, (c) 0.94×1012 m-2·s-1 (The inserts are the corresponding FFT patterns, which is similar to SAED pattern that could identify whether the sample is crystallized). As shown in the series of experiments, the crystallization time of amorphous films gradually increases with the electron beam intensity decreases. As the intensity of the electron beam decreases to 0.94×1012 m-2·s-1, the amorphous film does not crystallize within 90 minutes, indicating a threshold of electron beam induced crystallization in amorphous GeSb2Te4 films
沉積在Si上的薄膜雖然足夠進行輻照實驗,但由于電子束無法穿透極厚的Si襯底,很難實現電子束輻照的量化表征,因此本課題組在銅載網上沉積了厚度約為80 nm 的GeSb2Te4非晶薄膜進行同樣的輻照實驗以量化電子束輻照誘導非晶相GeSbTe材料結晶化的閾值。首先進行了一組對比實驗,實驗條件與上文一致,輻照電壓為200 keV,電子束強度為6.25×1012m-2·s-1。結果顯示隨著輻照的進行,80 nm的GeSb2Te4非晶薄膜與前文實驗的結晶行為完全一致,唯一的區別僅在于其晶化速度比沉積在Si基底上的薄膜更快,這是由于樣品厚度不同導致的,沉積在Si基底上的薄膜較厚,因此需要更長的時間來誘導晶化。對比實驗說明利用沉積在銅載網上的GeSb2Te4非晶薄膜量化電子束誘導GeSbTe材料晶化的閾值是可行的。
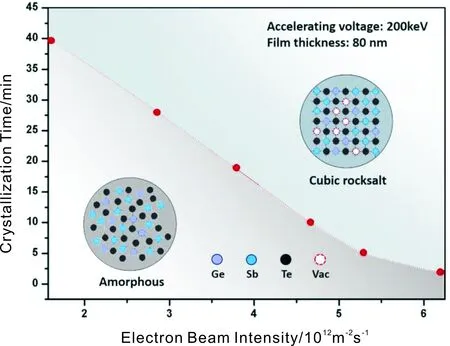
圖4 電子束強度與GeSb2Te4非晶薄膜結晶時間的關系。電子束強度與晶化時間呈反比關系,電子束強度越高,晶化所需時間越短。虛線上方藍色區域表示薄膜會發生晶化,下方灰色區域表示不會發生晶化。插圖為相應的原子結構簡圖,圖中紫色、藍色、黑色和白色小球分別代表Ge,Sb,Te原子和空位Fig.4 Relation of beam intensity and irradition time of GeSb2Te4 films. The electron beam intensity is inversely proportional to the crystallization time, the higher the electron beam intensity, the shorter the crystallization time. The dashed line suggests a safe range to sustain the amorphous phase under the electron beam irradiation. Under the accelerating voltage of 200 keV, the ~80 nm films remain amorphous in the area below the dashed line, while crystallization occurs above the line. The inserts display the corresponding structure of samples, in which the purple, blue, black and white cycles represent Ge, Sb, Te atoms and vacancy, respectively
為了量化電子束強度誘發GeSb2Te4非晶薄膜晶化的閾值,本課題組對GeSb2Te4非晶薄膜進行了不同程度的電子束輻照實驗,得出了電子束輻照強度與樣品結晶化時長的關系,結果如圖4所示,電子束輻照強度與GeSb2Te4非晶薄膜晶化時間呈反比關系,電子束強度越低,晶化所需時間越長,當電子束強度減小到1.57×1012m-2·s-1時,非晶薄膜在40 min內并未發生晶化。正常情況下,40 min足以完成一般的形貌、結構表征過程,因此圖中紅色虛線可以認為是透射電子顯微鏡中表征GeSb2Te4非晶薄膜的安全閾值,虛線以下樣品保持了非晶態,虛線以上樣品則發生了晶化。結合上文中實驗,可以得出結論:在加速電壓為200 keV的TEM模式下,電子束輻照會誘導GeSb2Te4非晶薄膜發生晶化,但具有一個安全閾值,對于厚度接近100 nm的非晶薄膜來說,當電子束強度接近或小于1.00×1012m-2·s-1時,對樣品進行分析表征是安全的,表征過程中非晶薄膜的形貌結構不會受到電子束的明顯影響。
4 結 論
本文通過磁控濺射沉積技術分別在Si基底和超薄碳支持膜銅載網上制備了不同厚度的GeSb2Te4非晶薄膜,利用場發射透射電子顯微鏡在TEM模式下對制備的非晶薄膜樣品進行了不同程度的電子束輻照實驗,全面分析了不同電子束流對GeSb2Te4非晶材料的影響,發現非晶薄膜在較大束流的輻照下會發生晶化,晶化所需時間與束流強度成反比;量化了電子束束流誘發GeSb2Te4薄膜晶化的閾值,明確了電子束流強度和輻照誘導相變時間的關系,對于厚度接近100 nm的非晶薄膜,當電子束強度低于1.00×1012m-2·s-1時,樣品在表征過程中很難晶化。透射電子顯微鏡中的原位電子束輻照實驗對鍺銻碲相變材料的非晶結構表征及相變機理的研究具有重要的參考意義,尤其是輻照相變閾值的量化,可以有效地指導透射電子顯微鏡實驗過程中盡可能避免電子束輻照對相變材料的影響。

