點缺陷對Al0.5Ga0.5N納米片的電子性質和光學性質影響:第一性原理研究
屈藝譜,陳 雪,王 芳,劉玉懷
(鄭州大學 信息工程學院,產業技術研究院,河南 鄭州 450001)
1 引言
深紫外(UV)波段中的高效光源具有廣泛的應用,包括水凈化、滅菌、醫學診斷和生物/化學傳感。傳統的應用設備如汞蒸氣燈、一些氣體激光器和基于變頻的激光器,設備效率低,生態足跡大,光源包含有害物質。相比之下,化合物半導體器件因為其高電效率、高電子-光子轉換率、小尺寸和更綠色的器件制造工藝而越來越受到人們的青睞。AlGaN合金覆蓋了約3.4~ 6.2 eV(200~364 nm)的帶隙能量,可用于固態深紫外光電器件。然而,Al的前驅體TMA的活性非常高,正常的外延生長容易受到一些副反應干擾,氣相中TMA的組分越高,副反應越劇烈,超過50%后,Al結合進AlGaN的效率明顯降低,這樣就造成了高Al組分AlGaN的生長更加困難[1]。
在過去的幾十年中,石墨烯(單層石墨片)由于其獨特的電子結構特性以及廣泛的應用前景,在納米電子學領域引起了人們極大的興趣[2-4]。正是由于這些優異的性能,人們又將目光轉向了Ⅲ-Ⅴ族合成的類石墨烯材料[5]。低維AlGaN納米材料因其具有較好的光電特性、高的熱穩定性和機械穩定性而在過去十年中引起了極大的關注。陳飛等通過化學氣相沉積工藝在Si(100)襯底上制造了多種納米結構的氮化鋁鎵,所有AlxGa1-xN納米結構呈現六方纖鋅礦單相結構和沿(0001)方向的優選取向,通過調整生長參數,根據前體的飽和蒸氣壓力系統地研究了各種AlxGa1-xN納米結構的演變[6]。楊明珠等計算了點缺陷對Al0.375Ga0.625N光電子性質的影響,結果表明,Ga和Al空位導致p型性質,同時N空位的晶體擁有n型屬性。具有點缺陷的晶體的帶隙小于本征晶體的帶隙,Ga空位的形成能最低,表明Ga空位最容易存在于晶體中[7]。通過PA-MBE工藝生長Ⅲ族氮化物通常需要高的Ⅲ族含量以產生光滑的表面和界面。以前Sampath等已有報道,在弱過量Ⅲ族條件下AlGaN的生長導致納米級組成不均勻,這強烈影響它們的載體定位和重組[8]。高涵等計算了六邊形Ⅲ族氮化物單層中的點缺陷,有序合金AlGaN和InGaN單層是具有間接帶隙的非磁性半導體,帶隙寬度取決于合金濃度[9]。AlN[10-12]和GaN[13-15]的二維納米材料研究較多,理論上,AlGaN納米片帶隙能量在1.95 eV[15]和2.93 eV[16]之間。然而,AlGaN二維納米材料的點缺陷研究還很少。
本文建立了5種不同類型的點缺陷模型,包括Al、Ga、N空位和N取代Al、N取代Ga的Al0.5Ga0.5N缺陷模型。
2 理論模型和計算方法
2.1 理論模型
在熱力學下,理想的穩定GaN晶體呈現六方纖鋅礦結構,屬于P63mc(186)空間群。Ga原子坐標(0.333 3,0.666 7,0),N原子坐標(0.333 3,0.666 7,0.381),晶格常數a=b=0.318 9 nm,c=0.518 5 nm,Ga—N鍵長0.194 2 nm,優化后與實驗值和理論值能較好地吻合。為了得到初始的二維GaN納米片,對纖鋅礦GaN沿(001)面切面,構造了一個包含16個Ga原子、16個N原子的4×4×1的單層GaN納米片超胞,不考慮分子層間的相互干擾,真空層設為1.5 nm。為了確保周期性,將其中8個互不相鄰Ga原子替換為Al原子,構建成二維Al0.5Ga0.5N納米片(8個Al原子,8個Ga原子,16個N原子)。本征Al0.5Ga0.5N納米片具有類石墨烯結構,如圖1(a)所示,優化后相鄰最近的3個N原子之間的距離分別是0.311 8,0.311 8,0.318 9 nm,由于N原子之間的庫倫斥力發生變化,相比優化前的值0.318 9 nm有所減小。圖1(b)、(c)、(d)顯示了3個空位缺陷,分別是Al空位(VAl)、Ga空位(VGa)和N空位(VN)的Al0.5Ga0.5N納米片,其中VAl和VGa造成了相鄰N原子之間的距離增加,而VN使得距離減小。圖1(e)、(f)是替代缺陷,分別是N原子取代Al原子(NAl)和N原子取代Ga原子(NGa)的Al0.5Ga0.5N納米片,替換原子周圍由于Al、Ga、N原子的半徑不相同,所以N原子之間距離發生變化。

圖1 不同缺陷下Al0.5Ga0.5N納米片的結構。(a)本征;(b)VAl;(c)VGa;(d)VN;(e)NAl;(f)NGa。Fig.1 Structure of Al0.5Ga0.5N nanosheets under different defects.(a)Intrinsic.(b)VAl.(c)VGa.(d)VN.(e)NAl.(f)NGa.
2.2 計算方法
本文中的所有計算均基于密度泛函理論[17]的從頭算量子力學程序Materialsstudio中的CASTEP(Cambridge sequential total energy package)模塊完成,對電子能帶結構的分析采用平面波贗勢的方法,交換互聯泛函采用PBE(Perdew-Burke-Ernzerhof)形式的廣義梯度近似GGA(Generalized gradient approximation)[18]表示。截斷能為450 eV,采用BFGS算法,對以下參數進行設置。單原子能量收斂精度為1×10-5eV/atom,最大力收斂精度0.3 eV/nm,最大應變收斂精度小于0.05 GPa,最大位移收斂精度小于0.000 1 nm。布里淵區(Brillouin-zone)[19]在自洽周期內的積分通過四面體方法進行,通過Monkhorst-Pack 7×7×1網格形式的高度對稱的K點計算。所有計算都在Al:3s23p1、Ga:3d104s24p1和N:2s22p3的倒數空間中進行。
3 計算結果與分析
3.1 能帶結構和態密度
為了分析缺陷對二維Al0.5Ga0.5N納米片能帶結構和態密度的影響,圖2和圖3分別給出了不同缺陷下Al0.5Ga0.5N納米片的能帶結構圖和電子態密度圖。從圖2(a)可知,Al0.5Ga0.5N導帶最小值位于G點2.537 eV,價帶最大值位于K點0 eV,屬于間接帶隙半導體。導帶位于2.537~5.2 eV,價帶主要由上價帶-5.8~0 eV和下價帶-14.6~-11.2 eV兩部分組成,下價帶距離較遠,不予考慮。從分波態密度圖3(a)中可以看出,價帶主要由N原子的2p態和少量Ga原子的4p態和Al原子的3p態組成,導帶主要由Ga原子的4s和4p態以及少量Al原子的3p態組成。在圖2(b)、(c)中發現,VAl和VGa使Al0.5Ga0.5N納米片帶隙減小,費米能級向價帶深處移動。態密度圖3(b)和圖3(c)較為相似,態密度有整體向低能區移動的趨勢,靠近費米能級附近的態密度峰變得尖銳形成孤立峰,附近的價帶幾乎全由N的2p態提供。從圖2(d)可知,VN缺陷下,費米能級向高能區移動進入導帶,導帶帶隙變窄,Al0.5-Ga0.5N納米片顯示n型特性。同時從圖3(d)可知,N的2s和2p態均向低能區移動,Al的3s和3p態以及Ga的3d、4s和4p態也有同樣的移動趨勢。從圖2(e)、(f)中看出,NAl和NGa都會使得帶隙變窄,呈現半金屬特性,具有NGa缺陷的Al0.5Ga0.5N納米片價帶和導帶有相接的趨勢,這一結論也可以從圖3(e)、(f)中得出。

圖2 不同缺陷下Al0.5Ga0.5N納米片的能帶結構。(a)本征;(b)VAl;(c)VGa;(d)VN;(e)NAl;(f)NGa。Fig.2 Energy band structure of Al0.5Ga0.5N nanosheets under different defects.(a)Intrinsic.(b)VAl.(c)VGa.(d)VN.(e)NAl.(f)NGa.

圖3 不同缺陷下Al0.5Ga0.5N納米片的態密度。(a)本征;(b)VAl;(c)VGa;(d)VN;(e)NAl;(f)NGa。Fig.3 Density of states of Al0.5Ga0.5N nanosheets under different defects.(a)Intrinsic.(b)VAl.(c)VGa.(d)VN.(e)NAl.(f)NGa.
3.2 光學特性
3.2.1 復介電函數
為了研究Al0.5Ga0.5N納米片的光學性質,我們首先計算了納米片復介電函數ε(ω)的實部ε1(ω)和虛部ε2(ω):
ε(ω)=ε1(ω)+iε2(ω),
(1)
ε1(ω)=n2-k2,ε2(ω)=2nk,
(2)
其中,n表示折射系數,k表示消光系數。虛部ε2(ω)通過計算固體電子結構得到,與電子響應有密切的關系。帶間躍遷對介電函數虛部的貢獻,可以通過計算在布里淵區內所有的k點處電子從價帶躍遷到導帶對介電函數虛部貢獻的總和而得到。實部ε1(ω)可通過克拉默斯-克勒尼希(Kramer-Kronig)關系來獲得。表示如下:
|e·MC,V(K)|2d[EC(K)-EV(K)-?ω],
(3)
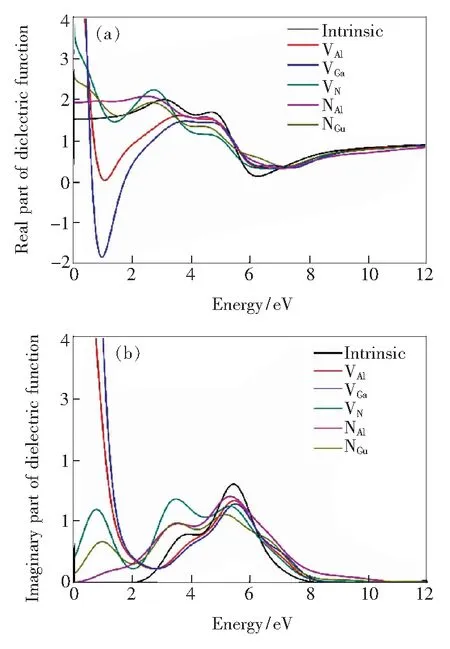
圖4 不同缺陷下Al0.5Ga0.5N納米片的復介電函數。(a)實部;(b)虛部。
Fig.4 Complex dielectric function of Al0.5Ga0.5N nanosheets under different defects.(a)Real part.(b)Imaginary part.
(4)
其中,C、V表示導帶和價帶,BZ代表第一布里淵區,K為倒格矢,|e·MC,V(K)|2是動量躍遷矩陣元,ω是角頻率,EC(K)和EV(K)分別表示導帶和價帶上的本征能級,?是普朗克常量。
本征的和5種不同缺陷的Al0.5Ga0.5N納米片的復介電函數的實部和虛部如圖4(a)、(b)所示。在圖4(a)中,本征的Al0.5Ga0.5N納米片靜態介電函數ε1(0)=1.516,實部的最大值出現在3.07 eV,峰值為1.993;最小值在6.248 eV,谷值為0.124。在3.07~6.248 eV范圍內,實部連續下降。在6.248~23 eV范圍內,實部緩慢增長并最終趨于平穩。空位缺陷VAl、VGa和VN的介電函數實部分別在0~1.06 eV、0~0.96 eV和0~1.39 eV范圍內急劇下降,大于10 eV之后變化緩慢。替代缺陷NAl和NGa對應的靜態介電函數分別是1.93和2.65,相比本征的Al0.5Ga0.5N納米片的靜態介電函數更大。虛部表示帶間躍遷,曲線趨勢的波動可以從圖4(b)中看出。本征的Al0.5Ga0.5N納米片虛部有兩個峰值0.79和1.6,分別在3.86 eV和5.43 eV處。由缺陷導致的結構變化,使得Al0.5Ga0.5N納米片的電子躍遷向低能區移動。不同缺陷下的虛部峰值和所處的能量如表1所示。

表1 不同缺陷下的Al0.5Ga0.5N虛部峰值和對應的能量Tab.1 Al0.5Ga0.5N imaginary peak and corresponding energy under different defects eV
3.2.2 復折射率
材料的復折射率和復介電函數有以下關系:
(5)
(6)
(7)
公式(6)計算的復折射率實部n(ω)結果如圖5(a)所示,本征的Al0.5Ga0.5N納米片折射率靜態值n(0)=1.23,在能量3.13 eV處實部有最大值1.42。隨著能量的增加,大于10 eV之后,折射率的變化很小。空位缺陷VAl、VGa和VN的折射率實部在低能區2 eV之前下降迅速,在2 eV之后分別在3.61,4.8,2.8 eV處有峰值1.61,1.25,1.52,并在15 eV之后不再變化。替代缺陷NAl在0 eV處有靜態折射率1.39,相比本征的靜態折射率較高。在能量2.6 eV處,有峰值1.45,峰值位置向低能區方向偏移,折射率在高能區的范圍減小。N取代Ga缺陷的變化趨勢與N取代Al的相同,且變化幅度更明顯。圖5(b)是復折射率的虛部消光系數。本征的Al0.5Ga0.5N納米片復折射率虛部在4 eV和5.71 eV處均有峰值0.3和0.72。引入空位和替代缺陷后,峰值均向低能區移動,變化趨勢與介電函數虛部相似。
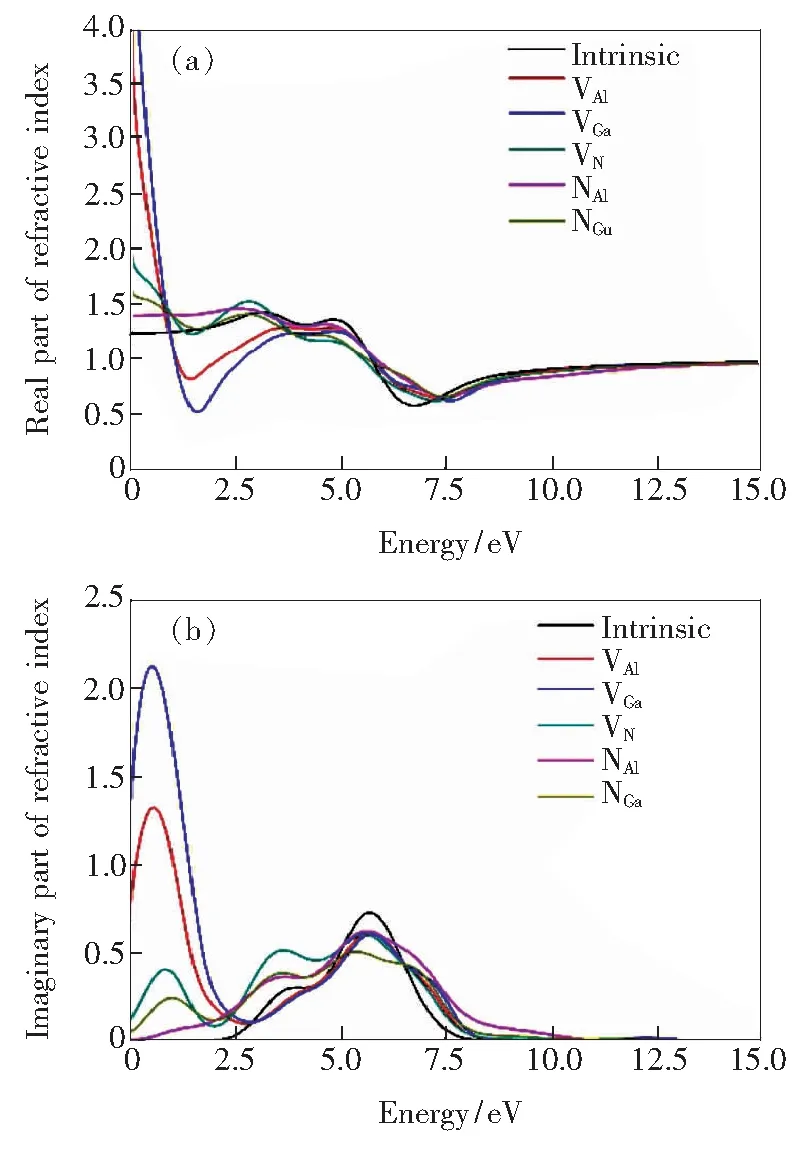
圖5 不同缺陷下Al0.5Ga0.5N納米片的折射率。(a)實部;(b)虛部。Fig.5 Refractive Index of Al0.5Ga0.5N nanosheets under different defects.(a)Real part.(b)Imaginary part.
3.2.3 吸收系數和電子能量損失譜
吸收系數和損失譜計算公式如下:
(8)
圖6(a)是本征的和5種不同缺陷結構的吸收系數。本征Al0.5Ga0.5N納米片的吸收系數吸收范圍在1.75~20.9 eV,在能量5.82 eV處有最大吸收系數6.72×105cm-1。空位缺陷VAl、VGa和VN將吸收光譜分成兩個區域,低能區0~2.8 eV出現新的吸收峰,同時在等同本征最大吸收系數的能量處也出現新的吸收峰,但是峰值低于本征吸收峰,這是因為空位缺陷導致附近的電子結構發生變化。引入替代缺陷NAl和NGa之后,吸收系數減小,在高能區域吸收光譜顯著擴展。電子能量損失函數(EELS)是描述材料中電子快速穿過的能量損失的重要因素。在損耗函數譜中可以看到峰值與共振頻率有關,并且該頻率被稱為等離子體頻率。從圖6(b)中可以看出,對于本征Al0.5Ga0.5N納米片,在6.72 eV處觀察到尖銳峰1.95,該峰值所對應的等離子體邊緣能量是指材料從金屬到絕緣體的轉變點。空位缺陷VAl、VN和VGa導致高能量區主峰的峰值降低并發生偏移,同時在低能區引入了新的尖峰。替代缺陷NAl和NGa導致損失譜范圍變寬,同時尖峰降低并向高能區移動。

圖6 不同缺陷下的Al0.5Ga0.5N納米片。(a)吸收系數;(b)損失譜。Fig.6 Al0.5Ga0.5N nanosheets under different defects.(a)Absorption coefficient.(b)Loss spectra.
4 結論
本文通過第一性原理密度泛函理論計算了5種點缺陷的Al0.5Ga0.5N納米片的電子結構和光學性質。在電子結構方面,空位缺陷導致帶隙變窄,費米能級進入能帶形成簡并態,態密度所在能量區略微變寬,同時向低能區移動;N替代Al或Ga的能帶圖中,價帶和導帶出現相連的趨勢,Al0.5Ga0.5N納米片呈現半金屬特性,仍為半導體材料。在光學性質中,空位缺陷和替代缺陷的影響主要集中在低能區,高能區影響減弱。空位缺陷導致介電函數虛部在低能區有峰值存在,這說明在可見光區域發生了電子躍遷。消光指數受缺陷的影響,導致能量區變寬,在0~0.25 eV區域出現峰值。此外,吸收譜顯示第一吸收高峰以5.82 eV為中心,第二吸收高峰在0.98 eV附近。從電子能量損失譜中發現,空位缺陷的存在導致可見光甚至紅外光區域的吸收增強,這適用于長波光的檢測。本工作對Al0.5Ga0.5N納米片的研究提供了理論參考。

