高能脈沖磁控濺射技術制備VO2薄膜研究進展
谷金鑫, 魏航, 任飛飛, 李龍, 范青潽, 趙九蓬, 豆書亮, 李垚
(1.哈爾濱工業大學 化工與化學學院,黑龍江 哈爾濱 150001;2.哈爾濱工業大學 復合材料與結構研究所,黑龍江 哈爾濱 150001)
高能脈沖磁控濺射(HiPIMS)技術是在直流磁控濺射技術(direet current magnerction sputtering,DCMS)基礎上發展起來的一種新興的電離化物理氣相沉積技術(physical vapour deposition, PVD),區別于傳統磁控濺射技術,HiPIMS技術具有峰值功率密度高(1 kW/cm2),靶附近平均離子密度大(107/cm2)的特點,所制得的薄膜平整致密,與基底結合良好,同時表現出優異的膜層性能[1-3]。目前,采用HiPIMS技術已經可以沉積得到大量功能材料薄膜,如TiO2[4]、ZrO2[5-6]、WC-DLC[7]、VO2[8]等。
二氧化釩(VO2)具有可逆的金屬-絕緣體相變(MIT),是一種熱致變色材料,相變前后其光學性能會發生顯著變化,在近紅外波段由低溫的高透過轉變為高溫的高反射狀態[10-12]。VO2相變溫度在340 K左右,是最接近室溫的熱致變色材料之一,在智能窗、熱控和輻射熱測定器等領域具有廣闊的應用潛力和空間[11-15]。傳統磁控濺射技術如直流磁控濺射(DCMS)和射頻磁控濺射(RFMS)技術如果濺射時基底溫度滿足要求,則可以直接濺射制備VO2薄膜,否則需要后退火等處理;而基底溫度一般要控制在450 ℃以上,難以滿足在柔性基底上的制備。而高能脈沖磁控濺射技術可以利用高能離子轟擊降低薄膜的沉積溫度,即在較低的制備溫度下獲得VO2薄膜,擴展了VO2薄膜的基底材料[8,16]。此外,采用HiPIMS技術沉積的VO2薄膜表面致密,不僅能夠降低其相變溫度,還具有相對良好的環境穩定性[17]。
本文首先介紹高能脈沖磁控濺射技術(HiPIMS),其次闡述了HiPIMS技術制備VO2的最新研究進展,最后展望HiPIMS技術在VO2薄膜制備上的應用前景。
1 高能脈沖磁控濺射技術
高能脈沖磁控濺射(HiPIMS)是一種新興的物理氣相沉積技術(physical vapour deposition,PVD)[18-19]。該技術主要工作原理如圖1(a)所示, HiPIMS技術在極高的脈沖電壓作用下使氬氣(Ar)高度電離,形成大量Ar+等離子體,極端情況下會產生高價等離子體(Ar2+),在艙內電磁場的作用下,正離子向陰極靶材高速移動,靶材濺射出來大量的金屬離子,一部分金屬離子在電場的作用下會繼續向靶面撞擊濺射出二次離子,該過程稱為靶的自濺射過程[20-22],另一部分金屬離子由于動能較高,擺脫電場的束縛,沉積到基片上成膜。與傳統的磁控濺射相比,HiPIMS采用脈沖供電方式,頻率為幾十赫茲到千赫茲,脈沖寬度為10~500 μs,峰值功率極高,為平均功率的百倍以上,極大地提升了放電過程中的離化率。較低的占空比消除了由于電荷累積造成的 “打火”現象,克服了傳統磁控濺射功率過高時水冷不足引起的靶材過熱難題,保證了設備運行的安全性和穩定性,實現了高功率磁控濺射薄膜制備。高能脈沖磁控濺射技術的電壓-電流曲線如圖1(b)所示,隨著電壓的施加,靶電流逐漸增加,當電壓消失時,電流急劇下降,但仍不為零。可以看出一個脈沖周期內,峰值功率達到幾十千瓦。在較短的脈沖時間內,高能脈沖磁控放電過程如圖1(c)所示。階段Ⅰ:電流隨施加電壓逐漸升高,在電壓結束時出現峰值電流,由于電壓很低,此時峰值電流很小。階段Ⅱ:隨著電壓升高,峰值電流急劇增加,靶材濺射出的金屬離子足夠多,其中會有部分金屬離子轟擊靶材,提高了靶材的濺射效率,由于轟擊靶材的離子是靶材自身濺射出的離子,所以將這種濺射稱為自濺射。當電壓消失時由氣體放電所產生的電流也會消失,而自濺射產生的離子電流則會有一個短暫的滯后。階段Ⅲ:電壓繼續增高后,峰值電流也迅速增加,對應于氣體放電的劇烈變化。階段Ⅳ:當電壓增加到一定值時,在整個脈沖內電流隨電壓迅速變化,對應于自濺射的增強。階段Ⅴ:當電壓過高時則會處于一種不穩定放電的狀態,靶材表面劇烈放電,甚至產生電弧。一般高能脈沖磁控濺設發射在階段Ⅱ和Ⅳ,此時金屬靶材的離化率高,放電特性穩定,所制備的膜結構光滑致密,與基底間結合力變強,機械性能得到明顯提升,能滿足結構性質復雜的化合物薄膜制備要求[3,19-22]。

圖1 HiPIMS工作原理及放電過程特性曲線Fig.1 A schematic diagram for the working mechanism and the typical discharge process curve of HiPIMS
由于HiPIMS技術的諸多優點,在1999年由Kouznetsov V[24]提出該方法后發展迅速,近年來高能脈沖磁控濺射技術應用越來越廣泛。有研究發現將高能脈沖磁控濺射技術應用于制備VO2薄膜,所獲得的VO2薄膜較其他方法更加平滑致密,耐久性和抗氧化性有明顯提升[1,9],在一定條件下可大幅降低其制備溫度[24-26],為VO2薄膜制備提供了新的選擇。
2 高能脈沖磁控濺射制備VO2薄膜
2.1 VO2薄膜熱致變色機理
二氧化釩(VO2)是一種多晶相過渡金屬氧化物,只有單斜相VO2(M)和金紅石相VO2(R)之間才能發生可逆一級相變[27-28]。圖2(a)、(b)為VO2低溫單斜相(M)和高溫金紅石相(R)的結構,VO2相變前后的變化使自身的電學和光學性質也發生顯著地變化。當溫度低于68 ℃時,單斜相VO2呈現半導體態,電阻較高,近紅外波段高透過;當溫度超過68 ℃時,轉變為金紅石相VO2,呈現金屬態,電阻較低,近紅外波段高反射。
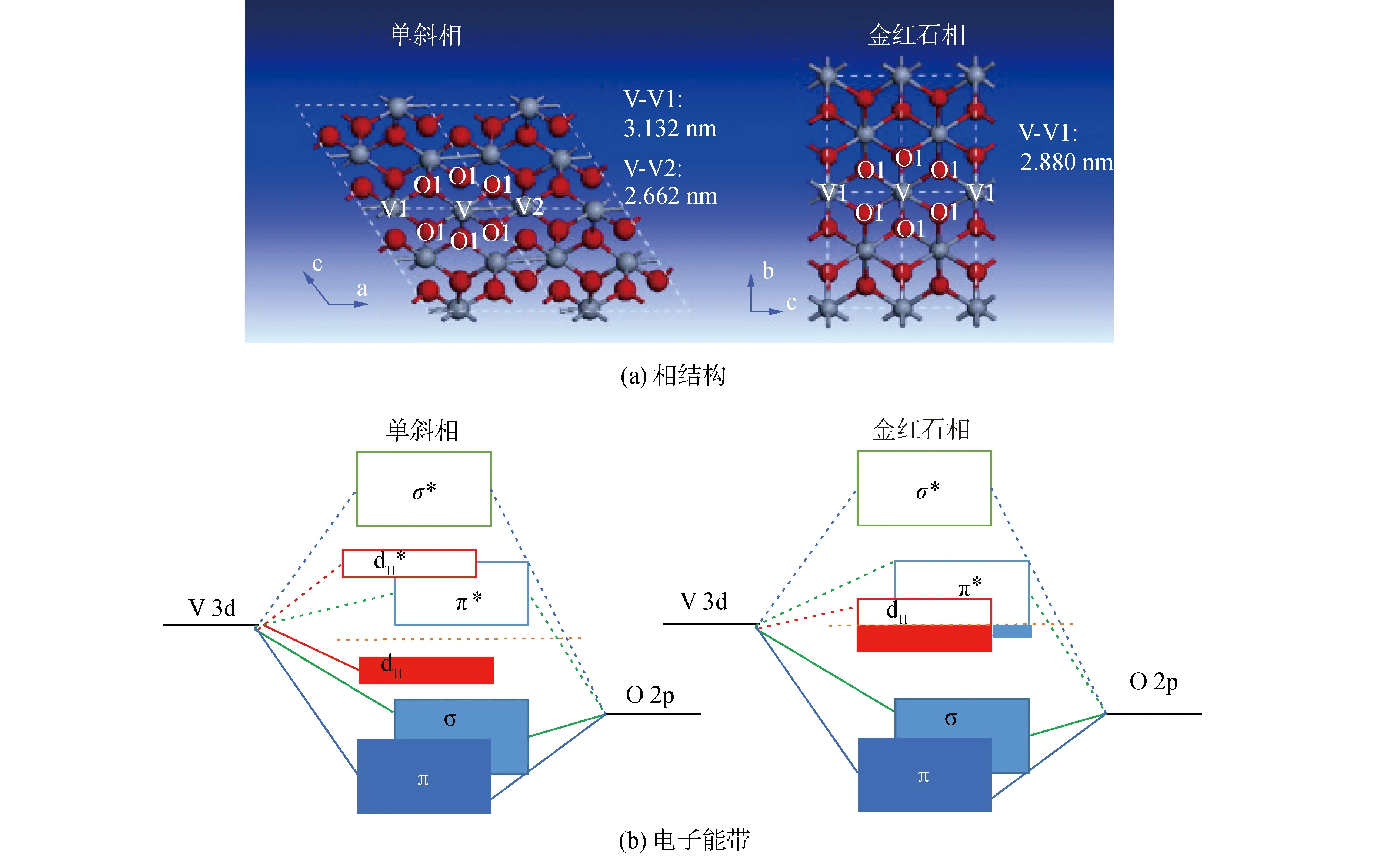
圖2 VO2的相結構和電子能帶結構圖[28,34]Fig.2 Structures and electronic band structure of different VO2 phases [28,34]
由于VO2相變的獨特性,其具體的相變機理也受到了廣泛的研究。目前有3種相變模型解釋其相變機理,分別為莫特相變模型、佩爾斯相變模型和莫特-佩爾斯(Mott-Peierls)相變模型。莫特相變認為電子之間的交互作用驅動相變;佩爾斯相變則認為是晶格畸變驅動相變[29]。但是這2種理論都不能完美的解釋VO2的相變機理,所以有學者提出第3種理論即莫特-佩爾斯相變模型,該模型認為結構變化和電子變化在VO2相變過程中具有協同作用[30-32]。

2.2 HiPIMS技術制備VO2薄膜研究
由于釩(V)價態多樣,其氧化物種類繁多,制備具有熱致變色特性VO2薄膜的條件極為苛刻。VO2薄膜物理性質受自身晶體結構和形貌所決定,而薄膜的晶體結構和形貌顯然又與沉積過程中工藝參數有關[34]。對于HiPIMS 技術而言,氬氧比、濺射功率、基片偏壓和沉積溫度等參數都會對 VO2薄膜的性能產生影響。目前對于HiPIMS技術沉積的VO2薄膜的研究主要集中于降低VO2沉積溫度和優化工藝參數得到結晶良好VO2薄膜[35-36]。
高能脈沖磁控濺射的高能濺射離子可以促進薄膜生長,因此該方法也能降低VO2的制備溫度。Martinu等[1]采用高能脈沖磁控濺射技術在300 ℃基底溫度下沉積得到致密的VO2薄膜,如圖3(a)、(b)所示,薄膜結晶良好,在2 500 nm處相變后透過率(T2500)變化61%,同時相變溫度降低至50 ℃。此外,該課題組利用HiPIMS技術在聚酰亞胺柔性聚合物基底上沉積熱致變色VO2薄膜,其制備溫度可以降低至300 ℃以下,很大程度解決柔性基底材料受溫度限制的問題,但是薄膜的熱致變色性能也因此受到影響,相變程度比較小,其中相轉變溫度在68 ℃左右,而且熱滯回線的寬度也比較大[8]。此外,AIJAZ等[26]通過施加偏壓增加襯底附近的等離子密度來提高電流通量,促進VO2薄膜在低溫下的生長,制備溫度也可以降低到300 ℃,但薄膜室溫透過率較低,如圖4(a)所示。王浪平等[37]則證明了基底偏壓會影響VO2薄膜晶體取以及晶體尺寸,進而影響薄膜相變性能。如圖4(b)、(c)所示,當偏壓從-50 V增加到-250 V時,薄膜晶粒尺寸逐漸變小,同時相變溫度從54 ℃降至31.5 ℃,熱滯回線寬度也逐漸變窄,施加-150 V偏壓所制備的VO2薄膜相變前后ΔT2500變化較大。該課題組研究人員又利用HiPIMS技術在石英玻璃上沉積了不同厚度的VO2薄膜,研究了厚度對VO2薄膜熱致變色特性的影響。如圖4(d)、(e),VO2薄膜厚度影響了薄膜的相變溫度,厚度的增加使薄膜的相變溫度下降,在襯底溫度485 ℃時獲得的8 nm超薄VO2薄膜可見透過達到75%以上[38]。

圖3 利用HiPIMS技術沉積的75nmVO2薄膜的結晶性及光學性能[1]Fig.3 Crystallinity and optical properties of a 75 nm thick VO2 film deposited by HiPIMS[1]
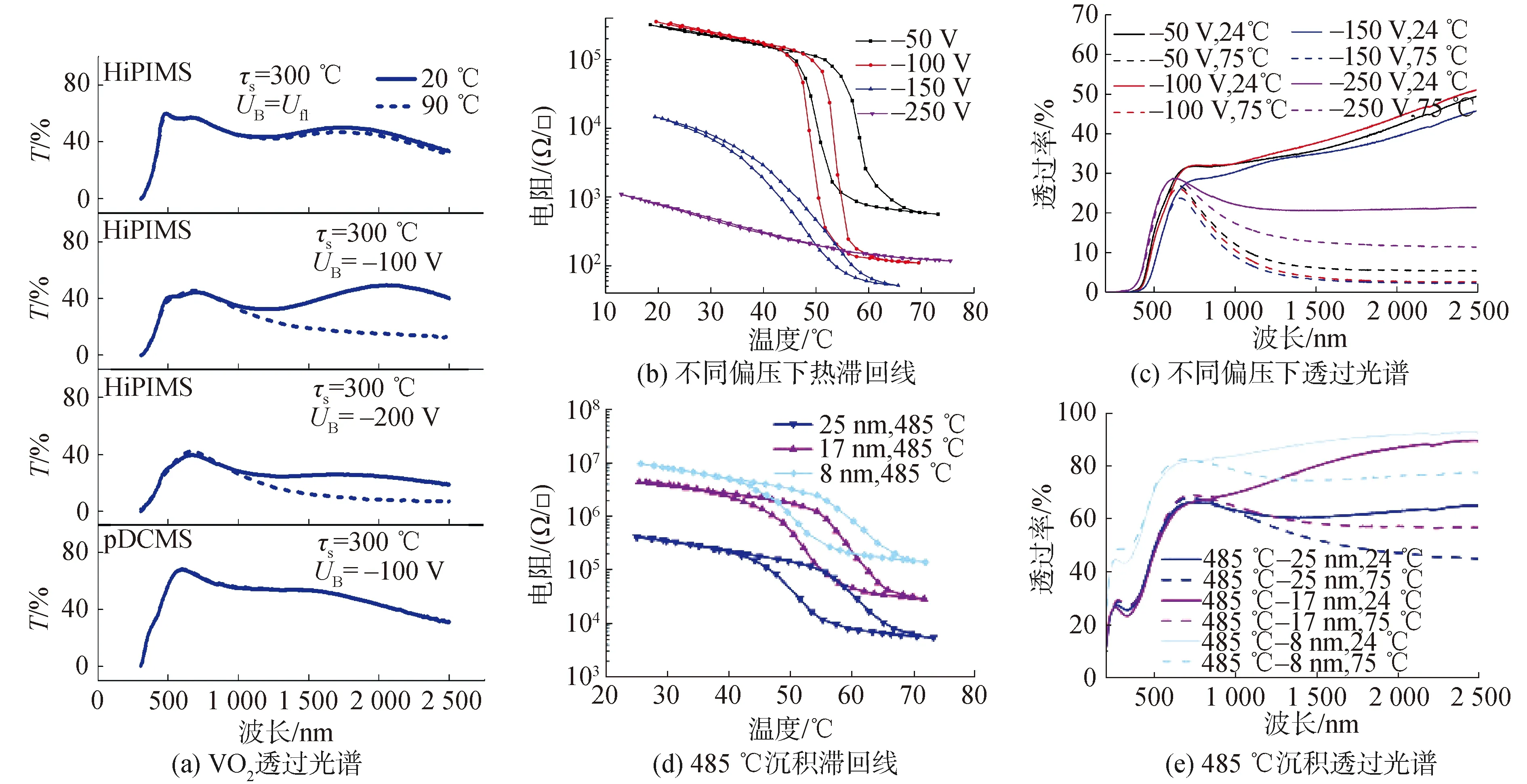
圖4 VO2透過光譜及熱滯回線圖Fig.4 Spectral transmittance and temperature dependence of sheet resistance of the VO2 thin films
此外,相關研究表明高能脈沖磁控濺射技術獲得的致密VO2薄膜能顯著提高其環境穩定性。Loquai S等[17]研究了HiPIMS和RFMS技術制備的VO2薄膜環境穩定性,與RFMS技術相比,利用HiPIMS技術制備的薄膜更加致密,在80 ℃和相對濕度100%的條件老化52 h后仍然保持相對較低粗糙度,ΔT2500從56.4%下降到46.7%,而普通射頻磁控濺射制備得到的薄膜經過相同條件老化之后,ΔT2500從55.2%下降到9%,如圖5所示。結果表明高能脈沖磁控濺射技術獲得的VO2薄膜具有相對較高的環境穩定性。
2.3 VO2多層膜制備研究
在基底上和VO2薄膜之間引入與VO2結構相似的緩沖層可以提高VO2薄膜熱致相變性能。此外,利用光的干涉原理引入一定厚度的增透層,如TiO2[39-41]、ZrO2[42]、Cr2O3[43]等,設計制備多層膜可以提高VO2薄膜的光學性能。目前采用高能脈沖磁控濺射技術制備VO2多層膜的研究開始有文獻報道[42-44]。
為防止高溫時鈉鈣玻璃中鈉的擴散影響薄膜的結晶性,Juan Pichun等[42]設計了VO2/TiO2/glass結構,發現TiO2層不僅可作為緩沖層緩解堿金屬的擴散,還可以改善薄膜的光學性能。如圖6(a)、(b)所示,將制備得到的VO2/TiO2雙層膜用于熱致變色智能窗,其對太陽輻射的調節能力可以達到10.4%。玻璃襯底通常呈現非晶結構,所以沉積在玻璃襯底上的薄膜一般具有多晶結構,熱致相變性能較差[40,43]。Kang Chaoyang等[42]選擇ZrxOy作為VO2薄膜生長的結構模板,設計并制備了VO2/ZrxOy/glass雙層膜,研究了不同溫度下制備的ZrxOy緩沖層對VO2薄膜性能的影響如圖6(c)~(i)所示。在圖6(d~i)中可以觀察到,當緩沖層的生長溫度達到550 ℃時,形成的ZrO2單斜相結構會顯著改善M-VO2薄膜的結晶性,降低了熱滯回線寬度。

圖5 利用RFMS和HiPIMS技術制備的VO2薄膜老化前后透過光譜Fig.5 Transmittance spectra of pre- and post-aging VO2 films prepared by RFMS and HiPIMS[17]

圖6 不同結構的VO2多層膜性能示意Fig.6 Schematic diagram of VO2 multilayer film performance of different structures
Jiri Houska等[43]設計了ZrO2/V1-xWxO2/ZrO2結構,利用二階干涉效應來改善薄膜光學性能。圖7(a)為所設計的三層膜結構示意圖,選用ZrO2作為增透層,W摻雜降低VO2薄膜相變溫度;如圖7(b)、(c)所示實驗得到的ZrO2(180 nm)/V0.988W0.012O2(70 nm)/ZrO2(180 nm)薄膜可見光透過比可達到57.2%,所制備ZrO2(180 nm)/V0.988W0.012O2(70 nm)/ZrO2(205 nm)薄膜的相變溫度降低到40 ℃。此外,該組研究人員還選用SiO2作為頂層增透層設計了VO2/SiO2雙層結構,SiO2薄膜的引入可將室溫下可見光透過比Tlum提高16%,同時提升太陽輻射調節能力,從7.7%提高到了10.3%[44]。

圖7 ZrO2/V1-xWxO2/ZrO2薄膜光學模型及透過光譜[45]Fig.7 Optical model and transmittance spectra of ZrO2/V1-xWxO2/ZrO2 films[45]
4 結論與展望
HiPIMS技術具有高峰值功率密度、高電離度和高等離子體密度等特點,是磁控濺射發展的重要方向,在大規模生產和使用中也具有潛在應用價值。基于上述優點,HiPIMS技術被廣泛的應用于沉積VO2薄膜,通過調控高能脈沖磁控濺射的沉積參數,控制濺射出來的金屬靶粒子能量,實現低溫原位制備VO2薄膜。HiPIMS技術的放電特性受到沉積氣體和靶材的影響。在采用高能脈沖磁控濺射的過程中氬氧比、濺射功率、基片偏壓和沉積溫度等參數都會對 VO2薄膜的性能產生影響。目前HiPIMS技術沉積的VO2薄膜的研究主要集中于降低VO2沉積溫度和優化工藝參數得到結晶良好VO2薄膜,進而獲得柔性VO2薄膜和提高薄膜的環境穩定性。但是在利用HiPIMS技術制備VO2的過程中仍需面臨許多挑戰,現總結如下兩點:
1)在應用HiPIMS技術沉積VO2薄膜的過程中,靶表面以及倉體里的狀況對沉積過程具有顯著的影響,研究如何避免因靶材中毒產生電弧放電現象以及高峰值離子電流引起的基底偏置,將對沉積薄膜的質量提高具有重要意義。
2)與傳統磁控濺射技術制備VO2薄膜相比,HiPIMS技術濺射過程中成膜機理尚未厘清,缺乏制備參數對成膜性能影響規律的詳細研究,仍需要開展大量研究工作。
綜上所述,未來對HiPIMS技術制備VO2薄膜的固有濺射機制、電弧現象以及相對復雜的工藝技術等進行更加深入的研究,將有利于推進VO2薄膜在智能窗、智能熱控、微輻射計和微機械等領域的應用。

